集成电路设计答案-王志功版
- 格式:docx
- 大小:201.64 KB
- 文档页数:10

集成电路版图设计习题答案第8章 MOS场效应晶体管【习题答案】1.请画出MOS晶体管的结构示意图。
答:2.请简述MOS晶体管各个版图层的作用。
●答:阱层(Well):阱层定义在衬底上制备阱的区域。
NMOS管制备在P型衬底上,PMOS管制备在N型衬底上。
一块原始的半导体材料,掺入的杂质类型只能有一种,即该衬底不是N型就是P型。
如果不对衬底进行加工处理的话,该衬底只能制备一种MOS晶体管。
CMOS集成电路是把NMOS晶体管和PMOS晶体管制备在同一个硅片衬底上,为了能够制造CMOS集成电路,需要对衬底进行处理,利用掺杂工艺在衬底上形成一个区域,该区域的掺杂类型和衬底的掺杂类型相反,这个区域就称为阱。
●有源区层(Active):有源区层的作用是在衬底上定义制作有源区的区域,该区域包括源区、漏区和沟道。
在衬底上淀积厚氧化层,利用光刻和刻蚀工艺在衬底上开窗口并把厚氧化层除去就可形成有源区,有源区之外的区域是场区。
显然,MOS管必须而且只能制备在有源区内。
●多晶硅层(Poly):多晶硅层的作用是定义制作多晶硅材料的区域。
最早的MOS集成电路制造工艺只能制备一层多晶硅,而现在已经有能够制备两层多晶硅的工艺了。
对于双层多晶硅工艺,第一层多晶硅主要用来制作栅极、导线和多晶硅—多晶硅电容的下极板,第二层多晶硅主要用来制作多晶硅电阻和多晶硅-多晶硅电容的上极板。
双层多晶硅工艺具有多晶硅1和多晶硅2这两个版图层。
●P+注入层和N+注入层(P+implant和N+ implant):P+注入层定义注入P+杂质离子的区域,而N+注入层定义注入N+杂质离子的区域。
由于NMOS晶体管和PMOS晶体管的结构相同,只是源漏区的掺杂类型相反。
同时,有源区层只是定义了源区、漏区和沟道的区域,却没有说明源区和漏区的掺杂类型。
P+注入层和N+注入层说明了注入杂质的类型,也就是说明了有源区的导电类型,实现了NMOS晶体管和PMOS晶体管的区分。

专升本《集成电路版图设计》一、(共75题,共150分)1. 单词“LAYOUT”的含义是:()。
(2分)A.版图B.电路C.输出.标准答案:A2. 集成电阻通常由扩散或者淀积层形成,通常可以用厚度一定的薄膜作为模型,因此习惯上把电阻率和厚度合成一个单位,称为()。
(2分)A.方块电阻B.电阻C.半导体电阻.标准答案:A3. 由于其较小的方块电阻,发射区是唯一适合于制作较小电阻(0.5~100)的区域。
对于发射区电阻可以忽略()和电导调制效应。
(2分)A.电流调制B.电压调制C.电荷调制.标准答案:B4. 在模拟BiCMOS工艺中,发射区电阻可以直接置入()外延层内;(2分)A.P型B.N型C.P型或N型.标准答案:A5. 电容的标准单位是()。
(2分)A.法拉B.伏特C.安培.标准答案:A6. CMOS工艺中的多晶硅-多晶硅电容,()可以用作多晶硅-多晶硅电容的下电极。
(2分)A.电阻多晶硅B.电容多晶硅C.多晶硅栅.标准答案:C7. 单位面积电容与相对介电常数即电介质常数成()。
(2分)A.反比B.正比C.无关.标准答案:B8. 流过导体的电流会在导体周围产生()。
(2分)A.电场B.磁场C.电磁场.标准答案:B9. 发射结和集电结的击穿决定了一个双极型晶体管的()工作电压。
重要的三种击穿电压为VEBO,VCBO,VCEO等。
(2分)A.最大 B.最小 C.任意.标准答案:A10. 发射极开路时集电极的击穿电压表示为VCBO,绝大多数晶体管的集电区和基区都是()的,所以VCBO通常很大。
(2分)A.重掺杂B.不掺杂C.轻掺杂.标准答案:C11. 二极管连接形式的晶体管可以作为一个很方便的基准()源。
(2分)A.电压B.电流C.电压或电流.标准答案:A12. 使用P型外延层,必须加入深的轻掺杂()型扩散区用于制作PMOS晶体管。
(2分)A.NB.PC.N或P.标准答案:A13. MOS晶体管是一种()控制器件。
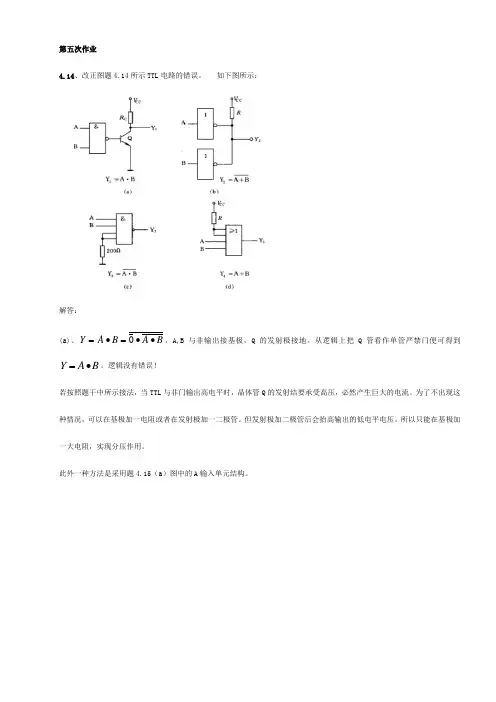
第五次作业4.14、改正图题4.14所示TTL 电路的错误。
如下图所示:解答:(a)、B A B A Y ••=•=0,A,B与非输出接基极,Q 的发射极接地。
从逻辑上把Q 管看作单管严禁门便可得到B A Y •=。
逻辑没有错误!若按照题干中所示接法,当TTL 与非门输出高电平时,晶体管Q 的发射结要承受高压,必然产生巨大的电流。
为了不出现这种情况,可以在基极加一电阻或者在发射极加一二极管。
但发射极加二极管后会抬高输出的低电平电压。
所以只能在基极加一大电阻,实现分压作用。
此外一种方法是采用题4.15(a )图中的A 输入单元结构。
(b)、要实现由,我们可以使用线与+得到和B A B A 。
但题干中的线与功能不合理。
若其中一个为高电平且此外一个为低电平时,高电平输出降会往低电平输出灌电流,从而容易引起逻辑电平混乱。
为了消除这一效应,可以在各自的输出加一个二极管。
(c)、电阻不应当接地,应当接高电平 (d)、电阻不应当接VCC ,而应当接低电平4.15、试分析图题4.15(a ),(b)所示电路的逻辑功能。
解答:图(a )中,单元1实现了A 的电平输入,B 是A 的对称单元。
功能单元2实现了A 和B 输入的或逻辑功能单元4充当了Q8管的泄放网络,同时抬高了Q3,Q4管的输入逻辑电平,此外该单元还将或的结果传递给了Q8管 功能单元3中的Q8管实现了非逻辑,Q6和Q7复合管加强了输出级的驱动能力。
综上所述,4.15(a )电路实现功能为B A Y +=,即或非的功能图(b)中,Q1,Q2管仍然实现传递输入的功能,Q3,Q4管实现或非的功能 Q6管和Q5管以及R5,R7共同组成的泄放网络实现了电压的传递Q9管实现了非功能,Q7,Q8管仍然是用来驱动负载的。
Q9管和Q7,Q8轮流导通综上所述,4.15(b )实现的功能为B A B A Y +=+=第六次作业:5.1已知一ECL 电路如图题5.1所示,其Vcc=0V ,V EE =-4.5V ,V BEF =0.8V ,V BB =-1.2V ,逻辑摆幅V L =0.8V 且对称于参考电压,各管的I E,MAX =5mA ,并假设输入和输出的逻辑电平V i ,V o 互相匹配,且忽略基极电流的影响。

集成电路设计复习题绪论1.画出集成电路设计与制造的主要流程框架。
2.集成电路分类情况如何?集成电路设计1.层次化、结构化设计概念,集成电路设计域和设计层次2.什么是集成电路设计?集成电路设计流程。
(三个设计步骤:系统功能设计逻辑和电路设计版图设计)3.模拟电路和数字电路设计各自的特点和流程4.版图验证和检查包括哪些内容?如何实现?5.版图设计规则的概念,主要内容以及表示方法。
为什么需要指定版图设计规则?6.集成电路设计方法分类?(全定制、半定制、PLD)7.标准单元/门阵列的概念,优点/缺点,设计流程8.PLD设计方法的特点,FPGA/CPLD的概念9.试述门阵列和标准单元设计方法的概念和它们之间的异同点。
10.标准单元库中的单元的主要描述形式有哪些?分别在IC设计的什么阶段应用?11.集成电路的可测性设计是指什么?Soc设计复习题1.什么是SoC?2.SoC设计的发展趋势及面临的挑战?3.SoC设计的特点?4.SoC设计与传统的ASIC设计最大的不同是什么?5.什么是软硬件协同设计?6.常用的可测性设计方法有哪些?7. IP的基本概念和IP分类8.什么是可综合RTL代码?9.么是同步电路,什么是异步电路,各有什么特点?10.逻辑综合的概念。
11.什么是触发器的建立时间(Setup Time),试画图进行说明。
12.什么是触发器的保持时间(Hold Time),试画图进行说明。
13. 什么是验证,什么是测试,两者有何区别?14.试画图简要说明扫描测试原理。
绪论1、 画出集成电路设计与制造的主要流程框架。
2、集成电路分类情况如何?集成电路设计1. 层次化、结构化设计概念,集成电路设计域和设计层次分层分级设计和模块化设计.将一个复杂的集成电路系统的设计问题分解为复杂性较低的设计级别,⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎩⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎪⎨⎧⎪⎪⎪⎪⎩⎪⎪⎪⎪⎨⎧⎩⎨⎧⎩⎨⎧⎪⎪⎪⎪⎩⎪⎪⎪⎪⎨⎧⎪⎪⎪⎪⎪⎪⎩⎪⎪⎪⎪⎪⎪⎨⎧⎩⎨⎧⎪⎪⎪⎪⎩⎪⎪⎪⎪⎨⎧⎩⎨⎧⎪⎩⎪⎨⎧按应用领域分类数字模拟混合电路非线性电路线性电路模拟电路时序逻辑电路组合逻辑电路数字电路按功能分类GSI ULSI VLSI LSI MSI SSI 按规模分类薄膜混合集成电路厚膜混合集成电路混合集成电路B iCMOS B iMOS 型B iMOS CMOS NMOS PMOS 型MOS双极型单片集成电路按结构分类集成电路这个级别可以再分解到复杂性更低的设计级别;这样的分解一直继续到使最终的设计级别的复杂性足够低,也就是说,能相当容易地由这一级设计出的单元逐级组织起复杂的系统。


2025年招聘集成电路设计岗位面试题与参考回答(某世界500强集团)(答案在后面)面试问答题(总共10个问题)第一题题目:请您解释什么是CMOS技术,并简述它在现代集成电路设计中的重要性。
此外,请说明CMOS技术相比于其他技术(如 Bipolar、BiCMOS)的优势和局限性。
第二题题目描述:请您描述一次您在集成电路设计项目中遇到的最大挑战,以及您是如何克服这个挑战的。
第三题题目:请解释什么是CMOS反相器,并描述其工作原理。
此外,请说明在实际应用中,CMOS 反相器如何实现低静态功耗的特点。
第四题题目:请描述一次你在集成电路设计中遇到的一个技术难题,以及你是如何解决这个问题的。
第五题题目:请解释什么是锁相环(PLL)及其在集成电路设计中的作用。
并描述一个简单的PLL 系统的基本组成模块及其工作原理。
第六题题目:请简要描述您在以往工作中遇到的最具挑战性的集成电路设计项目,以及您是如何克服这个挑战的。
第七题题目:请描述一次您在集成电路设计过程中遇到的技术难题,以及您是如何解决这个问题的。
第八题题目:请您描述一次在项目开发过程中,您遇到的技术难题,以及您是如何解决这个问题的。
第九题题目描述:请您描述一次在集成电路设计中遇到的技术难题,以及您是如何解决这个问题的。
请详细说明问题背景、您采取的解决方案、最终结果以及从中得到的经验教训。
第十题题目:请描述一次你在集成电路设计中遇到的最大挑战,你是如何克服这个挑战的?2025年招聘集成电路设计岗位面试题与参考回答(某世界500强集团)面试问答题(总共10个问题)第一题题目:请您解释什么是CMOS技术,并简述它在现代集成电路设计中的重要性。
此外,请说明CMOS技术相比于其他技术(如 Bipolar、BiCMOS)的优势和局限性。
参考答案:CMOS(Complementary Metal-Oxide-Semiconductor)技术是一种广泛应用于现代集成电路设计的技术。

CH11.按规模划分,集成电路的发展已经经历了哪几代?它的发展遵循了一条业界著名的定律,请说出是什么定律?晶体管-分立元件-SSI-MSI-LSI-VLSI-ULSI-GSI-SOC。
MOORE定律2.什么是无生产线集成电路设计?列出无生产线集成电路设计的特点和环境。
拥有设计人才和技术,但不拥有生产线。
特点:电路设计,工艺制造,封装分立运行。
环境:IC产业生产能力剩余,人们需要更多的功能芯片设计3.多项目晶圆(MPW)技术的特点是什么?对发展集成电路设计有什么意义?MPW:把几到几十种工艺上兼容的芯片拼装到一个宏芯片上,然后以步行的方式排列到一到多个晶圆上。
意义:降低成本。
4.集成电路设计需要哪四个方面的知识?系统,电路,工具,工艺方面的知识CH21.为什么硅材料在集成电路技术中起着举足轻重的作用 ?原材料来源丰富,技术成熟,硅基产品价格低廉2.GaAs和InP材料各有哪些特点? P10,11 3.怎样的条件下金属与半导体形成欧姆接触?怎样的条件下金属与半导体形成肖特基接触?接触区半导体重掺杂可实现欧姆接触,金属与掺杂半导体接触形成肖特基接触4.说出多晶硅在CMOS工艺中的作用。
P13 5.列出你知道的异质半导体材料系统。
GaAs/AlGaAs, InP/ InGaAs, Si/SiGe, 6.SOI材料是怎样形成的,有什么特点?SOI绝缘体上硅,可以通过氧隔离或者晶片粘结技术完成。
特点:电极与衬底之间寄生电容大大减少,器件速度更快,功率更低7. 肖特基接触和欧姆型接触各有什么特点?肖特基接触:阻挡层具有类似PN结的伏安特性。
欧姆型接触:载流子可以容易地利用量子遂穿效应相应自由传输。
8. 简述双极型晶体管和MOS晶体管的工作原理。
P19,21CH31.写出晶体外延的意义,列出三种外延生长方法,并比较各自的优缺点。
意义:用同质材料形成具有不同掺杂种类及浓度而具有不同性能的晶体层。
外延方法:液态生长,气相外延生长,金属有机物气相外延生长2.写出掩膜在IC制造过程中的作用,比较整版掩膜和单片掩膜的区别,列举三种掩膜的制造方法。

集成电路设计(王志功)第三版第二章复习材料1、电子系统特别是微电子系统应用的材料有哪几类?三类:导体,半导体,绝缘体。
2、集成电路制造常用的半导体材料有哪些?硅,锗,砷化镓,磷化铟等。
3、为什么说半导体材料在集成电路制造中起着根本性的作用?首先,集成电路通常是制作在半导体衬底材料之上的;同时,集成电路中的基本元件是根据半导体的特性构成的。
4、半导体材料得到广泛应用的原因是什么?①通过掺入杂质可以明显改变半导体的电导率;②当半导体受到外界热的刺激时,其导电能力将发生显著变化(热敏效应);③光照也可改变半导体的电导率(光敏效应);④多种由半导体构成的结构中,当注入电流时会发射出光。
5、Si、GaAs、InP三种基本半导体材料中,电子迁移率最高的是哪种?最低的是哪种?最高:GaAs 最低:Si6、在过去40年中,基于硅材料的多种成熟工艺技术有哪些?双极型晶体管(BJT)结型场效应管(J-FET)P型场效应管(PMOS)N型场效应管(NMOS)互补型金属-氧化物-半导体场效应管(CMOS)双极型管CMOS(BiCMOS)等。
7、硅基最先进的工艺线晶圆直径已达到多少?0.13umCMOS工艺制成的CPU运行速度已达多少?300mm(12英寸);超过2GHz。
8、为什么市场上90%的IC产品都是基于Si工艺的?因为原材料来源丰富,技术成熟,硅基产品保持价格低廉。
9、与Si材料相比,GaAs具有哪些优点?①砷化镓中非平衡少子饱和漂移速率为4×1072cm/(V.s),大约是硅9×1062cm/(V.s)的4倍,因此可制成更快的器件和IC;②砷化镓导带极小值和价带最大值都出现在布里渊区波矢为0处,而硅的导带最小值在X点,所以在砷化镓中,电子和空穴可直接复合,而硅则不行;③砷化镓中价带与导带之间的禁带为1.43eV,大于硅的1.11eV。
所以稳态时,在300K室温下,砷化镓本征激发中载流子密度(106cm3-)远小于硅(1010cm3-)。

1.集成电路的发展过程经历了哪些发展阶段?划分集成电路的标准是什么?集成电路的发展过程:•小规模集成电路(Small Scale IC,SSI)•中规模集成电路(Medium Scale IC,MSI)•大规模集成电路(Large Scale IC,LSI)•超大规模集成电路(Very Large Scale IC,VLSI)•特大规模集成电路(Ultra Large Scale IC,ULSI)•巨大规模集成电路(Gigantic Scale IC,GSI)划分集成电路规模的标准2.超大规模集成电路有哪些优点?1. 降低生产成本VLSI减少了体积和重量等,可靠性成万倍提高,功耗成万倍减少.2.提高工作速度VLSI内部连线很短,缩短了延迟时间.加工的技术越来越精细.电路工作速度的提高,主要是依靠减少尺寸获得.3. 降低功耗芯片内部电路尺寸小,连线短,分布电容小,驱动电路所需的功率下降.4. 简化逻辑电路芯片内部电路受干扰小,电路可简化.5.优越的可靠性采用VLSI后,元件数目和外部的接触点都大为减少,可靠性得到很大提高。
6.体积小重量轻7.缩短电子产品的设计和组装周期一片VLSI组件可以代替大量的元器件,组装工作极大的节省,生产线被压缩,加快了生产速度.3.简述双阱CMOS工艺制作CMOS反相器的工艺流程过程。
1、形成N阱2、形成P阱3、推阱4、形成场隔离区5、形成多晶硅栅6、形成硅化物7、形成N管源漏区8、形成P管源漏区9、形成接触孔10、形成第一层金属11、形成第一层金属12、形成穿通接触孔13、形成第二层金属14、合金15、形成钝化层16、测试、封装,完成集成电路的制造工艺4.在VLSI设计中,对互连线的要求和可能的互连线材料是什么?互连线的要求低电阻值:产生的电压降最小;信号传输延时最小(RC时间常数最小化)与器件之间的接触电阻低长期可靠工作可能的互连线材料金属(低电阻率),多晶硅(中等电阻率),高掺杂区的硅(注入或扩散)(中等电阻率)5.在进行版图设计时为什么要制定版图设计规则?—片集成电路上有成千上万个晶体管和电阻等元件以及大量的连线。

集成电路设计基础_华中科技大学中国大学mooc课后章节答案期末考试题库2023年1.画小信号等效电路时,恒定电流源视为。
答案:开路2.模拟集成电路设计中可使用小信号分析方法的是。
答案:增益3.模拟集成电路设计中可使用大信号分析方法的是()。
答案:输出摆幅4.题1-1-1 中国高端芯片联盟正式成立时间是:。
答案:2016年7月5.题1-1-2 如下不是集成电路产业特性的是:。
答案:低风险6.题1-1-3 摩尔定律是指集成电路上可容纳的晶体管数目,约每隔:个月便会增加一倍,性能也将提升一倍。
答案:187.MOS管的小信号模型中,体现沟长调制效应的参数是()。
答案:8.工作在饱和区的MOS管,可以被看作是一个。
答案:电压控制电流源9.下图中的MOS管工作在区(假定Vth=0.7V)。
【图片】答案:饱和区10.一个MOS管的本征增益表述错误的是。
答案:与MOS管电流无关11.工作在区的MOS管,其跨导是恒定值。
答案:饱和12.MOS管中相对最大的寄生电容是。
答案:栅极氧化层电容13.MOS管的小信号输出电阻【图片】是由MOS管的效应产生的。
答案:沟长调制14.题1-1-4 摩尔定律之后,集成电路发展有三条主线,以下不是集成电路发展主线的是:。
答案:SoC15.题1-1-5 单个芯片上集成约50万个器件,按照规模划分,该芯片为:。
答案:VLSI16.题1-1-6 年发明了世界上第一个点接触型晶体管。
答案:194717.题1-1-7 年发明了世界上第一块集成电路。
答案:195818.题1-1-8 FinFET等多种新结构器件的发明人是:。
答案:胡正明19.题1-1-9 集成电路代工产业的缔造者:。
答案:张忠谋20.题1-1-10 世界第一块集成电路发明者:。
答案:基尔比21.MOS管一旦出现现象,此时的MOS管将进入饱和区。
答案:夹断22.MOS管从不导通到导通过程中,最先出现的是。
答案:耗尽23.在CMOS模拟集成电路设计中,我们一般让MOS管工作在区。

2024年招聘集成电路设计岗位笔试题及解答(某大型国企)(答案在后面)一、单项选择题(本大题有10小题,每小题2分,共20分)1、集成电路设计的主要目的是实现以下哪种功能?A、数据存储B、数据传输C、信号放大D、逻辑运算2、在CMOS工艺中,以下哪一项不是晶体管的工作状态?A、线性放大区B、饱和区C、截止区D、存储区3、在CMOS逻辑电路中,当输入信号从低电平变为高电平时,NMOS晶体管的工作状态会如何变化?A. 从导通变为截止B. 保持导通C. 从截止变为导通D. 保持截止4、在数字集成电路中,同步复位与异步复位的主要区别在于:A. 同步复位只在时钟边沿有效,而异步复位则与时钟无关。
B. 异步复位比同步复位更节省电力。
C. 同步复位需要额外的外部信号来触发。
D. 异步复位可以实现更快的数据处理速度。
5、集成电路设计中,以下哪种类型的逻辑门在数字电路中应用最为广泛?A. OR门B. AND门C. NOT门D. XOR门6、在集成电路设计中,以下哪个术语用于描述在模拟电路中,由于温度、电源电压等因素变化而导致的电路性能变化?A. 时钟抖动B. 静态功耗C. 温度系数D. 信号完整性7、在CMOS工艺中,哪种场效应管使用最为广泛?A、NMOS管B、PMOS管C、NMOS2管D、CMOS管8、在高速运算电路中,如何减小延迟时间?A、增加晶体管尺寸B、降低电源电压C、优化布局布线D、提高环境温度9、题目:下面哪个选项描述的是集成电路设计中常见的半导体材料?A. 硅和锗B. 钨和钼C. 氮气和氢气D. 金和银 10、题目:在集成电路设计中,下面哪个术语描述的是电路中模拟信号转换为数字信号的过程?A. 编译器B. 读取操作C. 模数转换(A/D转换)D. 命令二、多项选择题(本大题有10小题,每小题4分,共40分)1、关于CMOS逻辑门电路的描述,哪些是正确的?(多选)A. CMOS逻辑门在静态情况下几乎不消耗电流。
集成电路版图设计习题答案第2章 集成电路制造工艺【习题答案】1.硅片制备主要包括(直拉法)、(磁控直拉法)和(悬浮区熔法)等三种方法。
2.简述外延工艺的用途。
答:外延工艺的应用很多。
外延硅片可以用来制作双极型晶体管,衬底为重掺杂的硅单晶(n +),在衬底上外延十几个微米的低掺杂的外延层(n ),双极型晶体管(NPN )制作在外延层上,其中b 为基极,e 为发射极,c 为集电极。
在外延硅片上制作双极型晶体管具有高的集电结电压,低的集电极串联电阻,性能优良。
使用外延硅片可以解决增大功率和提高频率对集电区电阻要求上的矛盾。
图 外延硅片上的双极型晶体管集成电路制造中,各元件之间必须进行电学隔离。
利用外延技术的PN 结隔离是早期双极型集成电路常采用的电隔离方法。
利用外延硅片制备CMOS 集成电路芯片可以避免闩锁效应,避免硅表面氧化物的淀积,而且硅片表面更光滑,损伤小,芯片成品率高。
外延工艺已经成为超大规模CMOS 集成电路中的标准工艺。
3.简述二氧化硅薄膜在集成电路中的用途。
答:二氧化硅是集成电路工艺中使用最多的介质薄膜,其在集成电路中的应用也非常广泛。
二氧化硅薄膜的作用包括:器件的组成部分、离子注入掩蔽膜、金属互连层之间的绝缘介质、隔离工艺中的绝缘介质、钝化保护膜。
4.为什么氧化工艺通常采用干氧、湿氧相结合的方式?答:干氧氧化就是将干燥纯净的氧气直接通入到高温反应炉内,氧气与硅表面的原子反应生成二氧化硅。
其特点:二氧化硅结构致密、均匀性和重复性好、针孔密度小、掩蔽能力强、与光刻胶粘附良好不易脱胶;生长速率慢、易龟裂不宜生长厚的二氧化硅。
湿氧氧化就是使氧气先通过加热的高纯去离子水(95℃),氧气中携带一定量的水汽,使氧化气氛既含有氧,又含有水汽。
因此湿氧氧化兼有干氧氧化和en +SiO 2n -Si 外延层 n +Si 衬底水汽氧化的作用,氧化速率和二氧化硅质量介于二者之间。
实际热氧化工艺通常采用干、湿氧交替的方式进行。
集成电路版图设计习题答案第1章半导体器件理论基础【习题答案】1.如何理解本征半导体和掺杂半导体材料的导电机理。
答:本征半导体就是一块没有杂质和缺陷的半导体,其晶格结构是完美的,在其内部除了硅原子外没有其它任何原子,因此是纯净的。
在绝对零度附近,本征半导体的共价键是完整的、饱和的,无本征激发,自然没有电子和空穴;当温度升高时,本征激发过程产生了电子和空穴,这些本征载流子的浓度虽然很低,但仍然可以导电。
在杂质半导体材料中,由于掺入杂质的数量远大于硅的本征载流子浓度,因此这些半导体材料的导电性不是由本征激发产生的载流子决定,而是受控于材料中所掺入的杂质(包括杂质的数量和类型)。
在半导体中可以掺入各种各样的杂质,但为了更好的控制半导体材料的导电性,通常掺入元素周期表中的III、V族元素。
杂质半导体的导电能力通常高于本征半导体。
2.如何理解空穴的导电机理。
答:空穴的导电作用如下图所示。
在下图中,位置(1)有一个空穴,它附近的价键上的电子就可以过来填补这个空位,例如从位置(2)跑一个价键电子到位置(1)去,但在位置(2)却留下了一个空位,相当于空穴从位置(1)移动到位置(2)去了。
同样,如果从位置(3)又跑一个电子到位置(2)去,空穴就又从位置(2)跑到位置(3),……。
如果用虚线箭头代表空穴移动的方向,实线箭头代表价键电子移动的方向,就可以看出,空穴的移动可以等效于价键电子在相反方向的移动。
图空穴的导电作用3.简述PN结的结构与导电特性。
答:在一块半导体材料中,如果一部分是N型区,另一部分是P型区,那么在N型区和P型区的交界面处就形成了PN结(简称为结)。
当P型区和N型区相接触时,一些空穴就从P型区扩散到N型区中。
同样,一些电子也从N型中扩散到P型区中。
扩散的结果是在N型区和P型区的交界面处的两侧形成了带正、负电荷的区域,称为空间电荷区。
在空间电荷区内由于存在正负离子将形成电场,这个电场称为自建电场,电场的方向从N型区指向P型区。
-第一章1.按规模划分,集成电路的发展已经经历了哪几代它的发展遵循了一条业界著名的定律,请说出是什么定律晶体管-分立元件-SSI-MSI-LSI-VLSI-ULSI-GSI-SOC。
MOORE定律2.什么是无生产线集成电路设计列出无生产线集成电路设计的特点和环境。
拥有设计人才和技术,但不拥有生产线。
特点:电路设计,工艺制造,封装分立运行。
环境:IC产业生产能力剩余,人们需要更多的功能芯片设计3.多项目晶圆(MPW)技术的特点是什么对发展集成电路设计有什么意义MPW:把几到几十种工艺上兼容的芯片拼装到一个宏芯片上,然后以步行的方式排列到一到多个晶圆上。
意义:降低成本。
4.集成电路设计需要哪四个方面的知识[系统,电路,工具,工艺方面的知识第二章1.为什么硅材料在集成电路技术中起着举足轻重的作用原材料来源丰富,技术成熟,硅基产品价格低廉2.GaAs和InP材料各有哪些特点P10,113.怎样的条件下金属与半导体形成欧姆接触怎样的条件下金属与半导体形成肖特基接触接触区半导体重掺杂可实现欧姆接触,金属与掺杂半导体接触形成肖特基接触`4.说出多晶硅在CMOS工艺中的作用。
P135.列出你知道的异质半导体材料系统。
GaAs/AlGaAs, InP/ InGaAs, Si/SiGe,6.SOI材料是怎样形成的,有什么特点SOI绝缘体上硅,可以通过氧隔离或者晶片粘结技术完成。
特点:电极与衬底之间寄生电容大大减少,器件速度更快,功率更低7. 肖特基接触和欧姆型接触各有什么特点肖特基接触:阻挡层具有类似PN结的伏安特性。
欧姆型接触:载流子可以容易地利用量子遂穿效应相应自由传输。
8. 简述双极型晶体管和MOS晶体管的工作原理。
P19,21!第三章1.写出晶体外延的意义,列出三种外延生长方法,并比较各自的优缺点。
意义:用同质材料形成具有不同掺杂种类及浓度而具有不同性能的晶体层。
外延方法:液态生长,气相外延生长,金属有机物气相外延生长2.写出掩膜在IC制造过程中的作用,比较整版掩膜和单片掩膜的区别,列举三种掩膜的制造方法。
集成电路设计答案-王志功版-CAL-FENGHAI-(2020YEAR-YICAI)_JINGBIAN第一章1.按规模划分,集成电路的发展已经经历了哪几代它的发展遵循了一条业界著名的定律,请说出是什么定律晶体管-分立元件-SSI-MSI-LSI-VLSI-ULSI-GSI-SOC。
MOORE定律2.什么是无生产线集成电路设计列出无生产线集成电路设计的特点和环境。
拥有设计人才和技术,但不拥有生产线。
特点:电路设计,工艺制造,封装分立运行。
环境:IC产业生产能力剩余,人们需要更多的功能芯片设计3.多项目晶圆(MPW)技术的特点是什么对发展集成电路设计有什么意义MPW:把几到几十种工艺上兼容的芯片拼装到一个宏芯片上,然后以步行的方式排列到一到多个晶圆上。
意义:降低成本。
4.集成电路设计需要哪四个方面的知识系统,电路,工具,工艺方面的知识第二章1.为什么硅材料在集成电路技术中起着举足轻重的作用原材料来源丰富,技术成熟,硅基产品价格低廉2.GaAs和InP材料各有哪些特点P10,113.怎样的条件下金属与半导体形成欧姆接触怎样的条件下金属与半导体形成肖特基接触接触区半导体重掺杂可实现欧姆接触,金属与掺杂半导体接触形成肖特基接触4.说出多晶硅在CMOS工艺中的作用。
P135.列出你知道的异质半导体材料系统。
GaAs/AlGaAs, InP/ InGaAs, Si/SiGe,6.SOI材料是怎样形成的,有什么特点SOI绝缘体上硅,可以通过氧隔离或者晶片粘结技术完成。
特点:电极与衬底之间寄生电容大大减少,器件速度更快,功率更低7. 肖特基接触和欧姆型接触各有什么特点肖特基接触:阻挡层具有类似PN结的伏安特性。
欧姆型接触:载流子可以容易地利用量子遂穿效应相应自由传输。
8. 简述双极型晶体管和MOS晶体管的工作原理。
P19,21第三章1.写出晶体外延的意义,列出三种外延生长方法,并比较各自的优缺点。
意义:用同质材料形成具有不同掺杂种类及浓度而具有不同性能的晶体层。
外延方法:液态生长,气相外延生长,金属有机物气相外延生长2.写出掩膜在IC制造过程中的作用,比较整版掩膜和单片掩膜的区别,列举三种掩膜的制造方法。
P28,293.写出光刻的作用,光刻有哪两种曝光方式作用:把掩膜上的图形转换成晶圆上的器件结构。
曝光方式有接触与非接触两种。
4.X射线制版和直接电子束直写技术替代光刻技术有什么优缺点X 射线(X-ray )具有比可见光短得多的波长,可用来制作更高分辨率的掩膜版。
电子束扫描法,,由于高速电子的波长很短,分辨率很高5. 说出半导体工艺中掺杂的作用,举出两种掺杂方法,并比较其优缺点。
热扩散掺杂和离子注入法。
与热扩散相比,离子注入法的优点如下:1.掺杂的过程可通过调整杂质剂量与能量来精确控制杂质分布。
2.可进行小剂量的掺杂。
3.可进行极小深度的掺杂。
4.较低的工业温度,故光刻胶可用作掩膜。
5.可供掺杂的离子种类较多,离子注入法也可用于制作隔离岛。
缺点:价格昂贵,大剂量注入时,半导体晶格会遭到严重破坏且难以恢复 6.列出干法和湿法氧化法形成SiO 2的化学反应式。
干氧湿氧第四章1.Si 工艺和GaAs 工艺都有哪些晶体管结构和电路形式 见表 2.比较CMOS 工艺和GaAs 工艺的特点。
CMOS 工艺技术成熟,功耗低。
GaAs 工艺技术不成熟,工作频率高。
3. 什么是MOS 工艺的特征尺寸工艺可以实现的平面结构的最小宽度,通常指最小栅长。
4. 为什么硅栅工艺取代铝栅工艺成为CMOS 工艺的主流技术铝栅工艺缺点是,制造源漏极与制造栅极需要两次掩膜步骤(MASKSTEP ),不容易对齐。
硅栅工艺的优点是:自对准的,它无需重叠设计,减小了电容,提高了速度,增加了电路的稳定性。
5. 为什么在栅长相同的情况下NMOS 管速度要高于PMOS 管 因为电子的迁移率大于空穴的迁移率 6.简述CMOS 工艺的基本工艺流程。
7.常规N-Well CMOS 工艺需要哪几层掩膜每层掩膜分别有什么作用 P50表第五章1. 说出MOSFET 的基本结构。
MOSFET 由两个PN 结和一个MOS 电容组成。
2. 写出MOSFET 的基本电流方程。
])[(221DS DS T GS l w t V V V V oxOX --•μξ 3. MOSFET 的饱和电流取决于哪些参数饱和电流取决于栅极宽度W ,栅极长度L ,栅-源之间压降GS V ,阈值电压T V ,氧化层厚度OX t ,氧化层介电常数OX ξ 4. 为什么说MOSFET 是平方率器件因为MOSFET 的饱和电流具有平方特性5. 什么是MOSFET 的阈值电压它受哪些因素影响22SiO O Si →+22222H SiO O H Si +→+阈值电压就是将栅极下面的Si表面从P型Si变成N型Si所必要的电压。
影响它的因素有4个:材料的功函数之差,SiO2层中可以移动的正离子的影响,氧化层中固定电荷的影响,界面势阱的影响6.什么是MOS器件的体效应由于衬底与源端未连接在一起,而引起的阈值电压的变化叫做体效应。
7.说明L、W对MOSFET的速度、功耗、驱动能力的影响。
P70,718.MOSFET按比例收缩后对器件特性有什么影响I不变,器件占用面积减少,提高电路集成度,减少功耗DS9.MOSFET存在哪些二阶效应分别是由什么原因引起的沟道长度调制效应,体效应,亚阈值效应10.说明MOSFET噪声的来源、成因及减小的方法。
噪声来源:热噪声和闪烁噪声。
热噪声是由沟道内载流子的无规则热运动造成的,可通过增加MOS管的栅宽和偏置电流减少热噪声。
闪烁噪声是由沟道处二氧化硅与硅界面上电子的充放电引起的,增加栅长栅宽可降低闪烁噪声。
第六章1.芯片电容有几种实现结构①利用二极管和三极管的结电容;②叉指金属结构;③金属-绝缘体-金属(MIM)结构;④多晶硅/金属-绝缘体-多晶硅结构。
2.采用半导体材料实现电阻要注意哪些问题精度、温度系数、寄生参数、尺寸、承受功耗以及匹配等方面问题3.画出电阻的高频等效电路。
4.芯片电感有几种实现结构(1)集总电感集总电感可以有下列两种形式:①匝线圈;②圆形、方形或其他螺旋形多匝线圈;(2)传输线电感5.微波集成电路设计中,场效应晶体管的栅极常常通过一段传输线接偏置电压。
试解释其作用。
阻抗匹配6.微带线传播TEM波的条件是什么7.在芯片上设计微带线时,如何考虑信号完整性问题为了保证模型的精确度和信号的完整性,需要对互连线的版图结构加以约束和进行规整。
为了减少信号或电源引起的损耗以及为了减少芯片面积,大多数连线应该尽量短。
应注意微带线的趋肤效应和寄生参数。
在长信号线上,分布电阻电容带来延迟;而在微带线长距离并行或不同层导线交叉时,要考虑相互串扰问题。
8.列出共面波导的特点。
CPW 的优点是:①工艺简单,费用低,因为所有接地线均在上表面而不需接触孔。
②在相邻的CPW 之间有更好的屏蔽,因此有更高的集成度和更小的芯片尺寸。
③比金属孔有更低的接地电感。
④低的阻抗和速度色散。
CPW 的缺点是:①衰减相对高一些,在50 GHz 时,CPW 的衰减是 dB/mm;③由于厚的介质层,导热能力差,不利于大功率放大器的实现。
第七章1. 集成电路电路级模拟的标准工具是什么软件, 能进行何种性能分析集成电路电路级模拟的标准工具是SPICE可以进行:(1)直流工作点分析(2)直流扫描分析(3)小信号传输函数(4)交流特性分析(5)直流或小信号交流灵敏度分析(6)噪声分析(7)瞬态特性分析(8)傅里叶分析(9)失真分析(10)零极点分析2. 写出MOS的SPICE元件输入格式与模型输入格式。
元件输入格式:M<编号> <漏极结点> <栅极结点> <源极结点> <衬底结点> <模型名称> <宽W> <长L> (<插指数M>)例如:M1 out in 0 0 nmos W= L= M=2模型输入格式:.Model <模型名称> <模型类型> <模型参数>……例如:.MODEL NMOS NMOS LEVEL=2 LD= TOX= VTO= KP=+NSUB=+15 GAMMA= PHI= U0=656 UEXP= UCRIT=31444+DELTA= VMAX=55261 XJ= LAMBDA= NFS=1E+12 NEFF=+NSS=1E+11 TPG= RSH= PB=+CGDO= CGSO= CJ= MJ= CJSW= MJSW=其中,+为SPICE语法,表示续行。
3. 用SPICE程序仿真出MOS管的输出特性曲线。
.title CH6-3.include “”M1 2 1 0 0 nmos w=5u l=Vds 2 0 5Vgs 1 0 1.dc vds 0 5 vgs 1 5 1.print dc v(2) i(vds).end4. 构思一个基本电路如一个放大器,画出电路图,编写SPICE输入文件,执行分析,观察结果。
.title CH6-4.include “”.global vddM1 out in 0 0 nmos w=5u l=M2 out in vdd vdd pmos w=5u l=Vcc vdd 0 5Vin in 0 sin(0 1 10G 1ps 0).trans 4u.print trans v(out).end第八章1.说明版图与电路图的关系。
版图(Layout)是集成电路设计者将设计、模拟和优化后的电路转化成为一系列的几何图形,它包含了集成电路尺寸、各层拓扑定义等器件相关的物理信息数据。
版图与电路图是一一对应的,包括元件对应以及结点连线对应。
2.说明版图层、掩膜层与工序的关系。
集成电路制造厂家根据版图中集成电路尺寸、各层拓扑定义等器件相关的物理信息数据来制造掩膜。
根据复杂程度,不同工艺需要的一套掩膜可能有几层到十几层。
一层掩膜对应于一种工艺制造中的一道或数道工序。
掩膜上的图形决定着芯片上器件或连接物理层的尺寸。
因此版图上的几何图形尺寸与芯片上物理层尺寸直接相关。
3.说明设计规则与工艺制造的关系。
由于器件的物理特性和工艺限制,芯片上物理层的尺寸对版图的设计有着特定的规则,这些规则是各集成电路制造厂家根据本身的工艺特点和技术水平而制定的。
因此不同的工艺,就有不同的设计规则。
4.设计规则主要包括哪几种几何关系设计规则主要包括各层的最小宽度、层与层之间的最小间距以及最小交叠等。
5.给出版图设计中的图元(Instance)与电路中的元件(Element)概念的区别。
图元可以是一些不具有电路功能的图形组合,譬如以图形组成的字母、图标(Logo)等。