第四章 半导体的导电性
- 格式:ppt
- 大小:2.46 MB
- 文档页数:45


第四章 半导体的导电性1、300K 时,Ge 的本征电阻率为47cm Ω⋅,如电子和空穴迁移率分别为39002cm /(V s)⋅和19002cm /(V s)⋅,试求本征Ge 的载流子浓度。
解:首先,已知Ge 的本征电阻率i ρ=47cm Ω⋅,可得Ge 的本征电导率i σ=1i ρ=1/47S cm 又()i i n p n q σμμ=+本征Ge 的载流子浓度1331921 2.29010/()47/ 1.6010(39001900)/()ii n p n cm q S cm C cm V s σμμ-===⨯+⨯⨯⨯+⋅ 2、试计算本征Si 在室温时的电导率,设电子和空穴迁移率分别为14502cm /(V s)⋅和5002cm /(V s)⋅。
当掺入百万分之一的As 后,设杂质全部电离,试计算其电导率。
比本征Si 的电导率增大了多少倍?解:(1)本征Si 的电导率()i i n p n q σμμ=+已知室温下22103,1450/(),500/(1.51)0n p i u cm V s u c cm m n V s - =⋅ =⨯⋅= ,代入上式得:64.6810/i S cm σ-=⨯(2) 已知Si 的原子密度为223510/cm ⨯,掺入百万分之一的As 后,在Si 中As 的浓度为:22316361510/510/10D N cm cm =⨯⨯=⨯ 因为杂质全电离,所以电离出的电子浓度1630510/D n N cm ==⨯当电离杂质浓度163510/i N cm =⨯时,可查图4-14得电子迁移率为:2850/()n cm V s μ=⋅由于1030(1.510/)i n n cm ⨯ ,又在室温下,则产生载流子以杂质电离为主,可忽略本征激发,即忽略少子空穴对导电的贡献,故此时电导率为: 163192510/ 1.6010850/() 6.8/n nqu cm C cm V s S cm σ-==⨯⨯⨯⨯⋅= 故:666.8// 1.45104.6810/i S cm S cmσσ==⨯⨯ 即电导率增大了145万倍。


第四章半导体的导电性本章主要内容载流子在外加电场作用下的漂移运动半导体的迁移率、电导率和电阻率随温度和杂质浓度的变化规律迁移率的本质-----散射4.1 载流子的漂移运动迁移率1、欧姆定律对于金属,电流I = V(电压)/R(电阻)V-I关系是直线对于半导体,流过不同截面的电流强度不一定相同,“即电流分布不均匀,而欧姆定律不能说明材料内部各处电流的分布情况。
电流密度:通过垂直于电流方向的单位面积的电流J = ∆I/∆S单位:A/cm2或A/m2欧姆定律微分形式:上式把通过导体中某一点的电流密度和该处的电导率及电场强度直接联系了起来。
S故: 半导体导电= 电子导电J = Jn + Jp = (nqu平均自由程:载流子在连续两次散射间自由运动的平均路程平均自由时间:载流子通过平均自由程所需的平均时间τ电场:载流子加速---定向运动;散射:载流子运动方向改变---杂乱无章,各个方向;半导体的主要散射机构:离化杂质散射晶格散射中性杂质散射位错散射(P为散射几率)起因:常温下,浅施主带正电• 双曲线,电离杂质处于一个焦点 • 速度小,作用时间长,偏离角θ大,τ小 • 弹性散射,不改变入射电子能量,只改变运动方向 τ ∝ T3/2/NI 杂质浓度(2)、晶格散射 晶格原子在其平衡位置附近不断进行热振动,且各个 原子的振动不是孤立的。
分析表明:晶格中原子的振动都 是由若干不同的基本波动按波的叠加原理组合而成,这些 基本波动称为格波。
q代表格波波矢, q 的方向即波的传播方向晶格散射:载流子在运动过程中遭受振动的晶格原子的散射, 失去在电场中获得的能量,失去动量。
在能带具有单一极值的半导体中 起主要散射作用的是长波。
即波 长比原子间距大很多倍的格波。
电子热运动速度~105m/s 电子波波长约10-8m 根据动量守恒要求,声子波长 范围应在同一量级,即10-8m,而 晶体中原子间距为10-10m,因而 起主要散射作用的是长波。



![半导体物理学[第四章半导体的导电性]课程复习](https://uimg.taocdn.com/0228f122915f804d2b16c1f0.webp)
第四章半导体的导电性
4.1 理论概要与重点分析
由于半导体的电阻率能用四探针法很方便地测量,所以常用它作为半导体的重要性能参量。
(3)由上可见,分析半导体的导电性,应从载流子浓度和迁移率两方面入手。
而载流子浓度问题在第3章中做了系统的讨论,在这里应用时,应全面考虑。
而迁移率的问题是本章的重点。
迁移率是载流子在晶体中运动时不断遭受到各种散射因素的作用决定的。
半导体中的主要散射机构是电离杂质散射和晶格振动散射。
而晶格振动散射又以长纵声学波和光学波的散射为主。
散射作用的强弱用散射概率p(或平均自由时间τ=1/p)来衡量,它表示单位时间内一个载流子遭受到散射的次数。
经分析,几
种主要的散射机构单独决定的散射概率与杂质浓度N
和温度T有如下的关系:
i
(5)半导体在外加电磁场的作用下,电子的分布函数要发生变化,稳态时分布函数的变化满足玻尔兹曼方程。
(6)在强电场作用下,载流子的平均漂移速度不再与电场强度成正比。
随着电场强度的增加,漂移速度的增加比线性变得缓慢,最后达到一个饱和值。
很显然,这时的迁移率变得与电场有关,这一物理现象可用热载流子与光学波的晶格散射概念予以解释。
(7)由于GaAs的导带具有多能谷结构,而最低能谷和次低能谷间的能量间隔较小,当电场强度达到一定程度时,最低能谷中电子从电场中获得能量后,使其与次低能谷的能量相当。
即会发生谷间散射,低能谷中的电子向高能谷中转移,且随电场强度的进一步增加,转移的电子越多,高能谷中电子的有效质量远大于
低能谷的有效质量,因而在这个区域内会出现微分负电导现象。


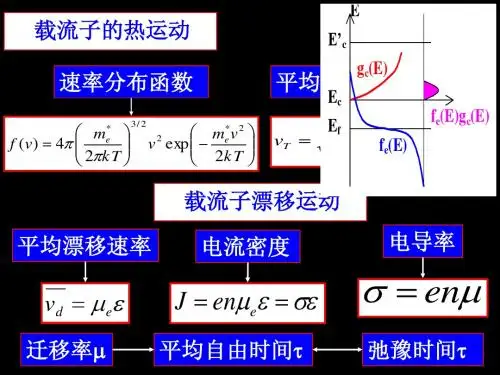
半导体物理学黄整载流子输运半导体中载流子的输运有三种形式:¾漂移¾扩散¾产生和复合2沿电场的反方向作定向运动(定向运动的速度称为漂移速度)dv 电流密度Ad I qnv =−dJ qnv =−4d v nq J =E μnq =Eσ=nq σμ=q 5半导体的电导率和迁移率半导体的导电作用为电子导电和空穴导电的总和==n p J J J +当电场强度不大时,满足J =σ E()n p nq pq μμ+En pnq pq σμμ=+N 型半导体n nq σμ=p n >>P 型半导体p pq σμ=n n ===n p >>6本征半导体i p ()i n p n q σμμ+散射概念的提出外加电场的作用下载流子应当作加速运动外加电场的作用下,载流子应当作加速运动−dJ qnv =不断增大但是J σ=E恒定7热运动在无电场作用下,载流子永无停息地做着无规则的、杂乱无章的运动,称为热运动。
晶体中的碰撞和散射引起净速度为零,净电流为零。
平均自由时间为τm~0.1ps8当有外电场作用时,载流子既受电场力的作用,同时不断发生散射。
载流子在外电场的作用下为热运动和漂移运动的叠加,因此电流密度恒定。
9散射的原因根本原因是周载流子在半导体内发生散射的期性势场遭到破坏附加势场ΔV使能带中的电子在不同k状态间跃迁,并使载流子的运动速度及方向发生改变。
10晶格振动对电子的散射格波¾形成原子振动的基本波动¾格波波矢q=2π/λ¾对应于某一q值的格波数目不定,一个晶体中格波的总数取决于原胞中所含的原子数¾Si、Ge半导体的原胞含有两个原子,对应于每一个q就有六个不同的格波,频率低的三个格波称为声学波,频率高的三个为光学波¾长声学波(声波)振动在散射前后电子能量基本不变,为弹性散射;光学波振动在散射前后电子能量有较大的改变,为非弹性散射12长光学波,能谷内部非弹性散射。
半导体物理习题答案第四章第4章半导体的导电性2.试计算本征Si 在室温时的电导率,设电⼦和空⽳迁移率分别为1350cm 2/V?s 和500 cm 2/V?s 。
当掺⼊百万分之⼀的As 后,设杂质全部电离,试计算其电导率。
掺杂后的电导率⽐本征Si 的电导率增⼤了多少倍解:将室温下Si 的本征载流⼦密度?1010/cm 3及题设电⼦和空⽳的迁移率代⼊电导率公式()i i n p n q σµµ=+即得:101961.510 1.610(1350500) 4.4410 s/cm i σ--=+=?;已知室温硅的原⼦密度为5?1022/cm 3,掺⼊1ppm 的砷,则砷浓度22616351010510 cm D N --=??=?在此等掺杂情况下可忽略少⼦对材料电导率的贡献,只考虑多⼦的贡献。
这时,电⼦密度n 0因杂质全部电离⽽等于N D ;电⼦迁移率考虑到电离杂质的散射⽽有所下降,查表4-14知n-Si 中电⼦迁移率在施主浓度为5?1016/cm 3时已下降为800 cm 2/V?s 。
于是得1619510 1.610800 6.4 s cm n nq σµ-===/该掺杂硅与本征硅电导率之⽐866.4 1.44104.4410i σσ-==?? 即百万分之⼀的砷杂质使硅的电导率增⼤了亿倍5. 500g 的Si 单晶中掺有?10-5g 的B ,设杂质全部电离,求其电阻率。
(硅单晶的密度为2.33g/cm 3,B 原⼦量为)。
解:为求电阻率须先求杂质浓度。
设掺⼊Si 中的B 原⼦总数为Z ,则由1原⼦质量单位=?10-24g 算得618244.510 2.51010.8 1.6610Z --?==个 500克Si 单晶的体积为3500214.6 cm 2.33V ==,于是知B 的浓度∴1816-32.510 1.1610 cm 214.6A Z N V ?===? 室温下硅中此等浓度的B 杂质应已完全电离,查表4-14知相应的空⽳迁移率为400 cm 2/V?s 。
第一篇 半导体中的电子状态习题1-1、 什么叫本征激发?温度越高,本征激发的载流子越多,为什么?试定性说明之。
1-2、 试定性说明Ge 、Si 的禁带宽度具有负温度系数的原因。
1-3、试指出空穴的主要特征。
1-4、简述Ge 、Si 和GaAS 的能带结构的主要特征。
1-5、某一维晶体的电子能带为[])sin(3.0)cos(1.01)(0ka ka E k E --=其中E 0=3eV ,晶格常数a=5х10-11m 。
求:(1) 能带宽度;(2) 能带底和能带顶的有效质量。
题解:1-1、 解:在一定温度下,价带电子获得足够的能量(≥E g )被激发到导带成为导电电子的过程就是本征激发。
其结果是在半导体中出现成对的电子-空穴对。
如果温度升高,则禁带宽度变窄,跃迁所需的能量变小,将会有更多的电子被激发到导带中。
1-2、 解:电子的共有化运动导致孤立原子的能级形成能带,即允带和禁带。
温度升高,则电子的共有化运动加剧,导致允带进一步分裂、变宽;允带变宽,则导致允带与允带之间的禁带相对变窄。
反之,温度降低,将导致禁带变宽。
因此,Ge 、Si 的禁带宽度具有负温度系数。
1-3、 解:空穴是未被电子占据的空量子态,被用来描述半满带中的大量电子的集体运动状态,是准粒子。
主要特征如下:A 、荷正电:+q ;B 、空穴浓度表示为p (电子浓度表示为n );C 、E P =-E nD 、m P *=-m n *。
1-4、 解:(1) Ge 、Si:a )Eg (Si :0K) = 1.17eV ;Eg (Ge :0K) = 0.744eV ;b )间接能隙结构c )禁带宽度E g 随温度增加而减小;(2) GaAs :a )Eg (0K) = 1.52eV ;b )直接能隙结构;c )Eg 负温度系数特性: dE g /dT = -3.95×10-4eV/K ;1-5、 解:(1) 由题意得:[][])sin(3)cos(1.0)cos(3)sin(1.002220ka ka E a k d dE ka ka aE dk dE+=-=eVE E E E a kd dE a k E a kd dE a k a k a k ka tg dk dE ooo o 1384.1min max ,01028.2)4349.198sin 34349.198(cos 1.0,4349.198,01028.2)4349.18sin 34349.18(cos 1.0,4349.184349.198,4349.1831,04002222400222121=-=∆<⨯-=+==>⨯=+====∴==--则能带宽度对应能带极大值。