晶圆制造工艺
- 格式:doc
- 大小:113.50 KB
- 文档页数:8

晶圆制作工艺一、引言晶圆制作工艺是半导体制造过程中的核心环节之一。
其涉及的工艺步骤和技术要求对最终产品的性能和质量有着重要影响。
本文将对晶圆制作工艺进行全面、详细、完整且深入地探讨,介绍晶圆制作工艺的基本原理、工艺流程和常见工艺技术。
二、晶圆制作工艺的基本原理晶圆制作工艺是将半导体材料加工成具有一定形状、尺寸和质量的晶圆,以便后续的集成电路制造。
其基本原理包括以下几个方面:2.1 材料选择和准备晶圆制作的材料主要有硅、硅化物和砷化镓等。
在材料选择上,需要考虑材料的物理特性、制备成本和工艺可行性等因素。
材料准备包括材料的精炼、制备和切割等步骤,确保材料具备一定的纯度和尺寸。
2.2 晶圆生长晶圆的生长是指通过各种物理或化学方法,在晶圆衬底上逐渐沉积出一层具有晶体结构的薄膜,形成单晶材料。
常用的晶圆生长方法包括气相沉积、熔融法和溅射法等,其中气相沉积是最常用的方法之一。
2.3 陶瓷制备陶瓷制备是指将材料粉末经过烧结或其他方法形成块状或多孔结构的过程,用于制作陶瓷衬底。
陶瓷衬底具有高温稳定性和电气绝缘性能,被广泛应用于光电子、电子器件等领域。
2.4 清洗和净化清洗和净化是晶圆制作过程中必不可少的步骤,主要目的是去除晶圆表面的污染物和杂质。
清洗方法包括化学溶液浸泡、超声波清洗和离子束清洗等,净化方法则采用真空处理或高温退火等方式。
三、晶圆制作工艺的流程晶圆制作工艺的流程包括以下几个主要步骤:3.1 晶圆生长晶圆生长是整个制作工艺中的关键步骤,它的质量和性能直接影响到后续工艺的进行和设备的性能。
晶圆生长的主要方法有: - Czochralski法(CZ法):通过在熔融的原料中拉出晶种并逐渐增长晶体,得到大直径的单晶圆。
- 悬拉法(Floating Zone Method,FZ法):利用悬吊附近的热源将单晶材料熔化,并自下向上生长。
- 气相沉积法(Chemical Vapor Deposition,CVD法):在气相中使反应气体分解并沉积在衬底表面上,形成单晶薄膜。

碳化硅(SiC)晶圆的制造工艺主要包括以下步骤:1. 原料准备:高纯度的硅粉和碳粉按照一定的比例混合,形成原始的前驱体材料。
2. 合成:通过高温化学气相沉积法(High Temperature Chemical Vapor Deposition, HTCVD)或物理气相传输法(Physical Vapor Transport, PVT)制备碳化硅单晶。
PVT法通常采用更高温度,将多晶或粉末状的SiC置于石墨crucible中,在真空或惰性气体环境下加热到约2000-2500℃,使SiC升华并在低温端重新结晶为单晶形态。
3. 晶体生长:在晶体生长炉内控制温度梯度、压力以及气体气氛,以实现定向和均匀的单晶生长。
晶体生长过程中需要严格控制生长速率和温度分布,以获得高质量的大尺寸单晶SiC晶锭。
4. 晶锭切割:成长好的SiC晶锭经过冷却后进行切片,利用精密的切割设备将其切割成特定厚度的晶圆。
由于SiC硬度高,传统的切割技术可能无法满足要求,因此采用专门针对SiC优化的划片工艺,例如采用金刚石砂轮或其他硬质工具,并提高切割速度及精度,同时减少裂纹和微裂纹的产生。
5. 研磨与抛光:切割后的晶圆表面粗糙,需经过粗磨、精磨和抛光等步骤使其达到半导体器件制造所需的平面度和平整度。
这一步骤旨在减少表面缺陷并确保晶圆的厚度和表面质量符合后续加工需求。
6. 清洗与检测:晶圆经过研磨和抛光后,要经过一系列的清洗程序去除残留颗粒和其他污染物,然后进行严格的表面质量和晶格结构检测,如光学显微镜检查、原子力显微镜(AFM)、X射线衍射(XRD)等。
7. 离子注入与退火:根据器件设计需求,晶圆可能还需要进行掺杂处理,包括离子注入来改变其电学性能。
随后,进行高温退火以激活掺杂剂,并修复离子注入带来的晶格损伤。
8. 薄膜沉积与光刻:经过以上预处理的SiC晶圆上可以进行外延生长、金属接触层沉积、绝缘层沉积等薄膜工艺,并通过光刻、刻蚀等微细加工技术制作出各种电子元器件结构。

晶圆制造工艺流程1、表面清洗2、初次氧化3、 CVD(Chemic al Vapordeposi tion)法沉积一层Si3N4(Hot CVD 或 LPCVD)。
(1)常压 CVD (Normal Pressu re CVD)(2)低压 CVD (Low Pressu re CVD)(3)热 CVD (Hot CVD)/(therma l CVD)(4)电浆增强 CVD (Plasma Enhanc ed CVD)(5)MOCVD(MetalOrgani c CVD) & 分子磊晶成长 (Molecu lar Beam Epitax y)(6)外延生长法(LPE)4、涂敷光刻胶(1)光刻胶的涂敷(2)预烘(pre bake)(3)曝光(4)显影(5)后烘(post bake)(6)腐蚀 (etchin g)(7)光刻胶的去除5、此处用干法氧化法将氮化硅去除6 、离子布植将硼离子(B+3) 透过SiO2 膜注入衬底,形成P 型阱7、去除光刻胶,放高温炉中进行退火处理8、用热磷酸去除氮化硅层,掺杂磷(P+5) 离子,形成N 型阱9、退火处理,然后用HF 去除SiO2 层10、干法氧化法生成一层SiO2 层,然后 LPCVD沉积一层氮化硅11、利用光刻技术和离子刻蚀技术,保留下栅隔离层上面的氮化硅层12、湿法氧化,生长未有氮化硅保护的SiO2 层,形成PN 之间的隔离区13、热磷酸去除氮化硅,然后用HF 溶液去除栅隔离层位置的SiO2 ,并重新生成品质更好的SiO2 薄膜, 作为栅极氧化层。
14、LPCVD沉积多晶硅层,然后涂敷光阻进行光刻,以及等离子蚀刻技术,栅极结构,并氧化生成SiO2 保护层。
15、表面涂敷光阻,去除P 阱区的光阻,注入砷(As) 离子,形成NMOS 的源漏极。
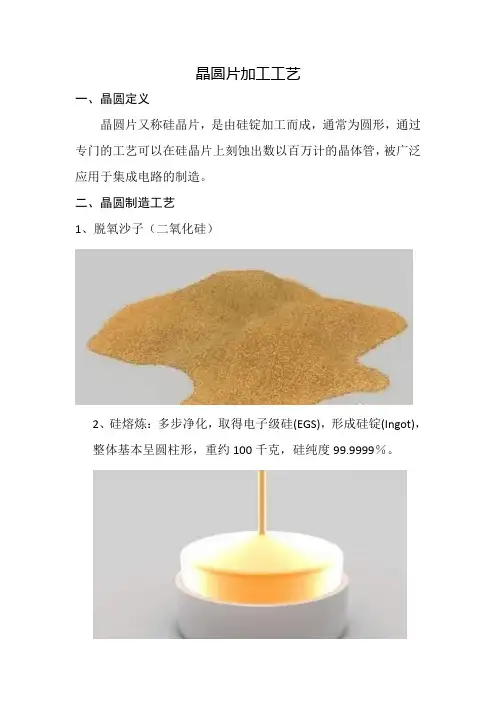
晶圆片加工工艺
一、晶圆定义
晶圆片又称硅晶片,是由硅锭加工而成,通常为圆形,通过专门的工艺可以在硅晶片上刻蚀出数以百万计的晶体管,被广泛应用于集成电路的制造。
二、晶圆制造工艺
1、脱氧沙子(二氧化硅)
2、硅熔炼:多步净化,取得电子级硅(EGS),形成硅锭(Ingot),
整体基本呈圆柱形,重约100千克,硅纯度99.9999%。
3、硅锭切割:横向切割成圆形的单个硅片,也就是我们常说的晶圆(Wafer)。
4、抛光后表面可以当镜子。
5、光刻:晶圆旋转过程中浇上去的光刻胶液体。
晶圆旋转可以让光刻胶铺得非常薄、非常平。
光刻胶层随后透过掩模(Mask)被曝光在紫外线(UV)之下,变得可溶,期间发生得化学反应类似按下机械相机快门那一刻胶片地变化。
掩模上印着预先设计好得电路图案,紫外线透过它照在光刻胶层上,就会形成微处理器的每一层电路图案。
一般来说,在晶圆上得到的电路图案是掩模上图案得四分之一。
6、溶解光刻胶:光刻过程中曝光在紫外线下的光刻胶被溶解掉,清除后留下的图案和掩模上的一致。
7、蚀刻:使用化学物质溶解掉暴露出来的晶圆部分,而剩下的光刻胶保护着不应该蚀刻的部分。
部清除后就可以看到设计好的电路图案。

晶圆制造工艺流程晶圆制造是指通过一系列工艺步骤来制作半导体芯片的过程。
以下是典型的晶圆制造工艺流程。
1.单晶片生长:晶圆制造的第一步是将纯度很高的硅材料通过化学气相沉积或其他方法生长为单晶片。
这个步骤是整个工艺流程的基础。
2.晶圆切割:在单晶片生长完成后,将其切割成薄片,即晶圆。
通常使用金刚石刀进行切割,切割后的晶圆具有相对平整的表面和一定的厚度。
3.光刻:光刻是晶圆制造中关键的步骤之一、在此步骤中,通过光刻机将需要形成的图案转移到晶圆表面。
这通常涉及到在晶圆表面涂覆光刻胶,然后通过光刻机的曝光和显影过程来形成所需的图案。
4.晶圆清洗:在光刻步骤完成后,晶圆需要进行清洗,以去除光刻胶的残留物和其他杂质。
晶圆清洗通常会使用化学溶液和超声波的作用来清洁晶圆表面。
5.电镀:在一些情况下,需要对晶圆进行电镀,以增加其表面的导电性和减小电阻。
这个步骤通常涉及将晶圆浸入含有金属离子的溶液中,在电流作用下使金属离子沉积在晶圆表面。
6.氧化:氧化是将晶圆表面涂覆一层氧化物的过程。
这个步骤可以在大气中进行,也可以通过化学气相沉积来完成。
氧化的目的是改善晶圆表面的质量,并为后续步骤提供一定的保护。
7.形成电极和连线:在晶圆上制作电极和连线是将芯片的不同部分连接起来的关键步骤。
这个步骤通常涉及使用光刻和电镀等技术,将导电材料沉积在晶圆表面,并通过化学蚀刻来形成所需的电极和连线。
8.打磨和抛光:在制造晶圆过程中,由于一些原因,晶圆表面可能会有一些不平整和缺陷。
为了修复这些问题,晶圆需要经过打磨和抛光,使其表面更加平整和光滑。
9.测试和封装:在晶圆制造完毕后,需要对芯片进行测试,以确保其正常工作。
测试通常会使用特定的测试设备和测试程序来进行,包括电性能测试、可靠性测试等。
然后,芯片会进行封装,即将其放入塑料或金属封装中,以保护芯片并为其提供适当的引脚。
以上是晶圆制造的典型工艺流程。
当然,实际的晶圆制造可能会因不同应用领域和制造工艺的差异而略有不同。

晶圆制造工艺及管控要求一、初识晶圆制造工艺1.1 什么是晶圆制造工艺晶圆制造工艺,是指将硅片(即晶圆)通过一系列的工艺加工和处理,制作成集成电路芯片的过程。
1.2 晶圆制造工艺的重要性晶圆制造工艺是整个集成电路生产过程中非常重要的环节,它直接决定了芯片的品质和性能。
二、晶圆制造工艺流程2.1 清洗和去杂质处理1.用超声波清洗机将晶圆放入去离子水中,去除表面的杂质和氧化物。
2.在酸性溶液中浸泡,去除晶圆表面的金属离子和有机物质。
2.2 氧化和扩散1.将晶圆放入高温炉中,在氧气或蒸汽中进行氧化处理,生成一层氧化硅。
2.将掺杂源固态扩散到氧化硅层中,调整晶圆的电性能。
2.3 光刻和曝光1.在光刻机中涂覆光刻胶到晶圆表面。
2.利用掩膜和紫外线曝光,将光刻胶在某些区域暴露出来,形成芯片的图形。
3.使用化学溶解光刻胶的方法,去除未暴露的部分。
2.4 蚀刻和沉积1.将晶圆放入蚀刻池中,用化学液体去除暴露的氧化硅或金属。
2.通过物理或化学反应,在芯片上沉积一层新的材料。
2.5 电镀和铺膜1.将晶圆浸入电镀液,使其表面镀上一层金属。
2.使用化学气相沉积法,将薄膜均匀覆盖在晶圆上。
2.6 制程控制和检测1.对制程参数进行监控和调整,确保每个工艺步骤的稳定性和一致性。
2.使用显微镜、扫描电镜等检测设备,对晶圆进行质量检测和缺陷分析。
三、晶圆制造管控要求3.1 温度控制要求1.不同工艺步骤对温度的要求不同,需要精确控制每个步骤的温度。
2.温度的波动范围应控制在允许范围内,以保证制程的稳定性和芯片品质。
3.2 时间控制要求1.每个工艺步骤所需的时间应精确掌握,以确保整个制程的时效性。
2.不同步骤的时间间隔也需要合理安排,以避免工艺步骤之间的冲突和干扰。
3.3 成本控制要求1.合理规划工艺流程,最大程度节约原材料和能源的使用。
2.优化制程参数,提高生产效率,降低生产成本。
3.4 质量控制要求1.建立严格的质量管理体系,确保每个工艺步骤的质量符合要求。

构成晶圆制造的五大工艺晶圆制造是半导体工业中最关键的环节之一,它涉及到许多复杂的工艺和技术。
晶圆制造的五大工艺包括晶圆切割、晶圆清洗、光刻、离子注入和薄膜沉积。
下面将对这五大工艺进行详细介绍。
1. 晶圆切割晶圆切割是将硅单晶棒切成薄片,即晶圆的过程。
通常使用钻石锯片进行切割,但由于硅单晶非常硬,因此需要用到高压水流或者磨料来辅助切割。
在切割过程中,还需要进行去毛边和去角处理,以确保最后得到的晶圆表面平整光滑。
2. 晶圆清洗在晶圆制造过程中,需要对晶片进行多次清洗以确保其表面干净无尘。
清洗过程通常包括化学溶解、超声波振荡和离心等步骤。
其中化学溶解可以去除表面污垢和有机物质;超声波振荡可以将难以去除的颗粒和污垢震落;离心可以将液体和固体分离,以便于后续处理。
3. 光刻光刻是一种利用光敏材料制作图形的技术。
在晶圆制造中,光刻通常用于制作电路图案。
首先,在晶圆上涂覆一层感光胶,然后使用掩模板对感光胶进行曝光,使得只有被曝光的部分会发生化学反应。
最后,使用化学溶解剂将未曝光的感光胶去除,留下所需的电路图案。
4. 离子注入离子注入是一种将材料中的离子注入到另一种材料中的技术。
在晶圆制造中,离子注入通常用于改变硅片的电学性质。
具体来说,通过向硅片中注入不同类型的离子(如磷、硼等),可以改变硅片中自由电子和空穴浓度,从而控制其导电性能。
5. 薄膜沉积薄膜沉积是一种将材料沉积到另一种材料表面上形成薄层的技术。
在晶圆制造中,薄膜沉积通常用于制作金属线路和绝缘层等。
常用的沉积方法包括物理气相沉积、化学气相沉积和溅射等。
其中,物理气相沉积是将固态材料加热到高温后,在真空环境下使其蒸发并在晶片表面形成薄层;化学气相沉积是通过化学反应在晶片表面形成薄层;溅射则是利用离子轰击材料表面将其溅射到晶片表面上。
总之,晶圆制造的五大工艺涵盖了许多复杂的技术和过程。
这些工艺不仅需要精密的设备和仪器,还需要高度专业化的技术人员来操作和控制。

晶圆制造十大工艺
晶圆制造是集成电路(IC)制造的关键步骤之一。
下面是晶圆制造中的十大工艺步骤:
1.晶圆生长(Czochralski Process):
•将单晶硅从熔融硅中拉出,形成长而纯净的单晶圆柱,用于后续的加工。
2.切割(Wafering):
•将长的单晶圆柱切割成薄片,形成晶圆。
这些薄片通常有200毫米或300毫米的直径。
3.化学机械抛光(Chemical Mechanical Polishing,CMP):
•对晶圆表面进行机械磨削和化学腐蚀,以获得平整的表面。
4.清洗(Cleaning):
•使用特殊的清洗过程去除晶圆表面的杂质,确保表面干净。
5.氧化(Oxidation):
•在晶圆表面形成氧化层,通常是二氧化硅(SiO2),用于隔离不同的区域。
6.光刻(Photolithography):
•利用光学光刻技术在晶圆表面敷设光阻,然后使用光掩模形成图案。
7.蚀刻(Etching):
•使用化学或物理方法将光刻过程中未被保护的区域去除,形成所需的图案结构。
8.离子注入(Ion Implantation):
•将离子注入晶圆,改变晶体结构,用于形成电子器件的特定区域。
9.金属化(Metallization):
•在晶圆表面涂覆金属层,用于连接电子器件和形成电路。
10.封装(Packaging):
•将晶圆上的芯片封装在塑料或陶瓷封装中,以提供电气和机械保护。
这些步骤是在晶圆制造的不同阶段进行的,最终形成成熟的集成电路芯片。
这些步骤的每一步都需要高度精密和精确的设备和工艺控制,以确保最终产品的性能和可靠性。

晶圆制造工艺流程1、表面清洗2、初次氧化3、 CVD(Chemical Vapor deposition) 法沉积一层 Si3N4 (Hot CVD 或 LPCVD) .(1)常压 CVD (Normal Pressure CVD)(2)低压 CVD (Low Pressure CVD)(3)热 CVD (Hot CVD)/(thermal CVD)(4)电浆增强 CVD (Plasma Enhanced CVD)(5)MOCVD (Metal Organic CVD)&分子磊晶成长 (Molecular Beam Epitaxy)(6)外延生长法(LPE)4、涂敷光刻胶(1)光刻胶的涂敷(2)预烘 (pre bake)(3)曝光(4)显影(5)后烘(post bake)(6)腐蚀(etching)(7)光刻胶的去除5、此处用干法氧化法将氮化硅去除6 、离子布植将硼离子 (B+3) 透过 SiO2 膜注入衬底,形成 P 型阱7、去除光刻胶,放高温炉中进行退火处理8、用热磷酸去除氮化硅层,掺杂磷(P+5) 离子,形成 N 型阱9、退火处理,然后用 HF 去除 SiO2 层10、干法氧化法生成一层 SiO2 层,然后 LPCVD 沉积一层氮化硅11、利用光刻技术和离子刻蚀技术,保留下栅隔离层上面的氮化硅层12、湿法氧化,生长未有氮化硅保护的 SiO2 层,形成 PN 之间的隔离区13、热磷酸去除氮化硅,然后用 HF 溶液去除栅隔离层位置的 SiO2 ,并重新生成品质更好的 SiO2 薄膜,作为栅极氧化层。
14、LPCVD 沉积多晶硅层,然后涂敷光阻进行光刻,以及等离子蚀刻技术,栅极结构,并氧化生成 SiO2 保护层。
15、表面涂敷光阻,去除 P 阱区的光阻,注入砷 (As)离子,形成 NMOS 的源漏极。
用同样的方法,在 N 阱区,注入 B 离子形成 PMOS 的源漏极。
16、利用 PECVD 沉积一层无掺杂氧化层,保护元件,并进行退火处理。

晶圆制造过程晶圆制造是半导体工业中不可或缺的一部分,它是制造集成电路的基础。
本文将介绍晶圆制造的整个过程。
1. 原材料准备晶圆制造的第一步是准备原材料。
通常使用的原材料是硅片,它具有良好的半导体性能。
硅片的生产需要高纯度的硅原料,通过多道提纯工艺来确保硅片的纯度。
2. 单晶生长单晶生长是制造晶圆的关键步骤之一。
在单晶生长过程中,将高纯度的硅熔液放入石英坩埚中,并加热到高温。
然后,通过在熔液上方引入细小的晶种,使硅原子逐渐结晶并沉积在晶种上。
随着晶体的不断生长,晶种逐渐向下移动,同时硅原子以相同的晶格结构沉积在晶种上,最终形成单晶硅棒。
3. 切割晶片在单晶生长过程结束后,将硅棒切割成薄片,即晶片。
切割晶片可以使用钻石锯片或线锯。
切割出来的晶片通常具有一定的厚度,需要经过后续的研磨和抛光工艺来获得所需的光滑度和薄度。
4. 清洗和去除杂质切割得到的晶片表面可能会附着一些杂质,需要通过清洗和去除工艺来保证晶片的纯净度。
清洗过程中使用一系列的溶液和超声波来去除附着在晶片表面的杂质。
然后,使用化学气相沉积或物理气相沉积等技术来形成一层保护膜,防止晶片表面再次被污染。
5. 掩膜和光刻接下来是掩膜和光刻的步骤。
通过在晶片表面涂覆一层光刻胶,然后使用光刻机进行曝光和显影,形成所需的图案。
光刻胶在曝光后会发生化学反应,使得图案被转移到晶片表面。
6. 电离注入和扩散电离注入是将所需的杂质掺入晶片中的关键步骤。
在电离注入过程中,使用离子加速器将所需的杂质离子注入晶片中,以改变晶片的电学性能。
注入后,需要进行扩散工艺,使得注入的杂质在晶片内部扩散开来,形成所需的电子器件结构。
7. 金属化和封装金属化是为了在晶片上形成电子器件的金属导线。
通过在晶片表面涂覆一层金属薄膜,并使用光刻和蚀刻工艺来形成金属导线的图案。
金属化后,需要进行封装工艺,将晶片封装在塑料或陶瓷封装中,并连接导线和外部引脚,以保护晶片并方便与其他电子器件连接。

晶圆生产工艺与流程介绍文档编制序号:[KK8UY-LL9IO69-TTO6M3-MTOL89-FTT688]晶圆的生产工艺流程介绍从大的方面来讲,晶圆生产包括晶棒制造和晶片制造两大步骤,它又可细分为以下几道主要工序(其中晶棒制造只包括下面的第一道工序,其余的全部属晶片制造,所以有时又统称它们为晶柱切片后处理工序):晶棒成长?-->?晶棒裁切与检测?-->?外径研磨?-->?切片?-->?圆边?-->?表层研磨?-->?蚀刻?-->?去疵?-->?抛光?-->?清洗?-->?检验?-->?包装1.晶棒成长工序:它又可细分为:1).融化(Melt?Down)将块状的高纯度复晶硅置于石英坩锅内,加热到其熔点1420°C以上,使其完全融化。
2).颈部成长(Neck?Growth)待硅融浆的温度稳定之后,将〈1.0.0〉方向的晶种慢慢插入其中,接着将晶种慢慢往上提升,使其直径缩小到一定尺寸(一般约6mm左右),维持此直径并拉长100-200mm,以消除晶种内的晶粒排列取向差异。
3).晶冠成长(Crown?Growth)颈部成长完成后,慢慢降低提升速度和温度,使颈部直径逐渐加大到所需尺寸(如5、6、8、12寸等)。
4).晶体成长(Body?Growth)不断调整提升速度和融炼温度,维持固定的晶棒直径,只到晶棒长度达到预定值。
5).尾部成长(Tail?Growth)当晶棒长度达到预定值后再逐渐加快提升速度并提高融炼温度,使晶棒直径逐渐变小,以避免因热应力造成排差和滑移等现象产生,最终使晶棒与液面完全分离。
到此即得到一根完整的晶棒。
2.晶棒裁切与检测(Cutting?&?Inspection)将长成的晶棒去掉直径偏小的头、尾部分,并对尺寸进行检测,以决定下步加工的工艺参数。
3.外径研磨(Surface?Grinding?&?Shaping)由于在晶棒成长过程中,其外径尺寸和圆度均有一定偏差,其外园柱面也凹凸不平,所以必须对外径进行修整、研磨,使其尺寸、形状误差均小于允许偏差。
晶圆加工工序
晶圆加工是半导体制造中极为重要的工序之一,其具体工艺流程包括:
1.掩膜制作:通过在晶圆表面加覆一层光刻胶,并在光刻胶表面制作具有所需结构的掩膜,完成对晶圆的器件结构定义。
2.光刻:晶圆经过覆盖掩膜后,通过紫外线照射来形成所需要的器件结构,这个过程叫光刻。
3.蚀刻:施加药液进行蚀刻,加工掉那些没有被紫外线照射到的地方,蚀刻后使晶圆形成所需的器件结构。
4.清洗:将晶圆上的残留物清洗掉,以保证下一道工序的正常进行。
5.离子注入:通过离子注入,将特定材料离子注入晶圆内,进一步定义器件结构,从而得到有效的半导体材料。
6.热处理:把给定的晶圆加热至一定温度,使之内部结构重新排列。
7.金属沉积:在晶圆上沉积金属,进行金属接触等必要的工艺,从而得到要求的电气特征的半导体材料。
整个晶圆加工流程一般需要多次循环以上各种工艺。
晶圆的生产工艺流程:从大的方面来讲,晶圆生产包括晶棒制造和晶片制造两大步骤,它又可细分为以下几道主要工序(其中晶棒制造只包括下面的第一道工序,其余的全部属晶片制造,所以有时又统称它们为晶柱切片后处理工序):晶棒成长 -- 晶棒裁切与检测 -- 外径研磨 -- 切片 -- 圆边-- 表层研磨 -- 蚀刻 -- 去疵 -- 抛光 -- 清洗 -- 检验 -- 包装 1、晶棒成长工序:它又可细分为:1)、融化(Melt Down):将块状的高纯度复晶硅置于石英坩锅内,加热到其熔点1420°C以上,使其完全融化。
2)、颈部成长(Neck Growth):待硅融浆的温度稳定之后,将〈1.0.0〉方向的晶种慢慢插入其中,接着将晶种慢慢往上提升,使其直径缩小到一定尺寸(一般约6mm左右),维持此直径并拉长100-200mm,以消除晶种内的晶粒排列取向差异。
3)、晶冠成长(Crown Growth):颈部成长完成后,慢慢降低提升速度和温度,使颈部直径逐渐加大到所需尺寸(如5、6、8、12吋等)。
4)、晶体成长(Body Growth):不断调整提升速度和融炼温度,维持固定的晶棒直径,只到晶棒长度达到预定值。
5)、尾部成长(Tail Growth):当晶棒长度达到预定值后再逐渐加快提升速度并提高融炼温度,使晶棒直径逐渐变小,以避免因热应力造成排差和滑移等现象产生,最终使晶棒与液面完全分离。
到此即得到一根完整的晶棒。
2、晶棒裁切与检测(Cutting & Inspection):将长成的晶棒去掉直径偏小的头、尾部分,并对尺寸进行检测,以决定下步加工的工艺参数。
3、外径研磨(Surface Grinding & Shaping):由于在晶棒成长过程中,其外径尺寸和圆度均有一定偏差,其外园柱面也凹凸不平,所以必须对外径进行修整、研磨,使其尺寸、形状误差均小于允许偏差。
4、切片(Wire Saw Slicing):由于硅的硬度非常大,所以在本工序里,采用环状、其内径边缘镶嵌有钻石颗粒的薄片锯片将晶棒切割成一片片薄片。
晶圆的生产工艺流程:从大的方面来讲,晶圆生产包括晶棒制造和晶片制造两大步骤,它又可细分为以下几道主要工序(其中晶棒制造只包括下面的第一道工序,其余的全部属晶片制造,所以有时又统称它们为晶柱切片后处理工序):晶棒成长 -- 晶棒裁切与检测 -- 外径研磨 -- 切片 -- 圆边-- 表层研磨 -- 蚀刻 -- 去疵 -- 抛光 -- 清洗 -- 检验 -- 包装 1、晶棒成长工序:它又可细分为:1)、融化(Melt Down):将块状的高纯度复晶硅置于石英坩锅内,加热到其熔点1420°C以上,使其完全融化。
2)、颈部成长(Neck Growth):待硅融浆的温度稳定之后,将〈1.0.0〉方向的晶种慢慢插入其中,接着将晶种慢慢往上提升,使其直径缩小到一定尺寸(一般约6mm左右),维持此直径并拉长100-200mm,以消除晶种内的晶粒排列取向差异。
3)、晶冠成长(Crown Growth):颈部成长完成后,慢慢降低提升速度和温度,使颈部直径逐渐加大到所需尺寸(如5、6、8、12吋等)。
4)、晶体成长(Body Growth):不断调整提升速度和融炼温度,维持固定的晶棒直径,只到晶棒长度达到预定值。
5)、尾部成长(Tail Growth):当晶棒长度达到预定值后再逐渐加快提升速度并提高融炼温度,使晶棒直径逐渐变小,以避免因热应力造成排差和滑移等现象产生,最终使晶棒与液面完全分离。
到此即得到一根完整的晶棒。
2、晶棒裁切与检测(Cutting & Inspection):将长成的晶棒去掉直径偏小的头、尾部分,并对尺寸进行检测,以决定下步加工的工艺参数。
3、外径研磨(Surface Grinding & Shaping):由于在晶棒成长过程中,其外径尺寸和圆度均有一定偏差,其外园柱面也凹凸不平,所以必须对外径进行修整、研磨,使其尺寸、形状误差均小于允许偏差。
4、切片(Wire Saw Slicing):由于硅的硬度非常大,所以在本工序里,采用环状、其内径边缘镶嵌有钻石颗粒的薄片锯片将晶棒切割成一片片薄片。
晶圆生产主要工艺流程晶圆生产是集成电路制造的基础工艺流程,也是整个芯片制造过程中的关键环节。
晶圆生产主要包括晶圆加工、掩膜制备、光刻、扩散、腐蚀、离子注入、热处理等多个工艺步骤。
下面将详细介绍晶圆生产的主要工艺流程。
一、晶圆加工晶圆加工是整个晶圆生产的第一步,也是最关键的一步。
首先,需要从硅单晶片中切割出晶圆,常用的切割方法有线锯切割和研磨切割两种。
切割完成后,需要对晶圆进行抛光,以去除切割过程中产生的毛刺和磨损层,使晶圆表面变得光滑。
二、掩膜制备掩膜制备是晶圆生产的重要一环,它是通过光刻技术来制备掩膜图形。
首先,需要将光刻胶涂覆在晶圆表面,然后使用掩膜对光刻胶进行曝光,通过光刻机进行曝光和显影处理,使光刻胶形成所需的图形。
掩膜图形决定了芯片的电路结构和功能。
三、光刻光刻是晶圆生产中的核心工艺步骤,用于将掩膜上的图形转移到晶圆上。
光刻过程中,首先将掩膜和晶圆对准,然后使用紫外光照射光刻胶,使光刻胶发生化学或物理变化。
然后,通过显影处理,使未曝光的部分光刻胶被溶解掉,暴露出晶圆表面的区域。
最后,使用蚀刻或其他加工方法,将暴露出来的晶圆表面进行加工。
四、扩散扩散是晶圆生产中的一种加工方法,用于控制晶圆表面杂质的浓度和分布。
扩散过程中,将晶圆置于高温炉中,与气体或液体中的杂质进行反应,使杂质从液体或气体中扩散到晶圆表面。
扩散后的晶圆表面形成了所需的掺杂区域,用于形成芯片中的电子器件。
五、腐蚀腐蚀是晶圆生产中的一种加工方法,用于去除晶圆表面的氧化层或其他不需要的杂质。
腐蚀过程中,将晶圆放置在腐蚀液中,使腐蚀液与晶圆表面发生化学反应,去除表面的氧化层或杂质。
腐蚀后的晶圆表面更加平整和清洁,有利于后续工艺的进行。
六、离子注入离子注入是晶圆生产中的一种加工方法,用于控制晶圆中杂质的浓度和分布。
离子注入过程中,将晶圆放置在离子注入机中,加速并定向注入离子束到晶圆表面。
注入的离子将与晶体中的原子进行替换或形成杂质,从而改变晶圆的电学性质。
1、表面清洗2、初次氧化3、CVD(Chemical Vapor deposition) 法沉积一层Si3N4 (Hot CVD 或LPCVD) 。
(1)常压CVD (Normal Pressure CVD)(2)低压CVD (Low Pressure CVD)(3)热CVD (Hot CVD)/(thermal CVD)(4)电浆增强CVD (Plasma Enhanced CVD)(5)MOCVD (Metal Organic CVD) & 分子磊晶成长(Molecular Beam Epitaxy)(6)外延生长法(LPE)4、涂敷光刻胶(1)光刻胶的涂敷(2)预烘(pre bake)(3)曝光(4)显影(5)后烘(post bake)(6)腐蚀(etching)(7)光刻胶的去除5、此处用干法氧化法将氮化硅去除6 、离子布植将硼离子(B+3) 透过SiO2 膜注入衬底,形成P 型阱7、去除光刻胶,放高温炉中进行退火处理8、用热磷酸去除氮化硅层,掺杂磷(P+5) 离子,形成N 型阱9、退火处理,然后用HF 去除SiO2 层10、干法氧化法生成一层SiO2 层,然后LPCVD 沉积一层氮化硅11、利用光刻技术和离子刻蚀技术,保留下栅隔离层上面的氮化硅层12、湿法氧化,生长未有氮化硅保护的SiO2 层,形成PN 之间的隔离区13、热磷酸去除氮化硅,然后用HF溶液去除栅隔离层位置的SiO2,并重新生成品质更好的SiO2薄膜,作为栅极氧化层。
14、LPCVD 沉积多晶硅层,然后涂敷光阻进行光刻,以及等离子蚀刻技术,栅极结构,并氧化生成SiO2 保护层。
15、表面涂敷光阻,去除P 阱区的光阻,注入砷(As) 离子,形成NMOS 的源漏极。
用同样的方法,在N 阱区,注入B离子形成PMOS 的源漏极。
16、利用PECVD 沉积一层无掺杂氧化层,保护元件,并进行退火处理。
17、沉积掺杂硼磷的氧化层18、濺镀第一层金属(1)薄膜的沉积方法根据其用途的不同而不同,厚度通常小于1um 。
(2)真空蒸发法(Evaporation Deposition )(3)溅镀(Sputtering Deposition )19、光刻技术定出VIA 孔洞,沉积第二层金属,并刻蚀出连线结构。
然后,用PECVD 法氧化层和氮化硅保护层。
20、光刻和离子刻蚀,定出PAD 位置21、最后进行退火处理,以保证整个Chip 的完整和连线的连接性晶圆制造总的工艺流程芯片的制造过程可概分为晶圆处理工序(Wafer Fabrication)、晶圆针测工序(Wafer Probe)、构装工序(Packaging)、测试工序(Initial Test and Final Test)等几个步骤。
其中晶圆处理工序和晶圆针测工序为前段(Front End)工序,而构装工序、测试工序为后段(Back End)工序。
1、晶圆处理工序:本工序的主要工作是在晶圆上制作电路及电子元件(如晶体管、电容、逻辑开关等),处理程序通常与产品种类和所使用的技术有关,但一般基本步骤是先将晶圆适当清洗,再在其表面进行氧化及化学气相沉积,然后进行涂膜、曝光、显影、蚀刻、离子植入、金属溅镀等反复步骤,最终在晶圆上完成数层电路及元件加工与制作。
2、晶圆针测工序:经过上道工序后,晶圆上就形成了一个个的小格,即晶粒,一般情况下,为便于测试,提高效率,同一片晶圆上制作同一品种、规格的产品;但也可根据需要制作几种不同品种、规格的产品。
在用针测(Probe)仪对每个晶粒检测其电气特性,并将不合格的晶粒标上记号后,将晶圆切开,分割成一颗颗单独的晶粒,再按其电气特性分类,装入不同的托盘中,不合格的晶粒则舍弃。
3、构装工序:就是将单个的晶粒固定在塑胶或陶瓷制的芯片基座上,并把晶粒上蚀刻出的一些引接线端与基座底部伸出的插脚连接,以作为与外界电路板连接之用,最后盖上塑胶盖板,用胶水封死。
其目的是用以保护晶粒避免受到机械刮伤或高温破坏。
到此才算制成了一块集成电路芯片(即我们在电脑里可以看到的那些黑色或褐色,两边或四边带有许多插脚或引线的矩形小块)。
4、测试工序:芯片制造的最后一道工序为测试,其又可分为一般测试和特殊测试,前者是将封装后的芯片置于各种环境下测试其电气特性,如消耗功率、运行速度、耐压度等。
经测试后的芯片,依其电气特性划分为不同等级。
而特殊测试则是根据客户特殊需求的技术参数,从相近参数规格、品种中拿出部分芯片,做有针对性的专门测试,看是否能满足客户的特殊需求,以决定是否须为客户设计专用芯片。
经一般测试合格的产品贴上规格、型号及出厂日期等标识的标签并加以包装后即可出厂。
而未通过测试的芯片则视其达到的参数情况定作降级品或废品ETCH何谓蚀刻(Etch)答:将形成在晶圆表面上的薄膜全部,或特定处所去除至必要厚度的制程。
蚀刻种类:答:(1) 干蚀刻 (2) 湿蚀刻蚀刻对象依薄膜种类可分为:答:poly,oxide, metal何谓dielectric 蚀刻(介电质蚀刻)答:Oxide etch and nitride etch半导体中一般介电质材质为何答:氧化硅/氮化硅何谓湿式蚀刻答:利用液相的酸液或溶剂将不要的薄膜去除何谓电浆Plasma答:电浆是物质的第四状态带有正,负电荷及中性粒子之总和;其中包含电子正离子,负离子,中性分子,活性基及发光子等,产生电浆的方法可使用高温或高电压.何谓干式蚀刻答:利用plasma将不要的薄膜去除何谓Under-etching(蚀刻不足)答:系指被蚀刻材料,在被蚀刻途中停止造成应被去除的薄膜仍有残留何谓Over-etching(过蚀刻)答:蚀刻过多造成底层被破坏何谓Etch rate(蚀刻速率)答:单位时间内可去除的蚀刻材料厚度或深度何谓Seasoning(陈化处理)答:是在蚀刻室的清净或更换零件后,为要稳定制程条件,使用仿真(dummy)晶圆进行数次的蚀刻循环。
Asher的主要用途答:光阻去除Wet bench dryer 功用为何答:将晶圆表面的水份去除列举目前Wet bench dry方法:答:(1) Spin Dryer (2) Marangoni dry (3) IPA Vapor Dry何谓Spin Dryer答:利用离心力将晶圆表面的水份去除何谓Maragoni Dryer答:利用表面张力将晶圆表面的水份去除何谓IPA Vapor Dryer答:利用IPA(异丙醇)和水共溶原理将晶圆表面的水份去除测Particle时,使用何种测量仪器答:Tencor Surfscan测蚀刻速率时,使用何者量测仪器答:膜厚计,测量膜厚差值何谓AEI答:After Etching Inspection 蚀刻后的检查AEI目检Wafer须检查哪些项目:答:(1) 正面颜色是否异常及刮伤(2) 有无缺角及Particle (3)刻号是否正确金属蚀刻机台转非金属蚀刻机台时应如何处理答:清机防止金属污染问题金属蚀刻机台asher的功用为何答:去光阻及防止腐蚀金属蚀刻后为何不可使用一般硫酸槽进行清洗答:因为金属线会溶于硫酸中"Hot Plate"机台是什幺用途答:烘烤Hot Plate 烘烤温度为何答:90~120 度C何种气体为Poly ETCH主要使用气体答:Cl2, HBr, HCl用于Al 金属蚀刻的主要气体为答:Cl2, BCl3用于W金属蚀刻的主要气体为答:SF6何种气体为oxide vai/contact ETCH主要使用气体答:C4F8, C5F8, C4F6硫酸槽的化学成份为:答:H2SO4/H2O2AMP槽的化学成份为:答:NH4OH/H2O2/H2OUV curing 是什幺用途答:利用UV光对光阻进行预处理以加强光阻的强度"UV curing"用于何种层次答:金属层何谓EMO答:机台紧急开关EMO作用为何答:当机台有危险发生之顾虑或已不可控制,可紧急按下湿式蚀刻门上贴有那些警示标示答:(1) 警告.内部有严重危险.严禁打开此门(2) 机械手臂危险. 严禁打开此门(3) 化学药剂危险严禁打开此门遇化学溶液泄漏时应如何处置答:严禁以手去测试漏出之液体应以酸碱试纸测试. 并寻找泄漏管路.遇IPA 槽着火时应如何处置答:立即关闭IPA 输送管路并以机台之灭火器灭火及通知紧急应变小组BOE槽之主成份为何答:HF(氢氟酸)与NH4F(氟化铵).BOE为那三个英文字缩写答:Buffered Oxide Etcher 。
有毒气体之阀柜(VMB)功用为何答:当有毒气体外泄时可利用抽气装置抽走,并防止有毒气体漏出电浆的频率一般MHz,为何不用其它频率答:为避免影响通讯品质,目前只开放特定频率,作为产生电浆之用,如380~420KHz ,,等何谓ESC(electrical static chuck)答:利用静电吸附的原理, 将Wafer 固定在极板(Substrate) 上Asher主要气体为答:O2Asher机台进行蚀刻最关键之参数为何答:温度简述TURBO PUMP 原理答:利用涡轮原理,可将压力抽至10-6TORR热交换器(HEAT EXCHANGER)之功用为何答:将热能经由介媒传输,以达到温度控制之目地简述BACKSIDE HELIUM COOLING之原理答:藉由氦气之良好之热传导特性,能将芯片上之温度均匀化ORIENTER 之用途为何答:搜寻notch边使芯片进反应腔的位置都固定可追踪问题简述EPD之功用答:侦测蚀刻终点End point detector利用波长侦测蚀刻终点何谓M F C答:mass flow controler气体流量控制器;用于控制反应气体的流量GDP 为何答:气体分配盘(gas distribution plate)GDP 有何作用答:均匀地将气体分布于芯片上方何谓isotropic etch答:等向性蚀刻侧壁侧向蚀刻的机率均等何谓anisotropic etch答:非等向性蚀刻;侧壁侧向蚀刻的机率少何谓etch 选择比答:不同材质之蚀刻率比值何谓AEI CD答:蚀刻后特定图形尺寸之大小,特征尺寸(Critical Dimension)何谓CD bias答:蚀刻CD减蚀刻前黄光CD简述何谓田口式实验计划法答:利用混合变因安排辅以统计归纳分析何谓反射功率答:蚀刻过程中,所施予之功率并不会完全地被反应腔内接收端所接受,会有部份值反射掉,此反射之量,称为反射功率Load Lock 之功能为何答:Wafers经由loadlock后再进出反应腔,确保反应腔维持在真空下不受粉尘及湿度的影响厂务供气系统中何谓Bulk Gas答:Bulk Gas 为大气中普遍存在之制程气体如N2, O2, Ar 等厂务供气系统中何谓Inert Gas答:Inert Gas 为一些特殊无强烈毒性的气体, 如NH3, CF4, CHF3, SF6 等厂务供气系统中何谓Toxic Gas答:Toxic Gas 为具有强烈危害人体的毒性气体, 如SiH4, Cl2, BCl3 等机台维修时异常告示排及机台控制权应如何处理答:将告示牌切至异常且将机台控制权移至维修区以防有人误动作冷却器的冷却液为何功用答:传导热Etch之废气有经何种方式处理答:利用水循环将废气溶解之后排放至废酸槽何谓RPM答:即Remote Power Module,系统总电源箱.火灾异常处理程序答:(1) 立即警告周围人员. (2) 尝试 3 秒钟灭火. (3) 按下EMO停止机台. (4) 关闭VMB Valve 并通知厂务. (5) 撤离.一氧化碳(CO)侦测器警报异常处理程序答:(1) 警告周围人员. (2) 按Pause 键,暂止Run 货. (3) 立即关闭VMB 阀,并通知厂务. (4) 进行测漏高压电击异常处理程序答:(1) 确认安全无虑下,按EMO键(2) 确认受伤原因(误触电源漏水等)(3) 处理受伤人员T/C (传送Transfer Chamber) 之功能为何答:提供一个真空环境, 以利机器手臂在反应腔与晶舟间传送Wafer,节省时间机台PM时需佩带面具否答:是,防毒面具机台停滞时间过久run货前需做何动作答:Seasoning(陈化处理)何谓Seasoning(陈化处理)答:是在蚀刻室的清净或更换零件后,为要稳定制程条件,使用仿真(dummy)晶圆进行数次的蚀刻循环。