晶圆的生产工艺流程汇总
- 格式:docx
- 大小:9.41 KB
- 文档页数:2

晶圆制造工艺流程和处理工序晶圆制造工艺流程1、表面清洗2、初次氧化3、CVD(Chemical Vapor deposiTIon) 法沉积一层Si3N4 (Hot CVD 或LPCVD) 。
(1)常压CVD (Normal Pressure CVD) (2)低压CVD (Low Pressure CVD) (3)热CVD (Hot CVD)/(thermal CVD) (4)电浆增强CVD (Plasma Enhanced CVD) (5)MOCVD (Metal Organic CVD) 分子磊晶成长(Molecular Beam Epitaxy) (6)外延生长法(LPE)4、涂敷光刻胶(1)光刻胶的涂敷(2)预烘(pre bake) (3)曝光(4)显影(5)后烘(post bake) (6)腐蚀(etching) (7)光刻胶的去除5、此处用干法氧化法将氮化硅去除6 、离子布植将硼离子(B+3) 透过SiO2 膜注入衬底,形成P 型阱7、去除光刻胶,放高温炉中进行退火处理8、用热磷酸去除氮化硅层,掺杂磷(P+5) 离子,形成N 型阱9、退火处理,然后用HF 去除SiO2 层10、干法氧化法生成一层SiO2 层,然后LPCVD 沉积一层氮化硅11、利用光刻技术和离子刻蚀技术,保留下栅隔离层上面的氮化硅层12、湿法氧化,生长未有氮化硅保护的SiO2 层,形成PN 之间的隔离区13、热磷酸去除氮化硅,然后用HF 溶液去除栅隔离层位置的SiO2 ,并重新生成品质更好的SiO2 薄膜, 作为栅极氧化层。
14、LPCVD 沉积多晶硅层,然后涂敷光阻进行光刻,以及等离子蚀刻技术,栅极结构,并氧化生成SiO2 保护层。
15、表面涂敷光阻,去除P 阱区的光阻,注入砷(As) 离子,形成NMOS 的源漏极。
用同样的方法,在N 阱区,注入B 离子形成PMOS 的源漏极。
16、利用PECVD 沉积一层无掺杂氧化层,保护元件,并进行退火处理。
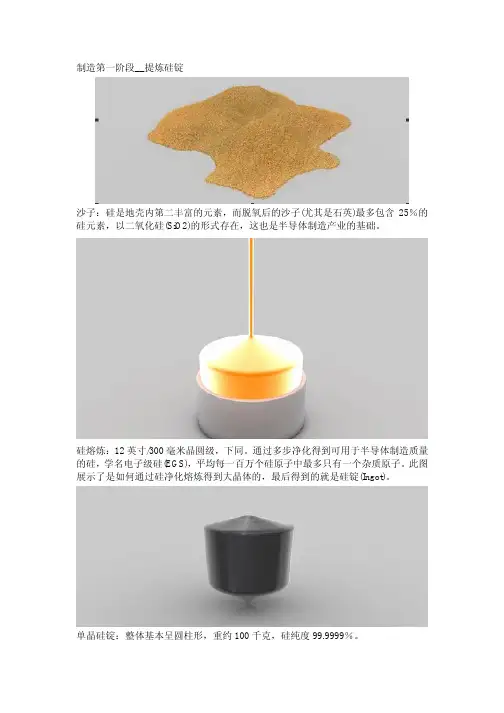
制造第一阶段__提炼硅锭沙子:硅是地壳内第二丰富的元素,而脱氧后的沙子(尤其是石英)最多包含25%的硅元素,以二氧化硅(SiO2)的形式存在,这也是半导体制造产业的基础。
硅熔炼:12英寸/300毫米晶圆级,下同。
通过多步净化得到可用于半导体制造质量的硅,学名电子级硅(EGS),平均每一百万个硅原子中最多只有一个杂质原子。
此图展示了是如何通过硅净化熔炼得到大晶体的,最后得到的就是硅锭(Ingot)。
单晶硅锭:整体基本呈圆柱形,重约100千克,硅纯度99.9999%。
硅锭切割:横向切割成圆形的单个硅片,也就是我们常说的晶圆(Wafer)。
晶圆:切割出的晶圆经过抛光后变得几乎完美无瑕,表面甚至可以当镜子。
事实上,所有的芯片公司自己并不生产这种晶圆,而是从第三方半导体企业那里直接购买成品,然后利用自己的生产线进一步加工,比如现在主流的45nm HKMG(高K金属栅极)。
光刻胶(Photo Resist):图中蓝色部分就是在晶圆旋转过程中浇上去的光刻胶液体,类似制作传统胶片的那种。
晶圆旋转可以让光刻胶铺的非常薄、非常平。
光刻:光刻胶层随后透过掩模(Mask)被曝光在紫外线(UV)之下,变得可溶,期间发生的化学反应类似按下机械相机快门那一刻胶片的变化。
掩模上印着预先设计好的电路图案,紫外线透过它照在光刻胶层上,就会形成微处理器的每一层电路图案。
一般来说,在晶圆上得到的电路图案是掩模上图案的四分之一。
光刻:由此进入50-200纳米尺寸的晶体管级别。
一块晶圆上可以切割出数百个处理器,不过从这里开始把视野缩小到其中一个上,展示如何制作晶体管等部件。
晶体管相当于开关,控制着电流的方向。
现在的晶体管已经如此之小,一个针头上就能放下大约3000万个。
制造第四阶段_光刻胶的使命溶解光刻胶:光刻过程中曝光在紫外线下的光刻胶被溶解掉,清除后留下的图案和掩模上的一致。
蚀刻:使用化学物质溶解掉暴露出来的晶圆部分,而剩下的光刻胶保护着不应该蚀刻的部分。

晶圆制备的九个工艺步骤嘿,朋友们!今天咱就来讲讲晶圆制备的那九个工艺步骤。
你可别小瞧这晶圆制备啊,就好比盖房子,那每一步都得精心细致,稍有差错可就全白费啦!首先就是要选好材料,这就像做菜选食材一样重要。
得挑那些高质量的,不然怎么能做出好的晶圆呢!然后呢,要进行清洗,把那些杂质啥的都洗掉,让晶圆清清爽爽的。
接下来就是热处理啦,这就像是给晶圆来个“桑拿浴”,让它变得更结实。
再之后就是光刻,这可神奇了,就像给晶圆画画一样,把那些精细的图案都印上去。
刻蚀就像是雕琢,把不需要的部分去掉,留下精华。
然后是掺杂,给晶圆加点“调料”,让它具备特殊的性能。
薄膜沉积呢,就像给晶圆穿上一层“衣服”,起到保护和功能性的作用。
平坦化就像是给地面磨平一样,让晶圆表面更光滑。
最后一步就是检查啦,这可不能马虎,得仔仔细细地看,有一点问题都不行啊!你想想,这九个步骤,哪一个不重要?哪一个能随便应付?这就跟人成长一样,每一步都得稳稳当当的。
要是中间出了岔子,那可就麻烦了。
咱就说,要是清洗不干净,那后面的步骤能做好吗?肯定不行啊!就好比脸上有脏东西没洗干净就化妆,那能好看吗?所以啊,这晶圆制备的九个工艺步骤,那都是环环相扣,缺一不可。
每一个从事这行的人都得打起十二分的精神,认真对待每一个步骤。
咱也得明白,科技的发展就是这样,一点点积累,一点点进步。
这晶圆制备虽然听起来很专业很复杂,但只要咱认真去了解,其实也不难理解嘛。
总之,这九个工艺步骤就是晶圆制备的关键,它们共同铸就了半导体行业的坚实基础。
让我们一起为这些默默付出的人们点赞,为科技的进步欢呼吧!。

晶圆的生产工艺流程介绍从大的方面来讲,晶圆生产包括晶棒制造和晶片制造两大步骤,它又可细分为以下几道主要工序(其中晶棒制造只包括下面的第一道工序,其余的全部属晶片制造,所以有时又统称它们为晶柱切片后处理工序):晶棒成长 --> 晶棒裁切与检测 --> 外径研磨 --> 切片 --> 圆边 --> 表层研磨 --> 蚀刻 --> 去疵 --> 抛光 --> 清洗 --> 检验 --> 包装1.晶棒成长工序:它又可细分为:1).融化(Melt Down)将块状的高纯度复晶硅置于石英坩锅内,加热到其熔点1420°C以上,使其完全融化。
2).颈部成长(Neck Growth)待硅融浆的温度稳定之后,将〈1.0.0〉方向的晶种慢慢插入其中,接着将晶种慢慢往上提升,使其直径缩小到一定尺寸(一般约6mm左右),维持此直径并拉长100-200mm,以消除晶种内的晶粒排列取向差异。
3).晶冠成长(Crown Growth)颈部成长完成后,慢慢降低提升速度和温度,使颈部直径逐渐加大到所需尺寸(如5、6、8、12吋等)。
4).晶体成长(Body Growth)不断调整提升速度和融炼温度,维持固定的晶棒直径,只到晶棒长度达到预定值。
5).尾部成长(Tail Growth)当晶棒长度达到预定值后再逐渐加快提升速度并提高融炼温度,使晶棒直径逐渐变小,以避免因热应力造成排差和滑移等现象产生,最终使晶棒与液面完全分离。
到此即得到一根完整的晶棒。
2.晶棒裁切与检测(Cutting & Inspection)将长成的晶棒去掉直径偏小的头、尾部分,并对尺寸进行检测,以决定下步加工的工艺参数。
3.外径研磨(Surface Grinding & Shaping)由于在晶棒成长过程中,其外径尺寸和圆度均有一定偏差,其外园柱面也凹凸不平,所以必须对外径进行修整、研磨,使其尺寸、形状误差均小于允许偏差。

晶圆制造工艺流程1、表面清洗2、初次氧化3、 CVD(Chemic al Vapordeposi tion)法沉积一层Si3N4(Hot CVD 或 LPCVD)。
(1)常压 CVD (Normal Pressu re CVD)(2)低压 CVD (Low Pressu re CVD)(3)热 CVD (Hot CVD)/(therma l CVD)(4)电浆增强 CVD (Plasma Enhanc ed CVD)(5)MOCVD(MetalOrgani c CVD) & 分子磊晶成长 (Molecu lar Beam Epitax y)(6)外延生长法(LPE)4、涂敷光刻胶(1)光刻胶的涂敷(2)预烘(pre bake)(3)曝光(4)显影(5)后烘(post bake)(6)腐蚀 (etchin g)(7)光刻胶的去除5、此处用干法氧化法将氮化硅去除6 、离子布植将硼离子(B+3) 透过SiO2 膜注入衬底,形成P 型阱7、去除光刻胶,放高温炉中进行退火处理8、用热磷酸去除氮化硅层,掺杂磷(P+5) 离子,形成N 型阱9、退火处理,然后用HF 去除SiO2 层10、干法氧化法生成一层SiO2 层,然后 LPCVD沉积一层氮化硅11、利用光刻技术和离子刻蚀技术,保留下栅隔离层上面的氮化硅层12、湿法氧化,生长未有氮化硅保护的SiO2 层,形成PN 之间的隔离区13、热磷酸去除氮化硅,然后用HF 溶液去除栅隔离层位置的SiO2 ,并重新生成品质更好的SiO2 薄膜, 作为栅极氧化层。
14、LPCVD沉积多晶硅层,然后涂敷光阻进行光刻,以及等离子蚀刻技术,栅极结构,并氧化生成SiO2 保护层。
15、表面涂敷光阻,去除P 阱区的光阻,注入砷(As) 离子,形成NMOS 的源漏极。

晶圆加工工艺流程1、表面清洗晶圆表面附着一层大约2um的Al2O3和甘油混合液保护之,在制作前必须进行化学刻蚀和表面清洗。
2、初次氧化有热氧化法生成SiO2 缓冲层,用来减小后续中Si3N4对晶圆的应力氧化技术:干法氧化Si(固)+O2 à SiO2(固)和湿法氧化Si(固)+2H2O à SiO2(固)+2H2。
干法氧化通常用来形成,栅极二氧化硅膜,要求薄,界面能级和固定电荷密度低的薄膜。
干法氧化成膜速度慢于湿法。
湿法氧化通常用来形成作为器件隔离用的比较厚的二氧化硅膜。
当SiO2膜较薄时,膜厚与时间成正比。
SiO2膜变厚时,膜厚与时间的平方根成正比。
因而,要形成较厚SiO2膜,需要较长的氧化时间。
SiO2膜形成的速度取决于经扩散穿过SiO2膜到达硅表面的O2及OH基等氧化剂的数量的多少。
湿法氧化时,因在于OH基SiO2膜中的扩散系数比O2的大。
氧化反应,Si 表面向深层移动,距离为SiO2膜厚的0.44倍。
因此,不同厚度的SiO2膜,去除后的Si表面的深度也不同。
SiO2膜为透明,通过光干涉来估计膜的厚度。
这种干涉色的周期约为200nm,如果预告知道是几次干涉,就能正确估计。
对其他的透明薄膜,如知道其折射率,也可用公式计算出(dSiO2)/(dox)=(nox)/(nSiO2)。
SiO2膜很薄时,看不到干涉色,但可利用Si的疏水性和SiO2的亲水性来判断SiO2膜是否存在。
也可用干涉膜计或椭圆仪等测出。
SiO2和Si界面能级密度和固定电荷密度可由MOS二极管的电容特性求得。
(100)面的Si的界面能级密度最低,约为10E+10-- 10E+11/cm ?2.eV-1 数量级。
(100)面时,氧化膜中固定电荷较多,固定电荷密度的大小成为左右阈值的主要因素。
3、热CVD(HotCVD)/(thermalCVD)此方法生产性高,梯状敷层性佳(不管多凹凸不平,深孔中的表面亦产生反应,及气体可到达表面而附着薄膜)等,故用途极广。

晶圆制造工艺流程晶圆制造是指通过一系列工艺步骤来制作半导体芯片的过程。
以下是典型的晶圆制造工艺流程。
1.单晶片生长:晶圆制造的第一步是将纯度很高的硅材料通过化学气相沉积或其他方法生长为单晶片。
这个步骤是整个工艺流程的基础。
2.晶圆切割:在单晶片生长完成后,将其切割成薄片,即晶圆。
通常使用金刚石刀进行切割,切割后的晶圆具有相对平整的表面和一定的厚度。
3.光刻:光刻是晶圆制造中关键的步骤之一、在此步骤中,通过光刻机将需要形成的图案转移到晶圆表面。
这通常涉及到在晶圆表面涂覆光刻胶,然后通过光刻机的曝光和显影过程来形成所需的图案。
4.晶圆清洗:在光刻步骤完成后,晶圆需要进行清洗,以去除光刻胶的残留物和其他杂质。
晶圆清洗通常会使用化学溶液和超声波的作用来清洁晶圆表面。
5.电镀:在一些情况下,需要对晶圆进行电镀,以增加其表面的导电性和减小电阻。
这个步骤通常涉及将晶圆浸入含有金属离子的溶液中,在电流作用下使金属离子沉积在晶圆表面。
6.氧化:氧化是将晶圆表面涂覆一层氧化物的过程。
这个步骤可以在大气中进行,也可以通过化学气相沉积来完成。
氧化的目的是改善晶圆表面的质量,并为后续步骤提供一定的保护。
7.形成电极和连线:在晶圆上制作电极和连线是将芯片的不同部分连接起来的关键步骤。
这个步骤通常涉及使用光刻和电镀等技术,将导电材料沉积在晶圆表面,并通过化学蚀刻来形成所需的电极和连线。
8.打磨和抛光:在制造晶圆过程中,由于一些原因,晶圆表面可能会有一些不平整和缺陷。
为了修复这些问题,晶圆需要经过打磨和抛光,使其表面更加平整和光滑。
9.测试和封装:在晶圆制造完毕后,需要对芯片进行测试,以确保其正常工作。
测试通常会使用特定的测试设备和测试程序来进行,包括电性能测试、可靠性测试等。
然后,芯片会进行封装,即将其放入塑料或金属封装中,以保护芯片并为其提供适当的引脚。
以上是晶圆制造的典型工艺流程。
当然,实际的晶圆制造可能会因不同应用领域和制造工艺的差异而略有不同。

晶圆制造工艺及管控要求一、初识晶圆制造工艺1.1 什么是晶圆制造工艺晶圆制造工艺,是指将硅片(即晶圆)通过一系列的工艺加工和处理,制作成集成电路芯片的过程。
1.2 晶圆制造工艺的重要性晶圆制造工艺是整个集成电路生产过程中非常重要的环节,它直接决定了芯片的品质和性能。
二、晶圆制造工艺流程2.1 清洗和去杂质处理1.用超声波清洗机将晶圆放入去离子水中,去除表面的杂质和氧化物。
2.在酸性溶液中浸泡,去除晶圆表面的金属离子和有机物质。
2.2 氧化和扩散1.将晶圆放入高温炉中,在氧气或蒸汽中进行氧化处理,生成一层氧化硅。
2.将掺杂源固态扩散到氧化硅层中,调整晶圆的电性能。
2.3 光刻和曝光1.在光刻机中涂覆光刻胶到晶圆表面。
2.利用掩膜和紫外线曝光,将光刻胶在某些区域暴露出来,形成芯片的图形。
3.使用化学溶解光刻胶的方法,去除未暴露的部分。
2.4 蚀刻和沉积1.将晶圆放入蚀刻池中,用化学液体去除暴露的氧化硅或金属。
2.通过物理或化学反应,在芯片上沉积一层新的材料。
2.5 电镀和铺膜1.将晶圆浸入电镀液,使其表面镀上一层金属。
2.使用化学气相沉积法,将薄膜均匀覆盖在晶圆上。
2.6 制程控制和检测1.对制程参数进行监控和调整,确保每个工艺步骤的稳定性和一致性。
2.使用显微镜、扫描电镜等检测设备,对晶圆进行质量检测和缺陷分析。
三、晶圆制造管控要求3.1 温度控制要求1.不同工艺步骤对温度的要求不同,需要精确控制每个步骤的温度。
2.温度的波动范围应控制在允许范围内,以保证制程的稳定性和芯片品质。
3.2 时间控制要求1.每个工艺步骤所需的时间应精确掌握,以确保整个制程的时效性。
2.不同步骤的时间间隔也需要合理安排,以避免工艺步骤之间的冲突和干扰。
3.3 成本控制要求1.合理规划工艺流程,最大程度节约原材料和能源的使用。
2.优化制程参数,提高生产效率,降低生产成本。
3.4 质量控制要求1.建立严格的质量管理体系,确保每个工艺步骤的质量符合要求。

晶圆制造十大工艺
晶圆制造是集成电路(IC)制造的关键步骤之一。
下面是晶圆制造中的十大工艺步骤:
1.晶圆生长(Czochralski Process):
•将单晶硅从熔融硅中拉出,形成长而纯净的单晶圆柱,用于后续的加工。
2.切割(Wafering):
•将长的单晶圆柱切割成薄片,形成晶圆。
这些薄片通常有200毫米或300毫米的直径。
3.化学机械抛光(Chemical Mechanical Polishing,CMP):
•对晶圆表面进行机械磨削和化学腐蚀,以获得平整的表面。
4.清洗(Cleaning):
•使用特殊的清洗过程去除晶圆表面的杂质,确保表面干净。
5.氧化(Oxidation):
•在晶圆表面形成氧化层,通常是二氧化硅(SiO2),用于隔离不同的区域。
6.光刻(Photolithography):
•利用光学光刻技术在晶圆表面敷设光阻,然后使用光掩模形成图案。
7.蚀刻(Etching):
•使用化学或物理方法将光刻过程中未被保护的区域去除,形成所需的图案结构。
8.离子注入(Ion Implantation):
•将离子注入晶圆,改变晶体结构,用于形成电子器件的特定区域。
9.金属化(Metallization):
•在晶圆表面涂覆金属层,用于连接电子器件和形成电路。
10.封装(Packaging):
•将晶圆上的芯片封装在塑料或陶瓷封装中,以提供电气和机械保护。
这些步骤是在晶圆制造的不同阶段进行的,最终形成成熟的集成电路芯片。
这些步骤的每一步都需要高度精密和精确的设备和工艺控制,以确保最终产品的性能和可靠性。

晶圆生产流程及关键工艺参数1. 晶圆生产流程概述晶圆生产是半导体工业中的重要环节,主要包括晶圆切割、清洗、掩膜光刻、离子注入、扩散、腐蚀、金属化等多个工序。
下面将详细介绍每个工序的步骤和关键工艺参数。
2. 晶圆生产流程详解2.1 晶圆切割晶圆切割是将硅单晶棒切割成具有一定厚度的硅片,主要步骤包括:2.1.1 硅单晶棒修整将硅单晶棒进行修整,使其表面光滑且直径均匀。
2.1.2 硅单晶棒预定位对硅单晶棒进行预定位,确定切割位置。
2.1.3 硅单晶棒切割使用金刚石线锯将硅单晶棒切割成硅片。
2.1.4 硅片清洗将切割好的硅片进行清洗,去除杂质和污染物。
2.2 清洗清洗是将硅片表面的杂质和污染物去除,主要步骤包括:2.2.1 预清洗将硅片浸泡在预清洗液中,去除大部分粉尘和有机污染物。
2.2.2 主清洗使用酸性或碱性清洗液对硅片进行主要清洗,去除残留的有机污染物和金属离子。
2.2.3 漂洗用纯水对硅片进行漂洗,去除清洗液残留。
2.2.4 干燥将硅片在干燥器中进行干燥,去除水分。
2.3 掩膜光刻掩膜光刻是通过光刻胶和掩膜模板将芯片图形转移到硅片上,主要步骤包括:2.3.1 光刻胶涂覆将光刻胶均匀涂覆在硅片上。
2.3.2 掩膜对位将掩膜模板对准硅片,并通过对位器进行精确定位。
2.3.3 曝光使用紫外光将掩膜模板上的芯片图形转移到硅片上。
2.3.4 显影使用显影液去除未曝光的光刻胶,形成芯片图形。
2.4 离子注入离子注入是将特定元素注入硅片表面,改变硅片的导电性能,主要步骤包括:2.4.1 离子源准备准备离子源和加速器设备,确定注入元素和能量。
2.4.2 离子束对准将离子束对准硅片表面,并通过对位器进行精确定位。
2.4.3 注入通过加速器加速离子束,使其注入硅片表面,并控制注入剂量和深度。
2.5 扩散扩散是将特定元素在硅片中进行扩散,形成PN结构,主要步骤包括:2.5.1 清洗将注入后的硅片进行清洗,去除污染物。

晶圆的生产工艺流程:从大的方面来讲,晶圆生产包括晶棒制造和晶片制造两大步骤,它又可细分为以下几道主要工序(其中晶棒制造只包括下面的第一道工序,其余的全部属晶片制造,所以有时又统称它们为晶柱切片后处理工序):晶棒成长 -- 晶棒裁切与检测 -- 外径研磨 -- 切片 -- 圆边-- 表层研磨 -- 蚀刻 -- 去疵 -- 抛光 -- 清洗 -- 检验 -- 包装 1、晶棒成长工序:它又可细分为:1)、融化(Melt Down):将块状的高纯度复晶硅置于石英坩锅内,加热到其熔点1420°C以上,使其完全融化。
2)、颈部成长(Neck Growth):待硅融浆的温度稳定之后,将〈1.0.0〉方向的晶种慢慢插入其中,接着将晶种慢慢往上提升,使其直径缩小到一定尺寸(一般约6mm左右),维持此直径并拉长100-200mm,以消除晶种内的晶粒排列取向差异。
3)、晶冠成长(Crown Growth):颈部成长完成后,慢慢降低提升速度和温度,使颈部直径逐渐加大到所需尺寸(如5、6、8、12吋等)。
4)、晶体成长(Body Growth):不断调整提升速度和融炼温度,维持固定的晶棒直径,只到晶棒长度达到预定值。
5)、尾部成长(Tail Growth):当晶棒长度达到预定值后再逐渐加快提升速度并提高融炼温度,使晶棒直径逐渐变小,以避免因热应力造成排差和滑移等现象产生,最终使晶棒与液面完全分离。
到此即得到一根完整的晶棒。
2、晶棒裁切与检测(Cutting & Inspection):将长成的晶棒去掉直径偏小的头、尾部分,并对尺寸进行检测,以决定下步加工的工艺参数。
3、外径研磨(Surface Grinding & Shaping):由于在晶棒成长过程中,其外径尺寸和圆度均有一定偏差,其外园柱面也凹凸不平,所以必须对外径进行修整、研磨,使其尺寸、形状误差均小于允许偏差。
4、切片(Wire Saw Slicing):由于硅的硬度非常大,所以在本工序里,采用环状、其内径边缘镶嵌有钻石颗粒的薄片锯片将晶棒切割成一片片薄片。
晶圆加工流程
晶圆加工流程通常包括以下步骤:
1. 晶圆生长:通常使用化学气相沉积(CVD)或物理气相沉
积(PVD)等方法,在衬底上通过不断加料、热处理等方式
逐渐生长出晶圆。
2. 退火:将生长出的晶圆加热至高温,以去除内部的应力和缺陷,并提高晶体品质。
3. 切割:将晶圆切割成标准的圆片,通常以钻孔和砂轮为主。
在切割过程中需要控制切割角度和切割深度等参数,以确保每个圆片的质量和规格一致。
4. 去胶:去除表面上的胶层,通常使用化学物质如酸、氢氟酸等,也可以使用激光去胶等方法。
5. 清洗:将切割后的圆片进行清洗,去除表面的污染和残留物,通常使用气流除尘和化学溶解等方法。
6. 处理:对圆片进行各种处理,如刻蚀、离子注入、薄膜沉积等,以制备出各种器件和元件。
7. 封装:将制备好的器件和元件封装成完整的芯片,以保护其内部结构和电路,并方便连接和使用。
以上是典型的晶圆加工流程,不同的应用和工艺还有许多细节和差异。
晶圆的生产工艺流程:从大的方面来讲,晶圆生产包括晶棒制造和晶片制造两大步骤,它又可细分为以下几道主要工序(其中晶棒制造只包括下面的第一道工序,其余的全部属晶片制造,所以有时又统称它们为晶柱切片后处理工序):晶棒成长 -- 晶棒裁切与检测 -- 外径研磨 -- 切片 -- 圆边-- 表层研磨 -- 蚀刻 -- 去疵 -- 抛光 -- 清洗 -- 检验 -- 包装 1、晶棒成长工序:它又可细分为:1)、融化(Melt Down):将块状的高纯度复晶硅置于石英坩锅内,加热到其熔点1420°C以上,使其完全融化。
2)、颈部成长(Neck Growth):待硅融浆的温度稳定之后,将〈1.0.0〉方向的晶种慢慢插入其中,接着将晶种慢慢往上提升,使其直径缩小到一定尺寸(一般约6mm左右),维持此直径并拉长100-200mm,以消除晶种内的晶粒排列取向差异。
3)、晶冠成长(Crown Growth):颈部成长完成后,慢慢降低提升速度和温度,使颈部直径逐渐加大到所需尺寸(如5、6、8、12吋等)。
4)、晶体成长(Body Growth):不断调整提升速度和融炼温度,维持固定的晶棒直径,只到晶棒长度达到预定值。
5)、尾部成长(Tail Growth):当晶棒长度达到预定值后再逐渐加快提升速度并提高融炼温度,使晶棒直径逐渐变小,以避免因热应力造成排差和滑移等现象产生,最终使晶棒与液面完全分离。
到此即得到一根完整的晶棒。
2、晶棒裁切与检测(Cutting & Inspection):将长成的晶棒去掉直径偏小的头、尾部分,并对尺寸进行检测,以决定下步加工的工艺参数。
3、外径研磨(Surface Grinding & Shaping):由于在晶棒成长过程中,其外径尺寸和圆度均有一定偏差,其外园柱面也凹凸不平,所以必须对外径进行修整、研磨,使其尺寸、形状误差均小于允许偏差。
4、切片(Wire Saw Slicing):由于硅的硬度非常大,所以在本工序里,采用环状、其内径边缘镶嵌有钻石颗粒的薄片锯片将晶棒切割成一片片薄片。
晶圆生产主要工艺流程晶圆生产是集成电路制造的基础工艺流程,也是整个芯片制造过程中的关键环节。
晶圆生产主要包括晶圆加工、掩膜制备、光刻、扩散、腐蚀、离子注入、热处理等多个工艺步骤。
下面将详细介绍晶圆生产的主要工艺流程。
一、晶圆加工晶圆加工是整个晶圆生产的第一步,也是最关键的一步。
首先,需要从硅单晶片中切割出晶圆,常用的切割方法有线锯切割和研磨切割两种。
切割完成后,需要对晶圆进行抛光,以去除切割过程中产生的毛刺和磨损层,使晶圆表面变得光滑。
二、掩膜制备掩膜制备是晶圆生产的重要一环,它是通过光刻技术来制备掩膜图形。
首先,需要将光刻胶涂覆在晶圆表面,然后使用掩膜对光刻胶进行曝光,通过光刻机进行曝光和显影处理,使光刻胶形成所需的图形。
掩膜图形决定了芯片的电路结构和功能。
三、光刻光刻是晶圆生产中的核心工艺步骤,用于将掩膜上的图形转移到晶圆上。
光刻过程中,首先将掩膜和晶圆对准,然后使用紫外光照射光刻胶,使光刻胶发生化学或物理变化。
然后,通过显影处理,使未曝光的部分光刻胶被溶解掉,暴露出晶圆表面的区域。
最后,使用蚀刻或其他加工方法,将暴露出来的晶圆表面进行加工。
四、扩散扩散是晶圆生产中的一种加工方法,用于控制晶圆表面杂质的浓度和分布。
扩散过程中,将晶圆置于高温炉中,与气体或液体中的杂质进行反应,使杂质从液体或气体中扩散到晶圆表面。
扩散后的晶圆表面形成了所需的掺杂区域,用于形成芯片中的电子器件。
五、腐蚀腐蚀是晶圆生产中的一种加工方法,用于去除晶圆表面的氧化层或其他不需要的杂质。
腐蚀过程中,将晶圆放置在腐蚀液中,使腐蚀液与晶圆表面发生化学反应,去除表面的氧化层或杂质。
腐蚀后的晶圆表面更加平整和清洁,有利于后续工艺的进行。
六、离子注入离子注入是晶圆生产中的一种加工方法,用于控制晶圆中杂质的浓度和分布。
离子注入过程中,将晶圆放置在离子注入机中,加速并定向注入离子束到晶圆表面。
注入的离子将与晶体中的原子进行替换或形成杂质,从而改变晶圆的电学性质。
晶圆制造流程
晶圆
晶圆是指硅半导体集成电路制作所用的硅晶片,由于其形状为圆形,故称为晶圆;在硅晶片上可加工制作成各种电路元件结构,而成为有特定电性功能之IC产品。
晶圆的原始材料是硅,而地壳表面有用之不竭的二氧化硅。
二氧化硅矿石经由电弧炉提炼,盐酸氯化,并经蒸馏后,制成了高纯度的多晶硅,其纯度高达99.999999999%。
晶圆制造流程
1、脱氧提纯
沙子/石英经过脱氧提纯以后的得到含硅量25%的Si02二氧化硅。
氧化硅经由电弧炉提炼,盐酸氯化,并蒸馏后,得到纯度高达99%以上的晶体硅。
晶体硅的纯度要求非常高,这也是造出晶圆昂贵的原因。
大家知道钻石是个什幺玩意儿吗?钻石就是碳元素经过脱氧以及其他因素形成的元素排列独特且纯度高达99.64%以上的晶体。
大家想想,晶圆比人造钻石便宜多了,感觉还是很划算的。
晶圆的生产工艺流程:从大的方面来讲,晶圆生产包括晶棒制造和晶片制造两大步骤,它又可细分为以下几道主要工序(其中晶棒制造只包括下面的第一道工序,其余的全部属晶片制造,所以有时又统称它们为晶柱切片后处理工序):晶棒成长 -- 晶棒裁切与检测 -- 外径研磨 -- 切片 -- 圆边-- 表层研磨 -- 蚀刻 -- 去疵 -- 抛光 -- 清洗 -- 检验 -- 包装 1、晶棒成长工序:它又可细分为:1)、融化(Melt Down):将块状的高纯度复晶硅置于石英坩锅内,加热到其熔点1420°C以上,使其完全融化。
2)、颈部成长(Neck Growth):待硅融浆的温度稳定之后,将〈1.0.0〉方向的晶种慢慢插入其中,接着将晶种慢慢往上提升,使其直径缩小到一定尺寸(一般约6mm左右),维持此直径并拉长100-200mm,以消除晶种内的晶粒排列取向差异。
3)、晶冠成长(Crown Growth):颈部成长完成后,慢慢降低提升速度和温度,使颈部直径逐渐加大到所需尺寸(如5、6、8、12吋等)。
4)、晶体成长(Body Growth):不断调整提升速度和融炼温度,维持固定的晶棒直径,只到晶棒长度达到预定值。
5)、尾部成长(Tail Growth):当晶棒长度达到预定值后再逐渐加快提升速度并提高融炼温度,使晶棒直径逐渐变小,以避免因热应力造成排差和滑移等现象产生,最终使晶棒与液面完全分离。
到此即得到一根完整的晶棒。
2、晶棒裁切与检测(Cutting & Inspection):将长成的晶棒去掉直径偏小的头、尾部分,并对尺寸进行检测,以决定下步加工的工艺参数。
3、外径研磨(Surface Grinding & Shaping):由于在晶棒成长过程中,其外径尺寸和圆度均有一定偏差,其外园柱面也凹凸不平,所以必须对外径进行修整、研磨,使其尺寸、形状误差均小于允许偏差。
4、切片(Wire Saw Slicing):由于硅的硬度非常大,所以在本工序里,采用环状、其内径边缘镶嵌有钻石颗粒的薄片锯片将晶棒切割成一片片薄片。
晶圆的生产工艺流程:
从大的方面来讲,晶圆生产包括晶棒制造和晶片制造两大步骤,它又可细分为以下几道主要工序(其中晶棒制造只包括下面的第一道工序,其余的全部属晶片制造,所以有时又统称它们为晶柱切片后处理工序):
晶棒成长--晶棒裁切与检测--外径研磨--切片--圆边--表层研磨--蚀刻--去疵--抛光--清洗--检验--包装1、晶棒成长工序:它又可细分为:
1)、融化(MeltDown ):将块状的高纯度复晶硅置于石英坩锅内,加热到其熔点1420°C以上,使其完全融化。
2)、颈部成长(Neck Growth):待硅融浆的温度安定之后,将〈1.0.0〉方向的晶种慢慢插入其中,接着将晶种慢慢往上提升,使其直径缩小到一定尺
寸(大凡约6mm左右),维持此直径并拉长100-200mm,以消除晶种内的晶粒排列取向差异。
3)、晶冠成长(CrownGrowth):颈部成长完成后,慢慢降低提升速度和温度,使颈部直径逐渐加大到所需尺寸(如5、6、8、12 吋等)。
4)、晶体成长(Body Growth):不断调整提升速度和融炼温度,维持不变的晶棒直径,只到晶棒长度达到预定值。
5)、尾部成长(Tail Growth):当晶棒长度达到预定值后再逐渐加快提升速度并提高融炼温度,使晶棒直径逐渐变小,以避免因热应力造成排差和滑移等现象产生,最终使晶棒与液面完全分离。
到此即得到一根统统的晶棒。
2、晶棒裁切与检测(Cutting&Inspection ) :将长成的晶棒去掉直径偏小的头、尾部分,并对尺寸进行检测,以决定下步加工的工艺参数。
3、外径研磨(Surface Grinding & Shaping :由于在晶棒成长过程中,其外径尺寸和圆度均有一定偏差,其外园柱面也凹凸不平,所以必须对外径进行修整、研磨,使其尺寸、形状误差均小于允许偏差。
4、切片(WireSawSlicing :由于硅的硬度非常大,所以在本工序里,采用环状、其内径边缘镶嵌有钻石颗粒的薄片锯片将晶棒切割成一片片薄片。
5、圆边(EdgeProfili ng):由于刚切下来的晶片外边缘很利害,硅单晶又是脆性材料,为避免边角崩裂影响晶片强度、破坏晶片表面光洁和对后工序带来污染颗粒,必须用专用的电脑控制设备自动修整晶片边缘形状和外径尺寸。
6、研磨(Lapping):研磨的目的在于去掉切割时在晶片表面产生的锯痕和破损,使晶片表面达到所要求的光洁度。
7、蚀刻(Etchi ng):以化学蚀刻的方法,去掉经上几道工序加工后在晶片表面因加工应力而产生的一层损伤层。
&去疵(Getteri ng):用喷砂法将晶片上的瑕疵与缺陷感到下半层,以利于后序加工。
9、抛光(Polishi ng):对晶片的边缘和表面进行抛光处理,一来进一步去掉附着在晶片上的微粒,二来获得极佳的表面平整度,以利于后面所要讲到的晶圆处理工序加工。
10、清洗(Cleaning):将加工完成的晶片进行最后的彻底清洗、风干。
11、检验(Inspection):进行最终全面的检验以保证产品最终达到规定的尺寸、形状、表面光洁度、平整度等技术指标。
12、包装(Pack ing):将成品用柔性材料,分隔、包裹、装箱,准备发往以下的芯片制造车间或出厂发往订货客户。