复旦大学集成电路工艺原理作业01
- 格式:doc
- 大小:36.00 KB
- 文档页数:1

集成电路技术集成电路工艺原理试卷(练习题库)1、用来做芯片的高纯硅被称为(),英文简称(),有时也被称为()。
2、单晶硅生长常用()和()两种生长方式,生长后的单晶硅被称为()。
3、晶圆的英文是(),其常用的材料是()和()。
4、晶圆制备的九个工艺步骤分别是()、整型、()、磨片倒角、刻蚀、()、清洗、检查和包装。
5、从半导体制造来讲,晶圆中用的最广的晶体平面的密勒符号是()、O 和()。
6、CZ直拉法生长单晶硅是把()变为()并且()的固体硅锭。
7、CZ直拉法的目的是()。
8、影响CZ直拉法的两个主要参数是O和()。
9、晶圆制备中的整型处理包括()、()和()。
10、制备半导体级硅的过程:1、();2、();3、O011、热氧化工艺的基本传输到芯片的不同部分。
77、多层金属化指用来连接硅片上高密度堆积器件的那些金属层。
78、阻挡层金属是淀积金属或金属塞,其作用是增加上下层材料的附着。
79、关键层是指那些线条宽度被刻蚀为器件特征尺寸的金属层。
80、传统互连金属线的材料是铝,即将取代它的金属材料是铜。
81、溅射是个化学过程,而非物理过程。
82、表面起伏的硅片进行平坦化处理,主要采用将低处填平的方法。
83、化学机械平坦化,简称CMP,它是一种表面全局平坦化技术。
84、平滑是一种平坦化类型,它只能使台阶角度圆滑和侧壁倾斜,但高度没有显著变化。
85、反刻是一种传统的平坦化技术,它能够实现全局平坦化。
86、电机电流终点检测不适合用作层间介质的化学机械平坦化。
87、在CMP为零的转换器。
133、CD是指硅片上的最小特征尺寸。
134、集成电路制造就是在硅片上执行一系列复杂的化学或者物理操作。
简而言之,这些操作可以分为四大基本类:薄膜135、人员持续不断地进出净化间,是净化间沾污的最大来源。
136、硅片制造厂可分为六个的区域,各个区域的照明都采用同一种光源以达到标准化。
137、世界上第一块集成电路是用硅半导体材料作为衬底制造的。

一、填空题(30分=1分*30)10题/章晶圆制备1.用来做芯片的高纯硅被称为(半导体级硅),英文简称(GSG ),有时也被称为(电子级硅)。
2.单晶硅生长常用(CZ法)和(区熔法)两种生长方式,生长后的单晶硅被称为(硅锭)。
3.晶圆的英文是(wafer ),其常用的材料是(硅)和(锗)。
4.晶圆制备的九个工艺步骤分别是(单晶生长)、整型、(切片)、磨片倒角、刻蚀、(抛光)、清洗、检查和包装。
5.从半导体制造来讲,晶圆中用的最广的晶体平面的密勒符号是(100 )、(110 )和(111 )。
6.CZ直拉法生长单晶硅是把(融化了的半导体级硅液体)变为(有正确晶向的)并且(被掺杂成p型或n型)的固体硅锭。
7.CZ直拉法的目的是(实现均匀掺杂的同时并且复制仔晶的结构,得到合适的硅锭直径并且限制杂质引入到硅中)。
影响CZ直拉法的两个主要参数是(拉伸速率)和(晶体旋转速率)。
8.晶圆制备中的整型处理包括(去掉两端)、(径向研磨)和(硅片定位边和定位槽)。
9.制备半导体级硅的过程:1(制备工业硅);2(生长硅单晶);3(提纯)。
氧化10.二氧化硅按结构可分为()和()或()。
11.热氧化工艺的基本设备有三种:(卧式炉)、(立式炉)和(快速热处理炉)。
12.根据氧化剂的不同,热氧化可分为(干氧氧化)、(湿氧氧化)和(水汽氧化)。
13.用于热工艺的立式炉的主要控制系统分为五部分:(工艺腔)、(硅片传输系统)、气体分配系统、尾气系统和(温控系统)。
14.选择性氧化常见的有(局部氧化)和(浅槽隔离),其英语缩略语分别为LOCOS和(STI )。
15.列出热氧化物在硅片制造的4种用途:(掺杂阻挡)、(表面钝化)、场氧化层和(金属层间介质)。
16.可在高温设备中进行的五种工艺分别是(氧化)、(扩散)、()、退火和合金。
17.硅片上的氧化物主要通过(热生长)和(淀积)的方法产生,由于硅片表面非常平整,使得产生的氧化物主要为层状结构,所以又称为(薄膜)。

一、填空题(30分=1分*30)10题/章晶圆制备1.用来做芯片的高纯硅被称为(半导体级硅),英文简称(GSG ),有时也被称为(电子级硅)。
2.单晶硅生长常用(CZ法)和(区熔法)两种生长方式,生长后的单晶硅被称为(硅锭)。
3.晶圆的英文是(wafer ),其常用的材料是(硅)和(锗)。
4.晶圆制备的九个工艺步骤分别是(单晶生长)、整型、(切片)、磨片倒角、刻蚀、(抛光)、清洗、检查和包装。
5.从半导体制造来讲,晶圆中用的最广的晶体平面的密勒符号是(100 )、(110 )和(111 )。
6.CZ直拉法生长单晶硅是把(融化了的半导体级硅液体)变为(有正确晶向的)并且(被掺杂成p型或n型)的固体硅锭。
7.CZ直拉法的目的是(实现均匀掺杂的同时并且复制仔晶的结构,得到合适的硅锭直径并且限制杂质引入到硅中)。
影响CZ直拉法的两个主要参数是(拉伸速率)和(晶体旋转速率)。
8.晶圆制备中的整型处理包括(去掉两端)、(径向研磨)和(硅片定位边和定位槽)。
9.制备半导体级硅的过程:1(制备工业硅);2(生长硅单晶);3(提纯)。
氧化10.二氧化硅按结构可分为()和()或()。
11.热氧化工艺的基本设备有三种:(卧式炉)、(立式炉)和(快速热处理炉)。
12.根据氧化剂的不同,热氧化可分为(干氧氧化)、(湿氧氧化)和(水汽氧化)。
13.用于热工艺的立式炉的主要控制系统分为五部分:(工艺腔)、(硅片传输系统)、气体分配系统、尾气系统和(温控系统)。
14.选择性氧化常见的有(局部氧化)和(浅槽隔离),其英语缩略语分别为LOCOS和(STI )。
15.列出热氧化物在硅片制造的4种用途:(掺杂阻挡)、(表面钝化)、场氧化层和(金属层间介质)。
16.可在高温设备中进行的五种工艺分别是(氧化)、(扩散)、()、退火和合金。
17.硅片上的氧化物主要通过(热生长)和(淀积)的方法产生,由于硅片表面非常平整,使得产生的氧化物主要为层状结构,所以又称为(薄膜)。

目录一、填空题(每空1分,共24分)....................................................................二、判断题(每小题1。
5分,共9分).................................................................三、简答题(每小题4分,共28分)..................................................................四、计算题(每小题5分,共10分)..................................................................五、综合题(共9分)...............................................................................一、填空题(每空1分,共24分)1.制作电阻分压器共需要三次光刻,分别是电阻薄膜层光刻、高层绝缘层光刻和互连金属层光刻。
2.集成电路制作工艺大体上可以分成三类,包括图形转化技术、薄膜制备技术、掺杂技术.3.晶体中的缺陷包括点缺陷、线缺陷、面缺陷、体缺陷等四种。
4.高纯硅制备过程为氧化硅→粗硅→ 低纯四氯化硅→ 高纯四氯化硅→ 高纯硅.5.直拉法单晶生长过程包括下种、收颈、放肩、等径生长、收尾等步骤.6.提拉出合格的单晶硅棒后,还要经过切片、研磨、抛光等工序过程方可制备出符合集成电路制造要求的硅衬底片。
7.常规的硅材料抛光方式有:机械抛光,化学抛光,机械化学抛光等。
8.热氧化制备SiO2的方法可分为四种,包括干氧氧化、水蒸汽氧化、湿氧氧化、氢氧合成氧化 .9.硅平面工艺中高温氧化生成的非本征无定性二氧化硅对硼、磷、砷(As)、锑(Sb)等元素具有掩蔽作用。
10.在SiO2内和Si— SiO2界面存在有可动离子电荷、氧化层固定电荷、界面陷阱电荷、氧化层陷阱等电荷.11.制备SiO2的方法有溅射法、真空蒸发法、阳极氧化法、热氧化法、热分解淀积法等。

作业3:光刻1
1. 对于NA =0.6的曝光系统,设k 1=0.6,k 2=0.5。
考虑100 nm
到1000 nm 之间的波长(DUV 至可见光),计算其在不同的曝光波长下的理论分辨率和焦深,并作图。
在图中标示出常用的光刻波长(i 线,g 线,KrF 和ArF )。
根据计算和图,请说明ArF 对于0.13 μm 和0.1 μm 技术是否足够?
2、 计算有9块掩模工艺的的最终成品率。
掩膜中有4块平均致命
缺陷密度为0.1cm -2, 4块为0.25 cm -2,还有一块为1.0 cm -2,芯片面积为50mm 2.
3、 一个X 光接近式曝光系统,使用的光子能量为1 keV ,如果版
和硅片的间距为20 μm ,估算该系统所能达到的理论衍射分辨率。
(注:λ/hC E =)。
4、 假定某种光刻胶可以MTF =0.3分辨图形,如果曝光系统的
NA =0.4,S =0.5。
则采用i 线光源时光刻分辨的最小尺寸为多少?(选做)。

集成电路工艺原理课后作业第一章1.单晶Si片的制备工艺流程答:a)石英沙⇒冶金硅(粗硅):SiO2+C⇒Si+CO2;b) 冶金硅粉末+HCl⇒三氯硅烷:将冶金硅压碎,制成冶金硅粉,通过与无水HCl 反应生成粗三氯硅烷,利用各组分沸点的不同来达到分离杂质的目的,通过气化和浓缩提纯三氯硅烷;c) 三氯硅烷+H2⇒多晶电子纯硅:精馏后的三氯硅烷,被高纯度H2带入“西门子反应器”还原。
d) 熔融的多晶电子纯硅(EGS)⇒单晶硅锭:①直拉法②区熔法e) 整型处理:去掉两端、径向研磨、定位边;单晶硅锭切片、磨片倒角、刻蚀、抛光;激光刻号,封装。
2.两种拉单晶的方法(CZ、FZ)及其特点答:直拉法:在石英坩埚中将多晶硅熔融,上面用单晶硅籽晶直接拉成单晶硅锭。
特点:便宜;大的硅片尺寸(直径300mm);材料可回收利用。
区熔法:将材料局部熔化,形成狭窄的熔区,然后令熔区沿着材料缓慢移动,利用分凝现象来分离杂质,生长单晶体。
特点:更纯的单晶硅(无坩埚);更贵,硅片尺寸小(150mm);主要用于功率器件。
3.单晶硅中硅的原子密度答:8/a3=5×1022/cm34.在硅半导体中形成替位式杂质的条件,可能的掺杂元素主要哪些?答:形成替位式杂质的条件:(1)原子大小:与原晶格上的原子大小接近。
(2)原子外部电子壳层和晶体结构具有相似性。
可能元素:Ⅲ、Ⅴ族元素B、P、As。
第二章1.热氧化法答:Si与氧或水汽等氧化剂在高温下发生化学反应生成SiO2。
2.SiO2在集成电路中的应用主要哪些?答:①自然层:无用②屏蔽层:离子注入③遮蔽层:扩散④场区氧化层及介局部氧化物:隔离⑤衬垫层:避免氮化物的强应力在Si中缺陷⑥牺牲层:消除Si表面缺陷。
⑦栅氧化层:栅极介质层。
⑧阻挡层:浅沟隔离STI。
3.热氧化法常用的氧化源有哪些?采用不同氧化源制备SiO2,其各自的特点是什么?答:①氧气(干氧氧化,薄膜均匀致密,生长速率慢)②水汽(水汽氧化,生长速率快,薄膜疏松,特性不好)③氢气与氧气(水汽氧化、湿氧氧化,氢气氧气摩尔比不同时,效果介于前两种之间)④含氯气体(掺入其它氧化剂中,使栅氧中可移动离子最小)4.在集成电路工艺中,制备厚的SiO2层主要采用什么氧化方式,其主要优点是什么?答:采用的是干氧-湿氧-干氧相结合的氧化方式。

电子与通信技术:集成电路工艺原理考试资料(题库版)1、问答题简述引线框架材料?正确答案:引线框架作为集成电路的芯片载体,是一种借助于键合材料(金丝、铝丝、铜丝)实现芯片内部电路引出端与外引线的电气连接,形成电气回路的关(江南博哥)键结构件,它起到了和外部导线连接的桥梁作用。
引线框架材料的要求为:热匹配,良好的机械性能,导电、导热性能好,使用过程无相变,材料中杂质少,低价,加工特性和二次性能好。
2、问答题简述MCM的概念、分类与特性?正确答案:概念:将多块半导体裸芯片组装在一块布线基板上的一种封装。
分类:MCM-L是采用片状多层基板的MCM、MCM-C是采用多层陶瓷基板的MCM、MCM-D是采用薄膜技术的MCM。
特性:尺寸小、技术集成度高、数据速度和信号质量高、可靠性高、成本低、PCB板设计简化、提高圆片利用率、降低投资风险。
可大幅度提高电路连线密度,增加封装效率;可完成轻、薄、短、小的封装设计;封装的可靠性提升。
3、问答题矩形片式电阻由哪几部分组成?各部分的主要作用是什么?正确答案:基板:基板要具有良好的电绝G8P-1A4PDC12缘性、导热性和机械强度高等特征。
一般基板的材科多采用高纯度的(96%)AL203陶瓷。
其工艺要求表面平整、划线准确,以确保电阻、电极浆料印制到位。
电极:片式电阻器一般都采用三层电极结构,最内层的是内层电极,它是连接电阻体位于中间层的是中间电极,它是镀镍(Ni)层,也被称为阻挡层,其主要作用是提高电阻器在焊接时的耐热性,避免造成内层电极被溶蚀。
位于最外层的是外层电极,它也被称为可焊层,该层除了使电极具有良好的可焊性外,还可以起到延长电极保存期的作用。
通常,外层电极采用锡一铅(S。
-PB.合金电镀而成。
电阻膜:电阻膜是采用具有一定电阻率的电阻浆料印制在陶瓷基板上,然后再经过烧结而成的厚膜电阻。
保护层:保护层位于电阻膜的外部,主要起保护作用。
它通常可以细分为封包玻璃保护膜、玻璃釉涂层和标志玻璃层。

第二次作业1.(1)随着MOS 器件尺寸不断缩小,栅氧化层的厚度也必须同时减薄。
在此情况下,请问MOS 器件对Na +的玷污的敏感度是增加了还是降低了,为什么?(2)在栅氧化层厚度不断减薄的情况下,对于硅片衬底的掺杂(或者器件沟道区的阈值电压的调整注入),必须采用什么样的措施才能保证器件的阈值电压不变,为什么?答:(1)根据阈值电压2TH FB f oxoxV V φ=+ 当t ox 减小时,C ox 会增加,所以此时同样的载流子数量Q M 对V TH 有更小的影响,即MOS 器件对Na +的玷污敏感度会降低。
(2)通过上面的分析,可知,在t ox 减薄时,,C ox 增大,为使V TH 保持不变,衬底(或沟道区掺杂浓度N A 必须增大。
2.2、基于使水(H 2O )中的氧(O 2)含量达到饱和并以此作为氧化剂的方法,目前已经提出了一种新的清洗程序,即采用H 2O/O 2取代H 2O 2。
假定硅片受到了微量的金、铁和铜原子的玷污,这种新清洗工艺能够有效去除杂质吗?为什么?答:如课文所述,清洗硅片表面金属离子包含了下面的化学原理: z e M Mz +−←⎯→+所以清洗金属离子机理就是使金属离子氧化变成可溶性离子,从而洗去,利用氧化剂来实现清洗硅片就要求此氧化剂的标准氧化势要低于被还原的金属离子,从而使金属离子失去电子。
从下表可知:O 2/H 2O 的氧化势大于Au ,低于Cu 和Fe ,所以O 2/H 2O 氧化剂可以去掉Cu 和Fe ,但无法去除金。
第三次作业1. 对于NA =0.6的曝光系统,设K1=0.6,K2=0.5,考虑100nm -1000nm 之间的波长,计算其在不同的曝光波长下的理论分辨率和焦深,并作图,图中标出常用的光刻波长(i 线,g 线,KrF ,ArF ),根据计算和图,请说明ArF 对于0.13um 和0.1um 技术是否足够?答:根据公式:10.60.6R k NAλλ==和2220.5()(0.6)DOF k NA λλ=±=±对g 线:λ=436nm ,则R =436nm ,DOF =605.6nm 对i 线:λ=365nm ,则R =365nm ,DOF =506.9nm 对KrF: λ=248nm ,则R =248nm ,DOF =344.4nm 对ArF :λ=193nm ,则R =193nm ,DOF =268.0nm 所得图如下所示:2. 假定某种光刻胶可以MTF =0.3分辨图形,如果曝光系统NA =0.4,S =0.5,则采用i线光源时光刻分辨的最小尺寸是多少?答:由ppt 讲义上图知:MTF =0.3,S =0.5时,对应空间频率y =0.57y o i 线λ=365nm ,00.41.80/0.610.61*365NA y u nmλ===m 即分辨率是每um 1.80×0.57=1.02条所以最小线条的分辨尺寸为1/2pitch =0.49um ,pitch =0.98um第四次作业1. 根据表格1中给定的值计算光刻胶Az -1450的4个波长的CMTF 。

集成电路制造技术-原理与工艺课后习题答案第一单元:3. 比较硅单晶锭CZ,MCZ和FZ三种生长方法的优缺点。
答:CZ直拉法工艺成熟,可拉出大直径硅棒,是目前采用最多的硅棒生产方法。
但直拉法中会使用到坩埚,而坩埚的使用会带来污染。
同时在坩埚中,会有自然对流存在,导致生长条纹和氧的引入。
直拉法生长多是采用液相掺杂,受杂质分凝、杂质蒸发,以及坩埚污染影响大,因此,直拉法生长的单晶硅掺杂浓度的均匀性较差。
MCZ磁控直拉法,在CZ法单晶炉上加一强磁场,高传导熔体硅的流动因切割磁力线而产生洛仑兹力,这相当于增强了熔体的粘性,熔体对流受阻。
能生长无氧、均匀好的大直径单晶硅棒。
设备较直拉法设备复杂得多,造价也高得多,强磁场的存在使得生产成本也大幅提高。
FZ 悬浮区熔法,多晶与单晶均由夹具夹着,由高频加热器产生一悬浮的溶区,多晶硅连续通过熔区熔融,在熔区与单晶接触的界面处生长单晶。
与直拉法相比,去掉了坩埚,没有坩埚的污染,因此能生长出无氧的,纯度更高的单晶硅棒。
6. 硅气相外延工艺采用的衬底不是准确的晶向, 通常偏离[100] 或[111] 等晶向一个小角度, 为什么?答:在外延生长过程中,外延气体进入反应器,气体中的反应剂气相输运到衬底,在高温衬底上发生化学反应,生成的外延物质沿着衬底晶向规则地排列,生长出外延层。
气相外延是由外延气体的气相质量传递和表面外延两个过程完成的。
表面外延过程实质上包含了吸附、分解、迁移、解吸这几个环节,表面过程表明外延生长是横向进行的,是在衬底台阶的结点位置发生的。
因此,在将硅锭切片制备外延衬底时,一般硅片都应偏离主晶面一个小角度。
目的是为了得到原子层台阶和结点位置,以利于表面外延生长。
7. 外延层杂质的分布主要受哪几种因素影响?答:杂质掺杂效率不仅依赖于外延温度、生长速率、气流中掺杂剂的摩尔分数、反应室的几何形状等因素,还依赖于掺杂剂自身的特性。
另外,影响掺杂效率的因素还有衬底的取向和外延层结晶质量。
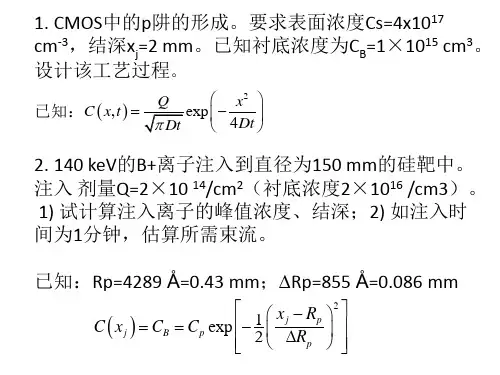

集成电路⼯艺原理(期末复习资料)第⼀章概述1、集成电路:通过⼀系列特定的加⼯⼯艺,将晶体管、⼆极管等有源器件和电阻、电容等⽆源器件,按照⼀定的电路互连,“集成”在⼀块半导体单晶⽚(如Si、GaAs)上,封装在⼀个内,执⾏特定电路或系统功能。
2、特征尺⼨:集成电路中半导体器件能够加⼯的最⼩尺⼨。
它是衡量集成电路设计和制造⽔平的重要尺度,越⼩,芯⽚的集成度越⾼,速度越快,性能越好3、摩尔定律:芯⽚上所集成的晶体管的数⽬,每隔18个⽉就翻⼀番。
4、High-K材料:⾼介电常数,取代SiO2作栅介质,降低漏电。
Low-K 材料:低介电常数,减少铜互连导线间的电容,提⾼信号速度5、功能多样化的“More Than Moore”:指的是⽤各种⽅法给最终⽤户提供附加价值,不⼀定要缩⼩特征尺⼨,如从系统组件级向3D集成或精确的封装级(SiP)或芯⽚级(SoC)转移。
6、IC企业的分类:通⽤电路⽣产⼚;集成器件制造;Foundry⼚;Fabless:IC设计公司;第⼆章:硅和硅⽚的制备7、单晶硅结构:晶胞重复的单晶结构能够制作⼯艺和器件特性所要求的电学和机械性能8、CZ法⽣长单晶硅:把熔化的半导体级硅液体变成有正确晶向,并且被掺杂成n或p型的固体硅锭;9、直拉法⽬的:实现均匀掺杂和复制籽晶结构,得到合适的硅锭直径,限制杂质引⼊;其关键参数:拉伸速率和晶体旋转速度10、区熔法特点:纯度⾼,含氧低;晶圆直径⼩。
第三章集成电路制造⼯艺概况11、亚微⽶CMOS IC 制造⼚典型的硅⽚流程模型第四章氧化12、热⽣长:在⾼温环境⾥,通过外部供给⾼纯氧⽓使之与硅衬底反应,得到⼀层热⽣长的SiO2 。
13、淀积:通过外部供给的氧⽓和硅源,使它们在腔体中⽅应,从⽽在硅⽚表⾯形成⼀层薄膜。
14、⼲氧:Si(固)+O2(⽓)-> SiO2(固):氧化速度慢,氧化层⼲燥、致密,均匀性、重复性好,与光刻胶的粘附性好.⽔汽氧化:Si (固)+H2O (⽔汽)->SiO2(固)+ H2 (⽓):氧化速度快,氧化层疏松,均匀性差,与光刻胶的粘附性差。
集成电路工艺作业第一章 半导体衬底1、列举生产半导体级硅的三个步骤,给出反应方程式。
说明半导体级硅有多纯?*含硅的三氯硅烷气体经过再一次化学过程并用氢气还原制备出纯度为99.9999999%的半导体级硅。
2、为什么要用单晶进行硅片制造?这是因为器件的许多电学和机械性质都与它的原子级结构有关。
这就要求原子具有重复性结构,从而使得芯片与芯片之间的性能具有重复性。
3、CZ 单晶生长法定义Czochralski(CZ)-查克洛斯基法生长单晶硅,把熔化了的半导体级硅液体变为有正确晶向并且被掺杂成n 型或p 型的固体硅锭。
85%以上的单晶硅是采用CZ 法生长出来的。
CZ 法特点:a. 低功率IC 的主要原料。
b. 占有~80%的市场。
c. 制备成本较低。
d. 硅片含氧量高。
4、影响CZ 法直拉工艺的两个主要参数是什么?拉伸速率和晶体旋转速率。
12级微电四班国旗5、区熔法的特点是什么?a. 硅片含氧量低、纯度高。
b. 主要用于高功率IC。
c. 制备成本比CZ法低。
d. 难生长大直径硅晶棒。
e. 低阻值硅晶棒掺杂均匀度较差。
7、使用更大直径硅片的主要原因是什么?300mm硅片比200mm硅片面积大2.25倍,这样就会在一块硅片上生产更多的芯片。
每块芯片加工和处理时间都减少了,设备生产效率提高了。
使用300mm直径的硅片可以把每块芯片的成本减少30%。
节省成本是驱使半导体业转向使用更大直径硅片的主要原因。
8、硅中的晶体缺陷:点缺陷、位错、层错。
第二章 氧化1、半导体器件生产中使用的介质材料有二氧化硅、氮化硅、多晶硅、硅化物。
2、二氧化硅的基本性质有哪些?a、可以方便地利用光刻和刻蚀实现图形转移b、可以作为多数杂质掺杂的掩蔽c、优秀的绝缘性能d、很高的击穿电场 (>107 V/cm)e、体电学性能稳定、f、稳定、可重复制造的Si/ SiO2界面3、金属层间绝缘阻挡层目的:用于金属连线间的保护层。
4、热生长SiO2 的各种运用对厚度有不同要求栅氧(0.18μm工艺):20-60埃;STI隔离氧化物:150埃;场氧:2500-15000埃5、有几种类型的电荷存在于氧化层内部或在SiO2和Si/SiO2界面附近?a)界面陷阱电荷; b)固定氧化层电荷; c)移动离子电荷; d)大量氧化层陷阱电荷6、干氧和湿氧氧化反应方程式及氧化层的特点?干氧生长的氧化膜表面干燥、结构致密,表面是非极性的硅烷(Si—O—Si)结构,光刻时与光刻胶接触良好、不易产生浮胶,但氧化速率极慢,这是由于O2 在SiO2中扩散系数通常小于H2 O 在SiO2 中的扩散系数。
一、填空题(30分=1分*30)10题/章晶圆制备1.用来做芯片的高纯硅被称为(半导体级硅),英文简称( GSG ),有时也被称为(电子级硅)。
2.单晶硅生长常用( CZ法)和(区熔法)两种生长方式,生长后的单晶硅被称为(硅锭)。
3.晶圆的英文是( wafer ),其常用的材料是(硅)和(锗)。
4.晶圆制备的九个工艺步骤分别是(单晶生长)、整型、(切片)、磨片倒角、刻蚀、(抛光)、清洗、检查和包装。
5.从半导体制造来讲,晶圆中用的最广的晶体平面的密勒符号是( 100 )、(110 )和(111 )。
6.CZ直拉法生长单晶硅是把(融化了的半导体级硅液体)变为(有正确晶向的)并且(被掺杂成p型或n型)的固体硅锭。
7.CZ直拉法的目的是(实现均匀掺杂的同时并且复制仔晶的结构,得到合适的硅锭直径并且限制杂质引入到硅中)。
影响CZ直拉法的两个主要参数是(拉伸速率)和(晶体旋转速率)。
8.晶圆制备中的整型处理包括(去掉两端)、(径向研磨)和(硅片定位边和定位槽)。
9.制备半导体级硅的过程:1(制备工业硅);2(生长硅单晶);3(提纯)。
氧化10.二氧化硅按结构可分为()和()或()。
11.热氧化工艺的基本设备有三种:(卧式炉)、(立式炉)和(快速热处理炉)。
12.根据氧化剂的不同,热氧化可分为(干氧氧化)、(湿氧氧化)和(水汽氧化)。
13.用于热工艺的立式炉的主要控制系统分为五部分:(工艺腔)、(硅片传输系统)、气体分配系统、尾气系统和(温控系统)。
14.选择性氧化常见的有(局部氧化)和(浅槽隔离),其英语缩略语分别为LOCOS和( STI )。
15.列出热氧化物在硅片制造的4种用途:(掺杂阻挡)、(表面钝化)、场氧化层和(金属层间介质)。
16.可在高温设备中进行的五种工艺分别是(氧化)、(扩散)、()、退火和合金。
17.硅片上的氧化物主要通过(热生长)和(淀积)的方法产生,由于硅片表面非常平整,使得产生的氧化物主要为层状结构,所以又称为(薄膜)。
集成电路制造技术作业热氧化1、解释名词:自掺杂外扩散SOS技术SOI技术.答:自掺杂:是指在高温外延时,高掺杂衬底中的杂质从基片外表面扩散进入气相边界层,又从边界层扩散掺入外延层的现象。
外扩散:又称为互扩散,是指在高温外延时,衬底和外延层中的杂质互相由浓度高的一侧向浓度低的一侧扩散的现象。
SOS技术:是SOI技术的一种,是在蓝宝石或尖晶石衬底上异质外延硅获得外延材料的技术。
SOI技术:是指在绝缘衬底上异质外延硅获得外延材料的技术.2、详述影响硅外延生长速率的因素。
答:影响外延生长速率的因素主要有外延温度、硅源种类、反应剂浓度、外延反应器结构类型、气体流速、衬底晶向等.外延温度的影响:外延过程可分为质量传递过程和表面反应过程。
在气相质量传递过程中,随着温度升高气相边界层中的气体分子热运动加剧、气体黏度增加、气体密度降低、气相边界层增厚,综合以上效应,气相质量传递速率随温度缓慢升高有所加快。
在表面反应过程中,外延剂吸附和气态生长物的解吸过程很快,对外延生长速率影响效果不明显;外延剂化学反应和生成硅原子迁移随着温度升高而明显加快,综合几个过程的综合效果,硅表面反应过程随温度升高速率加快非常明显。
因此,外延温度升高,外延生长速率加快。
硅源种类的影响:实际测得采用不同硅源,生长速率不同。
外延生长速率由高到低对应的硅源依次为:Si H4〉SiH2Cl2>SiHCl3〉SiCl4.反应剂浓度的影响:一般地,在反应剂浓度较低时,随着反应剂浓度增加,质量传递至衬底表面的外延剂就会增加,外延速度就会加快.但是,随着浓度进一步升高,到达某一临界浓度时,衬底表面生成硅原子速率大于硅原子在衬底表面生成单晶的速度或者反应剂分解形成硅粒堆积,就会生长出多晶硅,此时外延层的生长速率由硅原子形成单晶的速率控制.当采用含氯硅源时,如果反应剂浓度继续增加,到达某一浓度时,外延生长速率反而开始减小。
其他影响因素:外延器的结构类型、气体流速的因素对气相质量传递快慢造成影响。
集成电路制造技术第一次作业
1.摩尔定律:当价格不变时,集成电路上可容纳的晶体管数目约每隔12个月便会增加一倍,性能也将提升一倍,1980s后下降为每18个月翻一番,最小特征尺寸每三年减少70%,价格每两年下降50%。
意义:摩尔定律归纳了信息技术进步的速度,是集成电路发展的里程碑,由于高纯度硅独特性,集成度越高,晶体管价格越便宜,可包含的功能越多,因而摩尔定律具有经济学价值,它推动了整个信息技术产业的发展。
2.集成运算放大器:有深度负反馈并直接耦合的直流放大器,应用于运算、测量、控制及信号的产生、处理、变换等。
MOS集成电路:NMOS管组成的NMOS电路、PMOS管组成的PMOS电路及由NMOS和PMOS两种管子组成的互补MOS电路,即CMOS电路。
CMOS 集成电路有许多较优的性能,如抗辐射能力强,各种射线、辐射对其导电性能的影响都有限,因而特别适用于制作航天及核实验设备。
TTL集成电路:TTL数字集成电路约有400多个品种,大致可以分为以下几类:门电路、译码器/驱动器、触发器、计数器、移位寄存器、单稳/双稳电路和多谐振荡器、加法器/乘法器、奇偶校验器、码制转换器、线驱动器/线接收器、多路开关、存储器。
555时基电路:一种将模拟功能与逻辑功能巧妙地结合在同一硅片上的组合集成电路。
该电路可以在最基本的典型应用方式的基础上,根据实际需要,经过参数配置和电路的重新组合,与外接少量的阻容元件就能构成不同的电路,因而555电路在波形的产生与变换、测量与控制、家用电器等方面广泛应用。
3.。
作业1:阅读2011年国际半导体技术发展规划(ITRS)/
题目1-3为必做题,参考“Executive summary”,其余选做。
选做题目需要参考其他文档,见题目后面括号中的文档名。
注:技术节点以“DRAM”为准。
1.最小特征尺寸
a.请说明以下概念的区别:DRAM 1/2线宽、MPU 1/2线宽、光刻栅长以及物理栅长。
b.作图比较DRAM 1/2线宽、光刻栅长和物理栅长三个技术参数随年代的变化。
c.每个技术节点DRAM 1/2线宽减少多少?(以比例表示)
2.四个技术节点(32,22,16,10 nm)的比较:
a.作图说明高性能器件和低功耗器件工作电压的预期值。
b.作图说明四个技术节点高性能器件和低功耗器件阈值电压和工作电压的预期比值。
c.作图说明四个技术节点芯片尺寸的预期值。
d.作图说明四个技术节点最高时钟频率的预期值。
e.作图说明四个技术节点功率耗散的预期值。
假定你同时知道源电压的预期值,则这
些预期暗示着对32 nm技术节点和10 nm技术节点平均工作电流怎样的要求?
3.缺陷的数目及光刻版数目
a.作图对比2005版和2011版关于缺陷数目的规划(CPU和DRAM)。
b.作图表示CPU和DRAM光刻版数目在各个技术节点的变化。
4.驱动电流(I on)和关断电流(I off)(Process Integration, Devices, and Structures)
a.作图说明四个技术节点驱动电流(mA/um)的预期值。
b.作图说明四个技术节点关断电流(nA/um)的预期值。
c.作图说明四个技术节点驱动电流和关断电流的预期比值。
5.本征延时(Process Integration, Devices, and Structures)
a.作图说明四个技术节点CV/I的预期值。
b.作图说明相应CV/I和时钟频率的预期比值。
6.氧化层厚度(Process Integration, Devices, and Structures)
a.作图说明四个技术节点栅氧化层厚度的预期值。
b.作图说明四个技术节点的栅漏电流密度的预期值。
7.硅片表面处理(Front end processes)
a.作图说明随年代硅片表面颗粒大小和数目的要求。
b.作图说明随年代可动离子密度的变化。