场效应晶体管的结构工作原理和输出特性
- 格式:ppt
- 大小:979.50 KB
- 文档页数:40


功率场效应晶体管(MOSFET)基本知识功率场效应管(Power MOSFET)也叫电力场效应晶体管,是一种单极型的电压控制器件,不但有自关断能力,而且有驱动功率小,开关速度高、无二次击穿、安全工作区宽等特点。
由于其易于驱动和开关频率可高达500kHz,特别适于高频化电力电子装置,如应用于DC/DC变换、开关电源、便携式电子设备、航空航天以及汽车等电子电器设备中。
但因为其电流、热容量小,耐压低,一般只适用于小功率电力电子装置。
一、电力场效应管的结构和工作原理电力场效应晶体管种类和结构有许多种,按导电沟道可分为P沟道和N沟道,同时又有耗尽型和增强型之分。
在电力电子装置中,主要应用N沟道增强型。
电力场效应晶体管导电机理与小功率绝缘栅MOS管相同,但结构有很大区别。
小功率绝缘栅MOS管是一次扩散形成的器件,导电沟道平行于芯片表面,横向导电。
电力场效应晶体管大多采用垂直导电结构,提高了器件的耐电压和耐电流的能力。
按垂直导电结构的不同,又可分为2种:V形槽VVMOSFET和双扩散VDMOSFET。
电力场效应晶体管采用多单元集成结构,一个器件由成千上万个小的MOSFET组成。
N沟道增强型双扩散电力场效应晶体管一个单元的部面图,如图1(a)所示。
电气符号,如图1(b)所示。
电力场效应晶体管有3个端子:漏极D、源极S和栅极G。
当漏极接电源正,源极接电源负时,栅极和源极之间电压为0,沟道不导电,管子处于截止。
如果在栅极和源极之间加一正向电压UGS,并且使UGS大于或等于管子的开启电压UT,则管子开通,在漏、源极间流过电流ID。
UGS超过UT越大,导电能力越强,漏极电流越大。
二、电力场效应管的静态特性和主要参数Power MOSFET静态特性主要指输出特性和转移特性,与静态特性对应的主要参数有漏极击穿电压、漏极额定电压、漏极额定电流和栅极开启电压等。
1、静态特性(1)输出特性输出特性即是漏极的伏安特性。
特性曲线,如图2(b)所示。


垂直传输场效应晶体管垂直传输场效应晶体管(Vertical Transport Field-Effect Transistor,VT-FET)是一种新型的晶体管结构,其工作原理是利用电场作用在垂直方向上传输电子,具有高速、高密度、低功耗等优异特性,是未来半导体器件领域的重要发展方向之一。
一、VT-FET的基本结构VT-FET主要由三个部分组成:源区、漏区和栅极。
源区和漏区在一侧或两侧,由高掺杂的P或N型半导体材料构成。
栅极从上方垂直地贴在源区和漏区之间,由金属或半导体材料制成。
栅极下方垂直穿过源区和漏区,形成了垂直电场通道。
二、VT-FET的工作原理在工作过程中,当给栅极施加正电压时,栅极下方形成了N型区域,形成了势垒。
当施加反向电压时,栅极下方是P型区域,形成空穴势垒。
栅极下方的空穴和电子会在势垒的作用下汇聚,形成垂直电场通道。
当源极给电压VDS时,空间中的电荷被拉入源极和漏极之间,如此大的电压差驱动通道内部的电子,在通道中形成了电流。
电流从源电极流向漏电极,因空间受限而形成垂直的电流。
三、VT-FET的优势1.高速:由于VT-FET的电子传输是在垂直方向上实现的,电子速度快,通道内部不会出现盲道等不良作用,因此具有很高的频率响应。
2.高密度:由于通道宽度较窄,可以将大量的器件装配在同一个芯片上,实现高度的集成。
3.低功耗:VT-FET在设计时可以采用较低的电压和电流,从而实现低功耗的运行。
总之,VT-FET是一种新型的晶体管结构,其具有高速、高密度、低功耗等优秀特性,将在未来的半导体器件领域中扮演重要的角色。
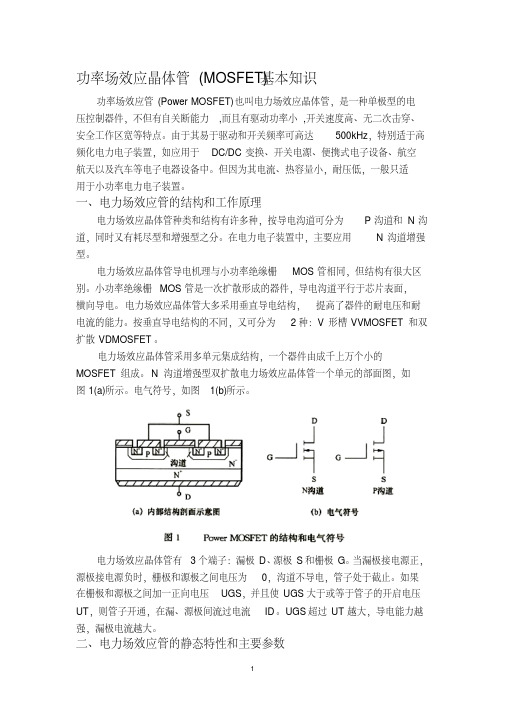
功率场效应晶体管(MOSFET)基本知识功率场效应管(Power MOSFET)也叫电力场效应晶体管,是一种单极型的电压控制器件,不但有自关断能力,而且有驱动功率小,开关速度高、无二次击穿、安全工作区宽等特点。
由于其易于驱动和开关频率可高达500kHz,特别适于高频化电力电子装置,如应用于DC/DC变换、开关电源、便携式电子设备、航空航天以及汽车等电子电器设备中。
但因为其电流、热容量小,耐压低,一般只适用于小功率电力电子装置。
一、电力场效应管的结构和工作原理电力场效应晶体管种类和结构有许多种,按导电沟道可分为P沟道和N沟道,同时又有耗尽型和增强型之分。
在电力电子装置中,主要应用N沟道增强型。
电力场效应晶体管导电机理与小功率绝缘栅MOS管相同,但结构有很大区别。
小功率绝缘栅MOS管是一次扩散形成的器件,导电沟道平行于芯片表面,横向导电。
电力场效应晶体管大多采用垂直导电结构,提高了器件的耐电压和耐电流的能力。
按垂直导电结构的不同,又可分为2种:V形槽VVMOSFET和双扩散VDMOSFET。
电力场效应晶体管采用多单元集成结构,一个器件由成千上万个小的MOSFET组成。
N沟道增强型双扩散电力场效应晶体管一个单元的部面图,如图1(a)所示。
电气符号,如图1(b)所示。
电力场效应晶体管有3个端子:漏极D、源极S和栅极G。
当漏极接电源正,源极接电源负时,栅极和源极之间电压为0,沟道不导电,管子处于截止。
如果在栅极和源极之间加一正向电压UGS,并且使UGS大于或等于管子的开启电压UT,则管子开通,在漏、源极间流过电流ID。
UGS超过UT越大,导电能力越强,漏极电流越大。
二、电力场效应管的静态特性和主要参数Power MOSFET静态特性主要指输出特性和转移特性,与静态特性对应的主要参数有漏极击穿电压、漏极额定电压、漏极额定电流和栅极开启电压等。
1、静态特性(1)输出特性输出特性即是漏极的伏安特性。
特性曲线,如图2(b)所示。

mosfet管工作原理MOSFET管是一种常用的晶体管,其工作原理基于金属氧化物半导体场效应晶体管(MOSFET)的特性。
MOSFET管以其高速度、低功耗和可靠性等优点,在现代电子器件中得到广泛应用。
本文将从MOSFET 管的结构、工作原理和特性等方面进行详细介绍。
一、MOSFET管的结构MOSFET管的结构主要由源极、漏极、栅极和绝缘层组成。
其中,源极和漏极是两个注入材料的区域,栅极则是一层金属或者多晶硅的薄膜。
绝缘层主要是由氧化硅构成,起到隔离栅极和半导体材料的作用。
二、MOSFET管的工作原理MOSFET管的工作原理基于栅极电压的变化来控制漏极和源极之间的电流。
当栅极电压为零时,绝缘层会阻止电流的流动,此时MOSFET 处于截止状态。
当栅极电压增加,绝缘层会形成一个电场,使得漏极和源极之间形成一个导电通道,电流开始流动,MOSFET处于放大状态。
当栅极电压继续增加,电流也会增加,MOSFET处于饱和状态。
通过调节栅极电压,可以精确地控制MOSFET的导通和截止,从而实现对电流的精确控制。
三、MOSFET管的特性1. 高输入阻抗:MOSFET管的绝缘层能有效地隔离栅极和半导体材料,使得栅极输入电阻非常高,从而减小了对输入信号的负载效应。
2. 低输出阻抗:MOSFET管的漏极和源极之间形成的导电通道具有低阻抗特性,能够输出较大的电流。
3. 高速度:由于MOSFET管的结构简单,电流的流动速度快,因此其响应速度较快。
4. 低功耗:MOSFET管在截止状态时,几乎没有功耗,只有在放大状态时才会有一定的功耗。
5. 可靠性高:MOSFET管的结构简单,且由于绝缘层的存在,能够有效地防止电路短路和漏电现象,提高了器件的可靠性。
四、MOSFET管的应用由于MOSFET管具有高速度、低功耗和可靠性高等特点,因此在现代电子器件中得到了广泛应用。
例如,在数字集成电路中,MOSFET管常用于构建逻辑门电路和存储器单元;在模拟集成电路中,MOSFET 管则用于构建放大器和开关电路等。
功率场效应晶体管(MOSFET)的工作原理、特性及主要参数功率场效应晶体管(Power Metal Oxide Semiconductor Field Effect Transistor,MOSFET)。
其特点是:属于电压型全控器件、栅极静态内阻极高(109Ω)、驱动功率很小、工作频率高、热稳定性好、无二次击穿、安全工作区宽等;但MOSFET的电流容量小、耐压低、功率不易做得过大,常用于中、小功率开关电路中。
MOSFET的结构和工作原理1.MOSFET的结构MOSFET和小功率MOS管导电机理相同,但在结构上有较大的区别。
小功率MOS管是一次扩散形成的器件,其栅极G、源极S和漏极D在芯片的同一侧。
而MOSFET主要采用立式结构,其3个外引电极与小功率MOS管相同,为栅极G、源极S和漏极D,但不在芯片的同一侧。
MOSFET的导电沟道分为N沟道和P沟道,栅偏压为零时漏源极之间就存在导电沟道的称为耗尽型,栅偏压大于零(N沟道)才存在导电沟道的称为增强型。
MOSFET的电气符号如图1所示,图1(a)表示N沟道MOSFET,电子流出源极;图1(b)表示P沟道MOSFET,空穴流出源极。
从结构上看,MOSFET还含有一个由S极下的P区和D极下的N区形成的寄生二极管,该寄生二极管的阳极和阴极就是MOSFET的S极和D极,它是与MOSFET不可分割的整体,使MOSFET无反向阻断能力。
图1中所示的虚线部分为寄生二极管。
图1 MOSFET的电气符号2.MOSFET的工作原理(1)当栅源电压uGS=0时,栅极下的P型区表面呈现空穴堆积状态,不可能出现反型层,无法沟通漏源极。
此时,即使在漏源极之间施加电压,MOS管也不会导通。
MOSFET结构示意图如图2(a)所示。
图2 MOSFET结构示意图(2)当栅源电压uGS>0且不够充分时,栅极下面的P型区表面呈现耗尽状态,还是无法沟通漏源极,此时MOS管仍保持关断状态,如图2(b)所示。