SOT23(18排)电子封装模具技术推演
- 格式:pdf
- 大小:1.76 MB
- 文档页数:5

元件封裝及基本腳位定義說明PS:以下收录说明的元件为常规元件A:零件封装是指实际零件焊接到电路板时所指示的外观和焊点的位置。
包括了实际元件的外型尺寸,所占空间位置,各管脚之间的间距等,是纯粹的空间概念。
因此不同的元件可共用同一零件封装,同种元件也可有不同的零件封装.普通的元件封装有针脚式封装(DIP)与表面贴片式封装(SMD)两大类。
(像电阻,有传统的针脚式,这种元件体积较大,电路板必须钻孔才能安置元件,完成钻孔后,插入元件,再过锡炉或喷锡(也可手焊),成本较高,较新的设计都是采用体积小的表面贴片式元件(SMD)这种元件不必钻孔,用钢膜将半熔状锡膏倒入电路板,再把SMD元件放上,即可焊接在电路板上了.)元件按电气性能分类为:电阻,电容(有极性,无极性),电感,晶体管(二极管,三极管),集成电路IC,端口(输入输出端口,连接器,插槽),开关系列,晶振,OTHER(显示器件,蜂鸣器,传感器,扬声器,受话器)1。
电阻:I。
直插式[1/20W 1/16W 1/10W 1/8W 1/4W]II.贴片式[0201 0402 0603 0805 1206]III.整合式[0402 0603 4合一或8合一排阻]IIII。
可调式[VR1~VR5]2.电容:I。
无极性电容[0402 0603 0805 1206 1210 1812 2225]II。
有极性电容分两种:电解电容[一般为铝电解电容,分为DIP与SMD两种]钽电容[为SMD型: A TYPE (3216 10V) B TYPE (3528 16V) C TYPE (6032 25V) D TYPE (7343 35V)]3.电感: I。
DIP型电感II。
SMD型电感4.晶体管:I.二极管[1N4148 (小功率) 1N4007(大功率)发光二极管(都分为SMD DIP 两大类)]II。
三极管[SOT23 SOT223 SOT252 SOT263]5.端口:I.输入输出端口[AUDIO KB/MS(组合与分立)LAN COM(DB-9)RGB(DB—15)LPT DVI USB(常规,微型) TUNER(高频头) GAME 1394 SATA POWER_JACK等] II。

电子元件封装知识电子元件封装知识元件封装小结电阻:RES1,RES2,RES3,RES4;封装属性为axial系列无极性电容:cap;封装属性为RAD-0.1到rad-0.4电解电容:electroi;封装属性为rb.2/.4到rb.5/1.0电位器:pot1,pot2;封装属性为vr-1到vr-5二极管:封装属性为diode-0.4(小功率)diode-0.7(大功率)三极管:常见的封装属性为to-18(普通三极管)to-22(大功率三极管)to-3(大功率达林顿管)电源稳压块有78与79系列;78系列如7805,7812,7820等79系列有7905,7912,7920等常见的封装属性有to126h与to126v整流桥:BRIDGE1,BRIDGE2: 封装属性为D系列(D-44,D-37,D-46)电阻:AXIAL0.3-AXIAL0.7 其中0.4-0.7指电阻的长度,通常用AXIAL0.4瓷片电容:RAD0.1-RAD0.3。
其中0.1-0.3指电容大小,通常用RAD0.1电解电容:RB.1/.2-RB.4/.8 其中.1/.2-.4/.8指电容大小。
通常470uF用RB.3/.6二极管:DIODE0.4-DIODE0.7 其中0.4-0.7指二极管长短,通常用DIODE0.4发光二极管:RB.1/.2集成块:DIP8-DIP40, 其中8-40指有多少脚,8脚的就是DIP8贴片电阻 0603表示的是封装尺寸与具体阻值没有关系,但封装尺寸与功率有关通常来说如下:0201 1/20W 0402 1/16W 0603 1/10W 0805 1/8W 1206 1/4W 电容电阻外形尺寸与封装的对应关系是:0402=1.0mmx0.5mm 0603=1.6mmx0.8mm 0805=2.0mmx1.2mm 1206=3.2mmx1.6mm1210=3.2mmx2.5mm 1812=4.5mmx3.2mm 2225=5.6mmx6.5mm零件封装是指实际零件焊接到电路板时所指示的外观与焊点的位置。

封装形式BGADIPHSOPMSOPPLCCQFNQFPQSOPS DIPSIPSODSOJSOPSotSSOPTO - DeviceTSSOPTQFPBGA(ballgridarray)球形触点陈列,表面贴装型封装之一。
在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI芯片,然后用模压树脂或灌封方法进行密封。
也称为凸点陈列载体(PAC)。
该封装是美国Motorola公司开发的,首先在便携式电话等设备中被采用,今后在美国有可能在个人计算机中普及。
最初,BGA的引脚(凸点)中心距为1.5mm,引脚数为225.现在也有一些LSI厂家正在开发500引脚的BGA.BGA的问题是回流焊后的外观检查。
现在尚不清楚是否有效的外观检查方法。
有的认为,由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。
序号封装编号封装说明实物图1 BGA封装内存2 CCGA3 CPGA CerAMIc PinGrid4 PBGA 1.5mm pitch5 SBGA ThermallyEnhanced6 WLP-CSP Chip ScalePackageDIP(du ALI n-line package)返回双列直插式封装。
插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。
DIP是最普及的插装型封装,应用范围包括标准逻辑IC,存贮器LSI,微机电路等。
引脚中心距2.54mm,引脚数从6到64.封装宽度通常为15.2mm.有的把宽度为7.52mm和10.16mm的封装分别称为skinnyDIP和slimDIP(窄体型DIP)。
但多数情况下并不加区分,只简单地统称为DIP.另外,用低熔点玻璃密封的陶瓷DIP也称为cerdip。
序号封装编号封装说明实物图1 DIP14M3 双列直插2 DIP16M3 双列直插3 DIP18M3 双列直插4 DIP20M3 双列直插5 DIP24M3 双列直插6 DIP24M67 DIP28M3 双列直插8 DIP28M69 DIP2M 直插10 DIP32M6 双列直插11 DIP40M612 DIP48M6 双列直插13 DIP8 双列直插14 DIP8M 双列直插HSOP 返回H-(withheatsink)表示带散热器的标记。

电子元件标准封装SOD-723 1.00*0.60*0.53 SOD-523 1.20*0.80*0.60 SOD-323 1.70*1.30*0.85 SOD-123 2.70*1.60*1.10 SOT-143SOT-523 1.60*0.80*0.75 SOT-363/SOT26 2.10*1.25*0.96 SOT-353/SOT25 2.10*1.25*0.96 SOT343 2.10*1.25*0.96SOT-323 2.10*1.25*0.96 SOT-23 2.90*1.30*1.00 SOT23-3L 2.92*1.60*1.10 SOT23-5L 2.92*1.60*1.10 SOT23-6L 2.92*1.60*1.10 SOT-89 4.50*2.45*1.50 `SOT-89-3L 4.50*2.45*1.50 `SOT-89-5L 4.50*2.45*1.50 `SOT-89-6L 4.50*2.45*1.50 SOT-223 6.30*3.56*1.60TO-92 4.50*4.50*3.50 TO-92S-2L 4.00*3.16*1.52 TO-92S-3L 4.00*3.16*1.52 TO-92L 4.90*8.00*3.90 TO-92MOD 6.00*8.60*4.90 TO-94 5.13*3.60*1.60 TO-126 7.60*10.80*2.70 TO-126B 8.00*11.00*3.20 TO-126C 8.00*11.00*3.20 TO-251 6.50*5.50*2.30TO-252-2L 6.50*5.50*2.30 TO-252-3L 6.50*5.50*2.30 TO-252-5L 6.50*5.50*2.30 TO-263-2L 10.16*8.70*4.57 TO-263-3L 10.16*8.70*4.57 TO-263-5L 10.00*8.40*4.57 TO-220-2L 10.16*8.70*4.57 TO-220-3L 10.16*8.7*4.57 TO-220-5L 10.00*8.40*4.57 TO-220F 10.16*15.00*4.50TO-220F-4 10.20*9.10*4.57 TO-247 15.60*20.45*5.00 TO-264TO-3P 15.75*20.45*4.8 TO-3P-5 15.75*20.45*4.8 TO-3PF-5 15.75*20.45*4.8 TO-3TO-5TO-8TO-18TO-52TO-71TO-72TO-78TO-93TO-99FTO-220ITO-220ITO-3P集成电路标准封装(s-z开关头)集成电路标准封装(s开关头)外形图封装说明SBGASC-70 5L详细规格SDIPSIMM30Single In-line Memory Module SIMM72Single In-line Memory Module SIMM72Single In-line Memory ModuleSIPSingle Inline PackageSLOT 1For intel Pentium II Pentium III & Celeron CPUSNAPTKSNAPTK SNAPZPSO DIMMSmall Outline Dual In-line Memory ModuleSOSmall Outline PackageSOCKET 370For intel 370 pin PGA Pentium III & Celeron CPUSOCKET 423For intel 423 pin PGA Pentium 4 CPUSOCKET462/SOCKET A For PGA AMD Athlon & Duron CPUSOCKET 7For intel Pentium & MMX Pentium CPUSocket 603FosterSOH-28SOJ 32L详细规格SOP EIAJ TYPE II 14L详细规格SSOP 16L详细规格SSOP外形图 封装说明TQFP 100L 详细规格TSOPThin Small Outline PackageTSSOP or TSOP II Thin Shrink Outline PackageLAMINATE TCSP 20L Chip Scale Package 详细规格LAMINATE UCSP 32L Chip Scale Package 详细规格uBGAMicro Ball Grid ArrayuBGAMicro Ball Grid ArrayVL BusVESA Local BusXT Bus8bitZIPZig-Zag Inline Package 集成电路标准封装(a-v字母开头)外形图封装说明AC'97v2.2specificationAGP 3.3VAcceleratedGraphics PortSpecification2.0AGP PROAcceleratedGraphics PortPROSpecification1.01AGPAcceleratedGraphics PortSpecification2.0AMRAudio/Modem RiserBGABall Grid Array BQFP132 EBGA 680L LBGA 160LPBGA 217L Plastic Ball Grid ArraySBGA 192LTSBGA 680LC-Bend LeadCERQUAD Ceramic QuadFlat PackCLCCCNR CommunicationandNetworkingRiser SpecificationRevision 1.2CPGA Ceramic Pin Grid ArrayCeramic CaseLAMINATE CSP 112L Chip Scale PackageDIPDual Inline PackageDIP-tabDual Inline Package with Metal HeatsinkDIMM 168 DIMM DDRDIMM168 Dual In-line Memory Module DIMM184For DDR SDRAM Dual In-line Memory ModuleEISA Extended ISAFBGAFDIPHSOP28ISAIndustryStandardArchitecture详细规格JLCCLCCLDCCLGALQFPLLP 8La详细规格PCDIPPCI 32bit 5V Peripheral Component Interconnect PCI 64bit 3.3V Peripheral Component InterconnectPCMCIAPDIPPGAPlastic Pin Grid ArrayPLCCPQFPPSDIPLQFP 100LMETAL QUAD100LQFPQuad FlatPackageRIMMRIMMFor DirectRambus一、什么叫封装封装,就是指把硅片上的电路管脚,用导线接引到外部接头处,以便与其它器件连接.封装形式是指安装半导体集成电路芯片用的外壳。

140科技资讯 SC I EN C E & TE C HN O LO G Y I NF O R MA T IO N工 业 技 术1 分析对比改进前后SOD-123引线框架(详见图1,表1)从以上数据分析可发现旧SOD-123引线框架每个产品间距=3.12太大,最终使得材料利用率极低。
因此产品工艺改进着重从改小产品间距入手。
SOD-123产品不仅要考虑引线框架的冲压工艺,还要考虑后续的注塑成型及组装是否可行。
随着注塑成型工艺不断精细化,引线框架产品间距大大缩小变得可行。
在分析每一加工工艺可行性后,决定实行重大工程变更。
(1)产品间距由3.12大大缩小为1.11,并去除掉每四个产品之间的连接带(tie-bar)。
S O D -123引线框架工艺改进及冲压模具设计赖永兴(中山市益能达精密电子有限公司 广东中山 528400)摘 要:现有SOD-123引线框架排样不太紧凑,材料利用率低。
而近年来铜材价格大幅攀升,导致原材料成本不断侵蚀企业利润。
因此急需把SOD-123引线框架精细化。
本文着重介绍了SOD-123引线框架工艺改进及冲压模具设计。
关键词:引线框架 排样 凸模 卸料板入子 凹模入子中图分类号:T M 5文献标识码:A 文章编号:1672-3791(2011)07(b)-0140-02(2)为增强引线框架的强度防止变形,把每一小单元产品由竖排改为横排,并在竖列间由连接带(tie-bar)连接,每一竖列由4pcs更改为8pcs。
(3)每一冲压取数由8pcs增加到16pcs。
(4)引线框架宽度由28.08变更为24.2。
以上产品工艺改进后,铜材使用量会显著降低,而且效率也会成倍增加。
因此经济效益十分可观。
2 分析对比改进前后SOD-123引线框架冲压模具排样(详见图2,表2)引线框架材料为:PM C 90-S H,厚度为0.15。
工艺改进后材料利用率提升:(30.266-14.625)/14.625×100%=109%。
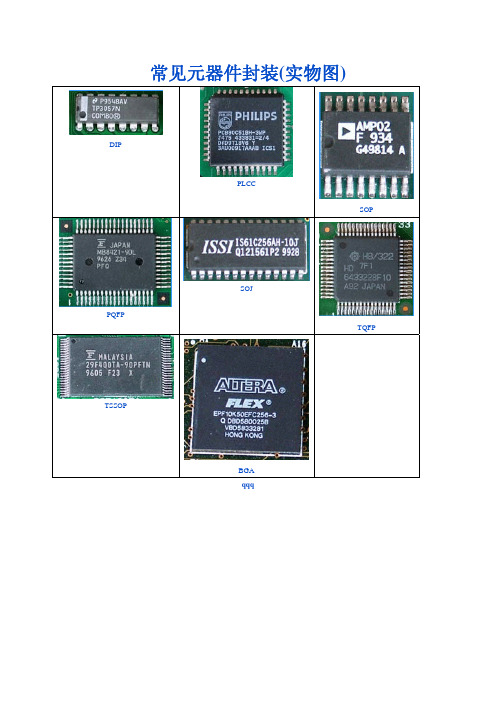
常见元器件封装(实物图)qqqDIPPLCCSOPPQFPSOJTQFPTSSOPBGA芯片封装技术知多少前言我们经常听说某某芯片采用什么什么的封装方式,在我们的电脑中,存在着各种各样不同处理芯片,那么,它们又是是采用何种封装形式呢?并且这些封装形式又有什么样的技术特点以及优越性呢?那么就请看看下面的这篇文章,将为你介绍个中芯片封装形式的特点和优点。
一、DIP双列直插式封装DIP(DualIn-line Package)是指采用双列直插形式封装的集成电路芯片,绝大多数中小规模集成电路(IC)均采用这种封装形式,其引脚数一般不超过100个。
采用DIP封装的CPU芯片有两排引脚,需要插入到具有DIP结构的芯片插座上。
当然,也可以直接插在有相同焊孔数和几何排列的电路板上进行焊接。
DIP封装的芯片在从芯片插座上插拔时应特别小心,以免损坏引脚。
DIP封装具有以下特点:1.适合在PCB(印刷电路板)上穿孔焊接,操作方便。
2.芯片面积与封装面积之间的比值较大,故体积也较大。
Intel系列CPU中8088就采用这种封装形式,缓存(Cache)和早期的内存芯片也是这种封装形式。
二、PQFP塑料方型扁平式封装和PFP塑料扁平组件式封装PQFP(Plastic Quad Flat Package)封装的芯片引脚之间距离很小,管脚很细,一般大规模或超大型集成电路都采用这种封装形式,其引脚数一般在100个以上。
用这种形式封装的芯片必须采用SMD(表面安装设备技术)将芯片与主板焊接起来。
采用SMD安装的芯片不必在主板上打孔,一般在主板表面上有设计好的相应管脚的焊点。
将芯片各脚对准相应的焊点,即可实现与主板的焊接。
用这种方法焊上去的芯片,如果不用专用工具是很难拆卸下来的。
PFP(Plastic Flat Package)方式封装的芯片与QFP方式基本相同。
唯一的区别是QFP一般为正方形,而PFP既可以是正方形,也可以是长方形。
最全的芯片封装方式大全各种IC封装形式图片各种封装缩写说明BGABQFP132BGABGABGABGABGA CLCCCNRPGADIPDIP-tab BGADIPTOFlat PackHSOP28 TOTOJLCC LCCCLCCBGALQFP DIPPGAPLCCPQFPDIP LQFPLQFPPQFPQFPQFPTQFP BGASC-70 5LDIPSIPSOSOHSOJSOJSOPTOSOPSOPCANTOTOTOTO3CANCANCANCANCANTO8TO92CANCANTSOPTSSOP or TSOP BGABGAZIPPCDIP以下封装形式未找到相关图片,仅作简易描述,供参考:DIM单列直插式,塑料例如:MH88500QUIP蜘蛛脚状四排直插式,塑料例如:NEC7810DBGA BGA系列中陶瓷芯片例如:EP20K400FC672-3CBGA BGA系列中金属封装芯片例如: EP20K300EBC652-3 MODULE方形状金属壳双列直插式例如:LH0084RQFP QFP封装系列中,表面带金属散装体例如:EPF10KRC系列DIMM电路正面或背面镶有LCC封装小芯片,陶瓷,双列直插式例如:X28C010DIP-BATTERY电池与微型芯片内封SRAM芯片,塑料双列直插式例如:达拉斯SRAM系列(五)按用途分类集成电路按用途可分为电视机用集成电路。
音响用集成电路、影碟机用集成电路、录像机用集成电路、电脑(微机)用集成电路、电子琴用集成电路、通信用集成电路、照相机用集成电路、遥控集成电路、语言集成电路、报警器用集成电路及各种专用集成电路。
电视机用集成电路包括行、场扫描集成电路、中放集成电路、伴音集成电路、彩色解码集成电路、AV/TV转换集成电路、开关电源集成电路、遥控集成电路、丽音解码集成电路、画中画处理集成电路、微处理器(CPU)集成电路、存储器集成电路等。
音响用集成电路包括AM/FM高中频电路、立体声解码电路、音频前置放大电路、音频运算放大集成电路、音频功率放大集成电路、环绕声处理集成电路、电平驱动集成电路、电子音量控制集成电路、延时混响集成电路、电子开关集成电路等。
封装有两大类;一类是通孔插入式封装(through-hole package);另—类为表面安装式封装(surface moun te d Package)。
每一类中又有多种形式。
表l和表2是它们的图例,英文缩写、英文全称和中文译名。
图6示出了封装技术在小尺寸和多引脚数这两个方向发展的情况。
DIP是20世纪70年代出现的封装形式。
它能适应当时多数集成电路工作频率的要求,制造成本较低,较易实现封装自动化印测试自动化,因而在相当一段时间内在集成电路封装中占有主导地位。
但DIP的引脚节距较大(为2.54mm),并占用PCB板较多的空间,为此出现了SHDIP和SKDIP等改进形式,它们在减小引脚节距和缩小体积方面作了不少改进,但DIP最大引脚数难以提高(最大引脚数为64条)且采用通孔插入方式,因而使它的应用受到很大限制。
为突破引脚数的限制,20世纪80年代开发了PGA封装,虽然它的引脚节距仍维持在2.54mm或1.77mm,但由于采用底面引出方式,因而引脚数可高达500条~600条。
随着表面安装技术(surface mounted technology, SMT)的出现,DIP封装的数量逐渐下降,表面安装技术可节省空间,提高性能,且可放置在印刷电路板的上下两面上。
SOP应运而生,它的引脚从两边引出,且为扁平封装,引脚可直接焊接在PCB板上,也不再需要插座。
它的引脚节距也从DIP的2.54 mm减小到1.77mm。
后来有SSOP和TSOP改进型的出现,但引脚数仍受到限制。
QFP也是扁平封装,但它们的引脚是从四边引出,且为水平直线,其电感较小,可工作在较高频率。
引脚节距进一步降低到1.00mm,以至0.65 mm和0.5 mm,引脚数可达500条,因而这种封装形式受到广泛欢迎。
但在管脚数要求不高的情况下,SOP以及它的变形SOJ(J型引脚)仍是优先选用的封装形式,也是目前生产最多的一种封装形式。
方形扁平封装-QFP (Quad Flat Package)[特点] 引脚间距较小及细,常用于大规模或超大规模集成电路封装。
SOT系列MGP模具研发浅谈汪宗华安徽中智光源科技有限公司技术开发部(安徽铜陵244000)【摘要】半导体产业的发展直接带动芯片封装的技术进步,而传统的单缸注胶头模具也已经满足不了先进封装的要求,多缸注胶头模具应运而生。
本文以SOT23制品塑模为例,谈谈多缸注胶头模具(MGP)结构与设计原理,从而推动集成电路模具发展。
关键词:集成电路;多缸注胶头;免预热;模盒结构;浇注系统;油缸中图分类号:TQ320.66文献标识码:BThe Research and Development of SOT Series MGP Mold 【Abstract】The development of the semiconductor industry directly promote technological progress in the chip package,the traditional single plunger rubber injection head mold also has been unable to meet the requirements of advanced packaging,multi plungers injection head mold came into being.This paper take SOT23products mold as an example,to discuss the structure and design principle of multi plungers glue injection head mold(MGP),so as to promote the development of IC mold.Key words:integrated circuit;multi plungers injection head;non pre-heating;mold structure; get system;cylinder1引言半导体产业景气的上升推动着国内封装技术的进步,中国的半导体制造业正慢慢进入成熟阶段,超高速计算机、数字化视听、移动通讯和便携式电子机器的火爆出现,直接带动芯片封装技术的进步。