BGA参考资料
- 格式:pdf
- 大小:1.25 MB
- 文档页数:35




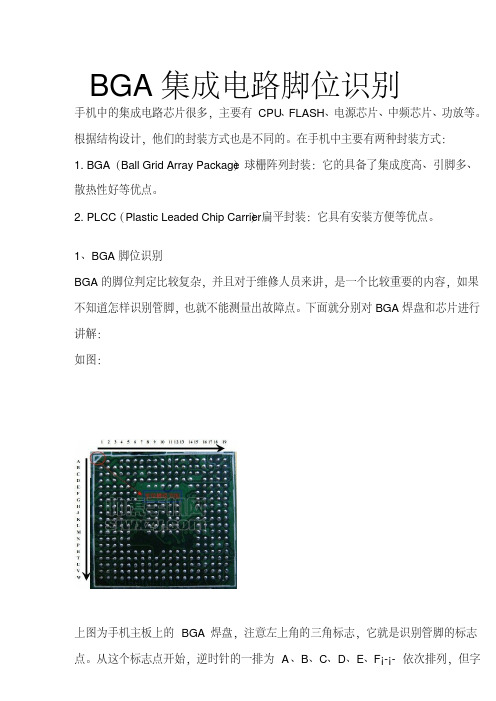
BGA集成电路脚位识别
手机中的集成电路芯片很多,主要有CPU、FLASH、电源芯片、中频芯片、功放等。
根据结构设计,他们的封装方式也是不同的。
在手机中主要有两种封装方式:
1. BGA(Ball Grid Array Package)球栅阵列封装:它的具备了集成度高、引脚多、散热性好等优点。
2. PLCC(Plastic Leaded Chip Carrier)扁平封装:它具有安装方便等优点。
1、BGA脚位识别
BGA的脚位判定比较复杂,并且对于维修人员来讲,是一个比较重要的内容,如果不知道怎样识别管脚,也就不能测量出故障点。
下面就分别对BGA焊盘和芯片进行讲解:
如图:
上图为手机主板上的BGA 焊盘,注意左上角的三角标志,它就是识别管脚的标志点。
从这个标志点开始,逆时针的一排为A、B、C、D、E、F¡-¡-依次排列,但字
母中没有I、O、Q、S、X、Z,如果排到I了,那么就把I甩掉,用J来顺延。
标志点顺时针一排为1、2、3、4、5、6¡-¡-依次排列。
如果字母排到Y还没有排完,那么字母可以延位为AA、AB、AC¡-¡-依次类推。
如果是BGA芯片,我们同样需要找到标志点。
如图红圈位置,根据上面焊盘的判断方法,我们可以分析出来,逆时针为1、2、3、4、5¡-¡-,顺时针为A、B、C、D、E¡-¡- 如图:
2、PLCC 脚位识别
PLCC 封装的脚位判断比较简单,只要先找到标志点,然后从标志点
开始逆时针数脚位就可以了。
如图:。

BGA 技术简介1 BGA 技术简介BGA技术的研究始于60年代,最早被美国IBM公司采用,但一直到90年代初,BGA 才真正进入实用化的阶段。
在80年代,人们对电子电路小型化和I/O引线数提出了更高的要求。
虽然SMT使电路组装具有轻、薄、短、小的特点,对于具有高引线数的精细间距器件的引线间距以及引线共平面度也提出了更为严格的要求,但是由于受到加工精度、可生产性、成本和组装工艺的制约,一般认为QFP(Quad Flat Pack 方型扁平封装)器件间距的极限为0.3mm,这就大大限制了高密度组装的发展。
另外,由于精细间距QFP器件对组装工艺要求严格,使其应用受到了限制,为此美国一些公司就把注意力放在开发和应用比QFP器件更优越的BGA器件上。
精细间距器件的局限性在于细引线易弯曲、质脆而易断,对于引线间的共平面度和贴装精度的要求很高。
BGA技术采用的是一种全新的设计思维方式,它采用将圆型或者柱状点隐藏在封装下面的结构,引线间距大、引线长度短。
这样,BGA就消除了精细间距器件中由于引线问题而引起的共平面度和翘曲的问题。
JEDEC(电子器件工程联合会)(JC-11)的工业部门制定了BGA封装的物理标准,BGA与QFD相比的最大优点是I/O引线间距大,已注册的引线间距有1.0、1.27和1.5mm,而且目前正在推荐由1.27mm和1. 5mm间距的BGA取代0.4mm-0.5mm的精细间距器件。
BGA器件的结构可按焊点形状分为两类:球形焊点和校状焊点。
球形焊点包括陶瓷球栅阵列CBGA(C eramic Ball Grid Array)、载带自动键合球栅阵列TBGA(Tape Automatec Ball Grid Array)塑料球栅阵列P BGA(Plastic Ball Array)。
CBGA、TBGA和PBGA是按封装方式的不同而划分的。
柱形焊点称为CCGA(Ce ramic Column Grid Array)。
1. Product profile1.1General descriptionSilicon Monolitic Microwave Integrated Circuit (MMIC) wideband amplifier with internalmatching circuit in a 6-pin SOT363 plastic SMD package.1.2Features and benefitsInternally matched to 50 ΩA gain of 20 dB at 250 MHz increasing to 20.6 dB at 2150 MHz Output power at 1 dB gain compression = −1 dBm Supply current = 10.5 mA at a supply voltage of 3.3 V Reverse isolation > 30 dB up to 2 GHzGood linearity with low second order and third order products Noise figure = 4 dB at 950 MHzUnconditionally stable (K > 1)1.3ApplicationsLNB IF amplifiersGeneral purpose low noise wideband amplifier for frequencies betweenDC and 2.2GHz2. Pinning informationBGA2800MMIC wideband amplifierRev. 2 — 18 October 2010Product data sheetTable 1.PinningPin Description Simplified outline Graphic symbol1V CC 2, 5GND23RF_OUT 4GND16RF_IN132456sym052132, 5643. Ordering information4. Marking5. Limiting values6. Thermal characteristics7. CharacteristicsTable 2.Ordering informationType number Package NameDescriptionVersion BGA2800-plastic surface-mounted package; 6 leadsSOT363Table 3.MarkingType numberMarking code DescriptionBGA2800*E7* = - : made in Hong Kong * = p : made in Hong Kong * = W : made in China * = t : made in MalaysiaTable 4.Limiting valuesIn accordance with the Absolute Maximum Rating System (IEC 60134).Symbol Parameter Conditions Min Max Unit V CC supply voltage RF input AC coupled−0.5 3.6V I CC supply current -55mA P tot total power dissipation T sp = 90 °C -200mW T stg storage temperature −40+125°C T j junction temperature -125°C P drivedrive power-−16.5dBmTable 5.Thermal characteristics Symbol ParameterConditionsTyp Unit R th(j-sp)thermal resistance from junction to solder pointP tot =200mW; T sp =90°C300K/WTable 6.CharacteristicsV CC = 3.3 V; Z S = Z L = 50 Ω; P i = −40 dBm; T amb = 25 °C; measured on demo board; unless otherwise specified.Symbol Parameter ConditionsMin Typ Max Unit V CC supply voltage 3.0 3.3 3.6V I CCsupply current8.810.512.1mATable 6.Characteristics …continuedV CC = 3.3 V; Z S = Z L = 50 Ω; P i = −40 dBm; T amb = 25 °C; measured on demo board; unless otherwise specified.Symbol Parameter Conditions Min Typ Max Unit G p power gain f = 250 MHz19.419.920.5dBf = 950 MHz19.820.521.2dBf = 2150 MHz18.720.221.7dB RL in input return loss f = 250 MHz192123dBf=950MHz192123dBf = 2150 MHz101522dB RL out output return loss f = 250 MHz151924dBf=950MHz161718dBf = 2150 MHz151720dB ISL isolation f = 250 MHz466787dBf=950MHz444647dBf = 2150 MHz353740dB NF noise figure f = 250 MHz 3.2 3.7 4.2dBf = 950 MHz 3.1 3.6 4.0dBf = 2150 MHz 3.3 3.7 4.2dB B−3dB−3 dB bandwidth 3 dB below gain at 1GHz 2.9 3.2 3.5GHz K Rollett stability factor f = 250 MHz49105160f = 950 MHz8910f = 2150 MHz 2.8 3.4 4.0P L(sat)saturated output power f = 250 MHz112dBmf = 950 MHz013dBmf = 2150 MHz−201dBm P L(1dB)output power at 1 dB gain compression f = 250 MHz−2−10dBmf = 950 MHz−2−10dBmf = 2150 MHz−3−2−1dBm IP3I input third-order intercept point P drive=−36dBm (for each tone)f1=250MHz; f2=251MHz−11−9−7dBmf1=950MHz; f2=951MHz−12−10−7dBmf1=2150MHz; f2=2151MHz−15−12−9dBm IP3O output third-order intercept point P drive=−36dBm (for each tone)f1=250MHz; f2=251MHz91113dBmf1=950MHz; f2=951MHz91113dBmf1=2150MHz; f2=2151MHz5811dBm P L(2H)second harmonic output power P drive=−34dBmf1H=250MHz; f2H=500MHz−62−60−58dBmf1H=950MHz; f2H=1900MHz−51−49−48dBm ΔIM2second-order intermodulation distance P drive=−36dBm (for each tone)f1=250MHz; f2=251MHz425364dBcf1=950MHz; f2=951MHz445567dBc8. Application informationFigure1 shows a typical application circuit for the BGA2800 MMIC. The device isinternally matched to 50 Ω, and therefore does not need any external matching. The valueof the input and output DC blocking capacitors C2 and C3 should not be more than 100 pFfor applications above 100 MHz. However, when the device is operated below 100 MHz,the capacitor value should be increased.The 22 nF supply decoupling capacitor C1 should be located as close as possible to theMMIC.The PCB top ground plane, connected to pins 2, 4 and 5 must be as close as possible tothe MMIC, preferably also below the MMIC. When using via holes, use multiple via holesas close as possible to the MMIC.8.1Application examples8.2Graphs8.3TablesTable 7.Supply current over temperature and supply voltagesTypical values.Symbol Parameter Conditions T amb (°C)Unit−402585I CC supply current V CC=3.0V9.188.968.80mAV CC=3.3V11.1810.5210.83mAV CC=3.6V12.0712.2811.62mA Table 8.Second harmonic output power over temperature and supply voltagesTypical values.Symbol Parameter Conditions T amb (°C)Unit−402585 P L(2H)second harmonic output power f = 250 MHz; P drive=−34dBmV CC=3.0V−53−58−63dBmV CC=3.3V−57−60−63dBmV CC=3.6V−58−61−62dBmf = 950 MHz; P drive=−34dBmV CC=3.0V−46−49−51dBmV CC=3.3V−47−49−51dBmV CC=3.6V−47−49−51dBmTable 9.Input power at 1 dB gain compression over temperature and supply voltages Typical values.Symbol Parameter Conditions T amb (°C)Unit−402585P i(1dB)input power at 1dB gain compression f = 250 MHzV CC=3.0V−21−21−21dBmV CC=3.3V−20−20−20dBmV CC=3.6V−20−20−20dBmf = 950 MHzV CC=3.0V−21−21−21dBmV CC=3.3V−20−20−20dBmV CC=3.6V−20−20−20dBmf = 2150 MHzV CC=3.0V−21−21−22dBmV CC=3.3V−21−21−22dBmV CC=3.6V−20−21−22dBm Table 10.Output power at 1 dB gain compression over temperature and supply voltages Typical values.Symbol Parameter Conditions T amb (°C)Unit−402585P L(1dB)output power at 1dB gain compression f = 250 MHzV CC=3.0V−3−3−3dBmV CC=3.3V−1−1−1dBmV CC=3.6V00−1dBmf = 950 MHzV CC=3.0V−3−3−3dBmV CC=3.3V−1−1−2dBmV CC=3.6V00−1dBmf = 2150 MHzV CC=3.0V−3−3−4dBmV CC=3.3V−1−2−3dBmV CC=3.6V0−1−3dBm分销商库存信息: NXPBGA2800,115。
BGABGA 的全稱是Ball Grid Array (球柵陣列結構的PCB ),它是集成電路採用有機載板的一種封裝法。
它具有:① 封裝面積減少②功能加大,引腳數目增多③P CB 板溶焊時能自我居中,易上錫④可靠性高⑤電性能好,整體成本低等特點。
有BGA 的PCB 板一般小孔較多,大多數客戶BGA 下過孔設計為成品孔直徑8~12mil ,BGA 處表面貼到孔的距離以規格為31.5mil 為例,一般不小於10.5mil 。
BGA 下過孔需圔孔,BGA 焊盤不允許上油墨,BGA 焊盤上不鑽孔。
目錄封裝就不能不提Kingmax公司的專利TinyBGA技術,TinyBGABGA封裝(7張)結構特點PBGA(Plasric BGA)載體為普通的印製板基材,一般為2~4層有機材料構成的多層板,芯片通過金屬絲壓焊方式連接到載體上表面,圕料模壓成形載體表面連接有共晶焊料球陣列。
例如Intel系列CPU中PemtiumII、III、IV處理器均採用這種封裝方式。
又有CDPBGA(Carity Down PBGA),指封裝中央有方形低陷的芯片區(又稱:空腔區)。
優點:封裝成本相對較低;和QFP相比,不易受到機械損傷;適用大批量的電子組裝;字體與PCB基材相同,熱膨脹係數幾乎相同,焊接時,對函電產生應力很小,對焊點可靠性影響也較少。
缺點:容易吸潮。
CBGA(CeramicBGA)載體為多層陶瓷,芯片與陶瓷載體的連接可以有兩種形式:金屬絲壓焊; 倒裝芯片技術。
例如Intel系列CPU中PemtiumI、II、PemtiumI Pro處理器均採用這種封裝方式。
優點:電性能和熱性能優良;既有良好的密封性;和QFP相比,不易受到機械損傷;適用於I/O數大於250的電子組裝。
缺點:與PCB相比熱膨脹係數不同,封裝尺寸大時,導致熱循環函電失效。
FCBGA(FilpChipBGA)採用硬質多層基板。
CCGACCGA是CBGA尺寸大於在32*32mm時的另一種形式,不同之處在於採用焊料柱代替焊料球。
bga封装BGA封装:背景,原理及应用摘要:BGA封装是一种高性能的集成电路封装技术,广泛应用于现代电子设备中。
本文将介绍BGA封装的背景知识、工作原理以及在电子行业中的应用,并探讨其中的优缺点。
一、背景介绍在过去的几十年中,电子行业发展迅猛,集成电路封装技术变得越来越重要。
BGA封装就是其中一种常见的封装技术。
随着半导体技术的进步,传统的封装技术(如DIP、QFP)已经不能满足高性能和高密度的需求。
为了解决这些问题,工程师们引入了BGA封装技术。
二、BGA封装的原理BGA封装(Ball Grid Array)是一种表面组装封装技术。
与传统的封装技术不同,BGA封装的引脚是通过焊球连接到封装的底部。
焊球通过加热和融化连接到印刷电路板(PCB)上的焊盘上,从而实现电气和机械连接。
BGA封装通过几个关键部分实现其功能:1. 封装基板(Package Substrate):通常由高热传导性的物质制成,如陶瓷或高温塑料。
封装基板上有一定数量的焊盘,用于连接印刷电路板。
2. 焊球(Solder Ball):焊球通常由锡合金制成,通过热融化连接到印刷电路板上的焊盘上。
3. 芯片(Die):芯片是电路封装的核心部分,它是由半导体材料制成的电子元件。
背胶(Underfill)是BGA封装的另一个重要组成部分,用于填充芯片和封装基板之间的空隙。
背胶可以提高连接的可靠性和机械强度。
三、应用领域BGA封装技术在各个领域得到了广泛的应用,尤其是在计算机和通信设备中。
以下是一些常见的应用案例:1. 芯片级封装:BGA封装技术已经成为芯片级封装的主要选择。
它可以为芯片提供更好的散热性能和机械强度,从而使芯片在高频率和高温环境下工作更加稳定可靠。
2. 通信设备:BGA封装在通信设备中起到关键作用。
由于BGA封装能够提供更高的连接密度,因此可以实现更小的设备尺寸和更高的集成度。
3. 汽车电子:汽车电子设备对封装技术的要求也越来越高。