第八章光刻8
- 格式:ppt
- 大小:7.73 MB
- 文档页数:71

第八章干刻工艺8.1 Dry Etch工序的目的广义而言,所谓的刻蚀技术,是将显影后所产生的光阻图案忠实地转印到光阻下的材质上,形成由光刻技术定义的图形。
它包含了将材质整面均匀移除及图案选择性部分去除,可分为湿式刻蚀(wet etching)和干式刻蚀(dry etching)两种技术。
第五章中已经对湿式刻蚀进行了较详细的介绍。
湿式刻蚀具有待刻蚀材料与光阻及下层材质良好的刻蚀选择比(selectivity)。
然而,由于化学反应没有方向性,因而湿式刻蚀是各向同性刻蚀。
当刻蚀溶液做纵向刻蚀时,侧向的刻蚀将同时发生,进而造成底切(Undercut)现象,导致图案线宽失真,如下图所示。
图8.1 底切现象自1970年以来,元件制造首先开始采用电浆刻蚀技术(也叫等离子体刻蚀技术),人们对于电浆化学性的了解与认识也就越来越深。
在现今的半导体集成电路或LCD制造过程中,要求精确地控制各种材料尺寸至次微米大小,而且还必须具有极高的再现性,电浆刻蚀是现今技术中唯一能极有效率地将此工作在高良率下完成的技术,因此电浆刻蚀便成为半导体制造以及TFT LCD Array制造中的主要技术之一。
干式刻蚀通常指利用辉光放电(glow discharge)方式,产生包含离子、电子等带电粒子以及具有高度化学活性的中性原子、分子及自由基的电浆,来进行图案转印(pattern transfer)的刻蚀技术。
干法刻蚀是亚微米尺寸下刻蚀器件的最主要方法,广泛应用于半导体或LCD 前段制程。
在本章节中,将针对干刻蚀技术加以说明。
8.2 Dry Etch 的分类及工艺的基本原理8.2.1蚀刻技术中的术语1.各向同性与各向异性蚀刻( Isotropic and Anisotropic Etching)不同的蚀刻机制将对蚀刻后的轮廓(Profile)产生直接的影响。
如图8.2所示,纯粹的化学蚀刻通常没有方向选择性,上下左右刻蚀速度相同,蚀刻后将形成圆弧的轮廓,并在遮罩(Mask)下形成底切(Undercut),这种刻蚀被称为各向同性蚀刻。
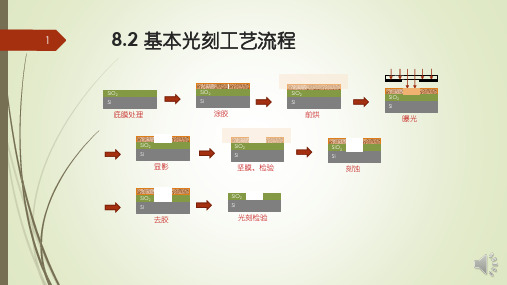




第八章光刻§8.1 引言ImplantDiffusionTest/SortEtch PolishPhotoCompleted waferUnpatternedwafer Wafer startThin FilmsWafer fabrication (front-end)关键步骤一、光刻技术的特点1、光刻是将电路/器件图形转移到半导体的表面形成光刻胶图形;2、光刻是复印图象和化学作用相结合的综合性技术;3、器件的尺寸越小,集成电路的集成度越高,对光刻精度的要求就越高,难度就越大。
4、光刻与芯片的价格和性能密切相关。
光刻成本占芯片制造成本的近1/3。
线宽Substrate光刻胶二、对光刻的基本要求高分辨率;高灵敏度;低缺陷;精密的套刻对准。
分辨率高的分辨率需要将曝光波长减小到与CD几乎一样大小。
UV Wavelength(nm)WavelengthNameUV Emission Source436g-line Mercury arc lamp 405h-line Mercury arc lamp 365i-line Mercury arc lamp248Deep UV (DUV)Mercury arc lamp or Krypton Fluoride (KrF) excimer laser193Deep UV (DUV)Argon Fluoride (ArF) excimer laser 157Vacuum UV (VUV)Fluorine (F2) excimer laserVisibleRadio wavesMicro-wavesInfrared Gamma rays UVX-raysf (Hz)1010101010101010101046810121416221820λ(m)42-2-4-6-8-14-10-1210101010101010101010365436405248193157ghiDUVDUV VUV λ(nm)Common UV wavelengths used in optical lithography.套准精度Top view of CMOS inverterPMOSFET NMOSFETCross section of CMOS inverter投影版( reticle)光掩膜版(photomask)1:1 Mask4:1 Reticle§8.2 光刻工艺一、正性光刻与负性光刻photoresist silicon substrate oxide oxide silicon substrate photoresist紫外光岛显影后图形阴影光刻胶曝光区铬岛窗口Silicon substrateSilicon substrate Photoresist Photoresist Oxide Oxide Oxide Oxide Silicon substrateSilicon substrate 光刻胶正性光刻紫外光岛显影后图形窗口光刻胶曝光区阴影铬岛Si substrate光刻胶光刻胶Oxide Oxide Silicon substrateSilicon substrate 负性光刻光刻胶Quartz IslandWindowChrome亮场掩膜版暗场掩膜版二、亮场版与暗场版用正性光刻胶的亮场掩膜版,具有相同图形的暗场掩膜版需要用负性光刻胶§8.3 光刻工艺的8个基本步骤一、工艺流程(共8步)1、气相成底膜处理:包括清洁、烘干、气相成底膜(采用六甲基二硅胺烷)。