电子产品失效分析技术模板
- 格式:ppt
- 大小:4.84 MB
- 文档页数:103


中国赛宝实验室可靠性研究分析中心案例一:1产品名称:单片机MD87C51/B2商标:Intel3分析依据:MIL-STD-883E 微电子器件试验方法和程序微电路的失效分析程序MIL-STD-883E 方法2010 内部目检(单片电路)4样品数量及编号:失效样品1#~6#,良品7#~12#5样品概述及失效背景:MD87C51/B是一高速CMOS单片机。
委托方一共提供四种批次的此类样品。
1#、5#、10#、11#、12#属9724 批次,其中1#样品已做过二次筛选和环境应力试验,是在整机测试过程中失效,5#样品在第一次通电工作不正常,须断电后重新通电可以正常工作,10#~12#样品是良品;2#、3#、4#样品属9731 批次,这三个样品在第一次上机时便无法写入程序,多次长时间擦除,内容显示为空,但仍不能写入;6#样品属9931 批次,失效情况同5#样品;7#~9#样品属9713 批次,为良品。
6分析仪器7 分析过程1)样品外观分析:1#~6#进行外目检均未发生异常;2)编程器读写试验:能对坏品进行内部程序存储器读取,但无法完成写操作,良品读写操作均正常;3)内部水汽含量测试:应委托方要求,8#与12#样品进行内部水汽含量测试,结果符合要求;中国赛宝实验室可靠性研究分析中心4)端口I -V 特性测试:使用静电放电测试系统剩下的样品进行I-V 端口扫描测试,发现:4#样品的Pin3、Pin4 、Pin5 、Pin7 对地呈现明显的电阻特性,使用图示仪测试后测得Pin3 对地呈现约660Ω 阻值、Pin4 与Pin5 对地呈现约300Ω 阻值、Pin7 对地呈现约140 Ω 阻值,且在1#与4#样品的Pin31(EA/Vpp)发现特性曲线异常,但并非每次都能出现;其他样品的管脚未发现明显异常;5)开封和内部分析:对1#~5#样品进行开封,内目检时发现:芯片的铝键合丝与键合台以外相邻的金属化层(有钝化层覆盖)存在跨接现象。
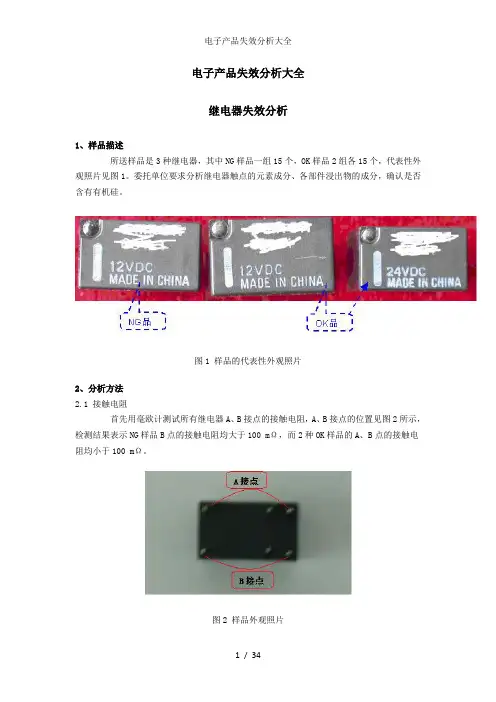
电子产品失效分析大全继电器失效分析1、样品描述所送样品是3种继电器,其中NG样品一组15个,OK样品2组各15个,代表性外观照片见图1。
委托单位要求分析继电器触点的元素成分、各部件浸出物的成分,确认是否含有有机硅。
图1 样品的代表性外观照片2、分析方法2.1 接触电阻首先用毫欧计测试所有继电器A、B接点的接触电阻,A、B接点的位置见图2所示,检测结果表示NG样品B点的接触电阻均大于100 mΩ,而2种OK样品的A、B点的接触电阻均小于100 mΩ。
图2 样品外观照片2.2 SEM&EDS分析对于NG品,根据所测接点电阻的结果,选取B接点接触电阻值高的2个继电器,对于2种OK品,每种任选2个继电器,在不污染触点及其周围的前提下,将样品进行拆分后,用SEM&EDS分析拆分后样品的触点及周围异物的元素成分。
触点位置标示如图3所示。
所检3种样品共6个继电器的触点中,NG品的触点及触点周围检出大量的含碳(C)、氧(O)、硅(Si)等元素的异物,而OK品的触点表面未检出异物。
典型图片如图4、图5所示。
图3 触点位置标识(D指触点C反面)图4 NG样品触点周围异物SEM&EDS检测结果典型图片图5 OK样品触点的SEM&EDS检测结果典型图片2.3 FT-IR分析在不污染各部件的前提下,将2.2条款中剩下的继电器进行拆分,并将拆分后的部件分成3组,即A组(接点、弹片(可动端子、固定端子))、B组(铁片、铁芯、支架、卷轴)、C组(漆包线),分别将A、B、C组部件装入干净的瓶中,见图6所示,处理后用FT-IR分析萃取物的化学成分,确认其是否含有有机硅。
图6 拆分后样品的外观照片结果表明,所检3种样品各部件的萃取物中,NG样品B组(铁片、铁芯、支架、卷轴)和C 组(漆包线)检出有机硅,其他样品的部件未检出有机硅。
典型图片见图7所示。
图7 NG品C组部件萃取物与聚二甲基硅氧烷的红外吸收光谱比较图3、结论1)所检3种继电器样品中,NG品B接点的接触电阻均大于100mΩ,不符合要求;而OK品A、B接点的接触电阻及NG品A接点的接触电阻均小于100mΩ,符合要求;2)所检3种继电器(2个/种)的触点中,NG品的触点及触点周围检出大量的含碳(C)、氧(O)、硅(Si)等元素的异物,而OK品的触点表面未检出异物;3)所检3种继电器(13个/种)部件的萃取物中,NG品B组(铁片、铁芯、支架、卷轴)和C组(漆包线)检出有机硅,其他样品的部件未检出有机硅。

.电子产品失效模式分析失效分析是一门发展中的新兴学科,近年开始从军工向普通企业普及,它一般根据失效模式和现象,通过分析和验证,模拟重现失效的现象,找出失效的原因,挖掘出失效的机理的活动。
在提高产品质量,技术开发、改进,产品修复及仲裁失效事故等方面具有很强的实际意义。
01、失效分析流程失效分析流程1 图02、各种材料失效分析检测方法失效分析PCB/PCBA1、文档Word.作为各种元器件的载体与电路信号传输的枢纽已经成为电子信息产品PCB的最为重要而关键的部分,其质量的好坏与可靠性水平决定了整机设备的质量与可靠性。
2 PCB/PCBA图失效模式爆板、分层、短路、起泡,焊接不良,腐蚀迁移等。
常用手段检测,红外检测,C-SAMX无损检测:外观检查,射线透视检测,三维CT 热成像表面元素分析:(SEM/EDS)扫描电镜及能谱分析?(FTIR)显微红外分析?(AES)俄歇电子能谱分析?文档Word.(XPS)射线光电子能谱分析X?(TOF-SIMS)二次离子质谱分析?热分析:(DSC)差示扫描量热法?(TMA)热机械分析?(TGA)热重分析?(DMA)动态热机械分析?)导热系数(稳态热流法、激光散射法?电性能测试:击穿电压、耐电压、介电常数、电迁移?破坏性能测试:?染色及渗透检测?、电子元器件失效分析2元器件电子元器件技术的快速发展和可靠性的提高奠定了现代电子装备的基础,可靠性工作的根本任务是提高元器件的可靠性。
文档Word.电子元器件3 图失效模式开路,短路,漏电,功能失效,电参数漂移,非稳定失效等功能测试常用手段电测:连接性测试电参数测试无损检测:)机械、化学、激光技术(?化学腐蚀去钝化层、等离子腐蚀去钝化层、机械研磨去钝化层技术(?)去钝化层CP)微区分析技术(FIB、?制样技术:)(机械、化学、激光技术?化学腐蚀去钝化层、等离子腐蚀去钝化层、机械研磨去钝化层技术(?)去钝化层CP)、微区分析技术(FIB?显微形貌分析:光学显微分析技术?文档Word.扫描电子显微镜二次电子像技术?表面元素分析:(SEM/EDS)扫描电镜及能谱分析?(AES)俄歇电子能谱分析?(XPS)X射线光电子能谱分析?(SIMS)二次离子质谱分析?无损分析技术:射线透视技术X?三维透视技术?(C-SAM)反射式扫描声学显微技术?、金属材料失效分析▍3科技以及人们的生活各农业、随着社会的进步和科技的发展,金属制品在工业、个领域的运用越来越广泛,因此金属材料的质量应更加值得关注。

最新失效分析经典案例分享案例一:某知名手机品牌电池爆炸事件某知名手机品牌近期发生了一起电池爆炸事件,导致用户受伤。
经过详细的失效分析,发现电池在高温环境下,由于内部结构设计不合理,导致电池内部短路,进而引发爆炸。
这一案例提醒我们,在产品设计和生产过程中,必须高度重视电池的安全性,严格把控电池的质量和性能。
案例二:某电动车品牌刹车失灵事件某电动车品牌近期发生了一起刹车失灵事件,导致用户在行驶过程中无法及时停车,造成交通事故。
经过失效分析,发现刹车系统中的传感器存在设计缺陷,导致刹车信号无法正常传输。
这一案例警示我们,在产品设计和生产过程中,必须关注关键部件的可靠性,确保产品的安全性。
案例三:某智能门锁品牌指纹识别失效事件某智能门锁品牌近期发生了一起指纹识别失效事件,导致用户无法正常使用门锁。
经过失效分析,发现指纹识别模块中的芯片存在质量问题,导致识别准确率下降。
这一案例提醒我们,在产品设计和生产过程中,必须关注关键零部件的质量,确保产品的稳定性和可靠性。
最新失效分析经典案例分享案例四:某品牌空调制冷效果不佳事件某品牌空调近期被用户投诉制冷效果不佳,经过详细的失效分析,发现空调制冷系统中的冷凝器存在制造缺陷,导致制冷剂泄漏,影响了空调的制冷效果。
这一案例提醒我们,在产品设计和生产过程中,必须重视冷凝器等关键部件的质量,确保空调的制冷效果。
案例五:某品牌笔记本电脑触摸屏失灵事件某品牌笔记本电脑近期发生了一起触摸屏失灵事件,导致用户无法正常使用触摸屏功能。
经过失效分析,发现触摸屏的传感器存在设计缺陷,导致触摸信号无法正常传输。
这一案例警示我们,在产品设计和生产过程中,必须关注触摸屏等关键部件的可靠性,确保产品的使用体验。
案例六:某品牌洗衣机漏水事件某品牌洗衣机近期发生了一起漏水事件,导致用户家中地面受损。
经过失效分析,发现洗衣机的排水系统存在设计缺陷,导致排水不畅,进而引发漏水。
这一案例提醒我们,在产品设计和生产过程中,必须关注排水系统等关键部件的设计,确保产品的使用安全。

电子元器件失效分析技术与案例费庆学二站开始使用电子器件当时电子元器件的寿命20h.American from 1959 开始:1。
可靠性评价,预估产品寿命2。
可靠性增长。
不一定知道产品寿命,通过方法延长寿命。
通过恶裂环境的试验。
通过改进提高寿命。
―――后来叫a.可靠性物理—实效分析的实例 b.可靠数学第一部分:电子元器件失效分析技术(方法)1.失效分析的基本的概念和一般程序。
A 定义:对电子元器件的失效的原因的诊断过程b.目的:0000000c.失效模式――》失效结果――》失效的表现形式――》通过电测的形式取得d.失效机理:失效的物理化学根源――》失效的原因1)开路的可能失效机理日本的失效机理分类:变形变质外来异物很多的芯片都有保护电路,保护电路很多都是由二极管组成正反向都不通为内部断开。
漏电和短路的可能的失效机理接触面积越小,电流密度就大,就会发热,而烧毁例:人造卫星的发射,因工人误操作装螺丝时掉了一个渣于继电器局部缺陷导致电流易集中导入产生热击穿(si 和al 互熔成为合金合金熔点更低)塑封器件烘烤效果好当开封后特性变好,说明器件受潮或有杂质失效机理环境应力:温度温度过低易使焊锡脆化而导致焊点脱落。
,2.失效机理的内容I失效模式与环境应力的关系任何产品都有一定的应力。
a当应力>强度就会失效如过电/静电:外加电压超过产品本身的额定值会失效b应力与时间应力虽没有超过额定值,但持续累计的发生故:如何增强强度&减少应力能延长产品的寿命c.一切正常,正常的应力,在时间的累计下,终止寿命特性随时间存在变化e机械应力如主板受热变形对零件的应力认为用力塑封的抗振动好应力好陶瓷的差。
f重复应力如:冷热冲击是很好的零件筛选方法重复应力易导致产品老化,存在不可靠性故使用其器件:不要过载;温湿度要适当II如何做失效分析例:一个EPROM在使用后不能读写1)先不要相信委托人的话,一定要复判。
2)快始失效分析:取NG&OK品,DataSheet,查找电源断地开始测试首先做待机电流测试(IV测试)电源对地的待机电流下降开封发现电源端线中间断(因为中间散热慢,两端散热快,有端子帮助散热)因为断开,相当于并联电阻少了一个电阻,电流减小。



电子元器件失效分析技术第一讲失效物理的概念失效的概念失效定义1 特性剧烈或缓慢变化2 不能正常工作失效种类1 致命性失效:如过电应力损伤2 缓慢退化:如MESFE的T IDSS下降3 间歇失效:如塑封器件随温度变化间歇失效失效物理的概念定义:研究电子元器件失效机理的学科失效物理与器件物理的区别失效物理的用途失效物理的定义定义:研究电子元器件失效机理的学科失效机理:失效的物理化学根源举例:金属电迁移金属电迁移失效模式:金属互连线电阻值增大或开路失效机理:电子风效应产生条件:电流密度大于10E5A/cm2高温纠正措施:高温淀积,增加铝颗粒直径,掺铜,降低工作温度,减少阶梯,铜互连、平面化工艺失效物理与器件物理的区别撤销应力后电特性的可恢复性时间性失效物理的用途1 失效分析:确定产品的失效模式、失效机理,提出纠正措施,防止失效重复出现2 可靠性评价:根据失效物理模型,确定模拟试验方法,评价产品的可靠性可靠性评价的主要容产品抗各种应力的能力产品平均寿命失效物理模型应力-强度模型失效原因:应力>强度强度随时间缓慢减小如: 过电应力(EOS)、静电放电(静电放电ESD)、闩锁(latch up)应力-时间模型(反应论模型)失效原因:应力的时间累积效应,特性变化超差。
如金属电迁移、腐蚀、热疲劳应力一强度模型的应用器件抗静电放电(ESD能力的测试温度应力-时间模型EdM Ae- kT dtT高,反应速率大,寿命短E大,反应速率小,寿命长温度应力的时间累积效应-EM t- M0 Ae- kT( - t0) t失效原因:温度应力的时间累积效应,特性变化超差与力学公式类比-E M t - M 0 Ae - kT( - t 0 ) tmv t- mv 0F (- tdM dtE Ae -kTdv dtt 0)失效物理模型小结应力-强度模型与断裂力学模型相似,不考虑激活能和时间效应,适用于偶然失效和致命性失效,失效过程短,特性变化快,属剧烈变化,失效现象明显应力-时间模型(反应论模型)与牛顿力学模型相似,考虑激活能和时间效应,适用于缓慢退化,失效现象不明显应力-时间模型的应用:预计元器件平均寿命1求激活能EA exp(kTln L ln L1E kT E kT 1ln L 2EkT 2Ln L2Ln L1B预计平均寿命的方法2 求加速系数FL2L1AL1A exp( ))kT2kT1A exp( L )F E 12 exp( ( -11))kTL 1 k T1 T2 1L2L1exp((11))T2T1预计平均寿命的方法由高温寿命L1推算常温寿命L2 F=L2/L1对指数分布L1=MTTF=1λ/ λ失效率失效率=试验时间失效的元件数初始时间未失效元件数试验时间温度应力-时间模型的简化:十度法则容:从室温算起,温度每升高10度,寿命减半。


电子产品失效分析大全继电器失效分析1、样品描述所送样品是3种继电器,其中NG样品一组15个,OK样品2组各15个,代表性外观照片见图1。
委托单位要求分析继电器触点的元素成分、各部件浸出物的成分,确认是否含有有机硅。
图1 样品的代表性外观照片2、分析方法2.1 接触电阻首先用毫欧计测试所有继电器A、B接点的接触电阻,A、B接点的位置见图2所示,检测结果表示NG样品B点的接触电阻均大于100 mΩ,而2种OK样品的A、B点的接触电阻均小于100 mΩ。
图2 样品外观照片2.2 SEM&EDS分析对于NG品,根据所测接点电阻的结果,选取B接点接触电阻值高的2个继电器,对于2种OK品,每种任选2个继电器,在不污染触点及其周围的前提下,将样品进行拆分后,用SEM&EDS分析拆分后样品的触点及周围异物的元素成分。
触点位置标示如图3所示。
所检3种样品共6个继电器的触点中,NG品的触点及触点周围检出大量的含碳(C)、氧(O)、硅(Si)等元素的异物,而OK品的触点表面未检出异物。
典型图片如图4、图5所示。
图3 触点位置标识(D指触点C反面)图4 NG样品触点周围异物SEM&EDS检测结果典型图片图5 OK样品触点的SEM&EDS检测结果典型图片2.3 FT-IR分析在不污染各部件的前提下,将2.2条款中剩下的继电器进行拆分,并将拆分后的部件分成3组,即A组(接点、弹片(可动端子、固定端子))、B组(铁片、铁芯、支架、卷轴)、C组(漆包线),分别将A、B、C组部件装入干净的瓶中,见图6所示,处理后用FT-IR分析萃取物的化学成分,确认其是否含有有机硅。
图6 拆分后样品的外观照片结果表明,所检3种样品各部件的萃取物中,NG样品B组(铁片、铁芯、支架、卷轴)和C 组(漆包线)检出有机硅,其他样品的部件未检出有机硅。
典型图片见图7所示。
图7 NG品C组部件萃取物与聚二甲基硅氧烷的红外吸收光谱比较图3、结论1)所检3种继电器样品中,NG品B接点的接触电阻均大于100mΩ,不符合要求;而OK品A、B接点的接触电阻及NG品A接点的接触电阻均小于100mΩ,符合要求;2)所检3种继电器(2个/种)的触点中,NG品的触点及触点周围检出大量的含碳(C)、氧(O)、硅(Si)等元素的异物,而OK品的触点表面未检出异物;3)所检3种继电器(13个/种)部件的萃取物中,NG品B组(铁片、铁芯、支架、卷轴)和C组(漆包线)检出有机硅,其他样品的部件未检出有机硅。
电子产品失效模式分析失效分析是一门发展中的新兴学科,近年开始从军工向普通企业普及,它一般根据失效模式和现象,通过分析和验证,模拟重现失效的现象,找出失效的原因,挖掘出失效的机理的活动。
在提高产品质量,技术开发、改进,产品修复及仲裁失效事故等方面具有很强的实际意义。
01、失效分析流程图1 失效分析流程02、各种材料失效分析检测方法1、PCB/PCBA失效分析PCB作为各种元器件的载体与电路信号传输的枢纽已经成为电子信息产品的最为重要而关键的部分,其质量的好坏与可靠性水平决定了整机设备的质量与可靠性。
图2 PCB/PCBA失效模式爆板、分层、短路、起泡,焊接不良,腐蚀迁移等。
常用手段无损检测:外观检查,X射线透视检测,三维CT检测,C-SAM检测,红外热成像表面元素分析:•扫描电镜及能谱分析(SEM/EDS)•显微红外分析(FTIR)•俄歇电子能谱分析(AES)•X射线光电子能谱分析(XPS)•二次离子质谱分析(TOF-SIMS)热分析:•差示扫描量热法(DSC)•热机械分析(TMA)•热重分析(TGA)•动态热机械分析(DMA)•导热系数(稳态热流法、激光散射法)电性能测试:•击穿电压、耐电压、介电常数、电迁移•破坏性能测试:•染色及渗透检测2、电子元器件失效分析电子元器件技术的快速发展和可靠性的提高奠定了现代电子装备的基础,元器件可靠性工作的根本任务是提高元器件的可靠性。
图3 电子元器件失效模式开路,短路,漏电,功能失效,电参数漂移,非稳定失效等常用手段电测:连接性测试电参数测试功能测试无损检测:•开封技术(机械开封、化学开封、激光开封)•去钝化层技术(化学腐蚀去钝化层、等离子腐蚀去钝化层、机械研磨去钝化层)•微区分析技术(FIB、CP)制样技术:•开封技术(机械开封、化学开封、激光开封)•去钝化层技术(化学腐蚀去钝化层、等离子腐蚀去钝化层、机械研磨去钝化层)•微区分析技术(FIB、CP)显微形貌分析:•光学显微分析技术•扫描电子显微镜二次电子像技术表面元素分析:•扫描电镜及能谱分析(SEM/EDS)•俄歇电子能谱分析(AES)•X射线光电子能谱分析(XPS)•二次离子质谱分析(SIMS)无损分析技术:•X射线透视技术•三维透视技术•反射式扫描声学显微技术(C-SAM)▍3、金属材料失效分析随着社会的进步和科技的发展,金属制品在工业、农业、科技以及人们的生活各个领域的运用越来越广泛,因此金属材料的质量应更加值得关注。
芯片失效分析范文芯片失效问题是电子产品中常见的一个技术难题。
对于芯片失效问题的分析,可以从多个角度进行,包括物理损坏、电路设计问题、材料质量问题等。
下面是一个关于芯片失效分析的范文,供参考。
芯片失效是指芯片在正常工作过程中出现故障或性能下降的现象。
对于芯片失效问题,首先需要进行全面的故障分析和排查。
理论上来说,芯片采用了多种技术手段进行故障检测和容错设计,但由于工艺的复杂性,芯片失效问题仍然难以完全避免。
首先,芯片失效问题可能与物理损坏有关。
过高的温度、电流、电压等因素可能导致芯片内部电路元件的物理损坏,进而导致芯片性能的下降或故障。
例如,芯片的金属线路或连接点可能出现开路、短路等问题;晶体管可能出现击穿、阻塞等问题;芯片承受不住外部的电磁辐射或机械冲击等,导致内部结构的损坏。
因此,在分析芯片失效时,可以通过物理检测手段,例如扫描电子显微镜、透射电子显微镜等,对芯片内部的物理结构进行观察和分析,以确定是否存在物理损坏现象。
其次,芯片失效问题还可能与电路设计有关。
电路设计的失误或不当可能导致芯片故障。
例如,电路的布线不合理导致信号干扰、电磁兼容性问题;设计的逻辑电路复杂度高,存在逻辑缺陷,导致芯片的功能出错;电源电路设计不合理,电压波动或噪声过大,影响芯片的正常工作等。
因此,在分析芯片失效时,需要对芯片的设计原理进行深入的分析,对电路设计的每个模块进行逐一检测,找出可能存在的问题,进而定位芯片失效的原因。
最后,芯片失效问题还可能与材料质量有关。
芯片中使用的材料质量直接影响着芯片的性能和寿命。
例如,IC芯片中使用的硅材料的纯度、掺杂浓度等对芯片的性能产生直接影响;金属材料的腐蚀腐蚀性、导电性等决定着芯片的可靠性等。
因此,分析芯片失效时,可以通过对芯片中材料的分析,例如扫描电子显微镜、能谱分析仪等,检测出芯片中存在的材料问题,进而确定芯片失效的原因。
综上所述,芯片失效分析需要从多个角度进行,包括物理损坏、电路设计问题、材料质量问题等。