PCB制造工艺流程(精)
- 格式:doc
- 大小:30.00 KB
- 文档页数:4
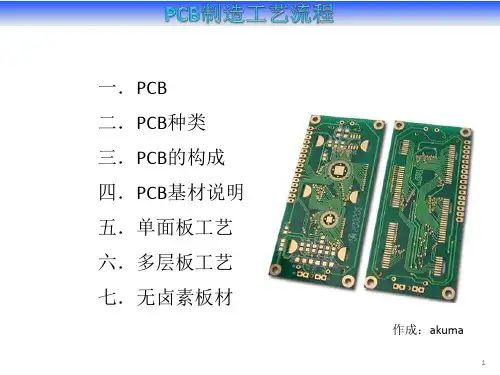

精心整理PCB 板制造工艺流程PCB 板的分类1、 按层数分:①单面板②双面板③多层板2、 按镀层工艺分:①热风整平板②化学沉金板③全板镀金板④热风整平+金手指3、 ⑤化学沉金+金手指4、 ⑥全板镀金+金手指5、 ⑦沉锡⑧沉银⑨OSP 板各种工艺多层板流程㈠热风整平多层板流程:开料——内层图像转移:(内层磨板、内层贴膜、菲林对位、曝光、显影、蚀刻、褪膜)——AOI ——棕化——层压——钻孔——沉铜——板镀——外层图像转移:(外层磨板、外层贴膜、菲林对位、曝光、显影、图镀、褪膜、蚀刻、褪锡)——丝印阻焊油墨————丝印阻——(外————(外墨——(W ——曝光、显影、蚀刻、褪膜)——AOI ——棕化——层压——钻孔——沉铜——板镀——外层图像转移:(外层磨板、外层贴膜、菲林对位、曝光、显影、图镀、褪膜、蚀刻、褪锡)——化学沉金——丝印字符——外光成像②(交货面积>1平方米)/贴蓝胶带(交货面积≤1平方米)——镀金手指——铣外形——金手指倒角——电测——终检——真空包装㈦单面板流程(热风整平为例):开料——钻孔——外层图像转移:(外层磨板、外层贴膜、菲林对位、曝光、显影、图镀、褪膜、蚀刻、褪锡)——AOI ——丝印阻焊油墨——阻焊图像转移:(菲林对位、曝光、显影)——丝印字符——热风整平——铣外形——电测——终检——真空包装(注:①因没有金属化孔,所以没有电测与沉铜板镀②外层线路菲林除全板镀金板用正片菲林外,其它都用负片)㈧双面板流程(热风整平为例):开料——钻孔——沉铜——板镀——外层图像转移:(外层磨板、外层贴膜、菲林对位、曝光、显影、图镀、褪膜、蚀刻、褪锡)——丝印阻焊油墨——阻焊图像转移:(菲林对位、曝光、显影)——丝印字符——热风整平——铣外形——电测——终检——真空包装(注:因一共两层,所以用电测代替了AOI)㈨OSP多层板流程:开料——内层图像转移:(内层磨板、内层贴膜、菲林对位、曝光、显影、蚀刻、褪膜)——AOI——棕化——层压——钻孔——沉铜——板镀——外层图像转移:(外层磨板、外层贴膜、菲林对位、曝光、显影、图镀、褪膜、蚀刻、褪锡)——丝印阻焊油墨——阻焊图像转移:(菲林对位、曝光、显影)——丝印字符——(二钻)——铣外形——OSP——终检——真空包装多层板流程的步骤、意义、作用、及注意事项,现以热风整平板+金手指为例。

PCB详细工艺流程介绍PCB(Printed Circuit Board,印刷电路板)是电子产品中常用的一种电路基板,其主要作用是支持和连接电子器件,并提供电气连接和机械支撑。
PCB的制造工艺是一个复杂的过程,包括设计、制图、加工、组装等多个环节。
下面我将详细介绍PCB的工艺流程。
首先,PCB的制造过程始于电路设计。
在设计过程中,工程师将根据电子产品的需求绘制出电路图,并确定所需的器件类型、布局和连接方式。
接下来,制图工程师将会使用CAD软件将电路图转化为PCB布局图。
布局图将定义PCB上各个电子器件的位置和布线的连接方式。
制图完成后,就进入了PCB加工的阶段。
PCB加工过程是将布局图转化为实际的印刷电路板。
首先,会将布局图进行放大,并打印到透明薄膜上。
这个薄膜被称为光绘制图(Artwork)。
接下来,将制作好的光绘制图放在覆铜板上,并将整个组合放入UV曝光机中进行曝光。
曝光的目的是使铜板上的覆盖了光绘制图的光敏感胶层暴露在UV光线下。
经过曝光的铜板将会进入腐蚀槽中,腐蚀液将会溶解暴露在光敏感胶层之外的铜层,以使电路板的形状与布局图相符合。
腐蚀完成后,将通过清洗去除残留的光敏感胶层和腐蚀液,然后使用钻孔机进行钻孔,以便为电子器件提供插针孔位。
钻孔完成后,使用金属化学沉积法在钻孔之内镀上薄铜层,以提高电路板的导电性能。
然后进行内层线路图的处理,这个过程包括覆铜板的涂覆、曝光、腐蚀和清洗等步骤。
接下来,将内层和外层线路图叠加到一起,通过热压技术将它们固定在一起并形成完整的印刷电路板。
然后进行冷镀锡处理,以保护线路图和提高导电性能。
经过冷镀锡处理后,将进行外层线路图的处理。
这个过程与内层线路图的处理类似,包括覆铜板的涂覆、曝光、腐蚀和清洗等步骤。
在线路图处理完成后,需要进行PCB的外围处理。
这包括切割成所需尺寸、打磨边缘、镜面处理等。
最后,进行电路板的组装和焊接。
在焊接过程中,需要将电子器件精确地安装到PCB上,然后通过炉热加热来实现焊接。


PCB制造各工艺流程详解1.电路设计电路设计是PCB制造的第一步,主要包括电路原理图设计和PCB版图设计。
初步确定电路的整体结构和连接方式,并将其转化为电路原理图。
然后,根据原理图设计PCB版图,确定各个元件的位置、布局、连接线路等。
2.元件采购与预处理在制造之前,需要采购元件并进行预处理。
元件的选择应根据电路设计的要求和元件的性能特点进行,可以通过下单、议价等方式采购。
预处理包括清洗、修整等,确保元件的质量和可用性。
3.PCB制版PCB制版是将PCB电路设计转化为实体的过程。
首先,将设计好的PCB版图按照比例放大到实际大小,并在光板上通过紫外线曝光将图形转移到光敏胶上。
然后,通过化学反应,将光敏胶上的图形转移到铜层上。
最后,通过蚀刻和清洗等步骤去除不需要的铜层,形成电路板的导电部分。
4.元件贴装元件贴装是将预处理过的元件按照设计好的位置进行安装的过程。
首先将PCB放置在贴装机上,然后自动或手动将元件精确定位到指定的位置。
贴装完成后,通过焊接技术将元件固定在PCB上。
5.焊接焊接是将元件与PCB电路板连接的过程,常用的焊接方法有插针焊接、表面焊接和波峰焊接等。
插针焊接是将元件引脚插入PCB的插孔中,并通过加热使焊点形成连接。
表面焊接是将元件的焊脚与PCB表面的焊盘直接连接,通过加热和焊料实现焊接。
波峰焊接是将PCB放置在流动的焊料波中,通过焊料的表面张力使焊点形成连接。
6.表面处理表面处理是对PCB表面进行处理,以增加PCB的耐腐蚀性和导电性。
常用的表面处理方法有镀金、镀锡和喷涂等。
镀金是在PCB表面覆盖一层金属,提高导电性。
镀锡是在PCB表面覆盖一层锡,增加耐腐蚀性。
喷涂是在PCB表面喷涂一层保护层,防止腐蚀和污染。
7.调试与测试8.包装与出货最后,将经过调试和测试的PCB进行包装和出货。
包装可根据客户要求进行,常用的包装方式有盒装、袋装和盘装等。
出货时要确保包装的完好性,以防止在运输过程中受到损坏。

PCB制作工艺流程一、开料目的:以制造流程单之规格,将大面积的敷铜泊基板依制前设计所规化的工作尺寸裁切尺寸及厚度发料并裁板。
1、裁板作业流程:仓库→裁板室→调整尺寸→裁板→检查测量2、磨边作业流程:设置长、宽→磨边→水洗一→水洗二→水洗三→挤干→吹干→烘干二、内层1、内层前处理目的:将除去板面氧化物及油污,再加磨刷粗化铜面增加感光材料于铜面的附著力。
作业流程:上板→化学清洗(H2SO4:3%~5%,压力:1.5±0.5㎏/C㎡)→溢流水洗(压力:1.5±0.5㎏/C㎡)→磨刷→中压水洗(压力:3.0±0.5㎏/C㎡)→微蚀刻(SPS:100~120g/1, H2SO4:1%~3%,压力:1.5±0.5㎏/C㎡)→溢流水洗(压力:1.5±0.5㎏/C㎡)→酸洗(H2SO4:1%~3%)→溢流水洗(压力:1.5±0.5㎏/C㎡)→烘干→检查注意事项:1、做板之前要做刷痕实验、水纹实验,刷痕宽度:1.0±0.2㎝,水纹:15秒以上;2、内层板厚分为两种:47mil的为普通基板,其他为特殊基板,特殊基板要做标记,还要测板厚;3、检查压力表;2、涂布目的:以抗蚀性材料附著力在铜面上,制作内层线路GND、VCC作业流程:进料→粘尘→下降→入料→涂布→烘烤(第一阶段:145℃;第二阶段:125℃;第三阶段:115℃;第四阶段:55℃;第五阶段:35℃) →出料→检查注意实项:1、粘尘纸200片后换一次;2、油墨刮刀压力调整(压力:1.0~3.0㎏/C㎡);3、检测膜厚(8.0±1.5mil),检查脏点等3、曝光(半自动曝光)目的:曝光灯发出紫外光投射在已贴有干膜的板面上,将曝光菲林上线路图形转移到感光干膜上,未吸紫外光的干膜显影时会溶解于显影液中作业流程:检查底片→架底片→调整对准度→放板→吸真空→曝光→检查注意事项:1、每天清洁机台,做能量测试;2、室内温度:22.0±2℃,湿度:55±5%;3、黑色底片每曝光2000次后报废,每曝光500次后底片检查;4、每曝光前用手动滚轮清洁一次底片,底片每曝光10片清洁一次,每50片上机检查一次;5、底片L2朝上,L3朝下;6、灯管亮到熄灭:12秒;7、抽真空度至少600~700MMHG;8、抽真空后用刮刀赶气;9、放板时,把底片翻开看到压条后,沿着压条放板,避免刮伤底片4、显影目的:显影是把尚未发生聚合反应的区域用显影液将之冲洗掉,已感光部分则因已发生聚合反应而洗不掉乃留在铜面上成为蚀刻之阻剂膜5、蚀刻目的:以蚀刻液将铜表面去除,留有抗蚀油墨之线路,制作内层线路GND、VCC 6、去墨剥膜目的:将线路上之抗蚀材料去掉,露出铜线路完成制作内层线路ND、VCC(4,5,6)工作流程:显影(温度:31.0±2℃;浓度:碳酸钠:1.0±0.2wt%,传送速度:4.0±0.5m/min;压力:1.75±0.25㎏/C㎡)→水洗(压力:1.5±0.3㎏/C㎡)→蚀刻(温度:40~45℃;传动速度:4.0±0.5m/min;喷压:上压3.0±0.5㎏/C㎡,下压2.8±0.5㎏/C㎡;铜含量:105~115g/l) →水洗(压力:1.5±0.3㎏/C㎡)→检查→软化去墨(温度:45~50℃;传动速度:4.5±0.5m/min;浓度:NaOH1.0~0.2%;去墨第一段0.1~0.2㎏/C㎡;去墨第二段0.5~0.2㎏/C㎡;去墨第三段1.5~0.2㎏/C㎡)→水洗→酸洗(温度:RT;压力:1.5±0.3㎏/C㎡,H2SO4浓度:1~3%)→水洗→烘干(温度:90.0±10℃)→检查→收板注意事项:1、每天退槽一次;2、有线路的板含有线路的板面朝上,没有线路的板不作要求;3、每天用报废板做显影、蚀刻实验,检查参数是否合格;4、检查压力表;5、每班换水一次;6、滤网每天清洗一次;7、检查喷嘴7、黑化处理工作流程:上料→碱性清洁(16″)→水洗(6″)→水洗(11″)→微蚀(8″)→水洗(1″)→水洗(5″)→预侵(6″)→黑化(15″)→热纯水洗(8″)→水洗(5″)→水洗(16″)→后侵(16″)→纯水洗(3″)→纯水洗(8″)→热纯水洗(16″)→滴干→烘干(35″)注意事项:1、开机前须检查各槽液位是否正常;2、插板时须一片一片的插;3、黑化好的板做首件、自主检查时需垂直向上取板且手指不能拿入单元内;4、黑化OK板预叠前所停放的时间不能超过一小时;5、生产的合格黑化板必须在24小时之内压合完毕,否则超过时间需要新烘烤或重工;6、卸板时需两手平行从飞靶上取出,轻放板上,防止动作不规范造成板面刮伤;7、检查黑化颜色均匀不均匀、漏不漏铜、刮伤、有没有烘干;8、HTG170以上只能在白班做;9、检查压力表;10、参数:微蚀35±2℃,室温32.8℃,黑化75±5℃,热水洗50±3℃,后侵28±5℃,热纯水洗50±3℃,烘干一:120±10℃,烘干二:120±10℃,烘干三:120±10℃,共用35分,清洁:50分8、棕化处理(TG150℃以上的不做棕化)作业流程:上料→酸洗(温度:30±5℃,浓度: 5±2%H2SO4,压力:上压1.5±0.2㎏/C㎡,下压1.5±0.2㎏/C㎡)→水洗(压力:上压1.0±0.2㎏/C㎡,下压1.0±0.2㎏/C㎡)→清洁(温度:50±2℃,压力:上压1.5~2.5㎏/C㎡,下压1.5~2.5㎏/C㎡,碱度:0.96±0.1N)→纯水洗(压力:上压1.0±0.2㎏/C㎡,下压1.0±0.2㎏/C㎡)→预侵(温度:30±3℃,强度:70~100%,酸度:0.06~0.12N,速度:3.6±0.2m/min)→棕化(温度:38~45℃,酸度:1.8~2.3N,CB2218A强度:90~120%,CB2218B强度:150±30%,H2O2:11.5±2g/l,CU2+<50g/l,微蚀量:40~80u″,速度:3.6±0.2m/min)→纯水洗(压力:上压1.0±0.2㎏/C㎡,下压1.0±0.2㎏/C㎡)→干燥1(温度:90±5℃)→干燥2(温度:90±5℃)→收板→检查注意事项:1、每天须做首件,检查各个参数是否合格;2、生产的合格棕化板必须在小时之内压合完毕;3、做完后,检查颜色均匀度、是否漏铜、是否刮伤;4、检查压力表;9、压合①、PP裁切工作流程:安装PP→调整刀具(上下间隙为0.08mm)→开机→长度设定(控制单位inch换mm,裁板尺寸依OP单规定)→速度设定→张数设定→加工作业(在更换裁切不同的TG材料前必须把机台上的粉尘清理干净后方可裁切)→手动部分→收料注意事项:1、温度:22±5℃,湿度:50±10℃;2、PP的经向、纬向一定要根据OP来裁切:3、裁切OK的PP可以静至一个月,超过时间不能用;4、裁切好的TG180℃PP用红色大字报表示,TG140℃的PP用白色大字报表示,TG150℃的PP用黄色大字报表示;5、裁好HTG的PP不能超过6小时;6、裁切首片,测量尺寸是否与OP单要求的尺寸相符;②、预叠(温度:20~18℃,湿度:55±5%)⑴、熔合(六层板或六层板以上)工作流程:开机(检查三点组合)→机台调整(检查定位pin位置是否于板的对位孔相重合)→参数设定→加工作业→关机⑵、铆合(六层板或六层板以上)工作流程:开机→机台调整→调整铆钉→加工作业→关机注意事项:1、预叠前,先看板是否有刮伤、颜色是否均匀等,方可叠合;2、熔合、铆合必须做首件,检查是否合格;3、熔合、铆合要求L2、L5朝外,L3、L4向里;4、隔2小时测量一次铆钉高度,铆钉高度的范围:1.27±0.2mm;5、熔合的温度不做限制,但是就好在340~360℃,时间:加光板的是30~33秒,其他的是22秒③、叠合(温度:22±2℃,湿度:60±5℃)工作流程:准备工作(铜箔、无尘纸、粘尘布、钢板)→清洁机台→检查铜箔→选择排版数→参数设定→叠板注意事项:1、读取工单叠合图所用铜箔规格、产商等,检查机台铜箔是否一致,否则更换;2、根据生产胺尺寸计算在钢板上的排版面积,排版所在钢板上的利用率尽可最大,在排版台上调整红外线固定排版位置或方向;3、根据SOP规定,生产板层数设定排版层数,排版总高度必须高于防滑块高度;4、把板放在红外线固定位置上,叠板时不能在叠台上齐板或抖动PP,叠板动作要轻快;5、六层板要求11叠,四层板12叠④、压合作业流程:开机→设立压合参数→上机→热压→冷压→下机注意事项:1、热板温度测试:180℃恒温10分钟状态,每个热盘取9点,使用感温探针直接测试;2、每6个月测试一次热板,正常热板温差为3.0℃±1.5℃;3、热盘平行度测试:①取直径3.0mm铅条,各热盘放置5根铅条并注意避开盘面滚珠依左右平均放置;②放置后以100psi压力压合10分钟;③取该热盘每一点值与该热盘所有点的平均值对比其差异值小于±0.03mm,否则进行维修,每年测试一次;4、热压真空度:700mmHg以上,热盘温度及压力:依附件之温度及压力设定;5、冷压系统压力设定:100~125㎏/C㎡(板面压力为85~105psi),时间:50min,冷压的降温速率为5℃/min下,冷压后板面的实际温度设定为53℃以下压合程式一览表:阶段T(℃)(±5℃)t(min)(±0.1min)P(psi)(±3psi)t(psi)(±0.1min)1 150 13 100 132 150 12 300 123 195 25 400 254 195 65 400 655 185 5 300 56 180 3 150 37 170 2 50 2 Total 125 125阶段T(℃)(±5℃)t(min)(±0.1min)P(psi)(±3psi)t(psi)(±0.1min)1 150 13 100 152 150 12 300 133 195 25 400 274 195 65 400 605 185 5 300 56 180 3 150 37 170 2 50 2Total 125 125压合程式执行完毕;②超出5分钟外来电时,将压合板取出,把表面PP及铜箔撕掉,再做一次黑化制程,后续正常作业(注:1、黑化制程不能做微蚀处理;2、只能适用于无阻抗控制板子)压合扳子取出→PP及铜箔撕掉→黑化→后续正常作业2、在压合程式第二阶段时停电停机因此时PP的树脂开始融化流动,有大量气泡存在不能重工3、在压合程式第三阶段(高压段)时停电停机①在压合程式第三阶段(高压段上压1~50分钟)时停电停机,因此时PP的树脂开始融化流程,有大量气泡存在不能重工②在压合程式第三阶段(高压段上压50分钟以上)时停电停机,此时树脂已固化,保证足够固化时间即可来电后接着该压合程式执行,下压后须测TG值、热冲击爆实验、介质厚度测试,判定是否合格10、裁切→捞边→铣靶→钻靶→磨边①磨边作业流程:开机→送板→磨边(根据不同板厚调整刀具的位置每次更换刀具后应做一次对应位置检测,进给量每边磨掉0.5mm左右即可)→洗板(传输速度:5.5±0.5m/min,水洗压力:第一段1.0±0.5㎏/C㎡,第二段1.5±0.5㎏/C㎡,第三段1.0±0.5㎏/C㎡)→烘干→收板11、钻孔多层板作业流程:钻孔工具准备→程式输入→裁定位PIN→上料→钻孔作业→下机台检验→刷磨去毛头双面板作业流程:磨板边→上PIN→钻孔工具准备→程式输入→上料→钻孔作业→下PIN→下机台检验→刷磨去毛头注意事项:1、核对OP,所取钻头是否合乎OP上之尺寸;2、检查钻头条件:进刀速、转速、孔限数设定,这些参数根据钻针大小、材质来设定的;3、打PIN (PIN直径:0.123″,深度12.5mm);4、铝垫板必须能涵盖所有的孔,以免断针;5、孔径15.7mil以下(﹤1.5mil),钻孔片数双面板2片,4-10层板2片;孔径15.7mil以上(≧15.7mil),钻孔片数双面板3片,4-6层板3片,8-10层板2片;6、钻孔前要空跑孔数,确认无误;7、胶带距离板边小于0.8cm;8、冰水机温度:19±2℃;9、喷锡板使用手推磨机600﹟,化金板、化银板、OSP 板、金手指板使用800﹟~1000﹟;10、检查备针是否备错,测量大小;11、钻孔、刷磨完后,用X-RAY孔位检查机检查是否钻偏;12、温度:22~25℃,湿度:45~50%;13、检查铝片上的压痕,确认压力角是否水平重工流程:检查并输入钻孔程式→上料→找孔→下料→检查①因停电、停气、断针等造成的漏孔、孔未钻透的板子检查后按照重工流程重工②因用错针造成孔小的板须重工12、去胶渣与化学铜目的:钻孔中造成高温产生胶渣黏于内层铜箔上,此胶渣会造成内层OPEN,所以要去胶渣工作流程:上板→酸洗(压力:1.0±0.2㎏/C㎡,H2SO4:3~5%)→水洗(压力:1.7±0.3㎏/C㎡)→刷磨(刷痕:1.0±0.2cm,电流:2.8±0.5A)→水洗(压力:1.7±0.3㎏/C㎡)→高压水洗(38±2㎏/C㎡)→超音波水洗(温度:40±5℃,电流:2.5±0.2A)→水洗(压力:1.7±0.3㎏/C㎡)→烘干(温度:75±5℃)→收板注:传动速度:3.5±0.5m/min;刷磨完成后的板子,须于12小时内完成一铜电镀作业13、一铜线工作流程:上架(抽样方式检视板子是否有严重凹陷及刮伤)→膨胀剂(Normal FR-4 材料:温度67~73℃,强度:10~16%;HTG材料:温度72~80℃,强度:13~16%,NaOH浓度:0.75~1.1N)→高锰酸钾(Normal FR-4 材料:温度72~78℃;HTG材料:温度76~80℃,NaOH浓度:1.0~1.4N,KmnO4浓度:45~65g/L,Mn6+:须保持在25g/L以下)→预中和(H2SO4浓度:2~4%,H2O2浓度:1.0~2%)→中和(温度:42~46℃)→碱性清洁(温度:47~51℃,碱当量:0.012~0.018N)→微蚀(温度:25~30℃,H2O2浓度:2~5%,SPS浓度:40~70g/L,CU﹥25g/L更槽)→预侵(温度:28~32℃,比重:1.100~1.1600,CU:少于1500PPM)→活化(温度:42~46℃,强度:70~100%,氯化亚钾﹥3g/L,比重:1.140~1.1820,CU:少于2000PPM,铁:少于100PPM)→化学铜(温度:30~36℃,CU2+:1.7~2.3g/L,NaOH:9.0~13g/L,甲醛浓度:3~5g/L,EDTA浓度:25~30g/L)→酸侵(H2O2浓度:100~120ml/L)→镀铜(温度:20~30℃,电流密度:14±2ASF,CuSO4.5H2O浓度:60~80g/L,H2SO4浓度:100~120ml/L,HCL浓度:40~80PPM,EP1100B-2:0.7~3.0ml/L,EP1100C-2:2.8~17ml/L)→烘烤(温度控制:95±5℃,速度:4.5±0.5m/min)→下架注意事项:1、每班分析膨胀剂后在添加,每周更换滤芯,每生产84万平方尺换槽;2、高锰酸钾槽,电流控制在1500±50A,不生产时控制在1000±50A,每生产100万平方尺后换槽;3、中和槽每生产15万平方尺后换槽;4、碱性清洁槽每生产6.7万平方尺后换槽;5、预侵槽每生产30万平方尺换槽;6、活化槽每日槽液浓度分析后添加,滤芯2周换一次,每一年换槽一次或CU﹥2000PPM换槽;7、化学铜槽每天依分析后添加,控制在14 ~26 ,每天二次试验控制在8-10级;8、镀铜槽:阳极铜块每星期检视、添加一次一年更换一次,每周做一次Hull Cell试验,每周分析一次槽液,每次分析后添加。


pcb的制造工艺
PCB的制造工艺是将电路图设计转化为实际的电路板的过程。
它涉及到许多步骤,包括设计、印刷、钻孔、电镀、蚀刻、掩膜、喷锡、组装等等。
首先,设计者需要使用CAD软件完成电路图的设计,包括电路连接、元器件位置和尺寸等等。
设计完成后,电路图将被转换成Gerber文件格式,并发送到PCB制造商的生产线。
然后,PCB制造商会通过印刷技术在铜箔覆盖的玻璃纤维板上印上电路图的反面。
然后,在所需的位置钻孔,以便在上面安装元器件。
接下来是电镀过程。
这是为了保证板子表面与元器件之间的连接性。
PCB板被放入铜盐水溶液中,使铜离子在板子的表面沉积。
这样就可以形成一个可靠的导电层来连接元件。
然后是蚀刻过程。
刻蚀液会去除不需要的铜箔,只留下电路图上需要的导线。
接下来是掩膜。
掩膜是一种保护层,用于保护PCB 电路板上不需要喷上锡的区域。
最后,喷锡和组装。
锡涂层有助于焊接元件,并且可以提高PCB板的抗腐蚀性。
在板子上安装元器件后,进行测试和调试,最终形成一个完整的电路板。
以上就是PCB制造工艺的基本流程。
在这个流程中,每一步都必须精密而准确,以确保最终产品的质量和性能。
- 1 -。

PCB板制造工艺流程PCB板的分类1、按层数分:①单面板②双面板③多层板2、按镀层工艺分:①热风整平板②化学沉金板③全板镀金板④热风整平+金手指3、⑤化学沉金+金手指4、⑥全板镀金+金手指5、⑦沉锡⑧沉银⑨OSP板各种工艺多层板流程㈠热风整平多层板流程:开料-—内层图像转移:(内层磨板、内层贴膜、菲林对位、曝光、显影、蚀刻、褪膜)—-AOI——棕化——层压—-钻孔——沉铜—-板镀——外层图像转移:(外层磨板、外层贴膜、菲林对位、曝光、显影、图镀、褪膜、蚀刻、褪锡)——丝印阻焊油墨—-阻焊图像转移:(菲林对位、曝光、显影)——丝印字符——热风整平——铣外形-—电测——终检-—真空包装㈡热风整平+金手指多层板流程:开料——内层图像转移:(内层磨板、内层贴膜、菲林对位、曝光、显影、蚀刻、褪膜)--AOI—-棕化——层压—-钻孔—-沉铜——板镀--外层图像转移:(外层磨板、外层贴膜、菲林对位、曝光、显影、图镀、褪膜、蚀刻、褪锡)—-丝印阻焊油墨——阻焊图像转移:(菲林对位、曝光、显影)——镀金手指—-丝印字符——热风整平-—铣外形——金手指倒角——电测—-终检——真空包装㈢化学沉金多层板流程:开料-—内层图像转移:(内层磨板、内层贴膜、菲林对位、曝光、显影、蚀刻、褪膜)--AOI——棕化-—层压——钻孔-—沉铜——板镀——外层图像转移:(外层磨板、外层贴膜、菲林对位、曝光、显影、图镀、褪膜、蚀刻、褪锡)-—丝印阻焊油墨—-阻焊图像转移:(菲林对位、曝光、显影)-—化学沉金-—丝印字符——铣外形-—电测——终检——真空包装㈣全板镀金板多层板流程:开料——内层图像转移:(内层磨板、内层贴膜、菲林对位、曝光、显影、蚀刻、褪膜)——AOI——棕化——层压-—钻孔—-沉铜——板镀——外层图像转移:(外层磨板、外层贴膜、菲林对位、曝光、显影、图镀镍金、褪膜、蚀刻、褪锡)—-丝印阻焊油墨-—阻焊图像转移:(菲林对位、曝光、显影)—-丝印字符-—铣外形——电测—-终检—-真空包装(全板镀金板外层线路不补偿)㈤全板镀金+金手指多层板流程:开料——内层图像转移:(内层磨板、内层贴膜、菲林对位、曝光、显影、蚀刻、褪膜)——AOI——棕化——层压-—钻孔-—沉铜—-板镀——外光成像①(外层磨板、外层贴膜、菲林对位、曝光、显影)—-图形电镀铜—-镀镍金——外光成像②(W—250干膜)——镀金手指—-褪膜——蚀刻—-丝印阻焊油墨——阻焊图像转移:(菲林对位、曝光、显影)——镀金手指——丝印字符——铣外形——金手指倒角—-电测——终检——真空包装㈥化学沉金+金手指多层板流程:开料—-内层图像转移:(内层磨板、内层贴膜、菲林对位、曝光、显影、蚀刻、褪膜)——AOI—-棕化——层压——钻孔——沉铜—-板镀——外层图像转移:(外层磨板、外层贴膜、菲林对位、曝光、显影、图镀、褪膜、蚀刻、褪锡)—-化学沉金——丝印字符-—外光成像②(交货面积>1平方米)/贴蓝胶带(交货面积≤1平方米)—-镀金手指-—铣外形-—金手指倒角——电测——终检—-真空包装㈦单面板流程(热风整平为例):开料—-钻孔——外层图像转移:(外层磨板、外层贴膜、菲林对位、曝光、显影、图镀、褪膜、蚀刻、褪锡)——AOI——丝印阻焊油墨—-阻焊图像转移:(菲林对位、曝光、显影)-—丝印字符——热风整平—-铣外形--电测-—终检——真空包装(注:①因没有金属化孔,所以没有电测与沉铜板镀②外层线路菲林除全板镀金板用正片菲林外,其它都用负片)㈧双面板流程(热风整平为例):开料——钻孔——沉铜——板镀—-外层图像转移:(外层磨板、外层贴膜、菲林对位、曝光、显影、图镀、褪膜、蚀刻、褪锡)——丝印阻焊油墨——阻焊图像转移:(菲林对位、曝光、显影)-—丝印字符——热风整平--铣外形-—电测-—终检—-真空包装(注:因一共两层,所以用电测代替了AOI)㈨OSP多层板流程:开料——内层图像转移:(内层磨板、内层贴膜、菲林对位、曝光、显影、蚀刻、褪膜)——AOI——棕化--层压——钻孔——沉铜—-板镀--外层图像转移:(外层磨板、外层贴膜、菲林对位、曝光、显影、图镀、褪膜、蚀刻、褪锡)——丝印阻焊油墨——阻焊图像转移:(菲林对位、曝光、显影)——丝印字符——(二钻)—-铣外形——OSP——终检——真空包装多层板流程的步骤、意义、作用、及注意事项,现以热风整平板+金手指为例。

pcb加工工艺流程
《PCB加工工艺流程》
PCB(Printed Circuit Board)是印刷电路板的缩写,是一种用于支持和连接电子组件的基板。
PCB加工工艺流程是指将设计好的电路图转化为实际的电路板的整个制造过程。
下面将介绍一下常见的PCB加工工艺流程。
1. 原材料准备: PCB加工的原材料主要包括基板、覆铜箔、匹配料、耐热型科技等。
其中基板是PCB的主体材料,而覆铜箔则是用于制作导线的材料。
2. 图纸设计:在PCB加工工艺流程中,首先需要进行电路图设计。
这个过程包括原理图、PCB布线、电路元件布局、封装库等。
3. 制造工艺:制造过程主要包括拼板、工艺、成型、外形、符合度、表面处理、印字、成型等。
4. 加工工艺:加工工艺是指经过图纸设计完成后,通过化学方法将所需的图形铺展在基板上,再使用镀铜、光刻、蚀刻、去膜、穿孔等工艺加工步骤将所需的电路图形形成在基板上。
5. 终端工艺:终端工艺是指将PCB加工完成的电路板进行部分成型、装配,使得其形成完整的PCB板。
以上就是关于PCB加工工艺流程的介绍,通过这个过程,可
以将设计好的电路图转化为实际的电路板,为电子产品的制造提供了基础保障。

PCB工艺流程及建厂要求PCB(Printed Circuit Board)是一种用于连接和支持电子元件的载体。
它在电子设备中起到了极其重要的作用,因此PCB的制造工艺流程和建厂要求非常重要。
下面将详细介绍PCB工艺流程和建厂要求。
一、PCB工艺流程1.设计:PCB的制造首先需要进行设计,包括电路图设计和PCB布局设计。
电路图设计是指根据电子设备的功能要求,绘制电路图,并进行电路分析和模拟。
PCB布局设计是指根据电路图设计的结果,将各个元件的位置进行布局,确定元件之间的连接关系和走线规划。
2.印制:印制是将设计好的电路图通过特殊的印刷设备,将电路图上的导线和元件图案印制到PCB基板上。
印制过程中需要使用特殊的蚀刻液将不需要的部分蚀刻掉,形成导线和元件图案。
3.钻孔:钻孔是指在PCB基板上钻孔,为元件的安装和焊接提供孔位。
钻孔的精度和孔位的准确性对于PCB的质量和稳定性非常重要。
4.电镀:电镀是将PCB基板表面涂上一层金属,通常是铜。
电镀的目的是增加PCB基板的导电性能,并保护导线和元件图案。
5.掩膜:掩膜是指在PCB基板上涂覆一层保护层,通常是绿色的光敏胶。
掩膜的作用是保护PCB基板上的导线和元件,防止受到外界环境的影响。
6.制版:制版是将PCB基板切割成所需的尺寸和形状。
制版的精度和切割的准确性对于PCB的最终性能和可靠性非常重要。
7.清洗和检测:最后,PCB制造完成后需要进行清洗和检测。
清洗是为了去除制造过程中产生的污垢和残留物,确保PCB的整洁。
检测是为了确保PCB的质量和可靠性,包括导线和元件的连接性能、PCB基板的绝缘性能等。
二、建厂要求1.地理位置:建立PCB制造厂需要选择适宜的地理位置,考虑到交通便利、供电和供水条件、环境污染等因素。
同时,还需要考虑到与供应商和客户的距离,以便于物流和交流。
2.设备和设施:建立PCB制造厂需要购买适当的设备和设施,包括印刷设备、蚀刻设备、钻孔设备、电镀设备、掩膜设备、制版设备等。
PCB工程的制作PCB(Printed Circuit Board)工程制作是电子技术中非常重要的一环,它通过设计和制造电子电路的载体,为电子产品的功能实现提供支持。
下面将详细介绍PCB工程制作的过程及相关技术。
一、PCB工程制作的流程1.原理图设计:根据电路的需求,制定电路的原理图。
在设计中需要考虑电路的功能实现,电路之间的连接方式,以及电源、地线的布局等。
2.PCB布局设计:将电路原理图转换为PCB板的布局。
首先根据电路元件和连接的需求确定PCB板的尺寸,然后在PCB板上放置电路元件,根据元件之间的连接关系进行布线,同时考虑布局的紧凑性和辐射噪声的抑制。
3.路线布线设计:根据布局设计好的PCB板,进行具体的线路布线设计。
按照电路原理图中元件之间的连接关系,在PCB板上绘制出连接线路。
要考虑信号传输的速度、稳定性和抗干扰等因素,避免布线冲突和交叉干扰。
4.元件布局设计:在完成布线设计后,重新进行元件布局调整,主要是根据布线的情况,调整元件的位置,以提高布线的效果。
5.元件库设计:制定PCB板所需元件的库,包括封装库和符号库。
封装库是描述元件的物理外观和引脚布线情况,符号库是描述元件的电路符号和编码。
6.PCB板制造:根据布局和布线的设计文件,进行PCB板的制造。
制造过程包括制版、镀铜、蚀刻、打孔、焊接和测试等步骤。
7.元件安装:将元件按照布局设计好的位置进行安装。
通过手工或自动化设备精确地将元件安装在PCB板上。
8.焊接连接:使用焊锡将元件与PCB板相连接,形成电路的物理连接。
焊接可以手工进行,也可以使用自动化设备。
9.测试与调试:对安装好的PCB板进行测试和调试,确保电路的功能正常和稳定。
测试包括电路测量、信号波形分析、功能验证等。
10.封装与包装:经过测试和调试后,将PCB板进行封装和包装。
根据产品的需求,选择适当的封装材料,如塑料、金属等,对PCB板进行包装。
二、PCB工程制作的技术要点1.PCB布局设计:在进行PCB布局设计时,要合理安排电路元件的位置,以缩短信号路径,减小电磁辐射和干扰。
PCB板生产工艺和制作流程详解1. 设计:PCB板的设计是整个制作流程的第一步。
设计师根据电路原理图进行PCB板的布线设计,确定电子元件的安装位置和连接方式。
2. 确定材料:根据设计要求,确定PCB板的基板材料。
常用的基板材料有FR-4玻璃纤维胶片、铝基板、陶瓷基板等。
3. 印制电路:在基板上通过化学腐蚀或机械加工的方法,将设计好的电路图案印制到基板表面。
这一步通常使用光刻技术,将电路图案转移到光刻胶上,然后在化学溶液中去除未曝光的部分。
4. 镀金属化:PCB板上的电路图案通常需要镀上一层金属,以增加导电性。
通常使用的金属化方法包括电镀、喷镀等。
5. 安装元件:在PCB板上进行元件的安装,通常采用表面贴装技术(SMT)或插件式焊接技术。
6. 焊接:通过波峰焊接、回流焊接或手工焊接等方法,将元件与PCB板焊接在一起。
7. 清洗和检验:清洗焊接后的PCB板,去除残留的焊膏和污垢。
然后进行电测试和可视检查,确保PCB板的质量。
8. 包装:对已经检验合格的PCB板进行包装,便于运输和存储。
PCB板的生产工艺和制作流程是复杂而精细的,每一个步骤都需要高度的专业知识和技术。
随着电子技术的发展,PCB板的制作工艺也在不断地更新和完善,以适应更多样化的电子产品需求。
PCB板(Printed Circuit Board)是一种用于支撑和连接电子元件的导电板。
PCB板是现代电子设备中必不可少的部分,它们被广泛应用于手机、计算机、汽车电子、医疗设备等各个领域。
生产PCB板的工艺和制作流程包括以下几个步骤:1. 设计:PCB板的设计是整个制作流程的第一步。
设计师根据电路原理图进行PCB板的布线设计,确定电子元件的安装位置和连接方式。
设计师需要考虑电路的复杂度、电路板的尺寸以及元件的布局等因素,以确保电路的性能和可靠性。
2. 确定材料:根据设计要求,确定PCB板的基板材料。
常用的基板材料有FR-4玻璃纤维胶片、铝基板、陶瓷基板等。
PCB制造工艺流程PCB(Printed Circuit Board,印刷电路板)是电子产品中的重要组成部分,主要用于支持电子组件之间的连线与固定。
制造PCB的工艺流程包括原料准备、印刷制作、电镀处理、化学蚀刻、清洗处理、钻孔加工、镀金等步骤。
下面将详细介绍PCB的制造工艺流程。
第一步:原料准备PCB板的主要原料包括玻璃纤维布、铜箔、表面处理剂、热固性环氧树脂等。
在制造开始前,需要准备好这些原料以供后续工艺使用。
第二步:印刷制作在玻璃纤维布上涂覆一层胶漆,然后将铜箔铺在胶漆上,并将其压合成复合板。
接下来,使用特定的光刻胶涂覆表面,并通过掩膜显影技术将所需电路图案留在PCB上。
最后,在设备的控制下,经过高温烘烤,使PCB与铜箔层牢固粘合。
第三步:电镀处理在电荷的作用下,将铜离子沉积在PCB插入设备中的铜箔上,使其增厚。
这个电镀层起到连接电路的作用,并提供电子元件接触的基础。
第四步:化学蚀刻使用化学蚀刻液来清除多余的铜箔,使纸浆板上只剩下需要的电路线。
而覆盖了光刻胶的部分则不受影响,形成所需的电路图案。
第五步:清洗处理将蚀刻后的PCB板放入清洗槽中进行清洁处理,以去除残留的光刻胶及化学蚀刻液。
清洗完成后,将板材经过烘烤处理以去除水分。
第六步:钻孔加工在PCB板上使用数控钻床进行钻孔加工,以形成电子元件插入的孔位。
同时,需要根据电路图纸上的规格进行定位,确保孔位的准确性。
第七步:镀金在钻孔后,需要给PCB板的插孔和焊盘镀金。
这是为了提高插头与插座的接触性能,避免氧化等问题。
镀金可以采用化学镀金或电镀金等不同技术。
以上就是PCB制造的主要工艺流程。
在实际制造过程中,还需要进行多次的检测与质量控制,以确保PCB产品的质量稳定可靠。
尽管PCB制造工艺流程较为复杂,但借助先进的设备与技术,可以高效地完成PCB的制造。
PCB作为电子产品的核心组件之一,其质量和稳定性对整个产品的正常运行具有重要影响。
因此,在PCB制造过程中,各个步骤都需要严格把控,确保产品能够完美地满足设计要求。
集成电路板生产工艺流程下载温馨提示:该文档是我店铺精心编制而成,希望大家下载以后,能够帮助大家解决实际的问题。
文档下载后可定制随意修改,请根据实际需要进行相应的调整和使用,谢谢!并且,本店铺为大家提供各种各样类型的实用资料,如教育随笔、日记赏析、句子摘抄、古诗大全、经典美文、话题作文、工作总结、词语解析、文案摘录、其他资料等等,如想了解不同资料格式和写法,敬请关注!Download tips: This document is carefully compiled by theeditor. I hope that after you download them,they can help yousolve practical problems. The document can be customized andmodified after downloading,please adjust and use it according toactual needs, thank you!In addition, our shop provides you with various types ofpractical materials,such as educational essays, diaryappreciation,sentence excerpts,ancient poems,classic articles,topic composition,work summary,word parsing,copy excerpts,other materials and so on,want to know different data formats andwriting methods,please pay attention!集成电路板(PCB,Printed Circuit Board)生产是现代电子制造业的基础工艺之一。
PCB工程制作 202.112.10.37目前汉化最深的补丁.解压密码a href= target=_a用过”pads importer”的朋友相信遇到过,转换protel pcb后,敷铜规则自动丢失,只剩敷铜区域外边框,这个问题的确很头疼。
暂时没有找到什么很好的方法去import pads中的敷铜形状,以下方法只是通过protel中的rule去做到pads中敷铜形状相同。
?敷铜与Outline的间距设置方法:选择“Design->Rules->Routing->Clearance Constraint”,点“add”添加,A区设置“Object Kind->Polygons”,B区设置“Object Kind->Keep-Out”,填写距离,并选择“Any Net”。
?敷铜与SMD焊盘的间距设置方法:除B区步骤同上,B区设置“Object-Kind->Smd Pad”。
?敷铜与过孔焊盘的间距设置方法:除AB区步骤同上,A区填写“Component Class->All Components”,B区填写“Object Kind->Polygons”。
在Rules设置完毕后,会DRC检查,速度比较慢,直接按ESC就可以。
最后在敷铜区域双击,选择相应的层,如“Polygon on Top”,点击OK按钮后会提示Rebuild,确定即可。
一、PCB制造工艺流程:一>、菲林底版。
菲林底版是印制电路板生产的前导工序,菲林底版的质量直接影响到印制板生产质量。
在生产某一种印制线路板时,必须有至少一套相应的菲林底版。
印制板的每种导电图形(信号层电路图形和地、电源层图形)和非导电图形(阻焊图形和字符)至少都应有一张菲林底片。
通过光化学转移工艺,将各种图形转移到生产板材上去。
菲林底版在印制板生产中的用途如下:图形转移中的感光掩膜图形,包括线路图形和光致阻焊图形。
网印工艺中的丝网模板的制作,包括阻焊图形和字符。
机加工(钻孔和外型铣)数控机床编程依据及钻孔参考。
随着电子工业的发展,对印制板的要求也越来越高。
印制板设计的高密度,细导线,小孔径趋向越来越快,印制板的生产工艺也越来越完善。
在这种情况下,如果没有高质量的菲林底版,能够生产出高质量的印制电路板。
现代印制板生产要求菲林底版需要满足以下条件:菲林底版的尺寸精度必须与印制板所要求的精度一致,并应考虑到生产工艺所造成的偏差而进行补偿。
菲林底版的图形应符合设计要求,图形符号完整。
菲林底版的图形边缘平直整齐,边缘不发虚;黑白反差大,满足感光工艺要求。
菲林底版的材料应具有良好的尺寸稳定性,即由于环境温度和湿度变化而产生的尺寸变化小。
双面板和多层板的菲林底版,要求焊盘及公共图形的重合精度好。
菲林底版各层应有明确标志或命名。
菲林底版片基能透过所要求的光波波长,一般感光需要的波长范围是3000--4000A。
以前制作菲林底版时,一般都需要先制出照相底图,再利用照相或翻版完成菲林底版的制作。
今年来,随着计算机技术的飞速发展,菲林底版的制作工艺也有了很大发展。
利用先进的激光光绘技术,极大提高了制作速度和底版的质量,并且能够制作出过去无法完成的高精度、细导线图形,使得印制板生产的CAM技术趋于完善。
二>、基板材料。
覆铜箔层压板(Copper Clad Laminates,简写为CCL),简称覆铜箔板或覆铜板,是制造印制电路板(以下简称PCB)的基板材料。
目前最广泛应用的蚀刻法制成的PCB,就是在覆铜箔板上有选择的进行的蚀刻,得到所需的线路的图形。
覆铜箔板在整个印制电路板上,主要担负着导电、绝缘和支撑三个方面的功能。
印制板的性能、质量和制造成本,在很大程度上取决于覆铜箔板。
三>、基本制造工艺流程。
印制板按照导体图形的层数可以分为单面、双面和多层印制板。
单面板的基本制造工艺流程如下:覆箔板-->下料-->烘板(防止变形)-->制模-->洗净、烘干-->贴膜(或网印) ->曝光显影(或抗腐蚀油墨) -->蚀刻-->去膜--->电气通断检测-->清洁处理-->网印阻焊图形(印绿油)-->固化-->网印标记符号-->固化-->钻孔-->外形加工-->清洗干燥-->检验-->包装-->成品。
双面板的基本制造工艺流程如下:近年来制造双面孔金属化印制板的典型工艺是SMOBC法和图形电镀法。
在某些特定场合也有使用工艺导线法。
1.图形电镀工艺流程。
覆箔板-->下料-->冲钻基准孔-->数控钻孔-->检验-->去?->化学镀薄铜-->电镀薄铜-->检验-->刷板-->贴膜(或网印)-->曝光显影(或固化)-->检验修板---->图形电镀(Cn十Sn/Pb)-->去膜-->蚀刻-->检验修板-->插头镀镍镀金-->热熔清洗-->电气通断检测-->清洁处理-->网印阻焊图形-->固化-->网印标记符号-->固化-->外形加工 -->清洗干燥-->检验-->包装-->成品。
流程中“化学镀薄铜 --> 电镀薄铜”这两道工序可用“化学镀厚铜”一道工序替代,两者各有优缺点。
图形电镀--蚀刻法制双面孔金属化板是六、七十年代的典型工艺。
八十年代中裸铜覆阻焊膜工艺(SMOBC)逐渐发展起来,特别在精密双面板制造中已成为主流工艺。
2.裸铜覆阻焊膜(SMOBC)工艺SMOBC板的主要优点是解决了细线条之间的焊料桥接短路现象,同时由于铅锡比例恒定,比热熔板有更好的可焊性和储藏性。
制造SMOBC板的方法很多,有标准图形电镀减去法再退铅锡的SMOBC工艺;用镀锡或浸锡等代替电镀铅锡的减去法图形电镀SMOBC工艺;堵孔或掩蔽孔法SMOBC工艺;加成法SMOBC工艺等。
下面主要介绍图形电镀法再退铅锡的SMOBC工艺和堵孔法SMOBC工艺流程。
图形电镀法再退铅锡的SMOBC工艺法相似于图形电镀法工艺。
只在蚀刻后发生变化。
双面覆铜箔板-->按图形电镀法工艺到蚀刻工序-->退铅锡-->检查---->清洗--->阻焊图形-->插头镀镍镀金-->插头贴胶带-->热风整平---->清洗--->网印标记符号--->外形加工--->清洗干燥--->成品检验-->包装-->成品。
堵孔法主要工艺流程如下:双面覆箔板-->钻孔-->化学镀铜-->整板电镀铜-->堵孔-->网印成像(正像)-->蚀刻-->去网印料、去堵孔料-->清洗-->阻焊图形-->插头镀镍、镀金-->插头贴胶带-->热风整平-->下面工序与上相同至成品。
此工艺的工艺步骤较简单、关键是堵孔和洗净堵孔的油墨。
在堵孔法工艺中如果不采用堵孔油墨堵孔和网印成像,而使用一种特殊的掩蔽型干膜来掩盖孔,再曝光制成正像图形,这就是掩蔽孔工艺。
它与堵孔法相比,不再存在洗净孔内油墨的难题,但对掩蔽干膜有较高的要求。
SMOBC工艺的基础是先制出裸铜孔金属化双面板,再应用热风整平工艺。
二、PCB工程制作:对于PCB印制板的生产来说,因为许多设计者并不了解线路板的生产工艺,所以其设计的线路图只是最基本的线路图,并无法直接用于生产。
因此在实际生产前需要对线路文件进行修改和编辑,不仅需要制作出可以适合本厂生产工艺的菲林图,而且需要制作出相应的打孔数据、开模数据,以及对生产有用的其它数据。
它直接关系到以后的各项生产工程。
这些都要求工程技术人员要了解必要的生产工艺,同时掌握相关的软件制作,包括常见的线路设计软件如:Protel、Pads2000、Autocad等等,更应熟悉必要的CAM软件如:View2001、CAM350;GCCAM等等,CAM应包括有PCB设计输入,可以对电路图形进行编辑、校正、修理和拼版,以磁盘为介质材料,并输出光绘、钻孔和检测的自动化数据。
一>、PCB工程制作的基本要求。
PCB工程制作的水平,可以体现出设计者的设计水准,也可以反映出印制板生产厂家的生产工艺能力和技术水平。
同时由于PCB工程制作融计算机辅助设计和辅助制造于一体,要求极高的精度和准确性,否则将影响到最终板载电子品的电气性能,严重时可能引起差错,进而导致整批印制板产品报废而延误生产厂家合同交货时间,并且蒙受经济损失。
因此作为PCB 工程制作者,必须时刻谨记自身的责任重大,切勿掉以轻心,务必仔细、认真、再仔细、再认真。
在处理PCB设计文件时,应该仔细检查:接收文件是否符合设计者所制定的规则?能否符合PCB制造工艺要求?有无定位标记?线路布局是否合理?线与线,线与元件焊盘,线与贯通孔,元件焊盘与贯通孔,贯通孔与贯通孔之间的距离是否合理,能否满足生产要求。
元件在二维、三维空间上有无冲突?印制板尺寸是否与加工图纸相符?后加在PCB图形中的图形(如图标、注标)是否会造成信号短路。
对一些不理想的线形进行编辑、修改。
在PCB上是否加有工艺线?阻焊是否符合生产工艺的要求,阻焊尺寸是否合适,字符标志是否压在器件焊盘上,以免影响电装质量。
等等…二>、光绘数据的产生。
1、拼版。
PCB设计完成因为PCB板形太小,不能满足生产工艺要求,或者一个产品由几块PCB组成,这样就需要把若干小板拼成一个面积符合生产要求的大板,或者将一个产品所用的多个PCB 拼在一起而便于生产电装。
前者类似于邮票板,它既能够满足PCB生产工艺条件也便于元器件电装,在使用时再分开,十分方便;后者是将一个产品的若干套PCB板拼装在一起,这样便于生产,也便于对一个产品齐套,清楚明了。