第六章:刻蚀.
- 格式:ppt
- 大小:3.88 MB
- 文档页数:51


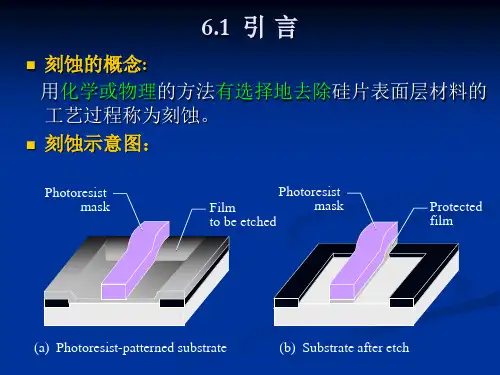







集成电路工艺作业第一章半导体衬底1、列举生产半导体级硅的三个步骤,给出反应方程式。
说明半导体级硅有多纯?2、为什么要用单晶进行硅片制造?3、CZ单晶生长法定义Czochralski(CZ)-查克洛斯基法生长单晶硅,把熔化了的半导体级硅液体变为有正确晶向并且被掺杂成n型或p型的固体硅锭。
85%以上的单晶硅是采用CZ法生长出来的。
CZ法特点:a. 低功率IC的主要原料。
b. 占有~80%的市场。
c. 制备成本较低。
d. 硅片含氧量高。
4、影响CZ法直拉工艺的两个主要参数是什么?拉伸速率和晶体旋转速率。
5、区熔法的特点是什么?a. 硅片含氧量低、纯度高。
b. 主要用于高功率IC。
c. 制备成本比CZ法低。
d. 难生长大直径硅晶棒。
e. 低阻值硅晶棒掺杂均匀度较差。
7、使用更大直径硅片的主要原因是什么?300mm硅片比200mm硅片面积大2.25倍,这样就会在一块硅片上生产更多的芯片。
每块芯片加工和处理时间都减少了,设备生产效率提高了。
使用300mm直径的硅片可以把每块芯片的成本减少30%。
节省成本是驱使半导体业转向使用更大直径硅片的主要原因。
8、硅中的晶体缺陷:点缺陷、位错、层错。
第二章氧化1、半导体器件生产中使用的介质材料有二氧化硅、氮化硅、多晶硅、硅化物。
2、二氧化硅的基本性质有哪些?a、可以方便地利用光刻和刻蚀实现图形转移、b、可以作为多数杂质掺杂的掩蔽、c、优秀的绝缘性能、d、很高的击穿电场(>107 V/cm)、e、体电学性能稳定、f、稳定、可重复制造的Si/ SiO2界面3、金属层间绝缘阻挡层目的:用于金属连线间的保护层。
4、热生长SiO2 的各种运用对厚度有不同要求栅氧(0.18μm工艺):20~60埃;STI隔离氧化物:150埃;场氧:2500~15000埃5、有几种类型的电荷存在于氧化层内部或在SiO2和Si/SiO2界面附近?a)界面陷阱电荷; b)固定氧化层电荷; c)移动离子电荷; d)大量氧化层陷阱电荷6、干氧和湿氧氧化反应方程式及氧化层的特点?这两种反应都在700 ºC~1200 ºC之间进行,湿氧氧化比干氧氧化反应速率约高10倍。
