COB邦定技术简介
- 格式:doc
- 大小:156.50 KB
- 文档页数:3

cob绑定工艺Cob绑定工艺是一种将芯片和散热器组合在一起的封装技术,可以提高芯片的散热性能和可靠性。
这种工艺在LED照明、电源模块和汽车电子等领域得到广泛应用。
Cob绑定工艺的核心是将芯片和散热器直接粘合在一起,形成一个整体。
这种粘合可以使用导热胶或者导热硅脂来实现。
导热胶是一种具有良好导热性能和粘附性的材料,可以将芯片和散热器紧密地连接在一起,有效地提高散热效果。
导热硅脂则是一种具有高导热性能的材料,可以填充芯片和散热器之间的微小空隙,提高散热效果。
Cob绑定工艺相比传统封装工艺具有很多优势。
首先,由于芯片和散热器直接粘合在一起,减少了封装材料和热界面材料的使用,降低了成本。
其次,由于芯片和散热器紧密连接,散热效果更好,可以提高芯片的工作稳定性和寿命。
此外,Cob绑定工艺还可以提高封装的紧凑性和可靠性,减小封装体积,提高产品的集成度。
在实际应用中,Cob绑定工艺有一些注意事项。
首先,需要选择合适的导热胶或导热硅脂,以确保良好的导热性能和粘附性。
其次,需要控制好粘合的厚度和均匀性,避免出现空隙或者厚度不均匀的情况。
此外,还需要考虑封装后的散热问题,选择合适的散热器和散热方案,以确保芯片的正常工作温度。
总结一下,Cob绑定工艺是一种将芯片和散热器直接粘合在一起的封装技术,可以提高芯片的散热性能和可靠性。
这种工艺具有成本低、散热效果好、紧凑可靠等优点,广泛应用于LED照明、电源模块和汽车电子等领域。
在应用过程中需要注意选择合适的粘合材料、控制好粘合厚度和均匀性,并考虑好散热问题。
Cob绑定工艺的发展为电子产品的封装和散热提供了新的解决方案,将在未来得到更广泛的应用。

PCB中的Bonding盘设计PCB中的Bonding设计,一般指的是应用COB(Chip On Board)技术的PCB 设计。
COB是将芯片的裸Die直接粘贴在PCB上,在通过引线键合并胶封。
COB 技术不同于常见的SMT,COB在SMT之后进行,类似于芯片的封装技术。
COB大致流程如下:洗板---点胶---Die粘贴---前测---封胶---烘烤---测试COB设计可以提高PCB的集成度、小型化、轻量化,同时也可以提高芯片的保密性。
当PCB中有Bonding盘设计时,结合COB工艺要求、PCB板厂的工艺能力,在PCB设计中做好Bonding的细节处理。
Bonding焊盘相对于封装后的IC器件的焊盘间距及焊盘尺寸,Bonding焊盘与焊盘间距通过更小。
COB中的Bonding焊盘pitch(焊盘中心距离)通常≤7mil,Bonding 焊盘的尺寸通常≤1/2pitch;这个数值,相对于常见的小pitch的IC(0.4mm pitch)尺寸小了很多,这就会导致PCB的生产难度加大,同时对PCB设计的布线带来挑战。
正常情况下,Bonding盘pitch不是固定的,可以根据layout情况进行调整。
对于生产厂家来说,希望间距能够大一些,这样更利于后端生产。
但是也不能让Die距离Bonding盘太远,否则键合线太长,不利于生产。
因此,PCB设计时,可以根据情况调整优化一下Bonding盘的间距位置,保证方便出线,同时距离中间的Die Pad不能太远,确保Bonding盘沿这Die Pad周边均匀分布。
PCB设计1.Bonding盘pitch不是固定的,可以根据layout情况调整Bonding盘位置;盘的摆放尽量均匀、保证die到盘的键合线不会相差太大;2.PCB中的Die Pad要比实际die大一些;3.添加mark点,辅助die定位;通常用十字型mark点;4.Bonding盘间距和尺寸比较小,PCB中走线尽量引出远一些打孔。


COB邦定车间基本流程和品质检测在LED照明行业中,COB邦定工艺是常见的LED封装技术之一。
COB(Chip on Board)即芯片直接粘贴于电路板上封装成一颗大型的、高功率的、高亮度的LED芯片。
COB邦定车间则是进行COB芯片的安装、焊接和包装等工序的场所。
在COB邦定车间中,品质检测是非常重要的一项工作,它直接关系到生产出的LED产品的品质和客户的信任。
本文就COB邦定车间基本流程和品质检测进行详细介绍。
COB邦定车间基本流程COB邦定车间包括多个工作环节,具体流程如下:1.引脚弯曲工序:在COB芯片焊线前,需要将基板上的引脚先行弯曲并锡覆盖。
2.芯片粘贴工序:在将COB芯片粘贴至基板时,需注意芯片的位置、定位框的使用和UV胶的涂布等。
3.焊接工序:在COB邦定车间中,使用技术精湛的焊接技术,利用高温和高亮度的能量,焊接芯片与基板之间的导线。
4.贴片工序:在用UV固化胶将COB芯片与基板连接后,需要贴片以增加灯珠的亮度,同时保证压力和均匀的光线输出。
5.打压工序:通过设定合适的压力和温度,让COB芯片与基板之间的连接更加牢固。
6.品质检测工序:在焊接前、焊接时和焊接后三个阶段都需对产品进行检测,包括点亮检测、防水等级检测、电气性能检测、光学性能检测等等。
COB邦定车间品质检测品质检测是COB邦定车间最为重要的一个环节,它可以确保产品的质量,提高客户的信任度,具体检测项目如下:焊接前的品质检测1.引脚检测:对芯片引脚的焊点进行检测。
2.基板检测:检测基板表面、外观和尺寸是否符合要求。
3.UV胶涂布检测:对UV胶的涂布量和均匀程度进行检测。
焊接时的品质检测1.电压、电流检测:对电气参数进行检测。
2.光通量和色温检测:检测内部LED光通量和色温是否符合要求。
焊接后的品质检测1.点亮检测:打开电源,检查所有LED是否亮起,亮度是否均匀。
2.耐热检测:检测产品在高温环境下的性能,包括稳定性和寿命等。



Bonding技术人员培训教材第一章:帮定焊接概念与原理一、COB(chip on board)板载芯片技术,是芯片组装的一门技术,它是将芯片直接粘在PCB上用引线键合达到芯片与PCB的电气联接,然后用黑胶包封保护。
主要焊接方式有以下三种:1.热压焊禾U用加热和加压力使金属比与焊区压焊在一起,其原理是通过加热和加压力,使焊区发发生塑性形变同时破坏压焊界面上的氧化层,从而使原子间产生吸引力达到“键合”的目的。
此外两金属不平整加热进可使上下的金属相互镶嵌。
此技术一般用在玻璃板上芯片上,即我们常讲的COG(Chip on Glass)2•超声波楔形焊接它是利用超声波发生器产生的能量,通过换能器在超高频的磁场感应下,迅速伸缩面产生弹性振动,使钢咀相应振动,同时在钢咀上施加一定的压力,于是钢咀在在这两种力的共同作用下,带动铝丝在被焊焊区的金属化层表面迅速摩擦,使铝线和金属化层表面产生塑性变形,这种形变也破坏了金属化层界面的氧化层,使两个纯净的金属面紧密接触,达到原子间的结合,从而形成焊接。
主要焊料为铝丝,焊头一般为楔形。
3.金丝球超声波焊接球焊在引线键合中是最具有代表性的焊接技术,它常用于二、三极管,LED、IC、BGA等CMOS产品的塑封。
它焊点牢固,速度快又无方向性。
它也是超声波焊接,不同的是它使用的是金丝,在焊接前在焊点部们的金丝会烧成一个球状。
二、邦定焊接介绍1•各种不同的叫法:裸片封装、BONDING Chip on Board(COB) 邦定wire bond(W/B)引线键合引线互连邦线打线Die bond(D/B) 2•我司常用的铝线焊接设备。
ASM 公司的:AB500/B AB510 AB520/A AB530 AB509/A AB559/A | 等ITM 综科的:BONDA101A BONDA101B BONDAIOOl]等K&S的:K&S1488等系列帮机近年还有一些其它公司推出了一些帮机设备如:天力精密、翠涛,威尔富等手邦机较好的有台湾的新美化,深圳的友邦等。

cob的用法-回复COB的用法COB(Chip on Board)是一种电子封装技术,常用于集成电路的封装和组装,具有结构简单、成本低、体积小等优点。
在本文中,我们将一步一步回答有关COB的用法,以帮助读者更好地理解和应用这项技术。
第一步:COB的基本原理COB技术将晶圆上的集成电路芯片直接连接到电路板上,省去了传统封装过程中使用封装底座和导线的环节。
COB技术将芯片直接贴合在金属或陶瓷基板上,然后使用导线粘合芯片和基板,形成一个完整的电子元件。
这种直接连接的方式不仅大大减小了封装尺寸,还提高了射频性能和热管理效果。
第二步:COB的封装过程COB封装过程通常包括以下几个步骤:准备基板、粘接芯片、导线连接、封装保护和测试。
首先,选择合适的基板材料,如金属或陶瓷基板,以满足封装的要求。
然后,将芯片定位在基板表面,并使用粘合剂将其固定在基板上。
接下来,使用导线连接芯片和基板的金属焊盘或金属线,形成电路连接。
最后,使用封装保护材料,如环氧树脂或硅胶,将芯片和导线保护起来,并进行必要的测试以确保封装质量。
第三步:COB的优点和应用领域COB技术具有许多优点,使其在许多应用领域得到广泛应用。
首先,COB 封装尺寸小,可以在更小的空间内实现更高的集成度,从而提供更高的性能。
其次,COB封装过程简单且成本低廉,适用于大规模生产。
此外,COB封装具有优良的热管理性能,能够有效地散热,提高集成电路的可靠性和寿命。
由于这些优点,COB技术广泛应用于LED照明、汽车电子、通信设备等领域。
第四步:COB的注意事项在使用COB技术封装集成电路时,还需注意一些重要事项。
首先,由于COB封装后芯片暴露在外,对尘埃和湿气非常敏感,因此需要在封装过程中加强清洁和干燥的措施。
其次,COB封装过程中需要进行精密的对位和焊接操作,以确保芯片和导线之间的良好联系。
最后,COB封装的尺寸较小,热散热能力有限,因此对于高功率应用,需要采取额外的散热措施,以保证芯片的稳定运行。

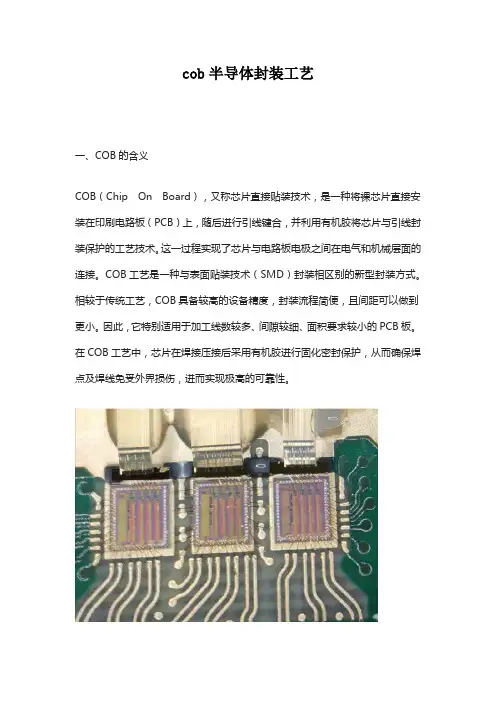
cob半导体封装工艺一、COB的含义COB(Chip On Board),又称芯片直接贴装技术,是一种将裸芯片直接安装在印刷电路板(PCB)上,随后进行引线键合,并利用有机胶将芯片与引线封装保护的工艺技术。
这一过程实现了芯片与电路板电极之间在电气和机械层面的连接。
COB工艺是一种与表面贴装技术(SMD)封装相区别的新型封装方式。
相较于传统工艺,COB具备较高的设备精度,封装流程简便,且间距可以做到更小。
因此,它特别适用于加工线数较多、间隙较细、面积要求较小的PCB板。
在COB工艺中,芯片在焊接压接后采用有机胶进行固化密封保护,从而确保焊点及焊线免受外界损伤,进而实现极高的可靠性。
二、COB封装的工艺流程及步骤:1.擦板:在COB工艺流程中,由于PCB等电子板上存在焊锡残渣和灰尘污渍,下一阶段的固晶和焊线等工序可能会导致不良产品增多和报废。
为解决此问题,厂家需对电子线路板进行清洁。
2.固晶:传统工艺采用点胶机或手动点胶,在PCB印刷线路板的IC位置上涂上适量红胶,再用真空吸笔或镊子将IC裸片正确放置在红胶上。
3.烘干:将涂好红胶的裸片放入热循环烘箱中烘烤一段时间,也可自然固化(时间较长)。
4.绑定:采用铝丝焊线机,将晶片(如LED晶粒或IC芯片)与PCB板上对应的焊盘铝丝进行桥接,即COB的内引线焊接。
5. 前测:使用专用检测工具(根据COB不同用途选择不同设备,简单的高精密度稳压电源)检测COB板,对不合格的板子进行重新返修。
6.封胶:将适量黑胶涂在绑定好的晶粒上,并根据客户要求进行外观封装。
7.固化:将封好胶的PCB印刷线路板放入热循环烘箱中恒温静置,可根据要求设定不同的烘干时间。
8.测试:采用专用检测工具对封装好的PCB印刷线路板进行电气性能测试,以区分好坏优劣。
相较于其他封装技术,COB技术具有价格低(仅为同芯片的1/3左右)、节约空间、工艺成熟等优势,因此在半导体封装领域得到广泛应用。
三、主要焊接方法1、热压焊:此方法通过加热和加压力使金属丝与焊区紧密结合。

cob封装概念
COB(ChipOnBoard)封装是一种用于将芯片(裸芯片)直接粘贴在印制电路板(PCB)上的技术。
它是一种常见的封装技术,可以用于将各种类型的芯片固定在PCB上,包括LED芯片、晶体管等。
COB封装的优点包括:
简单易行:COB封装相对其他封装技术来说比较简单,不需要复杂的设备和工艺,因此成本较低。
节省空间:COB封装可以将芯片直接粘贴在PCB上,不需要额外的连接器或插座,因此可以节省空间,使产品更小更轻。
降低成本:由于COB封装不需要额外的连接器和插座,因此可以降低成本,提高生产效率。
提高性能:COB封装可以提供更好的电气性能和热性能,因为芯片和PCB之间的连接距离更短,因此可以更快地传输信号和减少热损失。
在COB封装中,芯片和PCB之间的连接通常使用导电胶或焊接来固定。
此外,为了保护芯片和连接点,COB封装还可以使用一些保护材料,如填充胶、覆盖层等。
需要注意的是,COB封装也有一些缺点,例如对芯片和连接点的保护不够强、容易受到机械损伤等。
因此,在选择COB封装时需要根据具体情况进行评估和优化。
Chip on Board(板上芯片封装)板上芯片(Chip On Board, COB)工艺过程首先是在基底表面用导热环氧树脂(一般用掺银颗粒的环氧树脂)覆盖硅片安放点,然后将硅片直接安放在基底表面,热处理至硅片牢固地固定在基底为止,随后再用丝焊的方法在硅片和基底之间直接建立电气连接。
裸芯片技术主要有两种形式:一种是COB技术,另一种是倒装片技术(Flip Chip)。
板上芯片封装(COB),半导体芯片交接贴装在印刷线路板上,芯片与基板的电气连接用引线缝合方法实现,芯片与基板的电气连接用引线缝合方法实现,并用树脂覆盖以确保可靠性。
虽然COB是最简单的裸芯片贴装技术,但它的封装密度远不如TAB和倒片焊技术。
主要焊接方法(1)热压焊利用加热和加压力使金属丝与焊区压焊在一起。
其原理是通过加热和加压力,使焊区(如AI)发生塑性形变同时破坏压焊界面上的氧化层,从而使原子间产生吸引力达到“键合”的目的,此外,两金属界面不平整加热加压时可使上下的金属相互镶嵌。
此技术一般用为玻璃板上芯片COG。
(2)超声焊超声焊是利用超声波发生器产生的能量,通过换能器在超高频的磁场感应下,迅速伸缩产生弹性振动,使劈刀相应振动,同时在劈刀上施加一定的压力,于是劈刀在这两种力的共同作用下,带动AI丝在被焊区的金属化层如(AI膜)表面迅速摩擦,使AI丝和AI膜表面产生塑性变形,这种形变也破坏了AI层界面的氧化层,使两个纯净的金属表面紧密接触达到原子间的结合,从而形成焊接。
主要焊接材料为铝线焊头,一般为楔形。
(3)金丝焊球焊在引线键合中是最具代表性的焊接技术,因为现在的半导体封装二、三极管封装都采用AU线球焊。
而且它操作方便、灵活、焊点牢固(直径为25UM的AU丝的焊接强度一般为0.07~0.09N/点),又无方向性,焊接速度可高达15点/秒以上。
金丝焊也叫热(压)(超)声焊主要键合材料为金(AU)线焊头为球形故为球焊。
COB封装流程第一步:扩晶。
COB技術詳解一、 COB名詞解釋:COB是Chip On Board〈板上芯片直裝〉的英文縮寫。
二、 COB人員進入COB前的準備工作:1.換好白球鞋或拖鞋,穿好靜電服,戴好靜電帽。
2.做好靜電環測試并填寫《靜電環測試記錄表》。
3.經風淋室風淋後,進入COB車間。
三、 COB車間內環境要求:1.進入COB車間必須穿戴無塵衣、無塵帽。
2.進入COB車間必須經風淋室風淋,嚴禁兩門同時開著。
3.COB車間內禁止將頭髮露出無塵帽。
4.COB車間內所有通向外界之門窗平時不可敞開。
5.COB內的固定設備都須具備接地設施。
6.COB車間內溫、濕度要求:a.溫度范圍:18~25℃;b.濕度范圍:40~60%;7.生產廢料如黑膠、二甲苯化學物品必須用專用容器盛裝并標示,定期交由廠外廢物回收人員處理。
四、 COB技術流程概述:基板清潔――→點缺氧膠――→裝著晶圓――→烘烤――→焊線↓電測――→烘烤――→電測――→封膠――→電測↓OQC抽驗――→入庫五、 COB技術各流程及設備詳述:1.基板清潔作用:去除基板露銅處的氧化膜,確保點缺氧膠時無障礙,打線時不失線。
工/治具:橡皮、毛刷、鋁盤、防靜電布、靜電環。
注意事項:PCB金手指和PAD是鍍銅的,則用INK橡皮擦;鍍金或鎳烙合金的,則用藍色橡皮擦。
如需折板時,必須用治具,不可用手折。
2.點缺氧膠作用:點粘著劑,使晶圓能夠裝著在PCB的PAD上。
工/治具:針頭、針筒、防靜電布、靜電環。
材料:常用粘著劑有缺氧膠〈紅膠〉、黑膠〈混合膠、冷膠〉、銀漿。
操作步驟:操作人員在配戴好靜電環的情況下,手持灌好缺氧膠的針筒,將缺氧膠點在裝著晶圓的PAD上。
材料具體作用及適用產品:•缺氧膠:粘性一般,價格便宜。
一般用於P1058、P1205、P1128等英新達系列產品。
•銀漿:導電性和粘性很好,價格較貴,目前只用於正運達的XO產品。
•黑膠:粘性好,價格比銀漿便宜,目前用於HP系列產品。
〈HP系列有HP103,HP103C,HPCPU,HPCPUC〉注意事項:•膠量適中均勻,如果膠量過多易溢到金手指上;膠量過少,晶圓裝著不上。
[技術] COB (Chip On Board) 製程介紹/簡介/注意事項ICOB (Chip On Board)在電子製造業並不是一項新鮮的技術,但最近我卻常常被問到相關的問題及資料索取。
也許真的是產品越來越小了,而較進階的技術又太貴,所以又有人回過頭來考慮COB的製程。
這裡我就把多年前架設及操作COB的經驗重新整理,一方面是提醒自己這項工藝,另一方面是提供參考,當然有些資訊可能並不是最新,僅供參考。
IC、COB、及Flip Chip (COG)的演進歷史下圖可以了解電子晶片封裝的的演進歷史從IC封裝→ COB → Flip Chip (COG),尺寸越來越小。
其中COB只能說是介於目前技術的中間過度產品。
COB是直接將裸晶圓(die)黏貼在電路板(PCB)上,並將導線/焊線(wire)直接焊接(Bonding)在PCB 的鍍金線路上,再透過封膠的技術,有效的將IC製造過程中的封裝步驟轉移到電路板上直接組裝。
以前COB技術一般運用對信賴度比較不重視的消費性電子產品上,如玩具、計算器、小型顯示器、鐘錶等日常生活用品中,因為一般製作COB的廠商大都是因為低成本(Low Cost)的考量。
現今,有越來越多的廠商看上它的小尺寸,以及產品輕薄短小的趨勢,運用上有越來越廣的趨勢,如手機,照相機等要求短小的產品之中。
COB還有另一項優點使某些廠商特別鍾愛它。
由於需要封膠的關係,一般的COB會把所有的對外導線接腳全部都封在環氧樹脂(Epoxy)之中,對那些喜歡破解別人設計的駭客可能因為這個特性而需要花更多的時間來破解,間接的達到防駭安全等級的提升。
(※:防駭安全等級是由花費時間以破解一項技術的多寡來決定的)COB的環境要求建議要有潔淨室(Clean Room)且等級(Class)最好在100K以下。
因為COB的製程屬於晶圓封裝等級,任何小小的微粒沾污於焊接點都會造成嚴重的不良。
基本的無塵衣帽也有其必要,不需套頭包成肉粽式的無塵衣,但基本的帽子、衣服、及靜電鞋都是必須的。
cob原理COB(Chip on Board)即芯片贴片技术,是一种常用于电子零部件制造的技术。
它将裸露的芯片直接连接到电路基板上,通过银胶或焊接等方法进行粘贴或连接,以减小芯片与基板之间的材料衔接层厚度,从而提高电路性能。
COB原理的关键是将芯片与基板直接连接,取代传统的芯片封装方式。
在COB技术中,首先将裸露的芯片与电路基板上的金属焊脚等连接面进行对接,然后使用导电胶水或导电胶圈将芯片固定在基板上。
通过该粘贴连接方式,可以实现更紧密的芯片与基板之间的接触,提高信号传输效率,降低电阻和电感。
COB技术的优势在于其相对较小的尺寸和更高的集成度。
由于芯片直接连接到基板上,COB制造的元件相比传统封装的元件更紧凑,更薄,适用于高密度集成电路的需求。
此外,COB技术还能够在封装过程中省略传统封装中所需的外壳,使整体组件变得更加轻巧。
在应用方面,COB技术被广泛应用于各种电子设备中,尤其是LED照明和显示领域。
在LED照明中,COB技术可以将多个LED芯片直接集成在一个基板上,形成高亮度,高稳定性的照明源。
在显示领域,COB技术可以将LCD驱动器芯片直接连接到显示屏上,实现更高的显示质量和更快的响应速度。
然而,COB技术也存在一些限制和挑战。
首先,COB制造过程相对复杂,需要高精度的设备和工艺控制,从而提高制造成本。
此外,裸露的芯片容易受到外界环境的影响,因此需要特殊的保护措施来保证元件的稳定性和可靠性。
最后,COB技术的尺寸限制也限制了芯片的功率和功能密度。
综上所述,COB技术通过直接将芯片与基板连接,在电子设备制造中具有重要的应用价值。
虽然COB技术存在一些挑战和限制,但它仍然被认为是一种有前景和发展潜力的封装技术。
随着电子设备的不断进步和需求的增长,COB技术将继续在各个领域发挥重要作用,并取得进一步的突破和创新。