
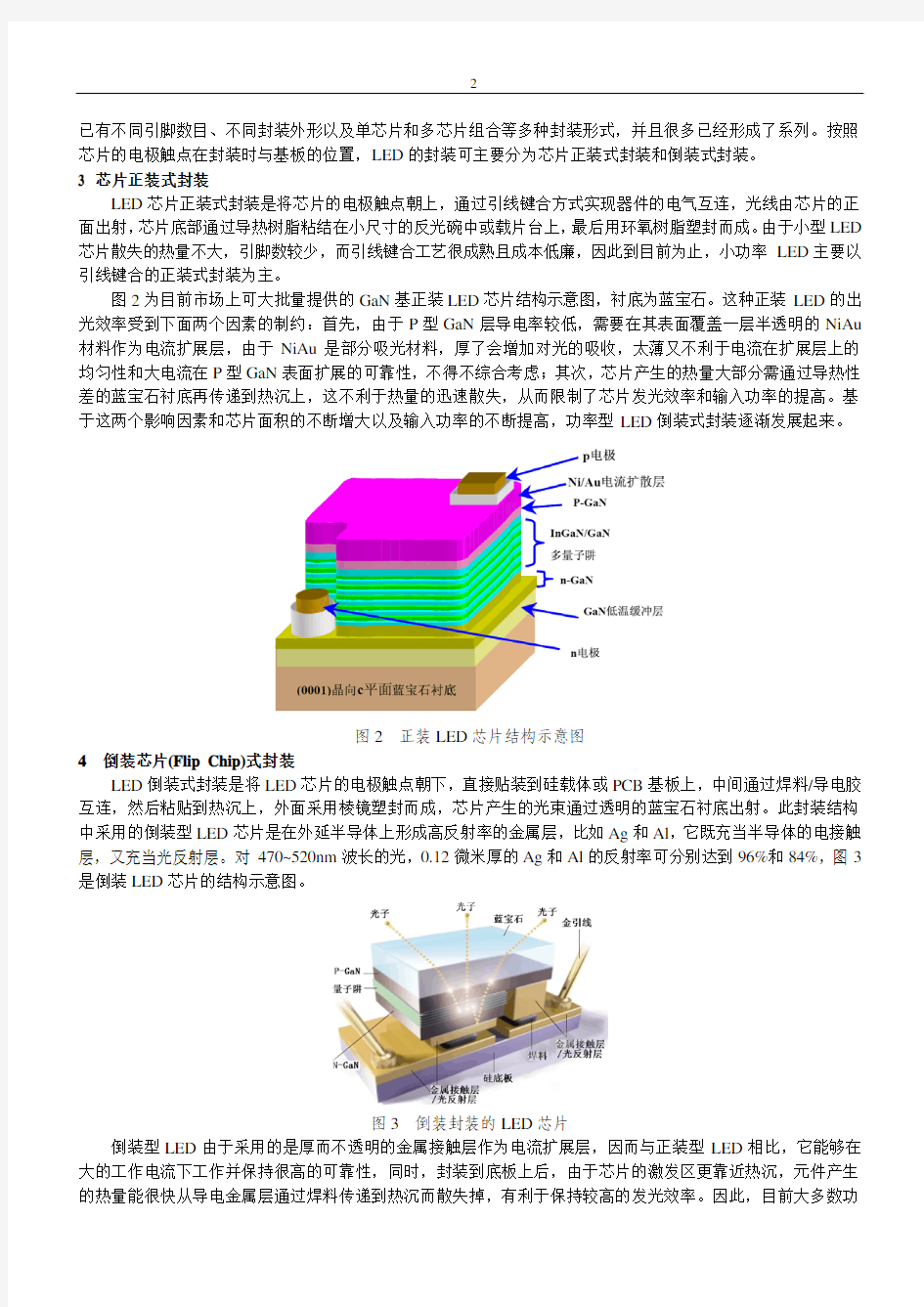
【环球SMT与封装】特约稿
吴懿平博士
华中科技大学教授/博导
上海交通大学兼职教授
Email: ypwu@https://www.doczj.com/doc/dc4904884.html,
半导体照明封装技术
摘要:半导体照明是21世纪最具发展前景的高技术领域之一,其封装是连接半导体照明产业和市场的纽
带。本文对功率型LED的封装特点作了简要的叙述,对正装式LED和倒装式LED两种封装方法作了论
述并对功率型LED封装技术的应用前景作了展望。
关键词:半导体照明,LED封装,倒装芯片式封装
1 前言
随着半导体发光技术的进步以及人们对绿色照明技术的需求,新兴的固体照明(solid-state lighting,SSL)光源,特别是高亮度发光二极管(high-brightness light emitting diodes,HB-LED)引起了人们密切的关注和深入的研究:它具有发光效率高、使用寿命长、耐震动冲击以及对环境友好等一系列优点,而且不同光色的固体光源组成的照明系统可通过矩阵、网络等实现照明亮度和光色的细微控制,得到丰富多彩的照明效果。固体照明光源被认为是人类照明史上继白炽灯、荧光灯和高压放电灯之后的第四代人工光源。欧、美、日等发达国家和地区均制定了相应的半导体照明发展计划,中国大陆也于2003年启动了国家半导体照明工程,大力扶持这一新兴产业。
在LED产业链中,衬底晶片及衬底生产处于上游, LED芯片设计及制造处于中游,而下游属于LED封装与测试。对于用作通用照明的大功率LED,目前研发目标之一是将单个LED的发光量提高到1000流明的水平,这除了需要增加芯片的面积并提高输入功率外,还需要改善芯片封装方法并提高固定设备的集成度,从而使LED芯片结点与周围环境间的热阻降到10K/W以下的水平。因此研发低热阻、优异光学特性、可靠性高而低成本的封装是高亮度LED进入通用照明市场的关键技术之一,从某种意义上讲,LED的封装是连接产业与市场的纽带,只有封装良好的产品才能赢得市场,为顾客接受,让人类早日跨入半导体照明时代。
2 LED封装的特点
LED是由数层很薄的搀杂半导体材料在衬底(蓝宝石或SiC等)上通过MOCVD法外延生长而成,其中一层带过量的电子,另一层因缺乏电子而形成带正电的“空穴”,当有电流通过时,电子和空穴复合并以辐射光子的形式释放出能量,从而直接将电能转化为可见光、紫外光或红外光,图1是其发光原理示意图。LED作为半导体器件,其封装技术基本上是在分立半导体器件的封装技术基础上发展演化而来的,但是作为半导体发光器件,LED的封装又有自己的特点:LED封装不但要完成电信号的输入输出,保护芯片在正常的电流下工作,还得维持工作状态下芯片的温度不超过允许的范围,这对于功率型LED的封装来说显得尤为重要,因为当芯片的结点温度升高到一定的水平后,会发生明显的颜色漂移和发光效率下降等现象;LED封装结构和材料要有利于提高出光效率,减少对芯片出射光的阻挡和吸收;另外还得尽量采用现有的标准封装材料,从而降低生产成本,毕竟价格是LED光源进入通用照明市场的关键之一。
图1. 半导体发光示意图
随着发光半导体芯片设计与制造等技术的进步,下游的封装技术和产业也获得了很大的发展。目前市场上
已有不同引脚数目、不同封装外形以及单芯片和多芯片组合等多种封装形式,并且很多已经形成了系列。按照芯片的电极触点在封装时与基板的位置,LED的封装可主要分为芯片正装式封装和倒装式封装。
3 芯片正装式封装
LED芯片正装式封装是将芯片的电极触点朝上,通过引线键合方式实现器件的电气互连,光线由芯片的正面出射,芯片底部通过导热树脂粘结在小尺寸的反光碗中或载片台上,最后用环氧树脂塑封而成。由于小型LED 芯片散失的热量不大,引脚数较少,而引线键合工艺很成熟且成本低廉,因此到目前为止,小功率LED主要以引线键合的正装式封装为主。
图2为目前市场上可大批量提供的GaN基正装LED芯片结构示意图,衬底为蓝宝石。这种正装LED的出光效率受到下面两个因素的制约:首先,由于P型GaN层导电率较低,需要在其表面覆盖一层半透明的NiAu 材料作为电流扩展层,由于NiAu是部分吸光材料,厚了会增加对光的吸收,太薄又不利于电流在扩展层上的均匀性和大电流在P型GaN表面扩展的可靠性,不得不综合考虑;其次,芯片产生的热量大部分需通过导热性差的蓝宝石衬底再传递到热沉上,这不利于热量的迅速散失,从而限制了芯片发光效率和输入功率的提高。基于这两个影响因素和芯片面积的不断增大以及输入功率的不断提高,功率型LED倒装式封装逐渐发展起来。
图2 正装LED芯片结构示意图
4 倒装芯片(Flip Chip)式封装
LED倒装式封装是将LED芯片的电极触点朝下,直接贴装到硅载体或PCB基板上,中间通过焊料/导电胶互连,然后粘贴到热沉上,外面采用棱镜塑封而成,芯片产生的光束通过透明的蓝宝石衬底出射。此封装结构中采用的倒装型LED芯片是在外延半导体上形成高反射率的金属层,比如Ag和Al,它既充当半导体的电接触层,又充当光反射层。对470~520nm波长的光,0.12微米厚的Ag和Al的反射率可分别达到96%和84%,图3是倒装LED芯片的结构示意图。
图3 倒装封装的LED芯片
倒装型LED由于采用的是厚而不透明的金属接触层作为电流扩展层,因而与正装型LED相比,它能够在大的工作电流下工作并保持很高的可靠性,同时,封装到底板上后,由于芯片的激发区更靠近热沉,元件产生的热量能很快从导电金属层通过焊料传递到热沉而散失掉,有利于保持较高的发光效率。因此,目前大多数功
率型LED(输入功率≥1W)均采用倒装型封装结构,这也是未来通用半导体照明的希望。
美国Lumileds公司的LUXEON系列LED是倒装型大功率LED封装的代表,如图4所示。该封装结构采用的是热电分离的形式:芯片倒装焊接在具有焊料凸点的硅载体上,然后把完成倒装焊接的硅载体装入热沉与管壳中,通过键合引线实现电互连;硅载体与热沉之间采用很薄的一层导热树脂连接形成导热通道,其封装热阻只有4~10K/W,不到常规φ5mm LED的十分之一;设计良好的反射杯和光学透镜使辐射图案可控和光学效率最高;为了提高金丝互连可靠性,器件内部填充有性能稳定的硅橡胶,能有效的吸收热冲击条件下(-40~120?C)产生的应力,最后将封装好的芯片通过焊料焊接到导热性能优良的金属基PCB板上。 LUXEON系列LED由于采用了上述新型封装结构和材料,使其从热、光和电的角度都达到了较佳的水平,这也是目前市场上大功率LED单芯片封装的主流形式。
图4 LUXEON系列LED封装结构示意图
除了LUXEON这种单芯片封装方法外,2003年,Lamina Ceramics 公司推出了自己的专利封装技术—多层低温陶瓷金属基烧结(LTCC-M)技术,生产出集成度很高的LED阵列,如图5所示。通过倒装封装工艺,该多芯片组装器件的发光亮度在840cd/in2以上,流明效率超过40lm/W,而使用寿命长达10年,并且能在高达250?C 的环境下正常工作。美国UOE公司研制的NORLUX系列大功率LED也为多芯片组合封装结构,见图6。NORLUX采用六角形铝基金属线路板作为热沉,直径为1.25英寸,发光区位于其中央部位,可根据所需输出光功率的大小在金属线路板上排列多达40个超高亮度倒装型LED芯片,包括AlGaInN 和AlGaInP,它们的发射光可为单色、彩色(RGB)、白色(RGB三基色合成或蓝色黄色二元色合成)。这些多芯片组合封装的功率型LED设计独到,不仅散热性能良好,而且可在大电流下工作,具有很高的光输出量,是一种很有发展前途的LED固体光源。
图5 Lamina Ceramics 公司的LTCC-M封装示意图
图6 NORLUX系列大功率LED
5 功率型LED封装发展趋势及应用前景
近几年,大功率LED芯片设计与制造技术发展日新月异,芯片的面积、输入功率和发光效率等均取得了很大进步,这也推动了功率型LED的封装技术不断改进以适应形势的发展,如下图所示:LED封装从最初的单芯片双引脚圆头型封装,发展到扩展引线框架式封装再到如今的多芯片倒装阵列式封装,其输入功率不断提高,而封装热阻显著降低。根据美国光电工业发展协会(OIDA)制定的目标,到2012年,LED的发光效率将提高到150 lm/W,输入功率密度达到400W/cm2,而成本则降到荧光灯的水平。为了实现这些目标,进一步改善LED 封装的热管理将是关键之一,另外芯片设计制造与封装工艺的有机融合也非常有利于产品性价比的提升,如美国Cree公司与Berkeley国家实验室合作,开发出了光通量超过1000 lm,发光效率达57 lm/W的LED灯泡,并已进入商业应用。随着表面贴装技术(SMT)在工业上的大规模应用,采用透明型封装材料和功率型MOSFET封装平台将是LED封装发展的一个方向,功能集成(比如驱动电路)也将进一步的推动LED封装技术的发展。
图7 功率型LED的封装发展史
6 结语
实现通用照明是LED发展的最终目标,目前离此仍有一段较长的距离。当前LED已经在建筑物亮化、装饰照明、大屏幕显示用背光源以及汽车内部照明等特殊照明领域获得了广泛的使用,这既是LED应用领域的拓展,又为LED向通用照明领域发展积累了技术与资金支持。LED封装产业具有技术密集和知识密集的双重特点,在这领域我国与国外的技术差距也较小,因而优先发展该产业,在短期内形成与国外一流企业竞争的态势,必定将提升我国LED产业的实力。抓住2008年奥运会和2010年世博会举办的机遇,中国LED照明产业必将获得长足的发展,封装作为连接LED照明产业和市场的纽带,必须引起我们足够的关注和重视!
(2005年3月12日)
第10期(2009年lo月中国科技论坛 ?99? 2.2专利申请国别分析 图1显示了1998--2007年的十年间,国外九个发达国家和地区在华有关半导体照明领域的专利申请量。其中,在总量方面,以台湾、日本、美国高居榜首。但是,在发明专利上,除台湾、日本、美国以外,韩国、荷兰、德国也显示出强大的实力。在实用新型方面,台湾香港地区为主,其他国家和地区很少,而香港较之台湾专利申请的差距十分明显。对于日本,在外观设计方面具有较强的领先优势,说明日本在相关半导体照明产品市场化方面居于前列。
图l 九个国家和地区专利申请详细分布图 国外在华申请的三个专利类型数量均在总体上呈现逐年上升的趋势(见图2。在2000年前,国外在华申请的有关半导体照明的专利几乎全部是发明专利,其原因一方面是在半导体照明领域,国外技术还处于发展早期阶段,比较注重于基础技术的研发,发明专利较多;另一方面,国外具有强烈的知识产权保护专利战略意识,一旦实现技术突破,就很快申请专利保护,抢占未被充分开发的市场,实现专利技术价值。在
2000年后,国外在华发明专利的申请数量继续保持突飞猛进,而在同时,实用新型和外观设计也成为国外企业的关注重点,其数量也在逐年提高。2.3半导体照明发明专利申请量趋势分析 1998 图2国外在华专利类型申请历年变化图 发明专利,其中台湾、美国、日本、韩国、荷兰、德国申请的发明专利均超过100件。在半导体照明领域,美日两国可以说是老牌专利大国,一直保持稳定快速发展的势头。我国台湾地区这一领域的专利,从2002年在大陆地区申请第一个发明专利以来,迅速发展,已经在量上赶超美日,可以说是这一领域的后起之秀。另外,作为一个新兴电子强国,韩国在半导体照明领域的发明专利申请量也很大(见图3。2.4半导体照明领域的企业竞争力分析 本文统计了各个国家和地区有关半导体照明领域的专利申请量大于10项(包含10项的企业数量,根据统计过程,这些专利以发明专利为主,且法国、新加坡由于专利少,没有企业归入(见图4。 图3有关半导体照明发明专利历年申请量变化图 图4有关半导体照明灯各国企业专利≥10个的企业个数
半导体器件有许多封装形式,按封装的外形、尺寸、结构分类可分为引脚插入型、表面贴装型和高级封装三类。从DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技术指标一代比一代先进。总体说来,半导体封装经历了三次重大革新:第一次是在上世纪80年代从引脚插入式封装到表面贴片封装,它极大地提高了印刷电路板上的组装密度;第二次是在上世纪90年代球型矩阵封装的出现,满足了市场对高引脚的需求,改善了半导体器件的性能;芯片级封装、系统封装等是现在第三次革新的产物,其目的就是将封装面积减到最小。 高级封装实现封装面积最小化 芯片级封装CSP。几年之前封装本体面积与芯片面积之比通常都是几倍到几十倍,但近几年来有些公司在BGA、TSOP的基础上加以改进而使得封装本体面积与芯片面积之比逐步减小到接近1的水平,所以就在原来的封装名称下冠以芯片级封装以用来区别以前的封装。就目前来看,人们对芯片级封装还没有一个统一的定义,有的公司将封装本体面积与芯片面积之比小于2的定为CSP,而有的公司将封装本体面积与芯片面积之比小于1.4或1.2的定为CSP。目前开发应用最为广泛的是FBGA和QFN等,主要用于内存和逻辑器件。就目前来看,CSP的引脚数还不可能太多,从几十到一百多。这种高密度、小巧、扁薄的封装非常适用于设计小巧的掌上型消费类电子装置。 CSP封装具有以下特点:解决了IC裸芯片不能进行交流参数测试和老化筛选的问题;封装面积缩小到BGA的1/4至1/10;延迟时间缩到极短;CSP封装的内存颗粒不仅可以通过PCB板散热,还可以从背
面散热,且散热效率良好。就封装形式而言,它属于已有封装形式的派生品,因此可直接按照现有封装形式分为四类:框架封装形式、硬质基板封装形式、软质基板封装形式和芯片级封装。 多芯片模块MCM。20世纪80年代初发源于美国,为解决单一芯片封装集成度低和功能不够完善的问题,把多个高集成度、高性能、高可靠性的芯片,在高密度多层互联基板上组成多种多样的电子模块系统,从而出现多芯片模块系统。它是把多块裸露的IC芯片安装在一块多层高密度互连衬底上,并组装在同一个封装中。它和CSP封装一样属于已有封装形式的派生品。 多芯片模块具有以下特点:封装密度更高,电性能更好,与等效的单芯片封装相比体积更小。如果采用传统的单个芯片封装的形式分别焊接在印刷电路板上,则芯片之间布线引起的信号传输延迟就显得非常严重,尤其是在高频电路中,而此封装最大的优点就是缩短芯片之间的布线长度,从而达到缩短延迟时间、易于实现模块高速化的目的。 WLCSP。此封装不同于传统的先切割晶圆,再组装测试的做法,而是先在整片晶圆上进行封装和测试,然后再切割。它有着更明显的优势:首先是工艺大大优化,晶圆直接进入封装工序,而传统工艺在封装之前还要对晶圆进行切割、分类;所有集成电路一次封装,刻印工作直接在晶圆上进行,设备测试一次完成,有别于传统组装工艺;生产周期和成本大幅下降,芯片所需引脚数减少,提高了集成度;引脚产生的电磁干扰几乎被消除,采用此封装的内存可以支持到800MHz的频
LED照明技术细节分析 led光源的技术日趋成熟,每瓦发光流明迅速增长,促使其逐年递减降价。led绿色灯具的海量市场和持续稳定数年增长需求将是集成电路行业继VCD、DVD、手机、MP3之后的消费电子市场的超级海啸! LED灯具的高节能、长寿命、利环保的优越性能获得普遍的公认。 led高节能:直流驱动,超低功耗(单管0.03瓦-1 瓦)电光功率转换接近100%,相同照明效果比传统光源节能80%以上。 led长寿命:led 光源被称为长寿灯。固体冷光源,环氧树脂封装,灯体内也没有松动的部分,不存在灯丝发光易烧、热沉积、光衰快等缺点。 led寿命:使用寿命可达5万到10万小时,比传统光源寿命长10倍以上。 led利环保:led是一种绿色光源,环保效益更佳。光谱中没有紫外线和红外线,热量低和无频闪,无辐射,而且废弃物可回收,没有污染不含汞元素,冷光源,可以安全触摸,属于典型的绿色照明光源。 led光源工作特点照明用led光源的VF电压都很低,一般VF =2.75-3.8V,IF在15-1400mA;因此LED驱动IC的输出电压是VF X N或VF X 1, IF恒流在15-1400mA。LED灯具使用的led光源有小功率 (IF=15-20mA)和大功率(IF》200mA))二种,小功率led多用来做led日光灯、装饰灯、格栅灯;大功率LED用来做家庭照明灯、射灯、水底灯、洗墙灯、路灯、隧道灯、汽车工作灯等。功率led光源是低电压、大电流驱动的器件,其发光的强度由流过led的电流大小决定,电流过强会引起led光的衰减,电流过弱会影响led的发光强度,因此,led的驱动
需要提供恒流电源,以保证大功率led使用的安全性,同时达到理想的发光强度。在led照明领域,要体现出节能和长寿命的特点,选择好LED 驱动IC至关重要,没有好的驱动IC的匹配,led照明的优势无法体现。led照明设计需要注意的技术细节led灯具对低压驱动芯片的要求: 1. 驱动芯片的标称输入电压范围应当满足DC8-40V,以覆盖应用面的需要,耐压如能大于45V更好;AC 12V或24 V输入时简单的桥式整流器输出电压会随电网电压波动,特别是电压偏高时输出直流电压也会偏高,驱动IC如不能适应宽电压范围,往往在电网电压升高时会被击穿,led光源也因此被烧毁。 2. 驱动芯片的标称输出电流要求大于1.2-1.5A,作为照明用的led 光源,1W功率的led光源其标称工作电流为350mA,3W功率的led光源其标称工作电流为700mA,功率大的需要更大的电流,因此LED照明灯具选用的驱动IC必需有足够的电流输出,设计产品时必需使驱动IC工作在满负输出的70-90%的最佳工作区域。使用满负输出电流的驱动IC在灯具狭小空间散热不畅,容易疲劳和早期失效。 3. 驱动芯片的输出电流必需长久恒定,led光源才能稳定发光,亮度不会闪烁;同一批驱动芯片在同等条件下使用,其输出电流大小要尽可能一致,也就是离散性要小,这样在大批量自动化生产线上生产才能有效和有序;对于输出电流有一定离散性的驱动芯片必选在出厂或投入生产线前分档,调整PCB板上电流设定电阻(Rs)的阻值大小,使之生产的led 灯具恒流驱动板对同类led光源的发光亮度一致,保持最终产品的一致性。
半导体集成电路封装技术试题汇总 第一章集成电路芯片封装技术 1. (P1)封装概念:狭义:集成电路芯片封装是利用(膜技术)及(微细加工技术),将芯片及其他要素在框架或基板上布置、粘贴固定及连接,引出接线端子并通过可塑性绝缘介质灌封固定,构成整体结构的工艺。 广义:将封装体与基板连接固定,装配成完整的系统或电子设备,并确保整个系统综合性能的工程。 2.集成电路封装的目的:在于保护芯片不受或者少受外界环境的影响,并为之提供一个良好的工作条件,以使集成电路具有稳定、正常的功能。 3.芯片封装所实现的功能:①传递电能,②传递电路信号,③提供散热途径,④结构保护与支持。 4.在选择具体的封装形式时主要考虑四种主要设计参数:性能,尺寸,重量,可靠性和成本目标。 5.封装工程的技术的技术层次? 第一层次,又称为芯片层次的封装,是指把集成电路芯片与封装基板或引脚架之间的粘贴固定电路连线与封装保护的工艺,使之成为易于取放输送,并可与下一层次的组装进行连接的模块元件。第二层次,将数个第一层次完成的封装与其他电子元器件组成一个电子卡的工艺。第三层次,将数个第二层次完成的封装组成的电路卡组合成在一个主电路版上使之成为一个部件或子系统的工艺。第四层次,将数个子系统组装成为一个完整电子厂品的工艺过程。 6.封装的分类?
按照封装中组合集成电路芯片的数目,芯片封装可分为:单芯片封装与多芯片封装两大类,按照密封的材料区分,可分为高分子材料和陶瓷为主的种类,按照器件与电路板互连方式,封装可区分为引脚插入型和表面贴装型两大类。依据引脚分布形态区分,封装元器件有单边引脚,双边引脚,四边引脚,底部引脚四种。常见的单边引脚有单列式封装与交叉引脚式封装,双边引脚元器件有双列式封装小型化封装,四边引脚有四边扁平封装,底部引脚有金属罐式与点阵列式封装。 7.芯片封装所使用的材料有金属陶瓷玻璃高分子 8.集成电路的发展主要表现在以下几个方面? 1芯片尺寸变得越来越大2工作频率越来越高3发热量日趋增大4引脚越来越多 对封装的要求:1小型化2适应高发热3集成度提高,同时适应大芯片要求4高密度化5适应多引脚6适应高温环境7适应高可靠性 9.有关名词: SIP :单列式封装 SQP:小型化封装 MCP:金属鑵式封装 DIP:双列式封装 CSP:芯片尺寸封装 QFP:四边扁平封装 PGA:点阵式封装 BGA:球栅阵列式封装 LCCC:无引线陶瓷芯片载体 第二章封装工艺流程 1.封装工艺流程一般可以分为两个部分,用塑料封装之前的工艺步骤成为前段操作,在成型之后的工艺步骤成为后段操作
某光源发出波长为460nm 的单色光,辐射功率为100W ,用Y 值表示其光通量,计算其色度坐标X 、Y 、Z 、x 、y 。 解:由教材表1-3查得460nm 单色光的三色视觉值分别为0.2908X =,0.0600Y =, 1.6692Z =,则对100W P =,有 4356831000.2908 1.98610lm 6831000.0600 4.09810lm 683100 1.6692 1.14010lm m m m X K PX Y K PY Z K PZ ==××=×==××=×==××=× 以及 )()0.144 0.030x X X Y Z y Y X Y Z =++==++=
1. GaP绿色LED的发光机理是什么,当氮掺杂浓度增加时,光谱有什么变化,为什么?GaP红色LED的发光机理是什么,发光峰值波长是多少? 答:GaP绿色LED的发光机理是在GaP间接跃迁型半导体中掺入等电子陷阱杂质N,代替P原子的N原子可以俘获电子,又靠该电子的电荷俘获空穴,形成束缚激子,激子复合发光。当氮掺杂浓度增加时,总光通量增加,主波长向长波移动,这是因为此时有大量的氮对形成新的等电子陷阱,氮对束缚激子发光峰增加,且向长波移动。 GaP红色LED的发光机理是在GaP晶体中掺入ZnO对等电子陷阱,其发光峰值波长为700nm的红光。 2. 液相外延生长的原理是什么?一般分为哪两种方法,这两种方法的区别在哪里? 答:液相外延生长过程的基础是在液体溶剂中溶质的溶解度随温度降低而减少,而且冷却与单晶相接触的初始饱和溶液时能够引起外延沉积,在衬底上生长一个薄的外延层。 液相外延生长一般分为降温法和温度梯度法两种。降温法的瞬态生长中,溶液与衬底组成的体系在均处于同一温度,并一同降温(在衬底与溶液接触时的时间和温度上,以及接触后是继续降温还是保持温度上,不同的技术有不同的处理)。而温度梯度法则是当体系达到稳定状态后,整个体系的温度再不改变,而是在溶液表面和溶液-衬底界面间建立稳定的温度梯度和浓度梯度。 3. 为何AlGaInP材料不能使用通常的气相外延和液相外延技术来制造? 答:在尝试用液相外延生长AlGaInP时,由于AlP和InP的热力学稳定性的不同,液相外延的组分控制十分困难。而当使用氢化物或氯化物气相外延时,会形成稳定的AlCl化合物,会在气相外延时阻碍含Al磷化物的成功生长。因此AlGaInP 材料不能使用通常的气相外延和液相外延技术来制造。
MSOP 是一种微型的SOP封装 半导体器件有许多封装形式,按封装的外形、尺寸、结构分类 可分为引脚插入型、表面贴装型和高级封装三类。从DIP、SOP、QFP、PGA、BGA到CSP再到SIP,技术指标一代比一代先进。总体说来,半导体封装经历了三次重大革新:第一次是在上世纪80年代从引脚插入式 封装到表面贴片封装,它极大地提高了印刷电路板上的组装密度;第 二次是在上世纪90年代球型矩阵封装的出现,满足了市场对高引脚的 需求,改善了半导体器件的性能;芯片级封装、系统封装等是现在第 三次革新的产物,其目的就是将封装面积减到最小。 高级封装实现封装面积最小化 芯片级封装CSP。几年之前封装本体面积与芯片面积之比 通常都是几倍到几十倍,但近几年来有些公司在BGA、TSOP的基础上 加以改进而使得封装本体面积与芯片面积之比逐步减小到接近1的水 平,所以就在原来的封装名称下冠以芯片级封装以用来区别以前的封 装。就目前来看,人们对芯片级封装还没有一个统一的定义,有的公 司将封装本体面积与芯片面积之比小于2的定为CSP,而有的公司将封 装本体面积与芯片面积之比小于1.4或1.2的定为CSP。目前开发应用 最为广泛的是FBGA和QFN等,主要用于内存和逻辑器件。就目前来看,CSP的引脚数还不可能太多,从几十到一百多。这种高密度、小巧、 扁薄的封装非常适用于设计小巧的掌上型消费类电子装置。 CSP封装具有以下特点:解决了IC裸芯片不能进行交流参数测试 和老化筛选的问题;封装面积缩小到BGA的1/4至1/10;延迟时间缩到 极短;CSP封装的内存颗粒不仅可以通过PCB板散热,还可以从背面散热,且散热效率良好。就封装形式而言,它属于已有封装形式的派生 品,因此可直接按照现有封装形式分为四类:框架封装形式、硬质基 板封装形式、软质基板封装形式和芯片级封装。 多芯片模块MCM。20世纪80年代初发源于美国,为解决单一芯片 封装集成度低和功能不够完善的问题,把多个高集成度、高性能、高 可靠性的芯片,在高密度多层互联基板上组成多种多样的电子模块系 统,从而出现多芯片模块系统。它是把多块裸露的IC芯片安装在一块 多层高密度互连衬底上,并组装在同一个封装中。它和CSP封装一样 属于已有封装形式的派生品。 多芯片模块具有以下特点:封装密度更高,电性能更好,与等效 的单芯片封装相比体积更小。如果采用传统的单个芯片封装的形式分 别焊接在印刷电路板上,则芯片之间布线引起的信号传输延迟就显得 非常严重,尤其是在高频电路中,而此封装最大的优点就是缩短芯片 之间的布线长度,从而达到缩短延迟时间、易于实现模块高速化的目 的。 WLCSP。此封装不同于传统的先切割晶圆,再组装测试的做法,而 是先在整片晶圆上进行封装和测试,然后再切割。它有着更明显的优
一填空题 1、LED3528小功率灯珠额定电流为___20 mA,1W灯珠额定电流为____350____mA。 2、RGB三基色指___ 红___,_____绿___,____蓝__ 三种颜色。 3、灯具驱动方式分:恒_ 流 __驱动和恒_ 压__驱动,LED光源常用恒__流 ___驱动。 4、LED灯具一般是由___ 光源,____外壳_ , __驱动电源 _等几部分组 5、光源的光效(lm/W)指光源发出___光通量除以光源所耗费的__电功率 _,它是衡量光源节能的重要指标。 6、LED调光功能的实现方式可分为两种: PWM 方式和模拟方式。 7、色温越偏蓝,色温越高,偏红则色温越低。 8、590nm波长的光是黄光;380nm波长的光是紫光(填颜色),可见光的波长范 围是 380-780 nm。 9、LED TV背光源常用到的LED芯片型号为2310,其尺寸为23mil×10mil,即 584.2 um× 254 um。 1mil=25.4um 10、T10的LED日光灯管,其直径是: 31.75 mm 。 25.4* (10/8)=31.75mm 11、目前市场主流的白光LED产品是由 InGaN(蓝光) 芯片产生的蓝光与其激发YAG 荧光粉产生的黄光混合而成的,且该方面的专利技术主要掌握在日本日亚化学公司手中。 12、对于GaAs,SiC导电衬底,具有面电极的红、黄(单电极或L型) LED芯片,采 用银胶来固晶;对于蓝宝石绝缘衬底的蓝、绿(双电极或V型)LED 芯片,采用绝缘胶来固定芯片。 13、银胶的性能和作用主要体现在:固定芯片、导电性、导热性。 14、LED胶体包括A,B,C,D胶,它们分别指的是主剂、硬化剂、 色剂、扩散剂。 15、翻译以下行业术语: 示例:外延片 Wafer (1)发光二极管 Light emitting diode (2)芯片 chip (3)荧光粉 phosphor (4)直插式LED LED Lamp
随着半导体技术的发展,摩尔定律接近失效的边缘。产业链上IC 设计、 晶圆制造、封装测试各个环节的难度不断加大,技术门槛也越来越高,资 本投入越来越大。由单个企业覆盖整个产业链工艺的难度显著加大。半导 体产业链向专业化、精细化分工发展是一个必然的大趋势。 全球半导体产业整体成长放缓,产业结构发生调整,产能在区域上重新分 配。半导体产业发达地区和不发达地区将会根据自身的优势在半导体产 业链中有不同侧重地发展。封装产能转移将持续,外包封装测试行业的增 速有望超越全行业。 芯片设计行业的技术壁垒和晶圆制造行业的资金壁垒决定了,在现阶段, 封装测试行业将是中国半导体产业发展的重点。 在传统封装工艺中,黄金成本占比最高。目前采用铜丝替代金丝是一个大 的趋势。用铜丝引线键合的芯片产品出货占比的上升有助于提高封装企 业的盈利能力。 半导体封装的发展朝着小型化和多I/O 化的大趋势方向发展。具体的技术 发展包括多I/O 引脚封装的BGA 和小尺寸封装的CSP 等。WLSCP 和 TSV 等新技术有望推动给芯片封装测试带来革命性的进步。 中国本土的封装测试企业各有特点:通富微电最直接享受全球产能转移; 长电科技在技术上稳步发展、巩固其行业龙头地位;华天科技依托地域优 势享受最高毛利率的同时通过投资实现技术的飞跃。 中国本土给封装企业做配套的上游企业,如康强电子和新华锦,都有望在 封装行业升级换代的过程中提升自己的行业地位。 风险提示:全球领先的封装测试企业在中国大陆直接投资,这将加大行 业内的竞争。同时用工成本的上升将直接影响半导体封装企业的盈利能 力。 半导体封装产能持续转移 半导体封装环节至关重要 半导体芯片的大体制备流程包括芯片设计->圆晶制造->封装测试。所谓半导体 ?封装(Packaging)?,是半导体芯片生产过程的最后一道工序,是将集成电路用绝缘的材料打包的技术。封装工艺主要有以下功能:功率分配(电源分配)、信号分配、散热通道、隔离保护和机械支持等。封装工艺对于芯片来说是必须的,也是至关重要的一个环节。因为芯片必须与外界隔离,以防止空气中的杂质对芯片电路的腐蚀而造成电气性能的下降。另外,封装后的芯片也更便于安装和运输。可以说封装是半导体集成电路与电路板的链接桥梁,封装技术的好坏还直接影响到芯片自身的性能和PCB 的设计与制造, 产业分工精细化 随着半导体产业的发展,?摩尔?定律持续地发酵,IC 芯片集成度以几何级数 上升,线宽大幅下降。以INTEL CPU 芯片为例,线宽已经由1978 年推出的8086 的3 μm 发展到2010 年推出Core i 7 的45nm , 对应的晶体管集成度由2.9 万只发展到7.8 亿只。产业链上IC 设计、晶圆制造、封装测试各个环节的难度不断加大,技术门槛也越来越高。同时随着技术水平的飞升和规模的扩大,产业链中的多个环节对资本投入的要求也大幅提高。由单个企业做完覆盖整个产业链工艺的难度越来越大。在这样的大环境下,产业链向专业化、精细化分工发展是一个必然的大趋势。 目前全球的半导体产业链大致可以归纳为几大类参与者:IDM 集成设备制造商;
1 半导体器件封装概述 电子产品是由半导体器件(集成电路和分立器件)、印刷线路板、导线、整机框架、外壳及显示等部分组成,其中集成电路是用来处理和控制信号,分立器件通常是信号放大,印刷线路板和导线是用来连接信号,整机框架外壳是起支撑和保护作用,显示部分是作为与人沟通的接口。所以说半导体器件是电子产品的主要和重要组成部分,在电子工业有“工业之米"的美称。 我国在上世纪60年代自行研制和生产了第一台计算机,其占用面积大约为100 m2以上,现在的便携式计算机只有书包大小,而将来的计算机可能只与钢笔一样大小或更小。计算机体积的这种迅速缩小而其功能越来越强大就是半导体科技发展的一个很好的佐证,其功劳主要归结于:(1)半导体芯片集成度的大幅度提高和晶圆制造(Wafer fabrication)中光刻精度的提高,使得芯片的功能日益强大而尺寸反而更小;(2)半导体封装技术的提高从而大大地提高了印刷线路板上集成电路的密集度,使得电子产品的体积大幅度地降低。 半导体组装技术(Assembly technology)的提高主要体现在它的封装型式(Package)不断发展。通常所指的组装(Assembly)可定义为:利用膜技术及微细连接技术将半导体芯片(Chip)和框架(Leadframe)或基板(Sulbstrate)或塑料薄片(Film)或印刷线路板中的导体部分连接以便引出接线引脚,并通过可塑性绝缘介质灌封固定,构成整体立体结构的工艺技术。它具有电路连接,物理支撑和保护,外场屏蔽,应力缓冲,散热,尺寸过度和标准化的作用。从三极管时代的插入式封装以及20世纪80年代的表面贴装式封装,发展到现在的模块封装,系统封装等等,前人已经研究出很多封装形式,每一种新封装形式都有可能要用到新材料,新工艺或新设备。 驱动半导体封装形式不断发展的动力是其价格和性能。电子市场的最终客户可分为3类:家庭用户、工业用户和国家用户。家庭用户最大的特点是价格便宜而性能要求不高;国家用户要求高性能而价格通常是普通用户的几十倍甚至几千倍,主要用在军事和航天等方面;工业用户通常是价格和性能都介于以上两者之间。低价格要求在原有的基础上降低成本,这样材料用得越少越好,一次性产出越大越好。高性能要求产品寿命长,能耐高低温及高湿度等恶劣环境。半导体生产厂家时时刻刻都想方设法降低成本和提高性能,当然也有其它的因素如环保要求和专利问题迫使他们改变封装型式。 2 封装的作用 封装(Package)对于芯片来说是必须的,也是至关重要的。封装也可以说是指安装半导体集成电路芯片用的外壳,它不仅起着保护芯片和增强导热性能的作用,而且还是沟通芯片内部世界与外部电路的桥梁和规格通用功能的作用。封装的主要作用有: (1)物理保护。因为芯片必须与外界隔离,以防止空气中的杂质对芯片电路的腐蚀而造成电气性能下降,保护芯片表面以及连接引线等,使相当柔嫩的芯片在电气或热物理等方面免受外力损害及外部环境的影响;同时通过封装使芯片的热膨胀系数与框架或基板的热膨胀系数相匹配,这样就能缓解由于热等外部环境的变化而产生的应力以及由于芯片发热而产生的应力,从而可防止芯片损坏失效。基于散热的要求,封装越薄越好,当芯片功耗大于2W时,在封装上需要增加散热片或热沉片,以增强其散热冷却功能;5~1OW 时必须采取强制冷却手段。另一方面,封装后的芯片也更便于安装和运输。 (2)电气连接。封装的尺寸调整(间距变换)功能可由芯片的极细引线间距,调整到实装基板的尺寸间距,从而便于实装操作。例如从以亚微米(目前已达到0.1 3μm以下)为特征尺寸的芯片,到以10μm为单位的芯片焊点,再到以100μm为单位的外部引脚,最后剑以毫米为单位的印刷电路板,都是通过封装米实
LED半导体照明的发展与应用 者按:半导体技术在上个世纪下半叶引发的一场微电子革命,催生了微电子工业和高科技IT产业,改变了整个世界的面貌。今天,化合物半导体技术的迅猛发展和不断突破,正孕育着一场新的革命——照明革命。新一代照明光源半导体LED,以传统光源所没有的优点引发了照明产业技术和应用的革命。半导体LED固态光源替代传统照明光源是大势所趋。1、LED半导体照明的机遇 (1)全球性的能源短缺和环境污染在经济高速发展的中国表现得尤为突出,节能和环保是中国实现社会经济可持续发展所急需解决的问题。作为能源消耗大户的照明领域,必须寻找可以替代传统光源的新一代节能环保的绿色光源。 (2)半导体LED是当今世界上最有可能替代传统光源的新一代光源。 其具有如下优点: ①高效低耗,节能环保; ②低压驱动,响应速度快安全性高; ③固体化封装,耐振动,体积小,便于装配组合; ④可见光区内颜色全系列化,色温、色纯、显色性、光指向性良好,便于照明应用组合; ⑤直流驱动,无频闪,用于照明有利于保护人眼视力; ⑥使用寿命长。 (3)现阶段LED的发光效率偏低和光通量成本偏高是制约其大规模进入照明领域的两大瓶颈。目前LED的应用领域主要集中在信号指示、智能显示、汽车灯具、景观照明和特殊照明领域等。但是,化合物半导体技术的迅猛发展和关键技术的即将突破,使今天成为大力发展半导体照明产业的最佳时机。2003年我国人均GDP首次突破1000美元大关,经济实力得到了进一步的增强,市场上已经初步具备了接受较高光通量成本(初始成本)光
源的能力。在未来的10~20年内,用半导体LED作为光源的固态照明灯,将逐渐取代传统的照明灯。 (4)各国政府予以高度重视,相继推出半导体照明计划,已形成世界性的半导体照明技术合围突破的态势。 ①美国:“下一代照明计划”时间是2000~2010年投资5亿美元。美国半导体照明发展蓝图如表1所示; ②日本:“21世纪的照明计划”,将耗费60亿日元推行半导体照明目标是在2006年用白光LED替代50%的传统照明; ③欧盟:“彩虹计划”已在2000年7月启动通过欧共体的资助推广应用白光LED照明; ④中国:2003年6月17日,由科技部牵头成立了跨部门、跨地区、跨行业的“国家半导体照明工程协调领导小组”。从协调领导小组成立之日到2005年年底之前,将是半导体照明工程项目的紧急启动期。从2006年的“十一五”开始,国家将把半导体照明工程作为一个重大项目进行推动; (5)我国 的半导体LED产业链经过多年的发展已相对完善,具备了一定的发展基础。同时,我国又是照明灯具产业的大国,只要政府和业界协调整合好,发展半导体LED照明产业是大有可为的; 2LED的发展历程(如图1所示) 2.1LED技术突破的历程
最新封装技术与发展 芯片制作流程 封装大致经过了如下发展进程: 结构方面:DIP 封装(70 年代)->SMT 工艺(80 年代LCCC/PLCC/SOP/QFP)->BGA 封装(90 年代)->面向未来的工艺(CSP/MCM) 材料方面:金属、陶瓷->陶瓷、塑料->塑料; 引脚形状:长引线直插->短引线或无引线贴装->球状凸点; 装配方式:通孔插装->表面组装->直接安装 封装技术各种类型 一.TO 晶体管外形封装 TO (Transistor Out-line)的中文意思是“晶体管外形”。这是早期的封装规格,例如TO-92,TO-92L,TO-220,TO-252 等等都是插入式封装设计。近年来表面贴装市场需求量增大,TO 封装也进展到表面贴装式封装。 TO252 和TO263 就是表面贴装封装。其中TO-252 又称之为D-PAK,TO-263 又称之为D2PAK。D-PAK 封装的MOSFET 有3 个电极,栅极(G)、漏极(D)、源极(S)。其中漏极(D)的引脚被剪断不用,而是使用背面的散热板作漏极(D),直接焊接在PCB 上,一方面用于输出大电流,一方面通过PCB 散热。所以PCB 的D-PAK 焊盘有三处,漏极(D)焊盘较大。
二.DIP 双列直插式封装 DIP(DualIn-line Package)是指采用双列直插形式封装的集成电路芯片,绝大多数中小规模集成电路(IC)均采用这种封装形式,其引脚数一般不超过100 个。封装材料有塑料和陶瓷两种。采用DIP 封装的CPU 芯片有两排引脚,使用时,需要插入到具有DIP 结构的芯片插座上。当然,也可以直接插在有相同焊孔数和几何排列的电路板上进行焊接。DIP 封装结构形式有:多层陶瓷双列直插式DIP,单层陶瓷双列直插式DIP,引线框架式DIP (含玻璃陶瓷封接式,塑料包封结构式,陶瓷低熔玻璃封装式)等。 DIP 封装具有以下特点: 1.适合在PCB (印刷电路板)上穿孔焊接,操作方便。 2. 比TO 型封装易于对PCB 布线。 3.芯片面积与封装面积之间的比值较大,故体积也较大。以采用40 根I/O 引脚塑料双列直插式封装(PDIP)的CPU 为例,其芯片面积/封装面积=(3×3)/(15.24×50)=1:86,离1 相差很远。(PS:衡量一个芯片封装技术先进与否的重要指标是芯片面积与封装面积之比,这个比值越接近1 越好。如果封装尺寸远比芯片大,说明封装效率很低,占去了很多有效安装面积。) 用途:DIP 是最普及的插装型封装,应用范围包括标准逻辑IC,存贮器LSI,微机电路等。Intel 公司早期CPU,如8086、80286 就采用这种封装形式,缓存(Cache )和早期的内存芯片也是这种封装形式。 三.QFP 方型扁平式封装 QFP(Plastic Quad Flat Pockage)技术实现的CPU 芯片引脚之间距离很小,管脚很细,一般大规模或超大规模集成电路采用这种封装形式,其引脚数一般都在100 以上。基材有陶瓷、金属和塑料三种。引脚中心距有1.0mm、0.8mm、0.65mm、0.5mm、0.4mm、0.3mm 等多种规格。 其特点是: 1.用SMT 表面安装技术在PCB 上安装布线。 2.封装外形尺寸小,寄生参数减小,适合高频应用。以0.5mm 焊区中心距、208 根I/O 引脚QFP 封装的CPU 为例,如果外形尺寸为28mm×28mm,芯片尺寸为10mm×10mm,则芯片面积/封装面积=(10×10)/(28×28)=1:7.8,由此可见QFP 封装比DIP 封装的尺寸大大减小。 3.封装CPU 操作方便、可靠性高。 QFP 的缺点是:当引脚中心距小于0.65mm 时,引脚容易弯曲。为了防止引脚变形,现已出现了几种改进的QFP 品种。如封装的四个角带有树指缓冲垫的BQFP(见右图);带树脂保护环覆盖引脚前端的GQFP;在封装本体里设置测试凸点、放在防止引脚变形的专用夹具里就可进行测试的TPQFP 。 用途:QFP 不仅用于微处理器(Intel 公司的80386 处理器就采用塑料四边引出扁平封装),门陈列等数字逻辑LSI 电路,而且也用于VTR 信号处理、音响信号处理等模拟LSI 电路。四.SOP 小尺寸封装 SOP 器件又称为SOIC(Small Outline Integrated Circuit),是DIP 的缩小形式,引线中心距为1.27mm,材料有塑料和陶瓷两种。SOP 也叫SOL 和DFP。SOP 封装标准有SOP-8、SOP-16、SOP-20、SOP-28 等等,SOP 后面的数字表示引脚数,业界往往把“P”省略,叫SO (Small Out-Line )。还派生出SOJ (J 型引脚小外形封装)、TSOP (薄小外形封装)、VSOP (甚小外形封装)、SSOP (缩小型SOP )、TSSOP (薄的缩小型SOP )及SOT (小外形晶
《半导体照明技术及其应用》课程教学大纲 (秋季) 一、课程名称:半导体照明技术及其应用Semiconductor Lighting Technology and Applications 二、课程编码: 三、学时与学分:32/2 四、先修课程: 微积分、大学物理、固体物理、半导体物理、微电子器件与IC设计 五、课程教学目标: 半导体照明是指用全固态发光器件LED作为光源的照明,具有高效、节能、环保、寿命长、易维护等显著特点,是近年来全球最具发展前景的高新技术领域之一,是人类照明史上继白炽灯、荧光灯之后的又一场照明光源的革命。本课程注重理论的系统性﹑结构的科学性和内容的实用性,在重点讲解发光二极管的材料、机理及其制造技术后,详细介绍器件的光电参数测试方法,器件的可靠性分析、驱动和控制方法,以及各种半导体照明的应用技术,使学生学完本课程以后,能对半导体照明有深入而全面的理解。 六﹑适用学科专业:电子科学与技术 七、基本教学内容与学时安排: 绪论(1学时) 半导体照明简介、学习本课程的目的及要求 第一章光视觉颜色(2学时) 1光的本质 2光的产生和传播 3人眼的光谱灵敏度 4光度学及其测量 5作为光学系统的人眼 6视觉的特征与功能 7颜色的性质 8国际照明委员会色度学系统 9色度学及其测量 第二章光源(1学时) 1太阳 2月亮和行星 3人工光源的发明与发展 4白炽灯 5卤钨灯 6荧光灯 7低压钠灯
8高压放电灯 9无电极放电灯 10发光二极管 11照明的经济核算 第三章半导体发光材料晶体导论(2学时) 1晶体结构 2能带结构 3半导体晶体材料的电学性质 4半导体发光材料的条件 第四章半导体的激发与发光(1学时) 1PN结及其特性 2注入载流子的复合 3辐射与非辐射复合之间的竞争 4异质结构和量子阱 第五章半导体发光材料体系(2学时) 1砷化镓 2磷化镓 3磷砷化镓 4镓铝砷 5铝镓铟磷 6铟镓氮 第六章半导体照明光源的发展和特征参量(1学时)1发光二极管的发展 2发光二极管材料生长方法 3高亮度发光二极管芯片结构 4照明用LED的特征参数和要求 第七章磷砷化镓、磷化镓、镓铝砷材料生长(3学时)1磷砷化镓氢化物气相外延生长(HVPE) 2氢化物外延体系的热力学分析 3液相外延原理 4磷化镓的液相外延 5镓铝砷的液相外延 第八章铝镓铟磷发光二极管(2学时) 1AlGaInP金属有机物化学气相沉积通论 2外延材料的规模生产问题 3电流扩展 4电流阻挡结构 5光的取出 6芯片制造技术
SMT工艺技术基础:半导体元器件封装技术 摘要:摘要:SMT工艺控制的主要目的就是有一个良好的焊接效果。工艺控制水平是影响焊接的关键因素,设计和材料则直接影响焊接效果 ... 摘要:SMT工艺控制的主要目的就是有一个良好的焊接效果。工艺控制水平是影响焊接的关键因素,设计和材料则直接影响焊接效果。本文主要涉及焊接材料的相关知识,如PCB的表面材料及其处理工艺,元器件的引脚材料等。 焊接与2个表面 焊接是用熔融的填充金属使结合点表面润湿且在两个金属部件之间形成冶金的键合,填充金属的熔点要低于450度。英文名字叫做Soldering,意为“用在接触处熔化的非铁填充金属(诸如黄铜和钎焊料之类,其熔点低于基体金属的熔点)来焊接金属”。对于较高温度熔点的填充金属,焊接工艺被规类为硬铅焊。 每每谈到焊接工艺,尤其在选择Flux时,我们首先要考虑两个表面:管脚表面和焊盘表面。 一般很少有人去关心管脚表面的材料究竟是什么样一种东西,因为大部分元器件都是供应商大批量生产和供货的,元器件的焊接部位采用什么样的表面处理工艺大部分由元器件制造商来决定,而PCB组装厂很难对其进行严格的控制。而且,针对不同的PCB组装厂来定制元器件管脚表面的处理工艺是不划算的,当然除了特殊情况。因此,对于SMT工艺工程师和来料检测人员来讲,应该把关注的重点放在元器件的可焊性上,尤其是来料检测人员必须确保元器件的可焊性。 而PCB就完全不一样了,因为每一个产品的PCB都是量身定作的,设计人员和工艺工程师可以决定让PCB制造厂采用哪种合适的材料和PCB表面处理工艺,并对焊盘的可焊性进行严格要求和控制。更为重要的是,为了把PCB组装缺陷降到最低,设计人员必须明确规定采用那些可焊性好的材料来处理焊盘表面,以及他们的具体的技术规格;是来料检测人员则要对来料的可焊性进行严格检查。 常用的几种焊接金属 1、裸铜 经过化学清洗的裸铜是最容易焊接的一种材料,即使采用非常柔和的助焊剂;而且裸铜的处理工艺简单经济。但是裸铜很容易氧化和失去光泽,从而导致可焊性急剧下降,除非在回流焊炉中有强劲的Flux(松香基)保护铜表面。如果生产中用到了裸铜表面,在使用和储藏(储藏时间要尽量短)当中必须注意裸铜的可焊性!裸铜不能储存在含有硫的环境中,如纸、纸板、印刷品,因为硫很容易使铜生锈。 2、金
LED具有高光效能,比传统霓虹灯节省电能80%以上,工作安全可靠。LED改变了白炽灯钨丝发光与节能灯三基色粉发光的原理,而采用电场发光。LED光源具有寿命长、光效高、无辐射与低功耗等特点。LED的光谱几乎全部集中于可见光频段,其发光效率可达80%~90%。将LED与普通白炽灯、螺旋节能灯及T5三基色荧光灯进行比较,其结果显示:普通白炽灯的光效为12lm/W,寿命小于2000h;螺旋节能灯的光效为60lm/W,寿命小于8000h;T5三基色荧光灯的光效则为96lm/W,寿命大约为10000h;而直径为5mm的白光LED的光效为 20~28lm/W,寿命可大于100000h。 (1)LED照明产品 在爱迪生1879年发明碳丝白炽灯之后,照明技术便进入一个崭新的时代。回顾20世纪的照明史,荧光灯、汞灯、高/低压钠灯、金属卤化物灯、紧凑型荧光灯、高频无极荧光灯以及微波硫灯等新光源层出不穷。白炽灯从其问世的那一天起就带有先天性缺陷,钨丝加热耗电大,灯泡易碎,而且容易使人触电。荧光灯虽说比白炽灯节电节能,但对人的视力不利,灯管内的汞也有害于人体和环境。真正引发照明技术发生质变的还是LED。与传统照明技术相比,LED的最大区别是结构和材料不同,它是一种能够将电能转化为可见光的半导体,上下两层装有电极,中间有导电材料,可以发光的材料在两电极的夹层中,光的颜色根据材料性质的不同而有所变化。 LED属于全固体冷光源,体积更小,重量更轻,结构更坚固,而且工作电压低,使用寿命长。按照通常的光效定义,LED的发光效率并不高,但由于LED的光谱几乎全部集中于可见光频段,效率可达80%~90%。而同等光效的白炽灯的可见效率仅为10%~20%。单体LED 的功率一般为0.05~1W,通过集群方式可以满足不同需要。 LED照明产品就是利用LED作为光源制造出来的照明器具,在照明领域LED发光产品的应用正吸引着世人的目光。LED作为一种新型的绿色光源产品,必然是未来发展的趋势,21世纪将进入以LED为 代表的新型照明光源时代。 (2)LED光源的优点 ①新型绿色环保光源:LED运用冷光源,眩光小,无辐射,使用中不产生有害物质。LED的工作电压低,采用直流驱动方式,超低功耗(单管0.03~0.06W),电光功率转换接近100%,在相同照明效果下
1. GaP绿色LED的发光机理是什么,当氮掺杂浓度增加时,光谱有什么变化,为什么?GaP红色LED的发光机理是什么,发光峰值波长是多少?答:GaP绿色LED的发光机理是在GaP间接跃迁型半导体中掺入等电子陷阱杂质N,代替P原子的N原子可以俘获电子,又靠该电子的电荷俘获空穴,形成束缚激子,激子复合发光。当氮掺杂浓度增加时,总光通量增加,主波长向长波移动,这是因为此时有大量的氮对形成新的等电子陷阱,氮对束缚激子发光峰增加,且向长波移动。 GaP红色LED的发光机理是在GaP晶体中掺入ZnO对等电子陷阱,其发光峰值波长为700nm的红光。 2. 液相外延生长的原理是什么?一般分为哪两种方法,这两种方法 的区别在哪里? 答:液相外延生长过程的基础是在液体溶剂中溶质的溶解度随温度 降低而减少,而且冷却与单晶相接触的初始饱和溶液时能够引起外 延沉积,在衬底上生长一个薄的外延层。 液相外延生长一般分为降温法和温度梯度法两种。降温法的瞬态生 长中,溶液与衬底组成的体系在均处于同一温度,并一同降温(在 衬底与溶液接触时的时间和温度上,以及接触后是继续降温还是保 持温度上,不同的技术有不同的处理)。而温度梯度法则是当体系 达到稳定状态后,整个体系的温度再不改变,而是在溶液表面和溶 液-衬底界面间建立稳定的温度梯度和浓度梯度。 3. 为何AlGaInP材料不能使用通常的气相外延和液相外延技术来制造?答:在尝试用液相外延生长AlGaInP时,由于AlP和InP的热力学稳定性的不同,液相外延的组分控制很困难。而当使用氢化物或氯化物气相外延时,会形成稳定的AlCl化合物,会在气相外延时阻碍含Al磷化物的成功生长。故AlGaInP材料不能用通常的气相外延和液相外延技术来制造。 4. 对三基色体系的白光LED,列出基色光源的三个最佳峰值波长。对荧光转换的白光LED和多芯片的白光LED,这三基色用什么方法来实现?答:三基色体系的白光LED,基色光源的三个最佳峰值波长分别为450nm、540nm和610nm。对荧光转换的白光LED,是用部分被吸收的AlInGaN 芯片的蓝光和适当的绿光和橙红光两种荧光粉来实现。对多芯片白光LED,是用峰值波长600nm附近的AlGaInP基LED,以及峰值波长450nm 和540nm的AlInGaN LED组成。 5. 简要说明LED封装技术发展三个阶段的时间范围、典型LED及其驱动电流、器件应用领域。 答:LED封装技术发展的3个阶段分别为: (1)1962~1989年期间,典型的LED为?3和?5的LED,驱动电流一般小于等于20mA,主要用做信号指示和显示。 (2)1990~1999年,发展了大光通量LED食人鱼和Snap,驱动电流在50~150mA,主要用于大型信号指示,如汽车信号灯、景观照明。 (3)2000年至今,研发和生产了功率型LED,电流≥350mA,开始用于照明,并开始了更大光通量输出的组件的研制和生产。 6. 画出透明衬底的AlGaInP LED的结构示意图,简要说明其芯片制造流程。 答:结构示意图如下图所示。 此LED结构用的是MOCVD生长在GaAs上的双异质结(AlxGa1-x)0.5In0.5P,并在结构上方VPE生长一个小于50μm厚的GaP 窗层。在外延生长后,用通常的化学腐蚀技术移除GaAs吸收衬底,使双异质结结构的N型层暴露,再通过升高温度和加压,将晶片黏结到200~250μm厚的N型GaP衬底上。1. 画出典型的具有GaP窗层和吸收衬底的双异质结AlGaInP LED的结构示意图,简述为什么需要使用电流扩展窗层。 答:结构示意图如下图所示。 为了使LED芯片获得高效的发光,电流扩展是主要关键之一,如 上图的结构,器件的上方覆盖了圆形的金属顶,电流从芯片的顶部 接触通过P型层流下到达结区,在结区发光。但是假如P型层的电 阻太高,电流将扩展很少,而仅仅限在金属之下,光仅仅发生在电极 之下,而且被芯片内部吸收。有效的最好性能的AlGaInP LED是在 通常的双异质结顶部再生长一个厚的P型窗层,而不用AlGaInP材 料。这个电流扩展窗层与AlGaInP相比,具有高的薄层电导率,而 且对发射光是透明的,可以达到很好的电流扩展效果。 4.LED作为城市景观照明中的首选光源的优点:①色彩丰富纯度高、节能②响应时间短,瞬时达到全光输出,可深度调光③体积小、方向 性强④直流低压驱动,简化系统设计,降低电路成本⑤寿命长,工作 安全可靠,维护费用大大降低。景观常用LED灯具有护栏灯、树灯 5. LED的电学性能特点:LED是单向导电器件。LED是个具有PN结结构的半导体器件,具有势垒电势,所以就有导通阈值电压。LED的电流—电压特性是非线性的。LED的正向压降与PN结结温的温度系数为负。流过LED的电流和LED的光通量的比值也是非线性的。 6. 电源驱动方案:(1)低电压驱动。是指用低于LED正向导通压降的电压驱动LED,如一节普通干电池、镍镉电池供电的低功耗照明器件,LED 手电、头灯、应急灯、路障灯、节能台灯等,采用电荷泵式升压变换器(2)过渡电压驱动。是指给LED供电的电源电压值在LED正向压降附近变动。如一节锂电池或两节串联的铅酸蓄电池,电池充满时在4V以上,快用完时在3V以下,应用有矿灯等,是反极性电荷泵式变换器(3)高压驱动。是指给LED供电的电压值高于LED的正向压降,如6V.12V.24V蓄电池,应用有太阳能草坪灯、太阳能庭院灯等,变换器电路是串联开关降压电路。(4)市电驱动。是对半导体照明应用最具有价值的供电方式,中小功率LED采用隔离式单端反激变换器,大功率用桥式变换电路。 7.可靠性试验指:产品在规定的条件下、在规定的时间内完成规定的功能的能力。产品在设计、应用过程中,不断经受自身及外界气候环境及机械环境的影响,而仍需要能够正常工作,这就需要以试验设备对其进行验证,按试验目的可分为筛选试验、例行试验、鉴定验收试验;按照试验项目可分为环境试验和寿命试验。 8. (1)平均寿命:指一批电子器件产品寿命的平均值(2)可靠寿命:指一批电子器件产品的可靠度下降到时,所经历的工作时间(3)中位寿命:指产品的可靠度降为50%时的寿命(4)特征寿命:指产品的可靠度降为1/e时的寿命(5)LED的寿命:通常用“半衰期”即器件的光输出下降到起始值50%时的时间作为LED的寿命。 用B50和L70来表示功率LED的寿命。L70(B50)表示功率LED比起初始值来,平均流明值下降到维持70%(50%)的时间。 9. 画出器件失效率随时间变化的曲线,说明曲线的各个阶段及其失 效原因。 答:曲线如图分为三个阶段: 第一个阶段称为早期失效或 老化阶段,失效率较高,随工作时间的延长而迅速下降。造成早期 失效的原因大多属生产型缺陷,由产品本身存在的缺陷所致。 第二个阶段为有效寿命阶段,又称随机失效阶段,失效率很低且 很稳定,近似为常数,器件失效往往带有偶然性。 第三个阶段称耗损失效阶段,失效率明显上升,大部分器件相继出现 失效,耗损失效都由于老化、磨损和疲劳等原因使器件性能恶化所致。 10. 伏安特性指流过PN结的电流随电压变化的特性,应将正、反向均包括在内。(1)反向击穿电压Vb:表示器件反向耐压高低的参数,通常是指一定漏电流下器件两端的反向电压值(2)反向电流Ir:给定反向电压下流过器件的反向电流值(3)正向电压Vf:指定正向电流下器件两端的正向电压值。作用:标志着结的体电阻及欧姆接触串联电阻的高低,可在一定程度上反应电极制作的好坏 12. 热管是依靠自身内部工质液相和气体二相变化来实现传热的导热元件,它是由高纯度的无氧铜管及铜丝网或铜粉烧结物组成,内充液体为工作介质。当受热端将工作液相蒸发成气相,气流经过中空管道流到冷却端,冷却后将工作流体凝结成液相,冷凝液借助于铜丝网或铜粉烧结物的毛细组织吸回受热端,完成吸热-放热循环,可在一定温差下将热量传导出。具有重量轻、结构简单、热传输量大、耐用寿命长、导热能力强等优点。回路热管比单管热管效率更高且不受位置影响。