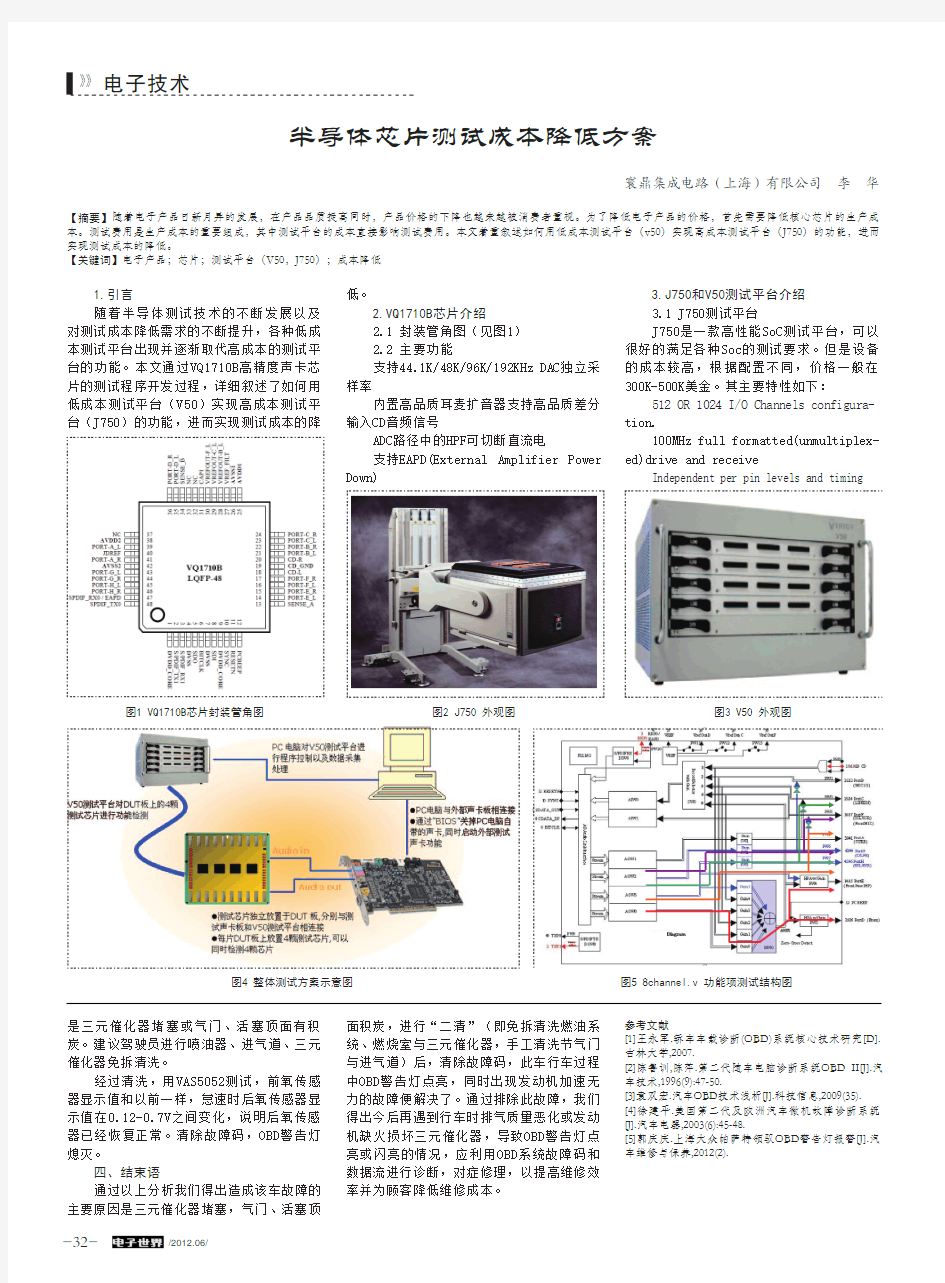

-32-
/2012.06/
是三元催化器堵塞或气门、活塞顶面有积
炭。建议驾驶员进行喷油器、进气道、三元催化器免拆清洗。
经过清洗,用VAS5052测试,前氧传感器显示值和以前一样,怠速时后氧传感器显示值在0.12-0.7V之间变化,说明后氧传感器已经恢复正常。清除故障码,OBD警告灯熄灭。
四、结束语
通过以上分析我们得出造成该车故障的主要原因是三元催化器堵塞,气门、活塞顶
面积炭,进行“二清”(即免拆清洗燃油系统、燃烧室与三元催化器,手工清洗节气门与进气道)后,清除故障码,此车行车过程中OBD警告灯点亮,同时出现发动机加速无力的故障便解决了。通过排除此故障,我们得出今后再遇到行车时排气质量恶化或发动机缺火损坏三元催化器,导致OBD警告灯点亮或闪亮的情况,应利用OBD系统故障码和数据流进行诊断,对症修理,以提高维修效率并为顾客降低维修成本。
参考文献
[1]王永军.轿车车载诊断(OBD)系统核心技术研究[D].吉林大学,2007.
[2]陈鲁训,陈萍.第二代随车电脑诊断系统OBD II[J].汽车技术,1996(9):47-50.
[3]袁双宏.汽车OBD技术浅析[J].科技信息,2009(35).[4]徐建平.美国第二代及欧洲汽车微机故障诊断系统[J].汽车电器,2003(6):45-48.
[5]郭庆庆.上海大众帕萨特领驭OBD警告灯报警[J].汽车维修与保养,2012(2).
半导体芯片测试成本降低方案寰鼎集成电路(上海)有限公司 李 华
【摘要】随着电子产品日新月异的发展,在产品品质提高同时,产品价格的下降也越来越被消费者重视。为了降低电子产品的价格,首先需要降低核心芯片的生产成本。测试费用是生产成本的重要组成,其中测试平台的成本直接影响测试费用。本文着重叙述如何用低成本测试平台(v50)实现高成本测试平台(J750)的功能,进而实现测试成本的降低。
【关键词】电子产品;芯片;测试平台(V50,J750);成本降低
1.引言
随着半导体测试技术的不断发展以及对测试成本降低需求的不断提升,各种低成本测试平台出现并逐渐取代高成本的测试平台的功能。本文通过VQ1710B高精度声卡芯片的测试程序开发过程,详细叙述了如何用低成本测试平台(V50)实现高成本测试平台(J750)的功能,进而实现测试成本的降
低。
2.VQ1710B芯片介绍
2.1 封装管角图(见图1)2.2 主要功能
支持44.1K/48K/96K/192KHz DAC独立采样率
内置高品质耳麦扩音器支持高品质差分输入CD音频信号
ADC路径中的HPF可切断直流电
支持EAPD(External Amplifier Power Down) 3.J750和V50测试平台介绍3.1 J750测试平台
J750是一款高性能SoC测试平台,可以很好的满足各种Soc的测试要求。但是设备的成本较高,根据配置不同,价格一般在300K-500K美金。其主要特性如下:
512 OR 1024 I/O Channels configura-tion.
100MHz full formatted(unmultiplex-ed)drive and receive
Independent per pin levels and timing
图1?VQ1710B芯片封装管角图
图2?J750?外观图图3?V50?外观图?
图4?整体测试方案示意图图5?8channel.v?功能项测试结构图
-33-
/2012.06
256 global time sets,32 per pin edge sets
6 edges per pin up to 50MHz,and 4 edges per pin up to 100MHz
3.2 V50测试平台介绍
V50是惠瑞杰旗下的一款多功能测试平台,可以测试数字类产品(测试频率低于50HZ),模拟类产品以及混合信号类产品,是中低端测试平台中性价比非常高的一款测试机,根据配置不同,价格一般在70K-150K 美金。其主要特性如下:
Channel count:64 channels per logic board
Maximum 256 channels for one system Parallelism:maximum 8-site
Scalability:different kinds of the board can
Signal Docking:256 channel cable mount
4.芯片功能测试项
判断一颗芯片是良品还是不良品,都是
透过检测其功能项来进行判断。如果所有的功能项均测试合格,则该芯片为良品。若有一项不通过,则为不良品。该芯片的功能测试项见表1。
由于文章篇幅的关系,以下着重介绍V50如何实现DA_PATH下的8Channel.v功能项(表一中的第10项)的测试。该功能测试项主要是检测该声卡芯片8个音频输入输出通道通道是否正常。
5.V50测试方案
5.1 整体测试方案示意图(见图4)5.2 DA_PATH之8channel.v功能项测试结构图(见图5)
在测试该功能项之前,V50测试平台会通过测试程序将芯片上Poat A–H 8个音频输入输出通道通道打开,并且输入频率为1KHZ,振幅为±2V的正弦波,然后对输出波形进行采集,比较。
6.软件实现
6.1 软件流程图(见图6)6.2 软件程序(C语言)
***********以下为检测PortA通道的子程序***************
@@PLAN DA_PORT_A
SITE_SEQUENCE=OFF;
DISABLE_BY_MARK_NO=NULL; S_SETUP_FILE=c:\set.dat; REMARK=DA_PORT_A; DC_INIT(); CLEAR_CONT();
LOGIC_CLOSE_DPS_OUTPUT_RELAY(1,ON);
LOGIC_CLOSE_DPS_OUTPUT_RELAY(2,ON);// V50初始化
LOGIC_FORCE_DPS(1,2.97V,100MA,-100MA,E1,I7,VI_MODE);
LOGIC_FORCE_DPS(2,4.5V,100MA, -100MA,E1,I7,VI_MODE);// 开启芯片工作电压
LOGIC_CLOSE_PE_RELAY(DIGITAL_PINS); LOGIC_SET_DRV_LEVEL(DIGITAL_PINS, 3.3V, 0.0V, VR0);
LOGIC_SET_CMP_LEVEL(DIGITAL_PINS, 1.485V, 1.485V, VR0);// V50测试管角设置
LOGIC_CLOSE_USER_RELAY("29,24");// 开通PortA通道
WAIT(1MS); V50MesgToClient(DA_PORT_A);
RUN_PATTERN(B1_8CH_1121:start,B1_8CH_1121:end,1,5);//设置芯片工作模式并启动测试
V50MesgToClient(MSG_START_RE-CORD);// 记录,处理测试数据
WAIT(10MS);Sleep(1);
int R1 = V50GetViaResult( ); GB[1] = R1;
PRINT_LOG(GB2,GB2);// 调用比较软件,输出测试结果(Pass or Fail)
CONDITION IF_FAIL
REJECT_BIN=14;//根据测试结果,进行好坏品归类
@@END_PLAN
****************************************
7.结束语
通过本案的方案,测试平台的购置成本至少降低50%以上,大大缩减了测试成本。同时希望更多的低成本平台可以实现更多高成本平台的功能,通过测试设备成本降低的方式缩减测试费用,从而降低产品成本,最终惠及终端用户。
参考文献
[1]刘恩科,朱秉升.半导体物理学[M].西安:西安交通大学出版社,1998.
[2]朱正涌.半导体集成电路[M].北京:清华大学出版社,2001.
[3]李亚伯.数字电路与系统[M].北京:电子工业出版社,2001.
[4]王毓银.数字电路逻辑设计[M].北京:高等教育出版社,1999.
[5]曹培栋,亢宝位.微电子技术基础[M].北京:电子工业出版社,2001
.
表1?芯片功能测试项列表
图6?软件流程图
图6?软件流程图
半导体材料吸收光谱测试分析 一、实验目的 1.掌握半导体材料的能带结构与特点、半导体材料禁带宽度的测量原理与方法。 2.掌握紫外可见分光光度计的构造、使用方法和光吸收定律。 二、实验仪器及材料 紫外可见分光光度计及其消耗品如氘灯、钨灯,玻璃基ZnO薄膜。 三、实验原理 1.紫外可见分光光度计的构造、光吸收定律 (1)仪器构造:光源、单色器、吸收池、检测器、显示记录系统。 a.光源:钨灯或卤钨灯——可见光源,350~1000nm;氢灯或氘灯——紫外光源,200~360nm。 b.单色器:包括狭缝、准直镜、色散元件 色散元件:棱镜——对不同波长的光折射率不同分出光波长不等距; 光栅——衍射和干涉分出光波长等距。 c.吸收池:玻璃——能吸收UV光,仅适用于可见光区;石英——不能吸收紫外光,适用于紫外和可见光区。 要求:匹配性(对光的吸收和反射应一致) d.检测器:将光信号转变为电信号的装置。如:光电池、光电管(红敏和蓝敏)、光电倍增管、二极管阵列检测器。 紫外可见分光光度计的工作流程如下: 0.575 光源单色器吸收池检测器显示双光束紫外可见分光光度计则为: 双光束紫外可见分光光度计的光路图如下:
(2)光吸收定律 单色光垂直入射到半导体表面时,进入到半导体内的光强遵照吸收定律: x x e I I?- =α d t e I I?- =α 0(1) I0:入射光强;I x:透过厚度x的光强;I t:透过膜薄的光强;α:材料吸收系数,与材料、入射光波长等因素有关。 透射率T为: d e I I T?- = =α t (2) 则 d e T d? = =?α α ln ) /1 ln( 透射光I t
半导体材料吸收光谱测试分析 一、实验目的 1.掌握半导体材料的能带结构与特点、半导体材料禁带宽度的测量原理与方法。 2.掌握紫外可见分光光度计的构造、使用方法和光吸收定律。 二、实验仪器及材料 紫外可见分光光度计及其消耗品如氘灯、钨灯、绘图打印机,玻璃基ZnO 薄膜。 三、实验原理 1.紫外可见分光光度计的构造、光吸收定律 UV762双光束紫外可见分光光度计外观图: (1)仪器构造:光源、单色器、吸收池、检测器、显示记录系统。 a .光源:钨灯或卤钨灯——可见光源,350~1000nm ;氢灯或氘灯——紫外光源,200~360nm 。 b .单色器:包括狭缝、准直镜、色散元件 色散元件:棱镜——对不同波长的光折射率不同分出光波长不等距; 光栅——衍射和干涉分出光波长等距。 c .吸收池:玻璃——能吸收UV 光,仅适用于可见光区;石英——不能吸收紫外光,适用于紫外和可见光区。 要求:匹配性(对光的吸收和反射应一致) d .检测器:将光信号转变为电信号的装置。如:光电池、光电管(红敏和蓝敏)、光电倍增管、二极管阵列检测器。 紫外可见分光光度计的工作流程如下: 光源 单色器 吸收池 检测器 显示 双光束紫外可见分光光度计则为:
双光束紫外可见分光光度计的光路图如下: (2)光吸收定律 单色光垂直入射到半导体表面时,进入到半导体内的光强遵照吸收定律: x x e I I ?-=α0 d t e I I ?-=α0 (1) I 0:入射光强;I x :透过厚度x 的光强;I t :透过膜薄的光强;α:材料吸收系数,与材料、入射光波长等因素有关。 透射率T 为: d e I I T ?-==α0 t (2)
《高分子材料典型力学性能测试实验》实验报告 学号姓名专业班级 实验地点指导教师实验时间 在这一实验中将选取两种典型的高分子材料力学测试实验,即拉伸实验及冲 击试验作为介绍。 实验一:高分子材料拉伸实验 一、实验目的 (1)熟悉高分子材料拉伸性能测试标准条件、测试原理及其操作,了解测 试条件对测定结果的影响。 (2)通过应力—应变曲线,判断不同高分子材料的性能特征。 二、实验原理 在规定的实验温度、湿度和实验速率下,在标准试样(通常为哑铃形)的 两端沿轴向施加载荷直至拉断为止。拉伸强度定义为断裂前试样承受最大载荷与试样的宽度和厚度的乘积的比值。实验不仅可以测得拉伸强度,同时可得到断裂伸长率和拉伸模量。 玻璃态聚合物在拉伸时典型的应力-应变曲线如下:
是在较低温度下出现的不均匀拉伸,所以又称为冷拉。 将试样夹持在专用夹具上,对试样施加静态拉伸负荷,通过压力传感器、 形变测量装置以及计算机处理,测绘出试样在拉伸变形过程中的拉伸应力—应变曲线,计算出曲线上的特征点如试样直至断裂为止所承受的最大拉伸应力(拉伸强度)、试样断裂时的拉伸应力(拉伸断裂应力)、在拉伸应力-应变曲线上屈服 点处的应力(拉伸屈服应力)和试样断裂时标线间距离的增加量与初始标距之比(断裂伸长率,以百分数表示)。所涉及的相关计算公式: (1)拉伸强度或拉伸断裂应力或拉伸屈服应力或偏置屈服应力σt σt 按式(1)计算: (1) 式中σt—抗拉伸强度或拉伸断裂应力或拉伸屈服应力或偏置屈服应力,MPa; p—最大负荷或断裂负荷或屈服负荷或偏置屈服负荷,N; b—实验宽度,mm;d—试样厚度,mm。 (2)断裂伸长率εt εt 按式(2)计算: 式中εt——断裂伸长率,%;
常用术语翻译 active region 有源区 2.active ponent有源器件 3.Anneal退火 4.atmospheric pressure CVD (APCVD) 常压化学气相淀积 5.BEOL(生产线)后端工序 6.BiCMOS双极CMOS 7.bonding wire 焊线,引线 8.BPSG 硼磷硅玻璃 9.channel length沟道长度 10.chemical vapor deposition (CVD) 化学气相淀积 11.chemical mechanical planarization (CMP)化学机械平坦化 12.damascene 大马士革工艺 13.deposition淀积 14.diffusion 扩散 15.dopant concentration掺杂浓度 16.dry oxidation 干法氧化 17.epitaxial layer 外延层 18.etch rate 刻蚀速率 19.fabrication制造 20.gate oxide 栅氧化硅 21.IC reliability 集成电路可靠性 22.interlayer dielectric 层间介质(ILD) 23.ion implanter 离子注入机 24.magnetron sputtering 磁控溅射 25.metalorganic CVD(MOCVD)金属有机化学气相淀积 26.pc board 印刷电路板 27.plasma enhanced CVD(PECVD) 等离子体增强CVD 28.polish 抛光 29.RF sputtering 射频溅射 30.silicon on insulator绝缘体上硅(SOI)
第一章 集成电路的测试 1.集成电路测试的定义 集成电路测试是对集成电路或模块进行检测,通过测量对于集成电路的输出回应和预期输出比较,以确定或评估集成电路元器件功能和性能的过程,是验证设计、监控生产、保证质量、分析失效以及指导应用的重要手段。 .2.集成电路测试的基本原理 输入Y 被测电路DUT(Device Under Test)可作为一个已知功能的实体,测试依据原始输入x 和网络功能集F(x),确定原始输出回应y,并分析y是否表达了电路网络的实际输出。因此,测试的基本任务是生成测试输入,而测试系统的基本任务则是将测试输人应用于被测器件,并分析其输出的正确性。测试过程中,测试系统首先生成输入定时波形信号施加到被测器件的原始输入管脚,第二步是从被测器件的原始输出管脚采样输出回应,最后经过分析处理得到测试结果。 3.集成电路故障与测试 集成电路的不正常状态有缺陷(defect)、故障(fault)和失效(failure)等。由于设计考虑不周全或制造过程中的一些物理、化学因素,使集成电路不符合技术条件而不能正常工作,称为集成电路存在缺陷。集成电路的缺陷导致它的功能发生变化,称为故障。故障可能使集成电路失效,也可能不失效,集成电路丧失了实施其特定规范要求的功能,称为集成电路失效。故障和缺陷等效,但两者有一定区别,缺陷会引发故障,故障是表象,相对稳定,并且易于测试;缺陷相对隐蔽和微观,缺陷的查找与定位较难。 4.集成电路测试的过程 1.测试设备 测试仪:通常被叫做自动测试设备,是用来向被测试器件施加输入,并观察输出。测试是要考虑DUT的技术指标和规范,包括:器件最高时钟频率、定时精度要求、输入\输出引脚的数目等。要考虑的因素:费用、可靠性、服务能力、软件编程难易程度等。 1.测试界面 测试界面主要根据DUT的封装形式、最高时钟频率、ATE的资源配置和界面板卡形等合理地选择测试插座和设计制作测试负载板。
半导体材料能带测试及计算 对于半导体,是指常温下导电性能介于导体与绝缘体之间的材料,其具有一定的带隙(E g)。通常对半导体材料而言,采用合适的光激发能够激发价带(VB)的电子激发到导带(CB),产生电子与空穴对。 图1. 半导体的带隙结构示意图。 在研究中,结构决定性能,对半导体的能带结构测试十分关键。通过对半导体的结构进行表征,可以通过其电子能带结构对其光电性能进行解析。对于半导体的能带结构进行测试及分析,通常应用的方法有以下几种(如图2): 1.紫外可见漫反射测试及计算带隙E g; 2.VB XPS测得价带位置(E v); 3.SRPES测得E f、E v以及缺陷态位置; 4.通过测试Mott-Schottky曲线得到平带电势; 5.通过电负性计算得到能带位置. 图2. 半导体的带隙结构常见测试方式。 1.紫外可见漫反射测试及计算带隙 紫外可见漫反射测试 2.制样:
背景测试制样:往图3左图所示的样品槽中加入适量的BaSO4粉末(由于BaSO4粉末几乎对光没有吸收,可做背景测试),然后用盖玻片将BaSO4粉末压实,使得BaSO4粉末填充整个样品槽,并压成一个平面,不能有凸出和凹陷,否者会影响测试结果。 样品测试制样:若样品较多足以填充样品槽,可以直接将样品填充样品槽并用盖玻片压平;若样品测试不够填充样品槽,可与BaSO4粉末混合,制成一系列等质量分数的样品,填充样品槽并用盖玻片压平。 图3. 紫外可见漫反射测试中的制样过程图。 1.测试: 用积分球进行测试紫外可见漫反射(UV-Vis DRS),采用背景测试样(BaSO4粉末)测试背景基线(选择R%模式),以其为background测试基线,然后将样品放入到样品卡槽中进行测试,得到紫外可见漫反射光谱。测试完一个样品后,重新制样,继续进行测试。 ?测试数据处理 数据的处理主要有两种方法:截线法和Tauc plot法。截线法的基本原理是认为半导体的带边波长(λg)决定于禁带宽度E g。两者之间存在E g(eV)=hc/λg=1240/λg(nm)的数量关系,可以通过求取λg来得到E g。由于目前很少用到这种方法,故不做详细介绍,以下主要来介绍Tauc plot法。 具体操作: 1、一般通过UV-Vis DRS测试可以得到样品在不同波长下的吸收,如图4所示; 图4. 紫外可见漫反射图。
实验一半导体材料的缺陷显示及观察
实验一半导体材料的缺陷显示及观察 实验目的 1.掌握半导体的缺陷显示技术、金相观察技术; 2.了解缺陷显示原理,位错的各晶面上的腐蚀图象的几何特性; 3.了解层错和位错的测试方法。 一、实验原理 半导体晶体在其生长过程或器件制作过程中都会产生许多晶体结构缺陷,缺陷的存在直接影响着晶体的物理性质及电学性能,晶体缺陷的研究在半导体技术上有着重要的意义。 半导体晶体的缺陷可以分为宏观缺陷和微观缺陷,微观缺陷又分点缺陷、线缺陷和面缺陷。位错是半导体中的主要缺陷,属于线缺陷;层错是面缺陷。 在晶体中,由于部分原子滑移的结果造成晶格排列的“错乱”,因而产生位错。所谓“位错线”,就是晶体中的滑移区与未滑移区的交界线,但并不是几何学上定义的线,而近乎是有一定宽度的“管道”。位错线只能终止在晶体表面或晶粒间界上,不能终止在晶粒内部。位错的存在意味着晶体的晶格受到破坏,晶体中原子的排列在位错处已失去原有的周期性,其平均能量比其它区域的原子能量大,原子不再是稳定的,所以在位错线附近不仅是高应力区,同时也是杂质的富集区。因而,位错区就较晶格完整区对化学腐蚀剂的作用灵敏些,也就是说位错区的腐蚀速度大于非位错区的腐蚀速度,这样我们就可以通过腐蚀坑的图象来显示位错。 位错的显示一般都是利用校验过的化学显示腐蚀剂来完成。腐蚀剂按其用途来分,可分为化学抛光剂与缺陷显示剂,缺陷显示剂就其腐蚀出图样的特点又可分为择优的和非择优的。 位错腐蚀坑的形状与腐蚀表面的晶向有关,与腐蚀剂的成分,腐蚀条件有关,与样品的性质也有关,影响腐蚀的因素相当繁杂,需要实践和熟悉的过程,以硅为例,表1列出硅中位错在各种界面上的腐蚀图象。 二、位错蚀坑的形状 仅供学习与交流,如有侵权请联系网站删除谢谢2
芯片制造-半导体工艺教程 Microchip Fabrication ----A Practical Guide to Semicondutor Processing 目录: 第一章:半导体工业[1][2][3] 第二章:半导体材料和工艺化学品[1][2][3][4][5]第三章:晶圆制备[1][2][3] 第四章:芯片制造概述[1][2][3] 第五章:污染控制[1][2][3][4][5][6] 第六章:工艺良品率[1][2] 第七章:氧化 第八章:基本光刻工艺流程-从表面准备到曝光 第九章:基本光刻工艺流程-从曝光到最终检验 第十章:高级光刻工艺 第十一章:掺杂 第十二章:淀积 第十三章:金属淀积 第十四章:工艺和器件评估 第十五章:晶圆加工中的商务因素 第十六章:半导体器件和集成电路的形成 第十七章:集成电路的类型 第十八章:封装 附录:术语表
#1 第一章半导体工业--1 芯片制造-半导体工艺教程点击查看章节目录 by r53858 概述 本章通过历史简介,在世界经济中的重要性以及纵览重大技术的发展和其成为世界领导工业的发展趋势来介绍半导体工业。并将按照产品类型介绍主要生产阶段和解释晶体管结构与集成度水平。 目的 完成本章后您将能够: 1. 描述分立器件和集成电路的区别。 2. 说明术语“固态,” “平面工艺”,““N””型和“P”型半导体材料。 3. 列举出四个主要半导体工艺步骤。 4. 解释集成度和不同集成水平电路的工艺的含义。 5. 列举出半导体制造的主要工艺和器件发展趋势。 一个工业的诞生 电信号处理工业始于由Lee Deforest 在1906年发现的真空三极管。1真空三极管使得收音机, 电视和其它消费电子产品成为可能。它也是世界上第一台电子计算机的大脑,这台被称为电子数字集成器和计算器(ENIAC)的计算机于1947年在宾西法尼亚的摩尔工程学院进行首次演示。 这台电子计算机和现代的计算机大相径庭。它占据约1500平方英尺,重30吨,工作时产生大量的热,并需要一个小型发电站来供电,花费了1940年时的400, 000美元。ENIAC的制造用了19000个真空管和数千个电阻及电容器。 真空管有三个元件,由一个栅极和两个被其栅极分开的电极在玻璃密封的空间中构成(图1.2)。密封空间内部为真空,以防止元件烧毁并易于电子的====移动。 真空管有两个重要的电子功能,开关和放大。开关是指电子器件可接通和切断电流;放大则较为复杂,它是指电子器件可把接收到的信号放大,并保持信号原有特征的功能。 真空管有一系列的缺点。体积大,连接处易于变松导致真空泄漏、易碎、要求相对较多的电能来运行,并且元件老化很快。ENIAC 和其它基于真空管的计算机的主要缺点是由于真空管的烧毁而导致运行时间有限。 这些问题成为许多实验室寻找真空管替代品的动力,这个努力在1947年12月23曰得以实现。贝尔实验室的三位科学家演示了由半导体材料锗制成的电子放大器。
XRD复习重点 1.X射线的产生及其分类 2.X射线粉晶衍射中靶材的选取 3.布拉格公式 4.PDF卡片 5.X射线粉晶衍射谱图 6.X射线粉晶衍射的应用 电子衍射及透射电镜、扫描电镜和电子探针分析复习提纲 透射电镜分析部分: 4.TEM的主要结构,按从上到下列出主要部件 1)电子光学系统——照明系统、图像系统、图像观察和记录系统;2)真空系统; 3)电源和控制系统。电子枪、第一聚光镜、第二聚光镜、聚光镜光阑、样品台、物镜光阑、物镜、选区光阑、中间镜、投影镜、双目光学显微镜、观察窗口、荧光屏、照相室。 5. TEM和光学显微镜有何不同? 光学显微镜用光束照明,简单直观,分辨本领低(0.2微米),只能观察表面形貌,不能做微区成分分析;TEM分辨本领高(1A)可把形貌观察,结构分析和成分分析结合起来,可以观察表面和内部结构,但仪器贵,不直观,分析困难,操作复杂,样品制备复杂。 6.几何像差和色差产生原因,消除办法。 球差即球面像差,是由于电磁透镜的中心区域和边缘区域对电子的折射能力不符合预定的规律而造成的。减小球差可以通过减小CS值和缩小孔径角来实现。 色差是由于入射电子波长(或能量)的非单一性造成的。采取稳定加速电压的方法可以有效的减小色差;适当调配透镜极性;卡斯汀速度过滤器。 7.TEM分析有那些制样方法?适合分析哪类样品?各有什么特点和用途? 制样方法:化学减薄、电解双喷、竭力、超薄切片、粉碎研磨、聚焦离子束、机械减薄、离子减薄; TEM样品类型:块状,用于普通微结构研究; 平面,用于薄膜和表面附近微结构研究; 横截面样面,均匀薄膜和界面的微结构研究; 小块粉末,粉末,纤维,纳米量级的材料。 二级复型法:研究金属材料的微观形态; 一级萃取复型:指制成的试样中包含着一部分金属或第二相实体,对它们可以直接作形态检验和晶体结构分析,其余部分则仍按浮雕方法间接地观察形态; 金属薄膜试样:电子束透明的金属薄膜,直接进行形态观察和晶体结构分析; 粉末试样:分散粉末法,胶粉混合法 思考题: 1.一电子管,由灯丝发出电子,一负偏压加在栅极收集电子,之后由阳极加速,回答由灯丝到栅极、由栅极到阳极电子的折向及受力方向? 2.为什么高分辨电镜要使用比普通电镜更短的短磁透镜作物镜? 高分辨电镜要比普通电镜的放大倍数高。为了提高放大倍数,需要短焦距的强磁透镜。透镜的光焦度1/f与磁场强度成H2正比。较短的f可以提高NA,使极限分辨率更小。 3.为什么选区光栏放在“象平面”上? 电子束之照射到待研究的视场内;防止光阑受到污染;将选区光阑位于向平面的附近,通过
半导体测试技术实践总结报告 一、实践目的 半导体测试技术及仪器集中学习是在课堂结束之后在实习地集中的实践性教学,是各项课间的综合应用,是巩固和深化课堂所学知识的必要环节。学习半导体器件与集成电路性能参数的测试原理、测试方法,掌握现代测试设备的结构原理、操作方法与测试结果的分析方法,并学以致用、理论联系实际,巩固和理解所学的理论知识。同时了解测试技术的发展现状、趋势以及本专业的发展现状,把握科技前进脉搏,拓宽专业知识面,开阔专业视野,从而巩固专业思想,明确努力方向。另外,培养在实际测试过程中发现问题、分析问题、解决问题和独立工作的能力,增强综合实践能力,建立劳动观念、实践观念和创新意识,树立实事求是、严肃认真的科学态度,提高综合素质。 二、实践安排(含时间、地点、内容等) 实践地点:西安西谷微电子有限责任公司 实践时间:2014年8月5日—2014年8月15日 实践内容:对分立器件,集成电路等进行性能测试并判定是否失效 三、实践过程和具体内容 西安西谷微电子有限责任公司专业从事集成电路测试、筛选、测试软硬件开发及相关技术配套服务,测试筛选使用标准主要为GJB548、GJB528、GJB360等。 1、认识半导体及测试设备
在一个器件封装之后,需要经过生产流程中的再次测试。这次测试称为“Final test”(即我们常说的FT测试)或“Package test”。在电路的特性要求界限方面,FT测试通常执行比CP测试更为严格的标准。芯片也许会在多组温度条件下进行多次测试以确保那些对温度敏感的特征参数。商业用途(民品)芯片通常会经过0℃、25℃和75℃条件下的测试,而军事用途(军品)芯片则需要经过-55℃、25℃和125℃。 芯片可以封装成不同的封装形式,图4显示了其中的一些样例。一些常用的封装形式如下表: DIP: Dual Inline Package (dual indicates the package has pins on two sides) 双列直插式 CerDIP:Ceramic Dual Inline Package 陶瓷 PDIP: Plastic Dual Inline Package 塑料 PGA: Pin Grid Array 管脚阵列
半导体工艺原理实验附录 姓名:xxx 学号:xxx 指导教师:xxx 目录 实验一.工艺设备模拟--氧化仿真实验 (1) 详细实验步骤 (1) 实验结果 (4) 实验二.工艺设备模拟--离子注入仿真实验 (5) 操作步骤 (5) 实验结果 (5) 第一组 (5) 第二组 (6) 第三组 (7) 第四组 (8) 其他组实验 (10) 实验三.刻蚀仿真实验 (13) 实验步骤 (13) 实验结果 (15) 实验四.超净间参观 (17) 参观过程 (17) 超净间定义 (17) 实验一.工艺设备模拟--氧化仿真实验 详细实验步骤 (1)(2)
(3)(4) (5)(6) (7)(8)
(9)(10) (11)(12) (13)(14)
(15)(16) (17)(18) 实验结果 晶片晶向时间(min)温度方式 1 100 1 890 900 880 2,3 表 1 参考参数 晶片号类型晶向氧化时间(min)氧化温度(?C)氧化厚度(A) 1Dry1102900180 2Dry11021000924 4Dry1112900183 3Dry11010900173 5Wet10010900669 6Wet10020900449 7Wet10030900660 8Wet110210001136 10Wet11010900902 9Wet11029003536 11Wet11129001310 表 2 实验数据
图 1 各组参数柱状图对比效果实验二.工艺设备模拟--离子注入仿真实验实验时间:2015年12月4日星期五 操作步骤 操作步骤大体与实验一类似,按照提示操作即可。 实验结果 第一组 深度(130) 浓度 (13) 深度 (130) 浓度 (13) 深度 (130) 浓度 (13) 0.0015.450.7013.49 1.408.75 0.0517.080.7513.09 1.458.47 0.1017.680.8012.69 1.508.20 0.1517.790.8512.31 1.557.94 0.2017.630.9011.94 1.607.68 0.2517.330.9511.58 1.657.43 0.3016.95 1.0011.23 1.707.18 0.3516.53 1.0510.89 1.75 6.94 0.4016.10 1.1010.56 1.80 6.71 0.4515.65 1.1510.24 1.85 6.49 0.5015.20 1.209.92 1.90 6.27 0.5514.76 1.259.62 1.95 6.06 0.6014.33 1.309.32 2.00 5.87 0.6513.90 1.359.03 表 3 离子注入第一组数据
聚合物结构与性能 1.非晶体聚合物的力学三态,说明各自分子运动特点,并用曲线表示出来。 力学三态:玻璃态、高弹态和粘流态称为聚合物的力学三态 玻璃态:温度低,链段的运动处于冻结,只有侧基、链节、链长、键角等局部运动,形变小; 高弹态:链段运动充分发展,形变大,可恢复; 粘流态:链段运动剧烈,导致分子链发生相对位移,形变不可逆。 2.晶态聚合物的力学状态及其转变 在轻度结晶的聚合物中,少量的晶区起类似交联点的作用,当温度升高时,其中非晶区由玻璃态转变为高弹态,可以观察到 Tg 的存在,但晶区的链段由于受晶格能的限制难以运动,使其形变受到限制,整个材料表现为由于非晶区的高弹态而具有一定的韧性,由于晶区的存在具有一定的硬度。 若晶区的Tm>T f (非晶区),则当晶区熔融后,非晶区已进入粘流态,不 呈现高弹态; 若Tm
半导体材料能带测试及计算对于半导体,是指常温下导电性能介于导体与绝缘体之间的材料,其具有一定的带隙(E g)。通常对半导体材料而言,采用合适的光激发能够激发价带(VB)的电子激发到导带(CB),产生电子与空穴对。 图1. 半导体的带隙结构示意图。 在研究中,结构决定性能,对半导体的能带结构测试十分关键。通过对半导体的结构进行表征,可以通过其电子能带结构对其光电性能进行解析。对于半导体的能带结构进行测试及分析,通常应用的方法有以下几种(如图2): 1.紫外可见漫反射测试及计算带隙E g; 2.VB XPS测得价带位置(E v); 3.SRPES测得E f、E v以及缺陷态位置; 4.通过测试Mott-Schottky曲线得到平带电势; 5.通过电负性计算得到能带位置.
图2. 半导体的带隙结构常见测试方式。 1.紫外可见漫反射测试及计算带隙 紫外可见漫反射测试 2.制样: 背景测试制样:往图3左图所示的样品槽中加入适量的BaSO4粉末(由于BaSO4粉末几乎对光没有吸收,可做背景测试),然后用盖玻片将BaSO4粉末压实,使得BaSO4粉末填充整个样品槽,并压成一个平面,不能有凸出和凹陷,否者会影响测试结果。 样品测试制样:若样品较多足以填充样品槽,可以直接将样品填充样品槽并用盖玻片压平;若样品测试不够填充样品槽,可与BaSO4粉末混合,制成一系列等质量分数的样品,填充样品槽并用盖玻片压平。 图3. 紫外可见漫反射测试中的制样过程图。 1.测试:
用积分球进行测试紫外可见漫反射(UV-Vis DRS),采用背景测试样(BaSO4粉末)测试背景基线(选择R%模式),以其为background测试基线,然后将样品放入到样品卡槽中进行测试,得到紫外可见漫反射光谱。测试完一个样品后,重新制样,继续进行测试。 ?测试数据处理 数据的处理主要有两种方法:截线法和Tauc plot法。截线法的基本原理是认为半导体的带边波长(λg)决定于禁带宽度E g。两者之间存在E g(eV)=hc/λg=1240/λg(nm)的数量关系,可以通过求取λg来得到E g。由于目前很少用到这种方法,故不做详细介绍,以下主要来介绍Tauc plot法。 具体操作: 1、一般通过UV-Vis DRS测试可以得到样品在不同波长下的吸收,如图4所示; 图4. 紫外可见漫反射图。 2. 根据(αhv)1/n = A(hv – Eg),其中α为吸光指数,h为普朗克常数,v为频率,Eg为半导体禁带宽度,A为常数。其中,n与半导体类型相关,直接带隙半导体的n取1/2,间接带隙半导体的n为2。
期末复习作业 一、 名词解释 1. 透湿量 透湿量即指水蒸气透过量。 薄膜两侧的水蒸气压差和薄膜厚度一 定, 温度一定的条件下1山2聚合物材料在24小时内所透过的蒸 汽量(用 v 表示) 2. 吸水性 吸水性是指材料吸收水分的能力。 通常以试样原质量与试样失水 后的 质量之差和原质量之比的百分比表示; 也可以用单位面积的 试样吸收 水分的量表示;还可以用吸收的水分量来表示。 3. 表观密度 对于粉状、 片状颗粒状、 纤维状等模塑料的表观密度是指单位体 对于泡沫塑料的表观密度是指单位体积的泡沫塑料在规定温度 4、拉伸强度 在拉伸试验中, 保持这种受力状态至最终, 就是测量拉伸力直至 应 力,用 t 表示) 5、弯曲强度 试样在弯曲过程中在达到规定挠度值时或之前承受的最大弯曲 应力 (用 f 表示) 积中的质量(用 a 表示) 和相对湿度时的重量,故又称体积密度或视密度(用 a 表示) 材料断裂为止, 所承受的最大拉伸应力称为拉伸强度 极限拉伸
6、压缩强度 指在压缩试验中试样所承受的最大压缩应力。 它可能是也可能不 7、屈服点 应力—应变曲线上应力不随应变增加的初始点。 8、细长比 14、压缩应变 是试样破裂的瞬间所承受的压缩应力(用 e 表示) 指试样的高度与试样横截面积的最小回转半径之比(用 表示) 9、断裂伸长率 断裂时伸长的长度与原始长度之比的百分数(用 t 表示) 10、弯曲弹性模量 比例极限内应力与应变比值(用 E f 表示) 11、压缩模量 指在应力—应变曲线的线性范围内压缩应力与压缩应变的比值。 由于直线与横坐标的交点一般不通过原点, 因此可用直线上两点 的应力差与对应的应变差之比表示(用 E e 表示) 12、弹性模量 在负荷—伸长曲线的初始直线部分, 材料所承受的应力与产生相 应的应变之比(用 E 表示) 13、压缩变形 指试样在压缩负荷左右下高度的改变量(用 h 表示) 指试样的压缩变形除以试样的原始高度(用 表示)
A Abrupt junction 突变结Accelerated testing 加速实验 Acceptor 受主Acceptor atom 受主原子 Accumulation 积累、堆积Accumulating contact 积累接触Accumulation region 积累区Accumulation layer 积累层 Active region 有源区Active component 有源元 Active device 有源器件Activation 激活 Activation energy 激活能Active region 有源(放大)区 Admittance 导纳Allowed band 允带 Alloy-junction device合金结器件Aluminum(Aluminium)铝 Aluminum - oxide 铝氧化物Aluminum passivation 铝钝化 Ambipolar 双极的Ambient temperature 环境温度 Amorphous 无定形的,非晶体的Amplifier 功放扩音器放大器 Analogue(Analog)comparator 模拟比较器Angstrom 埃 Anneal 退火Anisotropic 各向异性的 Anode 阳极Arsenic (AS)砷 Auger 俄歇Auger process 俄歇过程 Avalanche 雪崩Avalanche breakdown 雪崩击穿 Avalanche excitation雪崩激发 B Background carrier 本底载流子Background doping 本底掺杂 Backward 反向Backward bias 反向偏置 Ballasting resistor 整流电阻Ball bond 球形键合 Band 能带Band gap 能带间隙 Barrier 势垒Barrier layer 势垒层 Barrier width 势垒宽度Base 基极 Base contact 基区接触Base stretching 基区扩展效应 Base transit time 基区渡越时间Base transport efficiency基区输运系数Base-width modulation基区宽度调制Basis vector 基矢 Bias 偏置Bilateral switch 双向开关 Binary code 二进制代码Binary compound semiconductor 二元化合物半导体Bipolar 双极性的Bipolar Junction Transistor (BJT)双极晶体管 Bloch 布洛赫Blocking band 阻挡能带 Blocking contact 阻挡接触Body - centered 体心立方 Body-centred cubic structure 体立心结构Boltzmann 波尔兹曼 Bond 键、键合Bonding electron 价电子 Bonding pad 键合点Bootstrap circuit 自举电路 Bootstrapped emitter follower 自举射极跟随器Boron 硼 Borosilicate glass 硼硅玻璃Boundary condition 边界条件 Bound electron 束缚电子Breadboard 模拟板、实验板
一. 傅里叶红外光谱仪 1. 什么是红外光谱图 当一束连续变化的各种波长的红外光照射样品时,其中一部分被吸收,吸收的这部分光能就转变为分子的振动能量和转动能量;另一部分光透过,若将其透过的光用单色器进行色散,就可以得到一谱带。若以波长或波数为横坐标,以百分吸收率或透光度为纵坐标,把这谱带记录下来,就得到了该样品的红外吸收光谱图,也有称红外振-转光谱图 2. 红外光谱仪基本工作原理 用一定频率的红外线聚焦照射被分析的试样,如果分子中某个基团的振动频率与照射红外线相同就会产生共振,这个基团就吸收一定频率的红外线,把分子吸收的红外线的情况用仪器记录下来,便能得到全面反映试样成份特征的光谱,从而推测化合物的类型和结构。 3. 红外光谱产生的条件 (1) 辐射应具有能满足物质产生振动跃迁所需的能量; (2) 辐射与物质间有相互偶合作用。 4. 红外光谱图的三要素 峰位、峰强和峰形 5. 红外光谱样品的制备方法 1) 固体样品的制备 a. 压片法 b. 糊状法: c. 溶液法 2) 液体样品的制备 a. 液膜法 b. 液体吸收池法 3) 气态样品的制备: 气态样品一般都灌注于气体池内进行测试 4) 特殊样品的制备—薄膜法 a. 熔融法 b. 热压成膜法
c. 溶液制膜法 6. 红外对供试样品的要求 ①试样纯度应大于98%,或者符合商业规格,这样才便于与纯化合物的标准光谱或商业光谱进行对照,多组份试样应预先用分馏、萃取、重结晶或色谱法进行分离提纯,否则各组份光谱互相重叠,难予解析。 ②试样不应含水(结晶水或游离水) 水有红外吸收,与羟基峰干扰,而且会侵蚀吸收池的盐窗。所用试样应当经过干燥处理。 ③试样浓度和厚度要适当 使最强吸收透光度在5~20%之间 7. 红外光谱特点 1)红外吸收只有振-转跃迁,能量低; 2)应用范围广:除单原子分子及单核分子外,几乎所有有机物均有红外吸收;3)分子结构更为精细的表征:通过红外光谱的波数位置、波峰数目及强度确定分子基团、分子结构; 4)分析速度快; 5)固、液、气态样均可用,且用量少、不破坏样品; 6)与色谱等联用(GC-FTIR)具有强大的定性功能; 7)可以进行定量分析; 二. 紫外光谱 1. 什么是紫外-可见分光光度法?产生的原因及其特点? 紫外-可见分光光度法也称为紫外-可见吸收光谱法,属于分子吸收光谱,是利用某些物质对200-800 nm光谱区辐射的吸收进行分析测定的一种方法。紫外-可见吸收光谱主要产生于分子价电子(最外层电子)在电子能级间的跃迁。该方法具有灵敏度高,准确度好,使用的仪器设备简便,价格廉价,且易于操作等优点,故广泛应用于无机和有机物质的定性和定量测定。 2. 什么是吸收曲线?及其吸收曲线的特点? 测量某种物质对不同波长单色光的吸收程度,以波长为横坐标,吸光度为纵坐标作图,可得到一条曲线,称为吸收光谱曲线或光吸收曲线,它反映了物质
实验一半导体材料的缺陷显示及观察 实验目的 1.掌握半导体的缺陷显示技术、金相观察技术; 2.了解缺陷显示原理,位错的各晶面上的腐蚀图象的几何特性; 3.了解层错和位错的测试方法。 一、实验原理 半导体晶体在其生长过程或器件制作过程中都会产生许多晶体结构缺陷,缺陷的存在直接影响着晶体的物理性质及电学性能,晶体缺陷的研究在半导体技术上有着重要的意义。 半导体晶体的缺陷可以分为宏观缺陷和微观缺陷,微观缺陷又分点缺陷、线缺陷和面缺陷。位错是半导体中的主要缺陷,属于线缺陷;层错是面缺陷。 在晶体中,由于部分原子滑移的结果造成晶格排列的“错乱”,因而产生位错。所谓“位错线”,就是晶体中的滑移区与未滑移区的交界线,但并不是几何学上定义的线,而近乎是有一定宽度的“管道”。位错线只能终止在晶体表面或晶粒间界上,不能终止在晶粒内部。位错的存在意味着晶体的晶格受到破坏,晶体中原子的排列在位错处已失去原有的周期性,其平均能量比其它区域的原子能量大,原子不再是稳定的,所以在位错线附近不仅是高应力区,同时也是杂质的富集区。因而,位错区就较晶格完整区对化学腐蚀剂的作用灵敏些,也就是说位错区的腐蚀速度大于非位错区的腐蚀速度,这样我们就可以通过腐蚀坑的图象来显示位错。 位错的显示一般都是利用校验过的化学显示腐蚀剂来完成。腐蚀剂按其用途来分,可分为化学抛光剂与缺陷显示剂,缺陷显示剂就其腐蚀出图样的特点又可分为择优的和非择优的。 位错腐蚀坑的形状与腐蚀表面的晶向有关,与腐蚀剂的成分,腐蚀条件有关,与样品的性质也有关,影响腐蚀的因素相当繁杂,需要实践和熟悉的过程,以硅为例,表1列出硅中位错在各种界面上的腐蚀图象。 二、位错蚀坑的形状 当腐蚀条件为铬酸腐蚀剂时,<100>晶面上呈正方形蚀坑,<110>晶面上呈菱形或矩形蚀坑,<111>晶面上呈正三角形蚀坑。(见图1)。
半导体工艺认识实习报告 篇一:半导体认识实习报告 电子信息材料专业实习报告 电子信息材料是指在微电子、光电子技术和新型电子元器件领域中所用的材料,主要包括微电子材料、光电子材料、传感材料、磁性材料、电子陶瓷材料等,它们支撑着通信、计算机、信息家电和网络技术等现代信息产业及航空、航天、精确制导、灵巧武器等领域的发展。 电子信息材料是发展电子信息产业的先导和基础。以单晶硅为代表的第一代半导体材料是集成电路产业的基础。1948年发明了晶体管,1960年集成电路问世,1962年出现第一代半导体激光器,导致了电子技术、光电子技术革命,产生了半导体微电子学与半导体光电子学,有力地推动了计算机、通讯技术发
生根本改变。 光电子技术是现代信息技术的基石,21世纪是光电子时代。以砷化镓、磷化铟等化合物为代表的第二代半导体材料是新型激光器和光探测器用材料。半导体发光二极管的出现,其意义不亚于爱迪生发明白炽灯。半导体灯小巧可靠、寿命长,驱动电压低,发光效率高。它可以发出赤橙黄绿青蓝紫等的全彩色光和白色,它占尽了照明灯、指示灯的全部优点。半导体光照明的主体材料主要是第二代、第三代半导体材料,特别是第三代半导体材料氮化镓,它是唯一能发出蓝光和白光的材料。 磁性材料、电子陶瓷材料广泛应用于计算机、通信、航空等各个领域,是新型器件的基础材料。 (一)半导体材料(semiconductor material) 导电能力介于导体与绝缘体之间的物质称为半导体。半导体材料是一类具有半导体性能、可用来制作半导体器件
和集成电的电子材料, 其电导率在10(U-3)~10(U-9)欧姆/厘米范围内。半导体材料的电学性质对光、热、电、磁等外界因素的变化十分敏感,在半导体材料中掺入少量杂质可以控制这类材料的电导率。正是利用半导体材料的这些性质,才制造出功能多样的半导体器件。半导体材料是半导体工业的基础,它的发展对半导体技术的发展有极大的影响。 特性和参数半导体材料的导电性对某些微量杂质极敏感。纯度很高的半导体材料称为本征半导体,常温下其电阻率很高,是电的不良导体。在高纯半导体材料中掺入适当杂质后,由于杂质原子提供导电载流子,使材料的电阻率大为降低。这种掺杂半导体常称为杂质半导体。杂质半导体靠导带电子导电的称N型半导体,靠价带空穴导电的称P 型半导体。不同类型半导体间接触(构成PN结)或半导体与金属接触时,因电子(或空穴)浓度差而产生扩散,在接
《高分子材料分析测试与表征》实验教学大纲 课程名称:高分子材料分析测试与表征课程编号:050332024 课程类别:专业基础课课程性质:选修 适用专业:高分子材料与工程 课程总学时:32 实验(上机)计划学时:8 开课单位:材料科学与工程学院 一、大纲编写依据 1.高分子材料与工程专业2017版教学计划; 2. 高分子材料与工程专业《近代材料研究方法》理论教学大纲对实验环节的要求; 3. 近年来《近代材料研究方法》实验教学经验。 二、实验课程地位及相关课程的联系 1.《近代材料研究方法》是高分子材料与工程专业基础课程; 2.本实验项目是《近代材料研究方法》课程知识的运用; 3.本实验项目是理解和运用材料分析检测手段以及对检测结果进行分析标定的基础; 4.本实验以《材料科学基础》、《物理化学》、《大学物理》、《高分子物理》和《高分子 化学》为先修课。 5.本实验对毕业论文等工作具有指导意义。 三、实验目的、性质和任务 1.熟悉X射线衍射仪、紫外可见光分光光度计和热重分析仪 2.能够对X射线衍射图谱进行标定,能够利用粉末衍射卡片对单相物质进行物相鉴 定 3.了解扫描电镜、能谱仪和红外光谱仪的结构 4.通过实际分析,明确扫描电镜、红外光谱仪、紫外可见光分光光度计和热重分析 仪的用途 5.理解X射线衍射、光谱分析和热分析的基本理论,训练运用上述分析手段的基本 技能,掌握科学的实验方法; 6.培养学生观察问题、分析问题和独立解决问题的能力 7.通过设计性实验训练,使学生初步掌握如何根据需要选择合适的检测手段; 8.培养正确记录实验数据和现象,正确处理实验数据和分析实验结果的能力以及正 确书写实验报告的能力。 四、实验基本要求 1.实验项目的选定依据教学计划对学生工程实践能力培养的要求; 2.巩固和加深学生对X射线衍射、扫描电镜、紫外可见光分光光度计和热重分析仪等 基础知识的理解,提高学生综合运用所学知识的能力; 3.实验项目要求学生综合掌握本课程基本知识,并运用相关知识自行设计实验方案;