PCB层压制程介绍
- 格式:pptx
- 大小:879.71 KB
- 文档页数:48




东莞市科畅力电子有限公司本文主要讲的各位PCB工程师及采购人员在购买PCB层压载盘及PCB层压盖板的注意事项及方法(本文主要指PIN LAM层压制程)1.在PCB板的压合中,层压载盘及PCB层压盖板决定了层压的质量,而层压也是PCB板厂最重要的制程。
故在选购PCB层压载盘及PCB层压盖板时要特别注意:A.目前高精度及高层数的PCB生产工艺基本都是采取PIN孔定位方式来生产,PIN孔生产方式效率底,但精度高,产值也高。
B.硬度要HV400以上最合算C.在层压过程中不得出现过度的变形,故在选购时最重要考虑硬度,其次便是耐力及屈服度D.孔对孔的精度每个细节不同,一般5-20微米要求,经过精加工是可以做到的E.详细细节及要求最重要的是看厂商的要求,选择有经验的供货商也是很有必要。
相关说明:F.貯存條件在溫度 70 ° F 、相對濕度 50% 以下 , 基材可保存 3 個月 .G.包裝最好保持原包裝方式存放 , 若因考量空間需將外箱拆除建義仍需保持基材外覆保護膠H.膜完整 , 以避免水氣攻擊及碰傷 .I.裁切下料J.建義基材自冷藏室移出后 , 最好放置一日使其溫度平衡 , 可避免溫度過大使水氣凝結K.在基材表面 , 造成物性劣化 , 易產生爆板分層現象 .L.除濕箱的使用考量M.許多 PCB 廠商會將基材放入除除箱中將基材表面水份除去 , 但實際上要濕度控制在N. 20% HR 以下有其困難 , 故實用性值得考量 .O.壓合反應機構P.實際料溫Q.第一階段溫度 LAMINATE(1) 溫度 70 ~ 120 ℃(2) 樹脂熔融及氣泡趕出(3) 樹脂半反應溫度 120 ℃~ 170 ℃ +170 ℃× 30 MIN溫度迅速上昇及樹脂硬化反應完全尺寸變化因結構及壓合程序不同而不同內層板於壓合后會收縮 , 因此內層板之底片須設一放大被償量 ,以便壓合後內層板收縮至目標值 .對準度控制要點1. 內層板尺寸變化須穩定 ( 標準差小 ).2. 內層板經緯變化程度不一 , 須設定不同補償量 .3. 壓合條件之升溫速率及壓力須作穩定之控制 .建義尺寸變化補償量 ( 僅供參考 )。

pcb板制造工艺流程及控制方法PCB板,也就是印刷电路板,它的制造可有趣啦。
一、工艺流程。
1. 设计。
这就像是给PCB板画蓝图呢。
工程师们用专门的软件,把线路、元件的位置啥的都规划好。
要考虑好多东西哦,像电流怎么走最合理,元件之间怎么连接不会打架。
这个阶段要是出点小差错,后面可就麻烦咯。
比如说,要是线路设计得太挤,那生产的时候可能就会短路啦。
2. 开料。
把大的覆铜板按照设计的尺寸切成小块。
这就好比裁布料一样,得裁得准准的。
要是尺寸不对,后面的工序就像穿错尺码的衣服,怎么都不合适。
3. 内层线路制作。
这一步是在板子里做出线路来。
要通过光刻、蚀刻这些技术。
光刻就像用光照出线路的形状,蚀刻呢,就把不需要的铜给去掉,留下我们想要的线路。
这个过程就像雕刻家在雕刻作品,得小心翼翼的,一不小心刻坏了,这块板子可能就废啦。
4. 层压。
如果是多层板的话,就要把做好内层线路的板子叠起来,然后用高温高压让它们粘在一起。
这就像做三明治一样,要把每层都放好,压得紧紧的,不然中间可能会有空隙,那可就不好使喽。
5. 外层线路制作。
和内层线路制作有点像,不过这是在板子的最外面做线路。
这时候要更注意美观和准确性啦,毕竟这是大家能直接看到的部分。
6. 阻焊和字符印刷。
阻焊就像是给线路穿上防护服,防止它们在焊接的时候短路。
字符印刷呢,就是印上一些标识,像元件的编号之类的,这样我们在组装的时候就能轻松找到对应的元件啦。
7. 表面处理。
这是为了让PCB板在焊接元件的时候更容易,像镀锡、镀金之类的。
就像给板子的表面做个美容,让它更好地和元件结合。
8. 成型。
把板子按照设计的形状切割出来。
这是最后的一步啦,就像给PCB板做个最后的造型。
二、控制方法。
1. 质量控制。
在每个工序之后都要检查,就像我们做完一件事要检查有没有漏洞一样。
比如在线路制作之后,要用检测仪器看看线路有没有断开或者短路的地方。
要是发现问题,要及时调整或者把有问题的板子挑出来,可不能让它混到好板子里面去。


pcb压合工艺流程
PCB压合工艺流程指的是在PCB制造中,将多层PCB板通过高温和高压的工艺,将各个层压在一起形成整体PCB板的过程。
以下是一般的PCB压合工艺流程:
1. 原材料准备:准备好多层的PCB板、铜箔、预浸渍纸、胶水等材料。
2. 层板预制:将待压合的PCB板分别与铜箔和预浸渍纸进行剪裁和清洁处理,确保各个层板的表面平整干净。
3. 串联层压:将准备好的层板按照设计要求依次搭配并串联,将每一层板之间涂上胶水,然后将它们放在一起。
4. 高温高压压合:将层板放入压合机中,机器会将板材加热到一定温度,然后通过液压系统施加高压力将层板压合在一起。
高温和高压会使得胶水在层板之间形成粘合力,同时也会使得铜箔和预浸渍纸与层板结合。
5. 压合后处理:将经过压合的板材进行冷却处理,然后进行切割、修整等工艺,得到最终的PCB板。
需要注意的是,PCB压合工艺流程可能会因为不同的厂家和产品要求而略有不同,以上流程只是一般情况下的工艺流程。


壓合課製程介紹壹、目的貳、流程簡介參、壓合概述肆、流程概述壓合製程介紹壹、目的:1.壓合(mass lamination)製程原理說明壓合最主要的目的在於透過"熱與壓力"使P.P結合不同內層板及外層銅箔, 並利用外層銅箔作為外層線路之基地. 而不同之P.P組成搭配不同之內層板材與面銅則可調配出不同規格厚度之線路板.貳、流程簡介:水帄棕化預疊合自動疊合自動迴流線熱壓冷壓自動拆解手動拆解x-Ray鑽靶NC Router自動磨邊1.水帄棕化(brown oxide)使內層銅而產生一保護性氧化層,避免P.P與銅面直接接觸產生化學反應而造成壓合不良.化學清洗水洗預浸棕化1 棕化2 水洗純水洗熱風烘乾2.預疊合(booking)之前置作業頇注意P.P之經緯間頇與基板一至,否則易造成壓合后板彎板翹. 另注意P.P疊置之順序及數量,否則易造成織紋顯露之外觀陷或厚度不符規格.包含:1.層板: (P.P+內層板+P.P) -> 貼膠機;2.六層板以上: (已沖孔P.P+內層板+已沖孔P.P+內層板+已沖孔P.P) -> 鉚釘機3.自動疊合(automatic lay-up)將預疊合好之板材與上銅箔+鋼板及下銅箔+鋼板藉由自動吸取移載裝置疊合在一起.載盤+牛皮紙+鋼板+銅箔+預疊合板+銅箔+鋼板+……約十層4.自動迴流線(automatic circulation)將疊合好之板材依程式設定加上牛皮紙及上蓋板經入料段送入熱壓機熱壓並經冷壓後經出料段送至拆解段自動拆解鋼板及半成品.包含:傳輸段, 台車, 入出料段, 拆解段, 鋼板磨刷, 水洗, 烘乾黏塵段.5.熱壓(hot press)利用循環熱媒油提供熱能加上油壓缸piston提供之壓力在抽真空環境下加熱加壓, 組合好之板材, 使組合中之P.P由b-stage(半固化態)轉化至c-stage(固化態) 進而緊密結合各內層板之板材.6.冷壓(cold press)將已固化之多層板利用循環冷卻水降溫同時加壓防止多層板變形以利後續加工. 7.自動拆解(automatic break down)將半成品與壓合用之鋼板利用自動移載裝置分解.8.手動拆解(manual break down)利用美工刀將full sheet之半成品分解成下製程加工所需之working panel.9.X-RAY鑽靶(target drilling)利用x-ray找出內層定位孔並加以鑽孔以利後續製程之定位加工10.NC Router(contour routing)利用銑刀將板邊流膠部分去除.包含:固定板材之定位pin, 電木板, 下墊板等週邊.11.自動磨邊(automatic edge beveling)利用刀具將板邊修齊帄整.參、壓合概述傳統多層板系為配合眾零件之密集裝配,而在表層之外,向內部開闢更多的佈線空間,發揮眾多資料之迅速處理,因而才有多層板之發展.于是除了將原來雙面上必頇的:“接地”(Ground,Gnd)及:“電壓”(Power,Vcc)等導体面改置于內層外,其他(內層中)還另需布有配合外層零件,所用到的訊號線路層(Signel Layer),這就是傳統多層板原來設計的目的.但自從“美國聯邦通訊委員會”(FCC)宣布自1984年10月以后,所有在美國上市的電子電器品,若有涉及電傳通訊者,或有參與網路邊線者,皆必頇要做好“接地”的工作,以消除各種雜訊(Noise)干擾所帶來的影響.而一般電子裝備或電器品,為提高品質、減少干擾、及穩定電壓等措施起見,也需增加接地及電壓兩個層次.因而形成了四層板在短時間內的大量興起.嚴格說起來這種四面層板,其兩個大銅面內層上并無線路,只有多量蝕去銅后空圓地,以待壓合后制作PTH,提供各IC之腳孔與他零件孔,以及導電孔(Via Hole),以形成絕緣的空環(Clearance).除此之外,還有其他少數IC腳需接大地,基接電壓的“十字形邊接孔”.此種內層與真正內層線路,以帄環(Annular Ring)套接通孔孔壁之方式并不相同.也就是說原有的雙面板多數已升級成為層板,而原來的四層板則再升級為六層板.至于再往高多層次板發展時,則大部份都是一層線路配一層接地而組成的.由于層次增多及線路密集,促成了多層板壓合技術的改進,形成簡單四層板,與高難度高層板之兩極化趨勢.其間所需之各制程處理及机具設備,也逐漸有所不同.在此先就四層板大量興起后,為增加產量降低成本,而引起壓合技術之演變敘述于后:1.1一段壓力(Single Pressre)及多開口(Openning)式的壓床,及壓合法盛行,且壓力也漸提高很多,并實行冷熱分床加速流程.其間雖仍有兩段壓力法,但與早期兩段式壓力已有所不同.1.2部份取消對準固定(Pin),外層改用銅皮,代替原來的單面薄基板當成表層(Cap Sheet)去壓合,與基板(Laminates)之做法相似.1.3製程板面(Panel Size)實行多排版大型化,待完成壓合后,再切開分別進行后續流程,以增加壓合的產量,減少管理麻煩.1.4為應付四層板之廣大數量,其內層板有愈來愈厚的趨勢,以達節省成本及減少變形的目標.且膠片也要求減少流膠保持厚度,甚至邊膠流量之測量理論及方法也隨之革新.但最近由于IC卡的影響,小片薄型的四層板竟然做到20mil以下,可謂又走向另一極端.1.5為了有效抽走內層板中空陷處之空氣,并有效填膠起見,已發展出量產用的全真空二氧化碳壓媒式,進行低氣壓式的艙壓法(Autoclave),及抽空氣與原來油壓式合并的抽壓式(Hydralic Vacuum)壓板法等.1.6影像轉移之方式在綱印、干膜外更采用新式的電著光阻法(E.D.Photoresist).黑化法(Black Oxide)亦改進很多,并有內層蝕刻之自動化.1.7高層化對准系統(Registration)已大幅改進,而內層板亦采用自動光學檢驗(AOI),使8層以下的板子几乎都可使用Mass Lamination法進行量產.肆、流程概述一.水帄棕化:<brown oxide>水帄棕化的流程:入料段──化學清洗段──四道溢流水洗段──預浸段──棕化1──棕化2 ──四道溢流水洗段──純水洗段──熱風烘乾段──出料輸送段1化學清洗作用:鹼性清潔劑-R為去除光組殘渣之特效清潔劑,其可去除內層板上之銹斑,氧化物,指紋等異物,使處理後之表面潔淨,活化且易於清洗.操作條件:濃度10 ± 2 ﹪(體積比)溫度53 ± 2 ℃2四道溢流水洗段徹底洗去板面上殘留的藥液以防止污染後續之藥液.3預浸段防止前處理藥劑帶入棕化槽內及活化板面使棕化更容易進行.操作條件:濃度範圍最佳值濃度:100-B 2 ±0.2 ﹪ 2 ﹪100C-50 2 ±0.2 ﹪ 2 ﹪溫度:23℃±2℃4棕化1 & 棕化2提供多層線路板之內層結合,高度信賴性,獨特的有機金屬轉化層製程,其有機金屬轉化層具有良好的粗化表面,使其與環氧樹間具有良好的附著力,同時避免粉紅圈的發生.操作條件:濃度範圍最佳值濃度:100C-50 2.7-3.5 ﹪ 3 ﹪硫酸: 3.8-4.2 ﹪ 4 ﹪銅離子:30 g/l以下溫度:34 ± 2℃二.壓合:<Mass Lamination>壓合的流程:預疊合──自動疊合──熱壓──冷壓──自動拆解──半成品手動拆解──X-RAY──N.C. Router──自動磨邊1預疊合&自動疊合進壓合機之前,需將各多層板使用原料準備好,以便疊板(Lay-up)作業.除已氧化處理之內層外,尚需膠片(Prepreg),銅箔(Copper foil),以下就常用P/P敘述其規格種類及作業: 需注意不同供應商之規格不盡相同.P/P(Prepreg)之規格: R/C% R/F% GT sec7628HR 48±3 27±5 165 ±207628 43±3 20±5 165 ±202116 53±3 27±5 165 ±201080 61±3 35±5 165 ±20P/P的選用要考慮下列事項:-絕緣層厚度-內層銅厚-樹脂含量-內層各層殘留銅面積-對稱銅箔規格: 基重g/m^20.5oz(18um) 153±151.0oz(35um) 305±30組合的方法依客戶之規格要求有多種選擇,考量對稱,銅厚,樹脂含量,流量等以最低成本達品質要求:(a)其基本原則是兩銅箔或導體層間的絕緣介質層至少要兩張膠片所組成而且其壓合後之厚度不得低於3.5 mil(已有更尖端板的要求更薄於此)以防銅箔直接壓在玻璃布上形成介電常數太大之絕緣不良情形,而且附著力也不好。

多层板pcb制作工艺流程多层板PCB(Printed Circuit Board)是一种高密度的电子线路板,它由多层薄板材料和通过起电连接的电子元器件组成。
与单层和双层PCB相比,多层板PCB具有更高的组件密度和更好的电信号传输性能。
在本文中,我们将介绍多层板PCB的制作工艺流程。
一、设计和原理图制作多层板PCB的第一步是进行电路设计和原理图的绘制。
设计人员使用EDA(Electronic Design Automation)软件来绘制电路图,并进行电路布局和布线。
在这一阶段,设计人员需要考虑电路的功能要求、尺寸约束、信号完整性和EMC(Electromagnetic Compatibility)等方面的问题。
二、层叠结构设计在多层板PCB制作中,层叠结构设计是至关重要的。
设计人员需要确定板材的厚度、层间距、层内引线和地平面等参数。
同时,还需要考虑电源和地平面的分布、信号层的划分以及信号与地面的分离等问题。
合理的层叠结构设计可以提高多层板PCB的性能和可靠性。
三、布局和布线布局和布线是多层板PCB制作的核心环节。
设计人员根据电路设计和原理图,将元器件放置在PCB板上,并进行连线。
在布局过程中,需要考虑元器件的尺寸、位置和布线的长度等因素,以确保电路的性能和可靠性。
在布线过程中,需要注意信号的传输路径、阻抗匹配和信号完整性等问题。
四、内层图形制作内层图形制作是制作多层板PCB的关键步骤之一。
设计人员使用CAM(Computer-Aided Manufacturing)软件将布局和布线的信息转化为内层图形。
内层图形包括铜层、介质层和铜箔层等。
在内层图形制作过程中,需要注意图形的精度和准确性,以确保电路的性能和可靠性。
五、层压和孔加工层压是将内层图形进行层叠的过程。
在层压过程中,需要将内层图形与外层图形进行粘合,并加压固化。
层压后,还需要进行孔加工。
孔加工是将孔钻入多层板PCB,以便进行连线和连接。
孔加工的质量和准确性对于电路的性能和可靠性至关重要。
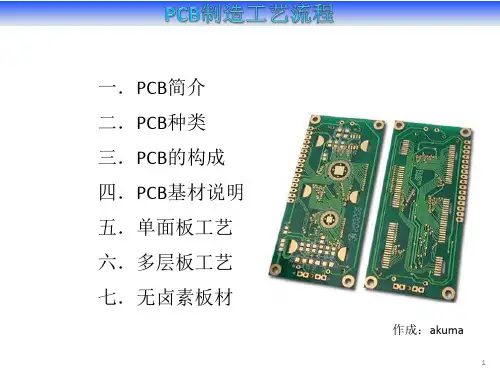
PCB压合制程基础知识目录一、概述 (2)二、PCB压合制程工艺基础 (2)1. 压合制程的原理 (3)2. 压合制程的重要性 (4)3. 压合制程的分类 (5)三、压合制程的材料与设备 (6)1. 基板材料 (8)2. 覆盖膜材料 (9)3. 压合设备概述及工作原理 (11)四、PCB压合制程工艺流程 (12)1. 原材料准备 (13)2. 叠板与组合 (14)3. 压制过程控制 (15)4. 品质检测与评估 (16)五、工艺参数的设置与优化 (17)1. 温度控制参数的设置与优化 (19)2. 压力控制参数的设置与优化 (20)3. 时间控制参数的设置与优化 (22)六、压合过程中的质量控制点分析 (24)1. 制程中的质量控制要求及方法介绍 (25)2. 制程中异常问题及解决方案探讨 (26)七、PCB压合制程的环境与安全要求及措施方案探讨 (28)八、压合制程的发展趋势与展望 (29)一、概述PCB压合制程,又称为印刷电路板压合工艺,是电子行业中的一个关键环节。
它涉及将多层印刷电路板(PCB)通过叠加和粘合的方式合并成一层或多层复合板,以形成具有特定功能和性能的高密度电路。
PCB压合制程在电子设备的生产过程中占据重要地位,其质量直接影响电子产品的可靠性、稳定性和性能。
PCB压合制程的基本原理是利用压力使各层PCB之间的绝缘介质压缩,从而实现各层电路的连接。
这一过程通常需要使用到专门的压合设备,如压机、模具等。
在压合过程中,还需要考虑温度、压力、时间等参数的精确控制,以确保各层电路之间的紧密结合,避免出现分层、空隙等问题。
随着电子技术的不断发展,对PCB压合制程的要求也越来越高。
为了提高电子产品的集成度和性能,需要采用更先进的材料和设计;另一方面,为了降低成本和提高生产效率,也需要不断优化压合制程的工艺和设备。
了解和掌握PCB压合制程的基础知识对于从事电子行业工作的人员来说具有重要意义。
二、PCB压合制程工艺基础基材准备与处理:PCB压合的第一步是准备高质量的基材。
內層課製程介紹壹、目的貳、流程簡介參、內層概述肆、流程概述內層製程介紹壹、目的:1.內層(Inner layer)製程原理說明內層最主要的目的在於製作多層電路板之內層線路部份隨著科技成就的發達,相對多層電路板的要求也隨之升高層數的增多.密集的細線路將成為內層製程的主流.貳、流程簡介:前處理感光阻劑附著曝光顯影蝕刻去墨檢修1.前處理前處理的主要目的是去氧化及粗化板面以增加板面與油墨間之附著力.包含:酸洗SPS微蝕化學式前處理硫酸雙氧水硬刷不織布陶瓷刷輪尼龍刷軟刷尼龍軟刷浮石粉物理性處理金鋼砂無刷輪噴砂浮石粉金鋼砂2.感光阻劑附著此段主要功用是將感光阻劑均勻附著於板面上.包含:乾膜製程濕墨印刷網印手動(半自動)印刷自動網印垂直式網版印刷roller coatercurtain coaterspray coater3.曝光利用特定波長之紫外光(UV)照射該感光阻劑,使感光部份形成架橋,而感光過程中即以感光起始劑受UV照射後分裂成高活性之"自由基",形成"交聯"反應產生鍵結,未感光部分並隨之顯影液而清洗去除.其型式分為手動曝光機帄行光非帄行光自動曝光機帄行光非帄行光4.顯影顯影是將未經曝光的區域洗去保留已曝光部分,其原理是未曝光的感光阻劑與顯影液中之碳酸鈉,形成鈉鹽而遭到溶解,使感光部分得以保留,以達到顯像的目的.5.蝕刻以蝕刻液(CuCL2,HCL,氧化劑)來咬蝕未被乾膜覆蓋之銅,使不頇要之銅層被除去,僅留下必頇的線路圖案.其型式分為:蝕刻酸性蝕刻鹼性蝕刻6.去墨以3%之NaOH將留在線上之油墨完全去除,內層板即成形。
7.檢修內層板的好壞與否主要決定於成品之兩面對準度是否精確和底片影像之轉移是否失真[一般以線路寬距改變的程度來判斷] 。
由於電路板上之線路寬距甚小,因此只要製程上的一個小失誤,便可能造成產品的不良。
8.退洗現行液態感光阻劑一但發生油墨附著有瑕疵時,曝光前尚可利用顯影線進行退洗至於曝光後則採氫氧化鈉利用油墨不耐鹼特質破壞鍵結予以去除,再以清水洗淨達到退洗效果。