常见电子元件的封装
- 格式:pptx
- 大小:3.96 MB
- 文档页数:55

元件封装的种类及辨识元件封装是指将电子元件或器件包装成具有一定外观尺寸和形状的外壳材料,以便于插入电路板或其他设备中,起到保护元件,方便组装和焊接的作用。
根据不同的要求和应用,元件封装有多种不同的类型和辨识方式。
下面将介绍一些常见的元件封装类型及其辨识方法。
1. DIP封装(Dual in-line package)DIP封装是一种常见的传统封装类型,多用于集成电路、模拟电路和线性电路等元件中。
辨识DIP封装的方法是通过外形尺寸和引脚数目来判断,通常为2至64个引脚,基本呈矩形形状。
2. SOP封装(Small Outline Package)SOP封装是一种比DIP更小巧且外形扁平的封装类型,常用于集成电路和数字电路等元件中。
辨识SOP封装的方法是通过外形尺寸和引脚数目来判断,通常为8至64个引脚,外形为长方形。
3. QFP封装(Quad Flat Package)QFP封装是一种大规模引脚密集的表面贴装封装类型,通常用于集成电路和微处理器等元件中。
辨识QFP封装的方法是通过外形尺寸和引脚数目来判断,通常为32至256个引脚,外形为正方形或长方形。
4. BGA封装(Ball Grid Array)BGA封装是一种与QFP相似的封装类型,其引脚位于封装底部,通过焊球连接到电路板上。
BGA封装常用于高密度和高频率电路中,例如芯片组、微处理器和图形处理器等元件。
辨识BGA封装的方法是通过外形尺寸和焊球排列布局来判断,外形通常为正方形。
5. SMD封装(Surface Mount Device)SMD封装是一种直接表面贴装的封装类型,用于电子元件直接焊接到电路板的表面。
SMD封装主要分为无源SMD和有源SMD两大类。
其中无源SMD封装包括贴片电阻、贴片电容等元件,有源SMD封装则包括晶体管、三极管等元件。
辨识SMD封装的方法是通过外形尺寸、标识代码和引脚间距来判断。
6. COB封装(Chip-On-Board)COB封装是指将芯片直接粘贴在电路板上,通常不使用封装外壳。


电子行业常见电子元件的封装引言在电子行业中,常用的电子元件可以分为许多不同的类型,它们在电子产品的设计与制造中起着至关重要的作用。
其中一个重要的方面就是元件的封装,即将电子元件嵌入到适当的封装中,以便于安装、使用和维护。
本文将介绍几种电子行业中常见的电子元件的封装类型,并说明它们的特点和应用场景。
1. DIP封装(Dual Inline Package)DIP封装是电子行业中最基本和最常见的封装类型之一。
它是一种通过两个平行的排针将元件与电路板连接的封装形式。
DIP封装通常用于集成电路(IC)和二极管等小型元件上,其较大的封装尺寸使得它易于手动安装和维修。
DIP封装的主要特点是易于制造和低成本,但其体积较大,不适用于高密度的电路板设计。
2. SMD封装(Surface Mount Device)SMD封装是一种在电子行业中越来越流行的封装类型。
相比于DIP封装,SMD封装更小巧、体积更小,适用于高密度电路板的设计。
SMD封装使用焊盘来连结元件和电路板,减少了排针的使用,因此可以实现更高的集成度和更好的电路性能。
SMD封装的另一个优点是它可以通过自动化设备进行快速的贴片焊接,提高了生产效率。
SMD封装有许多不同的类型,其中最常见的包括:•SOP封装(Small Outline Package):SOP封装是一种带有平行引脚的表面贴装元件封装。
SOP封装广泛应用于各种集成电路和传感器上。
它的特点是小型尺寸和较低的体积,适合于紧凑型电路板设计。
•QFP封装(Quad Flat Package):QFP封装是一种四边平行引脚的表面贴装封装,广泛应用于计算机和通信设备等高密度电子产品中。
QFP封装具有较高的引脚密度和较小的封装间距,可实现更高的集成度和更好的电路性能。
•BGA封装(Ball Grid Array):BGA封装是一种使用焊球连接元件和电路板的表面贴装封装。
BGA封装具有更高的引脚密度和更好的热性能,适用于需求更高性能和更高可靠性的电子产品。

常用电子元件封装(电阻,电容,二极管等)常用电子元件封装电阻:RES1,RES2,RES3,RES4;封装属性为axial系列无极性电容:cap;封装属性为RAD-0.1到rad-0.4电解电容:electroi;封装属性为rb.2/.4到rb.5/1.0电位器:pot1,pot2;封装属性为vr-1到vr-5二极管:封装属性为diode-0.4(小功率)diode-0.7(大功率)三极管:常见的封装属性为to-18(普通三极管)to-22(大功率三极管)to-3(大功率达林顿管)电源稳压块有78和79系列;78系列如7805,7812,7820等79系列有7905,7912,7920等常见的封装属性有to126h和to126v整流桥:BRIDGE1,BRIDGE2: 封装属性为D系列(D-44,D-37,D-46)电阻:AXIAL0.3-AXIAL0.7 其中0.4-0.7指电阻的长度,一般用AXIAL0.4瓷片电容:RAD0.1-RAD0.3。
其中0.1-0.3指电容大小,一般用RAD0.1电解电容:RB.1/.2-RB.4/.8 其中.1/.2-.4/.8指电容大小。
一般<100uF用RB.1/.2,100uF-470uF用RB.2/.4,>470uF用RB.3/.6二极管:DIODE0.4-DIODE0.7 其中0.4-0.7指二极管长短,一般用DIODE0.4发光二极管:RB.1/.2集成块:DIP8-DIP40, 其中8-40指有多少脚,8脚的就是DIP8 贴片电阻0603表示的是封装尺寸与具体阻值没有关系,但封装尺寸与功率有关通常来说如下:0201 1/20W0402 1/16W0603 1/10W0805 1/8W1206 1/4W电容电阻外形尺寸与封装的对应关系是:0402=1.0mmx0.5mm0603=1.6mmx0.8mm0805=2.0mmx1.2mm1206=3.2mmx1.6mm1210=3.2mmx2.5mm1812=4.5mmx3.2mm2225=5.6mmx6.5mm零件封装是指实际零件焊接到电路板时所指示的外观和焊点的位置。

封装形式BGADIPHSOPMSOPPLCCQFNQFPQSOPS DIPSIPSODSOJSOPSotSSOPTO - DeviceTSSOPTQFPBGA(ballgridarray)球形触点陈列,表面贴装型封装之一。
在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI芯片,然后用模压树脂或灌封方法进行密封。
也称为凸点陈列载体(PAC)。
该封装是美国Motorola公司开发的,首先在便携式电话等设备中被采用,今后在美国有可能在个人计算机中普及。
最初,BGA的引脚(凸点)中心距为1.5mm,引脚数为225.现在也有一些LSI厂家正在开发500引脚的BGA.BGA的问题是回流焊后的外观检查。
现在尚不清楚是否有效的外观检查方法。
有的认为,由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。
序号封装编号封装说明实物图1 BGA封装内存2 CCGA3 CPGA CerAMIc PinGrid4 PBGA 1.5mm pitch5 SBGA ThermallyEnhanced6 WLP-CSP Chip ScalePackageDIP(du ALI n-line package)返回双列直插式封装。
插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。
DIP是最普及的插装型封装,应用范围包括标准逻辑IC,存贮器LSI,微机电路等。
引脚中心距2.54mm,引脚数从6到64.封装宽度通常为15.2mm.有的把宽度为7.52mm和10.16mm的封装分别称为skinnyDIP和slimDIP(窄体型DIP)。
但多数情况下并不加区分,只简单地统称为DIP.另外,用低熔点玻璃密封的陶瓷DIP也称为cerdip。
序号封装编号封装说明实物图1 DIP14M3 双列直插2 DIP16M3 双列直插3 DIP18M3 双列直插4 DIP20M3 双列直插5 DIP24M3 双列直插6 DIP24M67 DIP28M3 双列直插8 DIP28M69 DIP2M 直插10 DIP32M6 双列直插11 DIP40M612 DIP48M6 双列直插13 DIP8 双列直插14 DIP8M 双列直插HSOP 返回H-(withheatsink)表示带散热器的标记。

电子元器件封装介绍电阻:RES1,RES2,RES3,RES4;封装属性为AXIAL系列无极性电容:CAP;封装属性为RAD-0.1到RAD-0.4电解电容:ELECTROI;封装属性为RB.2/.4到RB.5/1.0电位器:POT1,POT2;封装属性为VR-1到VR-5二极管:封装属性为DIODE-0.4(小功率)DIODE-0.7(大功率)三极管:常见的封装属性为TO-18(普通三极管)TO-22(大功率三极管)TO-3(大功率达林顿管)电源稳压块有78和79系列;78系列如7805,7812,7820等79系列有7905,7912,7920等常见的封装属性有TO126H和TO126V整流桥:BRIDGE1,BRIDGE2: 封装属性为D系列(D-44,D-37,D-46)电阻:AXIAL0.3-AXIAL0.7 其中0.3-0.7指电阻的长度,一般用AXIAL0.3瓷片电容:RAD0.1-RAD0.3。
其中0.1-0.3指电容大小,一般用RAD0.1电解电容:RB.1/.2-RB.4/.8 其中.1/.2-.4/.8指电容大小。
一般<100uF用RB.1/.2,100uF-470uF用RB.2/.4,>470uF用RB.3/.6二极管:DIODE0.4-DIODE0.7 其中0.4-0.7指二极管长短,一般用DIODE0.4发光二极管:RB.1/.2集成块:DIP8-DIP40, 其中8-40指有多少脚,8脚的就是DIP8贴片电阻0603表示的是封装尺寸与具体阻值没有关系,但封装尺寸与功率有关通常来说如下:0201 1/20W0402 1/16W0603 1/10W0805 1/8W1206 1/4W电容电阻外形尺寸与封装的对应关系是:0402=1.0mmx0.5mm0603=1.6mmx0.8mm0805=2.0mmx1.2mm1206=3.2mmx1.6mm1210=3.2mmx2.5mm1812=4.5mmx3.2mm2225=5.6mmx6.5mm零件封装是指实际零件焊接到电路板时所指示的外观和焊点的位置。

常用元件封装形式常用的元件封装形式有多种,每种形式适用于不同的应用和需求。
下面将介绍一些常见的元件封装形式及其特点。
1. 圆柱形封装(Axial package):圆柱形封装适用于通过引脚连接的元件,例如二极管、电容器、电感等。
这种封装形式有一定的体积,较容易安装于面板或PCB上,并且容易进行焊接。
2. 表面贴装封装(Surface Mount Package):表面贴装封装是目前常见的封装形式,特点是体积小、重量轻、可以高密度安装于PCB上,适用于高速电路和小型电子设备的需求。
常见的表面贴装封装有QFP(Quad Flat Package)、BGA(Ball Grid Array)、SOT(Small Outline Transistor)等。
3. 转接式封装(Dual in-line package,DIP):转接式封装是早期常用的封装形式,特点是引脚两侧对称排列,并通过两个直插式插座安装于PCB上。
这种封装形式适用于需要频繁更换元件的应用,如实验室、教学等场合。
4. 焊接式封装(Through-Hole Package):焊接式封装是最早使用的封装形式,适用于需要较大功率处理和较高的可靠性要求的元件。
由于焊接的强度较高,这种封装形式通常用于工业领域的电子设备。
5. 塑料封装(Plastic package):塑料封装是一种经济实用的封装形式,适用于大批量生产和消费电子产品的需求。
常见的塑料封装有TO-92、SOP(Small Outline Package)、DIP等,具有体积小、稳定性好和可靠性高的特点。
6. 瓷封装(Ceramic package):瓷封装适用于高温和高频率电路的需求,因为瓷封装具有较好的绝缘性能和热传导性能。
常见的瓷封装有TO-3、TO-220等,适用于功率放大器、稳压器等高功率元件。
7. 裸露芯片封装(Chip Scale Package,CSP):裸露芯片封装是一种高密度封装形式,将芯片直接封装在PCB上,没有外部封装物。

什么是电子元件的封装类型如何选择适当的封装类型电子元件是现代电子技术中不可或缺的基本组成部分,封装类型的选择对于电子设备的性能和可靠性具有重要影响。
本文将介绍电子元件的封装类型和选择适当封装类型的方法。
一、电子元件的封装类型1. DIP封装(Dual in-line package)DIP封装是一种传统的电子元件封装类型,常见于集成电路、二极管等元件。
DIP封装的特点是引脚通过直线排列,两侧有一定间距,方便手动插入和焊接。
然而,DIP封装的引脚数量有限,不适用于高密度、大功率的应用场景。
2. SOP封装(Small-outline package)SOP封装是一种小型化的封装类型,广泛应用于各种集成电路。
SOP封装的特点是引脚数量较多,密集排列,适用于高密度电路板的布局设计。
此外,SOP封装还具有良好的热散性能和良好的焊接可靠性。
3. BGA封装(Ball grid array)BGA封装是一种先进的电子元件封装类型,常见于微处理器、芯片组等高性能产品。
BGA封装的特点是引脚以球形焊珠的形式存在于封装底部,通过焊珠与电路板焊接,具有较高的引脚密度和可靠性。
BGA封装还可以提供较好的散热性能,适用于高功率应用。
4. QFN封装(Quad flat no-lead)QFN封装是一种无引脚的封装类型,适用于高密度和小尺寸的电子元件。
QFN封装的特点是引脚位于封装底部,通过焊盘与电路板连接。
QFN封装具有较好的散热性能和较小的封装占地面积,常用于集成电路和射频模块等应用。
二、选择适当的封装类型选择适当的封装类型需要综合考虑以下几个方面:1. 环境要求根据电子元件所处的环境需求,选择具备相应性能的封装类型。
如在高温环境下工作的元件,应选择具有良好热散性能的封装类型,如BGA封装。
2. 功能需求根据电子元件的功能需求,选择适当的封装类型。
如高密度、小尺寸的元件可选择QFN封装,而大功率应用可选择具有良好散热性能的封装类型。

元器件封装定义及分类
元器件封装是将电子元器件包装起来,以保护元器件,方便安装和使用。
根据元器件的尺寸、功率、形状、引脚数量和布局等因素,元器件封装可分为多种类型。
常见的元器件封装类型有:
1. DIP封装:双列直插封装,适用于引脚数量较少的元器件,如二极管、三极管等。
2. SOP封装:小外形直插封装,适用于引脚数量较多的集成电路和场效应管等元器件。
3. QFP封装:正方形扁平封装,适用于高密度元器件,如微处理器、控制器、存储器等。
4. BGA封装:球格阵列封装,适用于高密度、高速度、高功率的微处理器、控制器、存储器等。
5. SMT封装:表面贴装封装,适用于引脚数量少、尺寸小的元器件,如电容、电感、电阻等。
以上是常见的元器件封装类型,不同的封装类型适用于不同的元器件,有助于提高电路的可靠性和性能。
- 1 -。

电子行业电子元件标准封装1. 引言在电子行业领域,电子元件的封装是指将元器件封装成标准的外壳,以便于安装、维修和替换。
不同的元件在封装形式上存在差异,如贴片封装、插件封装、球栅阵列封装等。
本文将详细介绍电子行业中常见的电子元件标准封装形式和相关标准。
2. 贴片封装贴片封装是一种将电子元件固定在板面上的封装形式。
目前常见的贴片封装有SMD(Super Miniature Dimension)封装和COB(Chip On Board)封装。
SMD封装是指将元件的引脚直接焊接到PCB上,广泛应用于手机、平板电脑等小型电子设备中。
COB封装是将芯片直接粘贴在PCB上,然后使用导线连接。
常见的应用领域包括LED显示屏和车载电子设备。
贴片封装需要符合一定的标准,以确保元件的稳定性和可靠性。
一些常见的标准封装规格包括:0805、0603、0402等,其中数字代表了元件的尺寸大小。
3. 插件封装插件封装是一种将电子元件插入到插槽或插座中的封装形式。
这种封装方式适用于较大的电子元件,如电阻、电容、继电器等。
插件封装具有良好的可维修性,可以方便地进行元件的更换和升级。
常见的插件封装形式包括DIP(Dual In-Line Package)封装、PGA(Pin Grid Array)封装和BGA(Ball Grid Array)封装。
DIP封装是一种双排直插式封装,引脚从两侧分布。
该封装形式广泛应用于电路板的设计中,具有通用性和易使用性的特点。
PGA封装是一种引脚排列成网格状的封装形式,常用于高性能计算机的CPU等器件。
BGA封装是一种引脚以球状焊球连接到PCB上的封装形式,适用于高密度和高性能的应用领域。
4. 球栅阵列封装球栅阵列封装(Ball Grid Array,简称BGA)是一种将芯片封装为球形焊点阵列的封装形式。
BGA封装具有较高的密度、高速传输和散热性能好的特点,广泛应用于大型电子设备中,如计算机主板、网络设备等。
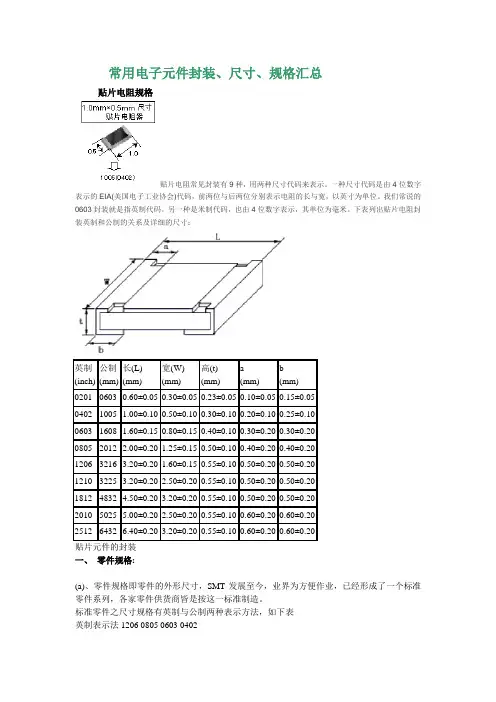
常用电子元件封装、尺寸、规格汇总贴片电阻规格贴片电阻常见封装有9种,用两种尺寸代码来表示。
一种尺寸代码是由4位数字表示的EIA(美国电子工业协会)代码,前两位与后两位分别表示电阻的长与宽,以英寸为单位。
我们常说的0603封装就是指英制代码。
另一种是米制代码,也由4位数字表示,其单位为毫米。
下表列出贴片电阻封装英制和公制的关系及详细的尺寸:贴片元件的封装一、零件规格:(a)、零件规格即零件的外形尺寸,SMT发展至今,业界为方便作业,已经形成了一个标准零件系列,各家零件供货商皆是按这一标准制造。
标准零件之尺寸规格有英制与公制两种表示方法,如下表英制表示法1206 0805 0603 0402公制表示法3216 2125 1608 1005含义L:1.2inch(3.2mm)W:0.6inch(1.6mm)L:0.8inch(2.0mm)W:0.5inch(1.25mm)L:0.6inch(1.6mm)W:0.3inch(0.8mm)L:0.4inch(1.0mm)W:0.2inch(0.5mm)注:a、L(Length):长度;W(Width):宽度;inch:英寸b、1inch=25.4mm(b)、在(1)中未提及零件的厚度,在这一点上因零件不同而有所差异,在生产时应以实际量测为准。
(c)、以上所讲的主要是针对电子产品中用量最大的电阻(排阻)和电容(排容),其它如电感、二极管、晶体管等等因用量较小,且形状也多种多样,在此不作讨论。
(d)、SMT发展至今,随着电子产品集成度的不断提高,标准零件逐步向微型化发展,如今最小的标准零件已经到了0201。
二、常用元件封装1)电阻:最为常见的有0805、0603两类,不同的是,它可以以排阻的身份出现,四位、八位都有,具体封装样式可参照MD16仿真版,也可以到设计所内部PCB库查询。
注:ABCD四类型的封装形式则为其具体尺寸,标注形式为L X S X H1210具体尺寸与电解电容B类3528类型相同0805具体尺寸:2.0 X 1.25 X 0.5(公制表示法)1206具体尺寸:3.0 X 1.5 0X 0.5(公制表示法)2)电阻的命名方法1、5%精度的命名:RS – 05 K 102 JT2、1%精度的命名:RS – 05 K 1002 FTR -表示电阻S -表示功率0402是1/16W、0603是1/10W、0805是1/8W、1206是1/4W、1210是1/3W、1812是1/2W、2010是3/4W、2512是1W。
常用电子元件封装、尺寸、规格汇总贴片电阻规格贴片电阻常见封装有9种,用两种尺寸代码来表示。
一种尺寸代码是由4位数字表示的EIA(美国电子工业协会)代码,前两位与后两位分别表示电阻的长与宽,以英寸为单位。
我们常说的0603封装就是指英制代码。
另一种是米制代码,也由4位数字表示,其单位为毫米。
下表列出贴片电阻封装英制和公制的关系及详细的尺寸:贴片元件的封装一、零件规格:(a)、零件规格即零件的外形尺寸,SMT发展至今,业界为方便作业,已经形成了一个标准零件系列,各家零件供货商皆是按这一标准制造。
标准零件之尺寸规格有英制与公制两种表示方法,如下表英制表示法1206 0805 0603 0402 公制表示法3216 2125 1608 1005含义L:1.2inch(3.2mm)W:0.6inch(1.6mm)L:0.8inch(2.0mm)W:0.5inch(1.25mm)L:0.6inch(1.6mm)W:0.3inch(0.8mm)L:0.4inch(1.0mm)W:0.2inch(0.5mm)注:a、L(Length):长度;W(Width):宽度;inch:英寸b、1inch=25.4mm(b)、在(1)中未提及零件的厚度,在这一点上因零件不同而有所差异,在生产时应以实际量测为准。
(c)、以上所讲的主要是针对电子产品中用量最大的电阻(排阻)和电容(排容),其它如电感、二极管、晶体管等等因用量较小,且形状也多种多样,在此不作讨论。
(d)、SMT发展至今,随着电子产品集成度的不断提高,标准零件逐步向微型化发展,如今最小的标准零件已经到了0201。
二、常用元件封装1)电阻:最为常见的有0805、0603两类,不同的是,它可以以排阻的身份出现,四位、八位都有,具体封装样式可参照MD16仿真版,也可以到设计所内部PCB库查询。
注:ABCD四类型的封装形式则为其具体尺寸,标注形式为L X S X H1210具体尺寸与电解电容B类3528类型相同0805具体尺寸:2.0 X 1.25 X 0.5(公制表示法)1206具体尺寸:3.0 X 1.5 0X 0.5(公制表示法)2)电阻的命名方法1、5%精度的命名:RS – 05 K 102 JT2、1%精度的命名:RS – 05 K 1002 FTR -表示电阻S -表示功率0402是1/16W、0603是1/10W、0805是1/8W、1206是1/4W、1210是1/3W、1812是1/2W、2010是3/4W、2512是1W。
常用电子元器件的封装形式1.DIP(直插式)封装:DIP封装是电子元器件的一种常见封装形式,其引脚以直插式连接到电路板上。
它的主要特点是易于手工焊接和更换,适用于大多数应用场景。
但是由于引脚间距相对较大,封装体积较大,无法满足小型化需求。
2.SOP(小外延封装)封装:SOP封装是一种较小的表面贴装封装,其引脚呈直线排列并焊接在电路板的表面上。
SOP封装具有容易自动化生产、体积小、引脚数量多等特点,适用于中等密度的电子元器件。
3.QFP(方形浸焊封装)封装:QFP封装是一种表面贴装封装,引脚排列呈方形形状,并通过焊点浸焊在电路板表面上。
QFP封装具有高密度、小尺寸、引脚数量多等特点,适用于高性能、小型化的电子设备。
4.BGA(球栅阵列)封装:BGA封装是一种高密度的表面贴装封装,引脚排列成网格状,并通过焊球连接到电路板的焊盘上。
BGA封装具有高密度、小尺寸、良好的散热性能等特点,适用于高性能计算机芯片、微处理器等。
5.SMD(表面贴装)封装:SMD封装是一种广泛应用于电子元器件的表面贴装封装。
其特点是体积小、重量轻、引脚密度高,适用于大规模自动化生产。
常见的SMD封装包括0805、1206、SOT-23等。
6.TO(金属外壳)封装:TO封装是一种金属外壳的电子元器件封装形式。
其主要特点是能够提供良好的散热性能和电磁屏蔽效果,适用于功率较大、需要散热的元器件。
7.COB(芯片上下接插封装)封装:COB封装是一种将芯片直接粘贴到电路板上,并通过金线进行引脚连接的封装形式。
COB封装具有体积小、重量轻、引脚数量多等特点,适用于小型化、高集成度的电子设备。
8.QFN(无引脚封装)封装:QFN封装是一种无引脚的表面贴装封装,引脚位于封装的底部。
QFN封装具有体积小、引脚密度高、良好的散热性能等特点,适用于小型、高性能的电子产品。
9.LCC(陶瓷外壳)封装:LCC封装是一种使用陶瓷材料制成的封装形式,具有较高的耐高温性和良好的散热性能。
电子行业电子元件封装概述在电子行业中,电子元件封装是指将片上集成电路(IC)、电阻、电容、电感等电子元件进行封装,以保护元件、方便组装和维修,并提供电路连接功能的过程。
电子元件封装在电子产品制造中起到非常重要的作用,它决定了电子产品的可靠性、性能和成本。
常见的电子元件封装类型1. 芯片级封装(Chip-level packaging)芯片级封装是将IC芯片封装成各种不同形式的外壳,保护芯片,并提供引脚连接。
常见的芯片级封装类型包括:•Dual In-line Package (DIP):双列直插封装,通常用于低密度IC芯片;•Small Outline Package (SOP):小外形封装,体积较小,适用于高密度集成电路;•Quad Flat Package (QFP):四边平封装,引脚在四周,适用于高密度集成电路;•Ball Grid Array (BGA):球栅阵列封装,引脚为球形,适用于高密度、高性能芯片。
2. 表面贴装封装(Surface Mount Technology, SMT)表面贴装封装是将电子元件直接焊接在印刷电路板(PCB)的表面,与传统的插针式封装不同。
常见的表面贴装封装类型包括:•零件级封装:将电阻、电容、电感等被动元件封装成带引脚的结构;•芯片级封装:将IC芯片封装成带引脚的结构;•模块级封装:将多个电子元件集成在一起,形成具有特定功能的封装。
3. 插针式封装(Through-hole technology, THT)插针式封装是将电子元件通过孔穿过印刷电路板,然后焊接在板的另一侧。
插针式封装通常用于较大、较重的元件,以及需要更高可靠性的应用。
常见的插针式封装类型包括:•DIP封装:将元件引脚插入直径合适的孔中;•TO封装:将元件引脚插入金属圆柱的孔中;•Header封装:将带有引脚的插座焊接在PCB上,用于插入其他元件。
封装对电子产品的影响电子元件封装直接影响电子产品的可靠性、性能和成本。
元器件封装形式对照表封装是电子元器件制造中的一个重要环节,它将裸露的芯片或器件进行包装,以保护和方便焊接或安装。
元器件封装形式对照表是一个指导性的工具,用于描述不同类型的元器件封装形式及其特点。
本文将根据元器件封装形式对照表的内容,介绍常见的几种元器件封装形式,包括DIP封装、SMD封装、BGA封装和QFN封装。
1. DIP封装(Dual In-line Package)DIP封装是最常见的一种封装形式,主要用于集成电路(IC)和其他一些小型器件。
它的特点是引脚以两排平行排列,可通过插针插入插座或焊接到电路板上。
DIP封装具有良好的可靠性和耐高温性能,但体积较大,适用于较低密度的电路设计。
2. SMD封装(Surface Mount Device)SMD封装是一种表面贴装技术,逐渐取代了传统的DIP封装。
SMD封装的元器件直接焊接在电路板的表面,无需插针或插座。
SMD封装具有体积小、重量轻、可靠性高、适应高密度布局等优点。
常见的SMD封装形式有SOIC、QFP、LGA等。
3. BGA封装(Ball Grid Array)BGA封装是一种高密度封装形式,适用于集成电路等大规模集成的器件。
BGA封装的特点是将引脚改为小球形焊球,通过焊球与电路板上的焊盘连接。
BGA封装具有连接可靠性好、散热性能优秀等优点,但维修困难,不适合频繁更换。
4. QFN封装(Quad Flat No-leads)QFN封装是一种无引脚封装形式,与BGA封装类似,但没有焊球,引脚直接暴露在封装底部。
QFN封装具有体积小、重量轻、散热性能好等优点,适用于高密度集成电路设计,如无线通信设备、嵌入式系统等。
除了以上四种常见的封装形式,还有许多其他类型的封装形式,如TO封装、PLCC封装、SOT封装等。
每种封装形式都有其特定的应用场景和优缺点,设计人员需要根据具体需求选择合适的封装形式。
总结:元器件封装形式对照表是一个有助于了解和选择合适封装形式的工具。
电子元器件封装大全1、BGA是英文Ball Grid Array Package的缩写,即球栅阵列封装。
20****90年代随着技术的进步,芯片集成度不断提高,I/O引脚数急剧增加,功耗也随之增大,对集成电路封装的要求也更加严格。
为了满足发展的需要,BGA封装开始被应用于生产。
采用BGA技术封装的内存,可以使内存在体积不变的情况下内存容量提高两到三倍,BGA与TSOP相比,具有更小的体积,更好的散热性能和电性能。
BGA封装技术使每平方英寸的存储量有了很大提升,采用BGA封装技术的内存产品在相同容量下,体积只有TSOP 封装的三分之一;另外,与传统TSOP封装方式相比,BGA封装方式有更加快速和有效的散热途径。
BGA封装的I/O端子以圆形或柱状焊点按阵列形式分布在封装下面,BGA技术的优点是I/O引脚数虽然增加了,但引脚间距并没有减小反而增加了,从而提高了组装成品率;虽然它的功耗增加,但BGA能用可控塌陷芯片法焊接,从而可以改善它的电热性能;厚度和重量都较以前的封装技术有所减少;寄生参数减小,信号传输延迟小,使用频率大大提高;组装可用共面焊接,可靠性高。
例如,引脚中心距为1.5mm的360引脚BGA仅为31mm见方;而引脚中心距为0.5mm 的304引脚QFP为40mm见方。
而且BGA不用担心QFP那样的引脚变形问题。
该封装是美国Motorola公司开发的,首先在便携式电话等设备中被采用,今后在美国有可能在个人计算机中普及。
最初,BGA的引脚(凸点)中心距为1.5mm,引脚数为225。
现在也有一些LSI厂家正在开发500引脚的BGA。
BGA的问题是回流焊后的外观检查。
现在尚不清楚是否有效的外观检查方法。
有的认为,由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。
美国Motorola公司把用模压树脂密封的封装称为OMPAC,而把灌封方法密封的封装称为GPAC(见OMPAC和GPAC)。