高度PCB(HDI)检验标准
- 格式:doc
- 大小:185.50 KB
- 文档页数:11

Q/DKBA 华为技术有限公司企业技术标准Q/DKBA3178.2-2004代替Q/DKBA3178.2-2003高密度PCB(HDI)检验标准2004年11月16日发布 2004年12月01日实施华为技术有限公司Huawei Technologies Co., Ltd.版权所有侵权必究All rights reserved目次前言 (4)1范围 (6)1.1范围 (6)1.2简介 (6)1.3关键词 (6)2规范性引用文件 (6)3术语和定义 (6)4文件优先顺序 (7)5材料要求 (7)5.1板材 (7)5.2铜箔 (7)5.3金属镀层 (8)6尺寸要求 (8)6.1板材厚度要求及公差 (8)6.1.1芯层厚度要求及公差 (8)6.1.2积层厚度要求及公差 (8)6.2导线公差 (8)6.3孔径公差 (8)6.4微孔孔位 (9)7结构完整性要求 (9)7.1镀层完整性 (9)7.2介质完整性 (9)7.3微孔形貌 (9)7.4积层被蚀厚度要求 (10)7.5埋孔塞孔要求 (10)8其他测试要求 (10)8.1附着力测试 (10)9电气性能 (11)9.1电路 (11)9.2介质耐电压 (11)10环境要求 (11)10.1湿热和绝缘电阻试验 (11)10.2热冲击(Thermal shock)试验 (11)11特殊要求 (11)12重要说明 (11)前言本标准的其他系列规范:Q/DKBA3178.1 刚性PCB检验标准Q/DKBA3178.3 柔性印制板(FPC)检验标准与对应的国际标准或其他文件的一致性程度:本标准对应于“IPC-6016 Qualification and Performance Specification for High Density Interconnect(HDI) Layers or Boards”。
本标准和IPC-6016的关系为非等效,主要差异为:依照华为公司实际需求对部分内容做了补充、修改和删除。


文件撰写及修订履历1.0 目的规范激光钻孔HDI板的各流程检验标准和运作流程。
保证HDI板各流程的品质。
2.0 范围:适用于崇达多层线路板有限公司的激光钻孔板的品质控制和检验。
3.0 职责:3.1 研发部负责编制并修改该文件。
本文为《盲埋孔(HDI)板制作能力及设计规范手册》的次级文件,如存在冲突,则以《盲埋孔(HDI)板制作能力及设计规范手册》内容为准。
3.2 品质部负责执行并监控该规范的使用3.3 生产部负责按照此规范的规定进行作业3.4 文控负责该文件的编号并进行归档4.0 作业内容:4.1 CAM资料/菲林检查4.1.1 检查规定4.1.2 检查标准4.1.2.1 内层有激光钻孔对位标靶标,与该激光钻孔对位标靶点对应的其他层位置要掏空;4.1.2.2 标靶必须距离最后一次外围粗锣板边6mm以上;4.1.2.3 内层要做激光盲孔检查矩阵PAD, PAD比激光盲孔直径大0.15mm(不含补偿);4.1.2.4 激光盲孔底PAD比激光盲孔直径通常大0.25-0.30mm,最小0.15mm(但需评审);4.1.2.5 底铜H oz板的盲孔开窗,蚀刻盲孔开窗直径比激光盲孔的直径大0.10mm,公差为+/-0.01mm,MI中需要注明;4.1.2.6 底铜1 oz板的盲孔开窗,蚀刻盲孔开窗直径比激光盲孔的直径大0.15mm,公差为+/-0.02mm,MI中需要注明;4.1.2.7 除绿油工序以外,内、外层所有菲林需要做CCD菲林;4.1.2.8 有盘中孔的板,原则上要做填孔电镀;客户要求做填平工艺的板,要做填孔电镀;如不明确,则问客确认是否需填孔电镀填平。
4.1.2.9 镀孔菲林开窗要比盲孔开窗直径单边大0.10mm(即,不含补偿,镀孔菲林开窗要比激光盲孔直径大0.15mm);4.2 内层(和外层)激光盲孔开窗4.2.2 检查标准4.2.2.1 盲孔开窗菲林、镀孔菲林全部需要使用CCD 菲林; 4.2.2.2 菲林图形在板上必须完整; 4.2.2.3 盲孔开窗菲林需要全部封边; 4.2.2.4 贴膜时干膜距离板边3mm ;4.2.2.5 盲孔开窗蚀刻必须做首板,检查盲孔开窗直径(注意公差:H oz 底铜:±0.01mm ;1oz 底铜±0.02mm ); 4.2.2.6首板切对角的盲孔矩阵,检查盲孔开窗与内层底PAD 的层间对位,要求盲孔开窗的直径必须在底PAD 直径的范围内。

高密度板标准参数
高密度板(High Density Board,简称HDI板)是一种在PCB领域中应用比较广泛的高密度互连技术,它可以在小尺寸板面上实现更多的功能。
HDI板可以缩小电路板的面积,提高电路板的密度,减少电磁干扰,同时增加电路板的可靠性和稳定性。
HDI板的标准参数主要包括以下几个方面:
1.层数:HDI板的层数一般是4-20层,而高端的HDI板可以达到40-50层。
2.线路宽度/间距:HDI板上线路的宽度和间距通常要求非常严格,常见的要求是线路宽度/间距为4/4mil(0.1mm),甚至更小。
3.盲孔、埋孔、母线:这些都是HDI板的特点之一,盲孔和埋孔可以减小电路板的面积,母线可以提高电路板的信号传输速率。
4.板厚:HDI板的板厚通常是0.8-3.2mm,其中1.6mm为最常见的厚度。
5.焊盘:HDI板上的焊盘一般要求非常小,常见的焊盘大小为0.2mm-0.5mm。
6.阻抗控制:对于高速信号传输的电路,HDI板的阻抗控制非常重要,要求非常
严格。
7.材料:HDI板的主要材料有FR4、BT、PI、PET等,不同的材料可以满足不同的要求。
总之,HDI板的标准参数非常多,需要根据具体的应用场景进行选择。
同时,HDI板的制造也非常复杂,需要采用先进的技术和设备,以及经验丰富的工程师进行设计和制造。



刚性印制板外观及信赖性验收通用准则规范外观验收通用准则规范:1.尺寸和形状:PCBHDI的尺寸和形状应满足设计要求,并且在制造过程中不应发生变形、扭曲或破损。
2.表面质量:PCBHDI的表面应平整、光滑,没有明显的划痕、凹陷或凸起。
印刷区域的喷涂油墨或丝印图案应清晰可见,没有模糊或缺失。
3.焊盘和引脚:PCBHDI的焊盘和引脚应与元器件连接良好,没有过量锡或缺失锡的情况。
焊盘和引脚的镀层应均匀、完整,并且符合相关的国际标准。
4.孔盖层:PCBHDI的孔盖层应完好无损,并且与周围的电路板层之间没有间隙或裂缝。
孔盖层的开孔应准确对位,并且尺寸应满足设计要求。
5.丝印标记:PCBHDI的丝印标记应清晰可见,丝印图案的文字和图形应完全可读,没有模糊或缺失。
丝印标记的位置应准确对位,并且与相关元器件的引脚或焊盘对应。
信赖性验收通用准则规范:1.焊接质量:PCBHDI的焊接质量应符合相关的国际标准,焊接接头应牢固可靠,没有冷焊、短路或焊脚受损的情况。
2.耐久性和稳定性:PCBHDI应具有良好的耐久性和稳定性,能够在长期使用和各种环境条件下保持正常工作。
它应能够耐受温度、湿度、振动和冲击等外部条件的影响,并且不易翘曲、老化或损坏。
3.电性能:PCBHDI的电性能应符合设计要求,能够提供稳定和可靠的电气连接。
它应具有低的电阻、电感和串扰,并且能够保持信号传输的准确性和完整性。
4.材料质量:PCBHDI所使用的材料应符合相关的国际标准,具有良好的质量和可靠性。
材料不应有问题,如气泡、裂纹、杂质或变色等。
总结起来,刚性印制板(PCBHDI)的外观和信赖性验收通用准则规范包括尺寸和形状、表面质量、焊盘和引脚、孔盖层、丝印标记等方面的要求。
这些准则和规范的遵循可以确保PCBHDI的质量和可靠性,提高其在电子产品中的应用性能。
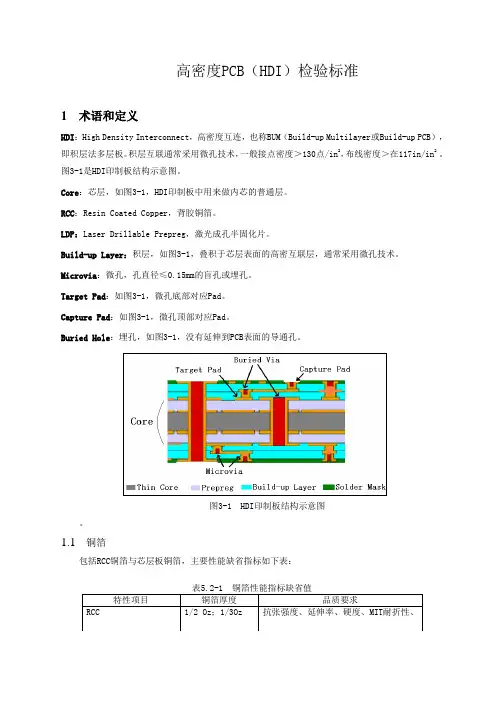
高密度PCB(HDI)检验标准1 术语和定义HDI:High Density Interconnect,高密度互连,也称BUM(Build-up Multilayer或Build-up PCB),即积层法多层板。
积层互联通常采用微孔技术,一般接点密度>130点/in2,布线密度>在117in/in2。
图3-1是HDI印制板结构示意图。
Core:芯层,如图3-1,HDI印制板中用来做内芯的普通层。
RCC:Resin Coated Copper,背胶铜箔。
LDP:Laser Drillable Prepreg,激光成孔半固化片。
Build-up Layer:积层,如图3-1,叠积于芯层表面的高密互联层,通常采用微孔技术。
Microvia:微孔,孔直径≤0.15mm的盲孔或埋孔。
Target Pad:如图3-1,微孔底部对应Pad。
Capture Pad:如图3-1,微孔顶部对应Pad。
Buried Hole:埋孔,如图3-1,没有延伸到PCB表面的导通孔。
图3-1 HDI印制板结构示意图。
1.1铜箔包括RCC铜箔与芯层板铜箔,主要性能缺省指标如下表:1.2金属镀层微孔镀铜厚度要求:表5.3-1 微孔镀层厚度要求2 尺寸要求本节描述HDI印制板的尺寸精度的特别要求,包括板材、导线、孔等。
尺度特性需用带刻度的≥30倍的放大系统作精确的测量和检验。
2.1板材厚度要求及公差2.1.1积层厚度要求及公差缺省积层介质为65~80um的RCC,压合后平均厚度≥40um,最薄处≥30um。
2.2导线公差导线宽度以线路底部宽度为准。
其公差要求如下表所示:表6.2-1 导线精度要求2.3孔径公差表6.3-1 孔径公差要求图6.3-1 微孔孔径示意图2.4微孔孔位微孔允许与Target Pad及Capture Pad相切,但不允许破盘。
图6.4-1 微孔孔位示意图3 结构完整性要求结构完整性要求需在热应力(Thermal stress)试验后进行,热应力试验方法:依据IPC-TM-650-2.6.8条件B进行。

高密度互联多层印制电路板国标定义一、引言高密度互联多层印制电路板(High Density Interconnect Multilayer Printed Circuit Board,简称HDI板)是一种在电子设备中广泛应用的关键元件,具有高集成度、高性能和高可靠性的特点。
为了确保HDI板的设计、制造和使用的一致性,国际上制定了一系列的标准,本文将对高密度互联多层印制电路板的国标进行详细解读。
二、HDI板的定义和分类HDI板是指印制电路板中通过高密度布线技术实现高集成度的多层板。
根据国际标准,HDI板分为三类:Type I、Type II和Type III。
Type I是指普通的多层印制电路板,Type II是指通过非阻塞装配技术实现高密度布线的多层板,Type III是指通过微细孔技术和盲埋孔技术实现高密度布线的多层板。
三、HDI板的国标要求1. 材料要求:HDI板应采用符合国际标准的无铅环保材料,以确保产品的安全性和可靠性。
2. 尺寸要求:HDI板的尺寸应符合设计要求,且边缘应平整,不得有毛刺或划痕。
3. 布线要求:HDI板的布线应符合设计规范,保证信号传输的稳定性和可靠性。
4. 孔径要求:HDI板的孔径应符合设计要求,孔径尺寸应准确,孔壁光滑,不得有残渣或毛刺。
5. 焊盘要求:HDI板的焊盘应具有良好的焊接性能,不得有氧化或污染物。
6. 焊接要求:HDI板的焊接应符合国际标准的焊接工艺要求,确保焊接质量的稳定性和可靠性。
7. 表面处理要求:HDI板的表面处理应符合设计要求,确保焊接性和耐腐蚀性。
8. 电气性能要求:HDI板的电气性能应符合设计规范,包括电阻、电容、介质常数等指标。
9. 可靠性要求:HDI板应经过严格的可靠性测试,确保产品在长时间使用中的稳定性和可靠性。
四、HDI板的应用领域HDI板在电子设备中的应用非常广泛,特别适用于移动通信设备、计算机、消费电子等领域。
HDI板的高集成度和高性能使得电子设备变得更加轻薄、高效和可靠。

Q/DKBA 华为技术企业技术标准Q/DKBA-2004代替Q/DKBA-2003高密度PCB〔HDI〕检验标准2004年11月16日公布2004年12月01日实施华为技术HuaweiTechnologiesCo.,Ltd.版权所有侵权必究Allrightsreserved目次前言本标准的其他系列标准:Q/DKBA3178.1刚性PCB检验标准Q/DKBA3178.3柔性印制板〔FPC〕检验标准与对应的国际标准或其他文件的一致性程度:本标准对应于“IPC-6016QualificationandPerformanceSpecificationforHighDensityInterconnect(HDI)Laye rsorBoards〞。
本标准和IPC-6016的关系为非等效,要紧差异为:依照华为公司实际需求对局部内容做了补充、修改和删除。
标准代替或作废的全部或局部其他文件:Q/DKBA3178.2-2003高密度PCB(HDI)检验标准与其他标准或文件的关系:上游标准Q/DKBA3061?单面贴装整线工艺能力?Q/DKBA3062?单面混装整线工艺能力?Q/DKBA3063?双面贴装整线工艺能力?Q/DKBA3065?选择性波峰焊双面混装整线工艺能力?DKBA3126?元器件工艺技术标准?Q/DKBA3121?PCB基材性能标准?下游标准PCBA板材外表外看检验标准?Q/DKBA3128?PCB工艺设计标准?与标准前一版本相比的升级更改的内容:相关于前一版本的变化是修订了RCC材料厚度及公差要求、微孔及埋孔孔径公差要求、镀铜厚度、热冲击条件等,增加了微孔形貌、积层被蚀厚度要求等。
本标准由工艺委员会电子装联分会提出。
本标准要紧起草和解释部门:工艺根底研究部本标准要紧起草专家:工艺技术治理部:居远道〔24755〕,业务部:成英华〔19901〕本标准要紧评审专家:工艺技术治理部:周欣〔1633〕、王界平〔7531〕、曹曦〔16524〕、张寿开〔19913〕、李英姿〔0181〕、张源〔16211〕、黄明利〔38651〕,业务部:丁海幸〔14610〕,采购策略中心:蔡刚〔12021〕、张勇〔14098〕,物料品质部:宋志锋〔38105〕、黄玉荣〔8730〕,互连设计部:景丰华〔24245〕、贾荣华〔14022〕,制造技术研究部总体技术部:郭朝阳〔11756〕本标准批准人:吴昆红本标准所替代的历次修订情况和修订专家为:高密度PCB〔HDI〕检验标准1范围1.1范围本标准是Q/DKBA3178?PCB检验标准?的子标准,包含了HDI制造中碰到的与HDI印制板相关的外看、结构完整性及可靠性等要求。

hdi标准
HDI即高密度互连板(High Density Interconnection,HDI),指线路密集、高多层、钻孔小于0.15mm的电路板。
HDI标准涉及多个方面,包括设备、人员和生产管控。
在设备方面,HDI需要全新的设备,前期投入资金十分庞大。
例如,CO激光成孔机平均每部50~60万美元,水平镀铜生产线PTH/CuPlating平均250~300万美元,细线曝光的激光直接成像设备超100万美元,细线与阻焊曝光的设备超100万美元,精密压合机同样百万美元以上。
此外,为放置各种先进设备,还必须配有无尘车间。
在人员方面,HDI生产需要配备多名专业的工程师。
具体包括激光钻孔工程师、HDI压合工程师、HDI全流程工艺工程师、线路工程师、阻焊工程师、高级工程研发人员等。
可见其生产操作的技术门槛是较高的。
在生产管控方面,HDI板厂需要拥有完整的生产体系,全工序不外发,严控产品质量。
以上信息仅供参考,如需了解更多信息,建议咨询专业人士。
高密度互联多层印制电路板国标定义高密度互联多层印制电路板(High-Density Interconnect Multilayer Printed Circuit Board,简称HDI PCB)是一种在电子设备中广泛使用的关键组件。
它采用高密度布线技术,通过多层堆叠的方式,将电子元器件连接在一起,实现电路的功能。
HDI PCB是根据国家标准进行设计和制造的。
国标规定了HDI PCB 的尺寸、材料、线宽线距、层数、阻抗控制等方面的要求,以确保其性能和可靠性。
同时,国标还规定了HDI PCB的测试方法和质量标准,以确保产品的合格率和稳定性。
HDI PCB相比于传统的印制电路板具有许多优势。
首先,HDI PCB 可以实现更高的电路密度。
由于采用了多层堆叠的结构,HDI PCB 可以在相同面积的情况下容纳更多的线路和元器件,从而提高了电路的集成度。
其次,HDI PCB可以减小电路板的尺寸和重量。
由于HDI PCB可以通过堆叠多层来实现电路功能,因此可以将传统的大面积电路缩小为小面积的多层结构,从而减小了电路板的尺寸和重量。
此外,HDI PCB还具有较好的电磁兼容性和抗干扰能力,可以提高电路的稳定性和可靠性。
为了满足国标的要求,HDI PCB的设计和制造需要考虑多个方面的因素。
首先,设计人员需要根据电路的功能和布局要求,确定电路板的层数和线宽线距。
其次,设计人员需要选择适合的材料,并进行阻抗控制和信号完整性分析,以确保电路板的性能。
此外,制造人员还需要掌握先进的生产工艺和设备,以确保电路板的质量和可靠性。
最后,测试人员需要按照国标的测试方法,对HDI PCB进行全面的检测和验证,以确保产品的合格率和可靠性。
HDI PCB在电子设备中有着广泛的应用。
首先,HDI PCB广泛应用于移动通信设备。
由于移动通信设备对电路板的尺寸和重量有较高的要求,因此HDI PCB的小尺寸和轻量化特性非常适合移动通信设备的需求。
Q/DKBA 华为技术有限公司企业技术标准Q/DKBA3178.2-2004代替Q/DKBA3178.2-2003高密度PCB(HDI)检验标准2004年11月16日发布 2004年12月01日实施目次前言 (4)1范围 (6)1.1范围 (6)1.2简介 (6)1.3关键词 (6)2规范性引用文件 (6)3术语和定义 (6)4文件优先顺序 (7)5材料要求 (7)5.1板材 (7)5.2铜箔 (7)5.3金属镀层 (8)6尺寸要求 (8)6.1板材厚度要求及公差 (8)6.1.1芯层厚度要求及公差 (8)6.1.2积层厚度要求及公差 (8)6.2导线公差 (8)6.3孔径公差 (8)6.4微孔孔位 (9)7结构完整性要求 (9)7.1镀层完整性 (9)7.2介质完整性 (9)7.3微孔形貌 (9)7.4积层被蚀厚度要求 (10)7.5埋孔塞孔要求 (10)8其他测试要求 (10)8.1附着力测试 (10)9电气性能 (11)9.1电路 (11)9.2介质耐电压 (11)10环境要求 (11)10.1湿热和绝缘电阻试验 (11)10.2热冲击(Thermal shock)试验 (11)11特殊要求 (11)12重要说明 (11)前言本标准的其他系列规范:Q/DKBA3178.1 刚性PCB检验标准Q/DKBA3178.3 柔性印制板(FPC)检验标准与对应的国际标准或其他文件的一致性程度:本标准对应于“IPC-6016 Qualification and Performance Specification for High Density Interconnect(HDI) Layers or Boards”。
本标准和IPC-6016的关系为非等效,主要差异为:依照华为公司实际需求对部分内容做了补充、修改和删除。
标准代替或作废的全部或部分其他文件:Q/DKBA3178.2-2003 高密度PCB(HDI)检验标准与其他标准或文件的关系:上游规范Q/DKBA3061 《单面贴装整线工艺能力》Q/DKBA3062 《单面混装整线工艺能力》Q/DKBA3063 《双面贴装整线工艺能力》Q/DKBA3065 《选择性波峰焊双面混装整线工艺能力》DKBA3126 《元器件工艺技术规范》Q/DKBA3121 《PCB基材性能标准》下游规范Q/DKBA3200.7 《PCBA板材表面外观检验标准》Q/DKBA3128 《PCB工艺设计规范》与标准前一版本相比的升级更改的内容:相对于前一版本的变化是修订了RCC材料厚度及公差要求、微孔及埋孔孔径公差要求、镀铜厚度、热冲击条件等,增加了微孔形貌、积层被蚀厚度要求等。
Q/DKBA 华为技术有限公司企业技术标准Q/DKBA3178.2-2004代替Q/DKBA3178.2-2003高密度PCB(HDI)检验标准2004年11月16日发布 2004年12月01日实施华为技术有限公司Huawei Technologies Co., Ltd.版权所有侵权必究All rights reserved目次前言 (4)1范围 (6)1.1范围 (6)1.2简介 (6)1.3关键词 (6)2规范性引用文件 (6)3术语和定义 (6)4文件优先顺序 (7)5材料要求 (7)5.1板材 (7)5.2铜箔 (7)5.3金属镀层 (8)6尺寸要求 (8)6.1板材厚度要求及公差 (8)6.1.1芯层厚度要求及公差 (8)6.1.2积层厚度要求及公差 (8)6.2导线公差 (8)6.3孔径公差 (8)6.4微孔孔位 (9)7结构完整性要求 (9)7.1镀层完整性 (9)7.2介质完整性 (9)7.3微孔形貌 (9)7.4积层被蚀厚度要求 (10)7.5埋孔塞孔要求 (10)8其他测试要求 (10)8.1附着力测试 (10)9电气性能 (11)9.1电路 (11)9.2介质耐电压 (11)10环境要求 (11)10.1湿热和绝缘电阻试验 (11)10.2热冲击(Thermal shock)试验 (11)11特殊要求 (11)12重要说明 (11)前言本标准的其他系列规范:Q/DKBA3178.1 刚性PCB检验标准Q/DKBA3178.3 柔性印制板(FPC)检验标准与对应的国际标准或其他文件的一致性程度:本标准对应于“IPC-6016 Qualification and Performance Specification for High Density Interconnect(HDI) Layers or Boards”。
本标准和IPC-6016的关系为非等效,主要差异为:依照华为公司实际需求对部分内容做了补充、修改和删除。
Q/DKBA 华为技术有限公司企业技术标准Q/DKBA3178.2-2004代替Q/DKBA3178.2-2003高密度PCB(HDI)检验标准2004年11月16日发布 2004年12月01日实施华为技术有限公司Huawei Technologies Co., Ltd.版权所有侵权必究All rights reserved目次前言 (4)1范围 (6)1.1范围 (6)1.2简介 (6)1.3关键词 (6)2规范性引用文件 (6)3术语和定义 (6)4文件优先顺序 (7)5材料要求 (7)5.1板材 (7)5.2铜箔 (7)5.3金属镀层 (8)6尺寸要求 (8)6.1板材厚度要求及公差 (8)6.1.1芯层厚度要求及公差 (8)6.1.2积层厚度要求及公差 (8)6.2导线公差 (8)6.3孔径公差 (8)6.4微孔孔位 (9)7结构完整性要求 (9)7.1镀层完整性 (9)7.2介质完整性 (9)7.3微孔形貌 (9)7.4积层被蚀厚度要求 (10)7.5埋孔塞孔要求 (10)8其他测试要求 (10)8.1附着力测试 (10)9电气性能 (11)9.1电路 (11)9.2介质耐电压 (11)10环境要求 (11)10.1湿热和绝缘电阻试验 (11)10.2热冲击(Thermal shock)试验 (11)11特殊要求 (11)12重要说明 (11)前言本标准的其他系列规范:Q/DKBA3178.1 刚性PCB检验标准Q/DKBA3178.3 柔性印制板(FPC)检验标准与对应的国际标准或其他文件的一致性程度:本标准对应于“IPC-6016 Qualification and Performance Specification for High Density Interconnect(HDI) Layers or Boards”。
本标准和IPC-6016的关系为非等效,主要差异为:依照华为公司实际需求对部分内容做了补充、修改和删除。
Q/DKBA 华为技术企业技术标准Q/DKBA3178.2-2004代替Q/DKBA3178.2-2003高密度PCB(HDI)检验标准2004年11月16日发布 2004年12月01日实施华为技术有限公司Huawei Technologies Co., Ltd.所有侵权必究All rights reserved目次前言 (4)1围 (6)1.1围 (6)1.2简介 (6)1.3关键词 (6)2规性引用文件 (6)3术语和定义 (6)4文件优先顺序 (7)5材料要求 (7)5.1板材 (7)5.2铜箔 (7)5.3金属镀层 (8)6尺寸要求 (8)6.1板材厚度要求及公差 (8)6.1.1芯层厚度要求及公差 (8)6.1.2积层厚度要求及公差 (8)6.2导线公差 (8)6.3孔径公差 (8)6.4微孔孔位 (9)7结构完整性要求 (9)7.1镀层完整性 (9)7.2介质完整性 (9)7.3微孔形貌 (9)7.4积层被蚀厚度要求 (10)7.5埋孔塞孔要求 (10)8其他测试要求 (10)8.1附着力测试 (10)9电气性能 (11)9.1电路 (11)9.2介质耐电压 (11)10环境要求 (11)10.1湿热和绝缘电阻试验 (11)10.2热冲击(Thermal shock)试验 (11)11特殊要求 (11)12重要说明 (11)前言本标准的其他系列规:Q/DKBA3178.1 刚性PCB检验标准Q/DKBA3178.3 柔性印制板(FPC)检验标准与对应的国际标准或其他文件的一致性程度:本标准对应于“IPC-6016 Qualification and Performance Specification for High Density Interconnect(HDI) Layers or Boards”。
本标准和IPC-6016的关系为非等效,主要差异为:依照华为公司实际需求对部分容做了补充、修改和删除。
Q/DKBA 华为技术有限公司企业技术标准Q/DKBA3178.2-2004代替Q/DKBA3178.2-2003高密度PCB(HDI)检验标准2004年11月16日发布 2004年12月01日实施华为技术有限公司Huawei TechnologiesCo.,Ltd.版权所有侵权必究All rights reserved目次前言ﻩ错误!未定义书签。
1范围ﻩ错误!未定义书签。
1.1ﻩ范围 ......................................... 错误!未定义书签。
1.2简介......................................... 错误!未定义书签。
1.3关键词ﻩ错误!未定义书签。
2规范性引用文件..................................... 错误!未定义书签。
3术语和定义ﻩ错误!未定义书签。
4ﻩ文件优先顺序 ........................................ 错误!未定义书签。
5ﻩ材料要求ﻩ错误!未定义书签。
5.1ﻩ板材 .......................................... 错误!未定义书签。
5.2ﻩ铜箔 ......................................... 错误!未定义书签。
5.3金属镀层ﻩ错误!未定义书签。
6尺寸要求........................................... 错误!未定义书签。
6.1ﻩ板材厚度要求及公差ﻩ错误!未定义书签。
6.1.1ﻩ芯层厚度要求及公差ﻩ错误!未定义书签。
6.1.2 ........................................... 积层厚度要求及公差ﻩ错误!未定义书签。
6.2导线公差ﻩ错误!未定义书签。
6.3孔径公差..................................... 错误!未定义书签。
6.4微孔孔位ﻩ错误!未定义书签。
7ﻩ结构完整性要求ﻩ错误!未定义书签。
7.1ﻩ镀层完整性ﻩ错误!未定义书签。
7.2ﻩ介质完整性 ................................... 错误!未定义书签。
7.3微孔形貌..................................... 错误!未定义书签。
7.4积层被蚀厚度要求ﻩ错误!未定义书签。
7.5ﻩ埋孔塞孔要求 ................................. 错误!未定义书签。
8ﻩ其他测试要求 ........................................ 错误!未定义书签。
8.1ﻩ附着力测试ﻩ错误!未定义书签。
9ﻩ电气性能ﻩ错误!未定义书签。
9.1电路错误!未定义书签。
9.2........................................................................... 介质耐电压ﻩ错误!未定义书签。
10ﻩ环境要求ﻩ错误!未定义书签。
10.1湿热和绝缘电阻试验.......................... 错误!未定义书签。
10.2热冲击(Thermalshock)试验................ 错误!未定义书签。
11ﻩ特殊要求 ........................................... 错误!未定义书签。
12重要说明ﻩ错误!未定义书签。
前言本标准的其他系列规范:Q/DKBA3178.1 刚性PCB检验标准Q/DKBA3178.3 柔性印制板(FPC)检验标准与对应的国际标准或其他文件的一致性程度:本标准对应于“IPC-6016 Qualification and Performance Specification for High Density Interconnect(HDI) Layersor Boards”。
本标准和IPC-6016的关系为非等效,主要差异为:依照华为公司实际需求对部分内容做了补充、修改和删除。
标准代替或作废的全部或部分其他文件:Q/DKBA3178.2-2003高密度PCB(HDI)检验标准与其他标准或文件的关系:上游规范Q/DKBA3061《单面贴装整线工艺能力》Q/DKBA3062 《单面混装整线工艺能力》Q/DKBA3063 《双面贴装整线工艺能力》ﻩQ/DKBA3065 《选择性波峰焊双面混装整线工艺能力》DKBA3126 《元器件工艺技术规范》Q/DKBA3121 《PCB基材性能标准》下游规范Q/DKBA3200.7 《PCBA板材表面外观检验标准》Q/DKBA3128 《PCB工艺设计规范》与标准前一版本相比的升级更改的内容:相对于前一版本的变化是修订了RCC材料厚度及公差要求、微孔及埋孔孔径公差要求、镀铜厚度、热冲击条件等,增加了微孔形貌、积层被蚀厚度要求等。
本标准由工艺委员会电子装联分会提出。
本标准主要起草和解释部门:工艺基础研究部本标准主要起草专家:工艺技术管理部:居远道(24755),手机业务部:成英华(19901)本标准主要评审专家:工艺技术管理部:周欣(1633)、王界平(7531)、曹曦(16524)、张寿开(19913)、李英姿(0181)、张源(16211)、黄明利(38651),手机业务部:丁海幸(14610),采购策略中心:蔡刚(12010)、张勇(14098),物料品质部:宋志锋(38105)、黄玉荣(8730),互连设计部:景丰华(24245)、贾荣华(14022),制造技术研究部总体技术部:郭朝阳(11756)本标准批准人:吴昆红本标准所替代的历次修订情况和修订专家为:高密度PCB(HDI)检验标准1 范围1.1范围本标准是Q/DKBA3178《PCB检验标准》的子标准,包含了HDI制造中遇到的与HDI印制板相关的外观、结构完整性及可靠性等要求。
本标准适用于华为公司高密度PCB(HDI)的进货检验、采购合同中的技术条文、高密度PCB(HDI)厂资格认证的佐证以及高密度PCB(HDI)设计参考。
1.2简介本标准针对HDI印制板特点,对积层材料、微孔、细线等性能及检测要求进行了描述。
本标准没有提到的其他条款,依照Q/DKBA3178.1《刚性PCB检验标准》执行。
1.3关键词PCB、HDI、检验2 规范性引用文件下列文件中的条款通过本规范的引用而成为本规范的条款。
凡是注日期的引用文件,其随后所有的修改单(不包括勘误的内容)或修订版均不适用于本规范,然而,鼓励根据本规范达成协议的各方研究是否可使用这些文件的最新版本。
凡是不注日期的引用文件,其最新版本适用于本规范。
3术语和定义HDI:High Density Interconnect,高密度互连,也称BUM(Build-up Multilayer或Buil d-upPCB),即积层法多层板。
积层互联通常采用微孔技术,一般接点密度>130点/in2,布线密度>在117in/in2。
图3-1是HDI印制板结构示意图。
Core:芯层,如图3-1,HDI印制板中用来做内芯的普通层。
RCC:Resin Coated Copper,背胶铜箔。
LDP:Laser Drillable Prepreg,激光成孔半固化片。
Build-up Layer:积层,如图3-1,叠积于芯层表面的高密互联层,通常采用微孔技术。
Microvia:微孔,孔直径≤0.15mm的盲孔或埋孔。
Target Pad:如图3-1,微孔底部对应Pad。
Capture Pad:如图3-1,微孔顶部对应Pad。
Buried Hole:埋孔,如图3-1,没有延伸到PCB表面的导通孔。
图3-1 HDI印制板结构示意图4 文件优先顺序当各种文件的条款出现冲突时,按如下由高到低的优先顺序进行处理:•印制电路板的设计文件(生产主图)•已批准(签发)的HDI印制板采购合同或技术协议•本高密度PCB(HDI)检验标准•已批准(签发)的普通印制板采购合同或技术协议•刚性PCB检验标准•IPC相关标准5材料要求本章描述HDI印制电路板所用材料基本要求。
5.1板材缺省芯层材料为FR-4,缺省积层材料为RCC;在满足产品性能前提下,积层材料也可采用106(FR-4)、1080(FR-4)及LDP材料。
以上材料均需满足华为Q/DKBA3121《PCB基材性能标准》性能要求。
5.2 铜箔包括RCC 铜箔与芯层板铜箔,主要性能缺省指标如下表:5.3 金属镀层微孔镀铜厚度要求:ﻩ表5.3-1 微孔镀层厚度要求6 尺寸要求本节描述HDI 印制板的尺寸精度的特别要求,包括板材、导线、孔等。
尺度特性需用带刻度的≥30倍的放大系统作精确的测量和检验。
6.1 板材厚度要求及公差 6.1.1 芯层厚度要求及公差缺省板材为FR-4覆铜板,其厚度要求及公差要求依据Q/DKBA3178.1《刚性PCB 检验标准》。
6.1.2 积层厚度要求及公差缺省积层介质为65~80um的RCC,压合后平均厚度≥40um,最薄处≥30um 。
若设计文件规定积层厚度,其厚度公差依据Q/DKB A3178.1《刚性PCB 检验标准》。
6.2 导线公差导线宽度以线路底部宽度为准。
其公差要求如下表所示:ﻩ表6.2-1 导线精度要求6.3 孔径公差表6.3-1 孔径公差要求类型孔径公差备注微孔±0.025mm微孔孔径为金属化前直径。
如下图“A”机械钻孔式埋孔±0.1mm 此处“孔径”指成孔孔径其他类型参考Q/DKBA3178.1《刚性PCB检验标准》图6.3-1 微孔孔径示意图6.4微孔孔位微孔允许与Target Pad及Capture Pad相切,但不允许破盘。
图6.4-1微孔孔位示意图7 结构完整性要求结构完整性要求需在热应力(Thermal stress)试验后进行,热应力试验方法:依据IPC -TM-650-2.6.8条件B进行。
除非特殊要求,要经过5次热应力后切片。
金相切片的制作要求依照IPC-TM-650-2.1.1或2.1.1.2进行,垂直切片至少检查3个孔。
金相切片的观察要求在100X ±5%的放大下进行,评判时在200X±5%的放大下进行,镀层厚度小于1um时不能用金相切片技术来测量。
7.1镀层完整性[1]金属镀层无裂纹、分离、空洞和污染物;[2]微孔底部和Target Pad之间不允许出现未除尽的胶渣或其他杂质。
7.2介质完整性测试后无剥离、气泡、分层、软化等现象。
7.3微孔形貌[1]微孔直径应满足:B≥0.5×A图7.3-1微孔形貌(注:A—微孔顶部电镀前直径;B—微孔底部电镀前直径。