BGA焊接失效分析报告
- 格式:doc
- 大小:1.22 MB
- 文档页数:12

BGA虚焊问题分析报告*****公司关于芯片BGA 虚焊问题分析(一)现场图片X-RAY照片(第一次时提供照片的截图,芯片未贴片前拍摄。
拍摄位置:芯片正上方)回流焊后异常芯片剥离照片问题芯片剥离图片放大图片1位置放大图片2位置问题芯片剥离图片细节放大放大图片1 放大图片2放大图片3回流焊后检测合格芯片剥离照片(芯片焊接面100%剥离)放大图片4(二)图片分析1.图片1焊接面使用高倍显微镜观察:锡面灰暗,空洞很多。
请特别注意红框位置;2.锡面灰暗应是焊锡高温氧化的迹象。
我们认为这里的锡面氧化应是在回流焊的高温影响后发生。
发生的原因与植球与芯片焊面的虚焊有关,并且这种虚焊在回流焊时无法得到改善。
我们认为芯片植球时已存在异常,导致植球与芯片接触面未初步形成有效地IMC(红色框)。
综合后我们认为植球与芯片间的有虚焊现象。
正常时植球后应该形成初步的焊点。
3.空洞较多也说明植球与芯片焊接面存在异常情况的发生;4.根据材质及焊接结合力、拉力分析:我们认为良好的植球与芯片形成良好的IMC后,当我们剥离芯片时大部分的芯片焊接面应被拉起脱落(各图片的蓝色框)。
而且我们剥离的合格芯片产品的焊接面观察,在芯片剥离后确实也是100%脱落(见放大图4)。
而有问题的芯片仅有四点拉脱(见回流焊后异常芯片剥离照片蓝色框);5.我司在外协厂贴片后植球与PCB间形成了良好的IMC,(参见图片3中的紫色框体内)。
整体移除锡球后没有看见异常现象。
(三)图片分析结论1.供方提供的芯片在植球时已出现植球与芯片有效焊接面的虚焊及不确定异常导致的较多空洞现象;2.供方植球时已出现植球与芯片有效焊接面的虚焊及不确定异常导致的较多空洞现象直接导致了SMT回流焊后无法调校的缺陷:芯片焊接面与植球间的虚焊或简单称为融合异常问题在回流焊后没有改善,导致芯片功能异常;(四)供方的回复(以下原文)发件人: **********发送时间: 2010年**月**日 ****收件人: *********主题: RE: Fw: 植球不良照片Hi ******空洞和虚焊是两个概念。
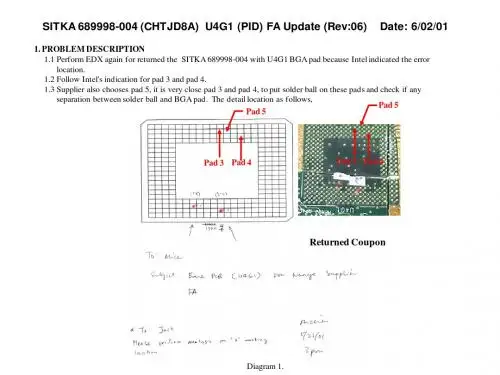





BGA焊点失效引发不开机案例分析生产质量部--Quality2010年8月25日问题描述不良情况汇总从公司成立至今,在售后返修不良原因中占数量最大的就是BGA虚焊或者焊点开裂(主要是CPU)。
因BGA虚焊或焊点开裂造成不开机、开机掉电等不良的项目累计有R1000、R6300、D16、D18、T616、M550、M555,其中不良最多的为R6300。
查看这些项目都有一个共性,并不是在组装线就退回。
都是在客户端使用一段时间后开始出现不开机、开机掉电、白屏、重启等问题,特别是用手按键时故障容易复现。
并且一旦有退回一般量都会比较大。
售后维修时重新焊接相应的BGA后故障消失,基本都是由BGA虚焊或者焊点开裂造成。
问题描述R6300不良数据此项目在07年5、6、8、10月共贴片24274pcs。
5月份贴片2k当时客户天鸿利在销售1-2周后几乎100%退机,造成客户该项目直接死掉。
故障都是不开机或者开机掉电、死机。
售后维修时重新加焊CPU即可,但过一段时间故障重现。
从6月中旬开始安排点胶,后面出货的22k全部是点胶后。
同一时期R1000结构类似故直接安排点胶后再出货。
问题描述D16不良数据在08年1-4月份生产D16出货后同样是因为不开机、开机掉电等退回,加焊CPU即可。
客户圣力天和盛世中唐、以诺、科讯都有退回,对于客户没有装机的3956pcs退回工厂后对CPU点胶,点胶后再测试功能OK重新出货。
整体不良比率在3%左右。
出货数量:42067pcs,总退回量:2178pcs客退比率:5.18%(CPU重焊占3%)CPU重焊:954pcs问题描述D18和T616不良数据D18生产数量:44215pcs退回数量:3800pcs客退比率:8.5% (CPU重焊占4.35%)CPU重焊:1925pcsT616生产数量:18000pcs(除7528pcs出货给客户装机无法点胶,剩余全部退工厂点胶)退回数量:1164pcs客退比率:6.5% (CPU重焊占3.6%)CPU重焊:643pcs问题描述M550不良数据明细M550项目从09年9月份开始生产,关于CPU 虚焊引起的不开机或者黑屏等不良统计,数据截止10年7月底整体不良在0.3%。

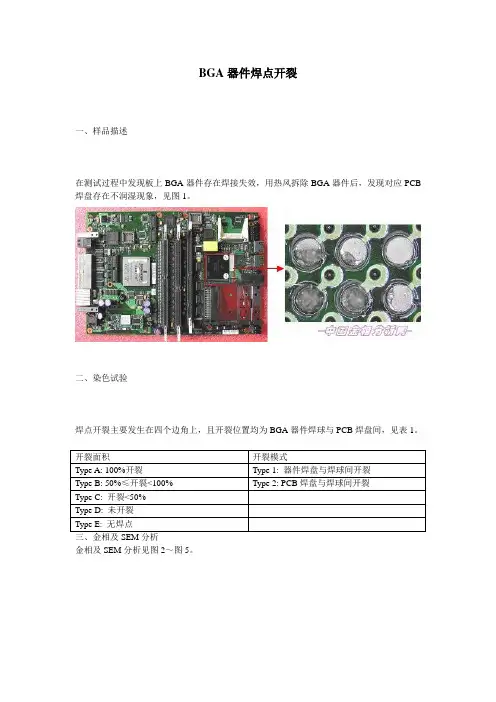
BGA器件焊点开裂一、样品描述在测试过程中发现板上BGA器件存在焊接失效,用热风拆除BGA器件后,发现对应PCB 焊盘存在不润湿现象,见图1。
二、染色试验焊点开裂主要发生在四个边角上,且开裂位置均为BGA器件焊球与PCB焊盘间,见表1。
开裂面积开裂模式Type A: 100%开裂Type 1: 器件焊盘与焊球间开裂Type B: 50%≤开裂<100% Type 2: PCB焊盘与焊球间开裂Type C: 开裂<50%Type D: 未开裂Type E: 无焊点金相及SEM分析见图2~图5。
四、综合分析对所送PCBA器件焊点进行分析,均发现已失效器件和还未失效器件焊点在IMC与Ni 层的富磷层(P-Rich)间存在开裂,且镍层存在腐蚀;在焊接过程中,Sn与Ni反应生成Sn/Ni 化合物,而镍层中的磷不参与合金反应,因此多余的磷原子则会留在镍层和合金层界面,过多的P在镍和IMC界面富集将形成黑色的富磷(P-Rich)层,同时,存在的镍层腐蚀会影响焊料与镍层的结合,富磷层和镍层腐蚀的存在会降低焊点与焊盘之间的结合强度;当焊点在组装过程中受到应力时,会在焊点强度最弱处发生开裂,BGA封装角部焊点由于远离中心点,承受的应力更大,故开裂一般会先发生在角部。
由于未发现板子严重翘起、器件机械损伤等异常应力作用的特征,因此导致焊点开裂的应力可能来自于回流焊接或者波峰焊接过程等环境中所受到的正常应力。
同时,同批次及相邻批次PCB样品(生产日期0725和0727)Au/Ni焊盘SEM&EDS 的分析结果也表明,PCB焊盘Ni层也存在一定腐蚀。
由以上分析可得,由于较厚富磷层(P-Rich)及镍层腐蚀的存在,将降低焊点与焊盘之间的结合强度,使得该处成为焊点强度最薄弱的地方,在受到正常应力情况下,发生开裂失效。
五、分析结论(1)BGA器件焊接失效表现为焊点存在100%开裂,开裂位置发生在IMC与PCB焊盘Ni层的富磷层(P-Rich)间。


BGA 封装的焊点失效分析张浩敏1,2,李晓倩1,2,张旭武1,2,李鹏1,3(1.工业和信息化部电子第五研究所,广东广州510610;2.宁波赛宝信息产业技术研究院有限公司,浙江宁波315040;3.工业和信息化部电子第五研究所华东分所,江苏苏州215011)摘要:针对BGA 封装中产生的PCB 焊盘坑裂,利用X 射线扫描、染色渗透、金相分析、扫描电镜和热分析等方法对其失效原因进行了分析。
结果表明:由于失效品器件PCB 焊盘的热膨胀系数不匹配,导致PCB 基材受到的热应力过大,最终导致PCB 焊盘坑裂。
关键词:球栅阵列封装;焊盘坑裂;热应力;失效分析中图分类号:TN 41文献标志码:A文章编号:1672-5468(2021)01-0032-07doi:10.3969/j.issn.1672-5468.2021.01.007Solder Joint Failure Analysis of BGA PackageZHANG Haomin 1,2,LI Xiaoqian 1,2,ZHANG Xuwu 1,2,LI Peng 1,3(1.CEPREI ,Guangzhou 510610,China ;2.Ningbo CEPREI Information Industry Technology Research Institute Co.,Ltd.,Ningbo 315040,China ;3.CEPREI-EAST ,Suzhou 215011,China )Abstract :In view of the PCB craters generated in BGA packaging ,the reasons for its failureare analyzed by X -ray scanning ,dyee penetration ,metallographic analysis ,scanning electron microscopy and thermal analysis.The results show that due to the mismatch of the coefficient of thermal expansion of the failed device PCB pad ,the PCB substrate is subjected to excessivethermal stress ,which eventually leads to the PCB pad cracking .Keywords :BGA package ;pad crack ;thermal stress ;failure analysis收稿日期:2020-05-11作者简介:张浩敏(1988-),男,安徽池州人,工业和信息化部电子第五研究所、宁波赛宝信息产业技术研究院有限公司工程师,主要从事电子元器件分析测试工作。
DFR-01
一、样品描述
所送检的PCBA样品经电性能测试发现其BGA部位可能有焊接不良(怀疑虚焊)存在,现需分析该问题是该PCBA在SMT制程中造成或是PCB 的(即上锡不良)原因。
委托单位提供了一件PCBA样品与所用的3件PCB 样品。
二、分析过程
1、显微分析
将PCBA上的BGA部分切下,用环氧树脂镶嵌、刨磨、抛光、腐蚀制作BGA焊点的金相剖面或截面,然后用Nikon OPTIPHOT金相显微镜与LEICA MZ6立体显微镜进行观察分析,发现在第一排的第四焊点存在缺陷,锡球与焊盘间有明显的分离现象(图1),其他焊点未检查到类似情况。
图1 BGA焊点(第一排第4个)切片截面显微镜照片(1)
2、PCB焊盘的可焊性分析
图2 BGA焊点缺陷部位放大的显微镜照片(2)
图3 PCB上的BGA焊接部位的润湿不良的焊盘(1)
图4 PCB上的润湿不良的焊盘(2)3、PCB表面状态分析
4、SEM以及EDX分析
图6 不良焊点截面的外观SEM分析照片。
图7 SEM照片中A部位的化学(元素)组成分析结果
图8 SEM照片中B部位的化学(元素)组成分析结果
图9 图5中不良焊盘的表面的化学(元素)组成分析结果
5、焊锡膏的润湿性分析
三、结论
经过以上分析,可以得出这样的结论:
1、送PCBA样品的BGA部位的第一排第4焊点存在不良缺陷,锡球焊点与
焊盘间有明显开路。
2、造成开路的原因为:该PCB的焊盘润湿性(可焊性)不良,焊盘表
面存在不明有机物,该有机物绝缘且阻焊,使BGA焊料球无法与焊盘在焊接时形成金属化层。
PCBA上BGA焊点失效失效分析BGA焊点失效是指BGA芯片与PCBA板上的焊点连接不牢固,导致电连接不良或完全失效的情况。
在PCBA制造和使用过程中,BGA焊点失效可能会引起电路故障、功能缺陷和产品质量问题。
本文将分析BGA焊点失效的原因以及解决方案。
一、BGA焊点失效的主要原因1.温度环境变化:BGA焊点处于多次温度循环中,高温会导致焊点疲劳,冷却后的收缩会引起应力集中,从而导致焊点断裂。
2.力学应力:BGA芯片在工作时,由于温度变化或物理碰撞等原因,会导致BGA芯片和PCBA板之间的力学应力增大,从而损坏焊点。
3.材料差异:焊料和基板的热膨胀系数不同,容易产生热应力,导致焊点断裂。
4.制造工艺不当:焊接过程中焊料粘附不牢固,焊接温度不足或过温,焊接时间过长或过短等制造工艺不当都会导致BGA焊点的失效。
5.设计不合理:PCB设计不合理,如焊点尺寸不合适、焊盘布局不合理等,会造成焊点无法正常连接。
二、BGA焊点失效类型及分析1.焊点疲劳断裂:由于温度变化引起焊点疲劳现象,焊点经过多次温度循环后,焊点材料会发生损伤、破裂,导致焊点失效。
此种情况可通过改进焊接工艺和优化焊料材料等方式进行处理。
2.焊点裂纹:焊点的高温冷却过程中,未能得到充分的冷却时间,导致焊点出现裂纹,影响焊接质量。
此种情况可通过控制焊接温度和冷却速度等方式进行处理。
3.焊点剥离:焊点粘附不牢固,焊盘与焊点之间会出现空隙,从而导致焊点剥离。
此种情况可通过改进焊接工艺和优化焊料粘附性能等方式进行处理。
4.焊点内部孔隙:焊点内部可能存在孔隙或气泡,导致焊点的结构不均匀,容易破裂。
此种情况可通过改进焊接工艺和优化焊料材料等方式进行处理。
5.焊点受污染:焊接过程中可能会受到污染物的侵入,导致焊点质量下降。
此种情况可通过增强焊接工艺的洁净度和环境控制等方式进行处理。
三、BGA焊点失效的解决方案1.优化焊接工艺:通过调整焊接温度、时间和压力等参数,保证焊接的稳定性和可靠性。
PCBA 分析报告
一样品描述
所送样品包括三片PCBA(手机主板)、四片相应的空白PCB以及工艺过程中使用的CPU器件和焊锡膏,PCBA(手机主板)的型号为C389,样品的外观照片见图1所示,委托单位要求对 PCBA 上的 CPU 与 Flash 器件焊接质量进行分析。
焊锡膏
空白
PCB
CPU
Flash
CPU 器件
图1样品的外观照片
二分析过程
2.1 外观检查
用立体显微镜对空白PCB和BGA器件进行外观检测,发现BGA器件的焊球大小均匀一致,共面性良好(见图2和图3);空白PCB焊盘表面存在一些坑洼点(见图4和图5),除此之外未观察到明显的异常。
图 2 CPU器件中BGA焊球的外观照片图 3 CPU器件中BGA焊球的局部外观照片
PCBA 分析报告
坑洼点
图 4 PCB板中CPU焊盘的外观照片图 5 PCB板中Flash的外观照片
2.2 X-RAY 检测
为了对焊点的内部状况进行检测,采用X射线系统对焊点质量进行无损检测,(X-Ray的照片见图6至图9),由照片可观察得出BGA焊点大小均匀一致,除发现焊点内部存在少量空洞外,未发现焊球错位,焊料熔融不完全以及桥连等明显焊接缺陷。
图 6 CPU焊点的X-ray典型照片图7 Flash焊点的X-ray典型照片
图8倾斜后观察到的CPU焊点的X-ray照片图9倾斜后观察到的Flash焊点的X-ray照片
PCBA 分析报告
空洞
空洞
图10部分CPU焊点的放大照片图11部分Flash焊点的放大照片2.3 金相切片分析
在样品上截取失效的BGA器件,用环氧树脂镶嵌后打磨抛光,用金相显微镜观察BGA器件焊点的金相切片,焊点的金相照片见图12~图25。
其中CPU焊点的典型金相照片见图12~图19,由图可以发现部分焊球焊料与PCB焊盘之间润湿不良,未观察到良好的金属间化合物层,个别焊点甚至发现存在开裂现象;同时还观察到焊球焊料熔融不完全,存在空洞等缺陷。
图12 CPU器件部分焊点的金相照片图13 CPU器件正常焊点的典型金相照片
PCB 焊盘
润湿不良
图14焊料与焊盘润湿不良的典型照片图15焊点局部放大照片(见图14红框)
PCBA 分析报告
图16出现空洞焊点的典型照片图17焊球焊料质量不良的典型照片
裂缝
图18焊球与PCB焊盘出现裂缝的典型照片1图19焊点局部放大照片(见图18红框)
A
B
图20 焊球与 PCB 焊盘出现裂缝的典型照片 2 图 21 焊点局部放大照片(见图 20 红框)
图22~图27 是Flash 焊点的典型金相照片,由图同样可以发现部分焊球焊料与PCB焊盘之间润湿性不够良好,焊料与焊盘之间未形成良好的金属间化合物层。
PCBA 分析报告
图22 Flash焊点的典型金相照片图23正常焊点的典型金相照片
润湿不良
图24出现空洞焊点的典型照片图25焊球焊料与焊盘润湿性不良的典型照片
焊球焊料出现开裂
图26焊料熔融不完全的典型照片图27焊点局部放大照片(见图24红框)由以上BGA焊点的金相照片分析发现,部分BGA焊球焊料与PCB焊盘润湿性不良,存在裂缝以及焊料熔融不良等现象,这说明焊球焊料与焊盘之间未形成良好的金属间化合物层。
而导致焊球焊料与PCB焊盘润湿不良的原因可能存在如下几方面:
(1)PCB焊盘氧化严重或沾污外来污染物导致焊盘的可焊性不
良。
(2)使用的焊锡膏润湿性不良。
(3)BGA焊锡球可焊性不良。
为了分析BGA焊球的质量对,未使用的CPU焊球和从所送手机主板上脱落的CPU
PCBA 分析报告
焊球进行金相切片分析,发现无论是未使用的CPU焊球还是脱落的CPU焊球焊料熔融均不够良好,焊球内部发现存在裂缝等缺陷,这说明BGA焊球质量不够良好。
图26脱落焊球的典型照片1图27脱落焊球的典型照片2
图28脱落焊球的局部放大照片图29脱落焊球内部出现裂缝的典型照片
图28未使用的CPU焊球的典型照片1图29未使用的CPU焊球的典型照片2
图30未使用的CPU焊球的典型照片1图31未使用的CPU焊球的典型照片2 2.4 焊锡膏润湿性分析
按照IPC-TM-650.2.4.45的要求对工艺过程中使用的焊锡膏的润湿性进行测试,
发现所使用的焊锡膏的润湿性良好(焊锡膏的可焊性试验照片见图26和图27)。
图26焊锡膏润湿性试验的典型照片1图27焊锡膏润湿性试验的典型照片2 2.5 空白 PCB 板焊盘的可焊性试验
按照IPC-STD-003(Solderability Tests for Printed Boards)要求,对委托单位所送的空白PCB的可焊性进行测试,试验温度为235,试验时间为3S,所使用的助焊剂为中性助焊剂(焊锡膏的可焊性试验照片见图28和图29),发现空白PCB的部分焊盘的可焊性较差(见图中红色箭头所指的黄色焊盘),焊料对焊盘的润湿不良或弱润湿,这说明BGA金相切片中发现的焊球与焊盘润湿不良与PCB 部分焊盘的可焊性不良有关。
而引起焊盘可焊性不良的原因可能是焊盘氧化
严重或表面沾污有机物。
图28 PCB焊盘可焊性试验的典型照片1图29 PCB焊盘可焊性试验的典型照片2 2.6 SEM 和 EDAX 分析
首先对图21所示的开裂焊点进行EDAX分析,发现标识A处焊盘处的主要的元素成分为镍(Ni)和磷(P)以及少量的锡(Sn)(见图30),由于锡含量较少,这说明开裂是位于PCB焊盘上的镍镀层与焊料之间,同时也说明PCB焊盘上的镍镀层与焊料之间未形成良好的金属间化合物层。
图30 裂缝 A 处 PCB 焊盘的能谱图
图31 是图 21 标识 B 处焊料的能谱图,由图可发现主要含有锡(Sn),磷(P),镍(Ni),碳(C)等元素,由谱图中检测到镍含量较多,这也能进一步说
明PCB 焊盘上的镍镀层与焊料之间未形成良好的金属间化合物层。
图31裂缝B处焊料的能谱
图
另外,对CPU器件脱落的PCB焊盘进行SEM观察,发现焊盘表面存在较多的裂缝,这说明镍镀层的表面的致密性较差(见图32和图33),因此,后续浸金工艺中的酸液容易残留其中,致使镍镀层腐蚀氧化,这必将导致焊盘的可焊性不良。
图32 CPU器件脱落的PCB焊盘典型外观照片1图33 CPU器件脱落的PCB焊盘典型外观照片2
接着对空白PCB的焊盘进行SEM观察,发现焊盘表面存在裂缝,这说明金镀层的表面的致密性不够良好(见图34和图35),对焊盘进行EDAX分析(结果见图36),发现主要存在碳(C),镍(Ni)和金(Au)等元素,由焊盘表面含有碳,这说明焊盘表面粘附的外来污染物为有机物。
裂缝
裂缝
图34空白PCB上CPU焊盘外观的典型照片图35空白PCB上FLASH焊盘外观的典型照片
图36空白PCB焊盘的能谱图
2.7 综合分析
(1) 由BGA焊点的金相切片和X-ray可见,BGA焊球焊料与PCBA焊盘润湿性较差,焊料与焊盘之间未形成良好的金属间合金层,因而焊料与焊盘之间的结合力较差,致使焊点容易出现裂缝。
而导致焊球焊料与PCB焊盘润湿不良的原因可能存在如下几方面:
(a) PCB 焊盘氧化严重或沾污外来有机物导致焊盘的可焊性不良。
(b) 使用的焊锡膏可焊性不良。
(c) BGA 焊锡球质量较差,可焊性不良。
(2) 对未使用的 BGA 器件焊球和脱落的 BGA 焊球进行外观及金相切片分析,发现BGA球大小均匀一致,焊球共面性良好,但焊球焊料熔融不够良好,焊球内部发现存在裂缝等缺陷,这说明BGA焊球质量不够良好;而从脱落的CPU 器件的焊点来看,脱落位置主要位于焊盘与焊料的连接处,并不是焊球本身开裂而脱落,这说明
PCBA 分析报告
BGA 焊球质量较差并不是导致 BGA 焊球焊料与 PCBA 焊盘润湿性较差的主要原因。
(3)进行焊锡膏的可焊性试验,发现焊锡膏的可焊性良好,这说明 BGA 金相切
片中发现的焊球与焊盘润湿不良并不是由于所使用的焊锡膏可焊性较差引起的。
(4)进行空白 PCB 焊盘可焊性试验,发现 PCB 焊盘的可焊性较差,说明焊球与焊盘润湿不良和结合力不强与PCB焊盘的可焊性较差有关;对空白PCB焊盘和器件脱落的PCB焊盘进行SEM观察和EDAX分析,发现金镀层和镍镀层表面存在裂缝,镀层的致密性不够良好,这容易导致镍镀层氧化腐蚀而使焊盘的可焊性不良,同时焊盘表面检测到沾污外来的有机污染物。
因此,可分析得出PCB焊盘可焊性较差可能一方面与镍镀层结构不致密,酸液容易残留其中,致使镍镀层腐蚀氧化有关;另一方面与焊盘表面粘附外来的有机污染物有关。
由于焊盘的可焊性较差才导致焊盘与焊料之间润湿不良,不能形成良好的金属间化合物层。
三分析结论
根据以上分析,可以得出以下结论:
BGA 焊点焊料与PCBA 焊盘润湿性较差,焊料与焊盘之间未形成良好的金属间合金层,因而焊料与焊盘之间的结合力不强;焊料与焊盘润湿不良的主要原因是PCB 焊盘可焊性。