LED封装五大原物料资料
- 格式:pptx
- 大小:7.51 MB
- 文档页数:13


LED封装物料培训尊敬的各位员工:大家好!今天我将为大家介绍一下LED封装物料的相关知识,希望能够帮助大家更好地了解LED封装,并提高工作效率。
首先,我们先来了解一下什么是LED封装。
LED封装是指将LED芯片粘在导电或非导电基板上,并通过引线与外部电子线路连接起来,然后再用封装胶或封装树脂进行封装,以保护LED芯片和引线,同时起到增强光线集中度和防潮防尘的作用。
LED封装物料通常包括以下几种主要材料:1. LED芯片:LED封装中最核心的部分,是产生光的关键元件,也是决定LED灯光性能的关键因素。
2. 基板:用于固定LED芯片的载体,可以是金属基板、陶瓷基板、玻璃基板等,根据不同的应用需求选择相应的材料。
3. 导线:用于连接LED芯片与外部电子线路的导电线,通常采用金属导线,如金丝、银丝等。
4. 封装胶或封装树脂:用于将LED芯片和引线进行封装,保护LED芯片和引线不受外界环境的影响,并起到增强光线集中度的作用。
常见的封装胶有环氧树脂、有机硅封装胶等。
在使用LED封装物料时,需要注意以下几点:1. 物料的选择:根据LED产品的具体要求,选择合适的LED 芯片、基板和封装胶等物料,确保LED产品的性能和质量。
2. 封装工艺控制:LED封装过程中要注意控制温度、压力和时间等参数,确保封装胶能够完全固化,避免出现胶水流动或发黏的情况。
3. 质量检测:对封装好的LED产品进行质量检测,包括外观检查、发光效果检测、电气性能测试等,确保LED产品的质量达到要求。
LED封装物料的正确选择和使用对LED产品的性能和质量有着重要影响,希望大家在工作中能够加强对LED封装物料相关知识的学习和理解,提高工作效率,更好地为公司发展贡献力量。
感谢大家的聆听!谢谢!【续写】5. 环境因素:LED封装物料的使用应该避免在潮湿的环境中进行,以免影响封装胶的固化效果。
此外,温度也是需要注意的因素。
在封装过程中,应确保温度适宜,不要过高或过低,以免对LED芯片产生热应力或影响封装胶的质量。


LED的五大原物料LED五大原物料分别是指:晶片,支架,银胶,金线,环氧树脂。
1、晶片1.1晶片的构成:由金垫,P极,N极,PN结,背金层构成(双pad晶片无背金层)。
1.2定义:晶片是由P层半导体元素,N层半导体元素靠电子移动而重新排列组合成的PN结合体。
也正是这种变化使晶片能够处于一个相对稳定的状态。
1.3晶片的发光原理:在晶片被一定的电压施加正向电极时,正向P区的空穴则会源源不断的游向N区,N区的电子则会相对于孔穴向P区运动。
在电子,空穴相对移动的同时,电子空穴互相结对,激发出光子,产生光能。
1.4晶片的分类:1.4.1按组成分:二元:如GaAs(砷化镓),GaP(磷化镓)等三元:InGaN(氮化铟镓),GaAlAs(砷化镓铝),GaAsP(磷化镓砷)等四元。
1.4.2按极性分:N/P,P/N。
1.4.3按发光类型分:表面发光型:光线大部分从晶片表面发出五面发光型:表面,侧面都有较多的光线射出。
1.4.4按发光颜色分:红,橙,黄,黄绿,纯绿,标准绿,蓝绿,蓝。
2、支架2.1支架的结构:1层铁;2层镀铜(导电性好,散热快);3层镀镍(防氧化),4层镀银(反光性好,易焊线)。
2.2型号分类:2号,3号,4号,6号,9号,食人鱼。
3、银胶(因种类较多,我们依H20E为例)3.1种类:H20E,826-1DS,84-1A。
3.2组成:银粉(导电,散热,固定晶片)+环氧树脂(固化银粉)+稀释剂(易于搅拌)。
3.3使用条件:储藏条件:银胶的制造商一般将银胶以-40 °C 储藏,应用单位一般将银胶以-5 °C 储藏。
单剂为25 °C/1年(干燥,通风的地方),混合剂25 °C/72小时(但在上线作业时因其他的因素“温湿度、通风的条件”,为保证产品的质量一般的混合剂使用时间为4小时)烘烤条件:150 °C/1.5H搅拌条件:顺一个方向均匀搅拌15分钟。
4、绝缘胶:也叫白胶,乳白色,绝缘粘合作用(烘烤温度为:100°C/1.5H)。


led 芯片材料体系LED(Light Emitting Diode)芯片是LED产品的核心部分,它通过半导体材料的能级跃迁来产生光。
LED芯片的材料体系主要包括以下几种:1. 硅基材料(Si-based):硅(Si)是最早被用于LED制造的材料之一,但由于其发光效率相对较低,目前主要用于低功率的LED应用,如指示灯。
2. 镓氮化物基材料(GaN-based):氮化镓(GaN)是制造蓝光LED的主要材料,因为它具有较高的击穿电压、良好的热稳定性和较宽的带隙。
蓝光LED可以通过与其他半导体材料结合形成量子阱结构来产生其他颜色的光,例如通过与砷化镓(GaAs)结合产生绿光,与铟镓磷(InGaP)结合产生黄光。
3. 磷化镓基材料(GaP-based):磷化镓(GaP)及其合金用于制造黄绿色、绿色到红色范围的LED。
4. 砷化镓基材料(GaAs-based):砷化镓(GaAs)常用于制造红光和红外线LED。
5. 铟镓氮化物基材料(InGaN-based):铟镓氮化物(InGaN)合金被用于制造高效率的蓝光和绿光LED。
6. 铝镓氮化物基材料(AlGaN-based):铝镓氮化物(AlGaN)合金可以产生紫外和深紫外光,常用于特殊应用,如UV固化、消毒等。
7. 复合材料:为了得到更广泛的光谱范围,研究者们开发了多种复合材料,如多元合金化镓氮化物(GaN-based alloys)。
LED芯片的设计和制造涉及到多种材料和工艺的结合,包括晶体生长、加工、封装等。
不同的材料体系具有不同的电学、热学和光学特性,因此选择合适的材料体系对于实现LED芯片的高效率、高稳定性和低成本生产至关重要。
随着技术的不断进步,新材料和新技术的开发也在持续进行中,以满足不断增长的市场需求。

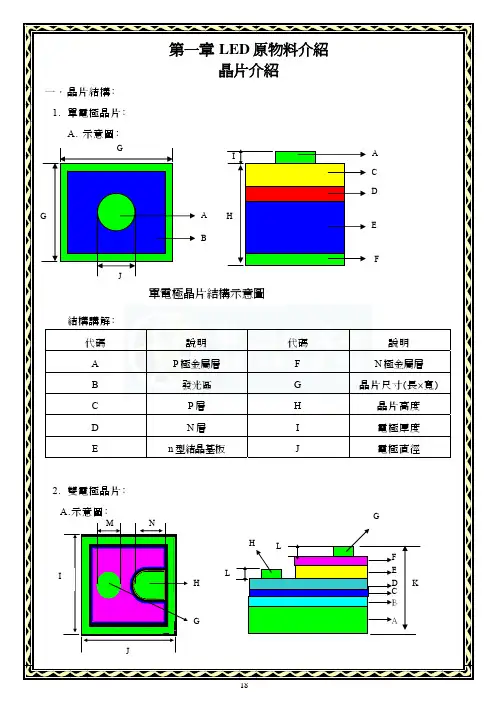
說明代碼A P極金屬層 F N晶片尺寸發光區 G顏色波長AlGaAs/GaAs紅 645nm~~655nmAlGaInP/GaAs高亮度紅 630nm~~645nm橙 GaAsP/GaP 605nm~~622nmAlloychip on waferPolishingProbingScribingSortingchip on tapeN-side Contact Measurement 制作電極以供打線用﹐目前使用Ti/Al=0.6/6kA 觸電極﹐可與n-GaN有良好的歐姆接觸。
做一般特性量測﹐主要有VF﹐亮度﹐波長﹐(Condensation) 司常用晶片簡圖﹕M80HOU M80SOU 812YGUFD135-GR525 FD135-PB4506 7 8 9高度腳寬腳中心距邊距上BAR以上稱功能區、上BAR及上BAR以下稱非功能區尺寸說明﹕支架管控相關條件﹕支架供應商﹕焊接標准長烤短烤焊接標准(03、04支架)2003L6 2003L232004WA1 2004-12009-2 3009待拍攝(持續) 焊點及碗偏離中心軸線向前后左右偏移(支架彎曲管控﹕0.5mm)1.成品偏心﹔2.造成焊線跨度距離過遠過近﹔3.造成焊線滑球。
待拍攝(持續) 時往一邊偏離) 過近(嚴重造成粘固不牢形成死燈待拍攝(持續) 支架任何部位因沖壓過程造成不規則變形者1.尺寸不符﹐無法使用。
待拍攝(持續)待拍攝(持續) 支架杯及陰極有左右偏離或上下偏離(可由測繪儀量測)1.成品偏心﹔2.嚴重者無法焊線。
結構說明﹕(TPX材質)物料簡介﹕PC、PMMA,有極佳的透明度﹐但PC C﹕35.5±0.2mm D﹕0.58±0.03mm圖一﹕卡點示意圖圖二﹕導柱示意圖1.膠杯共分功能區(發光區)及一般區﹔2.功能區不可有任何有塑膠結料痕﹐需光滑平順﹔一般區結料痕不可大于膠杯總長二分之一。
三.成形后圖示﹕子彈頭LED示意圖模條進料檢驗內容﹕待拍攝(持續) 模粒帽沿與硅鋼片間有裂痕 1.會造成模粒松脫轉動﹔2.模條周轉次數減少﹔3.插淺不良。

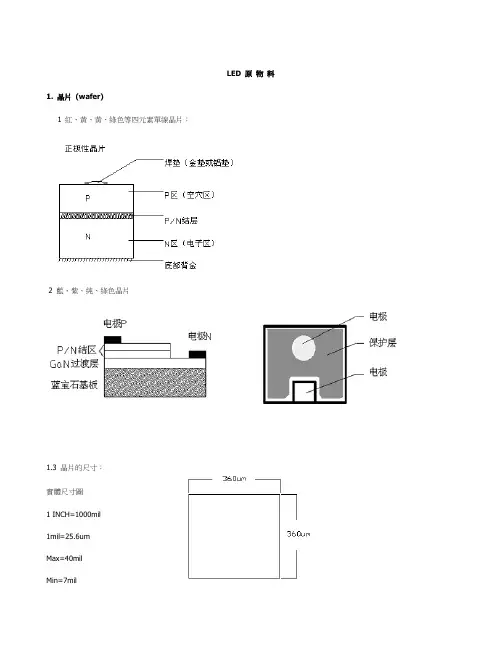
LED 原物料1. 晶片(wafer)1 紅、黃、黃、綠色等四元素單線晶片:2 藍、紫、純、綠色晶片1.3 晶片的尺寸:實體尺寸圖1 INCH=1000mil1mil=25.6umMax=40milMin=7mil2. 支架(用以盛裝晶片及二極體引腳之用)圖示:支架的碗杯赿深做出的二極體發光角赿小,反之赿大。
2.2 支架結構:素材:鐵和銅兩種,常用的為鐵材,銅材的成本很高;鍍材:素材――銅――鎳――銅――銀3. 銀膠和絕緣膠3.1 銀膠:銀粉+環氧樹脂絕緣膠:化學膠3. 2 有效期:-5 ℃/3 個月,25 ℃/ 一天;3.3 儲存期:-20 ℃/6 個月;3.4 固化條件:150 ℃/90 分鐘;3.5 銀膠內阻:0.00035 Ω,絕緣膠內阻:4.3MG Ω;3.6 銀膠用途:用於單線晶片的底部背金與支架碗杯底部的連接作用,液態時可配合固晶動作粘住晶片,工作時起到散熱作用;絕緣膠可起到粘接晶片作用,讓晶片底部與支架杯底絕緣;3.7 解凍條件:在冰箱拿出來時放在室溫放置1個半小時,擦幹瓶外水份後攪拌15-30分鐘,分裝於小瓶。
4. 金線4.1 尺寸:1.0mil, 有0.9mil 和1.1mil 兩種;4.2 含金量:99.9% ;4.3 作用:晶片的焊墊與支架連接作用。
5. 膠水A 膠:環氧樹脂――――――主劑B 膠:酸酐――――――――硬化劑C 膠:色素+環氧樹脂―――色劑DP 膠:擴散粉+環氧樹脂――擴散劑6. 模粒(模具系列)6.1 模粒圖示如下:LED 特性參數1.VF (順向電壓)一般:2.IF (順向電流)IF 值通常為20mA 被設為一個測試條件和常亮時的一個標準電流,設定不同的值用以測試二極體的各項性能參數,具體見特性曲線圖。
IF 特性:1 >以正常的壽命討論,通常標準IF 值設為20 -30mA ,瞬間(20ms )可增至100mA ;>IF 增大時LAMP 的顏色、亮度、VF 特性及工作溫度均會受到影響,它是正常工作時的一個先決條件,IF 值增大:壽命縮短、VF 值增大、波長偏低、溫度上升、亮度增大、角度不變,與相關參數間的關係見曲線圖;3.VR (LAMP 的反向崩潰電壓)由於LAMP 是二極體具有單向導電特性,反向通電時反向電流為0 ,而反向電壓高到一定程度時會把二極體擊穿,剛好能把二極體擊穿的電壓稱為反向崩潰電壓,可以用“VR ”來表示。

一.LED封装介绍:一导电胶、导电银胶导电胶是IED生产封装中不可或缺的一种胶水,其对导电银浆的要求是导电、导热性能要好,剪切强度要大,并且粘结力要强。
UNINWELL国际的导电胶和导电银胶导电性好、剪切力强、流变性也很好、并且吸潮性低。
特别适合大功率高高亮度LED的封装。
特别是UNINWELL的6886系列导电银胶,其导热系数为:25.8 剪切强度为:14.7,堪称行业之最。
二封装工艺1. LED的封装的任务是将外引线连接到LED芯片的电极上,同时保护好LED芯片,并且起到提高光取出效率的作用。
关键工序有装架、压焊、封装。
2. LED封装形式LED封装形式可以说是五花八门,主要根据不同的应用场合采用相应的外形尺寸,散热对策和出光效果。
LED按封装形式分类有Lamp-LED、TOP-LED、Side-LED、SMD-LED、High-Power-LED等。
3. LED封装工艺流程4.封装工艺说明1.芯片检验镜检:材料表面是否有机械损伤及麻点麻坑(lockhill)芯片尺寸及电极大小是否符合工艺要求电极图案是否完整2.扩片由于LED芯片在划片后依然排列紧密间距很小(约0.1mm),不利于后工序的操作。
我们采用扩片机对黏结芯片的膜进行扩张,是LED芯片的间距拉伸到约0.6mm。
也可以采用手工扩张,但很容易造成芯片掉落浪费等不良问题。
3.点胶在LED支架的相应位置点上银胶或绝缘胶。
(对于GaAs、SiC导电衬底,具有背面电极的红光、黄光、黄绿芯片,采用银胶。
对于蓝宝石绝缘衬底的蓝光、绿光LED芯片,采用绝缘胶来固定芯片。
)工艺难点在于点胶量的控制,在胶体高度、点胶位置均有详细的工艺要求。
由于银胶和绝缘胶在贮存和使用均有严格的要求,银胶的醒料、搅拌、使用时间都是工艺上必须注意的事项。
4.备胶和点胶相反,备胶是用备胶机先把银胶涂在LED背面电极上,然后把背部带银胶的LED安装在LED支架上。
备胶的效率远高于点胶,但不是所有产品均适用备胶工艺。
LED五大原物料是什么?led五大原物料分别是指:晶片,支架,银胶,金线,环氧树脂1、晶片1.1晶片的构成:由金垫,P极,N极,PN结,背金层构成(双pad晶片无背金层)。
1.2定义:晶片是由P层半导体元素,N层半导体元素靠电子移动而重新排列组合成的PN结合体。
也正是这种变化使晶片能够处于一个相对稳定的状态。
1.3晶片的发光原理:在晶片被一定的电压施加正向电极时,正向P区的空穴则会源源不断的游向N区,N区的电子则会相对于孔穴向P区运动。
在电子,空穴相对移动的同时,电子空穴互相结对,激发出光子,产生光能。
1.4晶片的分类:1.4.1按组成分:二元:如GaAs(砷化镓),GaP(磷化镓)等三元:InGaN(氮化铟镓),GaAlAs(砷化镓铝),GaAsP(磷化镓砷)等四元:AlInGaP,AlInGaAs1.4.2按极性分:N/P,P/N1.4.3按发光类型分:表面发光型: 光线大部分从晶片表面发出五面发光型:表面,侧面都有较多的光线射出1.4.4按发光颜色分:红,橙,黄,黄绿,纯绿,标准绿,蓝绿,蓝2、支架:2.1支架的结构:1层铁2层镀铜(导电性好,散热快)3层镀镍(防氧化),4层镀银(反光性好,易焊线)2.2型号分类:2号,3号,4号,6号,9号,食人鱼…3、银胶(因种类较多,我们依H20E为例)3.1种类:H20E,826-1DS,84-1A…3.2组成:银粉(导电,散热,固定晶片)+环氧树脂(固化银粉)+稀释剂(易于搅拌)3.3使用条件:储藏条件:银胶的制造商一般将银胶以-40 °C 储藏,应用单位一般将银胶以-5 °C 储藏。
单剂为25 °C/1年(干燥,通风的地方),混合剂25 °C/72小时(但在上线作业时因其他的因素“温湿度、通风的条件”,为保证产品的质量一般的混合剂使用时间为4小时)烘烤条件:150 °C/1.5H搅拌条件:顺一个方向均匀搅拌15分钟3.4 绝缘胶:也叫白胶,乳白色,绝缘粘合作用(烘烤温度为:100°C/1.5H)4、金线(依φ1.0mil为例)LED所用到的金线有φ1.0mil、φ1.2mil金线的材质:LED用金线的材质一般含金量为99.9%金线的用途:利用其含金量高材质较软、易变形且导电性好、散热性好的特性,让晶片与支架间形成一闭合电路。
LED封装材料主要有环氧树脂,聚碳酸脂,聚甲基丙烯酸甲脂,玻璃,有机硅材料等高透明材料。
其中聚碳酸脂,聚甲基丙烯酸甲脂,玻璃等用作外层透镜材料;环氧树脂,改性环氧树脂,有机硅材料等,主要作为封装材料,亦可作为透镜材料。
而高性能有机硅材料将成为高端LED封装材料的封装方向之一。
下面将主要介绍有机硅封装材料。
提高LED封装材料折射率可有效减少折射率物理屏障带来的光子损失,提高光量子效率,封装材料的折射率是一个重要指标,越高越好。
提高折射率可采用向封装材料中引入硫元素,引入形式多为硫醚键、硫脂键等,以环硫形式将硫元素引入聚合物单体,并以环硫基团为反应基团进行聚合则是一种较新的方法。
最新的研发动态,也有将纳米无机材料与聚合物体系复合制备封装材料,还有将金属络合物引入到封装材料,折射率可以达到1.6-1.8,甚至2.0,这样不仅可以提高折射率和耐紫外辐射性,还可提高封装材料的综合性能。
一、胶水基础特性1.1有机硅化合物--聚硅氧烷简介有机硅封装材料主要成分是有机硅化合物。
有机硅化合物是指含有Si-O键、且至少有一个有机基是直接与硅原子相连的化合物,习惯上也常把那些通过氧、硫、氮等使有机基与硅原子相连接的化合物也当作有机硅化合物。
其中,以硅氧键(-Si-0-Si-)为骨架组成的聚硅氧烷,是有机硅化合物中为数最多,研究最深、应用最广的一类,约占总用量的90%以上。
1.1.1结构其结构是一类以重复的Si-O键为主链,硅原子上直接连接有机基团的聚合物,其通式为R’---(Si R R’ ---O)n--- R”,其中,R、R’、R”代表基团,如甲基,苯基,羟基,H,乙烯基等;n为重复的Si-O键个数(n不小于2)。
有机硅材料结构的独特性:(1) Si原子上充足的基团将高能量的聚硅氧烷主链屏蔽起来;(2) C-H无极性,使分子间相互作用力十分微弱;(3) Si-O键长较长,Si-O-Si键键角大。
(4) Si-O键是具有50%离子键特征的共价键(共价键具有方向性,离子键无方向性)。
led封装材料LED封装材料。
LED(Light Emitting Diode)是一种半导体器件,具有发光功能。
LED封装材料是指用于封装LED芯片的材料,其性能直接影响LED的发光效果、稳定性和寿命。
LED封装材料的选择和应用对LED产品的质量和性能具有重要影响。
本文将对LED封装材料进行详细介绍。
一、封装材料的种类。
LED封装材料主要包括导热胶、封装胶、封装底座、支架等。
导热胶主要用于LED芯片与散热底座之间的导热连接,有效提高LED的散热效果;封装胶主要用于封装LED芯片,保护LED芯片不受潮气、尘埃等外界环境的影响;封装底座和支架则是用于固定LED芯片和连接线,保证LED芯片的稳定性和可靠性。
二、封装材料的特性。
1.导热性能,导热胶的导热性能直接影响LED的散热效果,优秀的导热性能可以有效降低LED的工作温度,提高LED的亮度和寿命。
2.光学性能,封装胶的透光性能和抗紫外性能对LED的发光效果和稳定性具有重要影响,优秀的光学性能可以提高LED的发光效率和颜色稳定性。
3.机械性能,封装底座和支架的机械性能对LED的安装和使用具有重要影响,优秀的机械性能可以保证LED的稳定性和可靠性。
三、封装材料的应用。
LED封装材料广泛应用于LED灯具、LED显示屏、汽车车灯、户外广告牌等领域。
在LED灯具中,优秀的导热胶可以有效降低LED的工作温度,提高LED 的亮度和寿命;优秀的封装胶可以保护LED芯片不受潮气、尘埃等外界环境的影响,提高LED的稳定性和可靠性。
在LED显示屏和汽车车灯中,优秀的光学性能可以提高LED的发光效率和颜色稳定性,保证LED的视觉效果和安全性。
四、封装材料的发展趋势。
随着LED技术的不断发展和应用领域的不断拓展,LED封装材料也在不断创新和改进。
未来,LED封装材料将朝着导热性能更优、光学性能更佳、机械性能更可靠的方向发展,以满足LED产品对于高亮度、高稳定性、长寿命的需求。