COB封装工艺流程PPT课件
- 格式:ppt
- 大小:11.74 MB
- 文档页数:10

cob封装工艺流程COB封装工艺流程(Chip on Board Packaging Process)COB封装技术是一种将芯片直接封装在基板上的高密度封装技术。
其具有封装性能好、体积小、可靠性高等优点,广泛应用于LED照明、传感器、电子产品等领域。
下面将详细介绍COB封装工艺流程。
1. 基板准备:选用高导热性能、低光散射率的基板作为底部,如铝基板、铜基板等。
对基板进行清洁处理,确保无尘、无油污、无氧化物等。
然后将基板进行机械打磨,提高表面粗糙度,增加与芯片的黏附力。
2. 芯片去膜及粘贴:将芯片进行去膜处理,去除掉芯片背面的封装材料,以免影响封装后的散热。
然后,使用导热胶或导热膜将芯片粘贴在基板上,并进行压合,确保芯片与基板之间有良好的热导通道。
3. 绑线:将导线焊接在芯片上的金属引脚上,形成电路连接。
绑线可以使用金线、铜线等材料,并使用微焊或超声波焊接技术进行焊接。
绑线需要小心操作,确保焊接质量良好,避免短路或断路等问题。
4. 封胶:使用环氧树脂或硅胶等封装材料将芯片和绑线密封起来,提高封装的可靠性和耐久性。
封胶需要注意控制好胶体的黏度和硬度,以确保胶体的均匀性和粘合性。
封胶后,进行硬化处理,使胶体牢固固定。
5. 电气测试:对已封装的芯片进行电气特性测试,检测芯片的正常工作情况和性能参数。
测试项目包括电流、电压、功率、工作温度等。
通过电气测试,可以及时发现和排除封装过程中的缺陷和问题。
6. 光学测试:对COB封装后的芯片进行光学特性测试,评估LED亮度、发光效率、色温、色坐标等参数。
光学测试可以通过光功率计、光谱仪、色温计等设备进行。
优质的光学性能是COB封装的重要指标之一。
7. 散热处理:COB封装后的芯片需要进行散热处理,以保证其正常工作温度。
常见的散热处理方法包括散热片安装、散热背板安装等。
散热处理需要注意散热材料的选择和安装方式,以提高散热效果。
8. 包装和出厂检验:对COB封装后的芯片进行包装,常用的包装方式有盒式包装、卷式包装等。


COB工艺流程及基本要求COB工艺指将裸芯片直接粘贴在印刷电路板上,然后进行引线键合,再用有机胶将芯片和引线包封保护的工艺。
和常规工艺相比,本工艺封装密度高、工序简便。
工艺流程及基本要求清洁PCB---滴粘接胶---芯片粘贴---测试---封黑胶加热固化---测试---入库1.清洁PCB清洗后的PCB板仍有油污或氧化层等不洁部分用皮擦试帮定位或测试针位对擦拭的PCB 板要用毛刷刷干净或用气枪吹净方可流入下一工序。
对于防静电严的产品要用离子吹尘机。
清洁的目的的为了把PCB板邦线焊盘上的灰尘和油污等清除干净以提高邦定的品质。
2.滴粘接胶滴粘接胶的目的是为了防止产品在传递和邦线过程中DIE脱落在COB工序中通常采用针式转移和压力注射法针式转移法:用针从容器里取一小滴粘剂点涂在PCB上,这是一种非常迅速的点胶方法压力注射法:将胶装入注射器内,施加一定的气压将胶挤出来,胶点的大小由注射器喷口口径的大小及加压时间和压力大小决定与与粘度有关。
此工艺一般用在滴粘机或DIE BOND 自动设备上胶滴的尺寸与高度取决于芯片(DIE)的类型,尺寸,与PAD位的距离,重量而定。
尺寸和重量大的芯片胶滴量大一些,也不宜过大以保证足够的粘度为准,同时粘接胶不能污染邦线焊盘。
如要一定说是有什么标准的话,那也只能按不同的产品来定。
硬把什么不能超过芯片的1/3高度不能露胶多少作为标准的话,实没有这个必要。
3.芯片粘贴芯片粘贴也叫DIE BOND(固晶)粘DIE邦DIE 邦IC等各公司叫法不一。
在芯片粘贴中,要求真空吸笔(吸咀)材质硬度要小(也些公司采用棉签粘贴)。
吸咀直径视芯片大小而定,咀尖必须平整以免刮伤DIE表面。
在粘贴时须检查DIE与PCB型号,粘贴方向是否正确,DIE巾到PCB必须做到“平稳正”“平”就是指DIE与PCB平行贴紧无虚位“稳”是批DIE与PCB 在整个流程中不易脱落“正”是指DIE与PCB预留位正贴,不可偏扭。
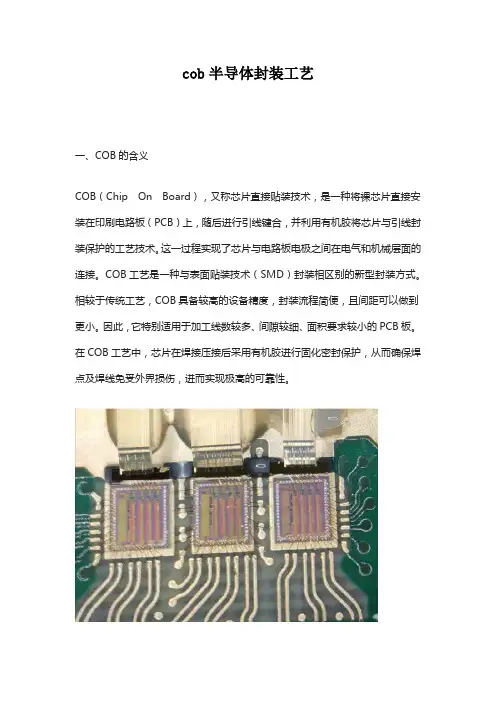
cob半导体封装工艺一、COB的含义COB(Chip On Board),又称芯片直接贴装技术,是一种将裸芯片直接安装在印刷电路板(PCB)上,随后进行引线键合,并利用有机胶将芯片与引线封装保护的工艺技术。
这一过程实现了芯片与电路板电极之间在电气和机械层面的连接。
COB工艺是一种与表面贴装技术(SMD)封装相区别的新型封装方式。
相较于传统工艺,COB具备较高的设备精度,封装流程简便,且间距可以做到更小。
因此,它特别适用于加工线数较多、间隙较细、面积要求较小的PCB板。
在COB工艺中,芯片在焊接压接后采用有机胶进行固化密封保护,从而确保焊点及焊线免受外界损伤,进而实现极高的可靠性。
二、COB封装的工艺流程及步骤:1.擦板:在COB工艺流程中,由于PCB等电子板上存在焊锡残渣和灰尘污渍,下一阶段的固晶和焊线等工序可能会导致不良产品增多和报废。
为解决此问题,厂家需对电子线路板进行清洁。
2.固晶:传统工艺采用点胶机或手动点胶,在PCB印刷线路板的IC位置上涂上适量红胶,再用真空吸笔或镊子将IC裸片正确放置在红胶上。
3.烘干:将涂好红胶的裸片放入热循环烘箱中烘烤一段时间,也可自然固化(时间较长)。
4.绑定:采用铝丝焊线机,将晶片(如LED晶粒或IC芯片)与PCB板上对应的焊盘铝丝进行桥接,即COB的内引线焊接。
5. 前测:使用专用检测工具(根据COB不同用途选择不同设备,简单的高精密度稳压电源)检测COB板,对不合格的板子进行重新返修。
6.封胶:将适量黑胶涂在绑定好的晶粒上,并根据客户要求进行外观封装。
7.固化:将封好胶的PCB印刷线路板放入热循环烘箱中恒温静置,可根据要求设定不同的烘干时间。
8.测试:采用专用检测工具对封装好的PCB印刷线路板进行电气性能测试,以区分好坏优劣。
相较于其他封装技术,COB技术具有价格低(仅为同芯片的1/3左右)、节约空间、工艺成熟等优势,因此在半导体封装领域得到广泛应用。
三、主要焊接方法1、热压焊:此方法通过加热和加压力使金属丝与焊区紧密结合。







cob半导体封装工艺
cob半导体封装工艺步骤如下:
1.基板表面处理。
去除基板表面的污垢和氧化物,确保芯片能够牢固地粘贴在上面。
2.芯片粘贴。
将芯片通过胶水或焊锡等方式粘贴在基板上。
粘贴前需对芯片进行测试和校正,确保质量和性能符合要求。
3.金线连接。
用金线将芯片的焊盘与基板上的引脚连接起来,通常使用焊线机器人操作。
4.封装胶粘贴。
在芯片和基板的周围粘贴封装胶,提高芯片的保护、散热和可靠性。
5.封装胶固化。
将封装胶进行固化,常用的固化方法有热固化和紫外线固化。
6.成型和切割。
将被封装的芯片和基板进行成型和切割,得到最终的封装产品。
COB工艺流程及基本要求COB工艺指将裸芯片直接粘贴在印刷电路板上,然后进行引线键合,再用有机胶将芯片和引线包封保护的工艺。
和常规工艺相比,本工艺封装密度高、工序简便。
工艺流程及基本要求清洁PCB---滴粘接胶---芯片粘贴---测试---封黑胶加热固化---测试---入库1.清洁PCB清洗后的PCB板仍有油污或氧化层等不洁部分用皮擦试帮定位或测试针位对擦拭的PCB 板要用毛刷刷干净或用气枪吹净方可流入下一工序。
对于防静电严的产品要用离子吹尘机。
清洁的目的的为了把PCB板邦线焊盘上的灰尘和油污等清除干净以提高邦定的品质。
2.滴粘接胶滴粘接胶的目的是为了防止产品在传递和邦线过程中DIE脱落在COB工序中通常采用针式转移和压力注射法针式转移法:用针从容器里取一小滴粘剂点涂在PCB上,这是一种非常迅速的点胶方法压力注射法:将胶装入注射器内,施加一定的气压将胶挤出来,胶点的大小由注射器喷口口径的大小及加压时间和压力大小决定与与粘度有关。
此工艺一般用在滴粘机或DIE BOND 自动设备上胶滴的尺寸与高度取决于芯片(DIE)的类型,尺寸,与PAD位的距离,重量而定。
尺寸和重量大的芯片胶滴量大一些,也不宜过大以保证足够的粘度为准,同时粘接胶不能污染邦线焊盘。
如要一定说是有什么标准的话,那也只能按不同的产品来定。
硬把什么不能超过芯片的1/3高度不能露胶多少作为标准的话,实没有这个必要。
3.芯片粘贴芯片粘贴也叫DIE BOND(固晶)粘DIE邦DIE 邦IC等各公司叫法不一。
在芯片粘贴中,要求真空吸笔(吸咀)材质硬度要小(也些公司采用棉签粘贴)。
吸咀直径视芯片大小而定,咀尖必须平整以免刮伤DIE表面。
在粘贴时须检查DIE与PCB型号,粘贴方向是否正确,DIE巾到PCB必须做到“平稳正”“平”就是指DIE与PCB平行贴紧无虚位“稳”是批DIE与PCB 在整个流程中不易脱落“正”是指DIE与PCB预留位正贴,不可偏扭。