若干电子装联焊接缺陷术语定义诠释
- 格式:pdf
- 大小:901.11 KB
- 文档页数:16

电子装联过程中常见焊接缺陷及解决方法摘要:电子装联技术是电子制造技术的重要组成部分。
随着现代电子产品的不断发展和广泛应用,电子装联技术已经成为现代电子产品制造业的重要支柱,成为现代电子产品制造过程中不可缺少的基本技术。
关键词:电子装联;焊接;缺陷;解决方法一、常见焊接缺陷及原因分析1、焊桥在电子装联的过程中,焊桥的出现应该属于严重不良,将会对产品的电气性能产生重大影响,所以应该避免焊桥的出现,一般来说,导致焊桥出现的主要原因是焊膏印刷后的错位、塌边以及焊膏过量。
其中,焊膏印刷后的错位主要发生在片状元件间距小于0.65mm的印制板时,对于这种情况,应该采用光学定位,并将基准点设在印制板对角线处。
但是如果不采用光学定位,就会出现定位误差,进而出现印刷错位,从而产生焊桥。
而出现焊膏塌边则主要有三种情况,第一种是印刷塌边,一般在焊膏印刷时会出现该种情况,一般来说与模板、焊膏特性以及印刷参数相关,如果焊膏的粘度不够,其保持形状的能力就较差,尤其是在印刷后,更是容易发生塌边,而且如果模板粗糙也会导致发生塌边;第二种情况则是在贴装时出现的塌边,如果在贴装的过程中的贴装压力过大就会导致焊膏外形变化,最终发生塌边;第三种是在焊接加热时的塌边,加热过程中,温度升高的速度加快,在这个过程中焊膏中的溶剂成分就会挥发,如果溶剂成分的挥发速度过快,就会出现将焊料颗粒挤出焊区的情况,这种情况下就导致了塌边的产生。
2、焊锡球焊锡球是另外一种常见的焊接缺陷。
一般来说,焊锡球是由于在焊接过程中的激素加入造成的焊料飞散导致的,一般来说,与焊膏氧化程度、助焊剂活性、焊膏吸湿、焊料颗粒的粗细、印制板清洗等因素有关。
其中焊料颗粒表面在接触空气后就可能产生氧化现象,在这个原因上,有相关统计证明,焊锡球的发生率与焊膏氧化物的百分率成正比。
另外焊料颗粒的均匀性不一致,也会导致焊锡球的发生,如果在焊料中20μm以下的颗粒含量较大的话,这些粒子容易氧化,所以能形成焊锡球。

SMT专业术语名词解释Accuracy(精度):测量结果与目标值之间的差额。
Additive Process(加成工艺):一种制造PCB导电布线的方法,通过选择性的在板层上沉淀导电材料(铜、锡等)。
Adhesion(附着力):类似于分子之间的吸引力。
Aerosol(气溶剂):小到足以空气传播的液态或气体粒子。
Angle of attack(迎角):丝印刮板面与丝印平面之间的夹角。
Anisotropic adhesive(各异向性胶):一种导电性物质,其粒子只在Z轴方向通过电流。
Annular ring(环状圈):钻孔周围的导电材料。
Application specific integrated circuit (AS IC特殊应用集成电路):客户定做得用于专门用途的电路。
Array(列阵):一组元素,比如:锡球点,按行列排列。
Artwork(布线图):PCB的导电布线图,用来产生照片原版,可以任何比例制作,但一般为3:1或4:1。
Automated test equipment (ATE自动测试设备):为了评估性能等级,设计用于自动分析功能或静态参数的设备,也用于故障离析。
Automatic optical inspection (AOI自动光学检查):在自动系统上,用相机来检查模型或物体Ball grid array (BGA球栅列阵):集成电路的包装形式,其输入输出点是在元件底面上按栅格样式排列的锡球。
Blind via(盲通路孔):PCB的外层与内层之间的导电连接,不继续通到板的另一面。
Bond lift-off(焊接升离):把焊接引脚从焊盘表面(电路板基底)分开的故障。
Bonding agent(粘合剂):将单层粘合形成多层板的胶剂。
Bridge(锡桥):把两个应该导电连接的导体连接起来的焊锡,引起短路。
Buried via(埋入的通路孔):PCB的两个或多个内层之间的导电连接(即,从外层看不见的)。

焊接常用中、英文术语定义及解释焊接常用中、英文术语定义及解释1 母材金属base mental, parent mental被焊金属材料的统称。
2 热影响区heat-affected zone焊接或切割过程中,材料因受热的影响(但未熔化)而发生金相组织和机械性能变化的区域。
3 过热区overheated zone焊接热影响区中,具有过热组织或晶粒显著粗大的区域。
4 焊缝weld焊件经焊接后所形成的结合部分。
5 焊缝区weld zone焊缝及其邻近区域的总称。
6 定位焊缝tack weld焊前为装配和固定构件接缝的位置而焊接的短焊缝。
7承载焊缝strength weld焊件上用作承受载荷的焊缝。
8 连续焊缝continuous weld连续焊接的焊缝。
9 断续焊缝intermittent weld焊接成具有一定间隔的焊缝。
10 纵向焊缝longitudinal weld沿焊件长度方向分布的焊缝。
11 横向焊缝transverse weld垂直于焊件长度方向的焊缝。
12 环缝girth weld, circumferential weld沿筒形焊件分布的头尾相接的封闭焊缝。
13 密封焊缝seal weld主要用于防止流体渗漏的焊缝。
14 并列断续角焊缝chain intermittent fillet weldT形接头两侧互相对称布置、长度基本相等的断续角焊缝。
15 交错断续角焊缝staggered intermittent fillet weldT形接头两侧互相交错布置、长度基本相等的断续角焊缝。
16 凸形角焊缝convex fillet weld焊缝表面突起的角焊缝。
17 凹形角焊缝concave fillet weld焊缝表面下凹的角焊缝。
18 焊缝正面face of weld焊后,从焊件的施焊面所见到的焊缝表面。
19 焊缝背面root surface焊后,从焊件施焊面的背面所见到的焊缝表面。

焊接缺陷和检验术语一、焊接缺陷1、焊接缺陷焊接过程中在焊接接头中产生的金属不连续、不致密或连接不良的现象。
2.未焊透焊接时接头根部未完全熔透的现象,对对接焊缝也指焊缝深度未达到设计要求的现象。
3.未熔合熔焊时,焊道与母材之间或焊道与焊道之间,未完全熔化结合的部分,电阻点焊指母材与母材之间未完全熔化结合的部分。
4.夹渣焊后残留在焊缝中的焊渣。
5.夹杂物由于焊接冶金反应产生的,焊后残留在焊缝金属中的微观非金属杂质(如氧化物、硫化物等)。
6.夹钨钨极惰性气体保护焊时由钨极进入到焊缝中的钨粒。
7.气孔焊接时,熔池中的气泡在凝固时未能逸出而残留下来所形成的空穴。
气孔可分为密集气孔、条虫状气孔和针状气孔等。
8.咬边由于焊接参数选择不当,或操作方法不正确,沿焊趾的母材部位产生的沟槽或凹陷。
9.焊瘤焊接过程中,熔化金属流淌到焊缝之外未熔化的母材上所形成的金属瘤。
10.白点在焊缝金属拉断面上,出现的如鱼目状的一种白色圆形斑点。
11.烧穿焊接过程中,熔化金属自坡口背面流出,形成穿孔的缺陷。
12.凹坑焊后在焊缝表面或焊缝背面形成的低于母材表面的局部低洼部分。
13.未焊满由于填充金属不足,在焊缝表面形成的连续或断续的沟槽。
14.下塌单面熔化焊时,由于焊接工艺不当,造成焊缝金属过量透过背面,而使焊缝正面塌陷,背面凸起的现象。
二、焊接裂纹1.焊接裂纹在焊接应力及其他致脆因素共同作用下,焊接接头中局部地区的金属原子结合力遭到破坏而形成的新界面所产生的缝隙。
它具有尖锐的缺口和大的长宽比的特征。
2.热裂纹焊接过程中,焊缝和热影响区金属冷却到固相线附近的高温区产生的焊接裂纹。
3.弧坑裂纹在弧坑中产生的热裂纹。
4.冷裂纹焊接接头冷却到较低温度下(对于钢来说在MS温度以下)时产生的焊接裂纹。
5.延迟裂纹钢的焊接接头跨却到室温后并在一定时间(几小时、几天、甚至十几天)才出现的焊接冷裂纹。
6.焊根裂纹沿应力集中的焊缝根部所形成的焊接冷裂纹。

SMT专业术语名词解释Accuracy(精度):测量结果与目标值之间的差额。
Additive Process(加成工艺):一种制造PCB导电布线的方法,通过选择性的在板层上沉淀导电材料(铜、锡等)。
Adhesion(附着力):类似于分子之间的吸引力。
Aerosol(气溶剂):小到足以空气传播的液态或气体粒子。
Angle of attack(迎角):丝印刮板面与丝印平面之间的夹角。
Anisotropic adhesive(各异向性胶):一种导电性物质,其粒子只在Z轴方向通过电流。
Annular ring(环状圈):钻孔周围的导电材料。
Application specific integrated circuit (AS IC特殊应用集成电路):客户定做得用于专门用途的电路。
Array(列阵):一组元素,比如:锡球点,按行列排列。
Artwork(布线图):PCB的导电布线图,用来产生照片原版,可以任何比例制作,但一般为3:1或4:1。
Automated test equipment (ATE自动测试设备):为了评估性能等级,设计用于自动分析功能或静态参数的设备,也用于故障离析。
Automatic optical inspection (AOI自动光学检查):在自动系统上,用相机来检查模型或物体Ball grid array (BGA球栅列阵):集成电路的包装形式,其输入输出点是在元件底面上按栅格样式排列的锡球。
Blind via(盲通路孔):PCB的外层与内层之间的导电连接,不继续通到板的另一面。
Bond lift-off(焊接升离):把焊接引脚从焊盘表面(电路板基底)分开的故障。
Bonding agent(粘合剂):将单层粘合形成多层板的胶剂。
Bridge(锡桥):把两个应该导电连接的导体连接起来的焊锡,引起短路。
Buried via(埋入的通路孔):PCB的两个或多个内层之间的导电连接(即,从外层看不见的)。

1.焊接缺陷:焊接过程中在焊接接头中产生的金属不连续、不致密或连接不良的现象。
2.未焊透:焊接时接头根部未完全熔透的现象,对对接焊缝也指焊缝深度未达到设计要求的现象。
3.未熔合:熔焊时,焊道与母材之间或焊道与焊道之间,未完全熔化结合的部分,电阻点焊指母材与母材之间未完全熔化结合的部分。
4.夹渣:焊后残留在焊缝中的焊渣。
5.夹杂物:由于焊接冶金反应产生的,焊后残留在焊缝金属中的微观非金属杂质(如氧化物、硫化物等)。
6.夹钨:钨极惰性气体保护焊时由钨极进入到焊缝中的钨粒。
7.气孔:焊接时,熔池中的气泡在凝固时未能逸出而残留下来所形成的空穴。
气孔可分为密集气孔、条虫状气孔和针状气孔等。
8.咬边:由于焊接参数选择不当,或操作方法不正确,沿焊趾的母材部位产生的沟槽或凹陷。
9.焊瘤:焊接过程中,熔化金属流淌到焊缝之外未熔化的母材上所形成的金属瘤。
10.白点:在焊缝金属拉断面上,出现的如鱼目状的一种白色圆形斑点。
11.烧穿:焊接过程中,熔化金属自坡口背面流出,形成穿孔的缺陷。
12.凹坑:焊后在焊缝表面或焊缝背面形成的低于母材表面的局部低洼部分。
13.未焊满:由于填充金属不足,在焊缝表面形成的连续或断续的沟槽。
14.下塌:单面熔化焊时,由于焊接工艺不当,造成焊缝金属过量透过背面,而使焊缝正面塌陷,背面凸起的现象。
15.焊接裂纹:在焊接应力及其他致脆因素共同作用下,焊接接头中局部地区的金属原子结合力遭到破坏而形成的新界面所产生的缝隙。
它具有尖锐的缺口和大的长宽比的特征。
16.热裂纹:焊接过程中,焊缝和热影响区金属冷却到固相线附近的高温区产生的焊接裂纹。
17.弧坑裂纹:在弧坑中产生的热裂纹。
18.冷裂纹:焊接接头冷却到较低温度下(对于钢来说在MS温度以下)时产生的焊接裂纹。
19.延迟裂纹:钢的焊接接头跨却到室温后并在一定时间(几小时、几天、甚至十几天)才出现的焊接冷裂纹。
20.焊根裂纹:沿应力集中的焊缝根部所形成的焊接冷裂纹。
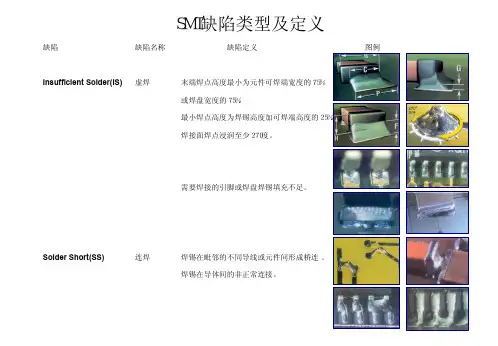

电弧缝焊arc seam weld 采用电弧焊方法焊成的缝形焊缝。
电弧点焊arc spot weld 采用电弧焊方法焊成的点状焊缝。
弧伤arc strike 由于疏忽大意,使电能在完成的焊缝(或母材)表面与焊条或磁探头(电流源)之间通过,从而发生电弧,造成在完成的焊缝(或母材)的外形轮廓上的任何烧伤。
螺柱弧焊arc stud swelding 一种弧焊方法。
此法在金属螺柱(或类似零件)和另一工件之间引发电弧,直至被连接的表面受到适当加热,然后再以压力使两者接合起来。
在螺柱外围加一陶瓷护套,可以获得适当的部分保护。
焊剂或保护气体可用可不用。
电弧焊arc welding 电弧焊是指某一焊接方法群,此焊接方法群是以单弧或多弧加热的办法来实现接合,填充金属可用可不用,外加压力亦可用可不用。
焊态as-welded 焊缝金属、焊接接头和焊件,在焊接后未接受任何后续处理例如热处理、机械处理或化学处理之前的状态。
自动焊automatic welding 采用施焊时间无需焊接操作工调节控制钮的机器进行的焊接。
这类焊机可以也可以不执行装卸工件的工作,参见机动焊。
背面清根back gouging 从一个部分焊接的接头的另一面清除一些焊缝金属和母材,以保证从这一面作后续焊接时能完全焊透。
后焊法backhand welding 焊炬或焊枪的指向与焊接方向相反的一种焊接技术。
衬垫backing 为了支撑熔化的焊接金属在焊接接头的根部放置一材料。
背面气体backing gas 采用氩、氦、氮或活性气体之类,从焊接接头根部的背面(与焊接侧相反的一面)排除氧气。
母材base metal 被焊接的或被切割的金属。
熔合线bond line, fusion line 见fusion line 对接接头butt joint 在近乎同一的平面内对装在一起的两元件之间的接头。
堆焊缓冲层buttering 堆焊缓冲层是指在接头准备作最终焊接前,预先在接头的一个(或两个)侧面堆焊一层(或多层)焊缝金属,以便为后续焊接提供适当的过渡层熔敷焊缝。

焊接钢管常见缺陷名词解释
咬边咬边是沿着焊缝中心线在焊缝边部与管体过渡区出现沟槽。
咬边是在焊速、电流、电压等条件匹配不适当的情况下产生的。
搭焊钢板边缘上、下错位对接,造成焊缝不平的现象,成为管缝错位或管缝搭焊。
焊瘤焊接过程中,熔化金属流淌到焊缝之外未融化的母材上所形成的金属瘤。
过烧焊接过程中,融化金属温度过高自坡口流出,形成焊缝缺陷。
焊偏焊道偏离焊接中心线,产生焊缝偏离的现象。
气孔焊接时,熔池中的气泡在凝固时未能逸出而残留在焊缝中形成的空穴。
气孔可分为密集气孔、条虫状气孔和针状气孔等。
夹渣焊接时,熔池中的气泡在凝固时未能逸出而残留在焊缝中形成的空穴。
气孔可分为密集气孔、条虫状气孔和针状气孔等。
未焊透焊接时接头根部未完全熔透的现象,也指焊缝深度未达到设计要求的现象。
热裂纹在埋弧焊接中,焊缝内可产生热裂纹,特别是在起弧和熄弧弧坑处由于温差大容易发生热裂纹。
热裂纹在焊缝应力很大的时候,或者焊缝金属内的Si含量很高的时候最容易产生。
焊接灰斑高频电阻焊(HFW)焊接方式所特有的焊接缺陷。
其特征是在拉伸试样或冲击试样焊缝宏观端口上所出现的无金属光泽的灰色区域。
通常认为,灰斑对焊缝的强度水平无明显影响,但对焊缝的韧性和塑性影响较大。
沟状腐蚀沟状腐蚀是ERW钢管焊缝中一种特殊的腐蚀现象。
服役于海水和工业用水等介质的电阻焊管在焊接区产生的选择性局部腐蚀现象称为沟状腐蚀,多从表面开始呈连续或非连续的沟状,它可以导致焊管在一年至数年内腐蚀穿孔。
压坑轧辊麻点或辊面与管坯间的硬物使管材表面产生的低凹压痕。

电子装联过程中常见焊接缺陷及解决方法摘要:电子装联工艺主要的利用一定的电子元件和零部件通过电子机械的装配与连接,使电子产品能够满足设计任务要求的一种工艺技术。
所以,只有可操作性强、成熟完善的电子装联工艺,才可以确保电子装联的高质量以及电子设备与产品具有较高的可靠性。
关键词:电子装联;焊接缺陷;解决方法1电子装联技术主要特征制造工程中的连接器和其他部件,在电磁介质环境中通过布局和布线来制作成设定的电气模型,此项技术属于工程实体制造技术。
从我国电子组装技术的发展来看,可以认为焊点是电气连接的“重要支撑点”。
电子产品在我国军事领域高密度组装方面不合格率要求不超过0.05‰,传统的电子组装技术根本无法满足这一要求。
这必然要求我们利用较为先进的电子装联技术来提高电子设备的可靠性。
电子组件的可靠性取决于各种元器件的可靠性,及这些组件之间的机械和热学、电学所具有的可靠性。
这些接触界面和焊接表面层不仅能提供电气连接,还提供电子元器件组件与PCB基板之间的机械连接,以及组件受热严重时的散热功能。
单独焊接很难说焊料是否可靠,但当电子元件经过焊料连接至PCB上时,此焊料就会变得独特,一旦系统完成,它就有较高的可靠性。
钎料的晶粒结构本质上是不稳定的。
钎料的再结晶温度低于其共晶温度。
颗粒的大小会随着时间的推移而增大。
晶粒结构生长降低了细晶粒的内能。
通过提高循环负载下的温度和再循环载荷中的应变能,使此种晶粒的增长过程不断改善。
晶粒生长当达到某一点时,将显示累积疲劳损伤。
这种情况在测试过程中,性能比在工作环境中使用焊料时更明显。
铅的氧化物、助焊剂残留物,大多都会残留在晶粒边界处。
伴随晶粒不断生长,此污染物浓度也会在边缘处生长,因而会减缓晶粒的生长。
当钎料被消耗掉约25%的疲劳寿命后,在晶粒边缘交叉处能观察到微空穴;当消耗约40%疲劳寿命之后,微空穴就会产生微裂纹;这些微裂纹聚集之后就会构成大裂纹,最终导致整个焊点发生断裂。
焊点通常会结合不同特性的材料,造成整体热膨胀不一致。

焊接缺陷和检验术语 Document number【980KGB-6898YT-769T8CB-246UT-18GG08】焊接缺陷和检验术语1.焊接缺陷焊接过程中在焊接接头中产生的金属不连续、不致密或连接不良的现象。
2.未焊透焊接时接头根部未完全熔透的现象,对对接焊缝也指焊缝深度未达到设计要求的现象。
3.未熔合熔焊时,焊道与母材之间或焊道与焊道之间,未完全熔化结合的部分,电阻点焊指母材与母材之间未完全熔化结合的部分。
4.夹渣焊后残留在焊缝中的焊渣。
5.夹杂物由于焊接冶金反应产生的,焊后残留在焊缝金属中的微观非金属杂质(如氧化物、硫化物等)。
6.夹钨钨极惰性气体保护焊时由钨极进入到焊缝中的钨粒。
7.气孔焊接时,熔池中的气泡在凝固时未能逸出而残留下来所形成的空穴。
气孔可分为密集气孔、条虫状气孔和针状气孔等。
8.咬边由于焊接参数选择不当,或操作方法不正确,沿焊趾的母材部位产生的沟槽或凹陷。
9.焊瘤焊接过程中,熔化金属流淌到焊缝之外未熔化的母材上所形成的金属瘤。
10.白点在焊缝金属拉断面上,出现的如鱼目状的一种白色圆形斑点。
11.烧穿焊接过程中,熔化金属自坡口背面流出,形成穿孔的缺陷。
12.凹坑焊后在焊缝表面或焊缝背面形成的低于母材表面的局部低洼部分。
13.未焊满由于填充金属不足,在焊缝表面形成的连续或断续的沟槽。
14.下塌单面熔化焊时,由于焊接工艺不当,造成焊缝金属过量透过背面,而使焊缝正面塌陷,背面凸起的现象。
15.焊接裂纹在焊接应力及其他致脆因素共同作用下,焊接接头中局部地区的金属原子结合力遭到破坏而形成的新界面所产生的缝隙。
它具有尖锐的缺口和大的长宽比的特征。
16.热裂纹焊接过程中,焊缝和热影响区金属冷却到固相线附近的高温区产生的焊接裂纹。
17.弧坑裂纹在弧坑中产生的热裂纹。
18.冷裂纹焊接接头冷却到较低温度下(对于钢来说在MS温度以下)时产生的焊接裂纹。
19.延迟裂纹钢的焊接接头跨却到室温后并在一定时间(几小时、几天、甚至十几天)才出现的焊接冷裂纹。
这些焊接缺陷的准确定义,你不一定都知道!咬边:由于焊接参数选择不当或操作方法不正确沿焊趾的母材部位产生的沟槽或凹陷。
未焊透:焊接时焊接接头根部未完全熔透的现象。
未熔合:焊接时,焊缝与母材之间或焊缝与焊缝之间,出现的没有完全熔化结合的现象。
焊穿:焊接过程中熔化金属从母材背面流出并形成穿孔现象。
焊瘤:在焊接过程中,熔化的金属流淌到焊缝之外未熔化的母材上所形成的金属瘤。
熔坑:由于焊接电流过大或操作不当在焊缝背面的母材上形成的点状凹坑。
偏焊:焊缝偏离母材,与母材没有完全结合。
气孔:指焊接时熔池中的气体在凝固时未能及时逸出而在焊缝金属内部或表面所形成的空穴。
飞溅:熔焊过程中向周围飞散的金属颗粒。
弧坑:焊缝收尾处产生的下陷部分叫做弧坑。
弧坑缩孔:指焊道末端的凹陷且在后续焊道焊接之前或焊接过程中未被消除。
焊缝尺寸不符合要求:如焊缝表面不规则[即表面过分粗糙];宽度不齐[焊缝宽度改变过大];焊缝过高[对接焊缝表面上的焊缝金属过高];型面不良[母材表面与靠近焊趾处焊缝表面切面间角度过小,焊缝于母材过渡不圆滑];凸度过大[角焊缝表面的焊缝金属过高];焊脚不对称[两侧焊脚尺寸差过大];接头不良[焊缝衔接处的局部表面不规则];焊缝厚度过大或不足。
漏焊:图纸设计有焊缝,由于操作失误而没有焊接的现象称为漏焊。
裂纹:在焊接应力及其他至脆因素共同作用下,焊接接头中局部地区的金属原子结合力遭到破坏而形成的新界面所产生的缝隙,它具有尖锐的缺口和大的长宽比特征。
夹渣:焊接后残留在焊缝中的熔渣称为夹渣。
渗透不良:在要求单面焊双面成型的焊接中,反面成型不规则(尖锐、粗细高低不一),反面成型(渗透)偏离两块焊件对接线,以及没有渗透或渗透达不到规定的长度要求,称为渗透不良。
在集装箱制造中,拼板焊接常见。
错边:装配时,由于两个焊件没有对正而造成板的中心线平行偏差或长度方向板边的不齐。
焊缝凹度过大:焊缝凹度过大时,易引起焊缝厚度不足。
若干电子装联焊接缺陷术语定义诠释中国电子科技集团公司第十研究所陈正浩一.引用标准及文献1.国家标准GB/T19247.2-2003/IEC61191-2:1998印制板组装第2部分:分规范表面安装焊接组装的要求2.航天标准QJ2828-95电子装联术语若干电子装联焊接缺陷的定义,国内外并无统一的定义,由此带来不少周折。
航天二院张永忠说:“对于虚焊的认识,我的看法也是看金属间化合物。
航天科工集团在2013年做了一期虚焊的专题,以质量简报的形式由集团科质部下发到各单位,里面对虚焊的定义引用了QJ标准对虚焊的定义,但是又做了延伸,分为显性虚焊(也叫广义虚焊),隐性虚焊,显性虚焊即外观可以检查得到的。
”航天二院的张永忠所说的QJ标准就是笔者在以后要多次引用的QJ2828-95《电子装联术语》,由航天七0八所提出,参考美国宇航局NASA标准和美MILL 军标而制定的我国航天标准,至今仍然有效。
3.电子行业标准1)SJ/T10668-2002表面组装术语2)SJ20385A-2008军用电子设备电气装配技术要求4.美国IPC标准笔者在这里同样也引用了美国IPC标准,需要说明的是IPC标准是由“IPC 美国连接电子业协会”制定的商用标准。
2010年4月出版的IPC-A-610E CN《电子组件的可接受性》在5.2节焊接异常一节里,把焊接缺陷归纳为:暴露金属基材、针孔/吹孔、焊膏再流不完全、不润湿、冷焊/松香焊接连接、退润湿、锡球/锡溅、桥连、锡网/泼锡、焊料受扰、焊料破裂或有裂纹、锡尖、无铅填充起翘和无铅热撕裂/孔收缩十四类,是不完全的。
3.著名SMT专家樊融融教授的著作笔者引用了樊融融教授对若干焊接缺陷的定义;樊融融教授是我国电子装联业界泰斗,七项联合国专利获得者,八十年代我国杰出的中青年科学家,现在是深圳中兴通信终生员工。
二.焊接缺陷定义的错误理解“虚焊其实仅针对于IPC中的open”,但IPC-A-610E并没有虚焊的说法,也没有open的说法;open就是开路,“开路”的说法中国有,但IPC-A-610E的焊接缺陷里没有。
1.焊接裂纹
在焊接应力及其他致脆因素共同作用下,焊接接头中局部地区的金属原子结合力遭到破坏而形成的新界面所产生的缝隙。
它具有尖锐的缺口和大的长宽比的特征。
2.焊缝成形差主要表现在焊缝波纹不美观,且不光亮;焊缝弯曲不直,宽窄不一,接头太多;焊缝中心突起,两边平坦或凹陷;焊缝满溢等。
3.焊脚尺寸(fillet weld size)在GB/T3375-94焊接术语中定义为:
在角焊缝横截面中画出的最大等腰直角三角形中直角边的长度,见图10。
4..错边:构件在焊接过程巾或焊后出现长度或厚度方向的不平齐。
5.飞溅:熔化金属飞向熔池之外,飞到熔池之外的金属称为飞溅。
6.电弧擦伤:由于焊条或焊钳不慎与工件接触,或地线与工件接触不良,引起电弧,而使工件表面留下的伤痕。
电弧擦伤一般不被人们注意,但是它的危害极大。
由于电弧擦伤处快速冷却,硬度很高,有脆化作用。
在易液火钢和低碳钢中,可能成为发生脆性破坏的起源点:不锈钢有电弧擦伤,会降低耐腐蚀性能。
所以,在施焊过程中,不得在坡口以外的地方引焊,管件与地线接触一定要良好,发现电弧擦伤,必须打磨,并视深度予以补焊。
7.未熔合:熔焊时,焊道与母材之间或焊道与焊道之间,未完全熔化结合的部分,电阻点焊指母材与母材之间未完全熔化结合的部分。
8.未焊透:焊接时接头根部未完全熔透的现象,对对接焊缝也指焊缝深度未达到设计要求的现象。
9.根部收缩:焊缝根部的局部内凹或下陷:焊缝根部向上收缩低于母材下表面时称为内凹,焊缝盖面低于母材上表面时称为下陷。
10.咬边:由于焊接参数选择不当,或操作方法不正确,沿焊趾的母材部位产生的沟槽或凹陷。
焊接常用关键术语和定义AC-交流电流;在美国,极性变化是每秒60次。
合金-具有金属特性的物质,并由二个或更多的元素组成,其中至少有一个是金属元素。
字母数字-运用于命名中的数字和字母的组合。
安培-测量电流强度的标准单位。
电弧偏吹-由于电磁力的作用,焊接电弧偏移其正常的路径。
电弧长度-从电极的尖端到熔池表面的距离。
钎焊(硬钎焊)-使用填充金属连接材料而母材不熔化,熔点大于840︒F(450︒C)。
见软钎焊。
毛细作用-在钎焊中,使与固体所接触的液体在要钎焊的接头紧密接触表面之间分布的力。
碳钢-铁和小量碳的混合物。
渗碳-在焊接中,用于描述多余的碳渗入热金属表面的术语。
在空气碳弧切割,CAC-A中可能出现。
结合-二个或多个材料连接在一起规范-由一城市,市政当局,州或国家所采用的文件,具有法律效应。
DC-直流;恒定的电极DCEN-直流电流,电极接负极。
称为直流正接。
DCEP-直流电流,电极接正极。
称为直流反接。
不连续-在材料结构中的任何中断;并不一定是缺陷。
后拖量-在OFC和PAC中,在切割进入点与退出点之间沿着切割边缘测量的偏移量。
电极-在电弧,熔化的导电焊渣或母材上终止的电路上的一元件。
接合面-一个部件与另一部件连接时接触或非常接近的的配合表面。
铁基的-描述金属主要由铁为基础而组成,如钢的术语。
填充金属-加入焊接,钎接的金属或合金。
焊剂-用于阻止氧化物或其它不期望物在熔化的金属和固体金属表面的材料,并能熔化或帮助去除这些物质。
夹渣-陷入的杂质材料,如焊渣,焊剂,钨或氧化物。
未熔合-在焊接金属熔合面或连接的焊道之间没有熔合出现的一焊接不连续。
接头未焊透-在坡口焊缝中跟部的焊缝金属没有贯穿整个接头厚度。
惰性气体-不能与其它材料化学地相结合的气体。
氩和氦是在焊接中最常用到的。
切口宽度-在切割工艺中产生的切口的宽度。
小孔效应焊接-在工件上穿透工件的孔。
当进行焊接时,熔化了的金属在小孔后流动形成焊缝。
ksi-每平方英寸一千磅的命名。
若干电子装联焊接缺陷术语定义诠释中国电子科技集团公司第十研究所陈正浩一.引用标准及文献1.国家标准GB/T19247.2-2003/IEC61191-2:1998印制板组装第2部分:分规范表面安装焊接组装的要求2.航天标准QJ2828-95电子装联术语若干电子装联焊接缺陷的定义,国内外并无统一的定义,由此带来不少周折。
航天二院张永忠说:“对于虚焊的认识,我的看法也是看金属间化合物。
航天科工集团在2013年做了一期虚焊的专题,以质量简报的形式由集团科质部下发到各单位,里面对虚焊的定义引用了QJ标准对虚焊的定义,但是又做了延伸,分为显性虚焊(也叫广义虚焊),隐性虚焊,显性虚焊即外观可以检查得到的。
”航天二院的张永忠所说的QJ标准就是笔者在以后要多次引用的QJ2828-95《电子装联术语》,由航天七0八所提出,参考美国宇航局NASA标准和美MILL 军标而制定的我国航天标准,至今仍然有效。
3.电子行业标准1)SJ/T10668-2002表面组装术语2)SJ20385A-2008军用电子设备电气装配技术要求4.美国IPC标准笔者在这里同样也引用了美国IPC标准,需要说明的是IPC标准是由“IPC 美国连接电子业协会”制定的商用标准。
2010年4月出版的IPC-A-610E CN《电子组件的可接受性》在5.2节焊接异常一节里,把焊接缺陷归纳为:暴露金属基材、针孔/吹孔、焊膏再流不完全、不润湿、冷焊/松香焊接连接、退润湿、锡球/锡溅、桥连、锡网/泼锡、焊料受扰、焊料破裂或有裂纹、锡尖、无铅填充起翘和无铅热撕裂/孔收缩十四类,是不完全的。
3.著名SMT专家樊融融教授的著作笔者引用了樊融融教授对若干焊接缺陷的定义;樊融融教授是我国电子装联业界泰斗,七项联合国专利获得者,八十年代我国杰出的中青年科学家,现在是深圳中兴通信终生员工。
二.焊接缺陷定义的错误理解“虚焊其实仅针对于IPC中的open”,但IPC-A-610E并没有虚焊的说法,也没有open的说法;open就是开路,“开路”的说法中国有,但IPC-A-610E的焊接缺陷里没有。
不润湿、假焊、空焊、开路、虚焊......,有些属于“俗语”而不是术语。
虚焊不等同于开路,虚焊的根本特征是金属间化合物不符合要求;开路也未必是虚焊所造成,例如“立碑”也是开路,但就不是虚焊;不润湿和虚焊含义不同,但不润湿必定导致虚焊;虚焊并非是中国的一个衍生泀,而是客观存在的事实。
中国电科10所的第一任工艺总工程师叶传垠是我国第一代电子工艺宗师,笔者自二十世纪六十年代初起从事电子装联工艺工作,师从叶老总,亲自聆听他关于虚焊的多次阐述。
而IPC-610的最早版本是九十年代初,与我国对于焊接缺陷之一——虚焊的提出滞后整整四十年!三.若干电子装联焊接缺陷的定义1.虚焊1)QJ2828-95中虚焊的定义为:虚焊Pseudo soldering焊料与焊接件的金属表面被氧化或其它污物所隔离,没有形成金属合金层,只是简单地依附在焊接件表面所造成的缺陷。
2)在焊接参数(温度、时间)全部正常的情况下,焊接过程中凡在连接界面上未形成合适厚度金属间化合物(IMC)的现象,均可定义为虚焊。
——樊融融,《现代电子装联工程应用1100问》,2011年.图1用3D显微镜和金相显微镜观察焊点外观润湿情况图2用3D视频显微仪观察焊接BGA焊点外观润湿情况图4用3D内窥镜观察焊接BGA焊点外观润湿情况图5用3D-XRay观察焊点虚焊图6用红外显微镜分析(FT)判定焊点虚焊图7用扫描电镜(SEM)判定焊点虚焊图8用金相切片判定焊点虚焊2.冷焊1)在焊接中钎料与基体金属之间没有达到最低要求的润湿温度;或者虽然局部发生了润湿,但冶金反应不完全而导致的现象,可定义为冷焊。
——樊融融,《现代电子装联工程应用1100问》,2011年. 2)QJ2828-95对冷焊的定义为:假焊(生焊,冷焊)cold solder joint 焊接温度过低,焊料在润湿和流动前就可能凝固,焊点外观不可能平滑光亮,是焊接质量比虚焊的更差的一种缺陷。
3)IPC-610E对冷焊焊接连接的定义为:冷焊焊接连接—是指呈现很差的润湿性、外表灰暗、疏松的焊接连接。
(这种现象是由于焊锡中杂质过多,焊接前清洁不充分,和/或焊接过程中热量不足所致)。
4)IPC-T-50对冷焊焊接连接的定义为:焊接连接呈现出润湿不良及灰色多孔外观。
(这是由于焊料杂质过多,焊接前清洁不充分,和/或焊接过程中热量不足造成的。
)焊接连接呈现不良的润湿,可能有截留的松香迹象,导致待连接的表面分离。
图9冷焊3.润湿1)QJ2828-95对润湿的定义为:润湿wetting熔融焊料粘附在被焊金属表面形成相当均匀光滑连续的焊料薄膜的现象。
2)SJ20385A-2008对润湿的定义为:润湿wetting液态焊料和被焊基体金属之间产生相互作用的现象,即熔融焊料在基体金属表面扩散形成完整均匀的覆盖层的现象。
3)SJ/T10668-2002对润湿的定义为:润湿wetting指液态焊料和被焊基体金属之间产生相互作用的现象,即熔融焊料在基体金属表面扩散形成完整均匀的覆盖层的现象。
4.润湿角1)SJ20385A-2008对润湿角的定义为:润湿角wetting金属表面和熔融焊料表面在其交点处切线和金属表面间的夹角。
润湿角θ为我们揭示了润湿情况的信息;SJ20385给出了焊接润湿角要求,见表1。
表1润湿角润湿条件判别15°<θ<30°良好30°<θ<40°好(合格)40°<θ<55°可接受55°<θ<70°不良θ>70°差2)润湿角诠释樊融融教授以他深厚的技术功底诠释了润湿角。
电子装联中软钎焊焊接接点形成理论基础是基于钎料金属、基体金属、助焊剂等三要素所构成的三相润湿系统。
在焊接过程中,基体金属呈固态,钎料金属呈液态,而助焊剂通常为气态(或液态),183℃是共晶点,见图10。
图10图11焊接界面,红色的箭指示的是Cu3Sn 以63Sn/37Pb焊料与Cu表面焊接为例,当温度达到210-230℃时,Sn向Cu 表面扩散,而Pb不扩散。
初期生成的Sn-Cu合金-Cu6Sn5。
其中Cu的重量百分比含量约为40%。
随着温度升高和时间延长,Cu原子渗透(溶解)到Cu6Sn5中,形成新的金属间化合物Cu6Sn和ε相的Cu3Sn。
局部结构转变为Cu3Sn,Cu含量由40%增加到66%。
当温度继续升高和时间进一步延长,Sn/Pb焊料中的Sn不断向Cu 表面扩散,在焊料一侧只留下Pb,形成富Pb层。
锡的不断流失造成锡铅焊料中锡含量相对减少,而铅含量增多,造成缩锡,即浸润性变差。
Cu6Sn5和富Pb层之间的的界面结合力非常脆弱,当受到温度、振动等冲击,就会在焊接界面处发生裂纹。
图12为润湿过程中热动力平衡状态示意图。
图12图中:VSF—是基体金属(固态)和助焊剂之间的界面张力,是使液态钎料在固态基体金属表面上漫流的力,即漫延力和润湿力;VLS——是液态钎料和基体金属(固态)之间的界面张力(界面能量);VLF——是液态钎料和助焊剂之间的界面张力。
其作用方向和液态钎料曲面相切。
它是使液态钎料表面趋向最小的作用力(表面张力)。
在无其它作用力的情况下,液体的表面张力能是其缩成球形。
润湿,指熔化的焊料在金属表面自由流动并向外扩展,形成同金属结合的附着层。
润湿角,指金属表面和熔融焊料交界面与熔融焊料表面在其交点处切线和金属表面的夹角。
润湿角θ≥90º,表明液态钎料和基体金属表面之间缺乏润湿亲合力,在此情况下,液态钎料根本没有润湿过基体金属表面,而只是在基体金属表面凝固,见图13。
图13润湿角90º>θ>M,通常取M=55º,表明了临界润湿情况,此种润湿是不能允许的。
润湿角θ<M(M=55º),表明良好润湿情况;如要求极高的焊接质量,M 值可取小于55º。
M明确规定为润湿良好和焊点良好的判据。
图15为润湿角θ≥90º,液态钎料和基体金属表面之间缺乏润湿亲合力实例;图16为具有洁净表面的铜和锡-铅共晶合金钎料之间的润湿角实例,大约为15º<θ<30º润湿角实例;图17,图18表示90º>θ>M接触角实例,此种润湿是不能允许的。
M=55º。
图15图16图17图18在印制电路板通孔插装焊接和表面贴装焊接中,类似润湿角θ≥90º,以及90º>θ>M的情况时有发生;同时,在电装工人和检验人员中还存在一些错误的认识,认为90º>θ>55是焊点“饱满”,而15º<θ<30º则是锡量太少!但恰恰是润湿角θ≥90º和90º>θ>55,不但焊接强度降低,还存在着“液态钎料和基体金属表面之间缺乏润湿亲合力”,潜伏着“虚焊”的危险性。
需要特别说明的是,上述情况都是针对铅锡合金(Sn63/Pb37)作为焊接材料而言,出于环保的需求和出口的需要,目前无铅焊接在民用电子消费品的电子组装中已经得到越来越广泛的应用,但我们也必须明确的指出,由于无铅焊料的可焊性差,润湿差,焊接温度高,对目前绝大部分元器件及焊接设备所留下的温度空间十分狭窄,无铅焊接焊点的形态(最佳θ角)也将由铅锡合金时的15º<θ<30º,发生较大的变化,过去被认为是不能允许的90º>θ>M(M=55º)润湿角及焊点灰白、不光亮等焊接缺陷,在无铅焊接中很可能被认为属于可接受的现象,因此即使在发起无铅焊接的美国,至今还没有看到无铅焊接的美国MIL军标出现,我们在航天航空等高可靠性电子设备中应用无铅焊接要十分慎重。
当30º<θ<45º时,焊点的机械强度最好,抗拉强度平均可以达到6.7Kg/mm2,抗拉试验断裂处几乎都是发生在引线上。
图195.半润湿1)QJ2828对半润湿的定义为:半润湿dewetting熔融焊料粘附在被焊金属表面后,形成回缩,遗留下不规则的焊料疙瘩,但不露基体金属的现象。
2)SJ/T10668-2002对半润湿的定义为:半润湿dewetting熔融焊料涂覆在基体金属表面后,焊料回缩,遗留下不规则的焊料疙瘩,但不露基体金属。
图20半润湿6.退润湿IPC-T-50对退润湿的定义为:熔融焊料涂覆在金属表面上然后焊料回缩,导致形成薄膜覆盖且未暴露金属基材或表面涂层的区域分隔开的不规则焊料堆的一种状况。