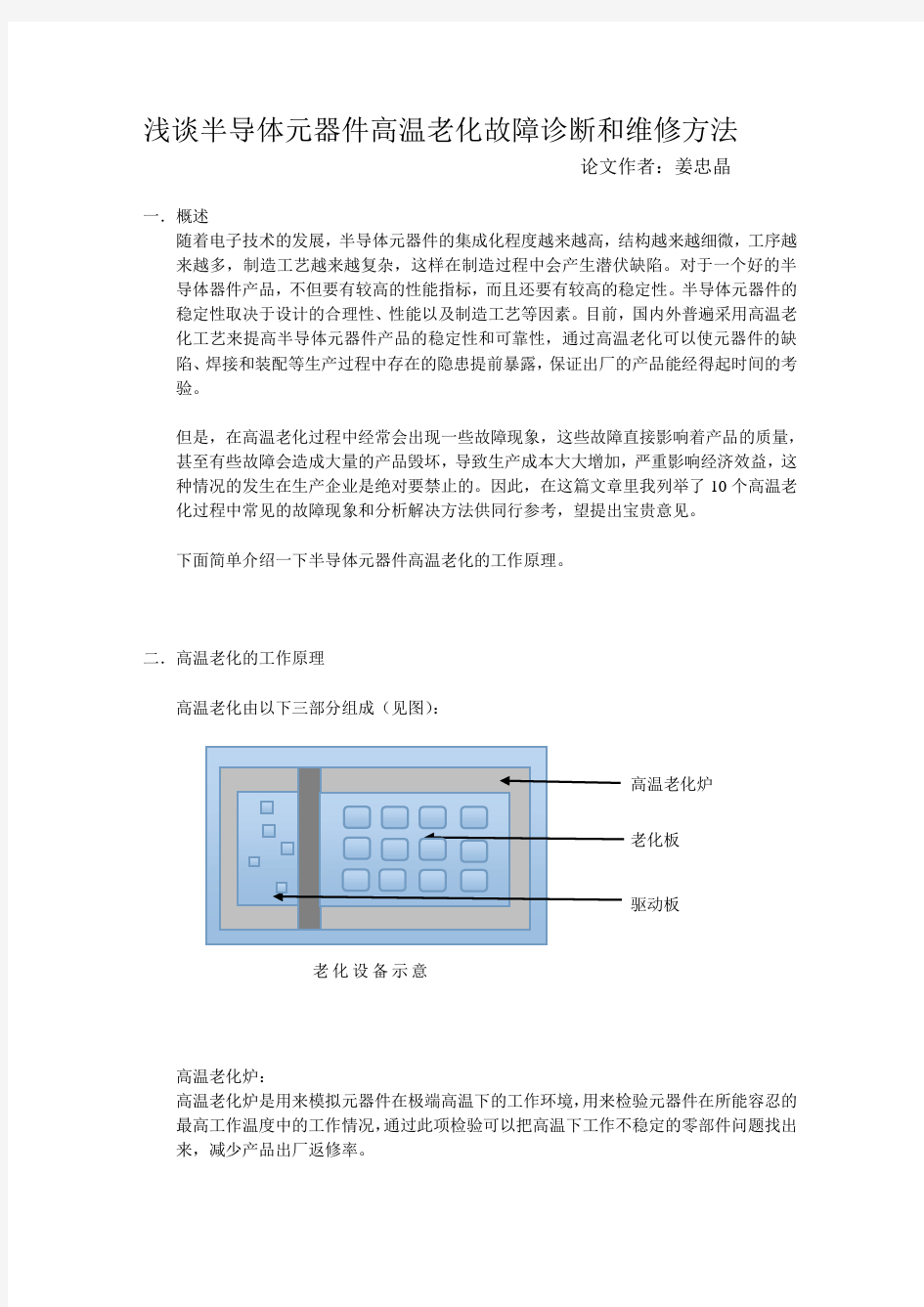

浅谈半导体元器件高温老化故障诊断和维修方法
论文作者:姜忠晶
一.概述
随着电子技术的发展,半导体元器件的集成化程度越来越高,结构越来越细微,工序越来越多,制造工艺越来越复杂,这样在制造过程中会产生潜伏缺陷。对于一个好的半导体器件产品,不但要有较高的性能指标,而且还要有较高的稳定性。半导体元器件的稳定性取决于设计的合理性、性能以及制造工艺等因素。目前,国内外普遍采用高温老化工艺来提高半导体元器件产品的稳定性和可靠性,通过高温老化可以使元器件的缺陷、焊接和装配等生产过程中存在的隐患提前暴露,保证出厂的产品能经得起时间的考验。
但是,在高温老化过程中经常会出现一些故障现象,这些故障直接影响着产品的质量,甚至有些故障会造成大量的产品毁坏,导致生产成本大大增加,严重影响经济效益,这种情况的发生在生产企业是绝对要禁止的。因此,在这篇文章里我列举了10个高温老化过程中常见的故障现象和分析解决方法供同行参考,望提出宝贵意见。
下面简单介绍一下半导体元器件高温老化的工作原理。
二.高温老化的工作原理
高温老化由以下三部分组成(见图):
高温老化炉
老化板
驱动板
老化设备示意
高温老化炉:
高温老化炉是用来模拟元器件在极端高温下的工作环境,用来检验元器件在所能容忍的最高工作温度中的工作情况,通过此项检验可以把高温下工作不稳定的零部件问题找出来,减少产品出厂返修率。
老化板:
老化板是提供给元器件在高温下进行老化工作的平台,它包括半导体器件本身的硬件电路和高温老化所需要的单元电路。
驱动板:
是驱动老化板工作的核心部分,它不仅包括单片机、I/O接口等硬件电路,还包括专用的老化程序软件。
高温老化流程:
开始
将被老化的半导体器件放到老化板上,然后将老化
板插到老化炉内
插入相应的驱动板且打开驱动板的电源
在老化炉上设定程序、温度、时间等参数,然后启
动老化炉开始运行
驱动板用特定的程序完成每一个半导体元器件的
老化过程,最后显示结果
将老化不合格的元器件筛选出来
高温老化结束
三.常见故障分析解决方法
故障1. 高温老化结果显示整个老化板NRD(没有找到被测物料)
描述这是非常常见的故障,驱动板找不到老化板上的物料,不能对其进行读写操作,因此被视为找不到被测物料,即NRD。
分析这种情况属于驱动板工作正常,检查老化板和驱动板有没有接触好,接插是否牢固。
驱动板上接收数据的存储器损坏导致老化板的数据接收不进来。驱动板上的控制线
失效,CPU发出指令信号,驱动板没有响应,可能是开路短路造成。
解决检查驱动板和老化板的接触。检查驱动板上接收数据的存储器工作是否正常,用示波器或万用表测量存储器的输入信号和输出信号,确认输入信号和输出信号的关系
是否正确,如果输入正确而输出不正确,则该存储器失效需要更换该存储器;如果
输入信号没有,要测量老化板的数据输出信号是否正常。检查老化板的电源电压和
数据输出线是否有开路和短路。
故障2. 高温老化结果显示单行或多行老化板NRD
描述老化板上的物料是以矩阵的形式排列的,行控制信号有问题会产生单行或多行NRD。
分析这种情况属于驱动板和老化板都能正常工作,但是驱动板和老化板的行控制信号有问题。
解决检查驱动板和老化板的行控制信号有无开路和短路,检查行控制器的输入输出信号,必要时更换行控制器件。
故障3. 高温老化结果显示整个老化板结果PASS(不识别)
描述这个故障表面看似乎没设么问题,但实际问题很大。这种情况跟故障1不一样,故障1 是接收不到老化板的反馈信号,而这种情况是接收到的信号是错误的,所以结
果是不能辨别好坏,这是非常严重的错误。
分析同样这种情况来自于驱动板的信号接收和老化板的信号输出。一般情况下是有器件损坏。
解决使用示波器和万用表认真检查驱动板的输入信号的逻辑关系和波型图,必要时更换输入存储器。检查老化板的输出信号有无异常,尤其要检查物料的反馈信号的逻辑
关系。
故障4. 老化板状态灯异常,且不能正常工作
描述一般情况下驱动板上都设有老化板的状态灯,它的状态表明有没有老化板或使用的老化板是否正确。
分析驱动板辨别老化板有两个方面,第一是辨别老化板的状态输出信号,他是辨别有无老化板的依据;第二是每种老化板有一个四位的逻辑编码,此编码标明是老化板的
种类,如果驱动板查出此码与程序不符,则停止工作并报警。
解决用示波器或万用表检查老化板上的状态输出信号和驱动板上接收该信号的器件,必要时进行更换。检查老化板上的四位逻辑编码和驱动板上相应的接收器件,必要时
也要及时更换。
故障5. 驱动板状态灯异常,且不能正常工作
描述每种驱动板状态灯有所不同,它们正常状态的定义也是不同的,要仔细区分驱动板状态灯的含义。
分析驱动板的状态灯包括电源电压指示灯,CPU工作状态灯,老化板状态灯和驱动板内部电压转换状态灯。一般情况下驱动板状态灯必须都要正确才可以正常使用,否
则要进行修理。
解决用电压表和示波器测量驱动板的电源电压,尤其是稳压器和保险丝,必要时及时更换。CUP的状态灯异常时首先要检查CPU的供电电压,如果供电电压正常而CPU
状态依然异常要更换CPU芯片。驱动板内部转换电压一般是检查各个电压相应的稳压器。
故障6. 启动老化程序后,驱动板死机
描述高温老化开始后有时出现驱动板显示乱码、黑屏甚至有异常响声,导致死机。
分析检查驱动板电源电压接触是否可靠,晶体振荡器电路是否正常。老化板上的物料是否有烧料的现象。
解决插紧驱动板使之良好接触,用示波器和万用表检查晶体振荡电路,必要时更换器件。
检查老化板上的物料,异常的取下。要确保在启动高温老化之前老化板上的物料没
有上错、上偏、上反、翘脚等不正常的物料。
故障7. 高温老化结果显示老化板过流
描述这种情况启动高温老化时报警,老化炉有显示。
分析原因是老化板问题,检查老化板上的物料有无异常,检查老化板本身元器件是否有损坏,尤其是电容器要重点检查。
解决剔除异常物料,更换烧坏的电容器。
故障8. 高温老化结果显示不稳定
描述这种现象经常出现,在同样的环境下重复启动,结果不同。
分析用万用表检查驱动板电源电压的滤波电容器,检查电源电压是否稳定,老化板和驱动板是否接触良好。
解决更换异常的滤波电容器。保持驱动板和老化板良好接触。
故障9. 启动老化程序后,老化板有烧料现象
描述这种现象可以通过视觉和嗅觉感知。
分析老化板上的物料没有上好。
解决剔除被烧毁的物料,启动老化程序之前要仔细检查老化板上的物料,确保没有上错、上偏、上反、翘脚等不正常的物料。
故障10. 如何正确判断故障点的位置
描述正确排除故障可以事半功倍,提高工作效率。相反盲目的修理、换件可能会导致增大维修成本,造成不必要的浪费。
分析举一个例子。高温老化后结果显示整个老化板报NRD,首先假定是老化板有问题,我们换另外一个好的老化板用同样的方法测量,如果结果显示PASS说明前边那块
老化板有问题,相反如果结果显示仍然是报整板NRD说明是驱动板和炉子的接触
槽有问题。同样,更换一块好的驱动板还用同样的方法测量,如果结果PASS说明
前边那块驱动板有问题,相反,如果结果仍然是报整板NRD则说明问题出在炉子
的接触槽,更换炉子的接触槽,问题就解决了。
四.结束语
以上这10个故障分析和解决方法,是我多年以来从事维修工作总结出来的。以后
随着电子技术的不断发展,各种电子设备不断翻新,我相信会有更多更新的技
术问世。同时,我也期望和我的同行不断探讨相互学习,把更多更好的经验写出
来跟大家共同探讨与分享。
电力电子变流技术试题汇总 (第一章 电力半导体器件) 一、填空题 1.晶闸管是三端器件,三个引出电极分别是,阳极、门极和__阴__极。 2.晶闸管额定通态平均电流I VEAR 是在规定条件下定义的,是晶闸管允许连续通过__工频__正弦半波电流的最大平均值。 3.处于阻断状态的晶闸管,只有在阳极承受正向电压,且__门极加上正向电压 _时,才能使其开通。 4.晶闸管额定通态平均电流I VEAR 是在规定条件下定义的,条件要求环境温度为_+400__。 5.对同一只晶闸管,断态不重复电压U DSM 与转折电压U BO 数值大小上有U DSM __小于_U BO 。 6..对同一只晶闸管,维持电流I H 与擎住电流I L 在数值大小上有I L _≈(2~4)_I H 。 7..晶闸管反向重复峰值电压等于反向不重复峰值电压的_90%___。 8.普通逆阻型晶闸管的管芯是一种大功率__四__层结构的半导体元件。 9.可关断晶闸管(GTO )的电流关断增益βoff 的定义式为min off G A I I -= β。 10.晶闸管门极触发刚从断态转入通态即移去触发信号,能维持通态所需要的最小阳极电流,称为____擎住电流 I L __。 11..晶闸管的额定电压为断态重复峰值电压U DRm 和反向重复峰值电压U RRm 中较_小__的规化值。 12.普通晶闸管的额定电流用通态平均电流值标定,双向晶闸管的额定电流用__有效值_标定。 13.普通晶闸管属于__半控型_器件,在整流电路中,门极的触发信号控制晶闸管的开通,晶闸管的关断由交流电源电压实现。 14.IGBT 的功率模块由IGBT 和_快速二极管_芯片集成而成。 15.对于同一个晶闸管,其维持电流I H _ 小于_擎住电流I L 。 16.2.可用于斩波和高频逆变电路,关断时间为数十微秒的晶闸管派生器件是__快速晶闸管____。 17.功率集成电路PIC 分为二大类,一类是高压集成电路,另一类是__智能功率集成电
《党政领导干部选拔任用工作条例》知识测试题(二) 姓名:单位: 职务:得分: 一、填空题(每题1分,共20分): 1、《党政领导干部选拔任用工作条例》于年月发布。 2、《党政领导干部选拔任用工作条例》是我们党规范选拔任用干部工作的一个重要法规,内容极为丰富,共有章条。 3、干部的四化是指革命化、知识化、年轻化、专业化。 4、,按照干部管理权限履行选拔任用党政领导干部的职责,负责《条例》的组织实施。 5、党政领导班子成员一般应当从后备干部中选拔。 6、民主推荐部门领导,本部门人数较少的,可以由全体人员参加。 7、党政机关部分专业性较强的领导职务实行聘任制△I称微分电阻 RBB---8、政协领导成员候选人的推荐和协商提名,按照RE---政协章程和有关规定办理。 Rs(rs----串联电阻 Rth----热阻 结到环境的热阻
动态电阻 本机关单位或本系统 r δ---衰减电阻 r(th--- Ta---环境温度 Tc---壳温 td---延迟时间 、对决定任用的干部,由党委(党组)指定专人同本人 tg---电路换向关断时间 12 Tj---和不同领导职务的职责要求,全面考察其德能勤绩廉toff---。 tr---上升时间13、民主推荐包括反向恢复时间 ts---存储时间和温度补偿二极管的贮成温度 p---发光峰值波长 △λ η---
15、考察中了解到的考察对象的表现情况,一般由考察组向VB---反向峰值击穿电压 Vc---整流输入电压 VB2B1---基极间电压 VBE10---发射极与第一基极反向电压 VEB---饱和压降 VFM---最大正向压降(正向峰值电压) 、正向压降(正向直流电压) △政府、断态重复峰值电压 VGT---门极触发电压 VGD---17、人民代表大会的临时党组织、人大常委会党组和人大常委会组成人员及人大代表中的党员,应当认真贯彻党委推荐意见 VGRM---门极反向峰值电压,带头(AV 履行职责交流输入电压 最大输出平均电压
半导体器件失效原因分析 发信站: 紫金飞鸿 (Mon Oct 2 12:02:48 2000) 多年来,用户要求有更可靠的电子设备,而与此同时,电子设备发展得越来越复杂。这两个因素的结合,促使人们更加关注电子设备在长期运行中确保无故障的能力。通过失效分析可以深入理解失效机理和原因,引导元器件和产品设计的改进,有助于提高电子设备(系统)的可靠性。 半导体器件的失效通常是因为产生的应力超过了它们的最大额定值。电气应力、热应力、化学应力、辐射应力、机械应力及其他因素都会造成器件失效。半导体器件的失效机理主要划分成以下6种: 一、包封失效。这类失效发生在用于封装器件的包封出现缺陷,通常是开裂。机械应力或热应力以及包封材料与金属引线之间热膨胀系数的不同都会引起包封开裂,当环境湿度很高或器件暴露在溶剂、清洗剂等中时,这些裂缝会使湿气浸入,产生的化学反应会使器件性能恶化,使它们失效。 二、导线连接失效。由于通过大电流造成过量的热应力、或由于连接不当使连接线中产生机械应力、连接线与裸芯之间界面的开裂、硅中的电致迁移、以及过量的连接压力,都会引起导线连接失效。 三、裸芯粘接故障。裸芯与衬底之间粘接不当时,就会恶化两者之间的导热性,结果会使裸芯过热,产生热应力和开裂,使器件失效。 四、本征硅的缺陷。由晶体瑕疵或本征硅材料中的杂质和污染物造成的缺陷使器件失效,在器件制造期间扩散工艺产生的工艺瑕疵也会造成器件失效。 五、氧化层缺陷。静电放电和通过器件引线的高压瞬时传送,可能会使氧化层(即绝缘体)断开,造成器件功能失常。氧化层中的开裂、划伤、或杂质也会导致器件失效。 六、铝金属缺陷。这类缺陷往往由下列几种情况造成:由于大电场导致在电流流动方向上发生铝的电迁移;由于大电流造成过量电气应力,导致铝导体断裂;铝被腐蚀;焊接引起铝金属耗损;接触孔被不适当地淀积上金属;有小丘和裂缝。 半导体器件应该工作在由生产厂确定的电压、电流和功耗限定范围内,当器件工作在这个“安全工作范围(SOA)”之外时,电气应力过 度(EOS)就会引起内部电压中断,导致器件内部损伤。如果EOS产生大电流,会使器件过热,形成热应力过度而使器件失效,即增加的热应力会导致“二次状态”失效。
半导体元器件的制造工艺及其失效 一、元器件概述 1、元器件的定义: 欧洲空间局ESA标准中的定义:完成某一电子、电气和机电功能,并由一个或几个部分构成而且一般不能被分解或不会破坏的某个装置。GJB4027-2000《军用电子元器件破坏性物理分析方法》中的定义:在电子线路或电子设备中执行电气、电子、电磁、机电或光电功能的基本单元,该基本单元可由一个或多个零件组成,通常不破坏是不能将其分解的。 2、元器件的分类:两大类 a)元件:在工厂生产加工时不改变分子成分的成品,本身不产生电子,对电压、电流无控制和变换作用。 b)器件:在工厂生产加工时改变了分子结构的成品,本身能产生电子,对电压电流的控制、变换(放大、开关、整流、检波、振荡和调制等),也称电子器件。分类(来源:2007年版的《军用电子元器件合格产品目录》) ? 3、电气元件 (1)电阻
最可靠的元器件之一,失效模式:开路、机械损伤、接点损坏、短路、绝缘击穿、焊接点老化造成的电阻值漂移量超过容差。 ? (2)电位器 失效模式:接触不良、滑动噪声大、开路等。 (3)二极管 (4)集成电路 失效模式:漏电或短路,击穿特性劣变,正向压降劣变,开路可高阻失效机理:电迁移,热载流子效应,与时间相关的介质击穿(TDDB),表面氧化层缺陷,绝缘层缺陷,外延层缺陷
(5)声表面波器件 (6)MEMS压力传感器 MEMS器件的主要失效机理: a.粘附两个光滑表面相接触时,在力作用下粘附在一起的现象; b.蠕变机械应力作用下原子缓慢运动的现象;变形、空洞; c.微粒污染阻碍器件的机械运动;
d.磨损尺寸超差,碎片卡入; e.疲劳断裂疲劳裂纹扩展失效。 (7)真空电子器件(vacuum electronic device) 指借助电子在真空或者气体中与电磁场发生相互作用,将一种形式电磁能量转换为另一种形式电磁能量的器件。具有真空密封管壳和若干电极,管内抽成真空,残余气体压力为10-4~10-8帕。有些在抽出管内气体后,再充入所需成分和压强的气体。广泛用于广播、通信、电视、雷达、导航、自动控制、电子对抗、计算机终端显示、医学诊断治疗等领域。 真空电子器件按其功能分为: 实现直流电能和电磁振荡能量之间转换的静电控制电子管; 将直流能量转换成频率为300兆赫~3000吉赫电磁振荡能量的微波电子管; 利用聚焦电子束实现光、电信号的记录、存储、转换和显示的电子束管; 利用光电子发射现象实现光电转换的光电管; 产生X射线的X射线管; 管内充有气体并产生气体放电的充气管; 以真空和气体中粒子受激辐射为工作机理,将电磁波加以放大的真空量子电子器件等。 自20世纪60年代以后,很多真空电子器件已逐步为固态电子器件所取代,但在高频率、大功率领域,真空电子器件仍然具有相当生命力,而电子束管和光电管仍将广泛应用并有所发展。[1] 真空电子器件里面就包含真空断路器,真空断路器具有很多优点,所以在变电站上应用很多。真空断路器已被快易优收录,由于采用了特殊的真空元件,随着近年来制造水平的提高,灭弧室部分的故障明显降低。真空灭弧室无需检修处理,当其损坏时,只能采取更换。真空断路器运行中发生的故障以操作机构部分所占比重较大,其次为一次导电部分,触头导电杆等。 二、元器件制造工艺与缺陷 1、芯片制造缺陷的分类: 全局缺陷:光刻对准误差、工艺参数随机起伏、线宽变化等;在成熟、可控性良好的工艺线上,可减少到极少,甚至几乎可以消除。 局域缺陷:氧化物针孔等点缺陷,不可完全消除,损失的成品率更高。 点缺陷:冗余物、丢失物、氧化物针孔、结泄漏 来源:灰尘微粒、硅片与设备的接触、化学试剂中的杂质颗粒。 2、混合集成电路的失效混合集成电路工艺:
第8章电力半导体器件及其应用 一、基本要求 1. 了解晶闸管的基本构造、工作原理、特性曲线和主要参数; 2. 掌握单相可控整流电路的可控原理,能够计算在电阻性负载和电感性负载时的输出电压、输出电流以及各元件所通过的平均电流和承受的最大正、反向电压; 3. 了解单结晶体管及其触发电路的作用原理; 4. 了解晶闸管的保护措施; 二、阅读指导 1.晶闸管 晶体闸流管是应用最为广泛的电力半导体器件。阳极加正向电压和控制极加正触发脉冲信号,这是晶闸管导通的必要条件,阳极电流应大于维持电流是晶闸管导通的充分条件。导通之后,控制极就失去控制作用。在晶闸管导通时,若减小阳极电压或阳极电流小于维持电流,晶闸管自动关断。读者在学习过程中必需了解晶闸管的导通和关断的条件。此外,还要了解正向转折电压U BO、反向击穿电压U BR(或称为反向转折电压)、正向重复峰值电压U FRM 及反向重复峰值电压U RRM的意义,并了解晶闸管的型号。 2. 可控整流电路 学习可控整流电路时,读者最好对照第4章中由二极管所组成的不可控整流电路来分析比较电路结构、电压和电流的波形、整流电压平均值和交流电压有效值之间的大小关系以及元件所承受最高反向电压等问题。特别应该注意,在可控整流电路中,晶闸管在交流电压的正半周并不一定全导通,因此晶闸管和二极管不一样,还有承受最高正向电压的问题。 难点是可控整流电路接电感性负载的情况,以及续流二极管的作用。为什么整流电压会出现负值?为什么接了续流二极管(注意其正、负极,不能接反)后,晶闸管在电源电压u2过零时能及时关断?读者应认真阅读教材并仔细思考。 单相桥式半控整流是一种较常用的电路,和二极管桥式整流电路类似,分析其工作原理时,也要分别找出在交流电压的正半周负半周时电流的通路,哪个管导通,哪个截止。 3. 单结晶体管触发电路 对单结晶体管,必须了解单结晶体管的发射极E与第一基极B1之间导通和恢复截止的条件。当发射极E和第一基极B1之间加的电压U E等于峰点电压U P时,单结晶体管导通。导通后,发射极电压U E降低,当U E低于谷点电压U V时,单结晶体管的E、B1间恢复截止。 教材图8-13是典型的晶闸管可控整流电路,其中采用单结晶体管触发电路,主电路是单相桥式半控整流电路。对这个电路,读者要了解三个作用,即稳压管的削波作用,变压器的同步作用和电位器R P的移相作用。要看懂教材图8-14所示的四个波形。 4. 晶闸管的保护 要了解晶闸管可控整流电路中,应用最为广泛快速熔断器的过电流保护和阻容吸收的过
半导体基础知识和半导体器件工艺 第一章半导体基础知识 通常物质根据其导电性能不同可分成三类。第一类为导体,它可以很好的传导电流,如:金属类,铜、银、铝、金等;电解液类:NaCl水溶液,血液,普通水等以及其它一些物体。第二类为绝缘体,电流不能通过,如橡胶、玻璃、陶瓷、木板等。第三类为半导体,其导电能力介于导体和绝缘体之间,如四族元素Ge锗、Si硅等,三、五族元素的化合物GaAs砷化镓等,二、六族元素的化合物氧化物、硫化物等。 物体的导电能力可以用电阻率来表示。电阻率定义为长1厘米、截面积为1平方厘米的物质的电阻值,单位为欧姆*厘米。电阻率越小说明该物质的导电性能越好。通常导体的电阻率在10-4欧姆*厘米以下,绝缘体的电阻率在109欧姆*厘米以上。 半导体的性质既不象一般的导体,也不同于普通的绝缘体,同时也不仅仅由于它的导电能力介于导体和绝缘体之间,而是由于半导体具有以下的特殊性质: (1) 温度的变化能显著的改变半导体的导电能力。当温度升高时,电阻率会降低。比如Si在200℃时电阻率比室温时的电阻率低几千倍。可以利用半导体的这个特性制成自动控制用的热敏组件(如热敏电阻等),但是由于半导体的这一特性,容易引起热不稳定性,在制作半导体器件时需要考虑器件自身产生的热量,需要考虑器件使用环境的温度等,考虑如何散热,否则将导致器件失效、报废。 (2) 半导体在受到外界光照的作用是导电能力大大提高。如硫化镉受到光照后导电能力可提高几十到几百倍,利用这一特点,可制成光敏三极管、光敏电阻等。 (3) 在纯净的半导体中加入微量(千万分之一)的其它元素(这个过程我们称为掺杂),可使他的导电能力提高百万倍。这是半导体的最初的特征。例如在原子密度为5*1022/cm3的硅中掺进大约5X1015/cm3磷原子,比例为10-7(即千万分之一),硅的导电能力提高了几十万倍。 物质是由原子构成的,而原子是由原子核和围绕它运动的电子组成的。电子很轻、很小,带负电,在一定的轨道上运转;原子核带正电,电荷量与电子的总电荷量相同,两者相互吸引。当原子的外层电子缺少后,整个原子呈现正电,缺少电子的地方产生一个空位,带正电,成为电洞。物体导电通常是由电子和电洞导电。 前面提到掺杂其它元素能改变半导体的导电能力,而参与导电的又分为电子和电洞,这样掺杂的元素(即杂质)可分为两种:施主杂质与受主杂质。 将施主杂质加到硅半导体中后,他与邻近的4个硅原子作用,产生许多自由电子参与导电,而杂质本身失去电子形成正离子,但不是电洞,不能接受电子。这时的半导体叫N型半导体。施主杂质主要为五族元素:锑、磷、砷等。 将施主杂质加到半导体中后,他与邻近的4个硅原子作用,产生许多电洞参与导电,这时的半导体叫p型半导体。受主杂质主要为三族元素:铝、镓、铟、硼等。 电洞和电子都是载子,在相同大小的电场作用下,电子导电的速度比电洞
半导体器件失效分析的研究Research on Semiconductor Device Failure Analysis
中文摘要 半导体失效分析在提高集成电路的可靠性方面有着至关重要的作用。随着集成度的提高,工艺尺寸的缩小,失效分析所面临的困难也逐步增大。因此,失效分析必须配备相应的先进、准确的设备和技术,配以具有专业半导体知识的分析人员,精确定位失效位置。在本文当中,着重介绍多种方法运用Photoemission 显微镜配合IR-OBIRCH精确定位失效位置,并辅以多项案例。 Photoemission是半导体元器件在不同状态下(二极管反向击穿、短路产生的电流、MOS管的饱和发光,等等),所产生的不同波长的光被捕获,从而在图像上产生相应的发光点。Photoemission在失效分析中有着不可或缺的作用,通过对好坏品所产生的发光点的对比,可以为后面的电路分析打下坚实的基础,而且在某些情况下,异常的发光点就是最后我们想要找到的defect的位置。 IR-OBIRCH(Infrared Optical beam Induced Resistance Change)主要是由两部分组成:激光加热器和电阻改变侦测器。电阻的改变是通过激光加热电流流经的路径时电流或者电压的变化来表现的,因此,在使用IR-OBIRCH时,前提是必须保证所加电压两端产生的电流路径要流过defect的位置,这样,在激光加热到defect位置时,由于电阻的改变才能产生电流的变化,从而在图像上显现出相应位置的热点。 虽然Photoemission和IR-OBIRCH可以很好的帮助我们找到defect的位置,但良好的电路分析以及微探针(microprobe)的使用在寻找失效路径方面是十分重要的,只有通过Photoemission的结果分析,加上电路分析以及微探针(micr oprobe)测量内部信号的波形以及I-V曲线,寻找出失效路径后,IR-OBIRCH才能更好的派上用场。因此,在失效分析中,各个步骤缺一不可。 关键词:失效分析;Photoemission;IR-OBIRCH;微探针(microprobe);
有机半导体材料 1 有机半导体材料的分子特征 有机半导体材料与传统半导体材料的区别不言自明,即有机半导体材料都是由有机分子组成的。有机半导体材料的分子中必须含有 键结构。如图1所示,在碳-碳双键结构中,两个碳原子的pz 轨道组成一对 轨道( 和 ),其成键轨道( )与反键轨道( )的能级差远小于两个 轨道之间的能级差。按照前线轨道理论, 轨道是最高填充轨道(HOMO), 是最低未填充轨道(LUMO)。在有机半导体的研究中,这两个轨道可以与无机半导体材料中的价带和导带类比。当HOMO 能级上的电子被激发到LUMO 能级上时,就会形成一对束缚在一起的空穴-电子对。有机半导体材料的电学和电子学性能正是由这些激发态的空穴和电子决定的。
在有机半导体材料分子里, 键结构会扩展到相邻的许多个原子上。根据分子结构单元的重复性,有机半导体材料可分为小分子型和高分子型两大类。 小分子型有机半导体材料的分子中没有呈链状交替存在的结构片断,通常只由一个比较大的 共轭体系构成。常见的小分子型有机半导体材料有并五苯、三苯基胺、富勒烯、酞菁、苝衍生物和花菁等(如图2),常见的高分子型有机半导体材料则主要包括聚乙炔型、聚芳环型和共聚物型几大类,其中聚芳环型又包括聚苯、聚噻吩、聚苯胺、聚吡咯等类型(如图3)。 事实上,由于有机分子的无限可修饰性,有机半导体材料的结构类型可以说是无穷无尽的。 图2: 几种常见的小分子有机半导体材料:(1)并五苯型,(2)三苯基胺类,(3)富勒烯,(4)酞菁,(5)苝衍生物和(6)花菁类。
图3: 几种常见的高分子有机半导体材料:(1)聚乙炔型,(2)聚芳环型,(3)共聚物型。 2 有机半导体材料中的载流子 我们知道无机半导体材料中的载流子只有电子和空穴两种,自由的电子和空穴分别在材料的导带和价带中传输。相形之下,有机半导体材料中的载流子构成则要复杂得多。 首先,由于能稳定存在的有机半导体材料的能隙(即LUMO 与HOMO 的能级差)通常较大,且电子亲和势较低,大多数有机半导体材料是p 型的,也就是说多数材料只能传导正电荷。无机半导体材料中的正电荷(即空穴)是高度离域、可以自由移动的,而有机半导体材料中的正电荷所代表的则是有机分子失去一个电子(通常是HOMO 能级上的电子)后呈现的氧化状态。因此,在有机半导体材料中引入一个正电荷,必然导致有机分子构型的改变。
9金属半导体与半导体异质结 一、肖特基势垒二极管 欧姆接触:通过金属-半导体的接触实现的连接。接触电阻很低。 金属与半导体接触时,在未接触时,半导体的费米能级高于金属的费米能级,接触后,半导体的电子流向金属,使得金属的费米能级上升。之间形成势垒为肖特基势垒。 在金属与半导体接触处,场强达到最大值,由于金属中场强为零,所以在金属——半导体结的金属区中存在表面负电荷。 影响肖特基势垒高度的非理想因素:肖特基效应的影响,即势垒的镜像力降低效应。金属中的电子镜像到半导体中的空穴使得半导体的费米能级程下降曲线。附图: 电流——电压关系:金属半导体结中的电流运输机制不同于pn结的少数载流子的扩散运动决定电流,而是取决于多数载流子通过热电子发射跃迁过内建电势差形成。附肖特基势垒二极管加反偏电压时的I-V曲线:反向电流随反偏电压增大而增大是由于势垒降低的影响。 肖特基势垒二极管与Pn结二极管的比较:1.反向饱和电流密度(同上),有效开启电压低于Pn结二极管的有效开启电压。2.开关特性肖特基二极管更好。应为肖特基二极管是一个多子导电器件,加正向偏压时不会产生扩散电容。从正偏到反偏时也不存在像Pn结器件的少数载流子存储效应。 二、金属-半导体的欧姆接触 附金属分别与N型p型半导体接触的能带示意图 三、异质结:两种不同的半导体形成一个结 小结:1.当在金属与半导体之间加一个正向电压时,半导体与金属之间的势垒高度降低,电子很容易从半导体流向金属,称为热电子发射。 2.肖特基二极管的反向饱和电流比pn结的大,因此达到相同电流时,肖特基二极管所需的反偏电压要低。 10双极型晶体管 双极型晶体管有三个掺杂不同的扩散区和两个Pn结,两个结很近所以之间可以互相作用。之所以成为双极型晶体管,是应为这种器件中包含电子和空穴两种极性不同的载流子运动。 一、工作原理 附npn型和pnp型的结构图 发射区掺杂浓度最高,集电区掺杂浓度最低 附常规npn截面图 造成实际结构复杂的原因是:1.各端点引线要做在表面上,为了降低半导体的电阻,必须要有重掺杂的N+型掩埋层。2.一片半导体材料上要做很多的双极型晶体管,各自必须隔离,应为不是所有的集电极都是同一个电位。 通常情况下,BE结是正偏的,BC结是反偏的。称为正向有源。附图: 由于发射结正偏,电子就从发射区越过发射结注入到基区。BC结反偏,所以在BC结边界,理想情况下少子电子浓度为零。 附基区中电子浓度示意图: 电子浓度梯度表明,从发射区注入的电子会越过基区扩散到BC结的空间电荷区,
一、半导体器件基本方程 1、半导体器件基本方程 泊松方程、电流密度方程、电子和空穴连续性方程的一维微分形式及其物理意义 2、基本方程的主要简化形式 泊松方程分别在N耗尽区和P耗尽区的简化形式 电流密度方程分别在忽略扩散电流和漂移电流时的简化形式 P型中性区电子净复合率、N型中性区空穴净复合率 P区电子和N区空穴的扩散方程及其定态形式 电子电流和空穴电流的电荷控制方程及其定态形式 注:第一章是整个课程的基础,直接考察的概率很小,一般都结合后面章节进行填空或者计算的考察,理解的基础上牢记各公式形式及其物理意义。 二、PN结 1、突变结与缓变结 理想突变结、理想线性缓变结、单边突变结的定义 2、PN结空间电荷区 理解空间电荷区的形成过程 注:自己用概括性的语句总结出来,可能考简述题。 3、耗尽近似与中性近似 耗尽近似、耗尽区、中性近似、中性区的概念 4、内建电场、耗尽区宽度、内建电势 内建电场、内建电势、约化浓度的概念 内建电场、耗尽区宽度、内建电势的推导 电场分布图的画法 内建电势的影响因素 Si和Ge内建电势的典型值 注:填空题可能考察一些物理概念的典型值,这部分内容主要掌握突变结的,可能考计算题,不会完全跟书上一样,会有变形,比如考察PIN结的相关计算;对于线性缓变结,只需记住结论公式即可。 5、外加电压下PN结中的载流子运动 正向电压下空穴扩散电流、电子扩散电流、势垒区复合电流的形成过程 反向电压下空穴扩散电流、电子扩散电流、势垒区产生电流的形成过程 正向电流很大反向电流很小的原因 6、PN结能带图 PN结分别在正向电压和反向电压下的能带图 注:所有作图题应力求完整,注意细节,标出所有图示需要的标识 7、PN结的少子分布 结定律:小注入下势垒区边界上的少子浓度表达式 少子浓度的边界条件 中性区内非平衡少子浓度分布公式 外加正反向电压时中性区中少子浓度分布图 注:书上给出了N区的推导,尽量自己推导一下P区的情况,加深理解 8、PN结的直流伏安特性
电子元器件失效分析技术与案例 费庆学 二站开始使用电子器件当时电子元器件的寿命20h. American from 1959 开始:1。可靠性评价,预估产品寿命 2。可靠性增长。不一定知道产品寿命,通过方法延长寿命。通过恶裂环境的试验。通过改进提高寿命。―――后来叫a.可靠性物理—实效分析的实例b.可靠数学 第一部分:电子元器件失效分析技术(方法) 1.失效分析的基本的概念和一般程序。 A 定义: 对电子元器件的失效的原因的诊断过程 b.目的:0000000 c.失效模式――》失效结果――》失效的表现形式――》通过电测的形式取得 d.失效机理:失效的物理化学根源 ――》失效的原因 1)开路的可能失效机理 日本的失效机理分类:变形变质外来异物 很多的芯片都有保护电路,保护电路很多都是由二极管组成正反向都不通为内部断开。 漏电和短路的可能的失效机理 接触面积越小,电流密度就大,就会发热,而烧毁 例:人造卫星的发射,因工人误操作装螺丝时掉了一个渣于继电器 局部缺陷导致电流易集中导入产生热击穿(si 和 al 互熔成为合金合金熔点更低) 塑封器件烘烤效果好当开封后特性变好,说明器件受潮或有杂质 失效机理 环境应力:温度温度过低易使焊锡脆化而导致焊点脱落。 , 2.失效机理的内容 I失效模式与环境应力的关系 任何产品都有一定的应力。
a当应力>强度就会失效 如过电/静电:外加电压超过产品本身的额定值会失效 b应力与时间应力虽没有超过额定值,但持续累计的发生 故:如何增强强度&减少应力能延长产品的寿命 c.一切正常,正常的应力,在时间的累计下,终止寿命 特性随时间存在变化 e机械应力如主板受热变形对零件的应力认为用力 塑封的抗振动好应力好陶瓷的差。 f重复应力如:冷热冲击是很好的零件筛选方法 重复应力易导致产品老化,存在不可靠性 故使用其器件:不要过载;温湿度要适当 II如何做失效分析 例:一个EPROM在使用后不能读写 1) 先不要相信委托人的话,一定要复判。 2) 快始失效分析: 取NG&OK品,DataSheet, 查找电源断地开始测试首先做待机电流测试(IV测试) 电源对地的待机电流下降 开封发现电源端线中间断(因为中间散热慢,两端散热快,有端子帮助散热)因为断开,相当于并联电阻少了一个电 阻,电流减小。 原因:闩锁效应应力大于产品本身强度 责任:确定失效责任方:模拟试验->测抗闩锁的能力 看触发的电流值(第一个拐点的电流值),越大越好,至少要大于datasheet或近似良品的值在标准范围内的。看维持电压(第二个拐点的电 压),若大于标准值,则很难回到原值。若多片良品抽测都OK, 说明使用者使用不当导致。 改善措施:改善供电,加保护电路。 III失效分析技术的延伸 失效分析的关键是打开样品 进货分析:不同的封装厂,在 芯片面积越小(扫描声学检测器,红的部分为空气,可用于辨别尺寸的大小),受应力越小。版本过新的产品也有可能存在可靠性问 题。可能存在设计的问题。 良品分析的作用:可以采取一层一层的分解拍照,找捷径
有机高分子半导体材料的导电与工作原理 及与硅基材料的比较 摘要: 本文从原理角度出发,对有机高分子半导体材料的导电模型与原理,有机高分子半导体材料器件的简要工作原理进行阐述,并将该材料的性能与硅基半导体材料相比较,最后对有机高分子半导体材料的发展提出自己的看法。 关键词:有机高分子半导体原理器件性能比较 1.背景: 随着无机半导体材料的发展、成熟与产业化,有机半导体材料以其种类多样性与巨大的应用潜力逐渐受到广泛关注。在有机电子领域的几项杰出成就,如1986年和1987年由Eastman Kodak 的Tang[4,5]等提出的有机光生伏打电池(OPVC)和有机发光二极管(OLED),为有机半导体的实际应用打下了基础。1986年有机场效应晶体管(OFET)也随之出现。与此同时,关于有机半导体的结构模型与导电原理的研究也成为了进一步解决其不足与优化其性能的基本出发点。高分子链紧束缚模型(SSH)的建立,高分子二聚现象的发现,1979年Su,Schrieffer与Heegerd对于孤子、极化子、双极化子等载流子概念的提出,激子在有机材料中的重新定位,跃迁机制对于迁移率的解释等,使人们对其基本规律有了一定程度的认识,并在积极地发展与完善。 2.有机高分子导体材料的分子结构与基本特征 有机高分子半导体,如聚乙炔,普遍存在共轭大π键结构,由成键π轨道与反键π*轨道构成。两者可分别相当于能带理论中的导带与价带,两个轨道之间的能级差称为带隙。许多高分子半导体的带隙处于1.5~3.0eV之间,处于可见光范围,十分合适作为太阳能电池。然而从整体来看,诸多较长的分子链通过范德华力相互纠缠在一起形成无序结构,一条分子链自身也有许多扭转变形,产生的结点破坏了共轭作用,由此关联的导电机制也更加复杂。 SSH模型认为,有机高分子固体可简化为具有一维特性的高分子弱耦合而成,并且电子在某一个碳原子附近时,将较紧地被该碳原子束缚而其他碳原子对其影响较小,及“紧束缚近似”,通过一系列计算描述晶格原子(碳原子)的移动和与电子的相互作用。之后又出现了修饰完善的TLM模型与PPP模型。一维体系Peierls不稳定性借助于SSH模型并通过计算说明,等距离排列的碳原子是不稳定的,碳原子将发生微小位移从而二聚化,使得有机高分子如聚乙炔分子中出现一定程度的单双键交替现象,这使得原来连续的能带分裂成导
半导体器件失效分析与检测 半导体元件的失效将直接影响相关产品的正常使用,文章主要就对半导体器件的失效原因进行了细致地分析并提出了几种检测的方法,供相关人士借鉴。 标签:半导体;器件;失效分析;检测 1 半导体器件失效分析 通过分析可知造成半导体器件失效的因素有很多,我们主要从几个方面进阐述。 1.1 金属化与器件失效 环境应力对半导体器件或集成电路可靠性的影响很大。金属化及其键合处就是一个不容忽视的失效源。迄今,大多数半导体器件平面工艺都采用二氧化硅作为掩膜钝化层。为在芯片上实现互连,往往在开窗口的二氧化硅层上淀积铝膜即金属化。 从物理、化学角度分析,金属化失效机理大体包括膜层张力、内聚力、机械疲劳、退火效应、杂质效应及电迁移等。 1.2 晶体缺陷与器件失效 晶体缺陷导致器件失效的机理十分复杂,有些问题至今尚不清楚。晶体缺陷分晶体材料固有缺陷(如微缺陷)和二次缺陷两类。后者是在器件制造过程中,由于氧化、扩散等热处理后出现或增殖的大量缺陷。两种缺陷或者彼此相互作用,都将导致器件性能的退化。二次击穿就是晶体缺陷招来的严重后果。 1.2.1 位错 这种缺陷有的是在晶体生长过程中形成的(原生位错),有的是在器件工艺中引入的(诱生位错)。位错易沿位错线加速扩散和析出,间接地促成器件劣化。事实证明,外表杂质原子(包括施主和受主)沿位错边缘的扩散比在完美晶体内快很多,其结果往往使P-N结的结平面不平整甚至穿通。鉴于位错具有“吸除效应”,对点缺陷如杂质原子、点阵空位、间隙原子等起到内部吸收的作用,故适量的位错反而对器件生产有利。 1.2.2 沉淀物 除位错造成不均匀掺杂外,外界杂质沾污也会带来严重后果,特别是重金属沾污,在半导体工艺中是经常发生的。如果这些金属杂质存在于固溶体内,其危害相对小一些;但是,一旦在P-N结处形成沉积物,则会产生严重失效,使反
半导体器件烧毁的物理机理* 余稳蔡新华黄文华刘国治 摘要叙述了半导体器件烧毁的物理机理、目前的研究进展及作者正在开展的工作. 关键词半导体器件,烧毁,高功率微波 MECHANISM OF BURNOUT OF SEMICONDUCTOR DEVICES Yu Wen Cai Xinhua (Institute of EM Theory, Changde Teachers' College,Hunan415000) Huang Wenhua Liu Guozhi (Northwest Institute of Nuclear Technology, Xi'an710024) Abstract The general mechanism of burnout of semiconductor devices is described,as well as recent progress and our present research. Key words semiconductor devices, burnout, high power microwave(HPM) 1前言 高功率微波(HPM)对电子系统进行破坏,可使系统暂时失灵或永久失效,这直接涉及系统内部电子元器件的暂时失灵或永久失效.因此要研究HPM对电子系统的破坏机理,首先要研究半导体器件烧毁的物理机理.另外,从系统的抗辐射能力和加固方面看,也需要对电子系统进行在电过应力(EOS)环境下的易损性评估.以下几个问题使得评估很困难:(1)对任意一个电子器件,很难得到精确的理论或实验失效阈值;(2)实际的EOS应力参数必须与用于理论或实验上确定失效阈值时使用的理想参数相比较,过度保守的估计将导致系统的超加固,增加不必要的成本,拖延进度,降低系统性能,而过高的估计则可使系统易损;(3)器件的复杂性问题[不同的制造过程、不同种类的器件(甚至同种器件间)有变化];(4)产生EOS的电磁环境问题[如电磁脉冲(EMP)、核电磁脉冲(NEMP)、光电磁脉冲(LEMP)、电磁干扰(EMI)、静电放电(ESD)、系统电磁脉冲(SGEMP)、微波(MW)等等];(5)同一批器件,数据变化也很大,不同一批器件和不同厂家的产品,数据变化就更大.因此,从理论上探讨器件烧毁的物理机理,找出大致规律,很有意义. 2器件烧毁的物理机理 半导体器件承受EOS测试时,将表现出很多失效物理机理[1],几乎器件的每一部分都有可能失效:(1)敷金属和引线能被熔化,电迁移能使金属膜导体变薄,甚至导致开路;(2)在器件的绝缘材料或氧化区或器件表面,可产生导致局部高温的电击穿;(3)在有源结区,可产生导致强流和高温的二次击穿. 根据研究,对双极型器件,90%的失效是由结区击穿引起的,敷金属失效仅占10%,但对MOS 器件,则63%的失效来源于敷金属失效,27%则属于氧化物击穿. 通常在局部温度升高到熔点时发生敷金属和引线失效,该热量来自于金属中的强流密度或金属附近的热硅(由其他地方的强流密度引起).敷金属失效将因线路分开(有点像保险丝烧毁)而导致开路.引起失效的强流可能来自于击穿或器件其他地方的失效,所以敷金属和引线失效可能只是一种结果而不是器件失效的原因.电迁移应用于强流密度情形下金属中的质量输运.最近,人们认为,对金属膜导体截面不够的半导体器件,电迁移可能是一种消耗失效模式,该失效将导致电路开路.当半导体或绝缘体两条蚀刻导电通道之间的电场超过中间介质击穿极限时,将因产生电弧形成熔融金属通道而使电路短路,器件线度越小,该失效机制越重要. PN结的表面条件将影响其电特性.依赖于表面条件的表面复合过程,对自由载流子来说像一个阱.强场表面击穿是表面损伤的原因之一.对半导体器件,该强场发生于靠近结区与表面的交界处.器件绝缘区失效主要是高压击穿(由材料中的强瞬间电场或硅材料附近热点的热损伤或机械损伤所致).半导体器件有源结区的失效通常来自于局部熔化及随后的硅再结晶,或来自于从结表面来的实际热注入,该热量由通过结的强流密度引起,反过来又导致热或电流二次击穿. 二次击穿模式有热模式和电流模式两种[2—4]. 随入射EOS功率不同而采取不同的模式,
題目:organic semiconductor materials 指導教授:郭豔光老師 班級:物四乙
學生:陳衍榮 學號:8522072 有機半導體材料 前言 早在1960年代初期,Pope等人在Anthracene之有機芳香族化合物晶體上入數百伏之跨壓下,發現存在電流流通與發光的現象,而啟開後人研究有機發光之大門。在後續的二十餘年間,因其元件特性距離實用仍有相當大的距離,因此仍專注在其相關的發光機制與電荷傳導等基礎研究。及至80年代末期,美國科達公司實驗室利用真空蒸鍍有機薄膜的技術和異質接面(heterojunction)多層有機膜(multilayer)之元件特性。諸如操作電壓<10V,量子效率>1﹪,與元件穩定性
等均已有大幅之改善,因而激增有機電激發光元件之實用性,也引發全球OEL之研究熱潮。另一方面則是在聚合物散料上的發展也令人囑目。Patridge在80年代初期便發表PVK材料(poly vinylcarbazole)亦具有機光導體之性質。此一發現,使得有機化合物在發光體上之應用更趨於廣泛。然而在1990年有機發光材料又有更進一步地發展。英國劍橋大學卡文迪實驗室(Calvendish Lab)發表第一個利用聚苯基乙烯(PPV, Poly p-phenylenevinylene)之共軛聚合物(conjugate polymer)製成的OEL元件。由於此類共軛聚合物具有類似半導體的特性與簡易的製程,從而激起對OEL元件的研究熱。而各種的研究材料,諸如摻雜發光的染料小分子或大分子之OEL元件,甚至在塑膠基板上可彎曲之OEL元件等均是被研究的主題。可見OEL之研究廣度與深度,而應用範圍也隨之更加寬廣。由於大部分OEL元件都具有類似二極體的特性,因此OEL又稱有有機發光二極體(OLED),而目前其最潛力之應用即在平面顯示器之發揮。以下圖一摘述OEL發展的簡史。
半导体器件失效分析_半导体器件芯片焊接技巧及控制 随着技术的发展,芯片的焊接(粘贴)技巧也越来越多并不断完善。半导体器件焊接(粘贴)失效主要与焊接面洁净度差、不平整、有氧化物、加热不当和基片镀层质量有关。树脂粘贴法还受粘料的组成结构及其有关的物理力学性能的制约和影响。要解决芯片微焊接不良问题,必须明白不同技巧的机理,逐一分析各种失效模式,及时发现影响焊接(粘贴)质量的不利因素,同时严格生产过程中的检验,加强工艺管理,才能有效地避免因芯片焊接不良对器件可靠性造成的潜在危害。 本文首先介绍了芯片焊接(粘贴)技巧及机理,其次介绍了失效模式分析,最后介绍了焊接质量的三种检验技巧以及焊接不良原因及对应措施,具体的跟随小编一起来了解一下。 芯片焊接(粘贴)技巧及机理芯片的焊接是指半导体芯片与载体(封装壳体或基片)形成牢固的、传导性或绝缘性连接的技巧。焊接层除了为器件提供机械连接和电连接外,还须为器件提供良好的散热通道。其技巧可分为树脂粘接法和金属合金焊接法。 树脂粘贴法是采用树脂粘合剂在芯片和封装体之间形成一层绝缘层或是在其中掺杂金属(如金或银)形成电和热的良导体。粘合剂大多采用环氧树脂。环氧树脂是稳定的线性聚合物,在加入固化剂后,环氧基打开形成羟基并交链,从而由线性聚合物交链成网状结构而固化成热固性塑料。其过程由液体或粘稠液→凝胶化→固体。固化的条件主要由固化剂种类的选择来决定。而其中掺杂的金属含量决定了其导电、导热性能的好坏。 掺银环氧粘贴法是当前最流行的芯片粘贴技巧之一,它所需的固化温度低,这能够避免热应力,但有银迁移的缺点。近年来应用于中小功率晶体管的金导电胶优于银导电胶。非导电性填料包括氧化铝、氧化铍和氧化镁,能够用来改善热导率。树脂粘贴法因其操作过程中载体不须加热,设备简单,易于实现工艺自动化操作且经济实惠而得到广泛应用,尤其在集成电路和小功率器件中应用更为广泛。树脂粘贴的器件热阻和电阻都很高。树脂在高温下简单分解,有可能发生填料的析出,在粘贴面上只留下一层树脂使该处电阻增大。因此它不适于要求在高温下工作或需低粘贴电阻的器件。另外,树脂粘贴法粘贴面的机械强
塑封器件是指用塑料等树脂类聚合物材料封装的半导体器件。由于树脂类材料固有的特点,限制了塑封器件在卫星、军事等一些高可靠性场合的使用[1]。虽然自20世纪70年代以来,封装 关键词:塑封器件热膨胀 1 引言 塑封器件是指用塑料等树脂类聚合物材料封装的半导体器件。由于树脂类材料固有的特点,限制了塑封器件在卫星、军事等一些高可靠性场合的使用[1]。虽然自20世纪70年代以来,封装材料、芯片钝化和生产工艺得到了极大的改进,塑封器件的可靠性也随之提高,但仍存在许多可靠性问题。这些可靠性问题大致可以分为:塑封材料固有的密封问题导致的腐蚀失效、爆米花失效等;生产工艺问题导致的芯片粘接缺陷、封装缺陷以及钝化层缺陷等[2];由于塑封材料与芯片之问的热膨胀系数(CTE)不匹配导致的低温/温冲失效。本文主要讨论最后一种缺陷。 2 CTE不匹配导致的失效及其机理分析 通常由元器件生产厂商提供的塑封器件对温度的要求不高,能满足如下3种温度范围的要求即可:0℃-70℃(商业温度)、-40℃~+85℃(工业温度)、-40℃~+125℃(汽车温度)。大量的失效案例表明[3],在以上3种温度范围内,器件失效的比例很高。对失效器件的分析表明,外界的温度冲击或低温环境造成的塑封材料对芯片的应力是主要机理。 2.1封装分层 在从室温到极端寒冷环境的温度循环过程中,模压复合物与基片或引线框之间的热膨胀系数(CTE)差异会造成分层和开裂。在极端低温下,由于与贮存温度和包封温度之间的差很大,可能会导致模压复合物与基片或引线框之间分层和开裂。并且,随着极端低温的下降,开裂的可能性还会随之增加(封装经过-55℃~+125℃的热循环时,引线框尖锐边缘处就会出现开 裂和分层)。另外,潮气会使低温下基片与封装材料界面上的分层加速。这种加速是由封装内凝结水汽的冻结所引起。 2.2对芯片的机械应力 由于塑封料和硅的线性热膨胀系数相差一个数量级(塑封料≈25×10-6℃-1,硅 ≈2.3×10-6℃-1,当温度变化时,它们的尺寸变化相差会较大。例如,对角线为1cm的芯片,温度每变化1℃,芯片对角线的长度可变化2.3×10-2μm;变化100℃,长度可变化2.3μm。而同样长度的塑封料每变化1℃,其长度将变化25×10-2μm;温度变化100℃,其长度将 变化25μm。如果塑封料与芯片表面是分离的,塑封料将会在芯片表面移动,它的最大位移量将会大于11.35μm。然而在一般情况下,塑封料是黏附在芯片表面的,它不可能在芯片表面移动(但存在这种趋势)。于是,在芯片和塑封料界面就会存在剪切应力。这个力可能会使芯片上附着力弱的金属化层产生滑移(温度升高,向芯片边缘滑移;温度降低,向芯片中