
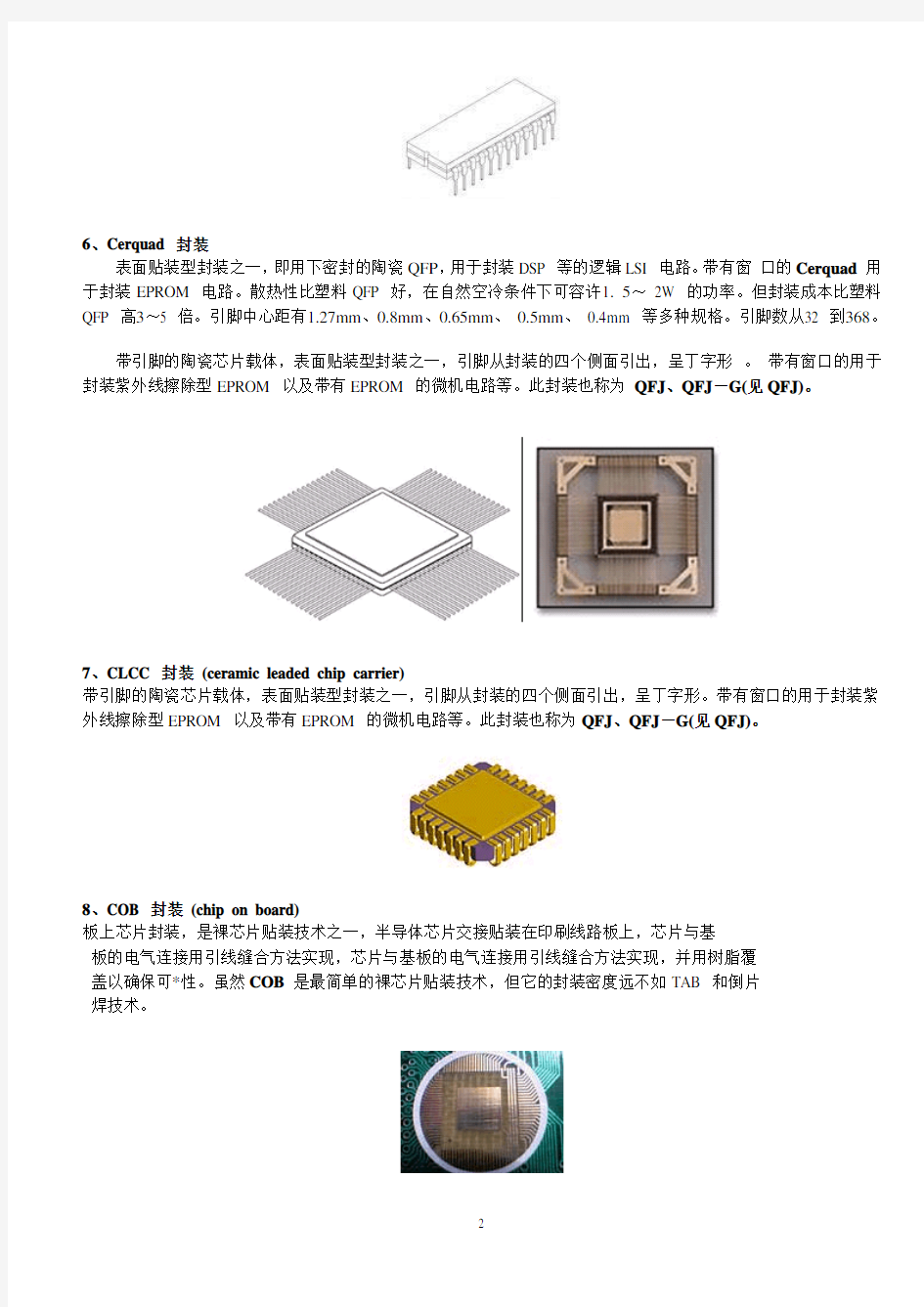
常用电子元件封装介绍
1、BGA 封装(ball grid array)
球形触点陈列,表面贴装型封装之一。在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI 芯片,然后用模压树脂或灌封方法进行密封。也称为凸点陈列载体(PAC)。引脚可超过200,是多引脚LSI 用的一种封装。封装本体也可做得比QFP(四侧引脚扁平封装)小。例如,引脚中心距为1.5mm 的360 引脚BGA 仅为31mm 见方;而引脚中心距为0.5mm 的304 引脚QFP 为40mm 见方。而且BGA 不用担心QFP 那样的引脚变形问题。该封装是美国Motorola 公司开发的,首先在便携式电话等设备中被采用,今后在美国有可能在个人计算机中普及。最初,BGA的引脚(凸点)中心距为1.5mm,引脚数为225。现在也有一些LSI 厂家正在开发500 引脚的BGA。BGA 的问题是回流焊后的外观检查。现在尚不清楚是否有效的外观检查方法。有的认为,由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。美国Motorola 公司把用模压树脂密封的封装称为OMPAC,而把灌封方法密封的封装称为GPAC(见OMPAC 和GPAC)。
2、BQFP 封装(quad flat package with bumper)
带缓冲垫的四侧引脚扁平封装。QFP封装之一,在封装本体的四个角设置突起(缓冲垫) 以防止在运送过程中引脚发生弯曲变形。美国半导体厂家主要在微处理器和ASIC 等电路中采用此封装。引脚中心距0.635mm,引脚数从84 到196 左右(见QFP)。
3、碰焊PGA 封装(butt joint pin grid array)
表面贴装型PGA的别称(见表面贴装型PGA)。
4、C-(ceramic) 封装
表示陶瓷封装的记号。例如,CDIP表示的是陶瓷DIP。是在实际中经常使用的记号。
5、Cerdip 封装
用玻璃密封的陶瓷双列直插式封装,用于ECL RAM,DSP(数字信号处理器)等电路。带有玻璃窗口的Cerdip 用于紫外线擦除型EPROM 以及内部带有EPROM 的微机电路等。引脚中心距2.54mm,引脚数从8 到42。在
6、Cerquad 封装
表面贴装型封装之一,即用下密封的陶瓷QFP,用于封装DSP 等的逻辑LSI 电路。带有窗口的Cerquad用于封装EPROM 电路。散热性比塑料QFP 好,在自然空冷条件下可容许1. 5~2W 的功率。但封装成本比塑料QFP 高3~5 倍。引脚中心距有1.27mm、0.8mm、0.65mm、0.5mm、0.4mm 等多种规格。引脚数从32 到368。
带引脚的陶瓷芯片载体,表面贴装型封装之一,引脚从封装的四个侧面引出,呈丁字形。带有窗口的用于封装紫外线擦除型EPROM 以及带有EPROM 的微机电路等。此封装也称为QFJ、QFJ-G(见QFJ)。
7、CLCC 封装(ceramic leaded chip carrier)
带引脚的陶瓷芯片载体,表面贴装型封装之一,引脚从封装的四个侧面引出,呈丁字形。带有窗口的用于封装紫外线擦除型EPROM 以及带有EPROM 的微机电路等。此封装也称为QFJ、QFJ-G(见QFJ)。
8、COB 封装(chip on board)
板上芯片封装,是裸芯片贴装技术之一,半导体芯片交接贴装在印刷线路板上,芯片与基
板的电气连接用引线缝合方法实现,芯片与基板的电气连接用引线缝合方法实现,并用树脂覆
盖以确保可*性。虽然COB是最简单的裸芯片贴装技术,但它的封装密度远不如TAB 和倒片
焊技术。
9、DFP(dual flat package)
双侧引脚扁平封装。是SOP 的别称(见SOP)。以前曾有此称法,现在已基本上不用。
10、DIC(dual in-line ceramic package)
陶瓷DIP(含玻璃密封)的别称(见DIP).
11、DIL(dual in-line)
DIP的别称(见DIP)。欧洲半导体厂家多用此名称。
12、DIP(dual in-line package)
双列直插式封装。插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。
DIP 是最普及的插装型封装,应用范围包括标准逻辑IC,存贮器LSI,微机电路等。
引脚中心距2.54mm,引脚数从6 到64。封装宽度通常为15.2mm。有的把宽度为7.52mm和10.16mm 的封装分别称为skinny DIP和slim DIP(窄体型DIP)。但多数情况下并不加区分,只简单地统称为DIP。另外,用低熔点玻璃密封的陶瓷DIP也称为cerdip(见cerdip)。
13、DSO(dual small out-lint)
双侧引脚小外形封装。SOP的别称(见SOP)。部分半导体厂家采用此名称。
14、DICP(dual tape carrier package)
双侧引脚带载封装。TCP(带载封装)之一。引脚制作在绝缘带上并从封装两侧引出。由于利用的是TAB(自动带载焊接)技术,封装外形非常薄。常用于液晶显示驱动LSI,但多数为定制品。另外,0.5mm 厚的存储器LSI 簿形封装正处于开发阶段。在日本,按照EIAJ(日本电子机械工业)会标准规定,将DICP命名为DTP。
15、DIP(dual tape carrier package)
同上。日本电子机械工业会标准对DTCP的命名(见DTCP)。
16、FP(flat package)
扁平封装。表面贴装型封装之一。QFP或SOP(见QFP 和SOP)的别称。部分半导体厂家采用此名称。
17、Flip-chip
倒焊芯片。裸芯片封装技术之一,在LSI 芯片的电极区制作好金属凸点,然后把金属凸点与印刷基板上的电极区进行压焊连接。封装的占有面积基本上与芯片尺寸相同。是所有封装技术中体积最小、最薄的一种。
但如果基板的热膨胀系数与LSI 芯片不同,就会在接合处产生反应,从而影响连接的可靠性。因此必须用树脂来加固LSI 芯片,并使用热膨胀系数基本相同的基板材料。
其中SiS 756北桥芯片采用最新的Flip-chip封装,全面支持AMD Athlon 64/FX中央处理器。支持PCI Express X16接口,提供显卡最高8GB/s双向传输带宽。支持最高HyperTransport Technology,最高2000MT/s MHz的传输带宽。内建矽统科技独家Advanced HyperStreaming Technology,MuTIOL 1G Technology。
18、FQFP(fine pitch quad flat package)
小引脚中心距QFP。通常指引脚中心距小于0.65mm 的QFP(见QFP)。部分导导体厂家采用此名称。塑料四边引出扁平封装PQFP(Plastic Quad Flat Package)
PQFP的封装形式最为普遍。其芯片引脚之间距离很小,引脚很细,很多大规模或超大集成电路都采用这种封装形式,引脚数量一般都在100个以上。Intel系列CPU中80286、80386和某些486主板芯片采用这种封装形式。此种封装形式的芯片必须采用SMT技术(表面安装设备)将芯片与电路板焊接起来。采用SMT技术安装的芯片不必在电路板上打孔,一般在电路板表面上有设计好的相应引脚的焊点。将芯片各脚对准相应的焊点,即可实现与主板的焊接。用这种方法焊上去的芯片,如果不用专用工具是很难拆卸下来的。SMT技术也被广泛的使用在芯片焊接领域,此后很多高级的封装技术都需要使用SMT焊接。
以下是一颗AMD的QFP封装的286处理器芯片。0.5mm焊区中心距,208根I/O引脚,外形尺寸28×28mm,芯片尺寸10×10mm,则芯片面积/封装面积=10×10/28×28=1:7.8,由此可见QFP比DIP的封装尺寸大大减小了。
PQFP封装的主板声卡芯片
19、CPAC(globe top pad array carrier)
美国Motorola 公司对BGA的别称(见BGA)。
20、CQFP 軍用晶片陶瓷平版封裝(Ceramic Quad Flat-pack Package)
右邊這顆晶片為一種軍用晶片封裝(CQFP),這是封裝還沒被放入晶體以前的樣子。這種封裝在軍用品以及航太工業用晶片才有機會見到。晶片槽旁邊有厚厚的黃金隔層(有高起來,照片上不明顯)用來防止輻射及其他干擾。外圍有螺絲孔可以將晶片牢牢固定在主機板上。而最有趣的就是四周的鍍金針腳,這種設計可以大大減少晶片封裝的厚度並提供極佳的散熱。
21、H-(with heat sink)
表示带散热器的标记。例如,HSOP表示带散热器的SOP。
22、Pin Grid Array(Surface Mount Type)
表面贴装型PGA。通常PGA为插装型封装,引脚长约3.4mm。表面贴装型PGA 在封装的
底面有陈列状的引脚,其长度从1.5mm 到2.0mm。贴装采用与印刷基板碰焊的方法,因而也称
为碰焊PGA。因为引脚中心距只有1.27mm,比插装型PGA 小一半,所以封装本体可制作得不
怎么大,而引脚数比插装型多(250~528),是大规模逻辑LSI 用的封装。封装的基材有多层陶
瓷基板和玻璃环氧树脂印刷基数。以多层陶瓷基材制作封装已经实用化。
PGA封装威刚迷你DDR333本内存
23、JLCC 封装(J-leaded chip carrier)
J 形引脚芯片载体。指带窗口CLCC和带窗口的陶瓷QFJ的别称(见CLCC 和QFJ)。部分半导体厂家采用的名称。
24、LCC 封装(Leadless chip carrier)
无引脚芯片载体。指陶瓷基板的四个侧面只有电极接触而无引脚的表面贴装型封装。是高速和高频IC 用封装,也称为陶瓷QFN或QFN-C(见QFN)。
25、LGA 封装(land grid array)
触点陈列封装。即在底面制作有阵列状态坦电极触点的封装。装配时插入插座即可。现已实用的有227 触点(1.27mm 中心距)和447 触点(2.54mm 中心距)的陶瓷LGA,应用于高速逻辑LSI 电路。
LGA与QFP相比,能够以比较小的封装容纳更多的输入输出引脚。另外,由于引线的阻抗小,对于高速LSI 是很适用的。但由于插座制作复杂,成本高,现在基本上不怎么使用。预计今后对其需求会有所增加。
AMD的2.66GHz双核心的Opteron F的Santa Rosa平台
26、LOC 封装(lead on chip)
芯片上引线封装。LSI 封装技术之一,引线框架的前端处于芯片上方的一种结构,芯片的中心附近制作有凸焊点,用引线缝合进行电气连接。与原来把引线框架布置在芯片侧面附近的结构相比,在相同大小的封装中容纳的芯片达1mm 左右宽度。
27、LQFP 封装(low profile quad flat package)
薄型QFP。指封装本体厚度为1.4mm 的QFP,是日本电子机械工业会根据制定的新QFP
外形规格所用的名称。
28、L-QUAD封装
陶瓷QFP之一。封装基板用氮化铝,基导热率比氧化铝高7~8 倍,具有较好的散热性。
封装的框架用氧化铝,芯片用灌封法密封,从而抑制了成本。是为逻辑LSI 开发的一种封装,在自然空冷条件下可容许W3的功率。现已开发出了208 引脚(0.5mm 中心距)和160 引脚(0.65mm中心距)的LSI 逻辑用封
装,并于1993 年10 月开始投入批量生产。
29、MCM封装(multi-chip module)
多芯片组件。将多块半导体裸芯片组装在一块布线基板上的一种封装。
根据基板材料可分
为MCM-L,MCM-C和MCM-D三大类。
MCM-L是使用通常的玻璃环氧树脂多层印刷基板的组件。布线密度不怎么高,成本较低。
MCM-C是用厚膜技术形成多层布线,以陶瓷(氧化铝或玻璃陶瓷)作为基板的组件,与使
用多层陶瓷基板的厚膜混合IC 类似。两者无明显差别。布线密度高于MCM-L。
MCM-D是用薄膜技术形成多层布线,以陶瓷(氧化铝或氮化铝)或Si、Al 作为基板的组件。
布线密谋在三种组件中是最高的,但成本也高。
由于博客中有专门文章介绍此封装,本人就不在做详细讲解。如有需要请看:
30、MFP 封装( mini flat package)
小形扁平封装。塑料SOP或SSOP的别称(见SOP和SSOP)。部分半导体厂家采用的名称。
31、MQFP 封装(metric quad flat package)
按照JEDEC(美国联合电子设备委员会)标准对QFP进行的一种分类。指引脚中心距为0.65mm、本体厚度为3.8mm~2.0mm 的标准QFP(见QFP)。
32、MQUAD 封装(metal quad)
美国Olin 公司开发的一种QFP封装。基板与封盖均采用铝材,用粘合剂密封。在自然空冷条件下可容许2.5W~2.8W 的功率。日本新光电气工业公司于1993 年获得特许开始生产。
33、MSP 封装(mini square package)
QFI 的别称(见QFI),在开发初期多称为MSP。QFI 是日本电子机械工业会规定的名称。
34、OPMAC 封装(over molded pad array carrier)
模压树脂密封凸点陈列载体。美国Motorola公司对模压树脂密封BGA采用的名称(见BGA)。
35、P-(plastic)封装
表示塑料封装的记号。如PDIP表示塑料DIP。
36、PAC 封装(pad array carrier)
凸点陈列载体,BGA的别称(见BGA)。
37、PCLP(printed circuit board leadless package)
印刷电路板无引线封装。日本富士通公司对塑料QFN(塑料LCC)采用的名称(见QFN)。引脚中心距有0.55mm 和0.4mm 两种规格。目前正处于开发阶段。
38、PFPF(plastic flat package)
塑料扁平封装。塑料QFP的别称(见QFP)。部分LSI 厂家采用的名称。
39、PGA(pin grid array)
陈列引脚封装。插装型封装之一,其底面的垂直引脚呈陈列状排列。封装基材基本上都采用多层陶瓷基板。在未专门表示出材料名称的情况下,多数为陶瓷PGA,用于高速大规模逻辑LSI 电路。成本较高。引脚中心距通常为2.54mm,引脚数从64 到447 左右。了为降低成本,封装基材可用玻璃环氧树脂印刷基板代替。也有64~256 引脚的塑料PGA。另外,还有一种引脚中心距为1.27mm 的短引脚表面贴装型PGA(碰焊PGA)。(见表面贴装型PGA)。
40、Piggy Back
驮载封装。指配有插座的陶瓷封装,形关与DIP、QFP、QFN 相似。在开发带有微机的设备时用于评价程序确认操作。例如,将EPROM插入插座进行调试。这种封装基本上都是定制品,市场上不怎么流通。
41、PLCC(plastic leaded chip carrier)
带引线的塑料芯片载体。表面贴装型封装之一。引脚从封装的四个侧面引出,呈丁字形,是塑料制品。美国德克萨斯仪器公司首先在64k 位DRAM和256kDRAM 中采用,现在已经普及用于逻辑LSI、DLD(或程逻辑器件)等电路。引脚中心距1.27mm,引脚数从18 到84。J 形引脚不易变形,比QFP容易操作,但焊接后的外观检查较为困难。PLCC与LCC(也称QFN)相似。以前,两者的区别仅在于前者用塑料,后者用陶瓷。但现在已经出现用陶瓷制作的J 形引脚封装和用塑料制作的无引脚封装(标记为塑料LCC、PCLP、P-LCC等),已经无法分辨。为此,日本电子机械工业会于1988 年决定,把从四侧引出J 形引脚的封装称为QFJ,把在四侧带有电极凸点的封装称为QFN(见QFJ 和QFN)。
42、P-LCC(plastic teadless chip carrier)(plastic leaded chip currier)
有时候是塑料QFJ的别称,有时候是QFN(塑料LCC)的别称(见QFJ 和QFN)。部分LSI 厂家用PLCC 表示带引线封装,用P-LCC 表示无引线封装,以示区别。
43、QFH(quad flat high package)
四侧引脚厚体扁平封装。塑料QFP 的一种,为了防止封装本体断裂,QFP 本体制作得
较厚(见QFP)。部分半导体厂家采用的名称。
44、QFI(quad flat I-leaded packgac)
四侧I 形引脚扁平封装。表面贴装型封装之一。引脚从封装四个侧面引出,向下呈I 字。
也称为MSP(见MSP)。贴装与印刷基板进行碰焊连接。由于引脚无突出部分,贴装占有面积小
于QFP。
日立制作所为视频模拟IC 开发并使用了这种封装。此外,日本的Motorola 公司的PLL IC
四侧J 形引脚扁平封装。表面贴装封装之一。引脚从封装四个侧面引出,向下呈J 字形。
是日本电子机械工业会规定的名称。引脚中心距1.27mm。
材料有塑料和陶瓷两种。塑料QFJ 多数情况称为PLCC(见PLCC),用于微机、门陈列、
DRAM、ASSP、OTP 等电路。引脚数从18 至84。
陶瓷QFJ 也称为CLCC、JLCC(见CLCC)。带窗口的封装用于紫外线擦除型EPROM 以及
带有EPROM 的微机芯片电路。引脚数从32 至84。
46、QFN(quad flat non-leaded package)
四侧无引脚扁平封装。表面贴装型封装之一。现在多称为LCC。QFN 是日本电子机械工业
会规定的名称。封装四侧配置有电极触点,由于无引脚,贴装占有面积比QFP 小,高度比QFP
低。但是,当印刷基板与封装之间产生应力时,在电极接触处就不能得到缓解。因此电极触点
难于作到QFP 的引脚那样多,一般从14 到100 左右。
材料有陶瓷和塑料两种。当有LCC 标记时基本上都是陶瓷QFN。电极触点中心距1.27mm。
塑料QFN 是以玻璃环氧树脂印刷基板基材的一种低成本封装。电极触点中心距除1.27mm 外,
还有0.65mm 和0.5mm 两种。这种封装也称为塑料LCC、PCLC、P-LCC 等。
47、QFP(quad flat package)
四侧引脚扁平封装。表面贴装型封装之一,引脚从四个侧面引出呈海鸥翼(L)型。基材有陶瓷、金属和塑料三种。从数量上看,塑料封装占绝大部分。当没有特别表示出材料时,多数情况为塑料QFP。塑料QFP 是最普及的多引脚LSI 封装。不仅用于微处理器,门陈列等数字逻辑LSI 电路,而且也用于VTR 信号处理、音响信号处理等模拟LSI 电路。引脚中心距有1.0mm、0.8mm、0.65mm、0.5mm、0.4mm、0.3mm 等多种规格。0.65mm 中心距规格中最多引脚数为304。日本将引脚中心距小于0.65mm 的QFP 称为QFP(FP)。但现在日本电子机械工业会对QFP的外形规格进行了重新评价。在引脚中心距上不加区别,而是根据封装本体厚度分为QFP(2.0mm~3.6mm 厚)、LQFP(1.4mm 厚)和TQFP(1.0mm 厚)三种。
另外,有的LSI 厂家把引脚中心距为0.5mm 的QFP 专门称为收缩型QFP 或SQFP、VQFP。但有的厂家把引脚中心距为0.65mm 及0.4mm 的QFP 也称为SQFP,至使名称稍有一些混乱。
QFP 的缺点是,当引脚中心距小于0.65mm 时,引脚容易弯曲。为了防止引脚变形,现已出现了几种改进的QFP 品种。如封装的四个角带有树指缓冲垫的BQFP(见BQFP);带树脂保护环覆盖引脚前端的GQFP(见GQFP);在封装本体里设置测试凸点、放在防止引脚变形的专用夹具里就可进行测试的TPQFP(见TPQFP)。在逻辑LSI 方面,不少开发品和高可*品都封装在多层陶瓷QFP 里。引脚中心距最小为
0.4mm、引脚数最多为348 的产品也已问世。此外,也有用玻璃密封的陶瓷QFP(见Gerqad)。
48、QFP(FP)(QFP fine pitch)
小中心距QFP。日本电子机械工业会标准所规定的名称。指引脚中心距为0.55mm、0.4mm、
0.3mm 等小于0.65mm 的QFP(见QFP)。
49、QIC(quad in-line ceramic package)
陶瓷QFP 的别称。部分半导体厂家采用的名称(见QFP、Cerquad)。
50、QIP(quad in-line plastic package)
塑料QFP 的别称。部分半导体厂家采用的名称(见QFP)。
51、QTCP(quad tape carrier package)
四侧引脚带载封装。TCP 封装之一,在绝缘带上形成引脚并从封装四个侧面引出。是利用TAB 技术的薄型封装(见TAB、TCP)。
四侧引脚带载封装。日本电子机械工业会于1993 年4 月对QTCP 所制定的外形规格所用的名称(见TCP)。
53、QUIL(quad in-line)
QUIP 的别称(见QUIP)。
54、QUIP(quad in-line package)
四列引脚直插式封装。引脚从封装两个侧面引出,每隔一根交错向下弯曲成四列。引脚中心距1.27mm,当插入印刷基板时,插入中心距就变成2.5mm。因此可用于标准印刷线路板。是比标准DIP 更小的一种封装。日本电气公司在台式计算机和家电产品等的微机芯片中采用了些种封装。材料有陶瓷和塑料两种。引脚数64。
55、SDIP (shrink dual in-line package)
收缩型DIP。插装型封装之一,形状与DIP 相同,但引脚中心距(1.778mm)小于DIP(2.54mm),因而得此称呼。引脚数从14 到90。也有称为SH-DIP 的。材料有陶瓷和塑料两种。
56、SH-DIP(shrink dual in-line package)
同SDIP。部分半导体厂家采用的名称。
57、SIL(single in-line)
SIP 的别称(见SIP)。欧洲半导体厂家多采用SIL 这个名称。
58、SIMM(single in-line memory module)
单列存贮器组件。只在印刷基板的一个侧面附近配有电极的存贮器组件。通常指插入插座的组件。标准SIMM 有中心距为2.54mm 的30 电极和中心距为1.27mm 的72 电极两种规格。在印刷基板的单面或双面装有用SOJ 封装的1 兆位及4 兆位DRAM 的SIMM 已经在个人计算机、工作站等设备中获得广泛应用。至少有30~40%的DRAM 都装配在SIMM 里。
59、SIP(single in-line package)
单列直插式封装。引脚从封装一个侧面引出,排列成一条直线。当装配到印刷基板上时封装呈侧立状。引脚中心距通常为2.54mm,引脚数从2 至23,多数为定制产品。封装的形状各异。也有的把形状与ZIP 相同的封装称为SIP。
60、SK-DIP(skinny dual in-line package)
DIP 的一种。指宽度为7.62mm、引脚中心距为2.54mm 的窄体DIP。通常统称为DIP(见DIP)。
61、SL-DIP(slim dual in-line package)
DIP 的一种。指宽度为10.16mm,引脚中心距为2.54mm 的窄体DIP。通常统称为DIP。
62、SMD(surface mount devices)
表面贴装器件。偶而,有的半导体厂家把SOP 归为SMD(见SOP)。
63、SO(small out-line)
SOP 的别称。世界上很多半导体厂家都采用此别称。(见SOP)。
64、SOI(small out-line I-leaded package)
I 形引脚小外型封装。表面贴装型封装之一。引脚从封装双侧引出向下呈I 字形,中心距1.27mm。贴装占有面积小于SOP。日立公司在模拟IC(电机驱动用IC)中采用了此封装。引脚数26。
65、SOIC(small out-line integrated circuit)
SOP 的别称(见SOP)。国外有许多半导体厂家采用此名称。
66、SOJ(Small Out-Line J-Leaded Package)
J 形引脚小外型封装。表面贴装型封装之一。引脚从封装两侧引出向下呈J 字形,故此得名。通常为塑料制品,多数用于DRAM 和SRAM 等存储器LSI 电路,但绝大部分是DRAM。用SOJ封装的DRAM 器件很多都装配在SIMM 上。引脚中心距1.27mm,引脚数从20 至40(见SIMM)。
67、SQL(Small Out-Line L-leaded package)
按照JEDEC(美国联合电子设备工程委员会)标准对SOP 所采用的名称(见SOP)。
68、SONF(Small Out-Line Non-Fin)
无散热片的SOP。与通常的SOP 相同。为了在功率IC 封装中表示无散热片的区别,有意增添了NF(non-fin)标记。部分半导体厂家采用的名称(见SOP)。
69、SOF(small Out-Line package)
小外形封装。表面贴装型封装之一,引脚从封装两侧引出呈海鸥翼状(L 字形)。材料有塑料和陶瓷两种。另外也叫SOL 和DFP。SOP 除了用于存储器LSI 外,也广泛用于规模不太大的ASSP 等电路。在输入输出端子不超过10~40 的领域,SOP 是普及最广的表面贴装封装。引脚中心距1.27mm,引脚数从8~44。另外,引脚中心距小于1.27mm 的SOP 也称为SSOP;装配高度不到1.27mm 的SOP 也称为TSOP(见SSOP、TSOP)。还有一种带有散热片的SOP。
70、SOW (Small Outline Package(Wide-Jype))
宽体SOP。部分半导体厂家采用的名称。
BGA(Ball Grid Array):球栅阵列,面阵列封装的一种。
QFP(Quad Flat Package):方形扁平封装。
PLCC(Plastic Leaded Chip Carrier):有引线塑料芯片栽体。
DIP(Dual In-line Package):双列直插封装。
SIP(Single inline Package):单列直插封装
SOP(Small Out-Line Package):小外形封装。
SOJ(Small Out-Line J-Leaded Package):J形引线小外形封装。
COB(Chip on Board):板上芯片封装。
Flip-Chip:倒装焊芯片。
片式元件(CHIP):片式元件主要为片式电阻、片式电容、片式电感等无源元件。根据引脚的不同,有全端子元件(即元件引线端子覆盖整个元件端)和非全端子元件,一般的普通片式电阻、电容为全端子元件,而像钽电容之类则为非全端子元件。
THT(Through Hole Technology):通孔插装技术
SMT(Surface Mount Technology):表面安装技术
一.DIP双列直插式封装
DIP(DualIn-line Package)是指采用双列直插形式封装的集成电路芯片,绝大多数中小规模集成电路(IC)均采用这种封装形式,其引脚数一般不超过100个。采用DIP封装的CPU芯片有两排引脚,需要插入到具有DIP结构的芯片插座上。当然,也可以直接插在有相同焊孔数和几何排列的电路板上进行焊接。DIP封装的芯片在从芯片插座上插拔时应特别小心,以免损坏引脚。
DIP封装具有以下特点:
2.芯片面积与封装面积之间的比值较大,故体积也较大。
Intel系列CPU中8088就采用这种封装形式,缓存(Cache)和早期的内存芯片也是这种封装形式。
二.QFP塑料方型扁平式封装和PFP塑料扁平组件式封装PQFP(Plastic Quad Flat Package)
封装的芯片引脚之间距离很小,管脚很细,一般大规模或超大型集成电路都采用这种封装形式,其引脚数一般在100个以上。用这种形式封装的芯片必须采用SMD(表面安装设备技术)将芯片与主板焊接起来。采用SMD 安装的芯片不必在主板上打孔,一般在主板表面上有设计好的相应管脚的焊点。将芯片各脚对准相应的焊点,即可实现与主板的焊接。用这种方法焊上去的芯片,如果不用专用工具是很难拆卸下来的。
PFP(Plastic Flat Package)方式封装的芯片与QFP方式基本相同。唯一的区别是QFP一般为正方形,而PFP 既可以是正方形,也可以是长方形。
QFP/PFP封装具有以下特点:
1.适用于SMD表面安装技术在PCB电路板上安装布线。
2.适合高频使用。
3.操作方便,可靠性高。
4.芯片面积与封装面积之间的比值较小。
Intel系列CPU中80286、80386和某些486主板采用这种封装形式。
三.PGA插针网格阵列封装
PGA(Pin Grid Array Package)芯片封装形式在芯片的内外有多个方阵形的插针,每个方阵形插针沿芯片的四周间隔一定距离排列。根据引脚数目的多少,可以围成2-5圈。安装时,将芯片插入专门的PGA插座。为使CPU能够更方便地安装和拆卸,从486芯片开始,出现一种名为ZIF的CPU插座,专门用来满足PGA封装的CPU在安装和拆卸上的要求。
ZIF(Zero Insertion Force Socket)是指零插拔力的插座。把这种插座上的扳手轻轻抬起,CPU就可很容易、轻松地插入插座中。然后将扳手压回原处,利用插座本身的特殊结构生成的挤压力,将CPU的引脚与插座牢牢地接触,绝对不存在接触不良的问题。而拆卸CPU芯片只需将插座的扳手轻轻抬起,则压力解除,CPU芯片即可轻松取出。
PGA封装具有以下特点:
1.插拔操作更方便,可靠性高。
2.可适应更高的频率。
Intel系列CPU中,80486和Pentium、Pentium Pro均采用这种封装形式。
四.BGA球栅阵列封装
随着集成电路技术的发展,对集成电路的封装要求更加严格。这是因为封装技术关系到产品的功能性,当IC 的频率超过100MHz时,传统封装方式可能会产生所谓的“CrossTalk”现象,而且当IC的管脚数大于208 Pin时,传统的封装方式有其困难度。因此,除使用QFP封装方式外,现今大多数的高脚数芯片(如图形芯片与芯片组等)皆转而使用BGA(Ball Grid Array Package)封装技术。BGA一出现便成为CPU、主板上南/北桥芯片等高密度、高性能、多引脚封装的最佳选择。
BGA封装技术又可详分为五大类:
1.PBGA(Plasric BGA)基板:一般为2-4层有机材料构成的多层板。Intel系列CPU中,Pentium II、III、IV 处理器均采用这种封装形式。
2.CBGA(CeramicBGA)基板:即陶瓷基板,芯片与基板间的电气连接通常采用倒装芯片(FlipChip,简称
3.FCBGA(FilpChipBGA)基板:硬质多层基板。
4.TBGA(TapeBGA)基板:基板为带状软质的1-2层PCB电路板。
5.CDPBGA(Carity Down PBGA)基板:指封装中央有方型低陷的芯片区(又称空腔区)。
BGA封装具有以下特点:
1.I/O引脚数虽然增多,但引脚之间的距离远大于QFP封装方式,提高了成品率。
2.虽然BGA的功耗增加,但由于采用的是可控塌陷芯片法焊接,从而可以改善电热性能。
3.信号传输延迟小,适应频率大大提高。
4.组装可用共面焊接,可靠性大大提高。
BGA封装方式经过十多年的发展已经进入实用化阶段。1987年,***西铁城(Citizen)公司开始着手研制塑封球栅面阵列封装的芯片(即BGA)。而后,摩托罗拉、康柏等公司也随即加入到开发BGA的行列。1993年,摩托罗拉率先将BGA应用于移动电话。同年,康柏公司也在工作站、PC电脑上加以应用。直到五六年前,Intel公司在电脑CPU中(即奔腾II、奔腾III、奔腾IV等),以及芯片组(如i850)中开始使用BGA,这对BGA应用领域扩展发挥了推波助澜的作用。目前,BGA已成为极其热门的IC封装技术,其全球市场规模在2000年为12亿块,预计2005年市场需求将比2000年有70%以上幅度的增长。
五.CSP芯片尺寸封装
随着全球电子产品个性化、轻巧化的需求蔚为风潮,封装技术已进步到CSP(Chip Size Package)。它减小了芯片封装外形的尺寸,做到裸芯片尺寸有多大,封装尺寸就有多大。即封装后的IC尺寸边长不大于芯片的1.2倍,IC面积只比晶粒(Die)大不超过1.4倍。
CSP封装又可分为四类:
1.Lead Frame Type(传统导线架形式),代表厂商有富士通、日立、Rohm、高士达(Goldstar)等等。
2.Rigid Interposer Type(硬质内插板型),代表厂商有摩托罗拉、索尼、东芝、松下等等。
3.Flexible Interposer Type(软质内插板型),其中最有名的是Tessera公司的microBGA,CTS的sim-BGA也采用相同的原理。其他代表厂商包括通用电气(GE)和NEC。
4.Wafer Level Package(晶圆尺寸封装):有别于传统的单一芯片封装方式,WLCSP是将整片晶圆切割为一颗颗的单一芯片,它号称是封装技术的未来主流,已投入研发的厂商包括FCT、Aptos、卡西欧、EPIC、富士通、三菱电子等。
CSP封装具有以下特点:
1.满足了芯片I/O引脚不断增加的需要。
2.芯片面积与封装面积之间的比值很小。
3.极大地缩短延迟时间。
CSP封装适用于脚数少的IC,如内存条和便携电子产品。未来则将大量应用在信息家电(IA)、数字电视(DTV)、电子书(E-Book)、无线网络WLAN/GigabitEthemet、ADSL/手机芯片、蓝芽(Bluetooth)等新兴产品中。
六.MCM多芯片模块
为解决单一芯片集成度低和功能不够完善的问题,把多个高集成度、高性能、高可靠性的芯片,在高密度多层互联基板上用SMD技术组成多种多样的电子模块系统,从而出现MCM(Multi Chip Model)多芯片模块系统。MCM具有以下特点:
1.封装延迟时间缩小,易于实现模块高速化。
2.缩小整机/模块的封装尺寸和重量。
3.系统可靠性大大提高。
总之,由于CPU和其他超大型集成电路在不断发展,集成电路的封装形式也不断作出相应的调整变化,而封
贴片封装 - 两脚表贴
现在常用的的电阻、电容、电感、二极管都有贴片封装。贴片封装用四位数字标识,表明了器件的长度和宽度。贴片电阻有百分五和百分一两种精度,购买时不特别说明的话就是指百分五。一般说的贴片电容是片式多层陶瓷电容(MLCC ),也称独石电容。附表是贴片电阻的参数。
英制 (mil) 公制 (mm) 长(L) (mm) 宽(W) (mm) 高(t) (mm) a (mm) b (mm)
常规 功率W 提升 功率 W 最大
工作 电
压 V
0201 0603 0.60±0.05 0.30±0.05 0.23±0.05 0.10±0.05 0.15±0.05 1/20 25 0402 1005 1.00±0.10 0.50±0.10 0.30±0.10 0.20±0.10 0.25±0.10 1/16
50
0603 1608 1.60±0.15 0.80±0.15 0.40±0.10 0.30±0.20 0.30±0.20 1/16 1/10 50 0805 2012 2.00±0.20 1.25±0.15 0.50±0.10 0.40±0.20 0.40±0.20 1/10 1/8 150 **** **** 3.20±0.20 1.60±0.15 0.55±0.10 0.50±0.20 0.50±0.20 1/8 1/4 200 1210 3225 3.20±0.20 2.50±0.20 0.55±0.10 0.50±0.20 0.50±0.20 1/4 1/3 200 1812 4832 4.50±0.20 3.20±0.20 0.55±0.10 0.50±0.20 0.50±0.20 1/2 200 2010 5025 5.00±0.20 2.50±0.20 0.55±0.10 0.60±0.20 0.60±0.20 1/2 3/4 200
2512 6432 6.40±0.20 3.20±0.20 0.55±0.10 0.60±0.20 0.60±0.20 1
200
AXIAL - 两脚直插
AXIAL 就是普通直插电阻的封装,也用于电感之类的器件。后面的数字是指两个焊盘的间距。 AXIAL-0.3 小功率直插电阻(1/4W);普通二极管(1N4148);色环电感(10uH )
AXIAL-0.4 1A 的二极管,用于整流(1N4007);1A 肖特基二极管,用于开关电源(1N5819);瞬态保护二极管 AXIAL-0.8 大功率直插电阻(1W 和2W) DIP - 双列直插
直插芯片常用的古老封装。 SOIC - 双列表贴
现在用的贴片max232就是soic-16,后面的数字显然是管脚数。 贴片485芯片有SOIC-8S ,管脚排布更密了。 TO - 直插
DPY_7-SEG_DP 数码管
直插三极管用的是TO-92,普通直插7805电源芯片用TO-220,类似三极管的78L05用TO-92。 直插开关电源芯片2576有五个管脚,用TO-220T 。
贴片的2576看起来像D-PAK ,但却是TO-263,奇怪。它有五个管脚,再加上一个比较大的地。 SOT - 表贴
贴片三极管和场效应管用的是SOT-23。LM1117电源芯片用SOT-223,加上地共有四个引脚。 D-PAK - 表贴
贴片的7805电源芯片就用这个封装,有一个面积比较大的地,还有两个引脚分别是输入和输出。 TQFP - 表贴芯片
一直在用的贴片avr 单片机芯片就是TQFP 的,比如mega8用TQFP-32。管脚数少的avr 比如tiny13,则采用soic
atmel的7s64 ARM芯片用了LQFP-64,似乎管脚排列更紧密了。见过有一款国内的soic 51芯片用了PQFP-64,管脚排布比TQFP紧密。
DB9
9针串口座,这个也是必须要有的。
PZ-4 四位排阻
RW 精密电位器
TO-92 直插三极管
SOT-23 贴片三极管;贴片场效应管
RB-.1/.2,.1/.3,.2/.4,.2/.5,.3/.6直插电解电容
RB-3/6 LM2575专用电感(330uH直插)
CAPT-170 贴片电解电容10uF/25V
LED-3 直插发光二极管
DAY-4 四位八字LED管
电源IC
D-PAK 贴片7805
TO-220 直插7805
TO-92 直插78L05
SOT-223 LM1117,3.3V贴片
TO-263 LM2575贴片
TO-220T LM2575直插2575有五个脚;2576和2575封装一样(插、贴),区别是2576开关、2575线性。
78L05 100ma
78M05 500ma
7805 1.5A
PCB画圆形焊盘默认孔径30mil,总直径60mil(0.762mm,1.524mm)。
自恢复电阻管脚直径0.6mm,封装定义孔径为0.7mm,总直径1.5mm。
压敏电阻管教直径1mm,封装定义孔径1.27mm,总直径2.54mm(50mil,100mil)。
(用于焊接220V导线的焊盘:3mm x 1.8mm)
电源线不低于18mil,信号线不低于12mil,cpu入出线不低于10mil(或8mil),线间距不低于10mil。
正常过孔不低于30mil(内孔一般不能小于10mil)。
100mil对应2.54mm。
双列直插焊盘间距100mil,两排间距300mil。焊盘60mil,孔径40mil。
元件封装电阻AXIAL
无极性电容RAD
电解电容RB-
电位器VR
二极管DIODE
三极管TO
电源稳压块78和79系列TO-126H和TO-126V
场效应管和三极管一样
整流桥D-44 D-37 D-46
单排多针插座CON SIP (搜索con可找到任何插座)
双列直插元件DIP
晶振XTAL1
电阻:RES1,RES2,RES3,RES4;封装属性为axial系列
无极性电容:cap;封装属性为RAD-0.1到rad-0.4
电解电容:electroi;封装属性为rb.2/.4到rb.5/1.0
二极管:封装属性为diode-0.4(小功率)diode-0.7(大功率)
三极管:常见的封装属性为to-18(普通三极管)to-22(大功率三极管)to-3(大功率达林
顿管)
电源稳压块有78和79系列;78系列如7805,7812,7820等;79系列有7905,7912,7920等.常见的封装属性有to126h和to126v
整流桥:BRIDGE1,BRIDGE2: 封装属性为D系列(D-44,D-37,D-46)
电阻:AXIAL0.3-AXIAL0.7其中0.4-0.7指电阻的长度,一般用AXIAL0.4
瓷片电容:RAD0.1-RAD0.3。其中0.1-0.3指电容大小,一般用RAD0.1
电解电容:RB.1/.2-RB.4/.8 其中.1/.2-.4/.8指电容大小。一般<100uF用
RB.1/.2,100uF-470uF用RB.2/.4,>470uF用RB.3/.6
二极管:DIODE0.4-DIODE0.7 其中0.4-0.7指二极管长短,一般用DIODE0.4
发光二极管:RB.1/.2
集成块:DIP8-DIP40, 其中8-40指有多少脚,8脚的就是DIP8
贴片电阻
0603表示的是封装尺寸与具体阻值没有关系
但封装尺寸与功率有关通常来说
0201 1/20W
0402 1/16W
0603 1/10W
0805 1/8W
1206 1/4W
电容电阻外形尺寸与封装的对应关系是:
0402=1.0x0.5
0603=1.6x0.8
0805=2.0x1.2
1206=3.2x1.6
1210=3.2x2.5
1812=4.5x3.2
2225=5.6x6.5
零件封装是指实际零件焊接到电路板时所指示的外观和焊点的位置。是纯粹的空间概念因此
不同的元件可共用同一零件封装,同种元件也可有不同的零件封装。像电阻,有传统的针插
式,这种元件体积较大,电路板必须钻孔才能安置元件,完成钻孔后,插入元件,再过锡炉
或喷锡(也可手焊),成本较高,较新的设计都是采用体积小的表面贴片式元件(SMD)这
种元件不必钻孔,用钢膜将半熔状锡膏倒入电路板,再把SMD元件放上,即可焊接在电路板上了。
关于零件封装我们在前面说过,除了DEVICE。LIB库中的元件外,其它库的元件都已经有了固定的元件封装,这是因为这个库中的元件都有多种形式:以晶体管为例说明一下:
晶体管是我们常用的的元件之一,在DEVICE。LIB库中,简简单单的只有NPN与PNP之分,但实际上,如果它是NPN的2N3055那它有可能是铁壳子的TO—3,如果它是NPN的2N3054,则有可能是铁壳的TO-66或TO-5,而学用的CS9013,有TO-92A,TO-92B,还有TO-5,TO-46,TO-5
2等等,千变万化。
还有一个就是电阻,在DEVICE库中,它也是简单地把它们称为RES1和RES2,不管它是100Ω
还是470KΩ都一样,对电路板而言,它与欧姆数根本不相关,完全是按该电阻的功率数来决定的我们选用的1/4W 和甚至1/2W的电阻,都可以用AXIAL0.3元件封装,而功率数大一点的话,可用AXIAL0.4,AXIAL0.5等等。现将常用的元件封装整理如下:
电阻类及无极性双端元件AXIAL0.3-AXIAL1.0
无极性电容RAD0.1-RAD0.4
二极管DIODE0.4及DIODE0.7
石英晶体振荡器XTAL1
晶体管、FET、UJT TO-xxx(TO-3,TO-5)
可变电阻(POT1、POT2)VR1-VR5
当然,我们也可以打开C:Client98PCB98libraryadvpcb.lib库来查找所用零件的对应封装。
这些常用的元件封装,大家最好能把它背下来,这些元件封装,大家可以把它拆分成两部分
来记如电阻AXIAL0.3可拆成AXIAL和0.3,AXIAL翻译成中文就是轴状的,0.3则是该电阻在印刷电路板上的焊盘间的距离也就是300mil(因为在电机领域里,是以英制单位为主的。同样的,对于无极性的电容,RAD0.1-RAD0.4也是一样;对有极性的电容如电解电容,其封装为RB.2/.4,RB.3/.6等,其中“.2”为焊盘间距,“.4”为电容圆筒的外径。
对于晶体管,那就直接看它的外形及功率,大功率的晶体管,就用TO—3,中功率的晶体管,如果是扁平的,就用TO-220,如果是金属壳的,就用TO-66,小功率的晶体管,就用TO-5,TO-46,TO-92A等都可以,反正它的管脚也长,弯一下也可以。
对于常用的集成IC电路,有DIPxx,就是双列直插的元件封装,DIP8就是双排,每排有4个引脚,两排间距离是300mil,焊盘间的距离是100mil。SIPxx就是单排的封装。等等。
值得我们注意的是晶体管与可变电阻,它们的包装才是最令人头痛的,同样的包装,其管脚
可不一定一样。例如,对于TO-92B之类的包装,通常是1脚为E(发射极),而2脚有可能是B极(基极),也可能是C(集电极);同样的,3脚有可能是C,也有可能是B,具体是那个,只有拿到了元件才能确定。因此,电路软件不敢硬性定义焊盘名称(管脚名称),同样的,场效应管,MOS管也可以用跟晶体管一样的封装,它可以通用于三个引脚的元件。
Q1-B,在PCB里,加载这种网络表的时候,就会找不到节点(对不上)。
在可变电阻上也同样会出现类似的问题;在原理图中,可变电阻的管脚分别为1、W、及2,所产生的网络表,就是1、2和W,在PCB电路板中,焊盘就是1,2,3。当电路中有这两种元件时,就要修改PCB与SCH之间的差异最快的方法是在产生网络表后,直接在网络表中,将晶体管管脚改为1,2,3;将可变电阻的改成与电路板元件外形一样的1,2,3即可。
中英对照
1.电阻
固定电阻:RES
半导体电阻:RESSEMT 电位计;POT
变电阻;RV AR
可调电阻;res1.....
2.电容
定值无极性电容;CAP
定值有极性电容;CAP
半导体电容:CAPSEMI 可调电容:CAPV AR
3.电感:INDUCTOR
4.二极管:DIODE.LIB
发光二极管:LED
5.三极管:NPN1
6.结型场效应管:JFET.lib
7.MOS场效应管
8.MES场效应管
9.继电器:PELAY. LIB 11.运放:OPAMP
12.数码管:DPY_7-SEG_DP (MISCELLANEOUS DEVICES.LIB)
13.开关;sw_pb
原理图常用库文件:Miscellaneous Devices.ddb ,Dallas Microprocessor.ddb ,Intel Databooks.ddb ,Protel DOS Schematic Libraries.ddb
PCB元件常用库:Advpcb.ddb ,General IC.ddb ,Miscellaneous.ddb
部分分立元件库元件名称及中英对照
AND 与门
ANTENNA 天线
BATTERY 直流电源
BELL 铃,钟
BVC 同轴电缆接插件
BRIDEG 1 整流桥(二极管)
BRIDEG 2 整流桥(集成块)
BUFFER 缓冲器
BUZZER 蜂鸣器
常见电子元器件封装 元件封装是指实际元件焊接到电路板时所指示的外观和焊点的位置。是纯粹的空间概念.因此不同的元件可共用同一元件封装,同种元件也可有不同的元件封装。像电阻,有传统的针插式,这种元件体积较大,电路板必须钻孔才能安置元件,完成钻孔后,插入元件,再过锡炉或喷锡(也可手焊),成本较高,较新的设计都是采用体积小的表面贴片式元件(SMD)这种元件不必钻孔,用钢膜将半熔状锡膏倒入电路板,再把SMD元件放上,即可焊接在电路板上了。 电源稳压块78和79系列TO-126H和TO-126V 场效应管和三极管一样 整流桥D-44D-37D-46 单排多针插座CON SIPn(n为针脚个数) 双列直插元件(集成块):DIP8-DIP40,其中8-40指有多少脚,8脚的就是DIP8 石英晶体振荡器XTAL1 运放OP07 电阻:RES1,RES2,RES3,RES4封装属性为axial系列AXIAL0.3-AXIAL0.7其中0.4-0.7指电阻的长度,一般用AXIAL0.4/0.3 添片的有0603080510051206 无极性电容:cap;封装属性为RAD-0.1到rad-0.4 电位器:VR pot1,pot2;封装属性为vr-1到vr-5 发光二极管:led RB.1/.2 二极管:DIODE封装属性为diode-0.4(小功率)diode-0.7(大功率)其中0.4-0.7指二极管长短,一般用DIODE0.4 三极管:TO IGBT NPN常见的封装属性为to-18(普通三极管)to-22(大功率三极管)to-3(大功率达林顿管) 电源稳压块有78和79系列;78系列如7805,7812,7820等79系列有7905,7912,7920等常见的封装属性有to126h和to126v
电子元件封装大全及封装常识 2010-04-12 19:33 一、什么叫封装 封装,就是指把硅片上的电路管脚,用导线接引到外部接头处,以便与其它器件连接.封装形式是指安装半导体集成电路芯片用的外壳。它不仅起着安装、固定、密封、保护芯片及增强电热性能等方面的作用,而且还通过芯片上的接点用导线连接到封装外壳的引脚上,这些引脚又通过印刷电路板上的导线与其他器件相连接,从而实现内部芯片与外部电路的连接。因为芯片必须与外界隔离,以防止空气中的杂质对芯片电路的腐蚀而造成电气性能下降。另一方面,封装后的芯片也更便于安装和运输。由于封装技术的好坏还直接影响到芯片自身性能的发挥和与之连接的PCB(印制电路板)的设计和制造,因此它是至关重要的。 衡量一个芯片封装技术先进与否的重要指标是芯片面积与封装面积之比,这个比值越接近1越好。封装时主要考虑的因素: 1、芯片面积与封装面积之比为提高封装效率,尽量接近1:1; 2、引脚要尽量短以减少延迟,引脚间的距离尽量远,以保证互不干扰,提高性能; 3、基于散热的要求,封装越薄越好。 封装主要分为DIP双列直插和SMD贴片封装两种。从结构方面,封装经历了最早期的晶体管TO(如TO-89、TO92)封装发展到了双列直插封装,随后由PHILIP公司开发出了SOP小外型封装,以后逐渐派生出SOJ(J型引脚小外形封装)、TSOP(薄小外形封装)、VSOP(甚小外形封装)、SSOP(缩小型SOP)、TSSOP(薄的缩小型SOP)及SOT(小外形晶体管)、SOIC (小外形集成电路)等。从材料介质方面,包括金属、陶瓷、塑料、塑料,目前很多高强度工作条件需求的电路如军工和宇航级别仍有大量的金属封装。 封装大致经过了如下发展进程: 结构方面:TO->DIP->PLCC->QFP->BGA ->CSP; 材料方面:金属、陶瓷->陶瓷、塑料->塑料; 引脚形状:长引线直插->短引线或无引线贴装->球状凸点; 装配方式:通孔插装->表面组装->直接安装 二、具体的封装形式 1、 SOP/SOIC封装 SOP是英文Small Outline Package 的缩写,即小外形封装。SOP封装技术由1968~1969年菲利浦公司开发成功,以后逐渐派生出SOJ(J型引脚小外形封装)、TSOP(薄小外形封装)、VSOP(甚小外形封装)、SSOP(缩小型SOP)、TSSOP(薄的缩小型SOP)及SOT(小外形晶体管)、SOIC(小外形集成电路)等。 2、 DIP封装 DIP是英文 Double In-line Package的缩写,即双列直插式封装。插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。DIP是最普及的插装型封装,应用范围包括标准逻辑IC,存贮器LSI,微机电路等。 < 1 > 3、 PLCC封装 PLCC是英文Plastic Leaded Chip Carrier 的缩写,即塑封J引线芯片封装。PLCC封装方式,外形呈正方形,32脚封装,四周都有管脚,外形尺寸比DIP封装小得多。PLCC封装适合用SMT表面安装技术在PCB上安装布线,具有外形尺寸小、可靠性高的优点。 4、 TQFP封装 TQFP是英文thin quad flat package的缩写,即薄塑封四角扁平封装。四边扁平封装(TQFP)
常用电子元件封装、尺寸、规格汇总 贴片电阻规格 贴片电阻常见封装有9种,用两种尺寸代码来表示。一种尺寸代码是由4位数字表示的EIA(美国电子工业协会)代码,前两位与后两位分别表示电阻的长与宽,以英寸为单位。我们常说的0603封装就是指英制代码。另一种是米制代码,也由4位数字表示,其单位为毫米。下表列出贴片电阻封装英制和公制的关系及详细的尺寸: 贴片元件的封装 一、零件规格: (a)、零件规格即零件的外形尺寸,SMT发展至今,业界为方便作业,已经形成了一个标准零件系列,各家零件供货商皆是按这一标准制造。标准零件之尺寸规格有英制与公制两种表示方法,如下表英制表示法1206 0805 0603 0402 公制表示法3216 2125 1608 1005含义L:1.2inch(3.2mm)W:0.6inch(1.6mm) L:0.8inch(2.0mm)W:0.5inch(1.25mm) L:0.6inch(1.6mm)W:0.3inch(0.8mm) L:0.4inch(1.0mm)W:0.2inch(0.5mm) 注: a、L(Length):长度;W(Width):宽度;inch:英寸 b、1inch=25.4mm(b)、在(1)中未提及零件的厚度,在这一点上因零件不同而有所差异,在生产时应以实际量测为准。(c)、以上所讲的主要是针对电子产品中用量最大的电阻(排阻)和电容(排容),其它如电感、二极管、晶体管等等因用量较小,且形状也多种多样,在此不作讨论。(d)、SMT发展至今,随着电子产品集成度的不断提高,标准零件逐步向微型化发展,如今最小的标准零件已经到了0201。二、常用元件封装1)电阻:最为常见的有0805、0603两类,不同的是,它可以以排阻的身份出现,四位、八位都有,具体封装样式可参照
修改者:林子木 电子元件封装大全及封装常识 一、什么叫封装 封装,就是指把硅片上的电路管脚,用导线接引到外部接头处,以便与其它器件连 接.封装形式是指安装半导体集成电路芯片用的外壳。它不仅起着安装、固定、 密封、保护芯片及增强电热性能等方面的作用,而且还通过芯片上的接点用导线 连接到封装外壳的引脚上,这些引脚又通过印刷电路板上的导线与其他器件相连 接,从而实现内部芯片与外部电路的连接。因为芯片必须与外界隔离,以防止空 气中的杂质对芯片电路的腐蚀而造成电气性能下降。另一方面,封装后的芯片也 更便于安装和运输。由于封装技术的好坏还直接影响到芯片自身性能的发挥和与 之连接的PCB(印制电路板)的设计和制造,因此它是至关重要的。 衡量一个芯片封装技术先进与否的重要指标是芯片面积与封装面积之比,这个比 值越接近1 越好。封装时主要考虑的因素: 1、芯片面积与封装面积之比为提高封装效率,尽量接近1:1; 2、引脚要尽量短以减少延迟,引脚间的距离尽量远,以保证互不干扰,提高性 能; 3、基于散热的要求,封装越薄越好。 封装主要分为DIP 双列直插和SMD 贴片封装两种。从结构方面,封装经历了最 早期的晶体管TO(如TO-89、TO92)封装发展到了双列直插封装,随后由PHILIP 公司开发出了SOP 小外型封装,以后逐渐派生出SOJ(J 型引脚小外形封装)、 TSOP(薄小外形封装)、VSOP(甚小外形封装)、SSOP(缩小型SOP)、 TSSOP(薄的缩小型SOP)及SOT(小外形晶体管)、SOIC(小外形集成电 路)等。从材料介质方面,包括金属、陶瓷、塑料、塑料,目前很多高强度工作 条件需求的电路如军工和宇航级别仍有大量的金属封装。 封装大致经过了如下发展进程: 结构方面:TO->DIP->PLCC->QFP->BGA ->CSP; 材料方面:金属、陶瓷->陶瓷、塑料->塑料; 引脚形状:长引线直插->短引线或无引线贴装->球状凸点; 装配方式:通孔插装->表面组装->直接安装 二、具体的封装形式 1、SOP/SOIC 封装 SOP 是英文Small Outline Package 的缩写,即小外形封装。SOP 封装技术由 1968~1969 年菲利浦公司开发成功,以后逐渐派生出SOJ(J 型引脚小外形封 装)、TSOP(薄小外形封装)、VSOP(甚小外形封装)、SSOP(缩小型SOP)、 TSSOP(薄的缩小型SOP)及SOT(小外形晶体管)、SOIC(小外形集成电 路)等。 SOP(Small Out-Line package) 也叫SOIC,小外形封装。表面贴装型封装之一, 引脚从封装两侧引出呈海鸥翼状(L 字形)。材料有塑料和陶瓷两种。SOP 除了用 于存储器LSI 外,也广泛用于规模不太大的ASSP 等电路。在输入输出端子不 超过10~40 的领域,SOP 是普及最广的表面贴装封装。引脚中心距 1.27mm,引脚数从8~44。另外,引脚中心距小于1.27mm 的SOP 也称为SSOP;装配 高度不到1.27mm 的SOP 也称为TSOP。还有一种带有散热片的SOP。
常用电子元件封装 电阻:RES1, RES2, RES3, RES4;封装属性为axial系列 无极性电容:cap;封装属性为RAD-0.1到rad-0.4 电解电容:electroi;封装属性为rb.2/.4至到rb.5/1.0 电位器:pot1,pot2 ;封装属性为vr-1到vr-5 二极管:封装属性为diode-0.4(小功率)diode-0.7(大功率) 三极管:常见的封装属性为to-18 (普通三极管)to-22(大功率三极管)to-3(大功率达林顿管)电源稳压块有78和79系列;78系列如7805 , 7812 , 7820等 79 系列有7905 , 7912 , 7920 等 常见的封装属性有to126h和to126v 整流桥:BRIDGE1,BRIDGE2:封装属性为 D 系列(D-44 , D-37 , D-46 )电阻:AXIAL0.3- AXIAL0.7 其中0.4-0.7指电阻的长度,一般用AXIAL0.4 瓷片电容:RAD0.1-RAD0.3。其中0.1-0.3指电容大小,一般用RAD0.1 电解电容:RB.1/.2- RB.4/.8 其中.1/.2-.4/.8 指电容大小。一般<100uF用 RB.1/.2,100uF-470uF 用RB.2/.4,>470uF 用RB.3/.6 二极管:DIODE0.4-DIODE0.7 其中0.4-0.7 指二极管长短,一般用DIODE0.4 发光二极管:RB.1/.2 集成块:DIP8-DIP40,其中8 —4 0指有多少脚,8脚的就是DIP8 贴片电阻 0603表示的是封装尺寸与具体阻值没有关系,但封装尺寸与功率有关通常来说如下: 0201 1/20W 0402 1/16W 0603 1/10W 0805 1/8W 1206 1/4W 电容电阻外形尺寸与封装的对应关系是: 0402=1.0mmx0.5mm 0603=1.6mmx0.8mm 0805=2.0mmx1.2mm 1206=3.2mmx1.6mm 1210=3.2mmx2.5mm 1812=4.5mmx3.2mm 2225=5.6mmx6.5mm 零件封装是指实际零件焊接到电路板时所指示的外观和焊点的位置。是纯粹的空间概念 因此不同的元件可共用同一零件封装,同种元件也可有不同的零件封装。像电阻,有传统的 针插式,这种元件体积较大,电路板必须钻孔才能安置元件,完成钻孔后,插入元件,再过锡炉或喷锡(也可手焊),成本较高,较新的设计都是采用体积小的表面贴片式元件(SMD)这种元件不必钻孔,用钢膜将半熔状锡膏倒入电路板,再把SMD元件放上,即可焊接在电 路板上了。 关于零件封装我们在前面说过,除了DEVICE。LIB库中的元件外,其它库的元件都已 经有了固定的元件封装,这是因为这个库中的元件都有多种形式:以晶体管为例说明一下:晶体管是我们常用的的元件之一,在DEVICE。LIB库中,简简单单的只有NPN与PNP 之分,但实际上,如果它是NPN的2N3055那它有可能是铁壳子的TO—3,如果它是NPN 的2N3054,则有可能是铁壳的TO-66或T0-5,而学用的CS9013,有TO-92A , TO-92B ,
TQFP hin Quad Flat Packs PPGA Plastic Pin Grid Arrays Mini-BGA Mini Ball Grid Array BGA Ball Grid Array CerDIP Ceramic Dual-In-Line Packages CQFP Ceramic Flatpacks CerSOJ Ceramic Small Outline J-Bend CPGA Ceramic Pin Grid Arrays WLCC Ceramic Windowed J-Leaded Chip Carriers PLCC Plastic Leaded Chip Carriers CerPACK Cerpacks LCC Ceramic Leadless Chip Carriers PQFP Plastic Quad Flatpacks SSOP Shrunk Small Outline Packages PDIP Plastic Dual-In-Line Packages QSOP Quarter Size Outline Packages W-LCC Ceramic Windowed Leadless Chip Carriers WPGA Ceramic Windowed Pin Grid Arrays SOIC Plastic Small Outline ICs W-CerPACK Windowed Cerpacks CQFP Ceramic Quad Flatpacks SOJ Plastic Small Outline J-Bend W-CerDIP Ceramic Windowed Dual-In-Line Packages CLCC Ceramic J-Leaded Chip Carriers TSOP Thin Small Outline Packages STSOP Small Thin Small Outline Packages RTSOP Reverse Thin Small Outline Packages TSOP II Thin Small Outline Packages, Type I 芯片的封装 芯片包装指包裹于硅晶外层的物质。目前最常见的包装称为 TSOP(Thin Small Outline Packaging) ,早期的芯片设计以 DIP(Dual In-line Package) 以及 SOJ(Small Outline J-lead) 的方式包装。较新的芯片,例如RDRAM 使用 CSP(Chip Scale Package) 包装。以下对不同封装方式的介绍能够帮助了解它们的不同点。 DIP (Dual In-Line Package 双列直插式封装、双入线封装)
元器件封装大全 A. 名称Axial 描述轴状的封装 名称 AGP (Accelerate Graphical Port) 描述加速图形接口 名称 AMR (Audio/MODEM Riser) 描述声音/调制解调器插卡 B. 名称 BGA (Ball Grid Array) 描述 球形触点阵列,表面贴 装型封装之一。在印刷基板 的背面按阵列方式制作出 球形凸点用以代替引脚,在 印刷基板的正面装配LSI 芯片,然后用模压树脂或灌 封方法进行密封。也称为凸 点阵列载体(PAC) 名称 BQFP (quad flat package with bumper) 描述 带缓冲垫的四侧引脚扁 平封装。QFP封装之一,在 封装本体的四个角设置突 (缓冲垫)以防止在运送过 程中引脚发生弯曲变形。 C.陶瓷片式载体封装 名称 C- (ceramic) 描述 表示陶瓷封装的记号。 例如,CDIP 表示的是陶瓷 DIP。 名称C-BEND LEAD 描述名称CDFP 描述
名称Cerdip 描述 用玻璃密封的陶瓷双列直插式封装,用于ECL RAM,DSP(数字信号处理器)等电路。带有玻璃窗口的Cerdip 用于紫外线擦除型EPROM 以及内部带有EPROM 的微机电路等。 名称CERAMIC CASE 描述 名称 CERQUAD (Ceramic Quad Flat Pack) 描述 表面贴装型封装之一, 即用下密封的陶瓷QFP,用 于封装DSP 等的逻辑LSI 电路。带有窗口的Cerquad 用于封装EPROM 电路。散热 性比塑料QFP 好,在自然空 冷条件下可容许 1.5~2W 的功率 名称CFP127 描述 名称 CGA (Column Grid Array)描述 圆柱栅格阵列,又称柱栅阵列封装 名称 CCGA (Ceramic Column Grid Array) 描述陶瓷圆柱栅格阵列 名称CNR 描述CNR是继AMR之后作为INTEL的标准扩展接口 名称CLCC 描述 带引脚的陶瓷芯片载体,引脚从封装的四个侧面引出,呈丁字形。带有窗口的用于封装紫外线擦除型EPROM 以及带有EPROM 的微机电路等。此封装也称为QFJ、QFJ-G.
1.0目的 制订本指南,规范公司的各层工作人员认识及辨别日常工作中常用的各类元件。 2.0范围 公司主要产品(电脑主机板)中的电子元件认识: 2.1工作中最常用的的电子元件有:电阻、电容、电感、晶体管(包括二极管、发光二极管及三极管)、晶体、晶振(振荡器)和集成电路(IC)。 2.2连接器元件主要有:插槽、插针、插座等。 2.3其它一些五金塑胶散件:散热片、胶针、跳线铁丝等。 4.0电子元件 4.1电阻 电阻用“R”表示,它的基本单位是欧姆(Ω) 1MΩ(兆欧)=1,000KΩ(千欧)=1,000,000Ω 公司常用的电阻有三种:色环电阻、排型电阻和片状电阻。 色环电阻的外观如图示: 图1五色环电阻图2四色环电阻 较大的两头叫金属帽,中间几道有颜色的圈叫色环,这些色环是用来表示该电阻的阻值和范围的,共有12种颜色,它们分别代表不同的数字(其中金色和银色表误差): 我们常用的色环电阻有四色环电阻(如图2)和五色环电阻(如图1): 1).四色环电阻(普通电阻):电阻外表上有四道色环: 这四道环,首先是要分出哪道是第一环、第二环、第三环和第四环:标在金属帽上的那道环叫第一环,表示电阻值的最高位,也表示读值的方向。如黄色表示最高位为四,紧挨第一环的叫第二环,表示电阻值的次高位,如紫色表示次高位为7;紧挨第2环的叫第3环,表示次高位后“0”的个数,如橙色表示后面有3个0;最后一环叫第4环,表示误差范围,一般仅用金色或银色表示,如为金色,则表示误差范围在±10%之间。 例如:某电阻色环颜色顺序为:黄-紫-橙-银,表示该电阻的阻值为:47,000Ω=47KΩ,误差范围:±10%之间。
常用贴片元件封装 1 电阻: 最为常见的有0201、0402、0805、0603、1206、1210、1812、2010、2512几类 1)贴片电阻的封装与尺寸如下表: 英制(mil) 公制(mm) 长(L)(mm) 宽(W)(mm) 高(t)(mm) 0201 0603 0.60±0.05 0.30±0.05 0.23±0.05 0402 1005 1.00±0.10 0.50±0.10 0.30±0.10 0603 1608 1.60±0.15 0.80±0.15 0.40±0.10 0805 2012 2.00±0.20 1.25±0.15 0.50±0.10 1206 3216 3.20±0.20 1.60±0.15 0.55±0.10 1210 3225 3.20±0.20 2.50±0.20 0.55±0.10 1812 4832 4.50±0.20 3.20±0.20 0.55±0.10 2010 5025 5.00±0.20 2.50±0.20 0.55±0.10 2512 6432 6.40±0.20 3.20±0.20 0.55±0.10 2)贴片电阻的封装、功率与电压关系如下表: 英制(mil)公制(mm)额定功率@ 70°C 最大工作电压(V) 0201 0603 1/20W 25 0402 1005 1/16W 50 0603 1608 1/10W 50 0805 2012 1/8W 150 1206 3216 1/4W 200
1210 3225 1/3W 200 1812 4832 1/2W 200 2010 5025 3/4W 200 2512 6432 1W 200 3)贴片电阻的精度与阻值 贴片电阻阻值误差精度有±1%、±2%、±5%、±10%精度, J -表示精度为5%、 F-表示精度为1%。 T -表示编带包装 阻值范围从0R-100M 2电容: 1)贴片电容可分为无极性和有极性两种,容值范围从0.22pF-100uF 无极性电容下述两类封装最为常见,即0805、0603; 英制尺寸公制尺寸长度宽度厚度 0402 1005 1.00±0.05 0.50±0.05 0.50±0.05 0603 1608 1.60±0.10 0.80±0.10 0.80±0.10 0805 2012 2.00±0.20 1.25±0.20 0.70±0.20 1206 3216 3.20±0.30 1.60±0.20 0.70±0.20 1210 3225 3.20±0.30 2.50±0.30 1.25±0.30 1808 4520 4.50±0.40 2.00±0.20 ≤2.00 1812 4532 4.50±0.40 3.20±0.30 ≤2.50 2225 5763 5.70±0.50 6.30±0.50 ≤2.50 3035 7690 7.60±0.50 9.00±0.05 ≤3.00
电子元器件封装技术详细介绍 电子元器件封装技术详细介绍 1、BGA(ballgridarray):球形触点陈列,表面贴装型封装之一。在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI芯片,然后用模压树脂或灌封方法进行密封。也称为凸点陈列载体(PAC)。引脚可超过200,是多引脚LSI用的一种封装。封装本体也可做得比QFP(四侧引脚扁平封装)小。 例如,引脚中心距为1.5mm的360引脚BGA仅为31mm见方;而引脚中心距为0.5mm的304引脚QFP为40mm见方。而且BGA不用担心QFP那样的引脚变形问题。该封装是美国Motorola公司开发的,首先在便携式电话等设备中被采用,今后在美国有可能在个人计算机中普及。最初,BGA的引脚(凸点)中心距为1.5mm,引脚数为225。现在也有一些LSI 厂家正在开发500引脚的BGA。BGA的问题是回流焊后的外观检查。现在尚不清楚是否有效的外观检查方法。有的认为,由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。美国Motorola公司把用模压树脂密封的封装称为OMPAC,而把灌封方法密封的封装称为GPAC(见OMPAC和GPAC)。 2、BQFP(quadflatpackagewithbumper):带缓冲垫的四侧引脚扁平封装。QFP封装之一,在封装本体的四个角设置突起(缓冲垫)以防止在运送过程中引脚发生弯曲变形。美国半导体厂家主要在微处理器和ASIC等电路中采用此封装。引脚中心距0.635mm,引脚数从84到196左右(见QFP)。 3、碰焊PGA(buttjointpingridarray):表面贴装型PGA的别称(见表面贴装型PGA)。 4、C-(ceramic):表示陶瓷封装的记号。例如,CDIP表示的是陶瓷DIP。是在实际中经常使用的记号。 5、Cerdip:用玻璃密封的陶瓷双列直插式封装,用于ECLRAM,DSP(数字
电子元器件封装知识 电子元器件封装知识一: 1、bga(ballgridarray)球形触点陈列,表面贴装型封装之一。在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配lsi芯片,然后用模压树脂或灌封方法进行密封。也称为凸点陈列载体(pac)。引脚可超过200,是多引脚lsi 用的一种封装。封装本体也可做得比qfp(四侧引脚扁平封装)小。例如,引脚中心距为1.5mm的360引脚bga仅为31mm见方;而引脚中心距为0.5mm的304引脚qfp为40mm见方。而且bga不用担心qfp那样的引脚变形问题。该封装是美国motorola公司开发的,首先在便携式电话等设备中被采用,今后在美国有可能在个人计算机中普及。最初,bga的引脚(凸点)中心距为1.5mm,引脚数为225。现在也有一些lsi厂家正在开发500引脚的bga。bga的问题是回流焊后的外观检查。现在尚不清楚是否有效的外观检查方法。有的认为,由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。美国motorola公司把用模压树脂密封的封装称为ompac,而把灌封方法密封的封装称为gpac(见ompac 和gpac)。 2、bqfp(quadflatpackagewithbumper)带缓冲垫的四侧引脚扁平封装。qfp封装之一,在封装本体的四个角设置突起(缓冲垫)以防止在运送过程中引脚发生弯曲变形。美国半导体厂家主要在
微处理器和asic等电路中采用此封装。引脚中心距0.635mm,引脚数从84到196左右(见qfp)。 3、碰焊pga(buttjointpingridarray)表面贴装型pga的别称(见表面贴装型pga)。 4、c-(ceramic)表示陶瓷封装的记号。例如,cdip表示的是陶瓷dip。是在实际中经常使用的记号。 5、cerdip用玻璃密封的陶瓷双列直插式封装,用于eclram,dsp(数字信号处理器)等电路。带有玻璃窗口的cerdip用于紫外线擦除型eprom以及内部带有eprom的微机电路等。引脚中心距2.54mm,引脚数从8到42。在日本,此封装表示为dip-g(g即玻璃密封的意思)。 6、cerquad表面贴装型封装之一,即用下密封的陶瓷qfp,用于封装dsp等的逻辑lsi电路。带有窗口的cerquad用于封装eprom电路。散热性比塑料qfp好,在自然空冷条件下可容许1.5~2w的功率。但封装成本比塑料qfp高3~5倍。引脚中心距有1.27mm、0.8mm、0.65mm、0.5mm、0.4mm等多种规格。引脚数从32到368。 7、clcc(ceramicleadedchipcarrier)带引脚的陶瓷芯片载体,表面贴装型封装之一,引脚从封装的四个侧面引出,呈丁字形。带有窗口的用于封装紫外线擦除型eprom以及带有eprom的微机电路等。此封装也称为qfj、qfj-g(见qfj)。 8、cob(chiponboard板上芯片封装,是裸芯片贴装技术之一,半导体芯片交接贴装在印刷线路板上,芯片与基板的电气连接用引线缝合方法实现,芯片与基板的电气连接用引线缝合方法实现,并用树脂覆盖以确保可靠性。虽然cob是最简单的裸芯片贴装技
常用元器件及元器件封装总结 一、元器件封装按照安装的方式不同可以分成两大类。(1) 直插式元器件封装直插式元器件封装的焊盘一般贯穿整个电路板,从顶层穿下,在底层进行元器件的引脚焊接,如图所示。 典型的直插式元器件及元器件封装如图所示。 (2)表贴式元器件封装。表贴式的元器件,指的是其焊盘只附着在电路板的顶层或底层,元器件的焊接是在装配元器件的工作层面上进行的,如图所示。
典型的表贴式元器件及元器件封装如图所示。在PCB元器件库中,表贴式的元器件封装的引脚一般为红色,表示处在电路板的顶层(TopLayer)。在PCB元器件库中,表贴式的元器件封装的引脚一般为红色,表示处在电路板的顶层(Top Layer)。 二、常用元器件的原理图符号和元器件封装 在设计PCB的过程中,有些元器件是设计者经常用到的,比如电阻、电容以及三端稳压源等。在Protel 99 SE中,同一种元器件虽然相同电气特性,但是由于应用的场合不同而导致元器件的封装存在一些差异。前面的章节中已经讲过,电阻由于其负载功率和运用场合不同而导致其元器件的封装也多种多样,这种情况对于电容来说也同样存在。因此,本节主要向读者介绍常用元器件的原理图符号和与之相对应的元器件封装,同时尽量给出一些元器件的实物图,使读者能够更快地了解并掌握这些常用元器件的原理图符号和元器件封装。(1)、电阻。电阻器通常简称为电阻,它是一种应用十分广泛的电子元器件,其英文名字为“Resistor”,缩写为“Res”。电阻的种类繁多,通常分为固定电阻、可变电阻和特种电阻3大类。固定电阻可按电阻的材料、结构形状及用途等进行多种分类。电阻的种类虽多,但常用的电阻类型主要为RT型碳膜电阻、RJ型金属膜电阻、RX型线绕电阻和片状电阻等。固定电阻的原理图符号的常用名称是“RES1”和“RES2”,如图F1-5(a)所示。常用的引脚封装形式为AXIAL系列,包括AXIAL-0.3、AXIAL-0.4、AXIAL-0.5、AXIAL-0.6、AXIAL-0.7、AXIAL-0.8、AXIAL-0.9和AXIAL-1.0等封装形式,其后缀数字代表两个焊盘的间距,单位为“英寸”,如图F1-5(b)所示。常用固定电阻的实物图如图F1-5(c)所示。
常用电子元件封装 电阻:RES1,RES2,RES3,RES4;封装属性为axial系列 无极性电容:cap;封装属性为RAD-0.1到rad-0.4 电解电容:electroi;封装属性为rb.2/.4到rb.5/1.0 电位器:pot1,pot2;封装属性为vr-1到vr-5 二极管:封装属性为diode-0.4(小功率)diode-0.7(大功率) 三极管:常见的封装属性为to-18(普通三极管)to-22(大功率三极管)to-3(大功率达林顿管) 电源稳压块有78和79系列;78系列如7805,7812,7820等 79系列有7905,7912,7920等 常见的封装属性有to126h和to126v 整流桥:BRIDGE1,BRIDGE2: 封装属性为D系列(D-44,D-37,D-46) 电阻:AXIAL0.3-AXIAL0.7 其中0.4-0.7指电阻的长度,一般用AXIAL0.4 瓷片电容:RAD0.1-RAD0.3。其中0.1-0.3指电容大小,一般用RAD0.1 电解电容:RB.1/.2-RB.4/.8 其中.1/.2-.4/.8指电容大小。一般<100uF用 RB.1/.2,100uF-470uF用RB.2/.4,>470uF用RB.3/.6 二极管:DIODE0.4-DIODE0.7 其中0.4-0.7指二极管长短,一般用DIODE0.4 发光二极管:RB.1/.2 集成块:DIP8-DIP40, 其中8-40指有多少脚,8脚的就是DIP8 贴片电阻 0603表示的是封装尺寸与具体阻值没有关系,但封装尺寸与功率有关通常来说如下: 0201 1/20W 0402 1/16W 0603 1/10W 0805 1/8W 1206 1/4W 电容电阻外形尺寸与封装的对应关系是:
常用电子元件封装大全 电阻:RES1,RES2,RES3,RES4;封装属性为axial系列 无极性电容:cap;封装属性为RAD-0.1到rad-0.4 电解电容:electroi;封装属性为rb.2/.4到rb.5/1.0 电位器:pot1,pot2;封装属性为vr-1到vr-5 二极管:封装属性为diode-0.4(小功率)diode-0.7(大功率) 三极管:常见的封装属性为to-18(普通三极管)to-22(大功率三极管)to-3(大功率达林顿管) 电源稳压块有78和79系列;78系列如7805,7812,7820等 79系列有7905,7912,7920等 常见的封装属性有to126h和to126v 整流桥:BRIDGE1,BRIDGE2: 封装属性为D系列(D-44,D-37,D-46) 电阻:AXIAL0.3-AXIAL0.7 其中0.4-0.7指电阻的长度,一般用AXIAL0.4 瓷片电容:RAD0.1-RAD0.3。其中0.1-0.3指电容大小,一般用RAD0.1 电解电容:RB.1/.2-RB.4/.8 其中.1/.2-.4/.8指电容大小。一般<100uF用 RB.1/.2,100uF-470uF用RB.2/.4,>470uF用RB.3/.6 二极管:DIODE0.4-DIODE0.7 其中0.4-0.7指二极管长短,一般用DIODE0.4 发光二极管:RB.1/.2 集成块:DIP8-DIP40, 其中8-40指有多少脚,8脚的就是DIP8 贴片电阻0603表示的是封装尺寸与具体阻值没有关系,但封装尺寸与功率有关通常来说如下: 0201 1/20W 0402 1/16W 0603 1/10W 0805 1/8W 1206 1/4W 电容电阻外形尺寸与封装的对应关系是:
DXP2004下Miscellaneous Devices.Intlib元件库中常用元件有: 电阻系列(res*)排组(res pack*) 电感(inductor*) 电容(cap*,capacitor*) 二极管系列(diode*,d*) 三极管系列(npn*,pnp*,mos*,MOSFET*,MESFET*,jfet*,IGBT*) 运算放大器系列(op*) 继电器(relay*) 8位数码显示管(dpy*) 电桥(bri*bridge) 光电耦合器( opto* ,optoisolator ) 光电二极管、三极管(photo*) 模数转换、数模转换器(adc-8,dac-8) 晶振(xtal) 电源(battery)喇叭(speaker)麦克风(mic*)小灯泡(lamp*)响铃(bell) 天线(antenna) 保险丝(fuse*) 开关系列(sw*)跳线(jumper*) 变压器系列(trans*) ????(tube*)(scr)(neon)(buzzer)(coax) 晶振(crystal oscillator)的元件库名称是Miscellaneous Devices.Intlib, 在search栏中输入*soc 即可。 ########### DXP2004下Miscellaneous connectors.Intlib元件库中常用元件有: (con*,connector*) (header*) (MHDR*) 定时器NE555P 在库TI analog timer circit.Intlib中 电阻AXIAL 无极性电容RAD 电解电容RB- 电位器VR 二极管DIODE
电子元器件封装图示大全 LQFP 100L METAL QUAD 100L PQFP 100L
QFP Quad Flat Package QFP Quad Flat Package TQFP 100L RIMM RIMM For Direct Rambus SBGA
SC-70 5L SDIP SIMM30 SIMM30 Pinout SIMM30 Single In-line Memory Module SIMM72 SIMM72 Pinout SIMM72 Single In-line Memory Module SIMM72 Single In-line Memory Module
SIP Single Inline Package SLOT 1 For intel Pentium II Pentium III & Celeron CPU SLOT A For AMD Athlon CPU SNAPTK SNAPTK SNAPZP SO DIMM Small Outline Dual In-line Memory Module
SO Small Outline Package SOCKET 370 For intel 370 pin PGA Pentium III & Celeron CPU SOCKET 423 For intel 423 pin PGA Pentium 4 CPU SOCKET 462/SOCKET A For PGA AMD Athlon & Duron CPU SOCKET 7 For intel Pentium & MMX Pentium CPU SOH
元器件封装大全 一、元器件封装的类型 元器件封装按照安装的方式不同可以分成两大类。 (1)直插式元器件封装。 直插式元器件封装的焊盘一般贯穿整个电路板,从顶层穿下,在底层进行元器件的引脚焊接,如图F1-1所示。 图F1-1 直插式元器件的封装示意图 典型的直插式元器件及元器件封装如图F1-2所示。 图F1-2 直插式元器件及元器件封装 (2)表贴式元器件封装。 表贴式的元器件,指的是其焊盘只附着在电路板的顶层或底层,元器件的焊接是在装配元器件的工作层面上进行的,如图F1-3所示。 焊盘贯穿整个电路板
Protel 99 SE基础教程 2 图F1-3 表贴式元器件的封装示意图典型的表贴式元器件及元器件封装如图F1-4所示。 图F1-4 表贴式元器件及元器件封装在 PCB元器件库中,表贴式的元器件封装的引脚一般为红色,表示处在电路板的顶层(Top Layer)。 二、常用元器件的原理图符号和元器件封装 在设计PCB的过程中,有些元器件是设计者经常用到的,比如电阻、电容以及三端稳压源等。在Protel 99 SE中,同一种元器件虽然相同电气特性,但是由于应用的场合不同而导致元器件的封装存在一些差异。前面的章节中已经讲过,电阻由于其负载功率和运用场合不同而导致其元器件的封装也多种多样,这种情况对于电容来说也同样存在。因此,本节主要向读者介绍常用元器件的原理图符号和与之相对应的元器件封装,同时尽量给出一些元器件的实物图,使读者能够更快地了解并掌握这些常用元器件的原理图符号和元器件封装。 (1)电阻。 电阻器通常简称为电阻,它是一种应用十分广泛的电子元器件,其英文名字为“Resistor”,缩写为“Res”。 电阻的种类繁多,通常分为固定电阻、可变电阻和特种电阻3大类。 固定电阻可按电阻的材料、结构形状及用途等进行多种分类。电阻的种类虽多,但常用的电阻类型主要为RT型碳膜电阻、RJ型金属膜电阻、RX型线绕电阻和片状电阻等。 固定电阻的原理图符号的常用名称是“RES1”和“RES2”,如图F1-5(a)所示。常用的引脚封装形式为AXIAL系列,包括AXIAL-0.3、AXIAL-0.4、AXIAL-0.5、AXIAL-0.6、AXIAL-0.7、AXIAL-0.8、AXIAL-0.9和AXIAL-1.0等封装形式,其后缀数字代表两个焊盘的间距,单位为“英寸”,如图F1-5(b)所示。常用固定电阻的实物图如图F1-5(c)所示。 焊盘只附着在电路板的顶层或底层
1 常用电子元件及封装 1、电阻 使用的贴片电阻封装常见为0603和0805两种,。一般的贴片电阻阻值精度为5%,0603封装电阻功率为1/10W,0805封装电阻功率为1/8W。中发通常100只起售 如图: 直插封装的电阻用于大功率的场合,体积越大的功率越大,一般1/4W的就够用了 2、电容 电容的容值小于等于100nF时,可以使用0603或0805封装贴片陶瓷电容。智能车上最常用的容值为100nF(104),容值精度为20%,耐压50V。 如图:
电容的容值大于100nF时,要根据应用场合的需要来选择使用贴片钽电容、贴片陶瓷电容或直插式铝电解电容。 贴片钽电容特点是贵、稳定、高频特性好。常用的容值为10uF、100uF、470 uF 等,耐压应取工作电压的二倍以上。注意使用时极性不要接反,带杠的是正极。 如图: 贴片陶瓷电容是新兴的替代小型贴片钽电容的产品,小容量(如10uF)价格较贴片钽电容便宜得多,体积基本相同。具有同样良好的高频特性和更低的内阻,但容量随温度变化大,适合用在电源的整流和去耦方面。 如图:
直插式铝电解电容最大的特点就是便宜,和其他电容相比,单位容量价格最低。它也是用于电源的整流和去耦方面,常用的容值为100uF、470uF、1000uF等。缺点是自身带有感性,使用时需并联陶瓷电容以提高高频性能。容值精度较低且随温度变化,寿命相对较短。有极性不可反接,带杠的是负极。 如图: 3、电感 电感使用1315和0808两种直插封装: 1315封装电感如下图:
0808封装电感如下图:
4、二极管
整流二极管(1N4007),高速二极管(FR157、1N4148),肖特基二极管(1N5819、1N5822),瞬态电压抑制二极管(P6KE),必须使用括号内标明的型号或用与之性能相近的型号替换,建议使用贴片封装。 发光二极管(LED)有0603、0805、1206、1210等贴片封装和Φ3、Φ5等直插封装,封装体积越大亮度越高,可承受的电流也越大。颜色自选(蓝、紫、白这三种颜色的LED较贵)。二极管带杠、带点、腿短一端为负极。
电子元件封装大全及封装常识 一、什么叫封装 封装,就是指把硅片上的电路管脚,用导线接引到外部接头处,以便与其它器件连接.封装形式是指安装半导体集成电路芯片用的外壳。它不仅起着安装、固定、密封、保护芯片及增强电热性能等方面的作用,而且还通过芯片上的接点用导线连接到封装外壳的引脚上,这些引脚又通过印刷电路板上的导线与其他器件相连接,从而实现内部芯片与外部电路的连接。因为芯片必须与外界隔离,以防止空气中的杂质对芯片电路的腐蚀而造成电气性能下降。另一方面,封装后的芯片也更便于安装和运输。由于封装技术的好坏还直接影响到芯片自身性能的发挥和与之连接的PCB(印制电路板)的设计和制造,因此它是至关重要的。 衡量一个芯片封装技术先进与否的重要指标是芯片面积与封装面积之比,这个比值越接近1越好。封装时主要考虑的因素: 1、芯片面积与封装面积之比为提高封装效率,尽量接近1:1; 2、引脚要尽量短以减少延迟,引脚间的距离尽量远,以保证互不干扰,提高性能; 3、基于散热的要求,封装越薄越好。 封装主要分为DIP双列直插和SMD贴片封装两种。从结构方面,封装经历了最早期的晶体管TO(如TO-89、TO92)封装发展到了双列直插封装,随后由PHILIP 公司开发出了SOP小外型封装,以后逐渐派生出SOJ(J型引脚小外形封装)、TSOP(薄小外形封装)、VSOP(甚小外形封装)、SSOP(缩小型SOP)、TSSOP (薄的缩小型SOP)及SOT(小外形晶体管)、SOIC(小外形集成电路)等。从材料介质方面,包括金属、陶瓷、塑料、塑料,目前很多高强度工作条件需求的电路如军工和宇航级别仍有大量的金属封装。