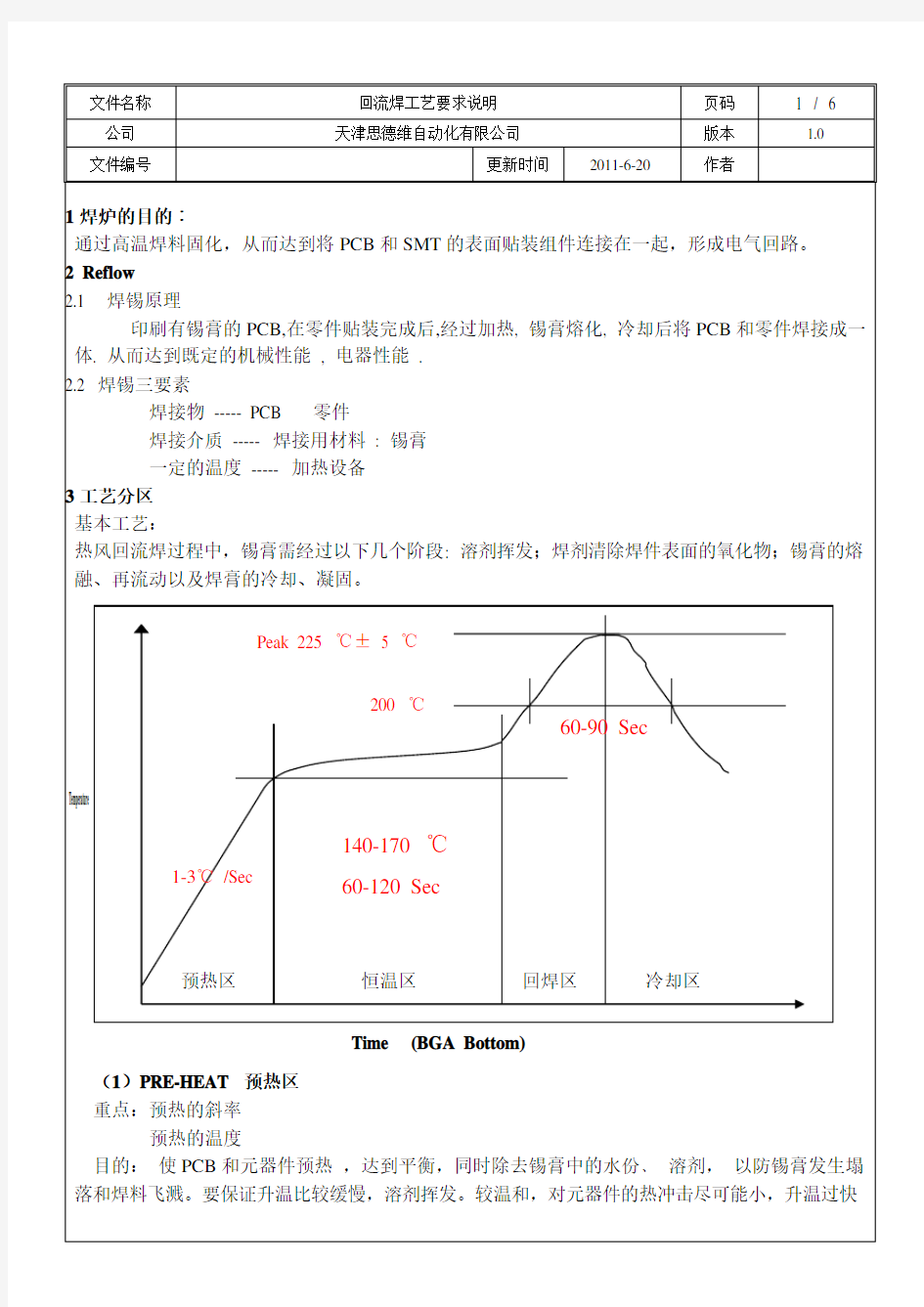

原因
1. 锡膏量太多(≧1mg/mm)
2. 印刷不精确
3. 锡膏塌陷
4. 刮刀压力太高
原因对策
1. 零件脚或锡球不平检查零件脚或锡球之平面度
2. 锡膏量太少增加钢板厚度和使用较小的开孔
3. 灯蕊效应锡膏先经烘烤作业
4. 零件脚不吃锡零件必需符合吃锡之需求
原因对策
1. 焊垫设计不当将锡垫以防焊膜分隔开,尺寸适切
2. 两端受热不均同零件的锡垫尺寸都要相同
3. 锡膏量太少增加锡膏量
4. 零件吃锡性不佳零件必需符合吃锡之需求
4.4 SMD 零件浮动(漂移)
原因对策
1. 零件两端受热不均锡垫分隔
2. 零件一端吃锡性不佳使用吃锡性较佳的零件
3. Reflow方式在Reflow 前先预热到
4.5 立碑 ( Tombstone) 效应
原因
1. 焊垫设计不当
2. 零件两端吃锡性不同
3. 零件两端受热不均
4. 温度曲线加热太快
原因
原因对策
1. Reflow 温度太低较高的Reflow
2. Reflow 时间太短较长的Reflow
3. 锡膏污染新的新鲜锡膏
4. PCB 或零件污染
4.8 零件微裂(Cracks in components)(龟裂)
通孔回流焊接的作用 一.什么叫通孔回流焊接技 在传统的电子组装工艺中,对于安装有过孔插装元件采用波峰焊接技术。但波峰焊接有许多不足之处:不适合高密度、细间距元件焊接;桥接、漏焊较多;需喷涂助焊剂; PCB板受到较大热冲击翘曲变形。因此波峰焊接在许多方面不能适应高精密度电子组装技术的发展。为了适应这种高精密度表面组装技术的发展,解决以上焊接难点的措施是采用通孔回流焊接技(THRThrough-holeReflow),又称为穿孔回流焊PIHR(Pin-in-HoleReflow)。该技术原理是在PCB板完成贴片后,使用一种安装有许多针管的特殊钢网模板,调整模板位置使针管与插装元件的过孔焊盘对齐,使用刮刀将模板上的锡膏漏印到焊盘上,然后安装插装元件,最后插装元件与贴片元件同时通过回流焊完成焊接。从中可以看出穿孔回流焊相对于传统工艺的优越性:首先是减少了工序,省去了波峰焊这道工序,节省了人工费用,在效率上也得到了提高;其次回流焊相对于波峰焊,产生桥接的可能性要小的多,这样就提高了一次通过率。穿孔回流焊相对传统工艺在生产效率、先进性上都有很大优势。通孔回流焊接技术起源于日本SONY公司,20世纪90年代初已开始应用,但它主要应用于SONY自己的产品上,如电视调谐器及CDWalkman。 通孔回流焊有时也称作分类元件回流焊,正在逐渐兴起。它可以去除波峰焊环节,而成为PCB混装技术中的一个工艺环节。通孔回流焊最大的好处就是可以在发挥表面贴装制造工艺的优点的同时使用通孔插件来得到较好的机械联接强度。对于较大尺寸的PCB板的平整度不能够使所有表面贴装元器件的引脚都能和焊盘接触,同时,就算引脚和焊盘都能接触上,它所提供的机械强度也往往是不够大的,很容易在产品的使用中脱开而成为故障点。尽管通孔回流焊可发取得偿还好处,但是在实际应用中通孔回流焊仍有几个缺点,锡膏量大,这样会增加因助焊剂的挥了冷却而产生对机器污染的程度,需要一个有效的助焊剂残留清除装置。通孔回流焊另外一点是许多连接器并没有设计成可以承受通孔回流焊的温度,早期通孔回流焊基于直接红外加热的回流焊炉子已不能适用,这种回流焊炉子缺少有效的热传递效率来处理一般表面贴装元件与具有复杂几何外观的通孔连接器同在一块PCB上的能力。只有大容量的具有高的热传递的强制对流通孔回流焊炉子,才有可能实现通孔回流,并且也得到实践证明,剩下的问题就是如何保证通孔中的锡膏与元件脚有一个适当的回流焊温度曲线。随着工艺与元件的改进,通孔回流焊也会越来越多被应用。影响回流焊工艺的因素很多,也很复杂,需要工艺人员在生产中不断研究探讨,将从多个方面来进行探讨。 二.通孔回流焊接工艺的特点 1. 通孔回流焊与波峰焊相比的优点 (1)通孔回流焊焊接质量好,不良比率PPM(百万分率的缺陷率)可低于20。 (2)虚焊、连锡等缺陷少,返修率极低。 (3)PCB布局的设计无须像波峰焊工艺那样特别考虑。 (4)工艺流程简单,设备操作简单。 (5)通孔回流焊设备占地面积少,因其印刷机及回流炉都较小,故只需较小的面积。 (6)无锡渣问题。 (7)机器为全封闭式,干净,生产车间里无异味。 (8)通孔回流焊设备管理及保养简单。 (9)印刷工艺中采用了印刷模板,各焊接点及印刷的焊膏量可根据需要调节。
回流焊工艺常用中英文术语 1. Solder Paste Technology(焊膏工艺) Solder Powder ( 锡粉) 休息再来接着说。 Solder Paste Rheology(锡膏流变学) Solder Paste Composition & Manufacturing(锡膏成分和制造) 2. Fundamentals of Solders and Soldering(焊料及焊接基础知识) Soldering Theory(焊接理论) Microstructure and Soldering(显微结构及焊接) Effect of Elemental Constituents on Wetting(焊料成分对润湿的影响) Effect of Impurities on Soldering(杂质对焊接的影响) 3. SMT Problems Occurred Prior to Reflow(回流前SMT问题) Flux Separation(助焊剂分离) Paste Hardening(焊膏硬化) Poor Stencil Life(网板寿命问题) Poor Print Thickness(印刷厚度不理想) Poor Paste Release From Squeegee(锡膏脱离刮刀问题) Smear(印锡模糊) Insufficiency(印锡不足) Needle Clogging(针孔堵塞) Slump(塌落) Low Tack(低粘性) Short Tack Time (粘性时间短) 4. SMT Problems Occurred During Reflow(回流过程中的SMT问题) Cold Joints(冷焊) Nonwetting(不润湿) Dewetting(反润湿) Leaching(浸析) Interllics(金属互化物) Tombstoning(立碑) Skewing(歪斜) Wicking(焊料上吸) Bridging(桥连) Voiding(空洞) Opening(开路) Solder Balling(锡球) Solder Beading(锡珠) Spattering(飞溅)
回流焊机原理以及工艺 1.什么是回流焊 回流焊是英文Reflow是通过重新熔化预先分配到印制板焊盘上的膏装软钎焊料,实现表面组装元器件焊端或引脚与印制板焊盘之间机械与电气连接的软钎焊。回流焊是将元器件焊接到PCB板材上,回流焊是对表面帖装器件的。回流焊是靠热气流对焊点的作用,胶状的焊剂在一定的高温气流下进行物理反应达到SMD的焊接;之所以叫"回流焊"是因为气体在焊机内循环流动产生高温达到焊接目的。 回流焊机原理分为几个描述: (回流焊温度曲线图) A.当PCB进入升温区时,焊膏中的溶剂、气体蒸发掉,同时,焊膏中的助焊剂润湿焊盘、元器件端头和引脚,焊膏软化、塌落、覆盖了焊盘,将焊盘、元器件引脚与氧气隔离。 B.PCB进入保温区时,使PCB和元器件得到充分的预热,以防PCB突然进入焊接高温区而损坏PCB和元器件。 C.当PCB进入焊接区时,温度迅速上升使焊膏达到熔化状态,液态焊锡对PCB的焊盘、元器件端头和引脚润湿、扩散、漫流或回流混合形成焊锡接点。 D.PCB进入冷却区,使焊点凝固此;时完成了回流焊。 2.回流焊机流程介绍 回流焊加工的为表面贴装的板,其流程比较复杂,可分为两种:单面贴装、双面贴装。 A,单面贴装:预涂锡膏→贴片(分为手工贴装和机器自动贴装)→回流焊→
检查及电测试。 B,双面贴装:A面预涂锡膏→贴片(分为手工贴装和机器自动贴装)→回流焊→B面预涂锡膏→贴片(分为手工贴装和机器自动贴装)→回流焊→检查及电测试。 回流焊的最简单的流程是"丝印焊膏--贴片--回流焊,其核心是丝印的准确,对贴片是由机器的PPM来定良率,回流焊是要控制温度上升和最高温度及下降温度曲线。" 回流焊机工艺要求 回流焊技术在电子制造领域并不陌生,我们电脑内使用的各种板卡上的元件都是通过这种工艺焊接到线路板上的。这种工艺的优势是温度易于控制,焊接过程中还能避免氧化,制造成本也更容易控制。这种设备的内部有一个加热电路,将氮气加热到足够高的温度后吹向已经贴好元件的线路板,让元件两侧的焊料融化后与主板粘结。 1.要设置合理的再流焊温度曲线并定期做温度曲线的实时测试。 2.要按照PCB设计时的焊接方向进行焊接。 3.焊接过程中严防传送带震动。 4.必须对首块印制板的焊接效果进行检查。 5.焊接是否充分、焊点表面是否光滑、焊点形状是否呈半月状、锡球和残留物的情况、连焊和虚焊的情况。还要检查PCB表面颜色变化等情况。并根据检查结果调整温度曲线。在整批生产过程中要定时检查焊接质量。 影响工艺的因素: 1.通常PLCC、QFP与一个分立片状元件相比热容量要大,焊接大面积元件就比小元件更困难些。 2.在回流焊炉中传送带在周而复使传送产品进行回流焊的同时,也成为一个散热系统,此外在加热部分的边缘与中心散热条件不同,边缘一般温度偏低,炉内除各温区温度要求不同外,同一载面的温度也差异。 3.产品装载量不同的影响。回流焊的温度曲线的调整要考虑在空载,负载及不同负载因子情况下能得到良好的重复性。负载因子定义为: LF=L/(L+S);其中L=组装基板的长度,S=组装基板的间隔。回流焊工艺要得到重复性好的结果,负载因子愈大愈困难。通常回流焊炉的最大负载因子的范围为0.5~0.9。这要根据产品情况(元件焊接密度、不同基板)和再流炉的不同型号来决定。要得到良好的焊接效果和重复性,实践经验很重要的。 3.回流焊机技术有那些优势? (1)再流焊技术进行焊接时,不需要将印刷电路板浸入熔融的焊料中,而是采用局部加热的方式完成焊接任务的;因而被焊接的元器件受到热冲击小,不会因过热造成元器件的损坏。 (2)由于在焊接技术仅需要在焊接部位施放焊料,并局部加热完成焊接,因而避免了桥接等焊接缺陷。 (3)再流焊技术中,焊料只是一次性使用,不存在再次利用的情况,因而焊料很纯净,没有杂质,保证了焊点的质量。 4.回流焊机的注意事项 1.为确保人身安全,操作人员必须把厂牌及挂饰摘下,袖子不能过于松垮。
回流焊接工艺 回流焊接是表面贴装技术(SMT)特有的重要工艺,焊接工 艺质量的优劣不仅影响正常生产,也影响最终的质量和可靠性。在使用表面贴装元件的印刷电路板(PCB)装配中,要得到优质的 焊点,一条优化的回流温度曲线是最重要的因素之一。温度曲线是施加于电路装配上的温度对时间的函数,当在笛卡尔平面作图时,回流过程中在任何给定的时间上,代表 PCB 上一个特定点上的温度形成一条曲线。几个参数影响曲线的形状,其中最关键的是传送带速度和每个温区的温度设定。链速决定基板暴露在每个温区所设定的温度下的持续时间,增加持续时间可以允许更多时间使电路装配接近该温区的温度设定。每个温区所花的持续时间总和决定总共的处理时间。每个区的温度设定影响 PCB 的温度上升速度。增加温区的设定温度允许基板更快地达到给定温度。因此,必须作出一个较好的图形来决定 PCB 的温度曲线,理想的温度曲线由基本的四个区组成,前面三个区加热、最后一个区冷却。回流炉的温区越多,越能使温度曲线的轮廓达到更准确和接近设定。大多数锡膏都能用四个基本温区成功回流。在回流焊接过程中,锡膏需经过溶剂挥发;焊剂清除焊件表面的氧化物;锡膏的熔融、再流动以及锡膏的冷却、凝固。以下就对温度曲线图及四个区进行介绍: 1
Peak: 熔点 220℃以 上 210~220℃ 180℃150℃ 时间 S 250S 200S 150S 100S 50S 预热区:也叫斜坡区。目的:使 PCB 和元器件预热,达到平衡,同时除去焊膏中的水份、溶剂,以防焊膏发生塌落和焊料飞溅。要保 证升温比较缓慢,溶剂挥发。较温和,对元器件的热冲击尽可能小, 在这个区,尽量将升温速度控制在 2~5℃/S,较理想的升温速度为 1~3 ℃/S,时间控制在 60~90S 之间。升温过快会造成对元器件的 伤害,如会引起多层陶瓷电容器开裂。同时还会造成焊料飞溅,使 在整个PCB的非焊接区域形成焊料球以及焊料不足的焊点。而温度上 升太慢,锡膏会感温过度,没有足够的时间使 PCB 达到活性温度。锡 炉的预热区一般占整个加热通道长度的 25~33%。 保温区:也称活性区、有时叫做干燥或浸润区。目的:保证在达到回流温度之前焊料能完全干燥,同时还起着焊剂活化的作用,清除 元器件、焊盘、焊粉中的金属氧化物。在这个阶段助焊剂开始挥发,
SMT回流焊工艺详细介绍 SMT回流焊工艺详细介绍 回流焊接是用在SMT装配工艺中的主要板级互连方法,这种焊接方法把所需要的焊接特性极好地结合在一起,这些特性包括易于加工、对各种SMT设计有广泛的兼容性,具有高的焊接可靠性以及成本低等. 然而,在回流焊接被用作为最重要的SMT元件级和板级互连方法的时候,它也受到要求进一步改进焊接性能的挑战,事实上,回流焊接技术能否经受住这一挑战将决定焊膏能否继续作为首要的SMT焊接材料,尤其是在超细微间距技术不断取得进展的情况之下。 下面我们将探讨影响改进回流焊接性能的几个主要问题 一,未焊满未焊满是在相邻的引线之间形成焊桥。 通常,所有能引起焊膏坍落的因素都会导致未焊满,这些因素包括: 1,升温速度太快; 2,焊膏的触变性能太差或是焊膏的粘度在剪切后恢复太慢; 3,金属负荷或固体含量太低; 4,粉料粒度分布太广; 5;焊剂表面张力太小。但是,坍落并非必然引起未焊满,在软熔时,熔化了的未焊满焊料在表面张力的推动下有断开的可能,焊料流失现象将使未焊满问题变得更加严重。在此情况下,由于焊料流失而聚集在某一区域的过量的焊料将会使熔融焊料变得过多而不易断开。 除了引起焊膏坍落的因素而外,下面的因素也引起未满焊的常见原因: 1,相对于焊点之间的空间而言,焊膏熔敷太多; 2,加热温度过高; 3,焊膏受热速度比电路板更快; 4,焊剂润湿速度太快; 5,焊剂蒸气压太低; 6;焊剂的溶剂成分太高; 7,焊剂树脂软化点太低。 二,断续润湿焊料膜的断续润湿是指有水出现在光滑的表面上,这是由于焊料能粘附在大多数的固体金属表面上,并且在熔化了的焊料覆盖层下隐藏着某些未被润湿的点,因此,在最初用熔化的焊料来覆盖表面时,会有断续润湿现象出现。 消除断续润湿现象的方法是: 1,降低焊接温度; 2,缩短软熔的停留时间; 3,采用流动的惰性气氛; 4,降低污染程度。
回流焊工艺调试管理规程拟制日期 审核日期 批准日期
修订记录
目录 1 目的 (4) 2 适用范围 (4) 3 定义----------------------------------------------------------------------------------------------------------------------------------------------4 4 职责---------------------------------------------------------------------------------------------------------------------------------------4 5 内容 (4) 5.1 回流炉回流曲线,红胶固化曲线工艺窗口定义 ------------------------------------------------------------------------------------4 5.2回流炉程序命名规则 (6) 5.3回流炉程序制作及优化 (6) 5.4回流炉程序的使用 (7) 5.5 回流炉温度的测试-----------------------------------------------------------------------------------------------------------------------8 5.6回流曲线的保存 (8) 6 注意事项 (8) 7 参考文档 (9) 8 补充说明 (9) 附回流炉标准程序参数设置表: (9)
回流焊的基本工艺 回流焊的过程中焊膏需要经过的以下几个阶段: 溶剂的挥发 焊剂清除被焊件表面的氧化物,焊膏的溶剂以及焊膏的冷却 凝固。回流焊的关键在于温度的控制,整个过程大约需要4-5分钟完成,从预热到冷却根据PCB材质不同,元件多少来确定准确定的焊接时间和温度。 1.预热区: 主要的目的是使PCB和元件预热到热平衡状态,同时去除锡膏中的水份溶剂,以防锡膏发生塌落和焊料飞溅问题,从室温升到100-150度典型的升温斜率为2-3.5度/秒,一般不超过4度/秒,要保证升温比较缓慢均匀,溶剂的挥发较为温和,对元器件的热冲击尽可能最小,升温过快会造成对元器件的损伤,如:会引起多层陶瓷电容器开裂,同时还会造成焊料飞溅使在整个PCB的非焊接区域形成焊料球以及焊料不足的缺陷。 2.活化区: 主要是保证在达到回流焊温度之前,焊料能够完全干燥,同时还起着焊机活化作用,清除元器件 焊盘 焊粉中的金属氧化物。一般时间在60-120秒,根据PCB材质 焊料性能有些差异。(助焊剂开始滚动起到活化作用的温度是165-175度,时间根据元件PCB焊盘的氧化程度决定) 3.回流焊接区: 焊膏中的焊料合金粉开始熔化,显现出流动状态,替代液态助焊剂润湿元件焊盘和元件焊端,这种润湿作用导致焊料进一步扩展,对于大多数焊料而言这种状态下的时间约为30-60秒,回流焊区的温度要高于锡膏熔点温度,一般要超过20度左右,才能保障回流焊的质量,不同的焊料熔点不同需要注意区分。有时改区域还划分为:熔融区和回焊区。(最高温度一般我们定义平均值,而不是一个瞬时间的顶峰值,PCB上有BGA时尤其要注意)
4.冷却区: 焊料随温度的降低而凝固,是元器件于焊膏形成良好的电接触,冷却速率要比预热速率略高,一般冷却速率为不低于5度/秒。
Q/ZDJG 青岛智动精工电子有限公司企业标准 Q/ZDJG G0204.3.34-2015 回流焊接工艺规范 青岛智动精工电子有限公司发布
Q/ZDJG G0204.3.34-2015 前言 本标准由青岛智动精工电子有限公司质量部提出。 本标准由青岛智动精工电子有限公司质量部起草。 本标准由青岛智动精工电子有限公司质量部负责解释。 本标准的修改状态为1/A。 本标准主要起草人:徐龙会 审核:日期:年月日 批准:日期:年月日
Q/ZDJG G0204.3.34-2015 回流焊接工艺规范 1 主题内容与适用范围 本工艺守则规定了生产中回流焊炉温测试、曲线确认等的工艺要求。适用于公司SMT车间回流焊生产工艺的管理。 2 规范性引用文件 无 3术语和定义 3.1回流温度曲线 回流温度曲线是指PCB基板在经过回流炉过程中板上指定位置的温度随时间的变化曲线,使焊锡膏受热融化从而让表面贴装元器件和PCB焊盘通过焊锡膏合金可靠地结合在一起。 3.2 固化温度曲线 固化温度曲线是指PCB基板在经过回流炉过程中板上指定位置的温度随时间的变化曲线,使贴片红胶受热固化从而让表面贴装元器件和PCB通过粘接可靠地结合在一起。 4职能部门与职责分工 质量部负责回流焊工艺规范的制定、监督和检查。 制造部负责按要求进行确认、操作。 5 管理内容和要求 5.1 管理流程图
5.2 炉温生成与管理要求 5.2.1 根据锡膏的技术规格书、推荐的炉温曲线要求和合金的生成原理初步设计出总体的制程界限,然后根据生产板件的板材、镀层特性、尺寸和布局的复杂程度设计出制程界限,如下表: 5.2.2 根据回流炉类型、特点和制程界限测定每种炉温类型在每条线体的《回流炉参数设定表》。 5.2.3 新品试制时,根据元器件资料(是否有耐热要求等)和PCB布局判断该产品是否符合现有的炉温类型,若没有,则需综合考虑PCB、元器件特殊要求、锡膏需求的制程界限、生产效率等方面生成新的炉温类型。 5.2.4 新生成的炉温类型或因焊接异常需要调整设置的炉温类型应经相关负责人和主管审核和批准,更新至《回流炉参数设定表》。 5.3 炉温测试板制作与管理要求 5.3.1制作测温板时尽量选取与生产基板相同或相似的报废基板。 5.3.2 在导入新品时,若产品有特殊要求、特殊元件和特殊板材,需要生产新的炉温类型,则必须制作相对应的特殊测温板或经客户同意使用通用的炉温测试板。 5.3.3主板复杂面的测温板应至少有5个测温点,主板简单面、副板和红胶板的测温板应至少有4个测温点,并均匀的分布在PCB板上。选择测温点时,外协产品测温点应包括:大型的BGA、QFP、电解电容、电感等元件,通信产品应包括BGA、QFP、连接器、UIM卡、TLLASH卡等元件。 5.3.4 测温点可使用高温胶、高温胶带或高温锡丝进行固定,测温固定点应尽量小,固定时引线暴露部分应尽量短,以免影响测温效果。 5.3.5 测温板制作完毕后应进行编号,如A类产品编号为RPT-A等,并标明启用日期。 5.3.6 测温板启用前必须经产品工艺确认所做测温板是否合格,判定合格后方可使用。 5.3.7 测温板每次使用后必须在《测温板使用记录表》对应测温板后依次打“√”以示使用次数,单个测试板的最多使用次数为50次。
回流焊工艺 (一)摘要:由于电子产品PCB板不断小型化的需要,出现了片状元件,传统的焊接方法已不能适应需要。首先在混合集成电路板组装中采用了回流焊工艺,组装焊接的元件多数为片状电容、片状电感,贴装型晶体管及二极管等。随着SMT整个技术发展日趋完善,多种贴片元件(SMC)和贴装器件(SMD)的出现,作为贴装技术一部分的回流焊工艺技术及设备也得到相应的发展,其应用日趋广泛,几乎在所有电子产品领域都已得到应用,而回流焊技术,围绕着设备的改进也经历以下发展阶段。 (二)技术产生背景:由于电子产品PCB板不断小型化的需要,出现了片状元件,传统的焊接方法已不能适应需要。起先,只在混合集成电路板组装中采用了回流焊工艺,组装焊接的元件多数为片状电容、片状电感,贴装型晶体管及二极管等。随着SMT整个技术发展日趋完善,多种贴片元件(SMC)和贴装器件(SMD)的出现,作为贴装技术一部分的回流焊工艺技术及设备也得到相应的发展,其应用日趋广泛,几乎在所有电子产品领域都已得到应用。 (三)发展阶段:根据产品的热传递效率和焊接的可靠性的不断提升,回流焊大致可分为五个发展阶段 第一代:热板传导回流焊设备:热传递效率最慢,5-30 W/m2K(不同材质的加热效率不一样),有阴影效应. 第二代:红外热辐射回流焊设备:热传递效率慢,5-30W/m2K(不同材质的红外辐射效率不一样),有阴影效应,元器件的颜色对吸热量有大的影响。 第三代:热风回流焊设备:热传递效率比较高,10-50 W/m2K,无阴影效应,颜色对吸热量没有影响。 第四代:气相回流焊接系统:热传递效率高,200-300 W/m2K,无阴影效应,焊接过程需要上下运动,冷却效果差。 第五代真空蒸汽冷凝焊接(真空汽相焊)系统:密闭空间的无空洞焊接,热传递效率最高,300 W-500W/m2K。焊接过程保持静止无震动。冷却效果优秀,颜色对吸热量没有影响 (四)回流焊的工作原理:再流焊又称回流焊。它主要用于贴片元器件的焊接上。再流焊技术是将焊料加工成一定颗粒的,并伴以适当的液态粘合剂,使之成为具有一定流动性的糊状焊膏,用它把将贴片元器件粘在印制电路板上,
1. 什么是回流焊? 回流焊是英文Reflow是通过重新熔化预先分配到印制板焊盘上的膏装软钎焊料,实现表面组装元器件焊端或引脚与印 制板焊盘之间机械与电气连接的软钎焊。回流焊是将元器件焊接到PCB板材上,回流焊是对表面帖装器件的。回流焊 是靠热气流对焊点的作用,胶状的焊剂在一定的高温气流下进行物理反应达到SMD的焊接;之所以叫“回流焊"是因为气 体在焊机内循环流动产生高温达到焊接目的。 回流焊温度曲线图: A. 当PCB进入升温区时,焊膏中的溶剂、气体蒸发掉,同时,焊膏中的助焊剂润湿焊盘、元器件端头和引脚,焊膏软化、塌落、覆盖了焊盘,将焊盘、元器件引脚与氧气隔离。 B. PCB进入保温区时,使PCB和元器件得到充分的预热,以防PCB突然进入焊接高温区而损坏PCB和元器件。 C. 当PCB进入焊接区时,温度迅速上升使焊膏达到熔化状态,液态焊锡对PCB的焊盘、元器件端头和引脚润湿、扩散、 漫流或回流混合形成焊锡接点。 D. PCB进入冷却区,使焊点凝固此;时完成了回流焊。 2. 回流焊流程介绍 回流焊工作流程图 回流焊加工的为表面贴装的板,其流程比较复杂,可分为两种:单面贴装、双面贴装。 A,单面贴装:预涂锡膏-贴片(分为手工贴装和机器自动贴装)-回流焊-检查及电测试。 B,双面贴装:A面预涂锡膏-贴片(分为手工贴装和机器自动贴装)-回流焊- B面预涂锡膏-贴片(分为手工贴装 和机器自动贴装)-回流焊-检查及电测试。 回流焊的最简单的流程是“丝印焊膏--贴片--回流焊,其核心是丝印的准确,对贴片是由机器的PPM来定良率,回流焊 是要控制温度上升和最高温度及下降温度曲线。 回流焊工艺要求 回流焊技术在电子制造领域并不陌生,我们电脑内使用的各种板卡上的元件都是通过这种工艺焊接到线路板上的。这 种工艺的优势是温度易于控制,焊接过程中还能避免氧化,制造成本也更容易控制。这种设备的内部有一个加热电路, 将氮气加热到足够高的温度后吹向已经贴好元件的线路板,让元件两侧的焊料融化后与主板粘结。 1. 要设置合理的再流焊温度曲线并定期做温度曲线的实时测试。 2. 要按照PCB设计时的焊接方向进行焊接。 3. 焊接过程中严防传送带震动。 4. 必须对首块印制板的焊接效果进行检查。 5. 焊接是否充分、焊点表面是否光滑、焊点形状是否呈半月状、锡球和残留物的情况、连焊和虚焊的情况。还要检查PCB表面颜色变化等情况。并根据检查结果调整温度曲线。在整批生产过程中要定时检查焊接质量。 影响工艺的因素:? 1. 通常PLCC QFP与一个分立片状元件相比热容量要大,焊接大面积元件就比小元件更困难些。 2. 在回流焊炉中传送带在周而复使传送产品进行回流焊的同时,也成为一个散热系统,此外在加热部分的边缘与中心散热条件不同,边缘一般温度偏低,炉内除各温区温度要求不同外,同一载面的温度也差异。 3. 产品装载量不同的影响。回流焊的温度曲线的调整要考虑在空载,负载及不同负载因子情况下能得到良好的重复性。 负载因子定义为:LF=L/(L+S);其中L=组装基板的长度,5=组装基板的间隔。回流焊工艺要得到重复性好的结果,负载因子愈大愈困难。通常回流焊炉的最大负载因子的范围为0.5?0.9。这要根据产品情况 (元件焊接密度、不同基板) 和再流炉的不同型号来决定。要得到良好的焊接效果和重复性,实践经验很重要的。 3. 回流焊技术有那些优势?? (1 )再流焊技术进行焊接时,不需要将印刷电路板浸入熔融的焊料中,而是采用局部加热的方式完成焊接任务的;因 而被焊接的元器件受到热冲击小,不会因过热造成元器件的损坏。 (2 )由于在焊接技术仅需要在焊接部位施放焊料,并局部加热完成焊接,因而避免了桥接等焊接缺陷。 (3)再流焊技术中,焊料只是一次性使用,不存在再次利用的情况,因而焊料很纯净,没有杂质,保证了焊点的质量。 4. 回流焊的注意事项
SMT回流焊常见缺陷分析及处理 不润湿(Nonwetting)/润湿不良(Poor Wetting) 通常润湿不良是指焊点焊锡合金没有很好的铺展开来,从而无法得到良好的焊点并直接影响到焊点的可 靠性。 产生原因: 1.焊盘或引脚表面的镀层被氧化,氧化层的存在阻挡了焊锡与镀层之间的接触; 2.镀层厚度不够或是加工不良,很容易在组装过程中被破坏; 3.焊接温度不够。相对SnPb而言,常用无铅焊锡合金的熔点升高且润湿性大为下降,需要更高的焊接温 度来保证焊接质量; 4.预热温度偏低或是助焊剂活性不够,使得助焊剂未能有效去除焊盘以及引脚表面氧化膜; 5.还有就是镀层与焊锡之间的不匹配业有可能产生润湿不良现象; 6.越来越多的采用0201以及01005元件之后,由于印刷的锡膏量少,在原有的温度曲线下锡膏中的助焊 剂快速的挥发掉从而影响了锡膏的润湿性能; 7.钎料或助焊剂被污染。 防止措施: 1.按要求储存板材以及元器件,不使用已变质的焊接材料; 2.选用镀层质量达到要求的板材。一般说来需要至少5μm厚的镀层来保证材料12个月内不过期; 3.焊接前黄铜引脚应该首先镀一层1~3μm的镀层,否则黄铜中的Zn将会影响到焊接质量; 4.合理设置工艺参数,适量提高预热或是焊接温度,保证足够的焊接时间; 5.氮气保护环境中各种焊锡的润湿行为都能得到明显改善; 6.焊接0201以及01005元件时调整原有的工艺参数,减缓预热曲线爬伸斜率,锡膏印刷方面做出调整。 黑焊盘(Black Pad) 黑焊盘: 指焊盘表面化镍浸金(ENIG)镀层形态良好,但金层下的镍层已变质生成只要为镍的氧化物的脆性黑色物 质,对焊点可靠性构成很大威胁。 产生原因:黑盘主要由Ni的氧化物组成,且黑盘面的P含量远高于正常Ni面,说明黑盘主要发生在槽 液使用一段时间之后。 1.化镍层在进行浸金过程中镍的氧化速度大于金的沉积速度,所以产生的镍的氧化物在未完全溶解之前 就被金层覆盖从而产生表面金层形态良好,实际镍层已发生变质的现象; 2.沉积的金层原子之间比较疏松,金层下面的镍层得以有继续氧化的机会。在GalvanicEffect的作用 下镍层会继续劣化。 防止措施: 目前还没有切实有效防止措施的相关报道,但可以从以下方面进行改善: 1.减少镍槽的寿命,生产中严格把关,控制P的含量在7%左右。镍槽使用寿命长了之后其中的P含量 会增加,从而会加快镍的氧化速度; 2.镍层厚度至少为4μm,这样可以使得镍层相对平坦;金层厚度不要超过0.1μm,过多的金只会使焊点 脆化; 3.焊前烘烤板对焊接质量不会起太大促进作用。黑焊盘在焊接之前就已经产生,烘烤过度反而会使镀层 恶化; 4.浸金溶液中加入还原剂,得到半置换半还原的复合金层,但成本会提高2.5倍。
目录 目录 (1) 第1章回流焊接过程确认概述 (3) 1.1任务来源 (3) 1.2确认过程 (3) 1.3时间与进度 (3) 第2章回流焊接过程确认计划 (4) 2.1回流焊接过程描述及评价 (4) 2.2回流焊接过程的输入及输出产品的接受准则: (4) 2.3回流焊过程参数及验证项目的确定(IQ、OQ、PQ) (4) 2.4回流过程人员人力资源要求 (6) 2.5回流焊过程再确认条件 (6) 2.6回流焊过程确认输出 (7) 2.7回流焊过程确认小组人员及职责 (7) 第3章IQ (8) 3.1安装查检表 (8) 3.2试机 (8) 3.3校准 (8) 3.4结论 (8) 第4章OQ (9) 4.1验证说明 (9) 4.2原材料合格验证 (9) 4.3炉温曲线验证 (9) 4.4结论 (17) 第5章PQ (18) 5.1同一批之间的重复性验证 (18) 5.2不同批之间的重复性验证 (19) 5.3结论 (23) 第6章过程变异因数的控制 (24) 6.1回流焊温度的控制 (24) 6.2测温板的控制 (24) 6.3炉温监测的控制 (24) 6.4回流焊参数的控制 (24) 6.5产品外观检验控制 (24) 第7章回流焊过程再确认条件 (25) 第8章回流焊接过程确认输出文档/文件列表 (26) 8.1炉温曲线图 (26) 8.2相关设备/工艺文件 (26)
8.3人员培训记录表 (26) 8.4回流焊接过程确认会议纪要 (26) 8.5回流焊过程确认报告 (26) 第9章回流焊接过程确认总结 (27)
第1章回流焊接过程确认概述 1.1任务来源 PCBA组装生产中所有工艺控制的目的都是为了获得良好的焊接质量,而回流焊接则是核心工艺,如果回流焊接过程控制不好会直接影响PCBA组装质量。其中焊点强度是回流焊焊点必须满足的要求,但又属于破坏性检查,不能在每块PCBA上实施,也无法在每个批次中执行,因此PCBA回流焊接过程属于特殊过程,需要进行过程确认。此次以KD-726\KD-575N\KD-525EN\KD-591\KD-796\KD-791 KD-788为例进行确认。 1.2确认过程 回流焊接过程确认分为三部分: 第一部分是对回流焊接过程涉及的设备进行安装鉴定,主要是从设备的设计特性、安全特性、维护保养制度等方面进行验证和确认,同时还包括仪器仪表的校准。 第二部分是对回流焊接过程的操作程序进行操作鉴定,主要是从原材料控制、操作程序的可行性、关键控制参数验证等方面进行测试和验证。 第三部分是对整个过程的输出进行实效鉴定,包括对过程稳定性、过程能力进行评估,确认该过程能保证长期的稳定的输出。 1.3时间与进度
双面板焊接工艺2012-07-26 和单面的Reflow 条件基本没有差异,但是第一面的比较重的零件要点胶,另外有些PTH 零件要考虑其他的置件方法 第一次过炉的(B面)优先是Chip类轻,短小型的零件的一面, 第二次过炉的(A面)应该是BGA,接口等比较体积大,分量重类型的零件一面。 普通双面板OSP工艺,两面锡膏 我们生产的双面板,使用的OSP工艺,两面锡膏(有高密度0.65间距的IC,要求平整度,不建议喷锡工艺),回流温度255,使用的无铅305锡膏。 目前存在的问题是: 通孔上锡个别孔,约30%的孔上锡不能满足75%;老板认为波峰还有调整的空间在里面;我认为目前行业OSP的局限性就存在着,好的高一代的药水价格偏高,可以解决这个问题,但涉及生产成本势必抬高PCB的价格。 请业界高手讨论。注:1.我的DOE实验:拿空板做,一次锡膏,两次锡膏,不过回流,然后一块拿到波峰上过,效果很明显有差异; 这是否可以说明:目前行业内,OSP自身的耐高温性,及耐高温次数尚未有突破? -----我也咨询OSP高工,及PCB厂家,目前大面积的一般价格低廉的OSP药水还达不到双面锡膏的要求; 2.09年4月曾经做过小日本DZ的板(一面锡膏,一面红胶),当时小日本从DZ拿过来的板,我第一时间就注意到其板的通孔上锡也有一些(较低比例10%)不良,就提出过这个问题。 当时我厂生产时使用的为0507的锡条,上锡不良出现比例稍大于DZ的,老板叫更换305的锡条,但上锡效果仍无多大改善;请来的日本波峰专家在这里调试了几天,也没什么改变,曾怀疑助焊剂,也换过;助焊剂的量也调整过,也曾用牙刷蘸取助焊剂直接刷到相关孔里面,使用的也是新劲拓波峰设备; 总之没有什么改变,即没有改善上锡效果,后来经沟通可以接受。 双面回流+波峰焊工艺 我这里同一条波峰, 都是双面锡膏板(305的锡膏,回流焊温度255) 1.使用双面OSP的板,每一块PCB上总是有10--20%的通孔上锡,达不到75%的通孔上锡高度;注:两面的焊接能保证,回流后到波峰的时间都小于24小时; 问题是通孔上锡不能完全保证; 2.使用双面喷锡工艺的板,不怎么调试就可以满足通孔上锡高度,即100%的孔100%的上锡高度。我的想法及讨论的目的是: 在主IC对平整度要求不是很严格的情况下(即两两引脚焊盘外围间隙大于0.3以上), 尽量使用喷锡表面处理,而不要使用OSP(对于PCB的成本,喷锡比OSP贵不到哪里) 关于有BGA的双面板工艺,大家有什么好的经验? 双面板两面都有BGA,还有电解电容,晶振等,如何设计生产工艺? 特别是过炉的问题:如何防止第一面不掉件,焊点熔化移位空焊等不良。 请高手指点! 反面容易掉件的进行点红胶 先生产铝电容和晶振这面,一次过炉后打红胶固定,然后再生产BGA那一面。 点红胶,炉子下温区设置低一些,就OK啦 这种在我们这叫做双制程!开一张钢网印锡膏,再开一张3毫米的铜网印红胶。过反面时将下温区的焊接温度减低就好了 双面板工艺!两次过炉可以吗? 我公司做双面板2面都贴片,又不想用红胶工艺,想2面都印锡膏不知道行吗?请教高手!我公司用炉子是劲拓10温区的炉子! 完全可以的!我们前一段时间做双面BGA的板子,调整好炉温曲线就可以了…… 我们正面是LED,反面是sop,还有电阻电容,请教先做那一面? LED尽量不要过两次炉,如果另外一面没有特别重的元件就先做另外一面 LED過兩次爐可能會導致發黃,建議先做另一面!…… 1
标准回流焊温度曲线的设定 摘要:回流焊接是表面组装技术(SMT)中所特有的工艺。本文由满港泉SMT主要介绍了锡膏工艺回流温度曲线的设定方法。 关键词:温度曲线、回流焊、温区、温度曲线设定 引言:自80年代以来,电子产品以惊人的速度向轻薄短小和高性能化方向发展,在这个过程中表面组装技术(SMT)的普及应用起了关键的作用。在目前业内的印刷和贴片设备、技术相差不大的情况下,回流焊接技术的好坏最终产品的质量和可靠性显得至关重要。因此对回流焊工艺进行深入研究、开发合理的回流焊温度曲线是保证表面表面组装质量的重要环节。 一、回流焊设备的发展: 在电子行业中,大量的表面组装组件(SMA)通过回流焊进行焊接,目前回流焊设备的种类以热传递方式划分有红外线、全热风、红外线加热风三种类型。 *红外线:红外线回流焊是以红外线辐射的方式实现被焊元器件加热的焊接方式。具有加热快,节能,运行平稳的特点。但由于印刷线路板及各种元器件因材质、色泽的不同红外线辐射的热吸收率存在较大的差异,因此造成印刷线路板上各种不同元件之间,以及相同元件的不同区域之间存在温度不均匀的现象。 *全热风:全热风回流焊是通过对流喷射管嘴或者耐热风机来迫使炉内热风流循环,从而实现被焊元器件加热的焊接方式。这种加热方式印刷线路板上元器件的温度接近设定的加热温区的气体温度,完全克服了红外线回流焊的温差和遮蔽效应,但在全热风回流焊设备中循环气体的对流速度至关重要,为确保炉内的循环气体能够作用于印刷线路板上的每一个区域,气流必须具有足够的速度,这在一定程度上易造成印刷线路板的抖动和元器件的移位。此外这种加热方式就热交换而言效率差、能耗高。 *红外线热风:红外线热风回流焊是在红外线加热的基础上追加了热风的循环,通过红外线和热风双重作用来实现被焊元器件加热的焊接方式这种加热方式使炉内的温度更均匀,充分利用了红外线穿透力强,具有热效率高,能耗低的特点,同时又有效克服了红外线加热方式的温差和遮蔽效应,弥补了热风加热方式对气体流动速度要求过快而造成不良影响。 二、温度曲线 温度曲线是施加于装配元件上的温度对时间的函数Y=F(T),体现为回流过程中印刷线路板上某一给定点的温度随时间变化的一条曲线。图中横轴是时间,纵轴是温度,曲线Y是一条随时间的增加温度不断变化的曲线。曲线Y在OtT坐标系中所包围的面积为被测点在整个回流焊接过程中所接收到的能量的总和。用能量的概念表示的温度曲线函数为Y=∫d(T)。温度曲线又可分为RSS曲线和RTS曲线。 *RSS曲线:是一种由升温、保温、回流、冷却四个温度区间组成的温度曲线。其每个温度区间在整个回流焊接过程中扮演着不同角色。升温去:通过缓慢加热的方式使印刷线路板从室温加热至135~175℃(无铅),升温速度一般在1~3℃/S。保温区:通
回流焊炉过炉操作规范机台: 1.目的 确保过炉参数正确、过板方式正确,保证过炉焊接品质。 2.适用范围 适用于本公司内SMT所有回流焊炉过板作业。 3.相关文件 本公司内所发行的作业指导书、操作规范必需执行。 4.责任 SMT工程和产线、品质IPQC有责任依此操作规范作业。 5、回流焊炉过板参数确认: 5-1、开线、中途转线SMT工程根据产线生产计划调用相对应的过炉程序,待温度达到设定值后(指示灯绿灯亮),使用炉温测试仪进行实测炉温。实际曲线标准请参照工程实验得出的四种过炉参数曲线为:①靠左边规道;②靠右边规道;③中间;④带铝盒。 5-2、将实测炉温曲线打印出来,经工程师或相应人员确认无误后签名并放置在炉旁,通知产线组长或过炉人员方可过板。 5-3、IPQC进行炉温设定记录与炉温监控超过±10℃(红灯或黄灯亮)通知工程人员进行确认。 并鉴督实测炉温曲线与试验曲线的相差:温度相差±5℃时间相差±10s。 6、过板方式和注意事项: 6-1、产线组长或过板人员安每条线生产的机种工艺,请工程确认具体安排在哪台炉过炉,务必确认炉温参数是否正确和达到要求,否则不可过炉。 6-2、锡膏工艺过炉时依据以下三种过炉模式进行: 6-2-1、一种板,采用轨道过炉,轨道上面板与板前后间距为50MM。 6-2-2、两种或两种以上,单面过炉采用网链过炉,网链上面板与板的前后左右间距为50MM,板与炉边的间距为30MM 6-2-3、两种或两种以上,双面过炉时采用铝盒装板放在网链上过炉,网链上面铝盒与铝盒前后左右间距为50MM,铝盒与轨道的间距为30MM,铝盒内板与板前后左右的间距为50MM,铝盒与板的间距为30MM。 6-2-4、发现不熔锡或其它异常时及时通知产线组长、工程人员、或上级进行处理。 6-2-5、特殊情况以工程要求、规定进行过炉,不可盳目过炉。 6-3、红胶工艺过炉时依据以下三种过炉模式进行: 6-3-1、要求有铅工艺或无铅工艺的单面红胶PCB板可在有铅回流焊过炉或在无铅回流焊过炉6-3-2、背面已生产有铅锡膏工艺当面生产红胶工艺的PCB板与背面已生产无铅锡膏工艺当面生产红胶工艺的PCB板同时过一个回流焊时,必须有其中一种PCB板采用铝盒过炉。 6-3-3、在有铅回流焊或无铅回流焊过背面已生产有铅锡膏工艺当面生产红胶工艺的PCB板或背面已生产无铅锡膏工艺当面生产红胶工艺的PCB板单独过其中一种PCB板时可不用铝盒。 7、过炉时发现亮黄灯与亮红灯或发出警报应立即停止过炉,并通知工程人员处理问题。 批准:审批:制定:
回流焊技术 1.什么是回流焊回流焊原理分为几个描述:(回流焊温度曲线图)双轨回流焊的工作原理 2.回流焊流程介绍回流焊工艺要求影响工艺的因素: 3.回流焊技术有那些优势? 4.回流焊的注意事项 1.桥联回流焊焊接加热过程中也会产生焊料塌边,这个情况出现在预热和主加热两种场合,当预热温度在几十至一百度范围内,作为焊料中成分之一的溶剂即会降低粘度而流出,如果其流出的趋势是十分强烈的,会同时将焊料颗粒挤出焊区外的含金颗粒,在熔融时如不能返回到焊区内,也会形成滞留的焊料球。除上面的因素外,SMD元件端电极是否平整良好,电路线路板布线设计与焊区间距是否规范,阻焊剂涂敷方法的选择和其涂敷精度等都会是造成桥联的原因。 2.立碑元件浮高(曼哈顿现象) 片式元件在遭受回流焊急速加热情况下发生的翘立,这是因为急热使元件两端存在温差,电极端一边的焊料完全熔融后获得良好的湿润,而另一边的焊料未完全熔融而引起湿润不良,这样促进了元件的翘立。因此,回流焊加热时要从时间要素的角度考虑,使水平方向的加热形成均衡的温度分布,避免回流焊急热的产生。防止元件翘立的主要因素有以下几点:①选择粘接力强的焊料,焊料的印刷精度和元件的贴装精度也需提高;②元件的外部电极需要有良好的湿润性和湿润稳定性。推荐:温度40℃以下,湿度70%RH以下,进厂元件的使用期不可超过6个月;③采用小的焊区宽度尺寸,以减少焊料熔融时对元件端部产生的表面张力。另外可适当减小焊料的印刷厚度,如选用100μm;④焊接温度管理条件设定也是元件翘立的一个因素。通常的目标是加热要均匀,特别在元件两连接端的焊接圆角形成之前,均衡加热不可出现波动。 3.润湿不良润湿不良是指回流焊焊接过程中焊料和电路基板的焊区(铜箔)或SMD的外部电极,经浸润后不生成相互间的反应层,而造成漏焊或少焊故障。其中原因大多是焊区表面受到污染或沾上阻焊剂,或是被接合物表面生成金属化合物层而引起的。譬如银的表面有硫化物、锡的表面有氧化物都会产生润湿不良。另外焊料中残留的铝、锌、镉等超过0.005%以上时,由于焊剂的吸湿作用使活化程度降低,也可发生润湿不良。因此在焊接基板表面和元件表面要做好防污措施。选择合适的焊料,并设定回流