封装基础集成电路封装
- 格式:pptx
- 大小:2.62 MB
- 文档页数:48


集成电路封装基础知识教材集成电路封装基础知识第一章集成电路的概述第一■节序言第二节集成电路的产生第三节集成电路的定义第四节集成电路的前道和后道的定义第五节集成电路的分类第二章集成电路的构成第一节集成电路的主要构成第二节各组成部分的作用第三章集成电路的封装类型第一节国外集成电路的封装类型第二节国内集成电路的命名第三节本公司内部的集成电路的封装类型第四节集成电路未来发展的趋势第四章集成电路的一脚(INDEX)识别第一节集成电路的一脚构成第二节集成电路的一脚识别第五章集成电路封装的主要材料第一节集成电路的主要原材料第二节各原材料的组成、保管、主要参数第六章集成电路封装工艺流程第一节集成电路封装的主要工艺流程第二节集成电路封装的详细工艺流程第三节封装中工艺流程的变化第七章集成电路封装设备的主要结构第一节封装设备的通用结构第二节设备各部分的作用第三节各工序各部分的结构不同第四节设备操作面板上常用英文和日文单词注释第八章集成电路封装设备的主要控制原理第一节PLC的概念第二节PLC的控制原理第三节设备的控制原理第九章集成电路封装中的常用单位换算第一节长度单位换算表第二节质量单位换算表第三节体积和容积单位换算表第四节力单位换算表第五节力矩和转矩单位换算表第六节压力和应力单位换算表第七节密度单位换算表第一节序言从本世纪50年代末开始,经历了半个多世纪的无线电电子技术正酝酿着一场新的革命.这场革命掀起的缘由是微电子学和微电子技术的兴起•而这场革命的旋涡中心则是集成电路和以其为基础的微型电子计算机.集成电路的问世,开辟了电子技术发展的新天地,而其后大规模和超大规模集成电路的出现,则迎来了世界新技术革命的曙光•由于集成电路的兴起和发展,创造了在一块小指甲般大小的硅片上集中数千万个晶体管的奇迹;使过去占住整幢大楼的复杂电子设备缩小到能放入人们的口袋,从而为人类社会迈向电子化,自动化,智能化和信息化奠定了最重要的物质基础•无怪乎有人将集成电路和微电子技术的兴起看成是跟火和蒸汽机的发明具有同等重要意义的大事1 •集成电路的产生5•集成电路的分类:TTL集成电路;(定义)集成运算放大器;COMS集成电路;接口集成电路; ECL集成电路;集成稳压器与非线性模拟集成电路微型计算机集成电路;HTL集成电路.2•集成电路的构成:.集成电路的封装类型1. 国外集成电路封装类型的命名及分类SIP ---------------------------------------------- (SINGLE IN -INE PACKAGE) ZIP ---------------------------------------- (ZIG-ZAG IN-LINE PACKAGE)DIP-------------------------------------------- (DUAL IN-LINE PACKAGE) SHDIP -------------------------- (SHRINK DUAL IN-LINE PACKAGE)WDIP ------------------ (WINDOW TYPE DUAL IN-LINE PACKAGE)PGA -------------------------------------- (PIN GRID ALLEY PACKAGE)SVP---------------------------------- (SURFACE VERTICAL PACKAGE) SOP ----------------------- (SMALL OUTLINE L-LEADED PACGAGE) TSOP1 ------------ (THIN SMALL OUTLINE L-LEADED PACKAGE)LSSOP -------------------------------------- (LOW PRO SMALL OUTLINE PACKAGE)TSSOP -------------------------------------- (THIN PRO SMALL OUTLINE PACKAGE)UTSOP ------------------------------------ (ULTRA THIN SMALL OUTLINE L-LEADED PACKAGE)QFP ------------------------------------------------------------------ (QUAD FLAT L-LEADED PACKAGE)LQFP -------------------------------------------- (LOW PRO FLAT L-LEADED PACKAGE)TQFP --------------------------------------------------------- (THIN QUAD FLAT L-LEADED PACKAGE)UTQFP ------------------------------------------ (ULTRA THIN QUAD FLAT L-LEADED PACKAGE)HQFP -------------------------------------------------------------------------------- (QFP WITH HEAT SINK)TPQFP ------------------------------------------------- (TEST PAD QUAD FLAT L-LEADED PACKAGE)SON ---------------------------------------------------- (SMALL OUTLINE NON-LEADED PACKAGE)QFN ----------------------------------------------------------- (QUAD FLAT NON-LEADED PACKAGE)SOJ ----------------------------------------------------------- (SMALL OUTLINE J-LEADED PACKAGE)QFJ ------------------------------------------------------------------- (QUAD FLAT J-LEADED PACKAGE)BGA ------------------------------------------------------------------------------------ (BALL GRID ARRAY)SPGA ------------------------------------------------------------- (SHRINK PIN GRID ALLEY PACKAGE)LGA ------------------------------------------------------------------------ (LEAD GRID ALLEY PACKAGE)DTP ------------------------------------------------------------------- (DUAL TAPE CARRIER PACKAGE)QTP ------------------------------------------------------------------- (QUAD TAPE CARRIER PACKAGE)SIMM ------------------------------------------------------------- (SINGLE INLINE MEMORY MODULE)DIMM ---------------------------------------------------------------- (DUAL INLINE MEMORY MODULE)SOCKET TYPE3. 国内外封装名称对照:SIP ----------- S INGLE IN LINE PACKAGE ------------------ 单列封装SIPT --------- S INGLE IN LINE PACKAGE WITH TAB----- 带散热片的单列封装DIP ----------- D UAL IN LINE PACKAGE ----------------------- 双列封装DIPT --------- D UAL IN LINE PACKAGE WITH TAB -------- 带散热片的双列封装SDIP --------- S HRINK DUAL IN LINE PACKAGE ----------- 纵向收缩型双列封装2. 国内集成电路的名称和代号:玻璃陶瓷扁平封装 W 陶瓷四面引线扁平封装 Q 塑料双列弯引线封装O 陶瓷熔封扁平封装 H 塑料双列封装 P 陶瓷熔封双列封装 J 金属菱形封装 K 塑料片式载体封装 E 陶瓷扁平封装 F 塑料扁平封装 B 塑料四面引线扁平封装 N 陶瓷双列封装 D 塑料单列封装 S 金属圆形封装 T 陶瓷无引线片式载体封装 --------------- C陶瓷针栅阵列封装 ---------------------- GSWDIP ----- SKINNY DIP OR SHRINK WIDTH DUAL IN LINE PACKAGE----------- 横向收缩型双列封装QIP ---------- QUAD IN LINE PACKAGE ----------------------- 四列封装ZIP ----------- ZIGZAG IN LINE PACKAGE -------------------- 引线交叉排列封装CERDIP ——CERAMIC DUAL IIN LINE PACKAGE ------- 陶瓷熔封双列式封装CDIP -------- CERAMIC DUAL IN LINE PACKAGE (SIDE BRAZED )----------- 陶瓷双列式封装(通常指侧面钎焊的)PGA --------- PIN GRID ARRAY --------------------------------- 针栅阵列封装SOP --------- SMALL OUT LINE PACKAGE ------------------ 微型封装(两面出腿)SOJ --------- SMALL OUTLINE PACKAGE WITH J LEAD----J 形弓 I 线微型封装PLCC -------- PLASTIC LEADED CHIP CARRIER ----------- CLCC/LCC--CERAMIC LEADLESS CHIP CAEEIER ------ 陶瓷片式载体 QFP --------- QUAD FLAT PACKGE ---------------------------- 四面引线扁平封装 薄的微型封装(两面出腿)塑封有引线的片式封装TSOP ------- THIN SMALL OUTLINE PACKAGE ------------4.本公司内现有的封装类型SIP、SIPTDIP、DIPT、SDIP、SKDIPDIP24、DIP28、DIPT14、SDIP42、SDIP52、SDIP64、SKDIP22、SKDIP24SOP8、SOP14 SOP16 SOP20、SOP24 SOP28 SOL8SOJ26QFP48、QFP64、QFP80、QFP100.集成电路的一脚(INDEX)识别印记正对人的位置,产品最左下角的起脚为一脚,然后按逆时针方向旋转,以次列数.DIP8、DIP14、DIP16、DIP18、DIP20、 SOP 、SOL SOJQFP5.本公司内现有的圭寸装品种.集成电路封装的主要材料1. 引线框架:LEAD FRAME(IC的载体,连接芯片和PCB板)(框架的一脚标记与芯片的一脚在装片时,要保持一致)2•银浆Ag:用以粘接芯片和L/F的PAD.3. 金丝:用以连接芯片和L/F.4. 树脂(塑封料):用以包封以键合好的半成品,以达到保护芯片的目的5. 油墨:用以标识集成电路.四.集成电路封装工艺流程1. 主要工艺流程:(磨片)-----划片-----装片-----键合——塑封——去飞边——电镀-----打印-----切筋打弯-------- 外观-----(测试)----包装2. 工艺流程的细化:贴片----磨片----贴片----划片----超声清洗----UV照射----崩片----装片----银浆固化----键合----塑封前烘----塑封----后固化----切筋----去飞边----电镀----打印----油墨固化----成形----外观----测试----包装七.设备的结构和控制原理1. 磨片(减薄):在使用大直径的硅片制造集成电路芯片时,由于其厚度较大,不能满足划片,装片和键合的工艺要求,因此需要对圆片的背面进行处理和减薄,除去其背面的氧化层,才能保证在装片和键合时有良好的浸润性,并改善装片后芯片与中岛之间的欧姆接触,减小串联附加电阻和提高散热性能.1.)研磨法:是利用大量硬度较大,颗粒较细并具有复杂棱角的磨料,在外力的推动下对被加工表面进行磨削作用的一种机械加工方法•研磨料:可采用天然或人造金刚砂,如a -AL2O3;a -SiC 磨料与水的比例为:1:52. )磨削法:是将机械平面磨削方法应用到半导体器件的加工中.磨削圆片时,砂轮和转盘各自以相反方向旋转,借助于它们的相对运动将圆片磨削减薄.(例:MPS2R30C减薄机)结构:由磨头,转盘(吸盘),磨头垂直和水平进给机构和冷却装置等部分组成.2. 划片:把已制有电路图形的集成电路圆片切割分离成具有单个图形(单元功能)的芯片,常用的方法有金刚刀划片,砂轮划片和激光划片等几种.而我们通常使用的是砂轮划片.砂轮划片机的砂轮转速为30000r/min左右,切割速度通常在50-150mm/min之间.圆片的固定方法是采用真空吸盘,并且工作台面是气垫式的,因此可以保证切割深度完全一致.同时利用监视图象或显微镜来进行定位.全自动划片机工艺步骤包括:圆片上料,对准,划片,清洗,烘干,进圆片盒等工步. 划片的切割方法:通常我们采用的是切割留深法.划片的切割方式:A模式(用于非FJ产品) C 模式(用于富士通产品)3. 装片:是把集成电路芯片粘接到引线框架中岛上的指定位置,为丝状引线的连接提供条件的工艺,称之为装片.3.1 装片的方法有:导电胶粘接法,银浆,低温玻璃烧结法和低熔点合金的共晶熔接法等.3.2 导电胶粘接法由于具有工艺简单.成本低,易采用自动化专用设备,同时在胶粘剂中增加一定比例的金属粉粒,以改善胶粘剂的导电和导热性能,有利于改善芯片的散热条件,因此目前广为应用的就是导电胶粘接法.3.3导电胶:是利用高分子有机化合物所制成的胶粘剂,是以环氧树脂为主体并加有银粉或铝粉等金属粉粒,再配置少量的固化剂和溶剂而成,其具体要求是:粘接牢固,固化时间短,在经受一定的温度后仍能保持其固化状态不变,并在固化期间不产生过多的挥发气体而污染芯片和具有较高的导电散热能力.3.4装片机:由承片台,真空吸嘴,芯片传送机构,加热系统,工件传送机构几个主要部分组成. 承片台:主要作用是将已经分离的但仍与塑料薄膜保持粘贴的芯片,连同贴片环进入承片台后,可由步进电机驱动承片台,作X和丫方向的移动,并通过图形识别装置,挑选出合格与合格芯片.对缺角,破裂和注有不合格标志的芯片,将有反馈信号加至步进电机,使承片台迅速移动,不将其剔除不用;而对合格芯片,则也有反馈信号输至步进电机,使承片台移动,将其送入到规定的位置上.真空吸嘴:作用是将到达规定位置的芯片,为了保护芯片不受损伤,采用真空吸力键芯片吸起,并送到引线框架的中岛上进行装片.真空吸嘴分为:平面吸嘴,斜面吸嘴和角锥吸嘴等. 根据材料的不同可分为:金属吸嘴和海绵吸嘴等.芯片的传送机构:通常采用悬臂式结构•主要作用是将由真空吸嘴吸取的芯片直接送到规定位置去进行装片,也可经过中途修正台修正位置后再送到规定位置上•加热系统:由内热式电阻加热,体积小但功率可达150-200W,并附有调温装置和预热设备,但仅限于共晶焊接装片使用.工件传送机构:对于塑料封装引线框架,可根据引线的尺寸来调整其轨道的宽度,并由步进电机按规定程序使之准确就位•4. 键合:将芯片的电极用金丝与引线框架的内引线连接起来,这一工艺过程称之为键合•4.1集成电路的芯片与封装外壳的连接方式可分为:有引线键合结构和无引线键合结构两大类有引线键合结构就是通常所说的丝焊法,即用金丝或铝丝实行金-金键合,金-铝键合或铝- 铝键合•由于都是在一定压力下进行的焊接,故又称为压焊•4.2目前塑料封装的集成电路通常使用有引线键合的金丝焊接.金丝焊接又分为:热压楔焊,热压球焊,超声热压焊,超声焊.4.3热压焊键合:就是在加热和加压的同时,对其芯片金属化层的压点(一般是铝层)以及外壳或引线框架的外引线引出端头,用金属丝引线(一般是金丝)通过焊接连接起来.由于金属丝和芯片上的铝层同时受热受压,其接触面产生了塑性变形,并破坏了界面的氧化膜,使两者接触面几乎接近原子引力的范围;又因为金丝和焊接层(铝层,镀金层或镀银层)表面存在的不平整现象,加压后其高低不平处相互填充而产生弹性嵌合作用,使两者紧密结合在一起,从而达到键合的目的.键合时,外壳或引线框架应预先加热到310-350 C°,金丝通过陶瓷,碳化钨或碳化钛硬质合金所做成的劈刀,并加热至200C°左右.当金丝由劈刀毛细孔中伸出时,利用氢气或电火花在其端头进行加热,使其熔化成球状,并立即通过50-160g的压力压焊在芯片金属化层的压点上.外焊点则仍采用楔形焊,,即金丝与外壳或引线框架的外引线引出端头实行金-金的热压焊接.4.4超声焊键合:是利用超声波的能量将金属丝(通常是用铝丝)在不加热的情况下,实行内外焊点的键合.其工作原理是由超声波发生器产生的几十千周的(通常为50-60kHz)超声波振荡电能,通过磁致伸缩换能器,在超声频磁场感应下迅速伸缩而产生弹性振动,再经变幅杆传给劈刀,并同时在劈刀上施加一定的压力.劈刀就在这两种力的作用下,带动金属丝在芯片金属层的压点和外壳或引线框架的外引出端头的表面迅速摩擦振动.这样不仅破坏了两者焊接界面的氧化膜,同时也使两者产生塑性变形,使两种纯净的金属面紧密接触,形成牢固的键合.超声焊接的内外焊点都是成楔形的,不需要对芯片和外壳加热,压点是实行铝-铝键合.键合状态主要由以下三个工艺参数所决定的:功率,时间,压力.4.5超声热压焊键合:在热压焊的基础上再加增加超声的能量所实现的键合,称之为超声热压超声热压焊同时具有热压和超声压焊两者的优点,可以降低热压焊的温度(从单纯的热压焊温度---300 C°以上下降至200-260 C°),使一些耐温不高的外壳货基片也能应用金丝作互连•对于引线框架较厚的和带有散热片的塑料封装集成电路,因为它们的散热好,温度梯度大,也可采用超声热压焊•超声热压焊机分为:手动式,半自动式,全自动式.操作步骤:(1)位置复原:确定芯片一金属化层压点为第一个焊接点,并调整其位置,使之置于对位光点之下;11/15(2) 按下开动钮:劈刀降落并进行第一点的焊接.当金球与芯片压点接触时,劈刀端头的内凹面在热能的作用下将金球压成钉头状的焊点,此时超声波发生器同步启动,并产生超声能量,以加速焊接的进行;(3) 劈刀自动提升到一定高度,丝夹张开,使金丝自动送出;(4) 把引线框架外引线一相应的引出端头作为第二焊点,并调整其位置,使之置于对位光点之下,按下开动钮,劈刀降落,以第二点的焊接,并用劈刀端头的外侧把金丝压成楔形的焊点,此时超声波发生器同步启动,并产生超声能量,以加速焊接的进行;(5) 劈刀自动升起时丝夹夹紧金丝,把金丝从楔形焊点的端头拉断,成为一个无丝尾的焊点;(6) 劈刀自动停在复原位置上,丝夹仍然夹紧金丝,电子烧球器产生高压电火花,把金丝端部烧成金球;(7) 丝夹松开,靠金丝的张力把金球升起到劈刀端部,准备进行下一个程序的循环.全自动式金丝球焊机:当对其第一个产品进行光点对位或采用自教程序进行焊接后,则所有的动作程序全部存储在微处理机中,通过自动传输机构,对以后的同类产品进行连续作业作业人员只需用料盒将已经装片的引线框架放到送料台上,并取走已焊接好的产品.如果个别芯片装片位置不当或有其他差错时,则设备上图形识别装置将会自动报警停机,以待作业人员处理.同时,当金丝使用完毕后,设备也会自动给出信号,告诉作业人员添加金丝.图形识别装置的作用:就是对芯片的焊接位置进行寻找和检测,其工作原理是采用相关法技术,即用工业视频摄像机摄取芯片表面的图形,并将摄取图象转换为二进制数码,然后和预先存储的标准的二进制数码图象进行比较.当发现差异时,可由步进电机按给定信号驱动工作台,作X和丫方向的移动,直至对位准确为止.校准范围一般在X= ± 0.2mm,Y= ± 0.2mm 0 =±5°.4.6 球焊劈刀:适用于金丝球焊键合,都是空心管状轴对称型,其端头的锥角有30 ° ,20 ° ,15° ,10° 等.劈刀常用材料有:陶瓷,碳化钨和碳化钛等.由于陶瓷能耐王水(3HCL+HNO3)的腐蚀,当金丝阻塞劈刀通孔而不能取出时,可用王水浸泡而将残存的金丝溶解出来,因此陶瓷劈刀应用较多.4.7金丝要求:(1)丝材的表面应光滑,清洁,不应有任何有机物如油脂,指印等的污染;(2) 不应有大于直径四分之一的影响丝材横截面的缺凹,划伤,裂痕,凸块和附着物⑶丝材应卷绕在特定的绕线轴上,不应有小于30°的死弯和小于0.76mm直径的结存在,且卷绕紧密整齐,不能杂乱松动;(4) 任意长的丝材卷绕在绕线轴上时,只能单层上绕式密绕,且每轴只绕一根,并在首尾注有标记;(5) 每轴丝材都应有严格的包装,以防止受损或污染,并应有规定的标志.⑹金丝纯度要求在99.99%以上,经制成细丝后还需进行退火处理,以保证其拉力强度和延伸率都能符合键合工艺要求.金丝成分表:金丝的选用:应根据集成电路的工作电流来加以选择.一般金丝的熔断电流与金丝的直径成线性关系.5.塑封:即塑料封装,是一种非气密性封装.它是将键合后的半成品用塑料封装起来,以达到保护作用以适应一定的环境.5.1塑料封装从50年代开始,70年代推广,到今天九十年代已广为使用.之所以塑料封装能发展到目前的水平,因其存在诸多的优点:(1) 塑料封装在集成电路的组装过程中一次加工完毕,不同与其他形式的气密性封装,需要事先作成封装外壳,大大简化了工艺流程;(2) 生产工艺简便.一次成型几百只,节省时间,提高工效,易于实现自动化,便于大批量生产;(3) 成本低.所用材料少,除了在初建初期需要对设备和模具投资外,以后的维护费用很低,是气密性封装的1/3-1/5;(4) 重量轻,抗冲击,振动和加速运动等机械性能都比较优越;(5) 环氧和硅酮树脂的抗辐射性能好;(6) 绝缘性能好,寄生参数小;(7) 抗化学腐蚀能力强;(8) 塑料封装中铀,钍的含量少,适于VLSI存储器的封装. 缺点:(1) 抗潮性能差;(2) 热性能差;(3) 抗盐雾腐蚀性能差;(4) 电屏蔽性能差;(5) 易老化.5.2塑封树脂:是一种热固性塑料,以高分子化合物合成的树脂为基体,加入固化剂仮应促进剂(催化剂),填充剂,阻燃剂,脱模剂和着色剂等组成.常用树脂有:环氧树脂,硅酮树脂等.目前我们使用的是环氧树脂. 树脂发展趋势:高纯度,低应力,低a射线等.树脂的保管:5C°以下.5.3塑料封装的成型方法有滴涂敷法,填充法,浇铸法和递模成型法.目前我们使用的是递模成型法. 递模成型法:是将塑料包封机上油缸压力,通过注塑头,传递到被预热的塑料上,使塑料经浇道,浇口缓慢挤入型腔,并充满整个型体,把芯片包封起来,该成型法称之为递模成型法.也就是通常称的塑封.5.4塑圭寸的工艺条件:⑴塑封模的温度:175土5C°(2) 合模压力:根据塑封模的大小,重量,型腔数,以下框架材料,成品外形尺寸和注塑压力等条件选定的.(3) 注塑压力:也称为递模压力和传递压力,其作用是传递塑料,使塑料能充满型腔.一般30-100Kg/cm2.⑷预热温度:塑料(塑封料)的预热温度取决于塑料的凝胶时间和流动性,一般为80-100C。


集成电路封装技术一、概述集成电路封装技术是指将芯片封装成实际可用的器件的过程,其重要性不言而喻。
封装技术不仅仅是保护芯片,还可以通过封装形式的不同来满足不同应用领域的需求。
本文将介绍集成电路封装技术的基本概念、发展历程、主要封装类型以及未来发展趋势等内容。
二、发展历程集成电路封装技术随着集成电路行业的发展逐渐成熟。
最早的集成电路封装形式是引脚直插式封装,随着技术的不断进步,出现了芯片级、无尘室级封装技术。
如今,随着3D封装、CSP、SiP等新技术的出现,集成电路封装技术正朝着更加高密度、高性能、多功能的方向发展。
三、主要封装类型1.BGA封装:球栅阵列封装,是一种常见的封装形式,具有焊接可靠性高、散热性好等优点。
2.QFN封装:裸露焊盘封装,具有体积小、重量轻、成本低等优点,适用于尺寸要求严格的应用场合。
3.CSP封装:芯片级封装,在尺寸更小、功耗更低的应用场合有着广泛的应用。
4.3D封装:通过将多个芯片垂直堆叠,实现更高的集成度和性能。
5.SiP封装:系统级封装,将多个不同功能的芯片封装在一起,实现更复杂的功能。
四、未来发展趋势随着物联网、人工智能等领域的兴起,集成电路封装技术也将迎来新的挑战和机遇。
未来,集成电路封装技术将朝着更高密度、更低功耗、更可靠、更环保的方向发展。
同时,新材料、新工艺和新技术的应用将为集成电路封装技术带来更多可能性。
五、结语集成电路封装技术是集成电路产业链中至关重要的一环,其发展水平直接关系到整个集成电路的性能和应用范围。
随着技术的不断进步,集成电路封装技术也在不断演进,为各个领域的技术发展提供了强有力的支撑。
希望本文能够帮助读者更好地了解集成电路封装技术的基本概念和发展趋势,为相关领域的研究和应用提供一定的参考价值。

集成电路的封装方式随着电子技术的发展,集成电路已经成为现代电子产品中不可或缺的一部分。
而集成电路的封装方式则是保护和连接芯片的重要环节。
本文将介绍几种常见的集成电路封装方式,包括DIP封装、QFP封装、BGA封装以及CSP封装。
DIP封装,即双列直插封装(Dual In-line Package),是最早也是最常见的一种封装方式。
DIP封装的芯片引脚通过两行排列在芯片的两侧,方便插入插座或焊接到电路板上。
DIP封装的优点是成本低廉、易于维修和更换,但其缺点是占用空间较大,限制了芯片的集成度和密度。
QFP封装,即四边形薄封装(Quad Flat Package),是一种较新的封装方式。
QFP封装的芯片引脚通过四边排列在芯片的四周,使得芯片的尺寸更小,适用于高密度集成电路。
QFP封装的优点是体积小、引脚多、传导性能好,但其缺点是焊接难度较大,需要使用SMT设备进行焊接。
BGA封装,即球栅阵列封装(Ball Grid Array),是一种高密度的封装方式。
BGA封装的芯片引脚通过芯片底部的焊球连接到电路板上,使得芯片的引脚数量和密度更高。
BGA封装的优点是高集成度、体积小、传导性能好,但其缺点是焊接难度较大,需要使用专用设备进行焊接。
CSP封装,即芯片级封装(Chip Scale Package),是一种最小尺寸的封装方式。
CSP封装将芯片封装在最小尺寸的封装基板上,使得芯片的尺寸和重量更小。
CSP封装的优点是体积小、重量轻、传导性能好,适用于小型移动设备等场景。
但由于其尺寸小,焊接和维修难度较大。
除了以上几种常见的封装方式外,还有一些特殊的封装方式,如PGA封装(Pin Grid Array)、SOIC封装(Small Outline Integrated Circuit)等。
这些封装方式都有各自的特点和适用场景,可以根据具体的需求选择合适的封装方式。
在选择集成电路的封装方式时,需要考虑多个因素,如芯片的功耗、集成度、散热性能、可靠性和成本等。

集成电路封装技术封装工艺流程介绍集成电路封装技术是指将芯片封装在塑料或陶瓷封装体内,以保护芯片不受外界环境的影响,并且方便与外部电路连接的一种技术。
封装工艺流程是集成电路封装技术的核心内容之一,其质量和工艺水平直接影响着集成电路产品的性能和可靠性。
下面将对集成电路封装技术封装工艺流程进行介绍。
1. 芯片测试首先,芯片在封装之前需要进行测试,以确保其性能符合要求。
常见的测试包括电性能测试、温度测试、湿度测试等。
只有通过测试的芯片才能进行封装。
2. 芯片准备在封装之前,需要对芯片进行准备工作,包括将芯片固定在封装底座上,并进行金线连接。
金线连接是将芯片的引脚与封装底座上的引脚连接起来,以实现与外部电路的连接。
3. 封装材料准备封装材料通常为塑料或陶瓷,其选择取决于芯片的性能要求和封装的环境条件。
在封装之前,需要将封装材料进行预处理,以确保其表面光滑、清洁,并且具有良好的粘附性。
4. 封装封装是整个封装工艺流程的核心环节。
在封装过程中,首先将芯片放置在封装底座上,然后将封装材料覆盖在芯片上,并通过加热和压力的方式将封装材料与封装底座紧密结合。
在封装过程中,需要控制封装温度、压力和时间,以确保封装材料与芯片、封装底座之间的结合质量。
5. 封装测试封装完成后,需要对封装产品进行测试,以确保其性能和可靠性符合要求。
常见的封装测试包括外观检查、尺寸测量、焊接质量检查、封装材料密封性测试等。
6. 封装成品通过封装测试合格的产品即为封装成品,可以进行包装、贴标签、入库等后续工作。
封装成品可以直接用于电子产品的生产和应用。
总的来说,集成电路封装技术封装工艺流程是一个复杂的过程,需要精密的设备和严格的工艺控制。
只有通过合理的工艺流程和严格的质量控制,才能生产出性能优良、可靠性高的集成电路产品。
随着科技的不断进步,集成电路封装技术也在不断创新和发展,以满足不断变化的市场需求。
相信随着技术的不断进步,集成电路封装技术将会迎来更加美好的发展前景。

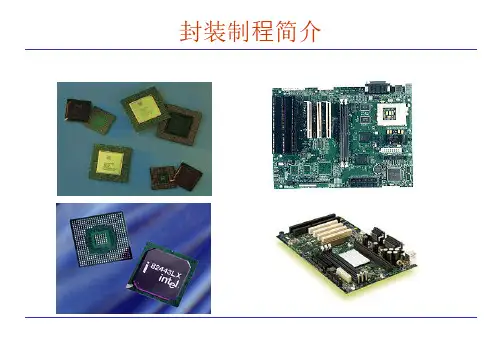

集成电路封装的主要流程一、集成电路封装的概述集成电路封装是指将芯片通过一系列工艺步骤,将其封装在塑料、陶瓷或金属外壳中,以保护芯片并方便使用。
封装后的芯片可以直接安装在电路板上,从而实现电子产品的制造。
二、集成电路封装的主要流程1. 芯片切割首先需要将晶圆切割成单个芯片。
这一步骤需要使用专业设备进行操作,以确保切割精度。
2. 焊盘制作接下来需要在芯片上添加焊盘。
焊盘是连接芯片和电路板的重要部分。
通常使用化学蚀刻或光刻技术制作。
3. 封装材料准备根据产品需求选择合适的封装材料,如塑料、陶瓷或金属等。
同时需要准备好其他辅助材料,如导线、引脚等。
4. 芯片安放和连接将焊盘与导线连接,并将芯片安放在封装材料中。
这一步骤通常需要借助自动化设备进行操作。
5. 封装材料固化对于塑料封装,需要进行固化处理。
通常采用高温烘烤或紫外线照射等方式,以确保封装材料的稳定性和可靠性。
6. 引脚整形对于某些封装方式,如QFN、BGA等,需要对引脚进行整形。
这一步骤需要使用专业设备进行操作。
7. 测试和质检完成封装后,需要进行测试和质检。
测试包括功能测试、可靠性测试等,以确保芯片的性能符合要求。
质检则包括外观检查、尺寸测量等,以确保产品符合标准。
8. 包装和出货最后将芯片包装,并出货给客户。
包装方式通常有盘式、管式、卡式等多种选择。
三、集成电路封装的常见类型1. DIP(双列直插式)DIP是一种常见的集成电路封装方式,具有双列引脚,可以直接插入电路板上的孔中。
2. QFP(方形扁平式)QFP是一种较为流行的表面贴装型封装方式,具有方形外观和扁平引脚。
该种封装方式通常用于中小功率芯片。
3. BGA(球形网格阵列式)BGA是一种高密度表面贴装型封装方式,具有球形引脚和网格状排列。
该种封装方式可以实现更高的芯片密度和更好的散热效果。
4. CSP(芯片级封装)CSP是一种新型的封装方式,将芯片直接封装在塑料或陶瓷基板上,无需添加导线和引脚。

集成电路封装工艺一、基本概念1.集成电路封装:将芯片与封装材料结合,形成电路封装结构,以提供芯片的保护、连接和安装环境。
2.封装工艺:指封装过程中所需要进行的操作和方法,包括封装流程、工艺参数的选择、工艺设备的操作等。
3.封装材料:封装芯片的材料,包括封装基底、封装芯片、引线材料等。
二、主要步骤1.芯片准备:在封装之前,需要进行芯片的准备工作,包括切割、测试和打磨等。
2.封装设计:根据芯片的尺寸、引脚数量和功能需求,设计封装结构和引线布局。
3.封装材料安装:将芯片放置在封装基底上,并固定好。
4.引线焊接:将引线与芯片的金属引脚相连接,实现信号传输和电路连接。
5.填充和灌封:使用封装材料填充器灌注封装基底中的空隙,以保护芯片。
6.引线修整和测试:修整引线的长度和位置,并进行封装的测试,确保封装质量和功能正常。
7.成品包装:对封装好的芯片进行标识、分类和包装,方便销售和使用。
三、常见封装类型1.DIP封装:双列直插封装,是最早的封装方式,引线通过孔插入电路板中。
2.QFP封装:方形扁平封装,引线以密集的“枪口”状排列,适用于高密度电路设计。
3.BGA封装:球栅阵列封装,芯片的引脚以球形焊点连接到电路板上,用于高性能和高速芯片。
4.CSP封装:芯片级封装,芯片直接封装在基底上,尺寸小、功耗低、散热性好。
5.COB封装:芯片覆盖封装,将芯片直接粘接在基底上,整个芯片组成一个整体。
封装工艺在集成电路制造中起到了重要的作用,能够增强电路的稳定性和可靠性,提高电路的性能和尺寸紧凑度。
随着科技的不断进步和集成电路的不断发展,封装工艺也在不断创新和改进。
未来,随着新的材料和封装技术的引入,集成电路封装工艺将会进一步提高,为电子设备的发展提供更多可能性。

常见集成电路封装类型同学们,今天咱们来聊聊常见的集成电路封装类型,这可是电子领域里很重要的一部分呢!来看看双列直插式封装,简称DIP。
这就像是一个小小的长方形盒子,两边伸出一排引脚。
它的优点是安装方便,咱们在一些老式的电路板上经常能看到。
比如说早期的计算机内存条,用的很多就是DIP 封装。
然后是球栅阵列封装,也就是BGA。
这种封装的引脚变成了一颗颗小小的锡球,密密麻麻地排列在芯片底部。
BGA 封装的集成电路体积更小,能容纳更多的引脚,性能也更强。
就像咱们现在用的高性能手机、电脑的处理器,很多都采用了BGA 封装。
接着是扁平封装,比如QFP(Quad Flat Package)。
它的引脚是从四个边伸出来的,而且引脚很细很密集。
QFP 封装的集成电路在一些对体积有一定要求,同时引脚数量又比较多的场合很常见,像一些高端的显卡芯片就可能会用这种封装。
再来说说小外形封装,SOP(Small Outline Package)。
它比DIP要小巧很多,引脚也是从两边伸出,但引脚数量相对少一些。
在一些小型的电子设备里,比如便携式音乐播放器,可能就会用到SOP 封装的集成电路。
还有一种叫芯片级封装,CSP(Chip Scale Package)。
它的尺寸几乎和芯片本身一样大,能极大地节省空间。
像一些超薄的电子设备,比如智能手表,就会选择CSP 封装来减小体积。
给大家举个例子,假如我们要组装一台高性能的游戏电脑,主板上的芯片可能就会有BGA 封装的处理器、QFP 封装的控制芯片等等。
而如果是制作一个小巧的智能手环,可能就会用到CSP 封装的传感器芯片。
还有无引脚封装,比如LGA(Land Grid Array)。
它的引脚不是伸出来的,而是在芯片底部形成一个个触点。
这种封装在一些对散热要求高的芯片上比较常见。
集成电路的封装类型多种多样,每种都有自己的特点和适用场景。
了解这些封装类型,能帮助我们更好地理解电子设备的内部结构和工作原理。
集成电路封装基础集成电路封装基础,你可能会想,哎,这个话题听起来像是高深莫测的东西,根本离咱们日常生活远着呢。
可事实是,集成电路封装其实无处不在,可能你每天都在用的手机、电脑、电视机、甚至是冰箱里,都有它的身影。
就像一颗颗“智慧的种子”,被封装在微小的“盒子”里,为我们的生活提供源源不断的动力。
你瞧,集成电路封装其实没有想象的那么神秘,它不过就是把那些小小的芯片和它们的电路通过一些方法,保护好、连接好,然后让它们能在各种设备里正常工作,怎么说呢?就像给一个刚出生的小婴儿穿上了防寒的衣服,保护它不受外界环境的干扰。
你可别小看这个封装,它可真不简单,集成电路如果没有一个合适的封装,可能就像是没穿衣服的小孩,在风吹雨打中,随时都可能受伤。
说到封装,大家的第一反应可能是,嗯,这是不是就是把芯片“包裹”起来的过程?对!但这只是其中的一部分。
要是简单粗暴地理解成“包裹”,就有点太天真了。
这个封装的过程,涉及的内容可不少。
就像是做一道精致的菜,不仅要选对材料,还得掌握好火候。
封装的材料得好,工艺得精,不然一个不小心,可能就会影响到芯片的性能。
那些你眼睛看不到的小小金属线、细如发丝的电极,它们能否连接顺畅,直接关系到芯片能否正常“工作”。
不信你看,芯片里的那点儿电路,就跟咱们人脑里的神经网络差不多,稍微堵一下,信息传递就会出问题。
嘿,这就像是你家里水管坏了,水流不畅,问题一个接一个,谁都烦。
封装的好坏,甚至决定了芯片能不能适应各种环境。
比如说温度高了,湿度大了,外面一大堆电磁干扰,你拿着那颗小芯片在外面晃荡,岂不是一顿乱炸?因此,封装不仅仅是外面的“外衣”,它还是芯片的“护盾”。
好比你在寒冷的冬天里穿上一件羽绒服,外面再大雪纷飞,你一点儿都不怕。
芯片的封装材料必须能抗住高温、低温、甚至是电磁干扰,这样才能确保芯片长时间稳定工作。
再聊聊封装的种类。
你以为集成电路封装就只有一种吗?呵呵,那可就大错特错了。
封装的种类可多得很,每一种封装都有它独特的优点和适用的场景。
集成电路封装形式简介(图文)封装大致经过了如下发展进程:结构方面:DIP封装(70年代)->SMT工艺(80年代LCCC/PLCC/SOP/QFP)->BGA封装(90年代)->面向未来的工艺(CSP/MCM)材料方面:金属、陶瓷->陶瓷、塑料->塑料;引脚形状:长引线直插->短引线或无引线贴装->球状凸点;装配方式:通孔插装->表面组装->直接安装裸片安装分类裸芯片在装载时,它的有电极的一面可以朝上也可以朝下,因此,芯片就有正装片和倒装片之分,布线面朝上为正装片,反之为倒装片(FC)。
另外,裸芯片在装载时,它们的电气连接方式亦有所不同,有的采用有引线键合方式,有的则采用无引线键合方式材料分类按芯片的封装材料分有金属封装、陶瓷封装、金属-陶瓷封装、塑料封装。
金属封装:金属材料可以冲、压,因此有封装精度高,尺寸严格,便于大量生产,价格低廉等优点。
陶瓷封装:陶瓷材料的电气性能优良,适用于高密度封装。
金属-陶瓷封装:兼有金属封装和陶瓷封装的优点。
塑料封装:塑料的可塑性强,成本低廉,工艺简单,适合大批量生产。
形式分类一.TO晶体管外形封装TO(Transistor Out-line)的中文意思是“晶体管外形”。
这是早期的封装规格,例如TO-92,TO-92L,TO-220,TO-252等等都是插入式封装设计。
近年来表面贴装市场需求量增大,TO封装也进展到表面贴装式封装。
TO252和TO263就是表面贴装封装。
其中TO-252又称之为D-PAK,TO-263又称之为D2PAK。
D-PAK封装的MOSFET有3个电极,栅极(G)、漏极(D)、源极(S)。
其中漏极(D)的引脚被剪断不用,而是使用背面的散热板作漏极(D),直接焊接在PCB上,一方面用于输出大电流,一方面通过PCB散热。
所以PCB的D-PAK焊盘有三处,漏极(D)焊盘较大。
二.DIP双列直插式封装DIP(DualIn-line Package)是指采用双列直插形式封装的集成电路芯片,绝大多数中小规模集成电路(IC)均采用这种封装形式,引脚节距为2.54 mm,其引脚数一般不超过100个。
第一章集成电路芯片封装技术1. (P1)封装概念:狭义:集成电路芯片封装是利用膜技术及微细加工技术,将芯片及其他要素在框架或基板上布置、粘贴固定及连接,引出接线端子并通过可塑性绝缘介质灌封固定,构成整体结构的工艺。
广义:将封装体与基板连接固定,装配成完整的系统或电子设备,并确保整个系统综合性能的工程。
2. 芯片封装实现的功能:1 传递电能,主要是指电源电压的分配和导通。
2 传递电路信号,主要是将电信号的延迟尽可能减小,在布线时应尽可能使信号线与芯片的互连路径以及通过封装的IO接口引出的路径达到最短。
3 提供散热途径,主要是指各种芯片封装都要考虑元器件、部件长期工作时如何将聚集的热量散出的问题。
4 结构保护与支持,主要是指芯片封装可为芯片和其他连接部件提供牢固可靠的机械支撑,并能适应各种工作环境和条件的变化。
3.在确定集成电路的封装要求时应注意以下儿个因素:1 成本2 外形与结构3 可靠性4 性能4.在选择具体的封装形式时,主要需要考虑4种设计参数:性能、尺寸、重量、可靠性和成本目标。
5.封装工程的技术层次:第一层次(Level1或First Level):该层次又称为芯片层次的封装(Chip Level Packaging),是指把集成电路芯片与封装基板或引脚架(Lead Frame)之间的粘贴固定、电路连线与封装保护的工艺,使之成为易于取放输送,并可与下一层次组装进行连接的模块(组件Module)元件。
第二层次(Level2或Second Level:将数个第一层次完成的封装与其他电子元器件组成个电路卡(Card〉的工艺.第三层次(Level3或Third Level):将数个第二层次完成的封装组装成的电路卡组合成在一个主电路板(Board)上使之成为一个部件或子系(Subsystem)的工艺。
第四层次(Level4或Fourth Level)将数个子系统组装成为一个完整电子产品的工艺过程。
在芯片上的集成电路元器件间的连线工艺也称为零级层次(Level 0)的封装,6.封装的分类:按照封装中组合集成电路芯片的数目,芯片封装可分为:单芯片封装与多芯片封装两大类。