PCB压合培训
- 格式:ppt
- 大小:263.50 KB
- 文档页数:50

压合工艺培训资料工艺流程简介棕化→预排→排板→压合→拆板→打靶→锣边→磨边→FQC→包装出货1、棕化:目的就是粗CU面,增加与树脂接触的表面积,加强二者之间的附着力(Adhesion);增加铜面对流动树脂之润湿性,使树脂能流入各死角而在硬化后有更强的黏结力,以增强PP与CU间的结合力。
棕化的好坏直接影响爆板。
2、预排:1)四层板:直接将PP按压板指示要求排在板上即可。
2)六层板以上:须定位熔合、铆合固定各层芯板..3)开PP:一般经板料开料尺寸大0.2”4)需注意的问题:横直料、排斜、清洁、用错PP等3、排板:将所需外层铜箔与已预排好的板叠合在一起,以待压合。
4、压合:通过半固化片在高温下进一步熔融固化,将多张芯板粘合在一起而成为多层压合板。
5、拆板:将已压合之板拆开。
6、打靶(打管位孔):将管位孔靶标用X-RAY或CCD打出。
作用:重要的工艺孔,用于锣边、外层钻孔、成型等定位。
7、锣边、磨边:锣出MI所要求外形尺寸,并将板边披峰磨光滑,以防后工序刮伤D/F、A/W。
二、物料介绍压合所有物料所用成本占整个内层(D/F→压合)成本的80%,因此所用物料是非常重要的,我们必须对这些物料物性有所了解板料构成:板料由介电层(树脂Resin、玻璃纤维Glass fiber)及高纯度的导体(铜箔copper foil)所构成的复合材料A:树脂(Resin)目前使用于线路板的树脂特别多:如酚醛树脂(phenolic)、环氧树脂(epoxy)、聚压酰胺树脂、聚四氟乙烯、B一三氮树脂等皆为热固型树脂1)环氧树脂B:玻璃纤维玻璃纤维(Fiber glass)在PCB基板中的功能,是作为补强材料,基板中的补强材料还有其他,如:纸质基板的纸材、Kelvar(Polyamide聚酰胺)纤维以及石英(Quarts)纤维玻璃本身是一种混合物,由一些无机物经高温熔融而成,再经抽丝冷却而成一种非结晶结构的坚硬物体玻璃纤维的制成可分两种,一种是连续式的纤维,另一种则是不连续式的纤维,前者即用于织成玻璃布,后者则做成片状的玻璃席。


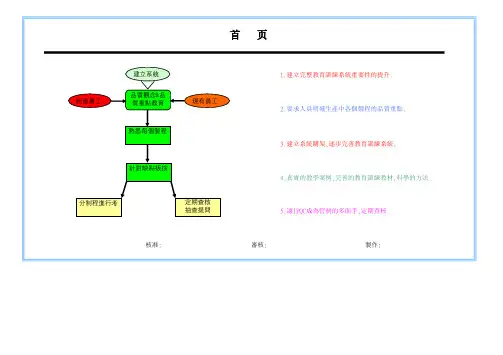


(培训体系)压板培训资料引言1、PCB发展简史:印制电路基本概念于本世纪初已有人于专利中提出过,1947年美国航空局和美国标准局发起了印制电路首次技术讨论会,当时列出了26种不同的印制电路制造方法.且归纳为六类:涂料法、喷涂法、化学沉积法、真空蒸发法、模压法和粉压法.当时这些方法均未能实现大规模工业化生产,直到五十的年代初期,由于铜箔和层压板的粘合问题得到解决,覆铜层压板性能稳定可靠,且实现了大规模工业化生产,铜箔蚀刻法,成为印制板制造技术的主流,壹直发展至今.六十年代,孔金属化双面印制和多层印制板实现了大规模生产,七十年代收于大规模集成电路和电子计算机和迅速发展,八十年代表面安装技术和九十年代多芯片组装技术的迅速发展推动了印制板生产技术的继续进步,壹批新材料、新设备、新测试仪器相继涌现.印制电路生产动手术进壹步向高密度,细导线,多层,高可靠性、低成本和自动化连续生产的方向发展.我国从五十年代中期开始了单面印制板的研制.首先应用于半导体收音机中.六十年代中自力更生地开发了我国的覆箔板基材,使铜箔蚀刻法成为我国PCB生产的主导工艺.六十年代已能大批量地生产单面板,小批量生产双面金属化孔印制,且于少数几个单位开始研制多层板.七十年代于国内推广了图形电镀蚀刻法工艺,但由于受到各种干扰,印制电路专用材料和专用设备没有及时跟上,整个生产技术水平落后于国外先进水平.到了八十年代,由于改革、开放政策的批引,不仅引进了大量具有国外八十年代先进水平的单面、双面、多层印制板生产线,而且经过十多年消化、吸收,较快地提高了我国印制电路生产技术水平.2、我国PCB行业发展现状:1990年以来香港、台湾地区及日本等外国PCB厂商纷纷来到我国合资或独资设厂,使我国PCB生产产量猛增,发展很快。
1995年全国印制电路行业协会进行了壹次全国调查,共调查了全国459个印制电路板生产企业,其中包括国营企业128个,集体企业125个,合资企业86个,私营企业22个,外资企业98个。


pcb压合工艺流程培训下载温馨提示:该文档是我店铺精心编制而成,希望大家下载以后,能够帮助大家解决实际的问题。
文档下载后可定制随意修改,请根据实际需要进行相应的调整和使用,谢谢!并且,本店铺为大家提供各种各样类型的实用资料,如教育随笔、日记赏析、句子摘抄、古诗大全、经典美文、话题作文、工作总结、词语解析、文案摘录、其他资料等等,如想了解不同资料格式和写法,敬请关注!Download tips: This document is carefully compiled by the editor. I hope that after you download them, they can help yousolve practical problems. The document can be customized and modified after downloading, please adjust and use it according to actual needs, thank you!In addition, our shop provides you with various types of practical materials, such as educational essays, diary appreciation, sentence excerpts, ancient poems, classic articles, topic composition, work summary, word parsing, copy excerpts,other materials and so on, want to know different data formats and writing methods, please pay attention!PCB压合工艺是电子制造过程中不可或缺的一环,其质量直接影响到整个产品的稳定性与可靠性。

第五课压合工序1.压合主要功能压合是將內层基板、PP胶片、铜箔按一定的順序叠合后,然后通过高温、高压粘合在一起,使之成为四层板或多层板。
2.压合流程內层基板→黑化/棕化→黑化板檢查→PP胶片裁切→PP胶片檢查→組合→銅箔裁切→钢板磨刷→排板及叠板→热压→冷压→拆板→分割→铣靶→钻靶→锣边→压合板送往钻孔工序3.压合主要物料a.PP胶片: PP粘合片是由玻璃布+环氧树脂(是阻燃性),经过浸漬、压合、烘烤成半透明、半固体的绝緣体,主要起粘合及绝缘作用常用PP型号有四种:7628、2116、1080,特性如下:型號7628 2116 1080 含膠量 RC48±3%54±3%68±3%流膠量 RF28±1%30±5%35±5%凝膠時間 GT160±20sec160±20 sec160±20 sec厚度0.20mm0.13mm0.08mm除此之外还有105,106,2313,2113,1506等,且每种型号都有不同的含胶量,比如:7628,有41%,43%,45%,48%,50%等,不同的含胶量对应的厚度不同,PP参数:含胶量:将PP称出重量,再经过高溫、焚化、烘干至玻璃布成純白色时,取出冷卻后的重量,再计算出焚化前与焚化后的比值,公式:流胶量:将PP称出重量,再将PP经过高溫压合后冷卻称出重量,再计算出压合前与压合后的比值,公式:凝胶時間:是指PP经过高温压合后树脂失去流动性的时间PP厚度:分PP来料厚度(理论厚度)与PP压合厚度,压合厚度指PP来料厚度经过压合时减去内层线路无铜区域填胶部分损耗后剩余的厚度b.铜箔主要是用于外层导电,主要有以下几规格:45〞45〞45〞45〞1/3OZ1/2OZ1OZ0.011mm±10%0.018mm±10%0.035mm±10%0.07mm±10% 2OZ4.叠板、排版:将铜箔、PP及内层基板,按MI规定的顺序叠放好,并根据压机大小排好版(叠板)(排版)(压机)5.拆板、分板6. X-Ray钻靶(钻靶)有的设备需要选铣掉靶标上的铜箔才能打靶,现在一般X_Ray打靶机都可以直接钻靶孔,钻靶孔目的就是为了钻孔定位,以保证与内层图形对齐,钻靶后还要锣板边压合工程设计要求1.压合叠构计算下图所示是一个普通的四层板叠构,我们再计算一下它的理论厚度是多少?残铜率:是指线路铜皮在所在层所占的比列,用GENESIS软件可以自动计算,例如:7628 PP的含胶量是50%,理论厚度是 0.25mm计算公式:L1-L2层PP压合厚度=PP理论厚度-基材位置的填胶厚度(基材的百分比*铜厚),即0.25-(1-86%)*0.03=0.246mmL3-L4层PP压合厚度=PP理论厚度-基材位置的填胶厚度(基材的百分比*铜厚),即0.25-(1-79%)*0.03=0.244mm总厚度=0.011+0.246+1.1+0.244+0.011=1.512mm2.压合叠构计算注意事项A.压合叠构理论值要比成品厚度小0.1mm制作,公差要比成品小0.03mm,如客户要求成品板厚为 1.6mm+/-0.16mm,那么产线压合厚度就按 1.5+/-0.13mm 管控,我们工程设计时按中值+/-0.05mm制作,即 1.5+/-0.05mm,超出此范围就要重新设计B. PP理论厚度根据各板料供应商及各厂家参数有所不同,比如同样是7628RC50%的P片,KB可能是0.25mm,而生益可能是0.2mm,所以一定要核对各厂家的PP参数,具体见PP厚度表C.上下对应的PP压合厚度一般取一个平均值,如上面L1-L2为 0.246mm,L3-L4层为0.244mm,我们就按平均值0.245mm就可以了D.设计压合叠构时一定要事先看看是否有阻抗要求,要先满足阻抗要求E.如果客户设计的叠构不能满足阻抗及板厚时需要咨询客户更改叠构F.内层芯板一般0.8mm以下为不含铜,0.8mm及以上为含铜,计算厚度时一定要看清楚,如芯板不含铜还要加上两层铜厚(0.8mm有含铜与不含铜两种)G. P片张数越少成本越低(不同厚度的P片价格相差不大,但不同张数的压合结构成本相差很大);H.相同P片张数的情况下内层芯板越薄成本越低(但要注意平衡涨缩控制问题,复杂的板不宜用太薄的芯板)。


压合制程1. 凡公司之多层板PCB 产品均适用之.2. 作业流程:黑氧化 →烘烤 → →叠合 →热压→ 冷却→ 下料→烘烤→ 点靶 →割废铜皮→ 检测 →铣靶 →转下制程3. 流程说明:3.1黑化: 3.1.1 黑化作用:清洁Cu 面以免环氧树脂的铵分子攻击铜面,从面增强树脂与内层的结合力.3.1.2要求:使铜而产生黑色的绒柱状体氧化膜,颜色一致,不能有露铜,发红等.3.1.3作业流程:插挂篮→ 清洁水→ 水洗12→ 粗化 →水洗22 →预黑化 →黑化→水洗 →下料3.1.3.1插挂篮:刷好之板每格对称插1pnl.注意:手不能直接触板面,以防氧化黑化不良,板与板不能碰到.3.1.3.2清洁:除指纹,油脂.条件:成份CT-110 T:55℃ 时间2min每生产100m2/加CT-110 3L,1200m2/换 浓度15%.3.1.3.3粗化:SPS.H2S04去除铜面氧化,便于黑化.条件:T=30℃ 时间2-3min添加100m2/SPS 1kg 7800m2/换 浓度 SPS 40-50 H2S04 5% 注意:粗化时间严格控制,过长易蚀掉表面Cu.3.1.3.4水洗去除表面粗化液,不影响下槽药水,清洁板面尘埃及铜盐.注意:流动水清洗,在空气中停留不要过长,以免氧化下道水洗必滴干,以免预黑化中起中和反应.3.1.3.5预黑化 CL-210B 碱剂.使板面一种微薄的黑化层.T=30℃ 时间1-2min 100m2/加1L 210B 2500m2/换 浓度10%(不允许酸性物质介入)3.1.3.6黑化:CL210A 210B 成份裁PP 贴靶 刷钢板 组合裁铜皮氧化铜面,生产黑化膜. T:70+5℃ /4-5min 100m2/加210A6L210B/1.5L 56000m2/换浓度碱剂20-30L/L氧化剂120-140L/L操作要过滤循环,并充分搅拌.黑化常见问题:发红原因:刷板沾锡,板面手印,油脂,粗化不够,粗化水洗不尽,沾酸性,黑化温度化时间不够,浓度不当.检验不良:发红,露Cu 沾胶.板洁状况 (手不允许摸黑化膜)退洗:HCL 30%-H20 65% 时间1-2min3.2烘干把板面水份烘干,使热压不起泡. T:130℃/40-50min板面水滴进烤箱时间:温度不要过久,以免板发黄.3.2.1 贴靶:用高温靶胶封住孔,使压合时树脂胶不流入孔内.3.2.2 P.P裁切:依规范选择树脂型号,四层板以发料尺寸,六层板以铆孔为准,经纬不允许混淆.3.2.3 裁铜箔:按规范要求选择铜皮厚度,1.0-0.5OZ 裁切尺寸比排版大40-60mm,不允许氧化,皱折.3.2.4 刷钢板:T 100±10℃ D=16℃刷轮尼龙刷,磨钢板400#砂纸,去除钢板上残胶,上下左右均匀打磨,不得刮花轻拿轻放,每pnL垫纸.3.2.5 组合:组合方式:(1.0T 内层压至1.6T).放1080#PP+7628#+内层+7628#+1080#PP→夹子夹住板的一边(数据及经纬要一致)3.3叠板:在投影灯下,将牛皮纸内层组合与铜皮,钢板完成上下对准之工作.工具:擦子牛皮纸.铝板钢板注:牛皮纸起到传热作用,一般用3次,每次14-16张.垒板时每层须对准胜条投影线,窄边朝里,排版间距4-6mil,取夹子,擦铜皮,注意防止树脂移位,钢板使用面积:Smin 30*20 Smax 40*303.4热压共分三段:第一段:15-20KG/Cm2 第二段:30-35kg/cm2第三段:P=S(内层板(IN2)*A排版数/7.7系数kg/in2注:上压开始2min至最后5min抽真空,入气保持5min OK.待机温度:铝板数待机℃1-----2 1603-----4 1705-----6 1803.5冷压:消除网应力,防止板弯板翘.压力:100kg/cm2 时间50min循环水塔清洗/周3.5.1下料:取板戴干净手套,以防氧化,钢板轻拿轻放防刮花.3.5.2烘烤:4H, T:150±5℃进一步烘烤防钻孔后缩水及板弯板翘.3.5.3点靶:用油色笔标示好靶孔位,便于铣靶作业.3.5.4割废铜箔,用介刀割掉所压板多余铜皮,戴手套作业,小心不允许刮伤板面3.5.6检测:1.测厚度(千分尺)是否与规范一致.2.板面状况,呈十点凹凸不平等.3.5.7铣靶:用铣靶机把靶胶封住的孔上残胶去除,露出孔为钻孔作准备.调刀:由浅至深不伤内层为至.4.注意事项:树脂环境要求5-21℃,PH65%以下.1烤后之板5H未用完,若再用时必须加烤10min/150℃.2合、叠板、P.P/铜皮裁切不允许通话,以防口沫沾于板上压合会引起气泡.。
五.壓合5.1. 製程目的:將銅箔(Copper Foil),膠片(Prepreg)與氧化處理(Oxidation)後的內層線路板,壓合成多層基板.本章仍介紹氧化處理,但未來因成本及縮短流程考量,取代製程會逐漸普遍.5.2. 壓合流程,如下圖5.1:5.3. 各製程說明5.3.1 內層氧化處理(Black/Brown Oxide Treatment)5.3.1.1 氧化反應A. 增加與樹脂接觸的表面積,加強二者之間的附著力(Adhesion).B. 增加銅面對流動樹脂之潤濕性,使樹脂能流入各死角而在硬化後有更強的抓地力。
C. 在裸銅表面產生一層緻密的鈍化層(Passivation)以阻絕高溫下液態樹脂中胺類(Amine)對銅面的影響。
5.3.1.2. 還原反應目的在增加氣化層之抗酸性,並剪短絨毛高度至恰當水準以使樹脂易於填充並能減少粉紅圈( pink ring ) 的發生。
5.3.1.3. 黑化及棕化標準配方:表一般配方及其操作條件上表中之亞氯酸鈉為主要氧化劑,其餘二者為安定劑,其氧化反應式。
此三式是金屬銅與亞氯酸鈉所釋放出的初生態氧先生成中間體氧化亞銅,2Cu+[O] →Cu2O,再繼續反應成為氧化銅CuO,若反應能徹底到達二價銅的境界,則呈現黑巧克力色之"棕氧化"層,若層膜中尚含有部份一價亞銅時則呈現無光澤的墨黑色的"黑氧化"層。
5.3.1.4. 製程操作條件( 一般代表),典型氧化流程及條件。
5.3.1.5 棕化與黑化的比較A.黑化層因液中存有高鹼度而雜有Cu2O,此物容易形成長針狀或羽毛狀結晶。
此種亞銅之長針在高溫下容易折斷而大大影響銅與樹脂間的附著力,並隨流膠而使黑點流散在板中形成電性問題,而且也容易出現水份而形成高熱後局部的分層爆板。
棕化層則呈碎石狀瘤狀結晶貼銅面,其結構緊密無疏孔,與膠片間附著力遠超過黑化層,不受高溫高壓的影響,成為聚亞醯胺多層板必須的製程。
PCB内层压合流程知识培训PCB(Printed Circuit Board)内层压合流程是指将多层PCB中的内层铜箔与其它层进行压合,形成完整的电路板的加工过程。
本文将对PCB内层压合流程进行详细介绍,包括准备工作、材料选择、压合过程控制等方面。
一、准备工作:1.设计需求评估:根据设计要求和电路板结构,评估内层压合的特殊需求,比如盲孔、埋孔等。
2. 材料准备:准备内层铜箔、导电胶、预preg(预浸料)等材料。
3.内层铜箔处理:将内层铜箔清洗干净,确保表面光洁,无油污和氧化物。
二、材料选择:1.内层铜箔:根据电路板设计和设备要求,选择合适厚度的内层铜箔,常用厚度有18μm、35μm、70μm等。
2.导电胶:导电胶是用于在内层铜箔和其他层之间建立电气连接的材料,常用的导电胶有聚酰亚胺(PI)和环氧树脂。
三、内层压合流程:1.预处理:将内层铜箔放入去离子水中清洗,并对铜箔表面进行化学处理,提高内层胶层附着力。
2.导电胶涂布:将导电胶均匀涂布在内层铜箔上,确保胶层良好的附着性和导电性。
3.人工贴合:将涂布了导电胶的内层铜箔与其他层排列组合好,确保每一层靶点位置准确。
4. 热压:将内层铜箔和其他层一起放入压合机,进行热压合作用。
热压温度和时间需要根据导电胶和预preg的特性和厚度进行调整。
5. 温升:压合机会逐渐升温,使导电胶和预preg中的树脂熔化,从而形成导电层和绝缘层。
6. 高压:压合机施加高压力,确保内层铜箔与其他层的良好结合。
高压时间也需要根据导电胶和预preg的特性和厚度进行调整。
7. 冷却:内层压合完成后,将PCB在压合机内冷却,使导电胶和预preg快速固化,形成稳定的连接。
四、流程控制:1. 温度控制:合适的温度可以保证导电胶和预preg的良好结合,同时避免过高温度导致材料焦糊。
2.压力控制:压合机需要施加合适的压力,确保内层铜箔与其他层的紧密结合,同时避免过高压力导致PCB板变形。
3. 时间控制:热压和高压的时间需要根据导电胶和预preg的特性和厚度进行调整,以保证良好的结合效果和稳定性。