IC的常见封装形式
- 格式:docx
- 大小:236.78 KB
- 文档页数:4

NO.IC封装方式英文全称1DIP Dual In-line Package2SOP Small Out-LinePackage3QFP Quad Flat Package4QFN Quad Flat No-leadPackage5BGA Ball Grid ArrayPackagePlastic Leaded 6PLCCChip Carrier常见IC封装方式简介图片DIP封装也叫双列直插式封装技术,是一种最简单的封装方式.指采用双列直插形式封装的集成电路芯片,绝大多数中小规模集成电路均采用这种封装形式,其引脚数一般不超过100。
DIP封装的CPU芯片有两排引脚,需要插入到具有DIP结构的芯片插座上。
SOP封装是一种元件封装形式,常见的封装材料有:塑料、陶瓷、玻璃、金属等,现在基本采用塑料封装.,应用范围很广,主要用在各种集成电路中。
这种技术的中文含义叫方型扁平式封装技术(Quad FlatPackage),该技术实现的CPU芯片引脚之间距离很小,管脚很细,一般大规模或超大规模集成电路采用这种封装形式,其引脚数一般都在100以上。
该技术封装CPU时操作方便,可靠性高;而且其封装外形尺寸较小,寄生参数减小,适合高频应用;该技术主要适合用SMT表面安装技术在PCB上安装布线。
QFN(Quad Flat No-leadPackage,方形扁平无引脚封装),表面贴装型封装之一。
现在多称为LCC。
QFN 是日本电子机械工业 会规定的名称。
封装四侧配置有电极触点,由于无引脚,贴装占有面积比QFP 小,高度 比QFP 低。
但是,当印刷基板与封装之间产生应力时,在电极接触处就不能得到缓解。
因此电 极触点 难于作到QFP 的引脚那样多,一般从14 到100 左右。
材料有陶瓷和塑料两种。
当有LCC 标记时基本上都是陶瓷QFN。
电极触点中心距1.27mm。
塑料QFN 是以玻璃环氧树脂印刷基板基材的一种低成本封装。

常用集成电路芯片封装图三极管封装图LQFP BQFP PQFPSC-70SOJSSOPSOP TQFP常见集成电路(IC)芯片的封装SIP(Single In-line Package)PGA(Pin Grid Array Package)PLCC(Plastic leaded Chip Carrier).CSP (Chip Scale Package)DIP,SIP,SOP,TO,SOT元件封裝形式(图)各元器件封装形式图解, 不知道有没有人发过. 暂且放上!CDIP-----Ceramic Dual In-Line PackageCLCC-----Ceramic Leaded Chip CarrierCQFP-----Ceramic Quad Flat PackDIP-----Dual In-Line PackageLQFP-----Low-Profile Quad Flat PackMAPBGA------Mold Array Process Ball Grid ArrayPBGA-----Plastic Ball Grid ArrayPLCC-----Plastic Leaded Chip CarrierPQFP-----Plastic Quad Flat PackQFP-----Quad Flat PackSDIP-----Shrink Dual In-Line PackageSOIC-----Small Outline Integrated PackageSSOP-----Shrink Small Outline PackageDIP-----Dual In-Line Package-----双列直插式封装。
插装型封装之一,引脚从封装两侧引出,封装材料有塑料和陶瓷两种。
DIP是最普及的插装型封装,应用范围包括标准逻辑IC,存贮器LSI,微机电路等。
PLCC-----Plastic Leaded Chip Carrier-----PLCC封装方式,外形呈正方形,32脚封装,四周都有管脚,外形尺寸比DIP封装小得多。



电子元件集成电路 IC 的封装 DIP、QFP、PGA、BGA CSP CGA LGA ZIF SOP PFP... 从foundry厂得到圆片进行减薄、中测打点后,即可进入后道封装。
封装对集成电路起着机械支撑和机械保护、传输信号和分配电源、散热、环境保护等作用。
芯片的封装技术已经历了好几代的变迁,从DIP、QFP、PGA、BGA到CSP再到MCM,技术指标一代比一代先进,包括芯片面积与封装面积之比越来越接近于1,适用频率越来越高,耐温性能越来越好,引脚数增多,引脚间距减小,重量减小,可靠性提高,使用更加方便等等。
近年来电子产品朝轻、薄、短、小及高功能发展,封装市场也随信息及通讯产品朝高频化、高I/O 数及小型化的趋势演进。
由1980 年代以前的通孔插装(PTH)型态,主流产品为DIP(Dual In-Line Package),进展至1980 年代以SMT(Surface Mount Technology)技术衍生出的SOP(Small Out-Line Package)、SOJ(Small Out-Line J-Lead)、PLCC(Plastic Leaded Chip Carrier)、QFP(Quad Flat Package)封装方式,在IC 功能及I/O 脚数逐渐增加后,1997 年Intel 率先由QFP 封装方式更新为BGA(Ball Grid Array,球脚数组矩阵)封装方式,除此之外,近期主流的封装方式有CSP(Chip Scale Package 芯片级封装)及Flip Chip(覆晶)。
BGA(Ball Grid Array)封装方式是在管壳底面或上表面焊有许多球状凸点,通过这些焊料凸点实现封装体与基板之间互连的一种先进封装技术。
BGA封装方式经过十多年的发展已经进入实用化阶段。
1987年,日本西铁城(Citizen)公司开始着手研制塑封球栅面阵列封装的芯片(即BGA)。
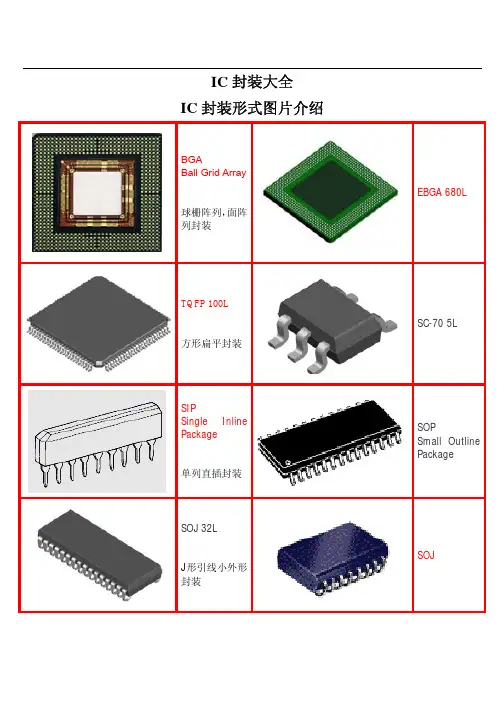
IC 封装大全 IC 封装形式图片介绍BGA Ball Grid Array EBGA 680L 球栅阵列, 面阵 列封装TQFP 100L SC-70 5L 方形扁平封装SIP Single Inline PackageSOP Small Outline Package单列直插封装SOJ 32L SOJ J 形引线小外形 封装SOP EIAJ TYPE II 14L SOT220 小外形封装SSOP 16LSSOPTO-18TO-220TO-247TO-264TO3TO52TO52TO71TO72TO78TO8TO92TO93TO99TSOP Thin Small Outline PackageTSSOP or TSOP II Thin Shrink Outline PackageuBGA Micro Ball Grid ArrayZIP Zig-Zag Inline PackageuBGA Micro Ball Grid ArrayZIP Zig-Zag PackageInlineBQFP132C-Bend LeadCERQUAD Ceramic Quad Flat PackCeramic CaseGull LeadsWingTO263/TO268LBGA 160LPBGA 217L Plastic Ball Grid ArraySBGA 192LTSBGA 680LCLCCCPGA Ceramic Pin Grid ArrayDIP Dual Inline PackageDIP-tab Dual Inline Package with Metal Heatsink双列直插封装FBGAFDIPFTO220Flat PackHSOP28ITO220ITO3pJLCCLCCLDCCLGALQFPPCDIPPGA Plastic Pin Grid ArrayPLCC PQFP 有引线塑料芯 片栽体PSDIPLQFP 100LMETAL QUAD 100LPQFP 100LQFP Quad PackageFlatSOT223SOT223SOT23SOT23/ SOT323SOT26/ SOT363SOT343SOT523SOT89SOT89LAMINATE TCSP 20L Chip Scale PackageTO252SO DIMM Small Outline Dual In-line Memory ModuleSIMM30 Single In-line Memory ModuleSocket 603FosterSOCKET 370 For intel 370 pin PGAPentium III &Celeron CPUPCI 64bit 3.3VPeripheralComponentInterconnect SIMM72 Single In-line Memory ModuleSOCKET462/SOCKET AFor PGA AMDAthlon &Duron CPUSOCKET 7 For intel Pentium & MMX Pentium CPUSLOT 1For intelPentium IIPentium III &Celeron CPUSLOT A For AMD Athlon CPUPCMCIASIMM72 Single In-line Memory ModuleIC封装形式文字介绍1、BGA(ball grid array)球形触点陈列,表面贴装型封装之一。


常见IC封装术语详解文章详细列出并解释了70个IC封装术语,供大家参考1、BGA(ball grid array)球形触点陈列,表面贴装型封装之一。
在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配LSI 芯片,然后用模压树脂或灌封方法进行密封。
也称为凸点陈列载体(PAC)。
引脚可超过200,是多引脚LSI 用的一种封装。
封装本体也可做得比QFP(四侧引脚扁平封装)小。
例如,引脚中心距为1.5mm 的360 引脚 BGA 仅为31mm 见方;而引脚中心距为0.5mm 的304 引脚QFP 为40mm 见方。
而且BGA 不用担心QFP 那样的引脚变形问题。
该封装是美国Motorola 公司开发的,首先在便携式电话等设备中被采用,今后在美国有可能在个人计算机中普及。
最初,BGA 的引脚(凸点)中心距为1.5mm,引脚数为225。
现在也有一些LSI 厂家正在开发500 引脚的BGA。
BGA 的问题是回流焊后的外观检查。
现在尚不清楚是否有效的外观检查方法。
有的认为,由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。
美国Motorola公司把用模压树脂密封的封装称为OMPAC,而把灌封方法密封的封装称为GPAC(见OMPAC 和GPAC)。
2、BQFP(quad flat package with bumper)带缓冲垫的四侧引脚扁平封装。
QFP 封装之一,在封装本体的四个角设置突起(缓冲垫) 以防止在运送过程中引脚发生弯曲变形。
美国半导体厂家主要在微处理器和ASIC 等电路中采用此封装。
引脚中心距0.635mm,引脚数从84 到196 左右(见QFP)。
3、碰焊PGA(butt joint pin grid array) 表面贴装型PGA 的别称(见表面贴装型PGA)。
4、C-(ceramic)表示陶瓷封装的记号。
例如,CDIP 表示的是陶瓷DIP。
是在实际中经常使用的记号。

IC的封装种类和图示汇编
答:
一、ARM中断控制器(ARM Interrupt Controller,简称AIC)封装种
类
ARM中断控制器(ARM Interrupt Controller,简称AIC)封装一般分
为三种,分别是V7M AIC、V6 AIC和V8 AIC。
1、V7MAIC
V7M AIC是ARMv7-M处理器核的封装种类,它被用于实现cortex-M
系列处理器的中断控制。
V7M AIC的特性如下图所示:
V7M AIC使用ARM提供的Nested Vectored Interrupt Controller (NVIC)构建,它是一个标准中断控制器,用于将中断请求(IRQ)传递
到Cortex-M处理器,以便进行中断处理,NVIC包含了表驱动的中断处理,可以根据中断请求(IRQ)类型调整中断优先级,支持嵌套中断,同时也
支持多核处理器。
2、V6AIC
V6 AIC是ARMv6处理器核的封装种类,它被用于实现cortex-A系列
处理器的中断控制。
V6 AIC的特性如下图所示:
V6 AIC使用ARMv6提供的Advanced Interrupt Controller(AIC)
构建,它允许中断请求者使用任意优先级来发起中断请求,并支持每个中
断请求者的嵌套中断处理,AIC同时也提供了更多高级功能,比如:中断
掩。

芯片封装大全集锦详细介绍一、DIP双列直插式封装DIP(DualIn-line Package)是指采用双列直插形式封装的集成电路芯片,绝大多数中小规模集成电路(IC)均采用这种封装形式,其引脚数一般不超过100个。
采用DI P封装的CPU芯片有两排引脚,需要插入到具有DIP结构的芯片插座上。
当然,也可以直接插在有相同焊孔数和几何排列的电路板上进行焊接。
DIP封装的芯片在从芯片插座上插拔时应特别小心,以免损坏引脚。
DIP封装具有以下特点:1.适合在PCB (印刷电路板)上穿孔焊接,操作方便。
2.芯片面积与封装面积之间的比值较大,故体积也较大。
Intel系列CPU中8088就采用这种封装形式,缓存(Cache )和早期的内存芯片也是这种封装形式。
二、QFP塑料方型扁平式封装和PFP塑料扁平组件式封装QFP(Plastic Quad Flat Package)封装的芯片引脚之间距离很小,管脚很细,一般大规模或超大型集成电路都采用这种封装形式,其引脚数一般在100个以上。
用这种形式封装的芯片必须采用SMD(表面安装设备技术)将芯片与主板焊接起来。
采用S MD安装的芯片不必在主板上打孔,一般在主板表面上有设计好的相应管脚的焊点。
将芯片各脚对准相应的焊点,即可实现与主板的焊接。
用这种方法焊上去的芯片,如果不用专用工具是很难拆卸下来的。
PFP(Plastic Flat Package)方式封装的芯片与QFP方式基本相同。
唯一的区别是QFP一般为正方形,而PFP既可以是正方形,也可以是长方形。
QFP/PFP封装具有以下特点:1.适用于SMD表面安装技术在P CB电路板上安装布线。
2.适合高频使用。
3.操作方便,可靠性高。
4.芯片面积与封装面积之间的比值较小。
Intel系列CPU中80286 、80386和某些486主板采用这种封装形式。
三、PGA插针网格阵列封装PGA(Pin Grid Array Package)芯片封装形式在芯片的内外有多个方阵形的插针,每个方阵形插针沿芯片的四周间隔一定距离排列。

IC产品封装形式⼤全IC产品封装形式⼤全什么叫封装封装,就是指把硅⽚上的电路管脚,⽤导线接引到外部接头处,以便与其它器件连接.封装形式是指安装半导体集成电路芯⽚⽤的外壳。
它不仅起着安装、固定、密封、保护芯⽚及增强电热性能等⽅⾯的作⽤,⽽且还通过芯⽚上的接点⽤导线连接到封装外壳的引脚上,这些引脚⼜通过印刷电路板上的导线与其他器件相连接,从⽽实现内部芯⽚与外部电路的连接。
因为芯⽚必须与外界隔离,以防⽌空⽓中的杂质对芯⽚电路的腐蚀⽽造成电⽓性能下降。
另⼀⽅⾯,封装后的芯⽚也更便于安装和运输。
由于封装技术的好坏还直接影响到芯⽚⾃⾝性能的发挥和与之连接的PCB(印制电路板)的设计和制造,因此它是⾄关重要的。
衡量⼀个芯⽚封装技术先进与否的重要指标是芯⽚⾯积与封装⾯积之⽐,这个⽐值越接近1越好。
封装时主要考虑的因素:1、芯⽚⾯积与封装⾯积之⽐为提⾼封装效率,尽量接近1:1;2、引脚要尽量短以减少延迟,引脚间的距离尽量远,以保证互不⼲扰,提⾼性能;3、基于散热的要求,封装越薄越好。
封装主要分为DIP双列直插和SMD贴⽚封装两种。
从结构⽅⾯,封装经历了最早期的晶体管TO(如TO-89、TO92)封装发展到了双列直插封装,随后由PHILIP公司开发出了SOP ⼩外型封装,以后逐渐派⽣出SOJ(J型引脚⼩外形封装)、TSOP(薄⼩外形封装)、VSOP (甚⼩外形封装)、SSOP(缩⼩型SOP)、TSSOP(薄的缩⼩型SOP)及SOT(⼩外形晶体管)、SOIC(⼩外形集成电路)等。
从材料介质⽅⾯,包括⾦属、陶瓷、塑料、塑料,⽬前很多⾼强度⼯作条件需求的电路如军⼯和宇航级别仍有⼤量的⾦属封装。
封装⼤致经过了如下发展进程:结构⽅⾯:TO->DIP->PLCC->QFP->BGA ->CSP;材料⽅⾯:⾦属、陶瓷->陶瓷、塑料->塑料;引脚形状:长引线直插->短引线或⽆引线贴装->球状凸点;装配⽅式:通孔插装->表⾯组装->直接安装⼆、具体的封装形式1、SOP/SOIC封装SOP是英⽂Small Outline Package 的缩写,即⼩外形封装。
IC封装分类大全该资料来源于深圳雷动天科技有限公司详细资料请参考于该网站1、BGA(Ball Grid Array) 球型触电陈列,表面贴装型封装。
在印刷基板的背面按陈列方式制作出球型凸点用以代替引脚,再印刷基板的正面装配LSI芯片,用后模压树脂或灌封方法进行密封(也称为凸点陈列载体,PGA),引脚可以超过200,是多引脚LSI的一种封装。
该封装是美国Motorola公司开发,广泛用于便携式电话等设备中。
BGA的问题在于回流焊后的外观检查,焊接质量检验需要X光或超声波检查设备,在没有检查设备的的情况下,可通过功能测试判断焊接质量,也可凭经验进行检查。
1.1 PBGA载体为普通的印制板基材,芯片通过金属丝压焊方式连接到载体上表面,塑料模压成形载体表面连接有共晶焊料球阵列。
优点:封装成本相对较低;和QFP相比,不易受到机械损伤;适用大批量的电子组装;字体与PCB基材相同,热膨胀系数几乎相同,焊接时,对函电产生应力很小,对焊点可靠性影响也较少。
缺点:容易吸潮。
1.2 CBGA载体为多层陶瓷,芯片与陶瓷载体的连接可以有两种形式:金属丝压焊;倒装芯片技术优点:电性能和热性能优良;既有良好的密封性;和QFP相比,不易受到机械损伤;适用于I/O数大于250的电子组装。
缺点:与PCB相比热膨胀系数不同,封装尺寸大时,导致热循环函电失效。
1.3 CCGACCGA是CBGA尺寸大于在32*32mm时的另一种形式,不同之处在于采用焊料柱代替焊料球。
焊料柱采用共晶焊料连接或直接浇注式固定在陶瓷底部。
优缺点与CCGA大体相同,不同在于焊料柱能够承受CTE不同所产生的应力,能够应用在大尺寸封装。
TBGA载体采用双金属层带,芯片连接采用倒装技术实现。
优点:可以实现更轻更小封装;适合I/O数可以较多封装;有良好的电性能;适于批量电子组装;焊点可靠性高。
缺点:容易吸潮;封装费用高。
2、QFP(Quad Flat Package)为四侧引脚扁平封装,是表面贴装型封装之一,引脚从四个侧面引出呈海鸥翼(L)型。
各类IC封装图片大全
封装形式是指安装半导体集成电路芯片用的外壳。
它不仅起着安装、固定、密封、爱惜芯片及增强电热性能等方面的作用,而且还通过芯片上的接点用导线连接到封装外壳的引脚上,这些引脚又通过印刷电路板上的导线与其他器件相连接。
衡量一个芯片封装技术先进与否的重要指标是芯片面积与封装面积之比,那个比值越接近 1越好。
封装大致经过了如下发展进程:
结构方面:TO->DIP->LCC->QFP->BGA ->CSP;
材料方面:金属、陶瓷->陶瓷、塑料->塑料;
引脚形状:长引线直插->短引线或无引线贴装->球状凸点;
装配方式:通孔插装->表面组装->直接安装。
芯片封装大全集锦详细介绍一、DIP双列直插式封装DIP(DualIn-line Package)是指采用双列直插形式封装的集成电路芯片,绝大多数中小规模集成电路(IC)均采用这种封装形式,其引脚数一般不超过100个。
采用DI P封装的CPU芯片有两排引脚,需要插入到具有DIP结构的芯片插座上。
当然,也可以直接插在有相同焊孔数和几何排列的电路板上进行焊接。
DIP封装的芯片在从芯片插座上插拔时应特别小心,以免损坏引脚。
DIP封装具有以下特点:1.适合在PCB (印刷电路板)上穿孔焊接,操作方便。
2.芯片面积与封装面积之间的比值较大,故体积也较大。
Intel系列CPU中8088就采用这种封装形式,缓存(Cache )和早期的内存芯片也是这种封装形式。
二、QFP塑料方型扁平式封装和PFP塑料扁平组件式封装QFP(Plastic Quad Flat Package)封装的芯片引脚之间距离很小,管脚很细,一般大规模或超大型集成电路都采用这种封装形式,其引脚数一般在100个以上。
用这种形式封装的芯片必须采用SMD(表面安装设备技术)将芯片与主板焊接起来。
采用S MD安装的芯片不必在主板上打孔,一般在主板表面上有设计好的相应管脚的焊点。
将芯片各脚对准相应的焊点,即可实现与主板的焊接。
用这种方法焊上去的芯片,如果不用专用工具是很难拆卸下来的。
PFP(Plastic Flat Package)方式封装的芯片与QFP方式基本相同。
唯一的区别是QFP一般为正方形,而PFP既可以是正方形,也可以是长方形。
QFP/PFP封装具有以下特点:1.适用于SMD表面安装技术在P CB电路板上安装布线。
2.适合高频使用。
3.操作方便,可靠性高。
4.芯片面积与封装面积之间的比值较小。
Intel系列CPU中80286 、80386和某些486主板采用这种封装形式。
三、PGA插针网格阵列封装PGA(Pin Grid Array Package)芯片封装形式在芯片的内外有多个方阵形的插针,每个方阵形插针沿芯片的四周间隔一定距离排列。
A、常用芯片封装介绍来源:互联网作者:关键字:芯片封装1、BGA 封装(ball grid array)球形触点陈列,表面贴装型封装之一。
在印刷基板的背面按陈列方式制作出球形凸点用以代替引脚,在印刷基板的正面装配 LSI 芯片,然后用模压树脂或灌封方法进行密封。
也称为凸点陈列载体(PAC)。
引脚可超过200,是多引脚 LSI 用的一种封装。
封装本体也可做得比 QFP(四侧引脚扁平封装)小。
例如,引脚中心距为1.5mm 的360 引脚 BGA 仅为31mm 见方;而引脚中心距为0.5mm 的304 引脚 QFP 为40mm 见方。
而且 BGA 不用担心 QFP 那样的引脚变形问题。
该封装是美国Motorola 公司开发的,首先在便携式电话等设备中被采用,今后在美国有可能在个人计算机中普及。
最初,BGA 的引脚(凸点)中心距为 1.5mm,引脚数为225。
现在也有一些 LSI 厂家正在开发500 引脚的 BGA。
BGA 的问题是回流焊后的外观检查。
现在尚不清楚是否有效的外观检查方法。
有的认为,由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。
美国 Motorola 公司把用模压树脂密封的封装称为 OMPAC,而把灌封方法密封的封装称为 GPAC(见 OMPAC 和 GPAC)。
2、BQFP 封装(quad flat package with bumper)带缓冲垫的四侧引脚扁平封装。
QFP 封装之一,在封装本体的四个角设置突起(缓冲垫) 以防止在运送过程中引脚发生弯曲变形。
美国半导体厂家主要在微处理器和 ASIC 等电路中采用此封装。
引脚中心距0.635mm,引脚数从84 到196 左右(见 QFP)。
3、碰焊PGA 封装(butt joint pin grid array)表面贴装型 PGA 的别称(见表面贴装型 PGA)。
4、C-(ceramic) 封装表示陶瓷封装的记号。
例如,CDIP 表示的是陶瓷 DIP。
IC的常见封装形式
常见的封装材料有:塑料、陶瓷、玻璃、金属等,现在基本采用塑料封装。
按封装形式分:普通双列直插式,普通单列直插式,小型双列扁平,小型四列扁平,圆形金属,体积较大的厚膜电路等。
按封装体积大小排列分:最大为厚膜电路,其次分别为双列直插式,单列直插式,金属封装、双列扁平、四列扁平为最小。
封装的历程变化:TO->DIP->PLCC->QFP->BGA ->CSP
1、DIP(Dual In-line Package)双列直插式封装
D—dual两侧
双列直插式封装。
插装型封装之一,引脚从封装两侧引出
2、SIP(single in-line package)单列直插式封装
引脚从封装一个侧面引出,排列成一条直线。
当装配到印刷基板上时封装呈侧立状
3、SOP(Small Out-Line Package) 小外形封装双列表面安装式封装
以后逐渐派生出SOJ(J型引脚小外形封装)、TSOP(薄小外形封装)、VSOP(甚小外形封装)、SSOP(缩小型SOP)、TSSOP(薄的缩小型SOP)及SOT(小外形晶体管)、SOIC(小外形集成电路)
4、PQFP(Plastic Quad Flat Package)塑料方型扁平式封装
芯片引脚之间距离很小,管脚很细,一般大规模或超大型集成电路都采用这种封装形式,其引脚数一般在100个以上。
适用于高频线路,一般采用SMT技术应用在PCB板上安装
5、BQFP(quad flat package with bumper) 带缓冲垫的四侧引脚扁平封装QFP 封装之一,在封装本体的四个角设置突起(缓冲垫) 以防止在运送过程中引脚发生弯曲变形
6、QFN(quad flat non-leaded package) 四侧无引脚扁平封装
封装四侧配置有电极触点,由于无引脚,贴装占有面积比QFP 小,高度比QFP 低。
但是,当印刷基板与封装之间产生应力时,在电极接触处就不能得到缓解。
因此电极触点难于作到QFP 的引脚那样多,一般从14 到100 左右。
材料有陶瓷和塑料两种。
当有LCC 标记时基本上都是陶瓷QFN
7、PGA(Pin Grid Array Package)插针网格阵列封装
插装型封装之一,其底面的垂直引脚呈阵列状排列,一般要通过插座与PCB板连接。
引脚中心距通常为2.54mm,引脚数从64 到447 左右。
8、BGA(Ball Grid Array Package)球栅阵列封装
其底面按阵列方式制作出球形凸点用以代替引脚。
适应频率超过100MHz,I/O 引脚数大于208 Pin。
电热性能好,信号传输延迟小,可靠性高。
9、PLCC(Plastic leaded Chip Carrier) 塑料有引线芯片载体
P-(plastic) 表示塑料封装的记号
引脚从封装的四个侧面引出,呈J字形。
引脚中心距1.27mm,引脚数18--84。
J 形引脚不易变形,但焊接后外观检查较为困难。
10、CLCC(Ceramic leaded Chip Carrier)陶瓷有引线芯片载体
C-(ceramic)表示陶瓷封装的记号
陶瓷封装,与PLCC相似
11、LCCC(leaded Ceramic Chip Carrier) 陶瓷无引线芯片载体
12、SIMM(Single 1n-line Memory Module) 单列存贮器组件
通常指插入插座的组件。
只在印刷基板的一个侧面附近配有电极的存贮器组件
13、FP(flat package)扁平封装
14、COG(Chip on Glass)芯片被直接绑定在玻璃上
国际上正日趋实用的COG(Chip on Glass)封装技术。
对液晶显示(LCD)技术发展大有影响
的封装技术
15、CSP(Chip Scale Package) 芯片级封装
CSP封装最新一代的内存芯片封装技术,CSP封装装可以让芯片面积与封装面积之比超过1:1.14,已经相当接近1:1的理想情况,绝对尺寸也仅有32平方毫米,约为普通的BGA 的1/3,仅仅相当于TSOP内存芯片面积的1/6。
与BGA封装相比,同等空间下CSP封装可以将存储容量提高三倍。