HDI流程(laser 盲孔和通孔顺序)及通孔补偿控制
- 格式:doc
- 大小:774.50 KB
- 文档页数:2


HDI板工艺流程介绍HDI板(High Density Interconnect board)是一种采用先进工艺制造的高密度互连电路板,具有更高的线路密度和更小的尺寸,可实现更复杂的电路设计和更高性能的电子产品。
HDI板工艺流程是指制造HDI板所需的一系列工艺步骤,下面将详细介绍HDI板工艺流程。
一、图纸设计与合规性审核HDI板制造的第一步是进行电路板的设计和图纸的制作。
设计师根据电路需求绘制电路图,然后将电路图转换为电路板的布局图,确定线路位置、尺寸和层级等。
设计师还需要对设计的电路板进行合规性审核,确保电路板满足相关的标准和规范要求。
二、材料准备与剥离在HDI板制造过程中,需要准备一系列的基板材料、介质材料和覆铜膜等。
首先,需要将基板材料剥离到所需的厚度,以便后续的加工和处理。
三、内层制作内层制作是HDI板工艺流程中的关键步骤之一、首先,需要在基板上涂覆一层铜薄膜,然后使用光刻技术将需要连接的电路图案绘制在铜薄膜上。
接下来,使用化学腐蚀技术将不需要的铜薄膜腐蚀掉,留下所需的电路线路。
四、填铜与压制填铜是为了加强电路板的机械强度和导电性能。
在填铜工艺中,首先在内层制作后的电路板表面涂覆薄膜覆铜剂,然后通过化学镀铜或电镀技术将铜层填充到所需的厚度。
填铜后,将多张内层电路板堆叠在一起,并使用高温和高压进行压制,以形成电路板的整体结构。
五、表面处理与图案化在HDI板制造的过程中,还需要对电路板进行表面处理和图案化。
表面处理主要是为了改善电路板的防腐蚀性能和易焊性。
常见的表面处理方法包括镀金、镀锡、化学镍金等。
图案化则是将电路板上的电路连接图案和器件安装图案绘制在电路板的外层。
通过光刻技术和蚀刻技术,将所需的线路和器件图案形成。
六、板间铜化与形成多层结构板间铜化是将多层电路板连接起来的关键步骤。
在板间铜化过程中,需要在电路板表面涂覆薄膜覆铜剂,然后通过电镀技术将铜层填充到所需的厚度。
多层电路板经过板间铜化后,形成一个整体的多层结构。


hdi多层板镭射盲孔对位方法在HD多层板制造过程中,镭射盲孔对位是一项非常重要的工艺。
它用于保证多层板上的内部连线与外部的过孔准确对位,确保电路板的正常运行。
而如何正确进行镭射盲孔对位呢?下面将结合具体实例,给大家介绍一下相关的方法和步骤。
首先,进行镭射盲孔对位前,我们需要准备一些必要的设备,包括镭射对位仪、双面胶纸、多层板等。
然后,我们需要将多层板放置在平整的工作台上,确保其表面完整,没有凹凸不平的问题。
接下来,我们要将镭射对位仪固定在多层板上,并将其调整到合适的位置。
这一步骤非常关键,因为它将直接影响到后续的对位结果。
我们可以使用双面胶纸将镭射对位仪固定在多层板上,保证其稳定性和准确性。
完成上述准备工作后,我们可以开始进行镭射盲孔对位了。
首先,我们需要将镭射对位仪的镭射光束对准多层板上的目标盲孔位置。
这时,我们需要通过观察镭射光束在盲孔周围的反射情况,来判断是否对位准确。
如果光束能够完全穿过盲孔,且没有任何偏移,那么就说明对位成功了。
反之,如果光束无法穿过或者出现明显的偏移,就需要进行调整。
为了更加准确地进行调整,我们可以使用镭射对位仪上的微调功能。
通过微调,我们可以使镭射光束在盲孔周围形成一个最小的交叉点,从而达到最佳的对位效果。
在微调过程中,我们需要细心观察光束的移动情况,以及盲孔周围的反射情况,及时做出调整,直到达到理想的对位效果为止。
在整个镭射盲孔对位过程中,我们需要注意一些细节。
首先,要保证工作环境的光线充足,以方便观察光束和盲孔的情况。
其次,要保持操作的稳定性,避免因为手颤抖等原因导致对位误差。
最后,对于较大的多层板,可能需要使用多个镭射对位仪进行对位,以提高对位的准确性和效率。
总的来说,镭射盲孔对位是一项非常重要的工艺,对于保证多层板的质量和性能起着至关重要的作用。
通过正确的方法和步骤进行对位,可以确保多层板上的内部连线与外部过孔准确对位,从而提高电路板的可靠性和稳定性。
希望以上内容能对大家进行一定的指导和帮助。


HDI基本知识制作流程随着电子行业日新月异的变化,电子产品向着轻、薄、短、小型化发展,相应的印制板也面临高精度、细线化、高密度的挑战。
全球市场印制板的趋势是在高密度互连产品中引入盲、埋孔,从而更有效的节省空间,使线宽、线间距更细更窄。
一.HDI定义HDI:high Density interconnection的简称,高密度互连,非机械钻孔,微盲孔孔环在6mil以下,内外层层间布线线宽/线隙在4mil以下,焊盘直径不大于0.35mm的增层法多层板制作方式称之为HDI板。
盲孔:Blind via的简称,实现内层与外层之间的连接导通埋孔:Buried via的简称,实现内层与内层之间的连接导通盲埋孔大都是直径为0.05mm~0.15mm的小孔,埋孔在內層薄板上按正常雙面板製作,而盲孔成孔方式有激光成孔,等离子蚀孔和光致成孔,通常采用激光成孔,而激光成孔又分为CO2和YAG紫外激光机(UV)。
二.HDI板板料1.HDI板板料有RCC, FR4,LD PP1)RCC:Resin coated copper的简称,涂树脂铜箔。
RCC是由表面经粗化、耐热、防氧化等处理的铜箔和树脂组成的,其结构如下图所示:(我司要求樹脂厚度需>4mil时才使用RCC)RCC的树脂层,具备与FR一4粘结片(Prepreg)相同的工艺性。
此外还要满足积层法多层板的有关性能要求,如:(1)高绝缘可靠性和微导通孔可靠性;(2)高玻璃化转变温度(Tg);膨脹係數CTE較大(3)低介电常数和低吸水率;(4)对铜箔有较高的粘和强度;但其peel strenth較差(5)固化后绝缘层厚度均匀同时,因为RCC是一种无玻璃纤维的新型产品,有利于激光、等离子体的蚀孔处理,有利于多层板的轻量化和薄型化。
另外,涂树脂铜箔具有9um,12um,18um等薄铜箔,容易加工。
2)FR4板料:我司要求樹脂厚度<=4mil时需使用FR4。
使用PP时一般采用1080, 尽量不要使用到2116的PP3)LD PP:一種可激光鑽孔的粘結片2. 铜箔要求:当客户无要求时,基板上铜箔在传统PCB内层优先采用1 OZ,HDI板优先使用HOZ,内外电镀层铜箔优先使用1/3 OZ。

HDI流程(laser 盲孔和通孔顺序)及通孔补偿控制一、背景:目前HDI板(盲孔开窗后再激光打孔)在ODF出现盲孔和通孔不能同时对上的问题。
针对问题,回顾分析现有两类HDI板(激光直接打铜、孔,盲孔开铜窗后再激光打孔)流程及生产制作,重新评估优化流程设计及生产控制。
❖根据目前公司制程,需要laser drill 形成盲孔的,优先采用“激光直接打铜、孔”工艺。
而因板设计导致无法采用以上直接打铜工艺的,才采用开窗后激光打孔。
❖如此,目前走“开窗后激光再打盲孔”的基本也就是“HDI+BVH”设计才使用。
三、新流程界定及通孔补偿运做程序:3.1. 流程综述:1) 针对激光直接打铜类HDI板,目前稳定的工艺及控制,全部按现在流程制作。
2) 针对开窗后再激光打孔类HDI板,主流程界定如下:•压板→钻孔(锣板边,及钻内层LDI盲孔开窗用的对位孔)→板面除胶→内层干膜(盲孔开窗)→内层蚀板→内层蚀检→激光钻孔→钻孔(钻通孔)→沉铜→正常流程•而针对“板面除胶”工艺环节按以下选择调整:选择条件流程设计副流程机械盲孔采用“VOP塞孔”--板面除胶--副流程机械盲孔采用“VOP塞孔”,依据副流程铜厚,在主流程有减铜需求--板面除胶→减铜(减铜到xxx mil)副流程机械盲孔采用“压板树脂填孔”--沉铜(板面除胶,沉铜检查)--副流程机械盲孔采用“压板树脂填孔”依据副流程铜厚,在主流程有减铜需求--沉铜(板面除胶,沉铜检查)→减铜(减铜到xxx mil)--其它/3.2.通孔补偿运做控制要求:HDI板类型流程说明通孔补偿运做控制程序激光直接打铜成盲孔先laser drill,后钻通孔开窗后再激光打盲孔先laser drill,后钻通孔。

HDI产品之激光钻孔工艺介绍及常见问题解决随着微电子技术的飞速发展,大规模和超大规模集成电路的广泛应用,微组装技术的进步,使印制电路板的制造向着积层化、多功能化方向发展,使印制电路图形导线细、微孔化窄间距化,加工中所采用的机械方式钻孔工艺技术已不能满足要求而迅速发展起来的一种新型的微孔加工方式即激光钻孔技术。
一激光成孔的原理激光是当“射线”受到外来的刺激而增加能量下所激发的一种强力光束,其中红外光和可见光具有热能,紫外光另具有光学能。
此种类型的光射到工件的表面时会发生三种现象即反射、吸收和穿透。
透过光学另件击打在基材上激光光点,其组成有多种模式,与被照点会产生三种反应。
激光钻孔的主要作用就是能够很快地除去所要加工的基板材料,它主要靠光热烧蚀和光化学烧蚀或称之谓切除。
(1)光热烧蚀:指被加工的材料吸收高能量的激光,在极短的时间加热到熔化并被蒸发掉的成孔原理。
此种工艺方法在基板材料受到高能量的作用下,在所形成的孔壁上有烧黑的炭化残渣,孔化前必须进行清理。
(2)光化学烧蚀:是指紫外线区所具有的高光子能量(超过2eV电子伏特)、激光波长超过400纳米的高能量光子起作用的结果。
而这种高能量的光子能破坏有机材料的长分子链,成为更小的微粒,而其能量大于原分子,极力从中逸出,在外力的掐吸情况之下,使基板材料被快速除去而形成微孔。
因此种类型的工艺方法,不含有热烧,也就不会产生炭化现象。
所以,孔化前清理就非常简单。
以上就是激光成孔的基本原理。
目前最常用的有两种激光钻孔方式:印制电路板钻孔用的激光器主要有RF激发的CO2气体激光器和UV固态Nd:YAG激光器。
(3)关于基板吸光度:激光成功率的高低与基板材料的吸光率有着直接的关系。
印制电路板是由铜箔与玻璃布和树脂组合而成,此三种材料的吸光度也因波长不同有所不同但其中铜箔与玻璃布在紫外光0.3mμ以下区域的吸收率较高,但进入可见光与IR后却大幅度滑落。
有机树脂材料则在三段光谱中,都能维持相当高的吸收率。

PCB工艺流程之常见HDI线路板工艺流程HDI(High-Density Interconnect)是一种高密度线路板技术,它可以使更多的线路、更密集的元件和更小的孔径布局在更小的面积上。
HDI线路板工艺流程相比传统线路板工艺流程更加复杂,包括多层穿孔、盲孔、埋孔等加工方式。
下面介绍一般的HDI线路板工艺流程。
首先,设计阶段。
在设计阶段,需要根据产品的功能需求和工艺要求,进行线路板的设计和规划。
设计人员需要根据产品的布局和尺寸来确定线路板的层数和层间距,以及线宽线距和孔径的设置。
其次,图形制作与光绘。
根据设计所得的线路板布局图,需要将其通过CAD系统转换为导出格式,然后使用光绘机将图形转移到基板上。
在光绘的过程中,需要注意对图形的对位精度和分辨率进行控制。
接下来是表面处理。
表面处理可分为表面清洁、化学镀覆和铜镀。
表面清洁通常采用碱性清洗剂进行除油和除垢,以使基板具备良好的附着性。
然后是化学镀覆,其主要作用是在基板表面均匀地覆盖一层铜。
最后是铜镀,能够增强基板的导电性,使线路通电流更加顺畅。
然后是孔的加工。
在HDI线路板中,因为元件和线路在较小的面积上布局,因此需要使用更小的孔径。
孔的加工方式包括多层穿孔、盲孔和埋孔。
多层穿孔是将穿过整个基板的孔,盲孔是只穿过一部分层的孔,而埋孔是孔壁都埋在基板中。
孔的加工过程中需要注意对孔径的控制,以确保孔的质量。
随后是内层制作。
内层制作是将通过孔连接起来的线路形成内层线路,通常采用图形覆膜、蚀刻和脱膜的方法。
图形覆膜是将光绘技术使用到内层制作中,蚀刻是通过化学腐蚀将不需要的铜层去除,而脱膜则是将覆盖在铜层上的光敏胶去除。
接下来是外层制作。
外层制作是将内层线路与外层线路连接起来,通常采用图形绘制、蚀刻和阻焊等步骤。
图形绘制将外层图形通过光刻技术转移到基板上,蚀刻将不需要的铜层去除,而阻焊则是在线路板上涂覆一层保护层,以保护线路并增强其对焊接的粘附性。
最后是封装和测试。
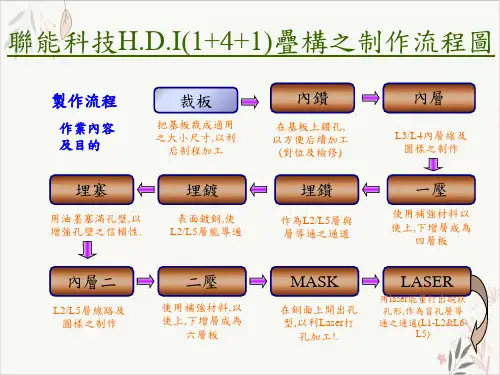

基本知识及制作流程随着电子行业日新月异的变化,电子产品向着轻、薄、短、小型化发展,相应的印制板也面临高精度、细线化、高密度的挑战。
全球市场印制板的趋势是在高密度互连产品中引入盲、埋孔,从而更有效的节省空间,使线宽、线间距更细更窄。
一.HDI定义HDI:high Density interconnection的简称,高密度互连,非机械钻孔,微盲孔孔环在6mil以下,内外层层间布线线宽/线隙在4mil以下,焊盘直径不大于0.35mm的增层法多层板制作方式称之为HDI板。
盲孔:Blind via的简称,实现内层与外层之间的连接导通埋孔:Buried via的简称,实现内层与内层之间的连接导通盲进孔大都是直径为0.05mm~0.15mm的小孔,埋盲孔成孔方式有激光成孔,等离子蚀孔和光致成孔,通常采用激光成孔,而激光成孔又分为CO2和YAG紫外激光机(UV)。
二.HDI板板料1.HDI板板料有RCC,LDPE,FR41)RCC:Resin coated copper的简称,涂树脂铜箔。
RCC是由表面经粗化、耐热、防氧化等处理的铜箔和树脂组成的,其结构如下图所示:(厚度>4mil时使用)RCC的树脂层,具备与FR一4粘结片(Prepreg)相同的工艺性。
此外还要满足积层法多层板的有关性能要求,如:(1)高绝缘可靠性和微导通孔可靠性;(2)高玻璃化转变温度(Tg);(3)低介电常数和低吸水率;(4)对铜箔有较高的粘和强度;(5)固化后绝缘层厚度均匀同时,因为RCC是一种无玻璃纤维的新型产品,有利于激光、等离子体的蚀孔处理,有利于多层板的轻量化和薄型化。
另外,涂树脂铜箔具有12pm,18pm等薄铜箔,容易加工。
2)LDPE:3)FR4板料:厚度<=4mil时使用。
使用PP时一般采用1080, 尽量不要使用到2116的PP2. 铜箔要求:当客户无要求时,基板上铜箔在传统PCB内层优先采用1 OZ,HDI板优先使用HOZ,内外电镀层铜箔优先使用1/3 OZ。
hdi (high-density interconnections)生产工艺是一种复杂复杂的工艺,包含多种重要因素。
其次是hdi生产工程的主要阶段。
设计阶段:根据客户的要求,决定电路图设计、板层结构和步法。
另外,还处于决定必要的层数和技术要求事项,准备后续制造工程的阶段。
材料准备:按照基板材料、被覆铜膜、被覆及内部层的相关标准,保证产品质量。
从基础材料、电镀溶液和油墨等可靠供应商处购买设计要求和配置。
激光穿孔:利用激光技术在板上加工小孔,实现电路的连接。
激光钻头能够准确地控制口径的大小和位置,这是实现高密度相互连接的关键步骤。
压延:通过热压技术,内外部板硬化,压缩电路板保障电路板的严密性和稳定性。
蚀刻:化学去除铜涂层不必要的部分,保持传导途径。
被覆:在板面进行电镀处理,使其具有良好的导电能力和防氧化性能。
插件及焊接:在电路中插入零件,进行焊接固定。
测试及检查:通过严格的测试及检查,保证产品的质量和性能。
在hdi多层电路板制造过程中,涉及了层叠式汇编、百叶窗孔(blind hole)技术等核心技术。
阶梯式组装是将带有多个电路图案的器材层层堆叠起来,形成多层电路板。
盲眼孔技术是指,不贯穿整个电路板,而制造贯穿两个或多个基材层的孔,提高电路板的集成度和信号传送性能。
请注意,具体的hdi制造工程根据制造商、技术标准及产品要求事项可能有所不同。
如果需要更详细的信息,最好参考相关专门文件或向hdi生产领域的专家咨询。
HDI制作流程HDI(High Density Interconnect)是一种高密度互连技术,用于制造具有高信号传输能力和密集性的印刷电路板(PCB)。
HDI制作流程是一个复杂的过程,涉及到多个步骤和技术。
以下是HDI制作流程的详细介绍:1.设计规划和准备阶段:在HDI制作流程的开始阶段,需要进行设计规划和准备工作。
这包括确定电路板尺寸、层数和设计规格,以及选择适当的材料和技术。
2.印制内层和外层:在HDI制作中,要首先制造内层和外层。
内层通常由铜箔和绝缘基材组成,而外层则由需要进行逐层堆叠的薄板组成。
这些层通过化学蚀刻或电镀等方法来制造。
3.内部追踪和电镀:内层和外层制作完成后,需要进行内部追踪和电镀。
这个步骤将在不同的层之间形成电连接,并提供对内部追踪的支持。
电镀可以通过电化学方法或金属化学还原法进行。
4.盲孔和盖孔:在HDI中,还需要制作盲孔和盖孔。
这些孔用于连接不同层之间的电连接,并提供通孔焊盘的支撑。
通常,盲孔和盖孔可以通过激光钻孔或机械钻孔来制作。
5.堆叠层:HDI的一个关键特点是多层堆叠。
在这一阶段,将内层、外层和孔连接层等组装在一起,并使用压力和温度来使它们紧密结合。
6.盲埋孔、内线和外线:接下来,需要制作盲埋孔、内线和外线。
盲埋孔用于连接不同层之间的电连接,内线用于连接器件和器件之间的电连接,外线用于连接印刷电路板和外部设备。
这些线路可以通过激光钻孔、刮板、电镀或者压铸等方法来制作。
7.表面处理和喷锡:在HDI制作完成后,需要对印刷电路板进行表面处理和喷锡。
表面处理可以增强印刷电路板的抗腐蚀性,并提供更好的焊接性能。
喷锡则是为了方便后续的表面组装。
8.质量检查和测试:最后,需要进行质量检查和测试。
这包括使用X射线检查内部连接和结构,以及使用测试设备检查电路的功能和性能。
总结:HDI制作流程是一个复杂、精细和技术密集的过程。
它需要设计规划、印制内层和外层、内部追踪和电镀、盲孔和盖孔、堆叠层、盲埋孔、内线和外线、表面处理和喷锡,以及质量检查和测试等多个步骤。
HDI流程(laser 盲孔和通孔顺序)及通孔补偿控制
一、背景:
目前HDI板(盲孔开窗后再激光打孔)在ODF出现盲孔和通孔不能同时对上的问题。
针对问题,回顾分析现有两类HDI板(激光直接打铜、孔,盲孔开铜窗后再激光打孔)流程及生产制作,重新评估优化流程设计及生产控制。
❖根据目前公司制程,需要laser drill 形成盲孔的,优先采用“激光直接打铜、孔”工艺。
而因板设计导致无法采用以上直接打铜工艺的,才采用开窗后激光打孔。
❖如此,目前走“开窗后激光再打盲孔”的基本也就是“HDI+BVH”设计才使用。
三、新流程界定及通孔补偿运做程序:
3.1. 流程综述:
1) 针对激光直接打铜类HDI板,目前稳定的工艺及控制,全部
按现在流程制作。
2) 针对开窗后再激光打孔类HDI板,主流程界定如下:
•压板→钻孔(锣板边,及钻内层LDI盲孔开窗用的对位孔)→板面除胶→内层干膜(盲孔开窗)→内层蚀板→内层蚀检→激光钻孔→钻孔(钻通孔)→沉铜→正常流程
•而针对“板面除胶”工艺环节按以下选择调整:选择条件流程设计
副流程机械盲孔采用“VOP塞孔”--板面除胶--
副流程机械盲孔采用“VOP塞孔”,依据副流程铜厚,在主流程有减铜需求--板面除胶→减铜(减铜到xxx mil)
副流程机械盲孔采用“压板树脂填孔”--沉铜(板面除胶,沉铜检查)--
副流程机械盲孔采用“压板树脂填孔”
依据副流程铜厚,在主流程有减铜需求--沉铜(板面除胶,沉铜检查)→减铜(减铜到xxx mil)--
其它/
3.2.通孔补偿运做控制要求:
HDI板类型流程说明通孔补偿运做控制程
序
激光直接打铜成盲孔先laser drill,后钻通孔
开窗后再激光打盲孔先laser drill,后钻通孔。