SMT(贴片)检查标准资料
- 格式:xls
- 大小:1.73 MB
- 文档页数:16
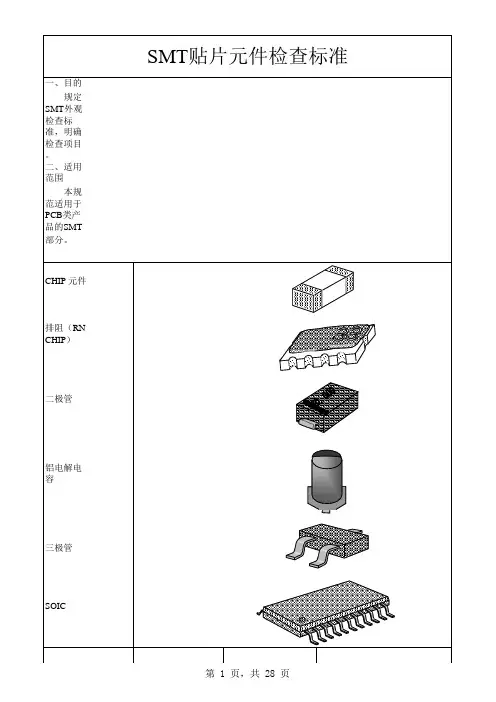

概述目,运用于公司内贴片板加工过程中质量要求、制成品验收、质量仲裁的依据,本规程依据公司《术语SMT组件:由自动贴装设备通过点胶(或印胶或漏印焊膏)然后贴装元器件,最后经固化(或回流焊接)后形成的印制板组件。
点胶(印胶)工艺:指采用涂敷设备(点胶机或丝印机)将贴片胶涂敷在印制板上,再经过元器件贴装和固化,最后通过波峰焊机进行焊接形成可靠的电器和机械连接的工艺方式。
丝印工艺:指采用涂敷设备(丝印机或点胶机)将焊膏涂敷在印制板的焊盘上,再进行元器件贴装,最后直接通过回流焊炉回流焊接形成可靠的电器和机械连接的工艺方式。
贴片板不良判据1印制板边缘缺口长度不伤及导线。
如右图。
2.边缘部分的安装孔不允许有贯穿性裂纹,允许有深度不大于3.边缘棱角处允许轻微碰伤,但不得起层和损伤印制板导线。
4.焊接面不允许机械划伤、阻焊膜破和露铜层,焊盘不允许起层和脱落。
5.允许在不影响下道工序正常生产情况下的工艺边缺损。
6.翘曲度超出设备允许指标是下曲。
Max: 0.5mmMax: 1.2mmLb贴片胶粘接强度要求检验项目、工具及其它1.印制板图号、印制板外观质量、2.检查点胶、丝印贴装状态是否符合技术规范,有无漏贴、错贴、连焊、虚焊、贴片移位、极性反以及立片等3.检验及返修工具包括烙铁、防静电手套、工作服、镊子、防静电刷子。
4. 质量记录表为《机检质量检验记录表》。
5.检验质量指标按检验卡上的质量指标要求执行。
Q/3204BUL001-2010点胶工艺锡膏印刷贴装技术回流焊接宽度一半或以上上(仅在印制导线阻焊情况下适用),判合格有旋转偏差,D>=元件宽度的一半,判合格元件全部位于焊盘上居中、无偏移,为最佳XY 方向有偏移,但引脚(含趾部和跟部)全部位于焊盘上,判合格HHD所有焊点目视或用5-20倍放大镜检查时,元件焊端或引脚与焊盘应润湿,焊缝表面不应开裂、蜕皮等,且焊点处不应呈凹凸不平或波浪起伏状。
焊膏与焊盘对齐且尺寸及形状相符;焊膏表面光滑不带有受扰区域或空穴;焊膏厚度等于钢模板厚度±0.03mm ,为最佳IC引脚趾部及跟部全部位于焊盘上,所有引脚对称居中,为最佳跟部趾部ICA元件全部位于焊盘上居中、无偏移,为最佳元件焊端位于焊盘胶点位置居中、胶量适宜,为最佳焊接面呈弯月状,且当元件高度>1.2mm 时,焊接面高度H >=0.4mm ;当元件高度<=1.2mm 时,焊接面高度H >=元件高度的1/3,为最佳过量的焊膏延伸出焊盘、且未与相邻焊盘接触;焊膏覆盖区域小于两倍的焊盘面积,判合格元件焊端与焊盘交叠后,焊盘伸出部分A 不小于焊端高度的1/3,判合格胶点位置偏移、但未触及焊盘也未接触元件引脚焊端,为合格当元件高度>1.2mm 时,焊接面高度H >=0.4mm ;当元件高度<=1.2mm 时,焊接面高度H >=元件高度的1/3,且焊接面有一端为凸圆体状,判为合格焊膏量较少,但焊膏覆盖住焊盘75%以上的面积,判合格胶点刚接触到焊盘、但对焊点的形成无不利影响,判合格SOP/QFP 器件引脚内侧形成的弯月形焊接面高度至少等于引脚的厚度,且整个引脚长度均被焊接,为最佳焊膏未和焊盘对齐,但焊盘75%以上的面积覆盖有焊膏,判合格有旋转偏移,但引脚全部位于焊盘上,判合格元件焊端宽度一半或以上位于焊盘上,且与相邻焊盘或元件相距0.5mm 以上,判合格SOP/QFP 器件引脚内侧形成的弯月形焊接面高度大于或等于引脚厚度的一半,且引脚长度的至少75%被焊接,判合格胶点大量覆盖焊盘、对焊点的形成有不利影响,判为不合格焊膏量太少,不合格焊膏溢出连接在一起,不合格SOJ/PLCC 器件引脚两边所形成的弯月形焊接面高度至少等于引脚两边弯度的厚度,为最佳元器件上的胶点直径等于贴装元器件之前涂布到PCB 上的胶点直径,为最佳凹形,焊膏量太少,不合格SOJ/PLCC 器件引脚两边所形成的弯月形焊接面高度至少等于引脚两边弯度厚度的一半,判合格焊膏边缘不清、有拉尖,不合格丝印工艺时:有XY 方向偏差,但A >=引脚宽度的一半,且引脚跟部和趾部位于焊盘上,判合格点胶工艺时:有XY 方向偏差,但A >=引脚宽度的2/3,且引脚跟部和趾部位于焊盘上,判合格胶点顶部直径大于底部直径的二分之一,且能正常的粘接元件,判合格焊膏有粘连,不合格OKNG NG OKA胶量太多或贴装压力太低,使元器件引脚未与焊盘接触,当浮起残存于PCB 上孤立焊球最大直径应小于相邻导体或元件焊盘最小间距的一半,或直径小于0.15mm ;残留在PCB 焊膏错位,不合格丝印工艺时:有旋转偏差,但A >=引脚宽度的一半,且引。



检验标准的准则●印刷检验总则:印刷在焊盘上的焊膏量允许有一定的偏差,但焊膏覆盖在每个焊盘上的面积应大于焊盘面积的75%。
●点胶检验理想胶点:烛=焊盘和引出端面上看不到贴片胶沾染的痕迹,胶点位于各个焊盘中间,其大小为点胶嘴的1.5倍左右,胶量以贴装后元件焊端与PCB 的焊盘不占污为宜。
炉前检验炉后检验良好的焊点应是焊点饱满、润湿良好,焊料铺展到焊盘边缘。
返修当完成PCBA的检查后,发现有缺陷的PCBA就需求进行维修,公司有返修SMT的PCBA有两种方法。
一是采用恒温烙铁(手工焊接)进行返修,一是采用返修工作台(热风焊接)进行返修。
不论采用那种方式都要求在最短的时间内形成良好的焊接点。
因此当采用烙铁时要求在少于5秒的时间内完成焊接点,最好是大约3秒钟。
铬铁返修法即手工焊接新烙铁在使用前的处理:新烙铁在使用前先给烙铁头镀上一层焊锡后才能正常使用,当烙铁使用一段时间后,烙铁头的刃面及周围就产生一层氧化层,这样便产生“吃锡”困难的现象,此时可锉去氧化层,重新镀上焊锡。
电烙铁的握法:a.反握法:是用五指把电烙铁的柄握在掌中。
此法适用于大功率电烙铁,焊接散热量较大的被焊件。
b.正握法:就是除大拇指外四指握住电烙铁柄,大拇指顺着电烙铁方向压紧,此法使用的电烙铁也比较大,且多为弯型烙铁头。
c.握笔法:握电烙铁如握钢笔,适用于小功率电烙铁,焊接小的被焊件。
本公司采用握笔法。
焊接步骤:焊接过程中,工具要放整齐,电烙铁要拿稳对准。
一般接点的焊接,最好使用带松香的管形焊锡丝。
要一手拿电烙铁,一手拿焊锡丝。
清洁烙铁头加温焊接点熔化焊料移动烙铁头拿开电烙铁一是快速地把加热和上锡的烙铁头接触带芯锡线(cored wire),然后接触焊接点区域,用熔化的焊锡帮助从烙铁到工件的最初的热传导,然后把锡线移开将要接触焊接表面的烙铁头。
一是把烙铁头接触引脚/焊盘,把锡线放在烙铁头与引脚之间,形成热桥;然后快速地把锡线移动到焊接点区域的反面。


文件主题SMT贴片检验规范检验项目检验方法检验标准不良描述检验类型检验阶段检验水平不良判定常规确认AQL钢网确认目测1、所用钢网必须与此款产品相一致;钢网与此款产品不一致√首件巡检正常II级单次Ac/Re:0/12、生产前应用钢网核对光源板焊盘,钢网开孔与焊盘完全一致才可生产;钢网开孔与焊盘不一致,且歪斜不能超过焊盘1/3√ 1.0锡膏解冻目测1、生产使用锡膏需在常湿下解冻2H-4H方可使用解冻时间不足2H √首件巡检正常II级单次2.52、解冻后对锡膏进行搅拌,搅拌均匀,不能有变质、颗料状的现象搅拌不均匀,变质、有颗料状√ 1.0印刷锡膏目测1、锡膏印刷应无偏移,锡膏表面平整,位置在焊盘中间、无连锡、无塌陷、无拉尖锡膏偏移不能超过焊盘1/2,表面不平整,连锡,塌陷,拉尖√首件巡检正常II级单次1.02、锡膏印刷厚度要求在钢网厚度的±0.02mm印刷好的锡膏超过钢网厚度±0.02mm√ 2.53、印刷好的锡膏量应覆盖焊盘开孔面积80%以上锡膏量覆盖在焊盘面积80%以下√ 1.0文件主题SMT贴片检验规范检验项目检验方法检验标准不良描述检验类型检验阶段检验水平不良判定常规确认AQL贴片目测1、上料时飞达的光源不能混电压、色温、光通量,且Bin应相同等;两边飞达的光源混电压、色温、光通量,且Bin区不同√首件巡检成品正常II级单次Ac/Re:0/12、光源正负极不能贴反,灯珠不能偏移,少件,贴翻等不良现象正负极贴反,灯珠偏移超过焊盘1/3,少件,贴翻等√ 1.03、贴片灯珠上飞达时应由IPQC确认后方可装入飞达进行贴片;贴片灯珠上飞达时未经过IPQC确认后进行贴片√ 1.04、确认灯珠时应用万用表进行点亮测试,灯珠点亮后万用表显示正值,红表笔所对应的一端为正极,黑表笔对应的一端为负极;反之,红表笔所对应的一端为负极,黑表笔所对应的一端为正极,再根据相应的极性装入飞达料盘;光源正负极装入飞达反向,光源装错,导致贴片后光源板不良√首件巡检正常II级单次Ac/Re:0/1文件主题SMT贴片检验规范检验项目检验方法检验标准不良描述检验类型检验阶段检验水平不良判定常规检验阶段AQL过回流焊目测1、炉内上下各分十个温区,上温区实际设定值比下温区大10度,后面温区上下温度一致,且10个温度区的设定值应符合作业指导书要求;上下温区温度全部设置一致,且不符合作业指导书要求√首件巡检正常II级单次1.02、生产过程中应对回流焊实际温度进行测试,保证炉内实际温度和设定温度保持一致(±5℃)回流焊炉内实际温度和设定温度不一致;√首件巡检1.03、在过回流焊时,不可出现产品翘起现象,若翘起,产品垂直高度不得大于50度,产品在炉内不可卡炉,、生锡、光源板柏油发黄、柏油层起翘的现象;产品垂直高度大于50度,产品在回流焊内卡炉,生锡、光源板柏油发黄、柏油层起翘√首件巡检成品1.0合格品图片:。

5.2.2 焊接异常---针孔/吹孔5.2.2缺陷-1,2,3级针孔/吹孔/空洞等使焊接特性降低至最低要求以下.文件编号 Doc.No审核 Audit.文件名称 Title 版本 Revision批准 Approve页码 Page标准化 Standard5.2.35.2.3 焊接异常--锡膏回流5.2.45.2.4 焊接异常-不润湿 5.2.55.2.5 焊接异常-反润湿融化的焊接料与基底金属不能形成金属性结合。
融化的焊接料先覆盖表面后退缩成一些形状不规则的的焊了堆,空当处有薄薄的焊料膜覆盖,为暴露基底金属和表面涂敷层。
5.2.75.2.7 焊接异常-焊锡过量/锡网,溅锡5.2.8 焊接异常-焊料受扰5.2.8带有冷却纹的焊点表面外观,大多发生在无铅合金中,不是受焊料受扰。
5.2.9 焊接异常-焊料破裂5.2.9缺陷-1,2,3级违反组件最大高度或引脚突出要求。
5.2.9 焊接异常-边缘夹簧/错位5.2.9文件编号 Doc.No审核 Audit.文件名称 Title 版本 Revision批准 Approve页码 Page标准化 Standard7.1.1.1元器件的安放-方向-水平7.1.5元器件的安放-DIP/SIP器件与插件引脚伸出长度满足要求文件编号 Doc.No审核 Audit.文件名称 Title 版本 Revision批准 Approve页码 Page标准化 Standard7.1.6元器件的安放-径向引脚-垂直7.1.8元器件的安放-连接器文件编号 Doc.No审核 Audit.文件名称 Title 版本 Revision批准 Approve页码 Page标准化 Standard7.3.2元器件固定--粘接剂粘接7.3.3元器件固定--粘接剂粘接文件编号 Doc.No审核 Audit.文件名称 Title 版本 Revision批准 Approve页码 Page标准化 Standard7.4.5非支撑孔--焊接7.4.5非支撑孔--焊接文件编号 Doc.No 审核 Audit.文件名称 Title版本 Revision 批准 Approve 页码 Page标准化 Standard7.4.5非支撑孔--导线弯折7.4.5支撑孔--焊接文件编号 Doc.No审核 Audit.文件名称 Title 版本 Revision批准 Approve页码 Page标准化 Standard7.4.5支撑孔--焊接--主面--引脚到孔壁7.4.5支撑孔--焊接--主面--引脚到孔壁文件编号 Doc.No审核 Audit. 年 月 日文件名称 Title 版本 Revision批准 Approve 年 月 日页码 Page标准化 Standard 年 月 日7.4.5支撑孔--焊接--辅面-焊盘区覆盖8.18.1 胶水粘固7.4.5支撑孔--焊点--引脚弯曲处的焊料文件编号 Doc.No审核 Audit. 年 月 日文件名称 Title 版本 Revision批准 Approve 年 月 日页码 Page标准化 Standard 年 月 日8.2.1.1片式元件-仅底部端子侧面偏移(A)8.2.1.2片式元件-仅底部端子侧面偏移(B)文件编号 Doc.No审核 Audit.文件名称 Title 版本 Revision批准 Approve页码 Page标准化 Standard8.2.1.3片式元件-仅底部端子末端连接宽度(C)8.2.2.1片式元件-矩形或方形端元件-侧面偏移(A)8.2.1.4片式元件-仅底部端子,最小填充高度(F)F 填充高度没有要求文件编号 Doc.No审核 Audit.文件名称 Title版本 Revision批准 Approve页码 Page标准化 Standard偏移大于50%,为不良8.2.2.3片式元件-矩形或方形端元件-末端连接宽度(C)偏移超出焊盘位置,为不良8.2.2.2片式元件-矩形或方形端元件-末端偏移(B)文件编号 Doc.No审核 Audit.文件名称 Title 版本 Revision批准 Approve页码 Page标准化 Standard8.2.2.5片式元件-矩形或方形端元件-最大填充高度(E)8.2.2.4片式元件-矩形或方形端元件-侧面连接长度(D)8.2.2.6片式元件-矩形或方形端元件-最小填充高度(F)文件编号 Doc.No审核 Audit.文件名称 Title 版本 Revision批准 Approve页码 Page标准化 Standard8.2.2.9片式元件-矩形或方形端元件-端子异常(J)8.2.2.8片式元件-矩形或方形端元件-末端重叠(J)文件编号 Doc.No审核 Audit.文件名称 Title版本 Revision批准 Approve页码 Page标准化 Standard 侧立/贴 立碑倒贴文件编号 Doc.No审核 Audit.文件名称 Title 版本 Revision批准 Approve页码 Page标准化 Standard文件编号 Doc.No审核 Audit.文件名称 Title 版本 Revision批准 Approve页码 Page标准化 Standard8.2.3.4元件端子-侧面连接长度(D)8.2.3.6元件端子-最小填充高度(F)可接收良品图片8.2.3.5元件端子-最大连接厚度(E)不可接收图片-不润湿不良现象图片文件编号 Doc.No审核 Audit.文件名称 Title 版本 Revision批准 Approve页码 Page标准化 Standard8.2.3.8元件端子-末端重叠(J)8.2.4.1城堡端子/引脚-侧面偏移(A)不可接收图片-重叠小于50%8.2.4.2城堡端子/引脚-最小侧面焊接长度(D)文件编号 Doc.No WI17-88-007审核 Audit.文件名称 Title 版本 Revision A批准 Approve页码 Page3/3标准化 Standard8.2.4.68.2.4.6 无引脚芯片端子-最小填充高度(F)8.2.5.18.2.5.1 扁平,L形,翼形引脚-侧面偏移(A)偏移大约50%,二级标准可以接收89910785 HE。

SMT贴片外观工艺检验标准形成。
P02元器件贴装A、元器件位置偏移超过焊盘的1/3.A、元器件倒装或漏装。
A、元器件间距不均匀。
A、元器件高度不一致。
一般工艺第3页共12页SMT加工品质检验标准本标准的目的是为了规范SMT加工的工艺质量要求,以确保产品品质符合要求。
适用于公司所有SMT加工生产过程中的工艺品质管控。
定义:一般作业工艺:指产品加工过程中质量常规管控的作业,如焊膏储存、印刷效果、贴片状况、回流焊,QC检验等。
A类(主要不良):工艺执行漏作业、错作业、作业不到位,功能不能实现。
(例:焊锡短路,错件等)B类(次要不良):工艺执行作业不到位,影响PCB板的安装使用与功能实现;影响产品的外观等不良。
(例:P板表面松香液体过多)相关标准:IPC-A-610D-2005《电子组件的接受条件》SJ/T - 1995《表面组装组件的焊点质量评定》SJ/T - 1995《表面组装工艺通用技术要求》标准组成:1、印刷工艺品质要求(P-01)2、元器件贴装工艺品质要求(P-02)3、元器件焊锡工艺要求(P-03)4、元器件外观工艺要求(P-04)检验方式:检验依据: GB/T2828.1-2003 -----II类水准AQL接收质量限:(A类)主要不良:0.65(B类)次要不良:1.0检验原则:一般情况下采用目检,当目检发生争议时,可采用10倍放大镜。
本标准参照相关标准由品质部制定,标准的发行与修订、废止需经品质部的允许。
P-01印刷工艺品质要求:1、锡浆的位置居中,无明显的偏移,不可影响粘贴与焊锡。
2、印刷锡浆适中,能良好的粘贴,无少锡、锡浆过多。
3、锡浆点成形良好,应无连锡、凹凸不平状。
P-02元器件贴装工艺品质要求:元器件位置偏移超过焊盘的1/3;元器件倒装或漏装;元器件间距不均匀;元器件高度不一致。
以上是本标准的主要内容,旨在规范SMT加工的工艺质量要求,以确保产品品质符合要求。
文中的工艺问题主要集中在元器件贴装和焊接方面。

SMT品质检验标准一、品质判定:SMT制程分为锡膏制程与点胶制程(1)制程中缺点分为:A、严重缺点,〈CRITICAL DEFECT〉:简写CR,凡有危害制品的使用者或携带者之生命或安全之缺点谓之;B、主要缺点,〈MAJOR DEFECT〉简写MA,制品单位的使用性能不能达到所期望之目的,明显的减低其实用性质的缺点谓之;C、次要缺点,〈MINOR DEFECT〉简写MI;2、点胶制程中的缺点,一般有:错件、缺件、反向、倒置、偏离、异物、溢胶、浮高、侧立、刮伤;3、锡膏制程中的缺点,一般有:空焊、假焊、冷焊、针孔、少锡、包焊、短路、错件、缺件、反向、倒置、偏离、异物、PCB起泡、直立、侧立、锡珠;二、SMT重点品质说明:1、空焊:零件脚或引脚与锡垫间因没有锡或其它因素造成没有接洽;2、假焊:假焊之现象与空焊类似,但其锡垫之锡量太少,低于接洽面标准;3、冷焊:锡或锡膏在回风炉气化后,在锡垫上仍有模糊的粒状附着物;4、针孔:板底不能有洞孔现象出现;5、少锡:零件面吃锡不良,未达75%以上;6、包焊:焊点焊锡过多,看不到零件脚或其轮廓者;7、短路:又称桥接,有脚零件在脚与脚之间被多余之焊锡所联接短路;8、错件:零件放置之规格或种类与作业规定或BOM、ECN不符者,即为错件;9、缺件:应放置零件之位置,因陋就简正常之缘故而产生空缺;10反向:有极性之零组件与加工工程样品、方向相反,即为反向;11、倒置:又为反白,零件有规格标示一面倒置于PDA上;12、偏离:零件超出PAD之部分,不得大于本体宽度之1/4;13、异物:可导电之异物〈锡渣、锡球、铁线〉;不可导电之异物〈贴纸〉;14、不洁:加工作业不良,造成板面不洁净或CHIPS脚与脚之间附有异物或CHIPS修补不良有点胶、助焊剂、防焊绿漆、松香等均视为不合格品;15、PCB起泡:PCB板离层起泡或白斑现象;16、溢胶:胶水溢于零件两端PAD上;17、点胶推拉力必须在1;5KG以上;18、锡珠:于零件脚四周,有白色结晶沉淀物;〈也可说为锡珠SOLDER BALL〉19、浮高:零件一脚〈端〉跷起;20、侧立:零件侧面立起;21、直立:零件纵向站立〈又称墓碑现象〉;22、刮伤:PCB板堆积防护不当或重工防护不当产生刮伤问题;23、报废:线路断;三、SMT检验要项:1、检验部分:A、板子外观是否有起泡、撞伤、刮伤等现象;B、核对BOM是否有错件、多件、缺件;C、检视吃锡状况是否良好;D、零件是否有极性反向、零件倒置、零件偏位;E、零件外观是否有破损、印刷不良等现象;F、板子及零件是否有污染、不洁、氧化等现象;G、是否有因修补等到问题造成不良;2、包装部分:A、现品票或流程卡之书写核对;B、辅助表单是否齐全正确;C、包材是否有破损且大于PCB之面积;D、应贴之贴纸是否齐全正确;E、是否有应作ECN标示而未标示;F、包装之方法是否正确,是否造成品质不良;G、PCB是否有混装现象;H、PCB外箱标示是否有与实物不符现象;I、是否有按厂商之规定包装;J、包装标示OK后,是否先经领班确认再由QA盖章;四、SMT检验标准:1、见SMT基板CHECK指导书;2、见SMT锡点检验标准;3、见SMT点胶CHECK指导书;。

产品名称:所有产品批准审核编制页数工序名称:SMT贴片检查A、机器B、手工1/1NO
1
21.确认贴片元件是否偏移、缺件.
4.不良数异常上升时,请立即通知领班派专人,确认设备、材料状况。
异常的时候马上通知领班!SMT刷胶检查(目视标准)工具/材料SMT贴片检查图形类别A B
C 不良品箱1.按检查标准图示进行全检。
2.不良品给维修人员进行返工,全检人员确认。
标准图 温度曲线重新调整设置温度。
2.根据不良情况,及时调整。
偏移
拒收图
SMT 作 业 指 导 书
版本/修订日期防静电手套SMT贴片
3.返工要求:贴片不良数量≤5点/pcb,用镊子取掉贴片后,手工点胶贴片;其余报废。
允收图。
印制板组装要求与检验规范SMT焊接品质验收标准1 片状、圆柱体、欧翼形等焊点接受标准理想状态(目标): 1.最佳焊点高度为焊锡高度加元件可焊端高度。
2.焊点覆盖引脚表面,但没有超过引脚转折处。
允收状态:1.最大焊点高度可超出焊盘或爬伸至金属镀层可焊端顶部,但不可接触元件体。
2.最小焊点高度(F)为焊锡厚度加可焊端高度(H)的25﹪或0.5mm(最小值)。
3.末端连接宽度(C)至少为元器件端子宽度(W)的75﹪,或焊盘宽度(P)的75﹪,取两者中的较小者。
4.最小侧面焊点长度(D)等于引脚宽度(W)。
5.当引脚长度(L)(由趾部到跟部弯折半径中心测量)小于引脚宽度(W),6. 引脚厚度(T)等于或小于0.38mm时,最小跟部填充为(G)+(T)。
引脚厚度(T)大于0.38mm时,最小跟部填充为(G)+(T)×50﹪。
7. 底部带散热面端子的元器件,散热面无侧面偏移,端子边缘100%润湿。
拒绝接受:1.焊点廷伸到本体上。
4.端连接宽度(C)小于元器件端子宽度(W)的50﹪,或焊盘宽度(P)的50﹪,取两者中的较小者。
WCp5.元器件端子面无可见的填充爬升。
最小填充高度(F)小于焊料厚度(G)加上25﹪的(H),或焊料厚度(G)加上0.5mm,取两者中的较小者。
6.最小侧面焊点长度(D)小于引脚宽度(W)侧面焊点长度(D)小于引脚长度(L)或引脚宽度(W)的25﹪。
F<G+(T×50﹪)8.焊接后,由于某些因素的影响,使焊点产生开裂。
2焊点桥联(连焊)定义:两个独立相邻焊点之间在焊接之后形成连接现象,导致短路。
图示:拒绝接受相邻引脚之间焊料互相连接3 漏焊定义:焊盘上未沾锡,未将元器件及基板焊接在一起。
图示:拒绝接受1.元器件与焊盘上未上锡4 元件遗漏(缺件)定义:该安装的元件没有被安装在PCB上或在生产过程中丢失。
拒绝接受5 反向(极性、方向错误)定义:元件极性、方向安装错误,使元件不能起到应有的作用。
smt贴片检验标准SMT贴片检验标准。
SMT贴片技术是一种表面贴装技术,广泛应用于电子产品的制造过程中。
在SMT贴片过程中,质量检验是非常重要的环节,它直接关系到产品的质量和稳定性。
因此,建立和执行严格的SMT贴片检验标准是至关重要的。
首先,SMT贴片检验标准应包括对于各种SMT贴片设备的检验要求。
例如,对于贴片机的检验应包括设备的精度、速度、稳定性等方面的要求。
对于回流炉的检验应包括设备的加热均匀性、温度控制精度等方面的要求。
通过对设备的检验,可以确保SMT贴片过程中设备的正常运行,从而保证产品的质量。
其次,SMT贴片检验标准还应包括对于贴片材料的检验要求。
贴片材料包括贴片元件、焊膏等。
对于贴片元件的检验应包括元件的尺寸、外观、焊盘的涂覆情况等方面的要求。
对于焊膏的检验应包括焊膏的粘度、温度特性、氧化情况等方面的要求。
通过对贴片材料的检验,可以确保贴片过程中所使用的材料符合质量要求,从而保证产品的可靠性。
另外,SMT贴片检验标准还应包括对于贴片过程的检验要求。
贴片过程包括元件的贴装、回流焊接等环节。
对于贴片过程的检验应包括贴片位置的精度、焊接温度曲线的合格性、焊接后的焊点外观等方面的要求。
通过对贴片过程的检验,可以确保贴片过程的稳定性和可控性,从而保证产品的一致性和稳定性。
最后,SMT贴片检验标准还应包括对于贴片产品的检验要求。
对于贴片产品的检验应包括外观检验、功能检验等方面的要求。
外观检验应包括产品的焊点外观、组装外观等方面的要求。
功能检验应包括产品的电气性能、可靠性等方面的要求。
通过对贴片产品的检验,可以确保产品的质量符合客户的要求,从而提升产品的市场竞争力。
总之,建立和执行严格的SMT贴片检验标准对于保证产品的质量和稳定性具有重要意义。
只有通过严格的检验,才能确保SMT贴片产品的质量符合要求,从而赢得客户的信任和认可。
.)以下为最大允收限度,如果超过25%则拒收。
名文件编号称发行版次1、电阻水平方向偏移,其基板焊点一端的空余长度 1. L2≧L*1/3,OK ;大于或等于另一端空余长度的1/3,为最大允收限度; 2. L2<L*1/3,NG .如果小于另一端空余长度的1/3则拒收。
L2L 1、两元件之间最小间隔在0.5mm 以上为最大允收;1. W ≧0.5mm,OK;2、两元件之间最小间隔小于0.5mm 拒收。
2. W<0.5mm,NG .零件直立拒收! 文字面帖反拒收。
1、按正面贴装,元件的两端置于基板焊点的中央位置。
1、元件偏移突出基板焊点的部份是元件宽度的25% 以下为最大允收限度,如果超出25%则拒收。
1、元件水平方向偏移,其基板焊点一端的空余长度 1. L2≧L*1/3,OK ; 大于或等于另一端空余长度的1/3,为最大允收限度;2. L2<L*1/3,NG .如果小于另一端空余长度的1/3则拒收。
L2L 1、两元件之间最小间隔在0.5mm 以上为最大允收;1. W ≧0.5mm,OK;2、两元件之间最小间隔小于0.5mm 拒收。
2. W<0.5mm,NG .电阻偏移(垂直方向)项 目零件直立电阻帖反标准模式电容、电感偏移零件间隔电容、电感偏移作 业 指 导 书SMT 通用检验标准WI-Q-001生效日期2004-12-15A01页码3/9判 定 說 明图 示 说 明(垂直方向)(水平方向)电阻偏移(水平方向)零件间隔电容、电感类实装W W1≧W*25%,NGW 零件直立拒收文字面(翻白)R757文字面电阻不可帖反(文字面OK W W1W1≧W*25%,NG W零件直立拒收!名文件编号称发行版次1、元件倾斜突出焊点的部份须小于元件宽度的25%,反之则拒收。
(NG)1、三极管的三个引脚处于焊点的中心位置。
1、三极管的引脚超出焊点的部份须小于或等于引脚 1. w1≦W*1/2, OK ; 宽度的1/2;若大于1/2则不良。