IGBT模块参数datasheet名称解释
- 格式:doc
- 大小:57.50 KB
- 文档页数:4

IGBT模块参数详解一-IGBT静态参数•VCES:集电极-发射极阻断电压在可使用的结温围栅极-发射极短路状态下,允许的断态集电极-发射极最高电压。
手册里VCES是规定在25°C结温条件下,随着结温的降低VCES也会有所降低。
降低幅度与温度变化的关系可由下式近似描述:.模块及芯片级的VCES对应安全工作区由下图所示:文章来源:.igbt8./jc/19.htmlCollector-emitter voltage of the IGBT由于模块部杂散电感,模块主端子与辅助端子的电压差值为,由于部及外部杂散电感,VCES在IGBT关断的时候最容易被超过。
VCES在任何条件下都不允许超出,否则IGBT就有可能被击穿。
•Ptot:最大允许功耗在Tc=25°C条件下,每个IGBT开关的最大允许功率损耗,及通过结到壳的热阻所允许的最大耗散功率。
Ptot可由下面公式获得:。
Maximum rating for Ptot二极管所允许的最大功耗可由相同的方法计算获得。
•IC nom:集电极直流电流在可使用的结温围流过集电极-发射极的最大直流电流。
根据最大耗散功率的定义,可以由Ptot的公式计算最大允许集电极电流。
因而为了给出一个模块的额定电流,必须指定对应的结和外壳的温度,如下图所示。
请注意,没有规定温度条件下的额定电流是没有意义的。
Specified as data code: FF450R17ME3在上式中Ic及VCEsat Ic都是未知量,不过可以在一些迭代中获得。
考虑到器件的容差,为了计算集电极额定直流电流,可以用VCEsat的最大值计算。
计算结果一般会高于手册值,所有该参数的值均为整数。
该参数仅仅代表IGBT的直流行为,可作为选择IGBT的参考,但不能作为一个衡量标准。
•ICRM:可重复的集电极峰值电流最大允许的集电极峰值电流(Tj≤150°C),IGBT在短时间可以超过额定电流。

正确理解IGBT模块规格书参数本文将阐述IGBT模块手册所规定的主要技术指标,包括电流参数、电压参数、开关参数、二极管参数及热学参数,使大家正确的理解IGBT模块规格书,为器件选型提供依据。
本文所用参数数据以英飞凌IGBT模块FF450R17ME3 为例。
一、电流参数1. 额定电流(IC nom)大功率IGBT模块一般是由内部并联若干IGBT芯片构成,FF450R17ME3内部是3个150A 芯片并联,所以标称值为450A额定电流可以用以下公式估算:Tjmax–TC= VCEsat·IC nom·RthJCVCEsat 是IC nom的函数,见规格书后图1,采用线性近似VCEsat=(IC nom+287)/310 Tjmax=150℃,TC=80℃,RthJC =0.055K/W计算得:IC nom=500A2. 脉冲电流(Icrm 和Irbsoa)Icrm是可重复的开通脉冲电流(1ms仅是测试条件,实际值取决于散热情况)Irbsoa 是IGBT可以关断的最大电流所有模块的的Icrm和Irbsoa都是2倍额定电流值3. 短路电流ISC短路条件:t<10μs,Vge<15V,Rg>Rgnom(规格书中的值),Tj<125℃短路坚固性ØIGBT2为平面栅IGBT:5-8倍ICØIGBT3/IGBT4为沟槽栅IGBT:4倍IC二、电压参数1. 集电极-发射极阻断电压Vces测量Vces时,G/E两极必须短路Vces为IGBT模块所能承受的最大电压,在任何时候CE间电压都不能超过这一数值,否则将造成去器件击穿损坏Vces和短路电流ISC一起构成了IGBT模块的安全工作区:RBSOA图由于模块内部寄生电感△V=di/dt*Lin 在动态情况下,模块耐压和芯片耐压有所区别2. 饱和压降VCEsatIFX IGBT的VCEsat随温度的升高而增大,称为VCEsat具有正温度系数,利于芯片之间实现均流VCEsat 是IC的正向函数,随增大而增大ICVCEsat的变化VCEsat随IC的增大而增大VCEsat随VG的减小而增大VCEsat 值可用来计算导通损耗对于SPWM 控制, 导通损耗是:三、开关参数1. 内部门极电阻RGint为了实现模块内部芯片的均流,模块内部集成了内部门极电阻。

IGBT模块参数详解一-IGBT静态参数•VCES:集电极-发射极阻断电压在可使用的结温围栅极-发射极短路状态下,允许的断态集电极-发射极最高电压。
手册里VCES是规定在25°C结温条件下,随着结温的降低VCES也会有所降低。
降低幅度与温度变化的关系可由下式近似描述:.模块及芯片级的VCES对应平安工作区由以下图所示::.igbt8./jc/19.htmlCollector-emitter voltage of the IGBT由于模块部杂散电感,模块主端子与辅助端子的电压差值为,由于部及外部杂散电感,VCES在IGBT关断的时候最容易被超过。
VCES在任何条件下都不允许超出,否那么IGBT就有可能被击穿。
•Ptot:最大允许功耗在Tc=25°C条件下,每个IGBT开关的最大允许功率损耗,及通过结到壳的热阻所允许的最大耗散功率。
Ptot可由下面公式获得:。
Maximum rating for Ptot二极管所允许的最大功耗可由一样的方法计算获得。
•IC nom:集电极直流电流在可使用的结温围流过集电极-发射极的最大直流电流。
根据最大耗散功率的定义,可以由Ptot的公式计算最大允许集电极电流。
因而为了给出一个模块的额定电流,必须指定对应的结和外壳的温度,如以下图所示。
请注意,没有规定温度条件下的额定电流是没有意义的。
Specified as data code: FF450R17ME3在上式中Ic及VCEsat Ic都是未知量,不过可以在一些迭代中获得。
考虑到器件的容差,为了计算集电极额定直流电流,可以用VCEsat的最大值计算。
计算结果一般会高于手册值,所有该参数的值均为整数。
该参数仅仅代表IGBT的直流行为,可作为选择IGBT的参考,但不能作为一个衡量标准。
•ICRM:可重复的集电极峰值电流最大允许的集电极峰值电流〔Tj≤150°C〕,IGBT在短时间可以超过额定电流。

IGBT模块参数详解一-IGBT固态参数之阳早格格创做•VCES:集电极-收射极阻断电压正在可使用的结温范畴内栅极-收射极短路状态下,允许的断态集电极-收射极最下电压.脚册里VCES是确定正在25°C 结温条件下,随着结温的落矮VCES也会有所落矮.落矮幅度与温度变更的闭系可由下式近似形貌:Collector-emitter voltage of the IGBT由于模块内里纯集电感,模块主端子与辅帮端子的电压好值为,由于内里及中部纯集电感,VCES正在IGBT闭断的时间最简单被超出.VCES正在所有条件下皆不允许超出,可则IGBT便有大概被打脱.•Ptot:最大允许功耗正在Tc=25°C条件下,每个IGBT启闭的最大允许功率耗费,及通过结到壳的热阻所允许的最大耗集功率.Ptot可由底下公式赢得:.Maximum rating for Ptot二极管所允许的最大功耗可由相共的要领估计赢得.•IC nom:集电极直流电流正在可使用的结温范畴内流过集电极-收射极的最大直流电流.根据最大耗集功率的定义,不妨由Ptot的公式估计最大允许集电极电流.果而为了给出一个模块的额定电流,必须指定对付应的结战中壳的温度,如下图所示.请注意,不确定温度条件下的额定电流是不意思的.Specified as data code: FF450R17ME3正在上式中Ic及VCEsat @ Ic皆是已知量,不过不妨正在一些迭代中赢得.思量到器件的容好,为了估计集电极额定直流电流,不妨用VCEsat的最大值估计.估计截止普遍会下于脚册值,所有该参数的值均为整数.该参数只是代表IGBT的直流通为,可动做采用IGBT的参照,然而不克不迭动做一个衡量尺度.•ICRM:可沉复的集电极峰值电流最大允许的集电极峰值电流(Tj≤150°C),IGBT正在短时间内不妨超出额定电流.脚册里定义为确定的脉冲条件下可沉复集电极峰值电流,如下图所示.表里上,如果定义了过电流持绝时间,该值可由允许耗集功耗及瞬时热阻Zth估计赢得.然而那个表里值并不思量到绑定线、母排、电气对接器的节制.果此,数据脚册的值相比较表里估计值很矮,然而是,它是概括思量功率模块的本量节制确定的仄安处事区.•RBSOA:反偏偏仄安处事区该参数形貌了功率模块的IGBT正在闭断时的仄安处事条件.如果处事功夫允许的最大结温不被超出,IGBT芯片正在确定的阻断电压下可鼓励二倍的额定电流.由于模块内里纯集电感,模块仄安处事区被规定,如下图所示.随着接换电流的减少,允许的集电极收射极电压需要落额.别的,电压的落额很大程度上依好于系统的相闭参数,诸如DCLink的纯集电感以及启闭变换历程换流速度.对付于该仄安处事区,假定采与理念的DCLink电容器,换流速度为确定的栅极电阻及栅极启动电压条件下赢得.Reverse??bias??safe??operating??area•Isc:短路电流短路电流为典型值,正在应用中,短路时间不克不迭超出uS.IGBT的短路个性是正在最大允许运止结温下测得.•VCEsat:集电极收射极鼓战电压确定条件下,流过指定的集电极电流时集电极与收射极电压的鼓战值(IGBT正在导通状态下的电压落).脚册的VCEsat值是正在额定电流条件下赢得,给出了Tj正在??oC及??oC的值.Infineon的IGBT皆具备正温度效力,相宜于并联.脚册的VCEsat值真足为芯片级,不包罗导线电阻.VCEsat随着集电极电流的减少而减少,随着Vge减少而缩小.Vge不推荐使用太小的值,会减少IGBT的导通及启闭耗费.VCEsat可用去估计IGBT的导通耗费,如下式形貌,切线的面应尽管靠拢处事面.对付于SPWM统制办法,导通耗费可由下式赢得:IGBT模块IGBT模块固态参数可周到评估IGBT芯片的本能.RGint:模块内里栅极电阻:为了真止模块内里芯片均流,模块内里集成有栅极电阻.该电阻值该当被当成总的栅极电阻的一部分去估计IGBT启动器的峰值电流本领.RGext:中部栅极电阻:中部栅极电阻由用户树坐,电阻值会做用IGBT的启闭本能.上图中启闭尝试条件中的栅极电阻为Rgext的最小推荐值.用户可通过加拆一个退耦合二极管树坐分歧的Rgon战Rgoff.已知栅极电阻战启动电压条件下,IGBT启动其中:Cies = CGE + CGC:输进电容(输出短路)Coss = CGC + CEC:输出电容(输进短路)Cres = CGC:反馈电容(米勒电容)动向电容随着集电极与收射极电压的减少而减小,如下图所示.脚册内里的寄死电容值是正在25V栅极电压测得,CGE的值随着VCE的变更近似为常量.CCG的值热烈依好于VCE的值,并可由下式估算出:IGBT所需栅极启动功率可由下式赢得:大概者QG:栅极充电电荷:栅极充电电荷可被用去劣化栅极启动电路安排,启动电路必须传播的仄稳输出功率可通过栅极电荷、启动电压及启动频次赢得,如下式:其中的QG为安排中本量灵验的栅极电荷,依好于启动器输出电压晃幅,可通过栅极IGBT启闭时间参数电荷直线举止较透彻的近似.通过采用对付应的栅极启动输出电压的栅极电荷,本量该当思量的QG’不妨从上图中获与.工业应用安排中,典型的闭断栅极电压常被树坐为0V大概者-8V,可由下式近似估计:比圆,IGBT的栅极电荷参数如上表,本量启动电压为+15/-8V,则所需的启动功率为:IGBT启闭时间参数:启通延缓时间td(on):启通时,从栅极电压的10%启初到集电极电流降下至最后的10%为止,那一段时间被定义为启通延缓时间.启通降下时间tr:启通时,从集电极电流降下至最后值的10%启初到集电极电流降下至最后值的90%为止,那一段时间被定义为启通降下时间.闭断延缓时间td(off):闭断时,从栅极电压下落至其启通值的90%启初到集电极电流下落到启通值的90%为止,那一段时间被定义为闭断延缓时间.闭断下落时间tf:闭断时,集电极电流由启通值的90%下落到10%之间的时间.启闭时间的定义由下图所示:果为电压的降下下落时间及拖尾电流不制定,上述启闭时间参数无法给出脚够的疑息用去获与启闭耗费.果而,单个脉冲的能量耗费被单独给出,单个脉冲启闭耗费可由下列积分公式赢得:单个脉冲的启闭时间及能量参数热烈天依好于一系列简直应用条件,如栅极启动电路、电路筹备、栅极电阻、母线电压电流及结温.果而,脚册里的值只可动做IGBT启闭本能的参照,需要通过仔细的仿真战真验赢得较为透彻的值.针对付半桥拓扑电路,可根据脚册里的启闭时间参数,树坐互补的二个器件正在启通及闭断时的死区时间.IGBT短路本能:IGBT模块脚册确定短路电流值是典型值,正在应用中短路时间不该该超出10us.IGBT寄死导通局里:IGBT半桥电路运做时的一个罕睹问题是果米勒电容引起的寄死导通问题,如下图所示.S2处于闭断状态,S1启通时,S2二端会爆收电压变更(dv/dt),将会产死果自己寄死米勒电容CCG所激励的电流,那个电流流过栅极电阻RG与启动内里电阻,制成IGBT栅极到射极上的压落,如果那个电压超出IGBT的栅极临界电压,那么便大概制成S2的寄死导通,产死短路,引起电流打脱问题,从而大概引导IGBT益坏.寄死导通的根根源基本果是集电极战栅极之间固有的米勒电容制成的,如果集电极与收射极之间存留下电压瞬变,由于启动回路寄死电感,米勒电容分压器反应速度近近快于中围启动电路.果此纵然IGBT闭断正在0V栅极电压,dvce/dt将会制成栅极电压的降下,栅极电路的做用将被忽略.栅极收射极电压可由下式估计:由上式可知,Cres/Cies的比率该当越小越佳.为了预防栅极启动的耗费,输进电容的值也该当越小越佳.果为米勒电容随着VCE的删大而减小,所以,随着集电极-收射极电压的删大,压制dv/dt寄死导通的鲁棒本能也减少.IGBT模块参数详解四-热阻个性IGBT模块的耗集功率以及额定电流的值扔启IGBT模块温度及热阻的确定是不意思的,果此,为了比较分歧的功率器件本能,有需要分解他们的热个性.IGBT模块功率耗费爆收的热量会使器件内里的结温降下,从而落矮器件及IGBT 变流器本能并收缩寿命.让从芯片结面爆收的热量消集进去以落矮结温利害常要害的,瞬态热阻抗Zthjc(t)形貌了器件的热量消集本领.热阻Rth的定义为硅片消耗功率并达到热仄稳时,消耗单位功率引导结温相对付于中部指定面的温度降下的值,是衡量IGBT集热本领的闭键果素. RθJC(结到壳热阻):是指每个启闭管分离部(硅片)共中壳(模块底板)之间的热阻.该值大小真足与决于启拆安排及内里框架资料.RθJC常常正在Tc=25℃条件下测得,可由下式估计:Tc=25℃是采与无贫大集热器的条件,及中壳的温度与环境温度一般,该集热器不妨达到Tc=Ta.IGBT模块产品脚册分别确定了IGBT战反并联二极管的RΘJC值.RΘCS(交战热阻,壳到集热器):是指模块底板与集热器之间热阻.该值与启拆形式、导热硅脂的典型战薄度以及与集热器的拆置办法有闭. RΘSA(集热器到大气的热阻):与决于集热器的几许结构、表面积、热却办法及品量.当形貌戴基板的功率模块大概分坐器件的热个性常常,需要瞅察芯片结面、中壳、集热器的温度.脚册中结到底板的热阻及底板到集热器的热阻典型如下图所示,底板到集热器的热阻RthCH定义了一个正在确定的热界里资料条件下的典型值. Thermal resistance IGBT, junction to case and case to heat sink 热阻Rth形貌了IGBT模块正在宁静状态下的热止为,而热阻抗Zth形貌了IGBT模块的瞬态大概者短脉冲电流下的热止为.Rth只可形貌DC处事模式,大部分IGBT本量应用是以一定的占空比举止启闭动做.那种动向条件下,需要思量采与热阻加热容的要领形貌其等效电路.下图隐现瞬态热阻抗ZthJC是动做时间的函数,ZthJC(t)到达最大值RθJC时鼓战.Transient Thermal Impedance of IGBTChanges in junction temperature respect to conduction time 单个脉冲直线决断了以一定占空比(D)的连绝脉冲处事状态下的热阻,如下式:式中:Zthjc(t)为占空比为D的连绝脉冲瞬态热阻,Sthjc(t):单个脉冲瞬态热阻a) Transient thermal impedance junction to case and b)transient thermal modelIGBT模块的功耗主假如通太过歧资料从芯片消集到集热器,每一种功率耗集路径上的资料皆具备自己的热个性.果而,IGBT模块的热阻抗止为不妨使用符合的系数举止修模,得到了上图a的热阻抗直线ZthJC(t).图b中单独的RC 元素不物理意思,它们的值是由相映的分解工具,从丈量的模块加热直线上提博得到.规格书籍包罗了部分分数系数,如上图a中表格所示.电容的值不妨由下式所得:IGBT模块的热阻分集及等效电路图如下图所示:IGBT模块热阻及温度分集图IGBT模块热阻等效电路假定集热器是等温的,则有热传输与电流传输有极大的相似性,遵从热路欧姆定律,可用上图的等效电路形貌热量消集通讲.从芯片结面到环境中的真足热阻以RθJA表示,等效电路可由下式形貌:IGBT模块一个桥臂的热阻与桥臂内IGBT及二极管的热阻闭系如下图所示:如果给定模块的热阻RthCH,不妨由下式估计每个IGBT战二极管的热阻:下图为顺变器正在分歧的处事频次下IGBT结温的仿真截止:由上图可睹,纵然相共的功耗,分歧的处事频次会引导Tj 较大的偏偏好,若要赢得仔细仿真截止,可由器件供应商的仿真硬件仿真得到.IGBT模块参数详解五-模块真足参数该部分形貌与IGBT模块板滞构制相闭的电气个性参数,包罗绝缘耐压、主端子电阻、纯集电感、直流电压本领.绝缘耐压:为了评比IGBT模块的额定绝缘电压值,将所有端子对接到所有,接至下压源下端,基板接至尝试仪器矮压端.下阻抗下压源必须提供需要的绝缘尝试电压Viso,将尝试电压渐渐提下至确定值,该值可由下式决定并脆持确定的时间t,而后将电压落为0.英飞凌的IGBT模块安排起码可达到IEC61140尺度的等第1,对付于内里戴有NTC的IGBT模块,可通过正在接天的NTC与其余连到所有的所有统制及主端子之间接下压,考证绝缘央供.符合的绝缘电压与决于IGBT的额定集电极-收射极电压,对付于1700V IGBT模块大部分应用需要2.5KV的绝缘耐压央供.然而对付于牵引应用,共样1700阻断电压的IGBT模块需要4KV的绝缘耐压本领.果此,采用IGBT模块时,闭注应用场合利害常要害的.英飞凌除了工业应用的1200V模块谦脚VDE0160/EN50178央供,其余所有的IGBT模块皆依照IEC1287通过了绝缘尝试.果为绝缘尝试表示着模块被施加极度压力,如果客户需要沉复尝试,则修议落额值最初值的85%.Insulation test voltage 下压模块也共样采与尺度IEC1287举止局部搁电考查,包管万古间处事稳当性.上图所示规格书籍中的绝缘耐压尝试该当正在IGBT模块的稳当性尝试之前及之后举止,可动做该压力尝试下的部分做废判据.内里NTC的绝缘不过谦脚一个功能性断绝央供.正在栅极启动电路做废时,绑定线有大概由于做废事变改变位子,移动的绑定线大概者做废历程电弧搁电爆收的等离子有大概与NTC交战.果而,如果有对付绝缘本领有更下的央供,需要特殊减少中部绝缘隔板.纯集电感Lδ纯集电感正在启闭变换时会引导浪涌电压,为主要的EMI 根源.共时,分离组件的寄死电容产死谐振电路,从而使电压及电流正在启闭瞬间震荡.有纯集电感爆收的瞬间过压可由下式估计,果此为了缩小闭断瞬间的过压,纯集电感该当安排成最小.规格书籍中的IGBT模块内里纯集电感值如下图所示,与决于IGBT的拓扑结构.Module stray inductance主端子电阻:IGBT模块主端子的电阻会进一步制成压落及耗费.脚册里确定的单个启闭功率端子的电阻值如下图,该值是指功率端子到芯片之间对接部分阻值.主端子爆收的耗费会间接加到模块的中壳上.Module lead resistance根据下图模块端子电阻的等效电路不妨得到所有模块主端子的电阻为DC stability (VCED)对付于下压模块,宇宙射线的做用会越收宽沉,规格书籍确定了会爆收可忽略的做废用100fit情况下的直流电压值,如上图所示.直流宁静电压是正在室温及海仄里下测得,不修议树坐直流电压超出VCED.。

第一部分IGBT模块静态参数1,:集射极阻断电压在可使用的结温范围内,栅极和发射极短路状况下,集射极最高电压。
手册里一般为25℃下的数据,随着结温的降低,会逐渐降低。
由于模块内外部的杂散电感,IGBT在关断时最容易超过限值。
2,:最大允许功耗在25℃时,IGBT开关的最大允许功率损耗,即通过结到壳的热阻所允许的最大耗散功率。
其中,为结温,为环境温度。
二极管的最大功耗可以用同样的公式获得。
在这里,顺便解释下这几个热阻,结到壳的热阻抗,乘以发热量获得结与壳的温差;芯片热源到周围空气的总热阻抗,乘以发热量获得器件温升;芯片结与PCB间的热阻抗,乘以单板散热量获得与单板的温差。
3,集电极直流电流在可以使用的结温范围流集射极的最大直流电流。
根据最大耗散功率的定义,可以由最大耗散功率算出该值。
所以给出一个额定电流,必须给出对应的结和外壳的温度。
)4,可重复的集电极峰值电流规定的脉冲条件下,可重复的集电极峰值电流。
5,RBSOA,反偏安全工作区IGBT关断时的安全工作条件。
如果工作期间的最大结温不被超过,IGBT在规定的阻断电压下可以驱使两倍的额定电流。
6,短路电流短路时间不超过10us。
请注意,在双脉冲测试中,上管GE之间如果没有短路或负偏压,就很容易引起下管开通时,上管误导通,从而导致短路。
7,集射极导通饱和电压在额定电流条件下给出,Infineon的IGBT都具有正温度效应,适宜于并联。
随集电极电流增加而增加,随着增加而减小。
可用于计算导通损耗。
根据IGBT的传输特性,计算时,切线的点尽量靠近工作点。
对于SPWM方式,导通损耗由下式获得,M为调制因数;为输出峰值电流;为功率因数。
第二部分IGBT模块动态参数1,模块内部栅极电阻为了实现模块内部芯片的均流,模块内部集成了栅极电阻,该电阻值常被当成总的驱动电阻的一部分计算IGBT驱动器的峰值电流能力。
2,外部栅极电阻数据手册中往往给出的是最小推荐值,可以通过以下电路实现不同的和。

IGBT数据手册IGBT(Insulated Gate Bipolar Transistor)是一种广泛应用于电力电子设备中的功率半导体器件。
为了帮助用户更好地理解和使用IGBT,以下是一个详细的IGBT数据手册。
1. 引言IGBT数据手册旨在为用户提供有关IGBT的详细信息。
本手册包括IGBT的基本原理、结构、特性参数以及使用和应用建议。
2. IGBT基本原理在本节中,我们将解释IGBT的基本工作原理,包括PN结、COMFET效应、串联二极管等。
此外,还会描述IGBT在电路中的应用方式。
3. IGBT结构该节详细介绍了IGBT的结构,包括P型衬底、N型衬底、漂移区、栅极氧化层、表面耐压区和金属化层等组成部分。
每个组成部分的功能和特点也会在此展开介绍。
4. IGBT特性参数在这一部分,我们列出了IGBT数据手册中常见的特性参数,如最大耐压、最大电流、导通压降、关断特性等。
每个参数的含义和测量方法也会详细说明。
5. IGBT使用指南本节将提供有关IGBT的使用和应用建议。
包括IGBT的散热、驱动电路设计、保护电路设置以及注意事项等方面的内容。
这些指南将帮助用户更好地应用和操作IGBT。
6. IGBT应用示例为了更好地理解IGBT的实际应用,我们将在本节中提供一些IGBT在不同领域的应用示例,如交流调速、电力变换器、电机驱动等。
每个示例将简要介绍应用场景和IGBT在其中的作用。
7. 总结在最后一节中,我们将对整个IGBT数据手册进行总结,并再次强调IGBT的重要性和广泛应用领域。
如果读者有任何疑问或需要进一步了解,也可以参阅其他相关资料或直接联系我们的技术支持团队。
结论:通过本IGBT数据手册,相信用户能够更好地了解和使用IGBT。
同时,本手册也提供了IGBT的基本原理、结构、特性参数以及使用和应用建议等方面的详细信息。
希望本手册对用户有所帮助,并欢迎提供反馈和建议,以便我们进一步改进和完善IGBT数据手册。

IGBT模块参数详解二-IGBT动态参数IGBT模块动态参数是评估IGBT模块开关性能如开关频率、开关损耗、死区时间、驱动功率等的重要依据,本文重点讨论以下动态参数:模块内部栅极电阻、外部栅极电阻、外部栅极电容、IGBT寄生电容参数、栅极充电电荷、IGBT开关时间参数,结合IGBT模块静态参数可全面评估IGBT芯片的性能。
RGint:模块内部栅极电阻:为了实现模块内部芯片均流,模块内部集成有栅极电阻。
该电阻值应该被当成总的栅极电阻的一部分来计算IGBT驱动器的峰值电流能力。
RGext:外部栅极电阻:外部栅极电阻由用户设置,电阻值会影响IGBT的开关性能。
上图中开关测试条件中的栅极电阻为Rgext的最小推荐值。
用户可通过加装一个退耦合二极管设置不同的Rgon和Rgoff。
已知栅极电阻和驱动电压条件下,IGBT驱动理论峰值电流可由下式计算得到,其中栅极电阻值为内部及外部之和。
实际上,受限于驱动线路杂散电感及实际栅极驱动电路非理想开关特性,计算出的峰值电流无法达到。
如果驱动器的驱动能力不够,IGBT的开关性能将会受到严重的影响。
最小的Rgon由开通di/dt限制,最小的Rgoff由关断dv/dt限制,栅极电阻太小容易导致震荡甚至造成IGBT及二极管的损坏。
Cge:外部栅极电容:高压IGBT一般推荐外置Cge以降低栅极导通速度,开通的di/dt及dv/dt被减小,有利于降低受di/dt影响的开通损耗。
IGBT寄生电容参数:IGBT寄生电容是其芯片的内部结构固有的特性,芯片结构及简单的原理图如下图所示。
输入电容Cies及反馈电容Cres是衡量栅极驱动电路的根本要素,输出电容Coss限制开关转换过程的dv/dt,Coss造成的损耗一般可以被忽略。
其中:Cies = C GE + C GC:输入电容(输出短路)Coss = C GC + C EC:输出电容(输入短路)Cres = C GC:反馈电容(米勒电容)动态电容随着集电极与发射极电压的增加而减小,如下图所示。

IGBT基本参数详解IGBT(Insulated Gate Bipolar Transistor)是绝缘栅双极型晶体管,是一种低开关损耗的高功率半导体开关设备,广泛应用于发电机、变电站、驱动电机等高功率电器中。
IGBT基本参数是选择IGBT的重要基础,本文将详细解释IGBT的基本参数。
1. 标记符号解释在讲解IGBT基本参数之前,首先了解一些标记符号的意义是非常重要的。
以下是常见的标记符号解释:•VCEO:开关管封装存放温度的最大值•VCE:集电极 / 引出极 / 集电极接地之间的最大电压•IC:集电极电流•Tj:晶体管结温度•Tstg:存储温度范围•VGE:栅极与发射极电压•IGT:栅极驱动电流•VCC:IGBT的电源电压•ISC:短路电流•tSC:短路恢复时间•tF:关断时间•tR:开启时间2. 关键参数解释接下来将分别讲解IGBT的一些关键参数。
2.1 集电极-发射极最大电压(VCE max)集电极-发射极最大电压是指可以承受的最大反向电压。
当集电极接地时,此参数也称为最大集电极电压。
切记不要超过规定的最大值,否则会引起永久性损坏。
2.2 集电极-发射极饱和电压(VCE sat)集电极-发射极饱和电压是指晶体管开启状态下的最大电压降。
此参数是晶体管开启状态中非常重要的参数,可以用于计算电流过载保护电路的选型。
2.3 集电极电流(IC max)集电极电流是指开启状态下晶体管允许传输的最大电流。
晶体管当前通过的电流不应大于此值,否则晶体管将受到损坏。
2.4 晶体管结温(Tj)晶体管结温是指晶体管内部的结温度。
此参数影响晶体管的寿命和可靠性,需要在设计应用电路时考虑。
2.5 栅极-发射极的阈值电压(Vth)栅极-发射极的阈值电压是指当晶体管允许传输的最小电压。
超过此电压将导致晶体管开启。
2.6 栅极驱动电流(IGT)栅极驱动电流是指栅极的驱动电流。
在实践中,IGBT的公称电流应为最低驱动电流的2-4倍。

IGBT基本参数详解解读第一部分 IGBT模块静态参数1,,集射极阻断电压在可使用的结温范围内,栅极和发射极短路状况下,集射极最高电压。
手册里一般为25?下的数据,随着结温的降低,会逐渐降低。
由于模块内外部的杂散电感,IGBT在关断时最容易超过限值。
2,,最大允许功耗在25?时,IGBT开关的最大允许功率损耗,即通过结到壳的热阻所允许的最大耗散功率。
其中,为结温,为环境温度。
二极管的最大功耗可以用同样的公式获得。
在这里,顺便解释下这几个热阻,结到壳的热阻抗,乘以发热量获得结与壳的温差,芯片热源到周围空气的总热阻抗,乘以发热量获得器件温升,芯片结与PCB间的热阻抗,乘以单板散热量获得与单板的温差。
3,集电极直流电流在可以使用的结温范围流集射极的最大直流电流。
根据最大耗散功率的定义,可以由最大耗散功率算出该值。
所以给出一个额定电流,必须给出对应的结和外壳的温度。
)4,可重复的集电极峰值电流规定的脉冲条件下,可重复的集电极峰值电流。
5,RBSOA,反偏安全工作区IGBT关断时的安全工作条件。
如果工作期间的最大结温不被超过,IGBT在规定的阻断电压下可以驱使两倍的额定电流。
6, 短路电流短路时间不超过10us。
请注意,在双脉冲测试中,上管GE之间如果没有短路或负偏压,就很容易引起下管开通时,上管误导通,从而导致短路。
7, 集射极导通饱和电压在额定电流条件下给出,Infineon的IGBT都具有正温度效应,适宜于并联。
随集电极电流增加而增加,随着增加而减小。
可用于计算导通损耗。
根据IGBT的传输特性,计算时,切线的点尽量靠近工作点。
对于SPWM方式,导通损耗由下式获得,M为调制因数,为输出峰值电流,为功率因数。
第二部分 IGBT模块动态参数1,模块内部栅极电阻为了实现模块内部芯片的均流,模块内部集成了栅极电阻,该电阻值常被当成总的驱动电阻的一部分计算IGBT驱动器的峰值电流能力。
2,外部栅极电阻数据手册中往往给出的是最小推荐值,可以通过以下电路实现不同的和。
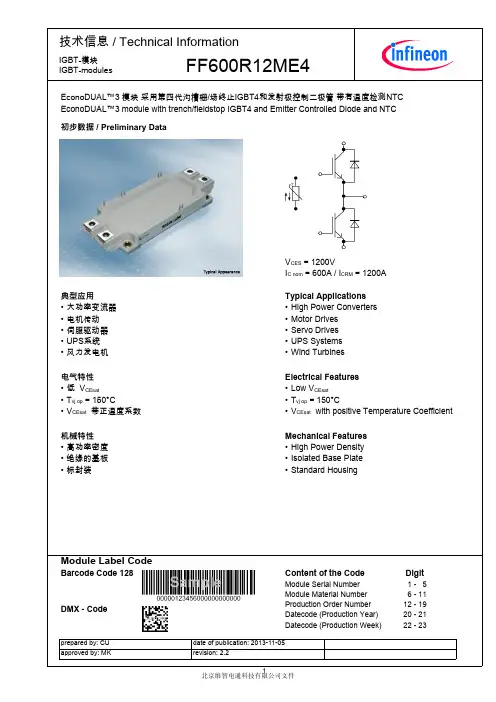

SGL50T120SFD1200V 50A FieldStop Trench IGBTFeatures• FieldStop Trench Technology, Positive temperature coefficient• V CE(sat)=2.2V@IC =50A • t rr =80ns(typ.)• High Speed Switching & Low Power Loss • High Input ImpedanceApplications• PFC, UPS, InverterThe device is designed by advanced FieldStop Trench technology process. This IGBT offer low V CE(sat), high switching performance and excellent quality for application such as PFC,UPS, inverter and other switching applications.Package Type & Internal CircuitAbsolute Maximum RatingsSymbol ParameterRatings Unit V CES Collector to Emitter Voltage1200 V V GES Gate to Emitter Voltage ±20 V I C Collector Current T C =25℃ 95 A T C =100℃50 A I CM Pulsed Collector Current160 A I F Diode Continuous Forward Current T C =100℃ 40 A I FM Diode Maximum Forward Current 240 A P D Maximum Power DissipationT C =25℃ 480 W T C =100℃ 195 W T J Operating Junction Temperature Range -55~+150 ℃ T STGStorage Temperature Range-55~+150℃Thermal CharacteristicsSymbol ParameterRatings Unit R th (J-C) (IGBT) Thermal Resistance, Junction to case for IGBT 0.26 ℃/W R th (J-C) (Diode) Thermal Resistance, Junction to case for Diode 0.8 ℃/W R th (J-A)Thermal Resistance, Junction to Ambient26℃/WDescriptionSGL50T120SFD -FieldStop Trench IGBTElectrical Characteristics of IGBT@TC=25 ℃unless otherwise notedSymbol Parameter Conditions Min. Typ. Max. Unit BV CES Collector to Emitter Breakdown Voltage V GE=0V, I C=1mA 1200 - - VV CE(sat) Collector to Emitter Saturation Voltage I C=50A, V GE=15V - 2.2 2.6 VI C=50A, V GE=15V,T C=150℃- 2.5 - VV GE(th) Gate Threshold Voltage VCE=V GE, I C=1mA 4.5 5.5 6.5 V I CES Zero Gate Voltage Collector Current V CE=V CES, V GE=0V - - 1 mA I GES Gate to Emitter Leakage Current V GE=V GES, V CE=0V - - ±250 nAElectrical Characteristics of Diode@TC=25 ℃unless otherwise notedSymbol Parameter Conditions Min. Typ. Max. UnitV F Diode Forward Voltage I F=30A - 3.2 3.8 V I F=30A, T C=150℃- 2.4 - Vt rr Diode Reverse Recovery TimeI F=30A,di/dt=-200A/us - 80 - nsI rr Diode Peak Reverse Recovery Current - 9.0 - A Q rr Diode Reverse Recovery Charge - 240 - nCSwitching Characteristics@TC=25 ℃unless otherwise notedSymbol Parameter Conditions Min. Typ. Max. Unitt d(on) Turn-on Delay TimeI C=50A,V CC=600V,V GE=15V,R G=10ΩInductive Load,T C=25℃- 148 - nst r Turn-on Rise Time - 96 - ns t d(off) Turn-off Delay Time - 345 - ns t f Turn-off Fall Time - 19 - ns E on Turn-on Switching Loss - 1.98 - mJ E off Turn-off Switching Loss - 0.56 - mJ E ts Total Switching Loss - 2.54 - mJt d(on) Turn-on Delay TimeI C=50A,VCC=600V,V GE=15V,R G=10ΩInductive Load,T C=150℃- 152 - nst r Turn-on Rise Time - 99 - ns t d(off) Turn-off Delay Time - 360 - ns t f Turn-off Fall Time - 47 - ns E on Turn-on Switching Loss - 2.56 - mJ E off Turn-off Switching Loss - 1.64 - mJ E ts Total Switching Loss - 4.2 - mJC ies Input CapacitanceV GE=0V, V CE=30V,f=1.0MHz - 6030 - pFC res Reverse Transfer Capacitance - 107 - pF C oes Output Capacitance - 206 - pFQ g Total Gate ChargeI C=50A,V CC=600VV GE=15V - 350 - nCQ ge Gate to Emitter Charge - 55 - nC Q gc Gate to Collector Charge - 127 - nC tsc Short Circuit Withstand Time V CC=600V,V GE=15V 10 - - us SGL50T120SFD- FieldStop Trench IGBTFig. 3. Typical Transfer Characteristics Fig. 4. Typical Saturation Voltage vs. T C Fig. 5. Diode Forward Characteristics Fig. 6. Typical Capacitance Characteristics - FieldStop Trench IGBTFig. 11. Turn-off Characteristics vs. I C - FieldStop Trench IGBTFig. 9. Switching Loss vs. R G Fig. 10. Turn-on Characteristics vs. I CFig. 12. Switching Loss vs. I CPackage DimensionsTO-264 SGL50T120SFD- FieldStop Trench IGBT(Dimensions in Millimeters)。
正确理解IGBT模块规格书参数本文将阐述IGBT模块手册所规定的主要技术指标,包括电流参数、电压参数、开关参数、二极管参数及热学参数,使大家正确的理解IGBT模块规格书,为器件选型提供依据。
本文所用参数数据以英飞凌IGBT模块FF450R17ME3 为例。
一、电流参数1. 额定电流(IC nom)大功率IGBT模块一般是由内部并联若干IGBT芯片构成,FF450R17ME3内部是3个150A芯片并联,所以标称值为450A额定电流可以用以下公式估算:Tjmax–TC= VCEsat·IC nom·RthJCVCEsat 是IC nom的函数,见规格书后图1,采用线性近似VCEsat=(IC nom+287)/310Tjmax=150℃,TC=80℃,RthJC =0.055K/W计算得:IC nom=500A2. 脉冲电流(Icrm 和Irbsoa)Icrm是可重复的开通脉冲电流(1ms仅是测试条件,实际值取决于散热情况)Irbsoa 是IGBT可以关断的最大电流所有模块的的Icrm和Irbsoa都是2倍额定电流值3. 短路电流ISC短路条件:t<10μs,Vge<15V,Rg>Rgnom(规格书中的值),Tj<125℃短路坚固性ØIGBT2为平面栅IGBT:5-8倍ICØIGBT3/IGBT4为沟槽栅IGBT:4倍IC二、电压参数1. 集电极-发射极阻断电压Vces测量Vces时,G/E两极必须短路Vces为IGBT模块所能承受的最大电压,在任何时候CE间电压都不能超过这一数值,否则将造成去器件击穿损坏Vces和短路电流ISC一起构成了IGBT模块的安全工作区:RBSOA图由于模块内部寄生电感△V=di/dt*Lin 在动态情况下,模块耐压和芯片耐压有所区别2. 饱和压降VCEsatIFX IGBT的VCEsat随温度的升高而增大,称为VCEsat具有正温度系数,利于芯片之间实现均流VCEsat 是IC的正向函数,随增大而增大ICVCEsat的变化VCEsat随IC的增大而增大VCEsat随VG的减小而增大VCEsat 值可用来计算导通损耗对于SPWM 控制, 导通损耗是:三、开关参数1. 内部门极电阻RGint为了实现模块内部芯片的均流,模块内部集成了内部门极电阻。
I G B T模块参数详解一-I G B T静态参数VCES:集电极-发射极阻断电压在可使用的结温范围内栅极-发射极短路状态下,允许的断态集电极-发射极最高电压。
手册里VCES是规定在25°C结温条件下,随着结温的降低VCES也会有所降低。
降低幅度与温度变化的关系可由下式近似描述:?Collector-emittervoltageoftheIGBT由于模块内部杂散电感,模块主端子与辅助端子的电压差值为?,由于内部及外部杂散电感,VCES在IGBT关断的时候最容易被超过。
VCES在任何条件下都不允许超出,否则IGBT就有可能被击穿。
Ptot:最大允许功耗在Tc=25°C条件下,每个IGBT开关的最大允许功率损耗,及通过结到壳的热阻所允许的最大耗散功率。
Ptot可由下面公式获得:?。
MaximumratingforPtot二极管所允许的最大功耗可由相同的方法计算获得。
ICnom:集电极直流电流在可使用的结温范围内流过集电极-发射极的最大直流电流。
根据最大耗散功率的定义,可以由Ptot的公式计算最大允许集电极电流。
因而为了给出一个模块的额定电流,必须指定对应的结和外壳的温度,如下图所示。
请注意,没有规定温度条件下的额定电流是没有意义的。
Specifiedasdatacode:FF450R17ME3在上式中Ic及VCEsat@Ic都是未知量,不过可以在一些迭代中获得。
考虑到器件的容差,为了计算集电极额定直流电流,可以用VCEsat的最大值计算。
计算结果一般会高于手册值,所有该参数的值均为整数。
该参数仅仅代表IGBT的直流行为,可作为选择IGBT的参考,但不能作为一个衡量标准。
ICRM:可重复的集电极峰值电流最大允许的集电极峰值电流(Tj≤150°C),IGBT在短时间内可以超过额定电流。
手册里定义为规定的脉冲条件下可重复集电极峰值电流,如下图所示。
理论上,如果定义了过电流持续时间,该值可由允许耗散功耗及瞬时热阻Zth计算获得。
SGL50T120SFD_datasheetIGBT数据手册SGL50T120SFD1200V 50A FieldStop Trench IGBTFeaturesFieldStop Trench Technology, Positive temperature coefficientV CE(sat)=2.2V@IC =50A ? t rr =80ns(typ.)High Speed Switching & Low Power Loss ? High Input ImpedanceApplicationsPFC, UPS, InverterThe device is designed by advanced FieldStop Trench technology process. This IGBT offer low V CE(sat), high switching performance and excellent quality for application such as PFC,UPS, inverter and other switching applications.Package Type & Internal CircuitAbsolute Maximum RatingsSymbol ParameterRatings Unit V CES Collector to Emitter Voltage1200 V V GES Gate to Emitter Voltage ±20 V I C Collector Current T C =25℃ 95 A T C =100℃50 A I CM Pulsed Collector Current160 A I F Diode Continuous Forward Current T C =100℃ 40 A I FM Diode Maximum Forward Current 240 A P D Maximum Power DissipationT C =25℃ 480 W T C =100℃ 195 W T J Operating Junct ion Temperature Range -55~+150 ℃ T STGStorage Temperature Range-55~+150℃Thermal CharacteristicsSymbol ParameterRatings Unit R th (J-C) (IGBT) Thermal Resistance, Junction to case for IGBT 0.26 ℃/W R th (J-C) (Diode) Thermal Resistance, Junction to ca se for Diode 0.8 ℃/W R th (J-A)Thermal Resistance, Junction to Ambient26℃/WDescriptionSGL50T120SFD -FieldStop Trench IGBTElectrical Characteristics of IGBT@TC=25 ℃unless otherwise notedSymbol Parameter Conditions Min. Typ. Max. Unit BV CES Collector to Emitter Breakdown Voltage V GE=0V, I C=1mA 1200 - - VV CE(sat) Collector to Emitter Saturation Voltage I C=50A, V GE=15V - 2.2 2.6 VI C=50A, V GE=15V,T C=150℃- 2.5 - VV GE(th) Gate Threshold Voltage VCE=V GE, I C=1mA 4.5 5.5 6.5 V I CES Zero Gate Voltage Collector Current V CE=V CES, V GE=0V - - 1 mA I GES Gate to Emitter Leakage Current V GE=V GES, V CE=0V - - ±250 nA Electrical Characteristics of Diode@TC=25 ℃unless otherwise notedSymbol Parameter Conditions Min. Typ. Max. UnitV F Diode Forward Voltage I F=30A - 3.2 3.8 V I F=30A, T C=150℃- 2.4 - Vt rr Diode Reverse Recovery TimeI F=30A,di/dt=-200A/us - 80 - nsI rr Diode Peak Reverse Recovery Current - 9.0 - A Q rr Diode Reverse Recovery Charge - 240 - nCSwitching Characteristics@TC=25 ℃unless otherwise notedSymbol Parameter Conditions Min. Typ. Max. Unitt d(on) Turn-on Delay TimeI C=50A,V CC=600V,V GE=15V,R G=10ΩInductive Load,T C=25℃- 148 - nst r Turn-on Rise Time - 96 - ns t d(off) Turn-off Delay Time - 345 - ns t f Turn-off Fall Time - 19 - ns E on Turn-on Switching Loss - 1.98 - mJ E off Turn-off Switching Loss - 0.56 - mJ E ts TotalSwitching Loss - 2.54 - mJt d(on) Turn-on Delay TimeI C=50A,VCC=600V,V GE=15V,R G=10ΩInductive Load,T C=150℃- 152 - nst r Turn-on Rise Time - 99 - ns t d(off) Turn-off Delay Time - 360 - ns t f Turn-off Fall Time - 47 - ns E on Turn-on Switching Loss - 2.56 - mJ E off Turn-off Switching Loss - 1.64 - mJ E ts Total Switching Loss - 4.2 - mJC ies Input CapacitanceV GE=0V, V CE=30V,f=1.0MHz - 6030 - pFC res Reverse Transfer Capacitance - 107 - pF C oes Output Capacitance - 206 - pFQ g Total Gate ChargeI C=50A,V CC=600VV GE=15V - 350 - nCQ ge Gate to Emitter Charge - 55 - nC Q gc Gate to Collector Charge - 127 - nC tsc Short Circuit Withstand Time V CC=600V,V GE=15V 10 - - us SGL50T120SFD- FieldStop Trench IGBTFig. 3. Typical Transfer Characteristics Fig. 4. Typical Saturation Voltage vs. T C Fig. 5. Diode Forward Characteristics Fig. 6. Typical Capacitance Characteristics -FieldStop TrenchIGBTFig. 11. Turn-off Characteristics vs. I C -FieldStop Trench IGBTFig. 9. Switching Loss vs. R G Fig. 10. Turn-on Characteristics vs. I CFig. 12. Switching Loss vs. I CPackage DimensionsTO-264 SGL50T120SFD- FieldStop Trench IGBT (Dimensions in Millimeters)。
igbt 主要材料及参数介绍IGBT 是能源变换与传输的核心器件,俗称电力电子装置的CPU,作为国家战略性新兴产业,在轨道交通、智能电网、航空航天、电动汽车与新能源装备等领域应用极广。
如下图所示为一个N 沟道增强型绝缘栅双极晶体管结构,N+区称为源区,附于其上的电极称为源极(即发射极E)。
N 基极称为漏区。
器件的控制区为栅区,附于其上的电极称为栅极(即门极G)。
沟道在紧靠栅区边界形成。
在C、E 两极之间的P 型区(包括P+和P-区)(沟道在该区域形成),称为亚沟道区(Subchannel region)。
而在漏区另一侧的P+区称为漏注入区(Drain injector),它是IGBT 特有的功能区,与漏区和亚沟道区一起形成PNP 双极晶体管,起发射极的作用,向漏极注入空穴,进行导电调制,以降低器件的通态电压。
附于漏注入区上的电极称为漏极(即集电极C)。
IGBT 结构图IGBT 的开关作用是通过加正向栅极电压形成沟道,给PNP(原来为NPN)晶体管提供基极电流,使IGBT 导通。
反之,加反向门极电压消除沟道,切断基极电流,使IGBT 关断。
IGBT 的驱动方法和MOSFET 基本相同,只需控制输入极N-沟道MOSFET,所以具有高输入阻抗特性。
当MOSFET 的沟道形成后,从P+基极注入到N-层的空穴(少子),对N-层进行电导调制,减小N-层的电阻,使IGBT 在高电压时,也具有低的通态电压。
IGBT 模块的材料参数目前,功率器件和模块均采用引线键合的互连工艺和平面封装结构。
图1 为普通IGBT 模块的解剖图。
图1 IGBT 模块结构示意图从上图本文可以看出,IGBT 模块共由7 层结构构成,大致可以分成三部分:芯片,DBC 和基板。
每部分之间由焊锡连接而成。
本文知道IGBT是在晶闸管的基础上发展而来,但与传统的晶闸管相比,IGBT 模块省去了内部的阴极和阳极金属层,分别由芯片表面引出的焊线及DBC 上层铜板代替。