CVD分类及简介-PECVD-MOCVD
- 格式:pdf
- 大小:274.99 KB
- 文档页数:3

化学气相沉积的分类
化学气相沉积(Chemical Vapor Deposition,CVD)是一种重要的薄膜制备技术,广泛应用于半导体、光电子、材料科学等领域。
根据反应条件和反应物状态的不同,CVD可以分为热CVD、低压CVD、等离子体增强CVD和原子层沉积(ALD)等几种类型。
热CVD是最早发展的CVD技术,其反应温度通常在800℃以上。
在高温下,反应物分子能够充分活化,反应速率较快,但也容易导致杂质的混入。
热CVD主要用于制备高质量的单晶薄膜,如硅、碳化硅等。
低压CVD是在较低的反应压力下进行的CVD技术,反应温度通常在500℃左右。
低压CVD可以有效地控制反应物的输送和反应速率,从而得到较高的薄膜质量和均匀性。
低压CVD广泛应用于制备金属、氧化物、氮化物等薄膜。
等离子体增强CVD(PECVD)是在等离子体的作用下进行的CVD 技术,反应温度通常在200℃左右。
等离子体能够激活反应物分子,提高反应速率和选择性,同时也能够减少杂质的混入。
PECVD主要用于制备非晶态薄膜,如氢化非晶硅、氮化硅等。
原子层沉积(ALD)是一种精密的CVD技术,其反应速率非常缓慢,通常需要几秒钟到几分钟的反应时间。
ALD可以精确地控制薄膜的厚度和成分,同时也能够制备复杂的多层结构。
ALD广泛应用于制
备高质量的绝缘体、金属、氧化物等薄膜。
CVD技术是一种非常重要的薄膜制备技术,不同类型的CVD技术具有各自的特点和应用范围。
随着科技的不断发展,CVD技术也将不断地得到改进和完善,为各个领域的应用提供更加优质的薄膜材料。


化学气相沉积的分类化学气相沉积(Chemical Vapor Deposition,简称CVD)是一种重要的化学合成方法,广泛应用于材料科学、纳米技术、能源储存等领域。
根据反应条件和沉积机理的不同,CVD可以分为几个不同的分类。
一、热分解CVD(Thermal Decomposition CVD)热分解CVD是最常见的一种CVD方法,也是最早被研究和应用的方法之一。
在热分解CVD中,反应物质通常是一种易于挥发的有机化合物,如金属有机化合物或有机溶液。
这些反应物质在高温下分解,释放出金属或非金属的原子或分子,然后在基底表面发生反应,生成所需的沉积物。
二、金属有机CVD(Metal-organic CVD,MOCVD)金属有机CVD是一种基于金属有机化合物的CVD方法,广泛应用于半导体行业。
在MOCVD中,金属有机化合物被分解为金属源和有机源,然后在基底表面发生反应,生成所需的材料。
MOCVD可以用于制备各种半导体材料,如GaN、InP等。
三、等离子体增强CVD(Plasma Enhanced CVD,PECVD)等离子体增强CVD是一种利用等离子体激活反应的CVD方法。
在PECVD中,反应物质通过等离子体的作用被激活,从而提高反应速率和沉积速率。
等离子体可以通过射频或微波等方式产生。
PECVD 广泛应用于薄膜的生长和表面修饰等领域。
四、气体相反应CVD(Gas-phase Reaction CVD)气体相反应CVD是一种通过气相反应生成沉积物的CVD方法。
在气体相反应CVD中,反应物质通常是气体或蒸汽态的化合物,通过在反应室中混合反应,生成所需的沉积物。
这种方法适用于制备高纯度、均匀性好的材料。
五、原子层沉积(Atomic Layer Deposition,ALD)原子层沉积是一种一层一层生长材料的CVD方法。
在ALD中,反应物质在基底表面以交替的方式进行反应,每一层都是通过逐个原子的沉积形成的。

化学气相沉积CVD设备种类特点及应用领域化学气相沉积(Chemical Vapor Deposition,CVD)是一种常用的薄膜制备方法,通过反应气体在高温条件下直接在基底表面生成固态产物。
CVD设备根据不同的工艺条件、反应策略和基底材料可以分为多种类型,每种设备都有其独特的特点和应用领域。
1. 热CVD设备(Thermal CVD)热CVD设备是最早被广泛应用的CVD方法之一、该方法通过在高温下热分解反应气体从而生成固态沉积物。
热CVD设备可以分为低压热CVD、大气压热CVD和液相热CVD等。
热CVD设备适用于制备金属、合金、氧化物和硅等材料,并广泛应用于电子器件、光电器件、化学传感器和纳米材料等领域。
2. 感应耦合等离子体增强CVD设备(Inductively Coupled Plasma Enhanced CVD,ICPECVD)ICPECVD设备利用感应耦合等离子体的高能量电子和离子来激发反应气体分子并增强反应速率,从而实现高质量、高速度的薄膜沉积。
该方法具有高沉积速率和低制备温度的优势,适用于制备金属、合金、氧化物、氮化物和碳化物等材料,并广泛应用于半导体器件、涂层和光学薄膜等领域。
3. 低压化学气相沉积设备(Low Pressure Chemical Vapor Deposition,LPCVD)LPCVD设备以低压和较低的温度进行气相反应,利用热分解或化学反应生成固态沉积物。
LPCVD设备适用于制备金属、合金、氧化物、硅和碳等材料,并广泛应用于半导体器件、光电器件和太阳能电池等领域。
4. 金属有机化学气相沉积设备(Metal-Organic Chemical Vapor Deposition,MOCVD)MOCVD设备利用金属有机前体和气相反应生成金属、合金、氮化物、磷化物和砷化物等复杂化合物,以制备高质量的光电器件材料。
MOCVD设备适用于制备光电材料、半导体器件和光学薄膜等领域。


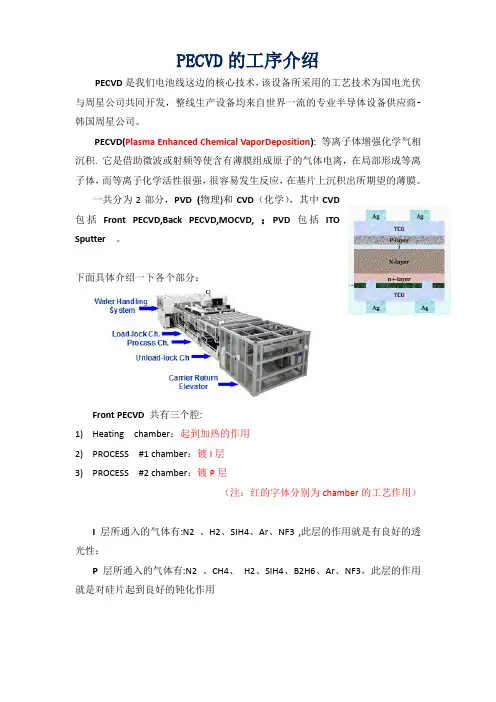
PECVD的工序介绍PECVD是我们电池线这边的核心技术,该设备所采用的工艺技术为国电光伏与周星公司共同开发,整线生产设备均来自世界一流的专业半导体设备供应商-韩国周星公司。
PECVD(Plasma Enhanced Chemical VaporDeposition): 等离子体增强化学气相沉积. 它是借助微波或射频等使含有薄膜组成原子的气体电离,在局部形成等离子体,而等离子化学活性很强,很容易发生反应,在基片上沉积出所期望的薄膜。
一共分为2部分,PVD (物理)和CVD(化学),其中CVD包括Front PECVD,Back PECVD,MOCVD, ;PVD包括ITOSputter 。
下面具体介绍一下各个部分:Front PECVD共有三个腔:1)Heating chamber:起到加热的作用2)PROCESS #1 chamber:镀I层3)PROCESS #2 chamber:镀P层(注:红的字体分别为chamber的工艺作用)I 层所通入的气体有:N2 、H2、SIH4、Ar、NF3 ,此层的作用就是有良好的透光性;P层所通入的气体有:N2 、CH4、H2、SIH4、B2H6、Ar、NF3,此层的作用就是对硅片起到良好的钝化作用1.1各腔室的temperature、RF、pressure温度(度)RF(W)压力(Torr) LC 250PM1 220 2000 1PM2 220 3500 11.2工艺腔所通入的气体和流量(单位sccm)GAS N2 H2 SIH4 B2H6 CH4 PM1 12000 1500 6PM2 10000 1500 4000ITO Sputter共有七个chamber:1)Heating chamber:加热腔2)TRANSFER HEARTING chamber:传输加热腔3)PROCESS #1 chamber:工艺腔14)PROCESS #2 chamber:工艺腔25)EXIT transfer chamber:冷却缓冲腔6)COOLING BUFFER chamber:冷却腔7)Unloading Chamber:下料(注:红的字体分别为chamber的工艺作用)ITO是在真空条件下采用低电压大电流,电离Ar得到Ar+轰击靶材沉积氧化铟和氧化锡,形成透明导电薄膜。

CVD技术化学气相淀积(chemicalvapordeposition)是通过气态物质的化学反应在衬底上淀积一层薄膜材料的过程cvd技术特点:它具有沉积温度低、薄膜成分和厚度易于控制、均匀性和重复性好、台阶覆盖率好、适用范围广、设备简单等一系列优点cvd方法几乎可以淀积集成电路工艺中所需要的各种薄膜,例如掺杂或不掺杂的sio2、多晶硅、非晶硅、氮化硅、金属(钨、钼)等常见的CVD技术包括:(1)常压化学气相淀积(apcvd);(2)低压化w气相淀积(lpcvd);(3)等离子增强化w气相淀积(pecvd)常见的CVD薄膜包括二氧化硅(通常直接称为氧化层)、氮化硅、多晶硅难熔金属及其硅化物常压化学汽相淀积(npcvd)(normalpressurecvd)大气压化学气相沉积(APCVD/npcvd)是一种在大气压下进行化学气相沉积的方法,是化学气相沉积的最初方法。
该工艺所需系统简单,反应速度快,沉积速率可达1000a/min以上,特别适用于介质沉积,但缺点是均匀性差。
因此,APCVD通常用于厚介质沉积。
npcvd为最简单的cvd法,使用于各种领域中。
其一般装置是由(1)输送反应气体至反应炉的载气体精密装置;(2)使反应气体原料气化的反应气体气化室;(3)反应炉;(4)反应后的气体回收装置等所构成。
其中中心部分为反应炉,炉的形式可分为四个种类,这些装置中重点为如何将反应气体均匀送入,故需在反应气体的流动与基板位置上用心改进。
当为水平时,则基板倾斜;当为纵型时,着反应气体由中心吹出,且使基板夹具回转。
而汽缸型亦可同时收容多数基板且使夹具旋转。
为扩散炉型时,在基板的上游加有混和气体使成乱流的装置。
低压化学气相沉积(LPCVD)随着半导体工艺特征尺寸的减小,对薄膜的均匀性要求及膜厚的误差要求不断提高,出现了低压化学气相淀积(lpcvd)。
低压化学气相淀积是指系统工作在较低的压强下的一种化学气相淀积的方法。

化学气相沉积1 前言化学气相沉积CVD(Chemical Vapor Deposition)是利用加热,等离子体激励或光辐射等方法,使气态或蒸汽状态的化学物质发生反应并以原子态沉积在置于适当位置的衬底上,从而形成所需要的固态薄膜或涂层的过程。
一般地说,化学气相沉积可以采用加热的方法获取活化能,这需要在较高的温度下进行;也可以采用等离子体激发或激光辐射等方法获取活化能,使沉积在较低的温度下进行。
另外,在工艺性质上,由于化学气相沉积是原子尺度内的粒子堆积,因而可以在很宽的范围内控制所制备薄膜的化学计量比;同时通过控制涂层化学成分的变化,可以制备梯度功能材料或得到多层涂层。
在工艺过程中,化学气相沉积常常在开放的非平衡状态下进行,根据耗散结构理论,利用化学气相沉积可以获得多种晶体结构。
在工艺材料上,化学气相沉积涵盖无机、有机金属及有机化合物,几乎可以制备所有的金属(包括碳和硅),非金属及其化合物(碳化物、氮化物、氧化物、金属间化合物等等)沉积层。
另外,由于气态原子或分子具有较大的转动动能,可以在深孔、阶梯、洼面或其他形状复杂的衬底及颗粒材料上进行沉积。
为使沉积层达到所需要的性能,对气相反应必须精确控制。
正是由于化学气相沉积在活化方式、涂层材料、涂层结构方面的多样性以及涂层纯度高工艺简单容易进行等一系列的特点,化学气相沉积成为一种非常灵活、应用极为广泛的工艺方法,可以用来制备各种涂层、粉末、纤维和成型元器件。
特别在半导体材料的生产方面,化学气相沉积的外延生长显示出与其他外延方法(如分子束外延、液相外延)无与伦比的优越性,即使在化学性质完全不同的衬底上,利用化学气相沉积也能产生出晶格常数与衬底匹配良好的外延薄膜。
此外,利用化学气相沉积还可生产耐磨、耐蚀、抗氧化、抗冲蚀等功能涂层。
在超大规模集成电路中很多薄膜都是采用CVD方法制备。
经过CVD 处理后,表面处理膜密着性约提高30%,防止高强力钢的弯曲,拉伸等成形时产生的刮痕。


化学气相沉积1 前言化学气相沉积CVD(Chemical Vapor Deposition)是利用加热,等离子体激励或光辐射等方法,使气态或蒸汽状态的化学物质发生反应并以原子态沉积在置于适当位置的衬底上,从而形成所需要的固态薄膜或涂层的过程。
一般地说,化学气相沉积可以采用加热的方法获取活化能,这需要在较高的温度下进行;也可以采用等离子体激发或激光辐射等方法获取活化能,使沉积在较低的温度下进行。
另外,在工艺性质上,由于化学气相沉积是原子尺度内的粒子堆积,因而可以在很宽的范围内控制所制备薄膜的化学计量比;同时通过控制涂层化学成分的变化,可以制备梯度功能材料或得到多层涂层。
在工艺过程中,化学气相沉积常常在开放的非平衡状态下进行,根据耗散结构理论,利用化学气相沉积可以获得多种晶体结构。
在工艺材料上,化学气相沉积涵盖无机、有机金属及有机化合物,几乎可以制备所有的金属(包括碳和硅),非金属及其化合物(碳化物、氮化物、氧化物、金属间化合物等等)沉积层。
另外,由于气态原子或分子具有较大的转动动能,可以在深孔、阶梯、洼面或其他形状复杂的衬底及颗粒材料上进行沉积。
为使沉积层达到所需要的性能,对气相反应必须精确控制。
正是由于化学气相沉积在活化方式、涂层材料、涂层结构方面的多样性以及涂层纯度高工艺简单容易进行等一系列的特点,化学气相沉积成为一种非常灵活、应用极为广泛的工艺方法,可以用来制备各种涂层、粉末、纤维和成型元器件。
特别在半导体材料的生产方面,化学气相沉积的外延生长显示出与其他外延方法(如分子束外延、液相外延)无与伦比的优越性,即使在化学性质完全不同的衬底上,利用化学气相沉积也能产生出晶格常数与衬底匹配良好的外延薄膜。
此外,利用化学气相沉积还可生产耐磨、耐蚀、抗氧化、抗冲蚀等功能涂层。
在超大规模集成电路中很多薄膜都是采用CVD方法制备。
经过CVD 处理后,表面处理膜密着性约提高30%,防止高强力钢的弯曲,拉伸等成形时产生的刮痕。
各种化学气相沉积技术的工作原理及优缺点各种化学气相沉积技术的工作原理及优缺点如下:化学气相沉积技术(CVD)是一种常用的材料制备和表面处理方法,其工作原理是利用气态的化学反应来合成固态的物质。
下面介绍几种常见的化学气相沉积技术。
1. 常压化学气相沉积(APCVD)工作原理:常压化学气相沉积是在常压下,将反应气体引入到加热的基体表面,通过热分解和化学反应来形成固态沉积物。
优点:沉积温度低,可沉积大面积的均匀涂层。
缺点:需要较高的温度和较长的沉积时间,基体材料受热可能发生氧化或结构变化。
2. 低压化学气相沉积(LPCVD)工作原理:低压化学气相沉积是在较低的压力下,将反应气体引入到加热的基体表面,通过热分解和化学反应来形成固态沉积物。
优点:可在较低的温度和较短的沉积时间内获得高质量的涂层。
缺点:需要高真空设备和较高的投资成本。
3. 等离子体增强化学气相沉积(PECVD)工作原理:等离子体增强化学气相沉积是利用辉光放电等离子体来增强气态反应的活性,使反应气体在较低的温度下也能发生化学反应形成固态沉积物。
优点:可在较低的温度下进行沉积,适用于各种材料的表面处理和涂层制备。
缺点:需要特殊的电源和控制设备,且沉积速率较低。
4. 激光化学气相沉积(LCVD)工作原理:激光化学气相沉积是利用激光诱导的气态反应来形成固态沉积物。
通过将激光束聚焦到基体表面,使局部区域快速加热并引发气态化学反应。
优点:可实现快速、高精度和局部化的沉积,适用于复杂形状和微细结构的制备。
缺点:需要高能激光器和精密的光学系统,且对基体材料的导热性能要求较高。
5. 金属有机化学气相沉积(MOCVD)工作原理:金属有机化学气相沉积是利用金属有机化合物作为反应气体,通过热分解和化学反应来形成金属或其化合物的固态沉积物。
优点:可制备高纯度、高附着力的金属或合金涂层,适用于电子、光学和催化等领域。
缺点:需要严格控制工艺条件,如温度、压力和气体流量等,且对操作人员的健康有一定危害。
CVDCVD(Chemical Vapor Deposition)原理CVD(Chemical Vapor Deposition,化学气相沉积),指把含有构成薄膜元素的气态反应剂或液态反应剂的蒸气及反应所需其它气体引入反应室,在衬底表面发生化学反应生成薄膜的过程。
在超大规模集成电路中很多薄膜都是采用CVD方法制备。
经过CVD处理后,表面处理膜密着性约提高30%,防止高强力钢的弯曲,拉伸等成形时产生的刮痕。
CVD特点淀积温度低,薄膜成份易控,膜厚与淀积时间成正比,均匀性,重复性好,台阶覆盖性优良。
CVD制备的必要条件1)在沉积温度下,反应物具有足够的蒸气压,并能以适当的速度被引入反应室;2)反应产物除了形成固态薄膜物质外,都必须是挥发性的;3)沉积薄膜和基体材料必须具有足够低的蒸气压。
编辑本段何为cvd?CVD是Chemical Vapor Deposition的简称,是指高温下的气相反应,例如,金属卤化物、有机金属、碳氢化合物等的热分解,氢还原或使它的混合气体在高温下发生化学反应以析出金属、氧化物、碳化物等无机材料的方法。
这种技术最初是作为涂层的手段而开发的,但目前,不只应用于耐热物质的涂层,而且应用于高纯度金属的精制、粉末合成、半导体薄膜等,是一个颇具特征的技术领域。
其技术特征在于:⑴高熔点物质能够在低温下合成;⑵析出物质的形态在单晶、多晶、晶须、粉末、薄膜等多种;⑶不仅可以在基片上进行涂层,而且可以在粉体表面涂层,等。
特别是在低温下可以合成高熔点物质,在节能方面做出了贡献,作为一种新技术是大有前途的。
例如,在1000℃左右可以合成a-Al2O3、SiC,而且正向更低温度发展。
CVD工艺大体分为二种:一种是使金属卤化物与含碳、氮、硼等的化合物进行气相反应;另一种是使加热基体表面的原料气体发生热分解。
CVD的装置由气化部分、载气精练部分、反应部分和排除气体处理部分所构成。
目前,正在开发批量生产的新装置。
十一种化学气相沉积(CVD)技术盘点CVD(化学气相沉积)是半导体工业中应用最为广泛的用来沉积多种材料的技术,包括大范围的绝缘材料,大多数金属材料和金属合金材料。
从理论上来说,它是很简单的:两种或两种以上的气态原材料导入到一个反应室内,然后他们相互之间发生化学反应,形成一种新的材料,沉积到晶片表面上。
淀积氮化硅膜(Si3N4)就是一个很好的例子,它是由硅烷和氮反应形成的。
化学气相沉积法是传统的制备薄膜的技术,其原理是利用气态的先驱反应物,通过原子、分子间化学反应,使得气态前驱体中的某些成分分解,而在基体上形成薄膜。
化学气相沉积包括常压化学气相沉积、等离子体辅助化学沉积、激光辅助化学沉积、金属有机化合物沉积等。
不过随着技术的发展,CVD技术也不断推陈出新,出现了很多针对某几种用途的专门技术,在此特为大家盘点介绍一些CVD技术。
等离子体增强化学气相沉积(PECVD)等离子体增强化学气相沉积是在化学气相沉积中,激发气体,使其产生低温等离子体,增强反应物质的化学活性,从而进行外延的一种方法。
该方法可在较低温度下形成固体膜。
例如在一个反应室内将基体材料置于阴极上,通入反应气体至较低气压(1~600Pa),基体保持一定温度,以某种方式产生辉光放电,基体表面附近气体电离,反应气体得到活化,同时基体表面产生阴极溅射,从而提高了表面活性。
在表面上不仅存在着通常的热化学反应,还存在着复杂的等离子体化学反应。
沉积膜就是在这两种化学反应的共同作用下形成的。
激发辉光放电的方法主要有:射频激发,直流高压激发,脉冲激发和微波激发。
等离子体增强化学气相沉积的主要优点是沉积温度低,对基体的结构和物理性质影响小;膜的厚度及成分均匀性好;膜组织致密、针孔少;膜层的附着力强;应用范围广,可制备各种金属膜、无机膜和有机膜。
高密度等离子体化学气相淀积(HDP CVD)HDP-CVD 是一种利用电感耦合等离子体(ICP)源的化学气相沉积设备,是一种越来越受欢迎的等离子体沉积设备。
CVDCVD(Chemical Vapor Deposition)原理CVD(Chemical Vapor Deposition,化学气相沉积),指把含有构成薄膜元素的气态反应剂或液态反应剂的蒸气及反应所需其它气体引入反应室,在衬底表面发生化学反应生成薄膜的过程。
在超大规模集成电路中很多薄膜都是采用CVD方法制备。
经过CVD处理后,表面处理膜密着性约提高30%,防止高强力钢的弯曲,拉伸等成形时产生的刮痕。
CVD特点淀积温度低,薄膜成份易控,膜厚与淀积时间成正比,均匀性,重复性好,台阶覆盖性优良。
CVD制备的必要条件1)在沉积温度下,反应物具有足够的蒸气压,并能以适当的速度被引入反应室;2)反应产物除了形成固态薄膜物质外,都必须是挥发性的;3)沉积薄膜和基体材料必须具有足够低的蒸气压。
编辑本段何为cvd?CVD是Chemical Vapor Deposition的简称,是指高温下的气相反应,例如,金属卤化物、有机金属、碳氢化合物等的热分解,氢还原或使它的混合气体在高温下发生化学反应以析出金属、氧化物、碳化物等无机材料的方法。
这种技术最初是作为涂层的手段而开发的,但目前,不只应用于耐热物质的涂层,而且应用于高纯度金属的精制、粉末合成、半导体薄膜等,是一个颇具特征的技术领域。
其技术特征在于:⑴高熔点物质能够在低温下合成;⑵析出物质的形态在单晶、多晶、晶须、粉末、薄膜等多种;⑶不仅可以在基片上进行涂层,而且可以在粉体表面涂层,等。
特别是在低温下可以合成高熔点物质,在节能方面做出了贡献,作为一种新技术是大有前途的。
例如,在1000℃左右可以合成a-Al2O3、SiC,而且正向更低温度发展。
CVD工艺大体分为二种:一种是使金属卤化物与含碳、氮、硼等的化合物进行气相反应;另一种是使加热基体表面的原料气体发生热分解。
CVD的装置由气化部分、载气精练部分、反应部分和排除气体处理部分所构成。
目前,正在开发批量生产的新装置。
CVD是在含有原料气体、通过反应产生的副生气体、载气等多成分系气相中进行的,因而,当被覆涂层时,在加热基体与流体的边界上形成扩散层,该层的存在,对于涂层的致密度有很大影响。
图2所示是这种扩散层的示意图。
这样,由许多化学分子形成的扩散层虽然存在,但其析出过程是复杂的。
粉体合成时,核的生成与成长的控制是工艺的重点。
作为新的CVD技术,有以下几种:⑴采用流动层的CVD;⑵流体床;⑶热解射流;⑷等离子体CVD;⑸真空CVD,等。
应用流动层的CVD如图3所示,可以形成被覆粒子(例如,在UO2表面被覆SiC、C),应用等离子体的CVD同样也有可能在低温下析出,而且这种可能性正在进一步扩大。
PECVDPECVD ( Plasma Enhanced Chemical Vapor Deposition ) -- 等离子体增强化学气相沉积法PECVD:是借助微波或射频等使含有薄膜组成原子的气体电离,在局部形成等离子体,而等离子体化学活性很强,很容易发生反应,在基片上沉积出所期望的薄膜。
为了使化学反应能在较低的温度下进行,利用了等离子体的活性来促进反应,因而这种CVD称为等离子体增强化学气相沉积(PECVD). 实验机理:是借助微波或射频等使含有薄膜组成原子的气体,在局部形成等离子体,而等离子体化学活性很强,很容易发生反应,在基片上沉积出所期望的薄膜。
优点:基本温度低;沉积速率快;成膜质量好,针孔较少,不易龟裂。
缺点如下: 1.设备投资大、成本高,对气体的纯度要求高; 2.涂层过程中产生的剧烈噪音、强光辐射、有害气体、金属蒸汽粉尘等对人体有害; 3.对小孔孔径内表面难以涂层等。
例子:在PECVD工艺中由于等离子体中高速运动的电子撞击到中性的反应气体分子,就会使中性反应气体分子变成碎片或处于激活的状态容易发生反应。
衬底温度通常保持在350℃左右就可以得到良好的SiOx或SiNx薄膜,可以作为集成电路最后的钝化保护层,提高集成电路的可靠性。
几种PECVD装置图(a)是一种最简单的电感耦合产生等离子体的PECVD装置,可以在实验室中使用。
图b)它是一种平行板结构装置。
衬底放在具有温控装置的下面平板上,压强通常保持在133Pa左右,射频电压加在上下平行板之间,于是在上下平板间就会出现电容耦合式的气体放电,并产生等离子体。
图(c)是一种扩散炉内放置若干平行板、由电容式放电产生等离子体的PECVD装置。
它的设计主要为了配合工厂生产的需要,增加炉产量。
MOCVDMOCVD是在气相外延生长(VPE)的基础上发展起来的一种新型气相外延生长技术。
缩写Metal-organic Chemical Vapor Deposition (金属有机化合物化学气相沉淀。
原理MOCVD是以Ⅲ族、Ⅱ族元素的有机化合物和V、Ⅵ族元素的氢化物等作为晶体生长源材料,以热分解反应方式在衬底上进行气相外延,生长各种Ⅲ-V族、Ⅱ-Ⅵ族化合物半导体以及它们的多元固溶体的薄层单晶材料。
通常MOCVD系统中的晶体生长都是在常压或低压(10-100Torr)下通H2的冷壁石英(不锈钢)反应室中进行,衬底温度为500-1200℃,用射频感应加热石墨基座(衬底基片在石墨基座上方),H2通过温度可控的液体源鼓泡携带金属有机物到生长区。
编辑本段概况系统组成因为MOCVD生长使用的源是易燃、易爆、毒性很大的物质,并且要生长多组分、大面积、薄层和超薄层异质材料。
因此在MOCVD系统的设计思想上,通常要考虑系统密封性,流量、温度控制要精确,组分变换要迅速,系统要紧凑等。
不同厂家和研究者所产生或组装的MOCVD设备是不同的。
一般由源供给系统、气体输运和流量控制系统、反应室及温度控制系统、尾气处理及安全防护报警系统、自动操作及电控系统。
【源供给系统】包括Ⅲ族金属有机化合物、V族氢化物及掺杂源的供给。
金属有机化合物装在特制的不锈刚的鼓泡器中,由通入的高纯H2携带输运到反应室。
为了保证金属有机化合物有恒定的蒸汽压,源瓶置入电子恒温器中,温度控制精度可达0.2℃以下。
氢化物一般是经高纯H2稀释到浓度5%一10%后,装入钢瓶中,使用时再用高纯H2稀释到所需浓度后,输运到反应室。
掺杂源有两类,一类是金属有机化合物,另一类是氢化物,其输运方法分别与金属有机化合物源和氢化物源的输运相同。
【气体输运系统】气体的输运管都是不锈钢管道。
为了防止存储效应,管内进行了电解抛光。
管道的接头用氢弧焊或VCR及Swagelok 方式连接,并进行正压检漏及Snoop液体或He泄漏检测,保证反应系统无泄漏是MOCVD 设备组装的关键之一。
流量是由不同量程、响应时间快、精度高的质量流量计和电磁阀、气动阀等来实现。
在真空系统与反应室之间设有过滤器,以防油污或其它颗粒倒吸到反应室中。
为了迅速变化反应室内的反应气体,而且不引起反应室内压力的变化,设置“run”和“vent,,管道。
【反应室和加热系统】反应室是由石英管和石墨基座组成。
为了生长组分均匀、超薄层、异质结构的化合物半导体材料,各生产厂家和研究者在反应室结构的设计上下了很大功夫,设计出了不同结构的反应室。
石墨基座是由高纯石墨制成,并包裹SIC层。
加热多采用高频感应加热,少数是辐射加热。
由热电偶和温度控制器来控制温度,一般温度控制精度可达到0.2℃或更低。
【尾气处理系统】反应气体经反应室后大部分热分解,但还有部分尚未完全分解,因此尾气不能直接排放到大气中,必须先进行处理,处理方法主要有高温热解炉再一次热分解,再用硅油或高锰酸钾溶液处理;也可以把尾气直接通入装有H2SO4+H2O及装有NaOH溶液的吸滤瓶处理;也有的把尾气通入固体吸附剂中吸附处理,以及用水淋洗尾气等。
【安全保护及报警系统】为了安全,一般的MOCVD系统还备有高纯从旁路系统,在断电或其它原因引起的不能正常工作时,通入纯N2保护生长的片子或系统内的清洁。
在停止生长期间也有常通高纯N2保护系统。
【手动和自动控制系统】一般MOCVD设备都具有手动和微机自动控制操作两种功能。
在控制系统面板上设有阀门开关、各个管路气体流量、温度的设定及数字显示,如有问题会自动报警,是操作者能及时了解设备运转的情况。
此外,MOCVD设备一般都设在具有强排风的工作室内。
优点1 适用范围广泛,几乎可以生长所有化合物及合金半导体;2 非常适合于生长各种异质结构材料;3 可以生长超薄外延层,并能获得很陡的界面过渡;4 生长易于控制;5 可以生长纯度很高的材料;6 外延层大面积均匀性良好;7 可以进行大规模生产。
目前全球及国内的MOCVD系统随着化合物半导体器件(如GaAs MMIC、InP MMIC以及GaN蓝光LED)市场的不断扩大,MOCVD系统的需求量不断增长。
目前国际上实力最为雄厚的MOCVD系统制造商有:德国Aixtron公司、美国的Emcore公司(其MOCVD已被Veeco兼并)、英国的Thomass~(1999年被Aixtron兼并)等。
因为MOCVD系统最关键的问题就是保证材料生长的均匀性和重复性,因此不同厂家的MOCVD系统最主要的区别在于反应室结构。
Aixtron采用行星反应(Planetary Reactor),Emcore采用TurboDisc反应室(该业务己出售给Veeco公司)、Thomas Swan(该公司于2003年2月份被Aixtron兼并)采用Closed Coupled Showerhead(CCS)反应室。
目前国内拥有的进口MOCVD系统700台左右,其中Aixtron MOCVD系统和Emcore MOCVD系统占绝大多数,有少量的Thomas Swan MOCVD系统、法国ASM MOCVD系统和日本RIPPON SANSO MOCVD系统,主要用于GaN LD/LED的研究和制造。