
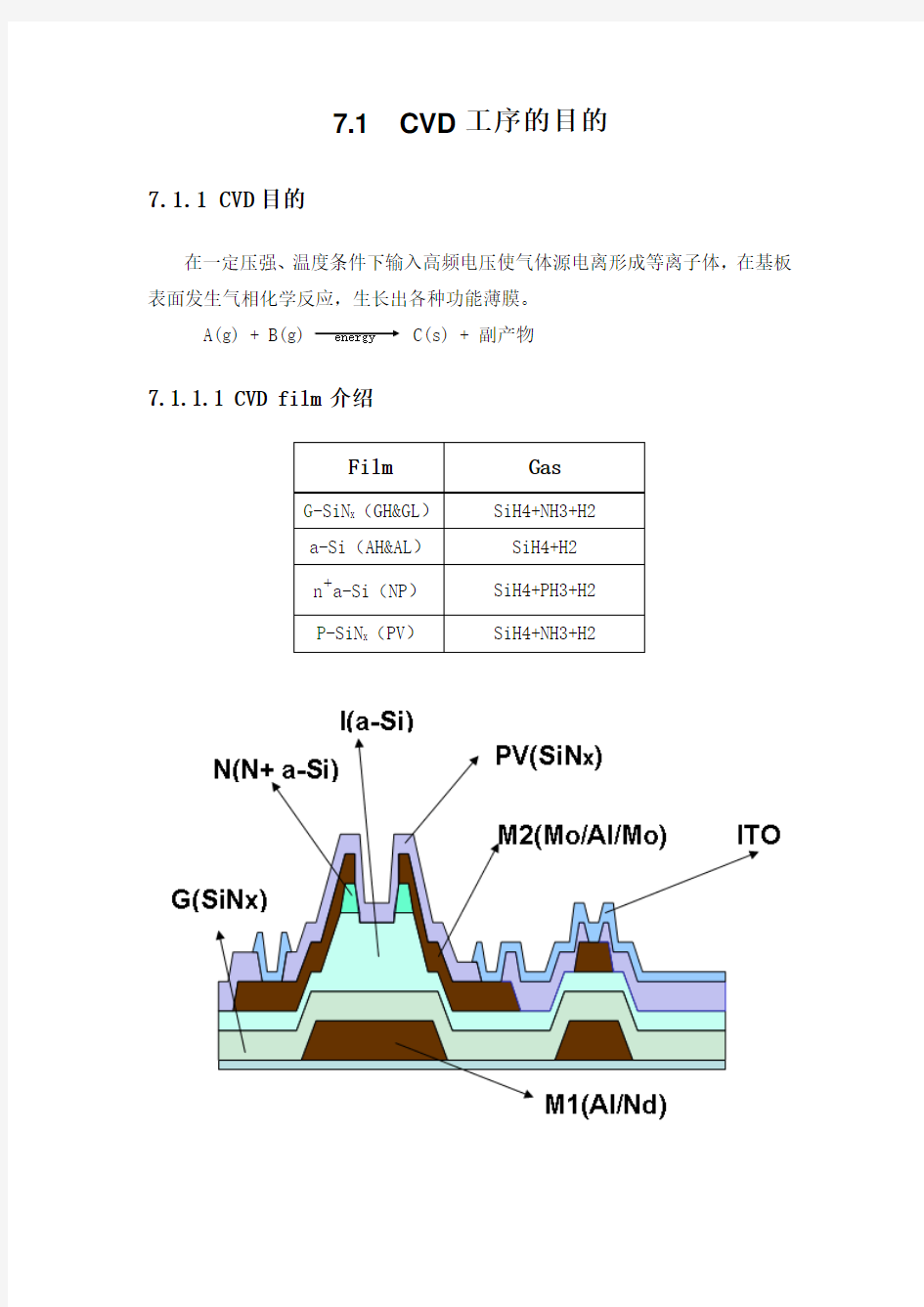
第七章CVD工序7.1 CVD工序的目的
7.2 CVD工艺的基本原理
7.3 CVD的设备构成和主要性能指标
7.4 CVD 工序的主要工艺参数和工艺质量评价7.5特种气体供应管理系统
7.1 CVD工序的目的
7.1.1 CVD目的
在一定压强、温度条件下输入高频电压使气体源电离形成等离子体,在基板表面发生气相化学反应,生长出各种功能薄膜。
A(g) + B(g) energy C(s) + 副产物
7.1.1.1 CVD film介绍
7.1.1.2各层薄膜的功能
1. G: Gate SiNx (绝缘层)
作用:防止M1与I层导通
2. a-Si (半导体)
作用:导通层,电子在该层产生
3. N: N+ a-Si (掺杂半导体)
作用:降低界面电位差,降低I层与M2之间的电位差
4. Passivation (保护层)
作用:该层的作用是保护M2,防止其发生氧化,腐蚀7.1.1.3生成各层的化学反应原理
(1)SiN X:H
SiH4 + NH3 + N2 → SiN X: H (2)a-Si:H
SiH4 + H2 → a-Si:H
(3)n+a-Si:H
SiH4 + PH3 + H2 →n+a-Si:H
7.2 CVD工艺的基本原理
通过前一章节的学习,我们应该对CVD的功能有了一定的了解,其实自从CVD镀膜技术被发现至今,已经得到了很大的发展,已经衍生出许多不同类型的CVD成膜方式。
按反应室内压力分:
APCVD: Atmospheric pressure CVD
SACVD: Sub Atmospheric pressure CVD
LPCVD: Low Pressure CVD
ULPCVD: Ultra-low pressure CVD
UHV_CVD: Ultra-high vacuum CVD
按能量供给方式分:
热活化式:Thermally-activated CVD
等离子辅助式:Plasma Enhanced CVD (PE-CVD)
射频方式:(Radio Frequency CVD RFCVD)
微波方式:(Microwave CVD)
电子回旋共振式:(Electron Cyclotron Resonance CVD)
引控式(Remote PCVD)
磁控式(Magnetic PCVD)
光辅助式:Photo-assisted CVD
雷射辅助式:Laser-induce CVD
下面将就PECVD系统构造、原理及特征等内容进行详细的说明,其他种类的CVD镀膜方式本节不做赘述:
PECVD技术是上世纪70年代初发展起来的新工艺,主要是为了适应现代半导体工业的发展,制取优质介质膜。现代科技对半导体器件的可靠性和稳定性要求越来越高,为了防止器件制造过程中的表面玷污,必须进行表面钝化,用PECVD 法制备的钝化膜的沉积实在低温下(200~400℃)进行的,钝化效果好,失效时间长,具有良好的热学和化学稳定性。80年代末随着TFT-LCD产业的兴起,PECVD
技术在低温,大面积镀膜方向上具备其他CVD镀膜无可比拟的优势,进一步推进了平板显示业的发展,更新,基板尺寸更大的生产线被制造出来。平板显示产业也得以发生了革命性的变化。
7.2.1 等离子体增强型化学气相沉积系统(PECVD)
为了适应低温、大面积镀膜的需求,PECVD技术被越来越多地应用于TFT-LCD 制造领域中。PECVD的沉积原理与一般的CVD之间没有太大的差异,电浆中的反应物是化学活性较高的离子或自由基,而且基板表面受到离子的撞击也会使得化学活性提高。这两项因素都可促进基板表面的化学反应速率,因此在较低的温度下可沉积薄膜。
PECVD乃是在真空中,导入反应气体而使用高频产生电浆与平行板电极之间,此时所产生的反应自由基将传达至基板表面,并产生表面反应而将其堆积成薄膜,所使用之原料气体为SiH4、PH3、NH3、H2等。通常基板是接地之阳极配置,在350℃温度以下可于大面积领域上,成长均匀的薄膜,而且可使用于大型薄板玻璃基板之非晶硅薄膜电晶体的制程,以便获得良好的整合性。
在LCD领域应用最广泛的还是RF-PECVD系统。从1世代的in-line生产线、batch-type生产线到目前已投入运营的8世代Cluster生产线,以及正在研制的更高世代的生产线,PECVD设备制造也得到了长足的进步。
图7.2.1展示的是in-line设备的机构示意图,及成膜室的基本构造。In-line 设备是最早应用于tft-lcd制造的生产线类型,基板成膜时竖立在腔室内,膜内不易产生particle。生产节拍较长,随着基板尺寸的不断增加,in-line设备渐渐被其他类型的设备所取代。
图7.2.1 in-line type PECVD system
图7.2.2展示的是batch type类型的PECVD结构示意图及成膜腔室的基本构造,采用这种设备的优点是可同时对多片基板进行镀膜,产量大,但从镀膜的均匀性上看不如单片式成膜设备。
7.2.2 Batch type PECVD system
图7.2.3展示的是cluster类型的生产线结构示意图及成膜腔室的基本结构,这种结构的PECVD系统,目前应用最广泛。5世代以上的lcd厂家几乎都采用这种结构的设备。这种设备的优点是采用单片成膜方式,各成膜腔室共用一个传输腔室,却又各自独立,当任意一个成膜腔室出现故障时,其他腔室不受影响。成膜质量较好,但膜内容易残留particle,镀膜达到一定数量后,需要应用RPSC (Remote Plasma Source Clean)对腔室进行清洗,以实现降低particle的目的。
图7.2.3 Cluster type PECVD system
7.2.2 PECVD 的原理及特征
PECVD借助于气体辉光放电产生的低温等离子体,增强了反应物质的化学活性,促进了气体间的化学反应,从而低温下也能在基板上形成新的固体膜。其反应机理如图7.2.4所示
图7.2.4 化学气相沉积反应机理
从图中可以看出,一般的CVD反应大致可分为以下几个步骤:
(1)反应气体分子由主气流 (Main Stream) 带至反应区域 (基板)附近;
(2)反应气体分子因浓度差而扩散并穿越边界层 (Boundary Layer);
(3)反应气体分子吸附(Absorption)在基板表面;
(4) 化学沉积反应发生
------- 沉积膜及副产物 (By-Products);
(5)副产物及剩余气体吸解 (Adsorption) 离开基板表面,副产物及剩余气体穿越边界层,副产物及剩余气体进入主气流,并由真空系统抽离。
图7.2.5是PECVD装置的示意图,将玻璃基板置于低气压辉光放电的电极上,然后通入适量气体,在一定的温度下,利用化学反应和离子轰击相结合的过程,在玻璃基板表面上获得相应的功能薄膜。可见,其中包括一般化学气相沉积技术,;又有辉光放电的强化作用。
辉光放电是典型的自激放电现象。而这一种放电最主要的特征是从阴极到负辉区之前的一小段中场强很大,而在阴极暗区中,会发生比较强烈的气体电离。电离产生的气体离子发生阴极溅射,为沉积薄膜提供的清洁而活性高的表面。辉光放电的存在,使反应气氛得到活化,其中基本的活性粒子是离子和原子团,它们中电子-分子碰撞所产生,或通过固体表面离子、电子、光子的碰撞所产生。这些作用在提高膜层结合力、降低沉积温度、加快反应速度等方面都创造了有利的条件。
等离子由向低压气体的射频场在放电区产生自由电子而形成。电子从电场获得足够能量,于是它们与气体分子碰撞,反应气体气相分离和离子化发生。这些分子将分解成多种成份:离子、原子以及活性基团(激发态)。高能物质(主要是原子团)在膜表面被吸收。(注意原子团具有高黏附系数,被吸收后容易沿表面迁移,这两个因素可以产生优异的膜一致性。)在衬底吸附,它们就受到离子和电子的轰击,重排,与其他被吸附物质反应,新键形成,膜长成,生长。被吸附的原子重排包括被吸附原子向稳定位置扩散,同时排斥反应产物。排斥速率取决于衬底温度。注意避免气相成核以减少粒子玷污。PECVD膜总的来说,不是理想配比,因为淀积反应广泛而复杂。而且,副产品和偶然产生的物质结合进膜。这些玷污的进入可能导致放气和伴生的气泡、裂缝或在以后的热循环中剥落,以及MOS电路中阈电压的漂移。等离子工艺需要控制和优化包括射频功率密度、频率和占空比。淀积工艺非常复杂,相互独立地依赖这些参数和寻常参数如气体组成、流速、温度和压力。
与其他CVD成膜方式相比较,低温淀积是PECVD镀膜的一个突出的优点。一
般工作在250℃~400℃范围内就可以实现薄膜沉积。PECVD 不是仅仅热能启动和
维持化学反应,而是用了射频辉光放电把能量传给反应气体,允许衬底温度低于
普通CVD 工艺的温度。事实上,衬底在以其它方式覆盖时可能热稳定不够(最重
要的是在金属上形成氮化硅),PECVD 提供了一种在这种衬底上淀积膜的方法。
另外,与单独的热反应相比,PECVD 能提高淀积速率,制造有独特成分和特性的
膜。但PECVD 的缺点是容易会有微粒的污染,而且在薄膜中含有大量的氢原子。
图7.2.5 等离子体增强型化学气相沉积装置示意图
RF
7.3 CVD的设备构成和主要性能指标
7.3.1 PECVD 系统
主要构成:1. 卡匣自动装载站;2. 主机;3. 远程辅助系统 4.尾气处理系统7.3.1.1 卡匣自动装载站
卡匣自动装载站主要用于生产制程卡匣的存放,处于无尘室与主机之间的交界地带。卡匣自动装载站中大气机械手臂从卡匣取出未生产制程的玻璃输送到装载卸载腔室中,从装载卸载腔室取出生产制程的玻璃传送到卡匣。
7.3.1.2 主机
主机结构图
主机结构图
主要构成:
○1装载卸载腔室:主要用来装载和卸载玻璃的,是大气状态和真空状态的缓冲区。注意在玻璃被卸载时要先使其冷却下来。
○2工艺腔室:淀积成膜腔室。各个工艺腔室可以同时进行淀积。
○3加热腔室:在淀积成膜前,提前在此腔室加热处理。
○4传输腔室:真空状态下,真空机械手臂在此腔室之间传递玻璃。
○5气体面板:控制进入工艺腔室的气流量。
○6主体电源控制塔:主体部分电力分配,直流电供用,主体设备信号控制, 对腔室温度的控制。
7.3.1.3.1 工艺腔室
主要组成部分及功能:
○1RF Match:主要用来消除容抗和感抗得到纯正的阻抗,其值大约为50欧姆。○2Slit Valve:真空阀门,是控制工艺腔室与传输腔室之间的玻璃进出的阀门○3RPS II Plasma Cleaning:主要用来清洗工艺腔室的,平均每淀积6或12片玻璃就要清洗一次腔室。
○4Throttle Valve Pressure Controller:压力控制阀(碟伐),主要作用是控制腔室内压力。
○5Z-Drive:主要控制pin以及susceptor的升降。
工作流程图:
7.3.1.3.2 卸载装载腔室
主要组成部分及功能:
○1Loadlock Door:是ACLS与Loadlock之间的门。○2AC Motor:主要为底座的升降提供动力。
○3Linear Slide:主要为基座升降的提供轨道。
工作流程图:
7.3.1.3.3 传输腔室
主要组成部分及功能:
○
1Chamber Lid :传输腔体的密封盖。 ○
2Lid O -ring :对Chamber Lid 与Chamber Window 的连接起密封作用。 ○
3Chamber Window :主要用于观察传输腔中玻璃基板状态。 ○
4Window O -ring :对Chamber Body 与Chamber Window 的连接起密封作用。 ○
5End Effectors :是卸载装载玻璃的手臂。 ○
6Slit Valve :是传输腔室与各个腔室之间的阀门。 ○
7Vacuum Robot :主要为各个腔室间玻璃的传递。
7.3.1.3 远程辅助系统
主要组成:
○
1远程支持模块:控制传输腔室和转载卸载腔室泵系统,为主机和远控模组提供冷却水,压缩空气以及控制信号的中转传输。
○2高频发生器:工艺腔室的高频发生器,提供高频放电。
○3真空泵:保证工艺腔室具有制程所需要的真空度。
○4热交换器:冷却每个工艺腔室上面的匹配箱。(冷却液体为DI water)
7.3.1.4 尾气处理系统
7.3.1.4.1尾气处理系统简要介绍:
在制程过程中将不同类型的气体如有毒的、易燃的、可燃的和腐蚀性的气体处理为安全的气体,防止对人身造成伤害,同时进一步完全地处理可能造成空气污染和全球温室效应的物质。
特别地,对PECVD工艺来说,Heat-wet方式的尾气处理装置可以用来处理气体如硅烷、磷烷、氨气、三氟化氮、氢气等。易燃气体在加热室内处理,同时副产品和水溶性气体在湿式室内处理。
7.3.1.4.2 Heat-wet设备结构简要介绍:
Gas Outlet
Heat chamber:反应腔室,并且要求防腐蚀。
Quench: 冷却反应后的气体。
Wet Column: 用水处理可溶性的废气。
Dry system:减少废气的相对湿度,防止后段管路腐蚀和水凝结。
Waste water drain tank: 废水储存槽。
7.4 CVD 工序的主要工艺参数和工艺质量评价
PECVD淀积薄膜的组分和结构往往取决于PECVD工艺的淀积条件,其中主要是衬底温度、气体流量和反应室气压、射频功率和频率、时间、板极间距等工艺参数。
7.4.1 CVD工序主要的工艺参数
7.4.1.1.衬底温度
PECVD淀积工艺中衬底温度对薄膜质量的影响主要在于局域态密度,电子迁移率以及薄膜的光学性质。
衬底温度的提高有助于薄膜淀积速率的加快,从而使薄膜表面悬挂键得到补偿,导致缺陷态密度下降,因此衬底温度的升高,有利于减少a-Si:H薄膜的局域态密度[1]。
但是,高的衬底温度并不意味着可以获得高质量的薄膜,高质量的薄膜还必须具备良好的光电性能。当衬底温度比较大时,尽管有利于电子漂移迁移率的增大,但是由于衬底温度的增大也会引起Si-H键的脱氢作用和H2的溢出,导致悬挂键密度的增加,影响光电流延迟及减小。
7.4.1.2 SiH4的气流量和反应室的压强
SiH4流量在PECVD制备a-Si:H过程中也是一个重要的工艺参数,它对淀积速率有着影响。SiH4流量在很大程度上决定了SiH4分子在等离子体中滞流的平均时间t,t的大小不仅对SiH4分子分解并结合到生长薄膜中去的几率起决定作用,而且还决定了等离子体中SiH4的耗尽情况,在其它淀积条件不变的情况下,t越长,SiH4的耗尽越充分,活性基团组态比例就越大,实验证明:SiH4流量增加,淀积速率将会增加,但如果SiH4流量过大时,会导致粉末产生[2]。
反应室气压不能太低也不能太高,如果气压过低,可能会影响薄膜的淀积机理,造成许多针状形态的缺陷,但气压过高时,等离子体的聚合反应明显增强,给薄膜造成不利影响,对淀积速率也有影响。
7.4.1.3 射频功率和频率
射频功率提高时,可以提高a-Si:H膜的淀积速率,但射频过大时,会导致淀积速率下降,因为射频过大,等离子体对衬底表面的轰击作用会使a-Si:H膜的生长速率下降,甚至会生成Si粉,使性能变坏。其二,射频功率提高.正离子动能将会增大,增加薄膜的损伤程度,从而使缺陷密度加大。另外射频功率的提高对薄膜折射率也存在影响。
射频频率主要影响a-Si:H薄膜的力学特性。实验证明[3],轰击在生长表面的离子总量为放电频率的函数,a-Si:H薄膜内应力的产生主要是由离子轰击所至,因此,PECVD放电频率的高低对存储在a-Si:H薄膜的内应力有很大影响。我们在PECVD制备a-Si:H薄膜时选用放电频率为13.56 MHz,此时的a-Si:H 薄膜内应力相应较小。内应力的增大会引入晶格缺陷,并且薄膜的机械完整性与应力大小密切相关,因此具备相对小的内应力也是获得高质量薄膜的必须条件之一。
7.4.1.4 时间
在其它条件确定之后,PECVD淀积的薄膜厚度主要就由淀积时间来控制,由于薄膜的厚度对其质量以及TFT的性能存在着不可忽视的影响,所以在PECVD 淀积工艺过程中,对于淀积时间的精确控制也是十分必要的。
7.4.1.5 板极间距
板极间距对淀积成膜有着非常重要的影响,间距不能太大也不能太小。如果间距太大,大大影响淀积速度,并造成particle问题,严重影响成膜质量。如果间距太小,从Show head出来的强气流直接喷到玻璃基板上,这样会造成以下可能后果:一是强气流直接冲击玻璃板面,离子可能来不及淀积就被强气流带走,这样就降低了成膜速率。二是因为间距太小,这样使得离子反应速度过快,即使离子没有被强气流带走而淀积到玻璃基板上,那么成膜的质量也是很差的,因为间距太小可能引起气相中的聚合反应(SiH4),从而引起颗粒的产生、成品率下降、组件可靠性降低等。三是板极过近会造成镀膜过程中arcing,击穿substrate 及susceptor表面阳极膜,造成设备损伤。所以要合理的控制板极的间距对成膜质量是非常重要的。
7.4.2 工艺质量评价参数
7.4.2.1 膜厚
膜层的厚度对于器件也有着十分显着的影响[4],经研究表明[5],适当减薄有源层厚度,将有利于关态电流的减小,提高通断电流比。但减薄超过一定的限度后通态电流也会随着显著减小,对器件造成很坏的影响,因此有源层的减薄是有一定限度的;a-Si:H薄膜厚度的减薄,还会影响TFT的平带电压,从而影响TFT 的阈值电压。
附:膜厚检测设备
主要设备有:
(1)椭圆偏振光谱仪(SE):其中还包括了应力测试仪(stress)和傅立叶红外光谱仪(FTIR)两个附加设备.
(2)分光反射仪((SR)
目的:
无论是SE还是SR,都是利用一定的光学原理来非接触性地测量薄膜的厚度、组分及其它性能的。他们的应用范围包括了:PECVD、ITO、光刻胶、有机膜等,可测试它们的膜厚、光学常数(如折射率n、吸收系数k、反射比、透射率,及光学带宽)等。在SE中,我们又附加了应力测试仪和FTIR这两个设备,从而增加了设备的功能性,通过应力测试仪,我们可以测试基片的应力。通过使用FTIR,我们可以测试a-Si:H的氢含量、Si-H/N-H的比,以及ITO的电阻值。其中,SE主要用于多层测试,SR主要用于单层测试。
(1)椭偏仪光学结构图:
工作原理:光线由非零度入射角至样品表面而反射, 因为样品的厚度及对光的反应(吸收或透明…)而产生极化状态的改变 (产生相位及振幅的改变), 此量测方式我们称为椭圆仪量测。量测时对于每个波长,得到两个独立的参数:ψ(膜层的入射角)和Δ(光程差),从而得到TAN(ψ)和COS(Δ)两个参数,然后使用模组公式来描述样品的物理参数, 求得 N,K,T. (使用WinElli分析软件)。
主要组成部分:
光学部分:
—光源:Xe灯(75W),短弧放电(Short arc)/高亮度(High brilliance)—极化偏光器(Polarizer):持续旋转,其频率为9Hz(可以得到最佳的S/N 比),使从光源发出的光变成线性偏振光,然后打到样品上。
—分析偏光器(Analyzer):角度由软件修正,使反射光变成椭圆偏振光,并接收。
—扫描系统(Scanning):PMT光电倍增管(photo multiplier tube)。这个模式主要是对接收到的偏振光进行逐个扫描并记录数据,从而得到想
要的参数。比CCD系统得到的参数更加精确,但是比较耗时。
— CCD系统:CCD(Charge-Coupled Devices)。这个模式是对接受到的偏振光进行整个的扫描和记录。测量时速度比较快。另外,CCD还分别被用来
对样品进行自动对焦和图形识别。
— Grating(光栅):解析度:0.08nm;线性分光(会产生second order效应)[Grating 正比于grating 的旋转角之余弦函数]
— Prism(棱镜):解析度:0.5nm;非线性分光(for order sorting)[Prism 正比于Prism的旋转角]
—讯号由HADAMART transform处理
?样品台:主要是用来装载测试样品的,它可以在X、Y、Z三个方向上运行。
?控制电源:用来控制整个设备的运作。
?电脑部分:由UPS(不间断电源)支持。当出现突然停电时,系统停止运行,
但是电脑可以在UPS的支持下,将未记录的测试数据及时记录下来,一般可维持十分钟左右。
应力测试仪:
应力测试仪是直接安装在椭偏仪上的,在测试过程中,我们不需要将样品从工作台上卸载,只要切换工作模式就可以进行应力测试。这个测试仪有两种装置,一种是将样品装载在pin(顶针)上,利用wavefront(波阵面)感应器来感应样品表面的偏差ΔZ,从而得出其弯曲度R;另一种是有条状的应力盘,通过自动对焦的方式来量测样品表面的偏差ΔZ,得出弯曲度R。
我们使用的是第一种方式,可测量在10Mpa—2000MPa范围的应力(压应力或张应力)。
傅立叶红外检测仪:
这个光学装置是直接附加在椭偏仪上的,在测试过程中,我们只要切换工作模式就可以进行相应的测量工作。
主要仪器组成:光源,麦克逊干涉仪,起偏器,微黑子,检测器,以及记录显示装置。
工作原理:利用红外光谱测量出膜层的折射率n和吸收系数k,通过得到的n、k值两个图形的峰值来计算Si:H或Si:N的含量比;在测量ITO时,可利用测得的图形的斜率来反推ITO的阻值。
(2)SR
SR原理图
分光反射仪实际上就是利用光的反射和干涉的原理来得到光程差,从而得到膜厚,并进一步得到折射率和吸收系数。
光信号路径是:从光源出发的可见光照射到膜层表面,形成表面反射和干涉,用玻璃纤维探测后,通过分光光度计进行波的分解,并进入CCD,经A/D 转换后将信号传到PC,用软件进行处理分析。
光谱曲线的形成:连续光照射后,经表面反射后得到一个反射光谱,同时部分光经过折射后进入下一个界面并反射出来,与之前的光谱形成叠加,出现干涉现象。从而得到光谱曲线。
根据测量而得到的光谱曲线图,经由系统软件分析后得出膜厚等其它参数。
主要组成部分:
测试控制单元:包括了支持测试的部分,支持电脑、监视器、控制器、
动力等部分。
?运动控制器:主要是利用马达控制光学头在X轴、Y轴、Z轴等方向上的运
动距离和速度,以完成测量的精确度。
?光学测量头:
— 2D(二维)的CCD:对图形的识别和记录。
—透镜旋转盘:上面有三个透镜,镜头倍率分别是5倍、10倍和20倍。
其中5倍的镜头是用来对准玻璃的,其他两个是用来进行膜厚测量的。
—光源:使用的好是钨丝卤素灯。
—分光探测器:使用的波长范围是400-800nm。
— L(线性旋转)运动控制。
?自动X、Y、Z工作台:工作台装载样品,光学头在X、Y、Z三个轴上运动,
通过自动对焦的方式进行测量。同时我们也可以利用手动的方式来对样品进行测量。
?设备主体框架:主要是用SUS不锈钢的材料做成。
?测试用的电脑等设备。
7.4.2.2 均一性
生长出膜质均一的a-Si:H薄膜也是获得a-Si:H和a-SiN X之间良好的界面特性的保证。在淀积a-Si:H薄膜过程中,减少绝缘层a-SiN X的缺陷,有助于减少界面态,提高TFT场效应迁移率和通态电流,对改善TFT电特性极为重要。
均一性计算公式:U%=(max-min)/(max+ min)*100%
7.4.2.3 元素成分比
a-SiN x∶H薄膜中的N/Si原子数比不但影响膜自身的物理特性(如带隙宽度、介电常数、电阻率等),而且还决定着a-SiN x∶H/ a-Si∶H的界面特性,所以控制a-SiN x∶H薄膜中的N/Si原子数比是非常重要的。[6]试验表明,调整NH3/SiH4流量比是有效控制a-SiN x∶H薄膜氮硅比的重要因素,并且随着SiH4/NH3流量比的增大,a-SiN x∶H薄膜中氮硅比逐渐增大,而折射率、介电常数以及生长速率均呈逐渐下降趋势。